Расчет параметров модели p-n перехода (плоскостного диода)
Министерство
образования Российской Федерации
ФГБОУ ВПО
«МОСКОВСКИЙ АВИАЦИОННЫЙ ИНСТИТУТ»
(национальный
исследовательский университет)
КУРСОВАЯ
РАБОТА
«Расчет
параметров модели p-n
перехода» (плоскостного диода)
Москва 2015
Работа 1. Вольт-амперные характеристики
полупроводникового диода
Цель работы:
. Расчет и построение вольт-амперных
характеристик полупроводникового диода при различных электрофизических
параметрах идеального p-n
перехода.
. Расчет и построение вольт-амперных характеристик
полупроводникового диода при учете сопротивления базы.
Исходные данные для проведения расчетов
Ln
= Lp = 0,8·10-2
см - диффузионные длины электронов и дырок в Si;
Ln
= Lp = 5·10-4
см - диффузионные длины электронов и дырок в GaAs;
NA
= 7·1016 см-3 - концентрация акцепторов;
ND
= 10·1014 см-3 - концентрация доноров;
Rб
= 45 Ом - сопротивление базы;
Sпер
= 9·10-4 см2 - площадь перехода;
Рмакс = 200·10-3 Вт -
максимальная рассеиваемая мощность в базе диода.
Определение величины обратного тока диодной
структуры I0
 ,
,
где  - концентрация неосновных носителей
в р-области (электронов в р-области) и
- концентрация неосновных носителей
в р-области (электронов в р-области) и  - концентрация неосновных носителей
в n-области
(дырок в n-области).
- концентрация неосновных носителей
в n-области
(дырок в n-области).
) Величина обратного тока кремниевого
диода
 см-3
см-3
 см-3
см-3
 9,75·10-14А
9,75·10-14А
) Величина обратного тока арсенид-галлиевого
диода
 см-3
см-3
 см-3
см-3

= 2,64·10-19 А
III. Расчет
вольт-амперной характеристики идеального перехода и зависимость
дифференциального сопротивления от напряжения
Вольт-амперная характеристика
идеального диода:

Дифференциальное сопротивление
идеального p-n перехода:

Тепловой потенциал
 В = 25,8 мВ.
В = 25,8 мВ.
величина прямого тока
 А = 66,6 мА.
А = 66,6 мА.
) Вольт-амперная характеристика
идеального кремниевого диода:

Рассмотрим обратную ветвь
вольт-амперной характеристики идеального диода, т.е. значения напряжения меньше
нуля U<0. Из
формулы  получаем,
что при
получаем,
что при  выражение
выражение  , что
эквивалентно формуле
, что
эквивалентно формуле  . Поэтому
обратная ветвь вольт-амперной характеристики идеального диода не зависит от
напряжения и равна постоянному значению I (U) = 9,75·10-14
(расчет значения приведен в подпункте 1 пункта II).
. Поэтому
обратная ветвь вольт-амперной характеристики идеального диода не зависит от
напряжения и равна постоянному значению I (U) = 9,75·10-14
(расчет значения приведен в подпункте 1 пункта II).
Прямая ветвь вольт-амперной
характеристики:
Дифференциальное сопротивление
идеального кремниевого p-n перехода:

Рис. 1

Дифференциальное сопротивление
идеального p-n перехода
при обратном смещении равно  т.к. ток не меняется, т.е. DI=0.
т.к. ток не меняется, т.е. DI=0.
Зависимость дифференциального
сопротивления от прямого напряжения:
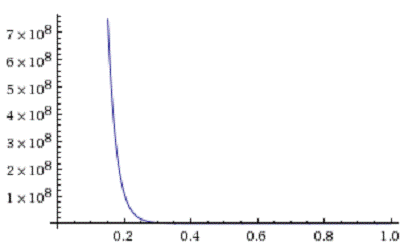
Рис. 3
2) Вольт-амперная характеристика
идеального арсенид-галлиевого диода:

Рассмотрим обратную ветвь
вольт-амперной характеристики идеального диода, т.е. значения напряжения меньше
нуля U<0. Из
формулы  получаем,
что при
получаем,
что при  выражение
выражение  , что
эквивалентно формуле
, что
эквивалентно формуле  . Поэтому
обратная ветвь вольт-амперной характеристики идеального диода не зависит от
напряжения и равна постоянному значению I (U) = 2,64·10-19
А (расчет значения приведен в подпункте 2 пункта II.
. Поэтому
обратная ветвь вольт-амперной характеристики идеального диода не зависит от
напряжения и равна постоянному значению I (U) = 2,64·10-19
А (расчет значения приведен в подпункте 2 пункта II.
Прямая ветвь вольт-амперной
характеристики (с увеличенным масштабом по оси абсцисс):

Рис. 4
Дифференциальное сопротивление
идеального арсенид-галлиевого p-n перехода:

Дифференциальное сопротивление
идеального p-n перехода
при обратном смещении равно  т.к. ток не меняется, т.е. DI=0.
т.к. ток не меняется, т.е. DI=0.
Зависимость дифференциального
сопротивления от прямого напряжения:

Рис. 5
Прямые ветви вольт-амперной
характеристики идеальных диодов:
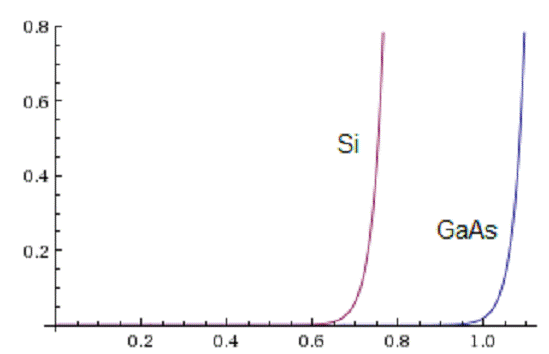
Рис. 6
IV. Расчет
вольт-амперной характеристики реального перехода и зависимость
дифференциального сопротивления от напряжения
Вольт-амперная характеристика
реального диода:

Для проведения расчетов используется
зависимость:
Дифференциальное сопротивление
реального p-n перехода

Обратный ток:

 ;
; 
1) Вольт-амперная характеристика реального кремниевого
диода:

Прямая ветвь:

Рис. 7
Обратный ток:

Обратная ветвь вольт-амперной
характеристики:

Рис. 8
Зависимость дифференциального
сопротивления от силы тока для прямого смещения:

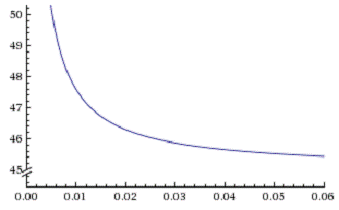
Рис. 9
Зависимость дифференциального
сопротивления от напряжения для обратного смещения:



Рис. 10
) Вольт-амперная характеристика
реального арсенид-галлиевого диода:

Прямая ветвь:
амперный диод напряжение

Рис. 11
Обратный ток:

Обратная ветвь:

Рис. 12
Зависимость дифференциального
сопротивления от напряжения для прямого смещения:

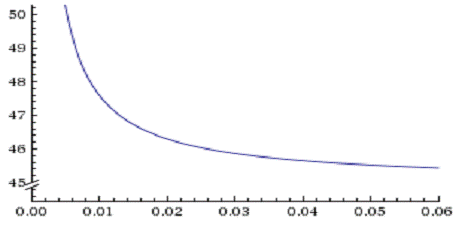
Рис. 13
Зависимость дифференциального
сопротивления от напряжения для обратного смещения:



Рис. 14
Прямые ветви вольт-амперной
характеристики реальных диодов:
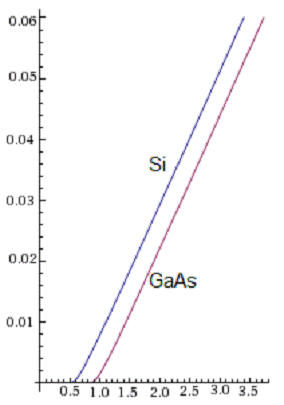
Рис. 15
В работе показано, что напряжение
открывания кремниевого диода меньше, чем арсенид-галлиевого, поскольку при
одинаковой температуре собственная концентрация кремния больше, чем арсенида
галлия, поэтому равновесная контактная разность потенциалов кремния меньше, чем
арсенида галлия. Следовательно, при равном внешнем напряжении, приложенном к
диоду, контактная разность потенциалов кремниевого меньше, чем
арсенид-галлиевого, и количество свободных носителей заряда (электронов и
дырок), перемещающихся через потенциальный барьер и обуславливающих ток,
протекающий через диод, в кремнии больше, чем в арсениде галлия. В арсенид
галлиевом диоде прямой и обратный токи меньше, чем в кремниевом.
Связано это с тем, что у арсенида
галлия ширина запрещенной зоны больше, именно поэтому для перехода носителей из
валентной зоны в зону проводимости им необходимо сообщить больше энергии. Так
же отметим, что величина обратного тока у кремниевого диода в рассмотренных
примерах больше, чем у арсенид галлиевого. А вязано с тем, что обратный ток -
ток неосновных носителей, которых в кремниевом переходе на порядки больше, чем
в арсенид галлиевом. При прямом включении внешнее напряжение создает в переходе
поле, которое противоположно по направлению внутреннему диффузионному полю.
Ширина перехода уменьшается, поэтому большое количество основных носителей
зарядов получает возможность диффузионно переходить в соседнюю область, а то
есть подвергаются инжекции (возникает диффузионный ток через переход).
Дифференциальное сопротивление p-n перехода,
определяемое формулой  , для прямой
ветви вольт-амперной характеристики уменьшается с ростом напряжения, потому что
увеличивается наклон зависимости I(U), т.к. при
возрастании напряжения ток возрастает экспоненциально. В реальном диоде
дифференциальное сопротивление для прямой ветви с ростом напряжение стремиться
к
, для прямой
ветви вольт-амперной характеристики уменьшается с ростом напряжения, потому что
увеличивается наклон зависимости I(U), т.к. при
возрастании напряжения ток возрастает экспоненциально. В реальном диоде
дифференциальное сопротивление для прямой ветви с ростом напряжение стремиться
к  .
.
Для обратной ветви вольт-амперной
характеристики идеального диода, т.е. при напряжении меньше нуля U<0, из
формулы  получаем,
что при
получаем,
что при  выражение
выражение  , что
эквивалентно формуле
, что
эквивалентно формуле  , т.е. ток
неизменен, поэтому дифференциальное сопротивление p-n перехода,
вычисляемое в виде
, т.е. ток
неизменен, поэтому дифференциальное сопротивление p-n перехода,
вычисляемое в виде  , равно
бесконечно большому значению. В реальном переходе дифференциальное
сопротивление остается большим.
, равно
бесконечно большому значению. В реальном переходе дифференциальное
сопротивление остается большим.
При обратном включении внешнее
напряжение создает электрическое поле, совпадающее по направлению с
диффузионным, что приводит к росту потенциального барьера и увеличению ширины
запирающего слоя. Таким образом уменьшается ток основных носителей, т.к. поле в
переходе их тормозит, а вот для неосновных носителей поле в переходе остается
ускоряющим, поэтому в переходе будет ток неосновных носителей (в переходе будет
наблюдаться явления экстракции - дрейфовый ток).
В реальном p-n переходе
сопротивление  влияет на
поведение ВАХ. Наличие споротивления базы приводит к тому, что напряжение от
источника распределяется между p-n переходом и
базовой областью. В формуле Шокли в показателе экспоненты стоит напряжение на
переходе, то при наличии сопротивления
влияет на
поведение ВАХ. Наличие споротивления базы приводит к тому, что напряжение от
источника распределяется между p-n переходом и
базовой областью. В формуле Шокли в показателе экспоненты стоит напряжение на
переходе, то при наличии сопротивления  , формула принимает вид
, формула принимает вид  . Из формулы
видно, что при малых токах I можно не учитывать напряжение на
. Из формулы
видно, что при малых токах I можно не учитывать напряжение на  , однако при
увеличении тока падение напряжения на базе может превысить напряжение на
переходе и на ВАХ появляется участок, близкий к линейному. Из расчетов видно,
что при одном и том же напряжении токи реального и идеального перехода сильно
отличаются.
, однако при
увеличении тока падение напряжения на базе может превысить напряжение на
переходе и на ВАХ появляется участок, близкий к линейному. Из расчетов видно,
что при одном и том же напряжении токи реального и идеального перехода сильно
отличаются.
Работа 2. Вольт-фарадные
характеристики полупроводникового диода
Цель работы:
. Расчет и построение зависимости
емкости обратно смещенного р-n перехода от напряжения.
. Определение диапазона электронной
перестройки частоты колебательного контура для заданных электрофизических
параметрах перехода.
Исходные данные для проведения
расчетов:
e
= 16 - диэлектрическая проницаемость германия;
e
= 12 - диэлектрическая проницаемость кремния;
ni = 2,5·1013
см-3 - собственная концентрация в германии;
ni = 2·1010
см-3 - собственная концентрация в кремнии;
NA = 7,0·1016
см-3 - концентрация акцепторов;
ND = 1015
см-3 - концентрация доноров;
Sпер = 10-6
м2 = 10-2 см2 - площадь перехода;
f0 = 100 МГц -
резонансная частота контура;
Lк = 20 мкГ -
эквивалентная индуктивность контура.
Определение зависимости барьерной и
диффузионной емкости от напряжения
Барьерная
емкость перехода вычисляется по формуле:

Тепловой потенциал  В = 25,8
мВ.
В = 25,8
мВ.


) Зависимость барьерной и
диффузионной емкости от напряжения германиевого диода.
Равновесная контактная разность
потенциалов:
 В.
В.
Барьерная емкость:


Диффузионная
емкость:

2) Зависимость барьерной и
диффузионной емкости от напряжения кремниевого диода.
 В
В



Определение зависимости толщины
обедненного слоя от напряжения обратного смещения перехода
Толщина
обедненного слоя вычисляется по формуле:

1) Зависимость толщины обедненного
слоя от напряжения германиевого диода.


) Зависимость толщины обедненного
слоя от напряжения кремниевого диода.


Графические зависимости барьерной
емкости и толщины обедненного слоя от напряжения обратного смещения перехода
1) Зависимость барьерной емкости от
напряжения германиевого диода.

Рис. 16
)
Зависимость барьерной емкости от напряжения кремниевого диода.

Рис. 17
) Зависимость толщины обедненного слоя от
напряжения германиевого диода.

Рис. 18
)
Зависимость толщины обедненного слоя от напряжения кремниевого диода.

Рис. 19
Графические зависимости диффузионной емкости от
напряжения прямого смещения перехода
) Зависимость диффузионной емкости от напряжения
германиевого диода.

Рис. 20
2) Зависимость диффузионной емкости от
напряжения кремниевого диода.

Рис. 21
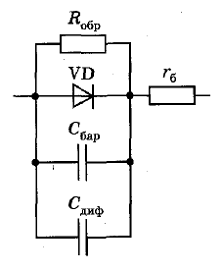
Рис. 22
Слева, на рисунке приведена эквивалентная схема p-n
перехода. На этом рисунке :
1. VD моделирует
идеализированный p-n
переход.
2.  объемное
сопротивление базы
объемное
сопротивление базы
.  обратное
сопротивление
обратное
сопротивление
.  барьерная
емкость
барьерная
емкость
.  диффузионная емкость
диффузионная емкость
Целью работы было проведение расчета и
построение зависимости емкости р-n перехода от напряжения. При подаче прямого
напряжения существуют две причины, обуславливаюие емкость p-n
перехода : изменение зарядов в обедненном слое и изменение концентрации
инжектированных носителей в нейтральных областях в близи границы p-n
перехода в зависимости от приложенного прямого напряжения.
На основе проведенных расчетов было установлено,
что барьерная емкость возрастает при увеличении внешнего напряжения,
приложенного к диоду, а толщина обедненного слоя уменьшается. Диффузионная
емкость возрастает экспоненциально при увеличении прямого напряжения. Барьерная
емкость, как и емкость обычных конденсаторов, возрастает при увеличении площади
p-n-перехода и диэлектрической проницаемости вещества полупроводника и
уменьшении толщины запирающего слоя. Особенность барьерной емкости состоит в
том, что она является нелинейной емкостью, т. е. изменяется при изменении
напряжения на переходе. Если обратное напряжение возрастает, то толщина
запирающего слоя увеличивается. А так как этот слой играет роль диэлектрика, то
барьерная емкость уменьшается. Барьерная (зарядная) емкость обусловлена
нескомпенсированным объемным зарядом ионов примесей, сосредоточенными по обе
стороны от границы р-n-перехода.
Из всех построенных графиков мы выяснили, что
при уменьшении обратного напряжения ширина перехода уменьшается, а барьерная
емкость увеличивается.
Так же от материала зависит амплитуда наклона
графика зависимости барьерной емкости от напряжения, так у Ge более резкий
наклон, чем у Si. А это значит, что у Ge быстрее возрастает емкость от
напряжения, а так же она больше. Ширина перехода тоже зависит от материала, для
Ge ширина может достигать большего значения, при одинаковых напряжениях.
Было определено, что при равных уровнях
легирования (концентрациях примесей) р- и n-областей
перехода и значениях обратного напряжения барьерная емкость германиевого диода
больше, т.к. диэлектрическая проницаемость германия больше, чем кремния, а
равновесная контактная разность потенциалов германия меньше, чем кремния.
Также, при равных уровнях легирования
(концентрациях примесей) р- и n-областей
перехода и значениях прямого напряжения диффузионная емкость германиевого диода
больше, чем кремниевого, т.к. собственная концентрация электронов и дырок при
одинаковой температуре, коэффициенты диффузий дырок и электронов, у германия
больше, чем кремния, при этом надо учитывать, что время жизни неосновных
носителей заряда у кремния хоть и больше, но не на существенную величину, что
вносит малый вклад в формировании диффузионной емкости. Диффузионная емкость
обусловлена изменением величины объемного заряда. Диффузионная емкость связана
с диффузией неосновных носителей, инжектированных через переход при прямом
смещении, и определяется зарядом этих носителей, накопленных за пределами
области перехода.