|
Размеры
ампулы
|
d=5-25 мм,
l=80-200
мм
|
5…17
|
|
Угол
конуса на кончике ампулы
|
≤
333К
|
|
Температура
источника
|
1073
- 1173 К
|
|
Температура
роста
|
973
- 1123 К
|
|
Разница
температур между кристаллами и исходным источником ∆Т
|
5
- 200 К
|
|
Температурный
градиент на поверхности роста dT/dx
|
0.5
- 50 К/см
|
|
Концентрация
йода
|
0.5
- 5 мкг/см3 объема ампулы
|
|
Время
роста
|
10
- 300 ч
|
.5.2 Технология PVT
PVT - метод аналогичен CVT - методу, но
транспортный реагент не используется. Этот метод, основанный на пересублимации
соединений, имеет некоторые преимущества над методами роста из расплава, а
именно:
) низкая температура роста;
) высокая степень очистки в результате различий
давлений паров собственных компонентов и примесей;
) наибольшая морфологическая стабильность
межфазных границ твердой - паровой фаз.- процесса управляется температурой
источника, парциальными давлениями паров Zn(г), Se2 в равновесии и
природой, давлением напускаемого газа [9].




Максимальная скорость массопереноса
имеет место при условии конгруэнтной сублимации, при этом состав паровой фазы,
по мнению авторов [10], становится стехиометрическим:

С целью установления конгруэнтной
сублимации были разработаны различные закрытые и полуоткрытые PVT - системы.
Одна из них была описана в работах, где подключали капилляр к ампуле, чтобы
получить кристаллы стехиометрического состава путем снижения общего давления до
минимального значения, соответствующего конгруэнтной сублимации. Далее авторы
подобрали условия, отвечающие максимальной скорости роста кристаллов. [11]
Высококачественные кристаллы
диаметром 40 - 55 мм были получены методом Маркова - Давыдова без контакта
выращенного кристалла со стенками реактора, предотвращающего растрескивание
кристалла при охлаждении и образование поликристаллического слитка. Затравка
ZnSe в виде ориентированной пластины толщиной 1,5 ÷ 2 мм
располагалась на особо чистом полированном сапфировом пьедестале в
осесимметричном тепловом поле. Над затравкой в верхней части реактора
размещался поликристаллический слиток ZnSe в качестве шихты. Гелий для
физического транспорта и водород или его смесь с аргоном для химического
транспорта были использованы в качестве транспортных газов. В запаянной ампуле
общее давление было постоянным для всех процессов и составляло около 1 атм при
рабочих температурах (1453 - 1473 K). После процесса роста кристалла печь
охлаждали со скоростью не более 50 K/ч. Нижний конец ампулы, находящийся при
комнатной температуре, служил емкостью для отгонки легколетучих примесей и избыточных
компонентов [12] рисунок ниже.
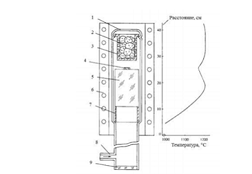
Рис.2. Схема ростовой ампулы и
температурный профиль для выращивания кристаллов ZnSe из паровой
фазы методом Маркова - Давыдова: 1 - ампула, 2 - шихта, 3 - камера, 4 -
затравка, 5 - подставка, 6 - печь, 7 - опора, 8 - газоснабжение, 9 - окно.
.5.3 Технология CVD
CVD метод является одним из наиболее
перспективных методов получения селенида цинка. Высокочистые кристаллы CVD-ZnSe
могут быть получены различными технологиями, но их однородность, оптические
свойства и механическая прочность существенно отличаются. В работах [13,14]
были представлены типичные реакции для приготовления поликристаллов CVD-ZnSe:





где Hal
= Br, Cl
и R = CnH2n+1,
n = 1, 2, 3.
Кристаллы селенида цинка, полученные по реакции
(1.1) могут содержать примеси галогенов, которые снижают оптические свойства.
Использование элементоорганических соединений цинка и селена, имеющих
достаточно высокую летучесть и высокую реактивность, при проведении химического
осаждения по реакциям (1.2, 1.3) позволяет снизить температуру процесса до 200
- 500 °С и обойтись без газа-носителя, который является потенциальным
источником загрязняющих примесей. Однако эти вещества приводят к загрязнению
углеродом и разнообразию реакций, протекающих в адсорбционном слое на
поверхности растущего кристалла. [15]
Поликристаллические слои ZnSe были получены по
реакции (1.4) под низким давлением в различных системах Zn - Se - H2
-Ar и Zn - H2Se - Ar при температуре от 480 до 800 °C и давлении от
0,7 - 6 кПа [21]. Процесс осаждения проводили в горизонтальных или вертикальных
реакторах. В качестве подложки использовали стеклоуглерод и кварцевое стекло. В
результате работы было обнаружено, что микроморфология и кристаллическая
структура полученного материала сильно зависят от условий осаждения и механизма
зародышеобразования. Тем не менее, качество полученного материала не было
достаточно высоким.
Вышесказанные проблемы могут быть решены с
помощью метода химического осаждения из газовой фазы с использованием паров
элементарного цинка и селеноводорода по реакции (1.5). В этом случае удалось
вырастить крупногабаритные, однородные и высокопрозрачные образцы селенида
цинка. Поток паров цинка с аргоном поступал в реактор, где они смешивались с
селеноводородом, предварительно также разбавленным аргоном. Температура в зоне
реакции составляла 600 - 800 °C при общем давлении менее 104 Па. В качестве
подложки использовали графитовые или стеклоуглеродные пластины. Несмотря на
высокую стоимость, именно этот метод нашел промышленное применение. [16]
Исследуя влияние газостатической обработки CVD-ZnSe на его оптическое и
механическое свойства, было обнаружено, что рекристаллизация CVD-ZnSe при
высоких температурах (1083 - 1473 K) и высоких статических давлениях (PAr
= 89 - 200 МПа) приводит к увеличению размера зерен поликристаллов (от 40 - 60
мкм до 250 - 300 мкм), приближению состава кристаллов к стехиометрическому,
уменьшению содержания дефектов и упорядочению кристаллической структуры.
Упругопластические свойства CVD-ZnSe улучшались и пропускание образцов в
видимой и ближней ИК области спектра повышалось.
.6 Эпитаксия селенида цинка на
пористом кремнии
В последние годы предпринимаются попытки
выращивания ZnSe на кремнии. Кремний является основным материалом
микроэлектроники, доступен в виде высококачественных пластин большого диаметра
и имеет приемлемую стоимость. Кроме того, принципиально важным его
преимуществом является наличие хорошо отработанной технологии, позволяющей
получать интегральные схемы высокой степени интеграции, вплоть до
высокопроизводительных процессоров. Последнее обстоятельство открывает
возможность реализации на пленках селенида цинка на кремнии совмещенных
сенсорных и коммуникационных устройств.
Однако прямая эпитаксия селенида цинка на
кремнии затруднена относительно большим рассогласованием параметров
кристаллической решетки (~4 %). Не смотря на это, предпринимались
экспериментальные попытки реализовать эту задачу методом молекулярно-лучевой
эпитаксии. [17] Разработана методика выращивания на кремнии с пористым буферным
слоем эпитаксиальных пленок селенида цинка.
Выращивание пленок селенида цинка осуществляется
методом термического испарения из ячейки Кнудсена в вакууме 5×10-6
Тор. В качестве подложек используются пластины монокристаллического кремния
легированного сурьмой до концентрации 4×1018
, со сформированным на их рабочей поверхности пористым слоем. Используются
также подложки из монолитного кремния, для сравнения, и прозрачные стеклянные
подложки - для оптических исследований. Пористый слой на кремниевых пластинах
формируется электрохимическим травлением монолитного кремния в растворе
фтористоводородной кислоты в изопропиловом спирте, взятых в соотношении 1:3,
при плотности тока 50 мА/см2 . Непосредственно перед вакуумированием
установки кремниевые подложки подвергаются травлению в смеси состава HF : H2O
= 1: 10, в течение 5 секунд. В качестве исходного материала для осаждения ZnSe
используются предварительно синтезированный из высокочистых элементарных
компонент поликристаллический селенид цинка. Синтез осуществляется в
вакуумированных до остаточного давления 10-5 Тор кварцевых ампулах.
Пленка, полученная осажденные на стеклянной
подложке прозрачна в спектральном диапазоне 500-3000 нм, у нее наблюдается
четкий край фундаментального поглощения, положение которого соответствует
селениду цинка. Наблюдается также интерференция, характерная для пленок
высокого оптического качества.
В случае осаждения ZnSe на пористом слое кремния
растут сплошные эпитаксиальные пленки. Полученные пленки по структурному
совершенству превосходят пленки ZnSe, осажденные на пористый кремний методом
CVD. [18]
В случае осаждения селенида цинка на подложку из
монолитного кремния также растет в целом эпитаксиальная пленка, но не сплошная.
При этом способе получения пленок результаты
демонстрируют эффективность использования пористого кремния в качестве
буферного слоя при эпитаксии на кремнии селенида цинка, что повышает
перспективы использования этого материала в микроэлектронике. [3]
3. Легирование полупроводников
Легирование полупроводникового материала - это
контролируемое введение необходимой концентрации определенной примеси. В
настоящее время в технике используются материалы с разной степенью легирования
- от очень «чистых» кристаллов с концентрацией электрически активной примеси
менее 1012 см-3 до сильно легированных с концентрацией
примеси более 1020 см-3. Планарная технология
изготовления полупроводниковых приборов предъявляет все более жесткие
требования к технике легирования. Это прежде всего получение равномерно
легированных кристаллов и тонких слоев (1 - 10 мкм) и легирование небольших
объемов сложной конфигурации. По этой причине методы легирования развиваются и
совершенствуются. [19]
.1 Способы легирования
полупроводников
Легирование выращенных кристаллов осуществляется
методом диффузии примеси, методом радиационного легирования и методом ионной
имплантации. Так же легирование кристаллов можно проводить в процессе
выращивания из жидкой и газовой фазы. [20]
.1.1 Метод диффузии примеси
Процессы диффузии очень распространены и играют
огромную роль во многих важнейших технологических процессах получения и
обработки полупроводников, а также при фазовых и структурных превращениях.
Диффузия примесей лежит в основе процесса гомогенизации свойств материала при
термообработках, в ряде случаев лимитирует очистку, играет огромную роль при распаде
пересыщенных твердых растворов, их упорядочении и разупорядочении. Процессы
диффузии используются для получения p−n-переходов для формирования
базовых и эмиттерных областей и резисторов в биполярной технологии изготовления
полупроводниковых приборов, для создания областей истока и стока в
МОП-технологии и т. д.
Под диффузией понимают процесс установления
внутри кристалла равновесного распределения концентраций, обусловленный
тепловым движением атомов и реализуемый обычно их перемещением. Элементарный акт
диффузии состоит в скачке атома на расстояние порядка межатомного, то есть
переходе из одного равновесного положения в решетке в другое.
Для совершения элементарного акта диффузии атом
должен преодолеть энергетический барьер, величина которого определяется
энергией активации диффузии. Последняя зависит от прочности связи атомов в
кристаллической решетке вещества. В зависимости от конкретного механизма
диффузии энергией активации по порядку величины может составить от долей до
нескольких эВ.
Единого универсального механизма диффузионных
перемещений для всех материалов и условий нет. Эти механизмы зависят от природы
химических связей, типа и компактности решетки, природы диффундирующей примеси,
температуры диффузии и других факторов. В некоторых веществах диффузионные
перемещения могут происходить по нескольким механизмам одновременно или с
изменением условий диффузии может меняться и ее механизм. Наиболее вероятны
следующие механизмы диффузии: междоузельный (перемещение атомов по
междоузлиям), вакансионный (перемещение атомов по вакансиям), кольцевой или
обменный (прямой обмен местами между атомами) и диссоциативный. [20]
Несмотря на большие усилия многих
экспериментаторов и теоретиков, предсказать достаточно точно результат диффузии
не всегда удастся. Кроме того, возникают чисто технические трудности при
легировании тонких шайб большого диаметра и при получении очень тонких
легированных слоев (~1 мкм). Первая трудность обусловлена тем, что диффузия
примеси обычно происходит при высоких температурах (1100-1350°С) и длительное
время, что приводит к деформации шайбы; вторая - невозможностью воспроизводимо
проводить диффузию на очень малые глубины. [19]
Таким образом метод диффузии в технологии
производства объемных легированных материалов не получил распространения из-за
малых скоростей диффузии в кристаллах. Тем не менее, сами процессы диффузии
играют большую роль в технологии получения и обработки полупроводниковых
материалов и создании приборов на их основе. [20]
.1.2 Метод радиационного легирования
Суть радиационного (или трансмутационного)
метода легирования выращенных кристаллов состоит в том что, при облучении
кристаллов полупроводников и диэлектриков ядерными частицами (нейтронами,
протонами, γ-квантами и др.) в
результате протекания ядерных реакций может происходить превращение части
атомов основного вещества в атомы других химических элементов, которые
отсутствовали ранее в веществе. [20] Первые эксперименты по радиационному
легированию полупроводникового материала проведены на германии, затем на кремнии
и бинарных соединениях. [19]
При взаимодействии нейтронов с изотопами
соединения образуются возбужденные составные ядра. Для составного ядра
существует несколько энергетически возможных путей распада, например: излучение
γ-квантами,
рассеивание нейтронов, испускание одной или нескольких частиц. Эти реакции
конкурируют между собой, и при определенных условиях осуществляется только одна
из них. Например, в кремнии под действием тепловых нейтронов происходит
реакция, приводящая к образованию легирующей добавки - фосфора.
Остановимся на некоторых побочных явлениях,
наблюдаемых при трансмутационном легировании полупроводникового материала. Это,
прежде всего искусственная, или наведенная, радиоактивность.
Следует различать активность поверхности и
объема образца. Активность поверхности слагается из активности примесей,
которые были на поверхности образца, и продуктов коррозии и распыления
материалов реактора (при использовании нейтронов). Активность объема вызвана
ядерными реакциями с существующими примесями и атомами матрицы. От
поверхностной активности избавляются путем механической или химической очистки
поверхности слитка. Объемная активность зависит от периода полураспада активных
изотопов. Например, период полураспада изотопа кремния Si31
(превращение Si31 в Р31) равен 2,6 ч, и активность
спадает до безопасного уровня за несколько дней. В тоже время изотопы германия
имеют период полураспада 76 дней, и приходится много месяцев выжидать, когда
радиоактивность спадет до безопасного уровня. Уже из этих примеров ясно, что
при трансмутационном легировании следует избегать использования элементов с
долгоживущими радиоактивными изотопами. [19]
.1.3 Метод ионной имплантации
Ионной имплантацией называют введение атомов в
приповерхностный слой материала подложки путем бомбардировки ее ионами с
энергией от нескольких килоэлектронвольт до нескольких мегаэлектронвольт. [19]
Метод ионного легирования весьма перспективен
для полупроводниковой электроники, а в ряде случаев обладает несомненными
преимуществами по сравнению с традиционными способами легирования (диффузия,
легирование из расплава). Преимущества этого метода в основном связаны с
нетепловым характером легирования.
К ним относятся:
) универсальность, т. е. возможность введения
любой примеси в любое твердое вещество;
) низкотемпературность - обычно сопутствующий
отжиг проводится при температурах существенно более низких, чем при
диффузионном легировании, что позволяет избежать нежелательных
высокотемпературных воздействий на полупроводниковый материал (например, искажения
плоскости фронта легирования);
) возможность гибкого управления распределением
примеси во всех трех измерениях путем вариации энергии ионов, применения
защитных масок и сканирования пучка;
) возможность строгой дозировки примеси при
легировании с помощью точного контроля плотности тока ионов и времени
облучения;
) возможность легирования через диэлектрические
и металлические покрытия.
В то же время методу ионного легирования присущи
некоторые ограничения и недостатки:
) малость глубины проникновения ионов;
) наличие радиационных дефектов;
) недостаточная изученность физических процессов
при ионном легировании;
) относительная сложность оборудования на данном
этапе развития метода.
Учитывая все недостатки и преимущества метода,
можно утверждать, что он не отрицает других способов легирования, напротив, в
сочетании с ними становится одной из важнейших составных частей полупроводниковой
технологии. [19]
.1.4 Легирование кристаллов в
процессе выращивания из жидкой фазы
Рассмотрим особенности легирования кристаллов в
процессе их выращивания из жидкой фазы. Широко применяемым методом получения
легированных монокристаллов полупроводников является выращивание их из
расплава, к которому добавлена нужная примесь. [19]
При выборе примесей для легирования необходимо
учитывать величину коэффициента разделения и ее изменение при изменении условий
выращивания. Эти факторы являются чрезвычайно важными для получения
монокристаллов с равномерным распределением примесей из-за принципиальной
однократности процесса легирования и невозможности исправления ошибок в
дозировании примеси. [19]
В случае если коэффициент разделения меньше
нуля, тогда если скорость роста кристалла больше, чем скорость выравнивания
состава в жидкой фазе, то из-за оттеснения примеси из твердой фазы в жидкую и
замедленности диффузионных процессов установления равновесия в жидкой фазе
концентрация примеси в расплаве у границы раздела будет возрастать. Накопление
избытка примеси приведет к образованию перед движущимся фронтом кристаллизации
диффузионного слоя, из которого примесь путем диффузии переходит в объем
расплава. Если коэффициент разделения больше нуля, то вблизи поверхности роста
ощущается недостаток примеси.
При выборе примеси важным является учет ее
чистоты, так как попадание в растущий кристалл вместе с легирующей примесью
неконтролируемых сопутствующих примесей даже в очень малых количествах может
приводить к существенному ухудшению параметров выращиваемых кристаллов
(например, существенно снижать время жизни неосновных носителей заряда).
Поэтому перед легированием оценивают требуемую чистоту легирующего элемента с
учетом особенностей используемого метода легирования и допустимого содержания в
легируемом кристалле посторонних примесей. [19]
3.1.5 Легирование кристаллов в
процессе выращивания из газовой фазы
Применение тех или иных методов легирования
кристаллов в конечном итоге определяется способом выращивания их из газовой
фазы. При выращивании кристаллов химическим осаждением из газовой фазы в
соответствии со способом получения легирующей парагазовой смеси заданного
состава различают следующие основные методы легирования:
. Метод жидкостного легирования (или жидких
лигатур).
. Метод индивидуальных легирующих соединений.
В методе жидкостного легирования источником
легирующей примеси является разбавленный раствор жидкого соединения этой
примеси в жидком источнике основного осаждаемого элемента.
Этот метод удобен тем, что фиксирует заданное
отношение концентрации примеси и основы как в жидкой, так и в газовой фазах
независимо от расхода газа-носителя через испаритель. В этом методе
используются главным образом жидкие лигатуры, имеющие при 25 °С упругость пара
600-27000 Па. Так как обычно требуемая концентрация примеси в кристалле
невелика, то в методе жидких лигатур используют чаще всего многократное
разбавление, в результате которого получают разбавленные растворы с
относительным содержанием примеси от 10-9 до 10-2, что
обеспечивает уровень легирования от 1020 до 1023 ат/м3.
Метод индивидуальных легирующих соединений
обладает значительно лучшей управляемостью процессом легирования по сравнению с
предыдущим. Это достигается за счет применения отдельного потока с примесным
соединением, который перед зоной роста кристалла смешивается с основным потоком
реагирующих газов. Поток с заданной концентрацией примесного соединения
формируют путем пропускания транспортирующего газа через отдельный испаритель с
жидким примесным соединением либо с использованием газообразных (в рабочих
условиях) примесных соединений. Поскольку содержание легирующего соединения в
газовой фазе, как правило, должно быть достаточно малым, в качестве легирующих
соединений целесообразно применять соединения с высокой температурой кипения.
При применении сравнительно легколетучих примесных соединений транспортирующий
газ, прошедший через испаритель, приходится дополнительно разбавлять до
заданной низкой концентрации легирующего вещества, что усложняет систему
газораспределения и снижает воспроизводимость получения низких концентраций
легирующих примесей в кристаллах. Метод же легирования индивидуальным
высококипящим соединением обеспечивает получение этой концентрации уже при
испарении легирующего вещества. Уровень легирования кристаллов примесью в этом
случае задается потоком транспортирующего газа через испаритель и температурой
испарителя.
Жидкостный метод легирования индивидуальным
легирующим веществом имеет следующие недостатки: недостаточно гибок в случае
необходимости программирования уровня легирования кристалла в процессе его
роста, так как управление процессом в широком интервале концентраций примеси в
кристалле (1020 - 1026 ат/м3) в пределах одной
установки сложно; применяемые примесные соединения адсорбируются на стенках
газопроводов и реакторов, создавая фон после проведения предыдущего процесса. В
результате этого в последующих процессах получение кристаллов с более низким
содержанием примеси возможно только лишь после тщательной промывки газовой
системы и реактора.
В настоящее время наиболее развитыми и
распространенными методами, обеспечивающими вполне удовлетворительную
воспроизводимость уровня легирования, в частности при использовании серийного
оборудования для получения эпитаксиальных слоев являются методы индивидуальных
легирующих соединений. [21]
3.2 Легирующие добавки селенида
цинка и свойства, легированных образцов
Опыт физико-химического исследования
полупроводников свидетельствует о том, что одними из наиболее значимых с точки
зрения практического применения являются монокристаллы, легированные различными
переходными металлами. [22]
Атомы переходных металлов замещают атомы металла
полупроводникового соединения и находятся в тетраэдрическом окружении, в
отличие от октаэдрического окружения, реализующегося в широко применяемых в
настоящее время лазерных материалах на основе легированных переходными
металлами диэлектриков. Это обстоятельство, а также значительно более слабое
кулоновское взаимодействия примесных атомов с атомами кристаллической решетки в
полупроводниках приводят к смещению частот основных d-d переходов из ближней ИК
области, характерной для диэлектрических материалов, в среднюю (2-3 мкм).
Одновременно вследствие уменьшения координационного числа и слабого электрон-фононного
взаимодействия при переходе к полупроводниковым кристаллическим матрицам
значительно уменьшается вероятность безизлучательных переходов электронов в
ионах переходных металлов.
Эти особенности полупроводниковых матриц
обуславливают высокий квантовый выход люминесценции в среднем ИК диапазоне при
комнатной температуре, что в сочетании с характерным для ионов переходных
металлов широким спектром люминесценции, делает материалы этого класса
перспективными для применения в качестве генерирующих сред твердотельных
перестраиваемых лазеров с диодной накачкой. Одновременно они представляют
интерес с точки зрения применения в качестве пассивных затворов для лазеров
ближнего ИК диапазона (1,5-2 мкм) вследствие наблюдаемого в них насыщения
поглощения при относительно небольших интенсивностях лазерного излучения. [23]
Легирование селенида цинка может происходить
различными металлами. В качестве легирующих наиболее часто используют следующие
элементы: Сr, Fe,
Ni, Со, Сu,
Ag. [24]
Селенид цинка легированный хромом является одним
из наиболее исследуемым халькогенидов цинка. Спектроскопическими особенностями
этого материала являются близкий к единице квантовых выход при комнатной
температуре, появление в спектрах поглощения одной широкой полосы с максимумом
1780 нм, обусловленной переходами ионов Cr2+. При увеличении
концентрации хрома интенсивность примесной полосы пропорционально
увеличивается. Спектр люминесценции при комнатной температуре так же как и
спектр поглощения содержит одну широкую полосу 2600 нм. [23]
Легирование селенида цинка железом приводит к
появлению в спектре коэффициента поглощения одной широкой полосы с максимумом
около 3000 нм, обусловленной электронно-колебательными переходами ионов Fe2+
замещающих катионы тетраэдрически координированных ионов Zn2+
селенида цинка и небольшому сдвигу в длинноволновую сторону края
фундаментального поглощения. При этом визуальная прозрачность кристалла
сохраняется, лишь немного изменяется цвет: от желтого к желто-зеленому, с
преобладанием желтого. Одновременно заметно возрастают оптические потери в
диапазоне длин волн 500- 6000 нм. Исследована фотолюминесценция кристаллов.
Установлено, что легирование железом приводит к разгоранию широкой полосы
люминесценции с максимумом в области 655 нм. Установлен рост интенсивности
люминесценции с увеличением концентрации примеси. [25]
Селенид цинка легированный никелем характеризуется
полосами поглощения на 1.41, 1.46 и 1.53 эВ. Интенсивность этих полос
возрастает с увеличением концентрации никеля. В то же время, положение этих полос
не меняется с изменением температуры кристаллов. В средней ИК-области кристаллы
характеризуются полосой поглощения на 1.1 эВ. Положение этих полос поглощения
так же не менялось с изменением температуры, что свидетельствует о
внутрицентровом характере оптических переходов, происходящие в пределах иона
Ni. По мере увеличения степени легирования кристаллов происходит размытие полос
поглощения. Аналогичное размытие структуры линий имеет место и в спектрах
поглощения в ближней ИК-области. Очевидно, это связано с проявлением
межпримесного взаимодействия ионов Ni2+. [25] Так же в кристаллах обнаружен эффект гигантского
теплосопротивления в области 15К, возрастающего более чем в 200 раз по
сравнению с теплосопротивлением чистого ZnSe. Этот эффект объяснен резонансным
рассеянием акустических фононов на внутрицентровых состояниях иона Ni2+, образованных вследствие сильного статического эффекта ЯТ
тригонального типа для основного орбитального триплета. [26]
Селенид цинка, легированный кобальтом, имеет
большое поперечное сечение поглощения и слабое поглощение возбужденным
состоянием в области 1.5 мкм что позволяет использовать его в качестве
насыщаемого поглотителя для чрезвычайно важного диапазона - лазера на стекле с
эрбием в диапазоне 1.54 мкм. [27]
Кристаллы, легированные медью участвуют в
формировании центров свечения, ответственных за люминесценцию селенида цинка в
длинноволновой красной и зеленой области спектра. [28] Отмечают, что центрами
ответственными за красную и зеленую люминесценцию являются одно- и двухзарядные
состояния примеси меди, замещающей атомы Zn
в решетке селенида цинка.(330900) Спектры возбуждения полос зеленого излучение
имеют длину волны 530 нм, а красного - 640 нм. Исследование температурной
зависимости спектров фотолюминесценции кристаллов селенида цинка в интервале от
77 до 400 K позволило установить, что до температуры порядка 120 K имеет место
постоянный темп гашения интенсивности полос красного и зеленого свечения. При
более высоких температурах наблюдается резкое гашение интенсивности полосы
зеленого излучения, которая при 150 K полностью гасится, в то время как
излучение в красной области спектра наблюдается до 400 K. [28]
Селенид цинка легированный серебром
имеет спектры индуцированной примесной фотопроводимости, которые состоят из
одной дискретной полосы с энергией 0.31 эВ. Эти центры прилипания наблюдаемые
только в кристаллах ZnSe, легированных серебром, связаны, с междоузельными
донорами, которые (перед возбуждением) имеют не спаренный электрон в 5s1
- состоянии. При фотовозбуждении кристаллов ZnSe легированных Ag при
температуре больше 140 К возможна многократная перезарядка этих центров
прилипания, что приводит к уменьшению интенсивности полосы, связанной с
примесными частицами Ag появлению линейчатых спектров, обусловленных образованием
молекул типа Ag2. [22]
Заключение
При написании курсовой работы были
изучены способы получения селенида цинка различными методами, такими как, осаждение
из водных растворов сульфида цинка, выращивание из расплава под давлением
инертного газа, сублимация в высоком вакууме, метод самораспространяющегося
высокотемпературного синтеза и метод химического осаждения из газовой фазы. Так
же были рассмотрены способы легирования, такие как, метод диффузии примеси,
метод радиационного легирования, метод ионной имплантации и легирование
кристаллов в процессе выращивания из жидкой и газовой фазы. Было изучено
влияние легирующих примесей на оптические, фотоэлектрические, люминесцентные
свойства образцов селенида цинка.
Библиографический список
1. Оболончик В. А. Селениды -
М.: Изд-во «Металлургия», 1972. - с. 296.
. Гаврищук Е. М. Получение
высокочистого селенида цинка для ИК-оптики: автореф. дис. док. хим. наук:
02.00.19 / Е.М. Гаврищук. - Нижний Новгород, 2000. - 52 с.
. Постнова Л. И., Левченко В.
И., Бондаренко В. П. Эпитаксия селенида цинка на пористом кремнии. - Минск: ГО
«НПЦ НАН Беларуси по материаловедению», 2015. - С. 100 - 102.
. Пат. 2170291 Украина, МПК
C30B. Способ получения полупроводникового материала n-типа на основе селенида
цинка / В. Д. Рыжиков [и др.]; заявитель и патентообладатель
Научно-технологический центр радиационного приборостроения. - № 2000105304/12;
заявл. 03.03.00; опубл. 10.07.01. - 5 с.
. Пат. 2019586 Российская
Федерация, МПК C30B23/00, C30B29/48. Способ получения оптических поликристаллических
блоков селенида цинка / Г. П. Егоркина, Ю. Н. Жилов, В. С. Карасев, Ю. С.
Рыжкин; заявитель и патентообладатель Научно-производственное объединение
"Государственный институт прикладной химии". - № 5042141/26; заявл.
12.05.92; опубл. 15.09.94. - 2 с.
. Дунаев А. А., Гарибин Е.
А., Гусев П. Е., Демиденко А. А., Егорова И. Л., Миронов И. А. Сырье для
выращивания поликристаллического оптического селенида цинка. - СПб: ЗАО
«ИНКРОМ», 2000. - 4 с.
. Кхань Ч. К. Нестехиометрия
и люминесцентные свойства кристаллического селенида цинка: дис. канд. хим.
наук: 05.27.06 / Ч. К. Кхань. - Москва, 2016. - 117 с.
8. Böttcher K., Hartmann
H. Zinc selenide single crystal growth by chemical
transport reactions // J Crystal Growth. 1995. V. 146. P. 53-58.
. Muranoi T., Shiohara
T., Sotokawa A., Yoshida H., Isobe S., Kanbe N. Gaseffect on transport rates of
ZnSe in closed ampoules // J Cryst. Growth. 1995. V. 146. P. 49-52.
. Kiyosawa T., Igaki
K., Ohashi N. Vapor phase crystal growth of zinc selenide under controlled
partial pressure and its crystal structure // Trans. Jap. Inst. Metals. 1972.
V. 13. P. 248-254.
. Blanconnier P., Henoc
P. Croissance epitaxique des composes II-VI en phase vapeur // J Cryst. Growth.
1972. V. 17. P. 218-221.
. Markov E. V., Davydov
A. A. Growing oriented single crystals of CdS from the vapor phase // Neorg.
Mater.1975. V. 11. P. 1755-1758.
. Vladyko M. N.,
Dernovskii V. I., and Tatarchenko V. A. Polycrystalline Zinc Selenide // Izv.
Akad. Nauk SSSR, Neorg. Mater. 1986. V. 22. N. 2. P. 208-210.
. Hartman H., Hildisch
L., Krause E., and Mohling W. Morphological Stability and Crystal Structure of
CVD Grown Zinc Selenide // J. Mater. Sci. 1991.V. 26. P. 4917-4923.
. Manasevit H. M.,
Simpson W. I. The use of metal - organic in the preparation of semiconductor
materials // J. Electrochem. Soc. 1971. V. 118. N. 4. P. 644.
16. Жук Б. В., Хамылов В. Н.,
Каверин Б. С., Домрачев Г. А. Кристаллизация селенида цинка при реакции
цинкорганического соединения и селеноводорода // Поверхность (физ,хим,мех). -
1982. - № 7. - С. 112.
. Mino
N., Kobayashi M., Konagy M., Takahashi K. J. Appl. Phys.
Sci. 1985. V.
58. P. 793.
18. Chang C. C., Lee C. H.
J. Mater. Sci. 2001 V.
136. P. 3801.
. Смирнов Л. С. Легирование
полупроводников методом ядерных реакций. - Новосибирск.: Наука, 1981. - 184 с.
. Случинская И. А. Основы
материаловедения и технологии полупроводников. - М.: Мир, 2002. - 376 с.
. Таиров Ю. М., Цветков В.
Ф. Технология полупроводниковых и диэлектрических материалов: учебник для вузов
/ Таиров Ю. М., Цветков В. Ф. - 3-е изд., стер. - СПб.: Изд-во «Лань», 2002. -
424 с.
. Солтамурадов Г. Д.
Фотохимические процессы в легированных кристаллах сульфоселенида кадмия и
селенида цинка: автореф. дис. канд. хим. наук: 02. 00. 04 / Г. Д Солтамурадов.
- Махачкала, 2012. - 15 с.
. Левченко В. И., Якимович
В. Н., Постнова Л. И., [и др]. Новые лазерные материалы на основе легированных
переходными металлами полупроводниковых соединений A2B6.
- Минск: Международный лазерный центр, 2015. - С. 389 - 406.
. Арзамасов Б. Н., Макарова
В. И., Мухин Г. Г. [и др]. Материаловедение: учебник для вузов/ Арзамасов Б.
Н., Макарова В. И., Мухин Г. Г. [и др]; под общ. ред. Б. Н. Арзамасова, Г.Г.
Мухина. - 8 - е изд., стер. - М.: Изд-во МГТУ им. Н.Э. Баумана, 2008. - 648 с.
. Яцун В. В., Молчиниколов
П. А. Оптические свойства кристаллов селенида цинка легированных никелем. -
Одесса.: Одесский национальный ун-т им. И.И.Мечникова, 2008. - С. 2-3.
. Лончаков А. Т. Тепловые и
акустические свойства соединений II-VI с примесями 3d - переходных металлов:
автореф. дис. док. физ.-мат. наук: 01.04.10 / А. Т. Лончаков. - Екатеринбург,
2010. - 37 с.
. Крамущенко Д. Д., Ильин И.
В., Солтамов В. А. и др. ЭПР-диагностика лазерных материалов на основе
кристаллов ZnSe, активированных переходными элементами. - СПб.:
Физико-технический институт им. А.Ф. Иоффе РАН, 2012. - С. 234-242.
. Иванова Г. Н., Касиян В.
А., Недеогло Д. Д., Опря С. В. Влияние способа легирования кристаллов n-ZnSe
медью на структуру центров свечения длинноволновой люминесценции. - Кишинев:
Молдавский государственный ун-т, 1997. - С. 171 - 177.