Исследование электрофизических параметров полупроводниковых материалов
Содержание
Введение
1. Основные электрофизические свойства полупроводниковых материалов
1.1 Основы зонной теории твердого тела
1.2 Энергетические зоны полупроводников
1.3 Генерация и рекомбинация носителей заряда
1.4 Собственные полупроводники
1.5 Примесные полупроводники
1.6 Определение удельного сопротивления полупроводников
1.7 Температурная зависимость электропроводности полупроводников
1.8 Фотопроводимость
1.9 Определение толщины диффузионного слоя
1.10 Определение толщины окисного слоя
2. Физические основы наноэлектроники
2.1 Физические основы наноструктур
2.2 Квантовые основы наноэлектроники
2.3 Методы и средства изучения свойств наноструктур
2.5 Применение наноструктур
3. Экспериментальное исследование электрофизических параметров
полупроводниковых материалов
3.1 Измерение удельного сопротивления четырехзондовым методом и
определение типа электропроводности
3.1 Исследование температурной зависимости электрического
сопротивления полупроводников
2.2 Изучение фотопроводимости полупроводников
2.3 Измерение толщины диффузионного слоя методом шарового шлифа
2.4 Измерение толщины окисного слоя визуальным цветовым методом
контроля наблюдения цвета пленки
2.5 Оценочные расчеты теоретического предела минимального размера
изображения при различных видах литографии
Заключение
Список использованной литературы
Приложение
Введение
С момента изобретения первого транзистора появилась и начала
развиваться интегральная электроника, которая базировалась на
планарно-эпитаксиальной технологии производства полупроводниковых приборов,
началось широкое применение полупроводников (главным образом германия и кремния
в радиоэлектронике). Одновременно началось интенсивное изучение свойств
полупроводников, чему способствовало совершенствование методов очистки
кристаллов и их легированию (введение в полупроводник определенных примесей).
Основной особенностью полупроводников является их способность
изменять свои свойства под влиянием различных внешних воздействий (изменение
температуры и освещения, приложение электрического и магнитного полей, внешнего
давления и т.д.). Свойства полупроводников сильно зависят от содержания
примесей. С введением примеси изменяется не только значение проводимости, но и
характер её температурной зависимости.
Микроэлектроника является перспективной областью физики, но
процесс миниатюризации микросхем достиг физических пределов. Дальнейшее
развитие электроники возможно на базе принципиально новых фихических и
технологических идей.
Перед микроэлектроникой стоят проблемы повышения степени
интеграции, уменьшения потребляемой мощности и размеров разрабатываемых ИС,
быстродействия, высокой чувствительности, технологии изготовления ИС, поэтому
важно знать физические ограничения, связанные с процессами их изготовления.
Предел микроэлектроники, а так же тенденция к уменьшению
размеров приборных структур являлись переходом к новой области науки и техники,
формирующейся сегодня на основе последних достижений физики твердого тела,
квантовой электроники, физической химии и технологии полупроводниковой
электроники - наноэлектронике.
Содержание наноэлектроники определяется необходимостью
установления фундаментальных закономерностей, определяющих физико-химические
особенности формирования наноразмерных структур, их электронные и оптические
свойства. Исследования в области наноэлектроники важны для разработки новых
принципов, а вместе с ними и нового поколения сверхминиатюрных
супербыстродействующих систем обработки информации.
Цель данной работы: изучение физических свойств
полупроводниковых материалов, изучение физических основ наноэлектроники,
исследование электрофизических свойств полупроводниковых материалов, проведение
оценочных расчетов теоретического предела минимального размера изображения,
получаемого при литографии.
Предметом исследования данной работы были выбраны:
температурная зависимость удельной проводимости, температурная зависимость
сопротивления полупроводников, зависимость электропроводности полупроводников
от напряженности электрического поля, тип электропроводности, толщина
диффузионного слоя, толщина окисного слоя эпитаксиальных структур.
Объектами исследования были выбраны: эпитаксиальные
структуры, терморезисторы ММт-8, КМТ-12, фоторезисторы типа ФСК-1.
Задача исследования состояла в глубоком изучении
теоретического материала, посвященного наиболее важным объемным свойствам
полупроводников, и наиболее распространенным методам измерения основных
физических параметров и характеристик полупроводниковых материалов и приборов.
Так же были сформированы экспериментальные задачи:
определение удельного сопротивления четырехзондовым методом эпитаксиальной
структуры, исследование физических свойств, характеристик и параметров
терморезисторов, исследование вольтамперных характеристик фоторезисторов,
определение толщины диффузионного слоя методом шарового шлифа, определение
толщины окисного слоя методом наблюдения цвета пленки.
Методы исследования, используемые в работе: анализ научной
литературы по исследуемой проблеме, физический эксперимент, выработка методики
определения величин, компьютерная обработка результатов экспериментов.
Данная работа состоит из введения, трех глав, заключения,
списка литературы, приложения.
Во введении отражена актуальность исследования свойств
полупроводниковых материалов, широко применяемых для изготовления современных
полупроводниковых приборов, поставлены цели и задачи исследования, определен
его предмет и объект.
В I главе отражены основные электрофизические свойства
полупроводниковых материалов, необходимые для рассмотрения электрофизических
параметров полупроводников, представлен необходимый теоретический материал, на
котором основывается исследовательская часть работы.
Во II главе рассматриваются физические основы
наноэлектроники, как физического продолжения микроэлектроники. Рассмотрены
физические основы наноструктур, квантовые основы наноэлектроники, методы и
средства изучения свойств наноструктур.
В III главе проведен ряд экспериментов, отражены результаты
измерений зависимости электрофизических параметров полупроводниковых приборов,
изучаемых в работе и выводы по экспериментальной части.
В заключении раскрыта значимость проведенных исследований
полупроводниковых материалов для более полного понимания сути физических
явлений и технологии изготовления полупроводниковых приборов.
1. Основные
электрофизические свойства полупроводниковых материалов
В первом приближении полупроводники выделяют из других веществ по
значению удельного электрического сопротивления 
 . Считают, что удельное сопротивление металлов менее 10-4
Ом * см, полупроводников - в диапазоне от 10-3 до 109
Ом*см, диэлектриков - более 1010 Ом*см. Что касается полупроводников
и металлов, то главное различие между ними заключается в том, что у металлов
удельное сопротивление возрастает с ростом температуры, а у полупроводников -
падает.
. Считают, что удельное сопротивление металлов менее 10-4
Ом * см, полупроводников - в диапазоне от 10-3 до 109
Ом*см, диэлектриков - более 1010 Ом*см. Что касается полупроводников
и металлов, то главное различие между ними заключается в том, что у металлов
удельное сопротивление возрастает с ростом температуры, а у полупроводников -
падает.
Из числа полупроводников наиболее подходящим для изготовления
интегральных схем оказался кремний.
К полупроводникам относится большое количество веществ с
электронной электропроводностью, удельное сопротивление которых при нормальной
температуре находится между значениями удельного сопротивления проводников и
диэлектриков. Основной особенностью полупроводников является их способность
изменять свои свойства под влиянием различных внешних воздействий (изменение
температуры и освещения, приложение электрического и магнитного полей, внешнего
давления и т.д.). В отличие от металлов полупроводники имеют в широком
интервале температур отрицательный температурный коэффициент удельного
сопротивления.
Свойства полупроводников очень сильно зависят от содержания
примесей, даже в малых количествах присутствующих в кристалле. При введении
примеси изменяется не только значение проводимости, но и характер ее
температурной зависимости. В этом также состоит качественное отличие
полупроводников от металлов, в которых примеси, независимо от их природы,
всегда снижают проводимость, не оказывая существенного влияния на характер
температурной зависимости.
1.1 Основы
зонной теории твердого тела
На основании квантовой теории электрон
обладает как световыми частицами, так и свойствами волны. Для электрона
вводились волновой вектор, энергетический уровень. Для атома водорода было
решено уравнение Шредингера, в результате чего получено, что энергетический
уровень электрона дискретный. Для электрона введены 4 квантовых числа. Для нас
наиболее важным является спиновое.
Принцип запрета Паули: на одном энергетическом уровне не могут
находиться 2 электрона с одинаковым набором квантового числа. Чаще атомы
являются связанными в молекулы. За счёт перекрытия электронных оболочек атомов,
происходит расщепление энергетических уровней. На одном уровне 
 , на втором -
, на втором - 
 ,.
,.
Учет взаимодействия электронов между собой и ядрами приводит к
более сложным уравнениям Шредингера. При рассмотрении кристаллической решётки
каждый энергетический уровень расщепляется на n подуровней.
В твёрдом теле говорят не об энергетических уровнях, а о зонах.
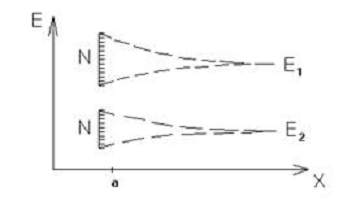
Рис. 1.1.1 Расщепление атомного энергетического уровня в системе
связанных атомов.
полупроводниковый материал наноэлектроника физический
1.2
Энергетические зоны полупроводников
Каждый электрон, входящий в состав атома,
обладает определенной полной энергией или занимает определенный энергетический
уровень.
В твердом теле благодаря взаимодействию
атомов энергетические уровни расщепляются и образуют энергетические зоны,
состоящие из отдельных близко расположенных по энергии уровней, число которых
соответствует числу однородных атомов в данном кристаллическом теле (рис.
1.2.1). Энергетическую зону или совокупность нескольких перекрывающихся
энергетических зон, которые образовались в результате расщепления одного или
нескольких энергетических уровней отдельного атома, называют разрешенной зоной.
Электроны в твердом теле могут иметь энергии, соответствующие разрешенной зоне.
Верхний энергетический уровень разрешенной зоны называют потолком, нижний -
дном.
Энергетические уровни валентных электронов
при расщеплении образуют валентную зону. Разрешенные энергетические уровни,
свободные от электронов в невозбужденном состоянии атома, расщепляясь, образуют
одну или несколько свободных зон. Нижнюю из свободных зон называют зоной проводимости.
От взаимного расположения валентной зоны и
зоны проводимости и от степени их заполнения электронами зависят электрические,
оптические и другие свойства твердых тел. Между разрешенными зонами находятся
запрещенные зоны, т.е. области значений энергии, которыми не могут обладать
электроны в идеальном кристалле. Для полупроводников наибольшее значение имеет
запрещенная зона, разделяющая валентную зону и зону проводимости. Она
характеризуется шириной запрещенной зоны АЭ, т.е. разностью энергий дна зоны проводимости
и потолка валентной зоны.
Энергетические диаграммы на рис.1.2.1
построены для энергии электрона. Когда энергия электрона увеличивается,
электрон занимает более высокое положение в зонной диаграмме. Если же говорить
об увеличении энергии дырки, то это будет соответствовать, очевидно,
продвижению дырки вглубь валентной зоны. Энергия электрона и дырки измеряется в
электрон-вольтах (эВ).
Ширина запрещенной зоны равна

 (1.2.1)
(1.2.1)
где 
 - соответственно энергетические уровни для зоны проводимости и
потолка валентной зоны.
- соответственно энергетические уровни для зоны проводимости и
потолка валентной зоны.
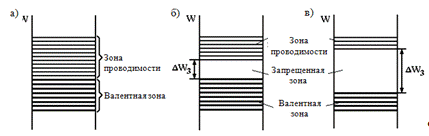
Рис. 1.2.1 Энергетические диаграммы металлов (а), полупроводников
(б) и диэлектриков (в)
На рисунке 1.2.2 показаны основные параметры зонных диаграмм
полупроводников для температуры, отличной от абсолютного нуля. Ширина
запрещенной зоны зависит от температуры:

 (1.2.2)
(1.2.2)
Где


Т - абсолютная температура,

 .
.
Энергию, соответствующую середине зоны, называют
электростатическим потенциалом проводника

 (1.2.3)
(1.2.3)

Рис. 1.2.2 Значения энергий в зонной диаграмме для собственного
(а), электронного (б), дырочного (в) полупроводников; 
 - уровень Ферми
- уровень Ферми
Приведенные выше качественные соображения относительно примесных
полупроводников могут быть проиллюстрированы еще раз качественно на зонных
диаграммах. Электрические уровни примесей показаны на зонных диаграммах +
(положительно заряженные ионы-доноры) и - (отрицательно заряженные
ионы-акцепторы), рис. 1.2.3.

Рис. 1.2.3 Схематическое атомистическое изображение и зонная
диаграмма примесных полупроводников: n-типа (а), p-типа (б) (1 - ионы доноров:
2 - ионы акцепторов; "-" - электроны; "+" - дырки)
В полупроводнике одновременно присутствуют электроны и дырки,
порожденные двумя причинами:
) возбуждением собственного полупроводника 
 и
и 
 2) возбуждением донорных и (или) акцепторных примесей. При этом
полные концентрации носителей заряда для примесного полупроводника будут
2) возбуждением донорных и (или) акцепторных примесей. При этом
полные концентрации носителей заряда для примесного полупроводника будут 
 и
и 
 (донорный);
(донорный); 
 и n
и n
 (акцепторный); при полной ионизации примесей
(акцепторный); при полной ионизации примесей 
 - количеству доноров, а
- количеству доноров, а 
 т.е. количеству акцепторов. Обычно вследствие малой энергии
возбуждения эти величины значительно выше собственных концентраций, т.е.
т.е. количеству акцепторов. Обычно вследствие малой энергии
возбуждения эти величины значительно выше собственных концентраций, т.е. 
 и
и 
 концентрации основных носителей определяются выражениями
концентрации основных носителей определяются выражениями 
 (на самом
деле
(на самом
деле 
 , но
, но 
 ) для донорного полупроводника и
) для донорного полупроводника и 
 для акцепторного полупроводника.
для акцепторного полупроводника.
1.3 Генерация
и рекомбинация носителей заряда
Образование свободных носителей заряда в
полупроводниках связано с переходом электронов из валентной зоны в зону
проводимости. Для осуществления такого перехода электрон должен получить
энергию, достаточную для преодоления запрещенной зоны. Эту энергию электрон
получает от ионов решетки, совершающих тепловые колебания. Концентрация
носителей заряда, вызванная термическим возбуждением в состоянии теплового
равновесия, называется равновесной.
Однако, помимо теплового возбуждения,
появление свободных носителей заряда может быть связано с другими причинами,
например в результате облучения фотонами или частицами большой энергии, ударной
ионизации, введения носителей заряда в полупроводник из другого тела (инжекция)
и др. Возникшие таким образом избыточные носители заряда называются неравновесными.
Процесс введения неравновесных носителей заряда называют инжекцией.
Таким образом, полная концентрация носителей заряда равна:

 (1.3.1)
(1.3.1)

 (1.3.2)
(1.3.2)
где n0 и p0 - равновесная
концентрация, а 
 и
и  p - неравновесные концентрации электронов и дырок.
p - неравновесные концентрации электронов и дырок.
Если возбуждение избыточных электронов производилось из валентной
зоны, а полупроводник однородный и не содержит объемного заряда, то
концентрация избыточных электронов равна концентрации избыточных дырок:

 (1.3.3)
(1.3.3)
После прекращения действия механизма, вызвавшего появление
неравновесной концентрации носителей, происходит постепенное возвращение к
равновесному состоянию. Процесс установления равновесия заключается в том, что
каждый избыточный электрон при встрече с вакантным местом (дыркой) занимает
его, в результате чего пара неравновесных носителей исчезает. Явление
исчезновения пары носителей получило название рекомбинации. В свою
очередь, возбуждение электрона из валентной зоны или примесного уровня,
сопровождающееся появлением дырки, называется генерацией носителей
заряда.
На рис. 1.3.1 G - это темп генерации, а R - темп
рекомбинации свободных носителей заряда в собственном полупроводнике.
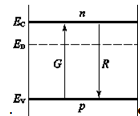
Рис. 1.3.1 Генерация и рекомбинация свободных электронов и дырок в
полупроводниках.
Скорость (темп) рекомбинации R пропорциональна концентрации
свободных носителей заряда:

 (1.3.4)
(1.3.4)
где 
 - коэффициент рекомбинации. При отсутствии освещения (в темноте) G
= G0 и R = R0 = γ·n0·p0, величины n0 и p0
иногда называют темновыми концентрациями свободных электронов и дырок
соответственно.
- коэффициент рекомбинации. При отсутствии освещения (в темноте) G
= G0 и R = R0 = γ·n0·p0, величины n0 и p0
иногда называют темновыми концентрациями свободных электронов и дырок
соответственно.
Из формулы (1.3.4), учитывая закон действующих масс 
 , получим:
, получим:

 (1.3.5)
(1.3.5)
где
Eg = EC - EV - ширина
запрещенной зоны. Таким образом, скорость рекомбинации R0
будет больше в узкозонных полупроводниках и при высоких температурах.
Если в полупроводнике нет электрического тока и объемных зарядов,
то изменение во времени неравновесных концентраций электронов и дырок в зонах
определяется уравнениями:

 (1.3.6)
(1.3.6)
Скорости (темпы) генерации и рекомбинации имеют две составляющие:

 (1.3.7)
(1.3.7)

 (1.3.8)
(1.3.8)
где DG, DR - темпы
генерации и рекомбинации только неравновесных электронов, т.е. DG - это темп генерации электронов и дырок за счет освещения
полупроводника, R0 = γn0p0
и ΔR = γΔnΔp. Используя равенства (1.3.1), (1.3.2) и (1.3.4), уравнение
(1.3.6) можно свести к следующему:

 (1.3.9)
(1.3.9)
Рассмотрим процесс рекомбинации неравновесных носителей заряда
(т.е. при выключении освещения в момент времени t = 0). Общее решение
уравнения (1.3.9) довольно сложное. Поэтому рассмотрим два частных случая.
В собственном полупроводнике при сильном освещении концентрация
избыточных электронов много больше суммы концентраций равновесных электронов и
дырок Δn >>n0 +p0.
Из (1.3.9) получим:

 (1.3.10)
(1.3.10)
где  n0 -
начальная концентрация неравновесных носителей заряда. Спад концентрации
происходит по гиперболическому закону.
n0 -
начальная концентрация неравновесных носителей заряда. Спад концентрации
происходит по гиперболическому закону.
В донорном полупроводнике в случае полной ионизации доноров n0
= ND, p0 << n0. Будем
также считать, что концентрация неравновесных носителей существенно меньше
концентрации основных носителей  n << n0. Это
условие часто называют критерием низкого уровня инжекции. Отметим, что при
условии низкого уровня инжекции проводимость, а следовательно, и удельное
сопротивление полупроводника не меняются.
n << n0. Это
условие часто называют критерием низкого уровня инжекции. Отметим, что при
условии низкого уровня инжекции проводимость, а следовательно, и удельное
сопротивление полупроводника не меняются.
С учетом критерия низкого уровня инжекции уравнение (1.3.10)
сводится к виду:

 (1.3.11)
(1.3.11)
где τn - время жизни неосновных носителей,
которое имеет следующее значение:

 (1.3.12)
(1.3.12)
Уравнение (1.3.11) легко решается:

 (1.3.13)
(1.3.13)
Величина 
 имеет смысл среднего времени жизни неравновесных электронов в
зоне проводимости. Полученные решения соответствуют кривой, изображенной на
рис.1.3.2 Из формулы (1.3.13) видно, что процесс рекомбинации описывается
экспоненциальной зависимостью от времени, причем среднее время жизни
представляет собой такой отрезок времени, за который концентрация избыточных
носителей изменяется в "е" раз.
имеет смысл среднего времени жизни неравновесных электронов в
зоне проводимости. Полученные решения соответствуют кривой, изображенной на
рис.1.3.2 Из формулы (1.3.13) видно, что процесс рекомбинации описывается
экспоненциальной зависимостью от времени, причем среднее время жизни
представляет собой такой отрезок времени, за который концентрация избыточных
носителей изменяется в "е" раз.
Неравновесные носители заряда появляются только в том случае, если
энергия фотонов при освещении полупроводника превышает ширину запрещенной зоны
(h
 > Eg).
> Eg).

Рис. 1.3.2 Спад неравновесной концентрации электронов во времени в
донорном полупроводнике
1.4
Собственные полупроводники
Собственный полупроводник - это полупроводник без
донорных и акцепторных примесей или с концентрацией примеси настолько малой,
что она не оказывает существенного влияния на удельную проводимость
полупроводника. В собственном полупроводнике при температуре абсолютного нуля
отсутствуют носители заряда, так как валентная зона полностью занята
электронами (там нет дырок), а в зоне проводимости нет электронов.
При температурах выше абсолютного нуля
некоторые электроны валентной зоны могут быть переброшены в зону проводимости -
возможна тепловая генерация пар носителей заряда, в зоне проводимости
появляются свободные электроны, а в валентной зоне - дырки. Процесс тепловой
генерации возможен даже при очень низких температурах из-за значительных
флуктуаций (отклонений) энергий тепловых колебаний атомов от средней энергии
тепловых колебаний атомов относительно узлов кристаллической решетки.
Кроме тепловой генерации носителей заряда
в полупроводнике существует и их рекомбинация, и эти процессы при любой
температуре взаимно уравновешены. При этом в собственном полупроводнике
существует собственная концентрация электронов, которая может быть выражена
соотношением:

 (1.4.1)
(1.4.1)
Формула для собственной концентрации дырок аналогична:

 (1.4.2)
(1.4.2)
Эффективные плотности уровней в зоне проводимости и в валентной
зоне определяются соотношениями:

 (1.4.3)
(1.4.3)

 (1.4.4)
(1.4.4)
где 
 - эффективные массы электронов и дырок (смысл этих параметров
рассмотрен далее); h-постоянная Планка.
- эффективные массы электронов и дырок (смысл этих параметров
рассмотрен далее); h-постоянная Планка.
Так как в собственном полупроводнике носители заряда образуются в
результате ионизации собственных атомов полупроводника, т.е. благодаря
перебросу электронов из валентной зоны в зону проводимости, то одновременно
возникает два носителя заряда противоположных знаков. Поэтому

 (1.4.5)
(1.4.5)
Определим положение уровня Ферми для собственного полупроводника.
При небольшом различии эффективных масс электронов и дырок

 (1.4.6)
(1.4.6)
т.е. в собственном полупроводнике приближенно можно считать, что
уровень Ферми расположен посередине запрещенной зоны.
Приняв в данном случае для простоты начало отсчета энергии от
потолка валентной зоны, т.е. 
 , собственные концентрации носителей можно выразить через ширину
запрещенной зоны
, собственные концентрации носителей можно выразить через ширину
запрещенной зоны 
 :
:

 (1.4.7)
(1.4.7)

 (1.4.8)
(1.4.8)
1.5 Примесные
полупроводники
Большинство полупроводниковых приборов
изготовляют на основе примесных полупроводников, т.е. полупроводников,
электрические характеристики которых определяются донорными или акцепторными
примесями. Таким образом, в рабочем диапазоне температур полупроводникового
прибора поставщиками основного количества носителей заряда в полупроводниковом
материале должны быть примеси. Поэтому в практике важное значение имеют такие
полупроводниковые материалы, у которых ощутимая собственная концентрация
носителей заряда появляется при возможно более высокой температуре, т.е.
полупроводники с достаточно большой шириной запрещенной зоны.
В элементарных полупроводниках, состоящих
в основном из атомов одного химического элемента, примесями являются чужеродные
атомы. В полупроводниковых соединениях и твердых растворах, состоящих из атомов
двух или большего числа химических элементов, примесями могут быть не только
включения атомов посторонних химических элементов, но и избыточные по отношению
к стехиометрическому составу атомы химических элементов, входящих в химическую
формулу сложного полупроводника.
Такую же роль, как примеси, могут играть
различные дефекты кристаллической решетки: пустые узлы, дислокации или сдвиги,
возникающие при пластической деформации кристалла, и т.д.
Рассмотрим роль примесей, атомы которых
создают дискретные энергетические уровни в пределах запрещенной зоны
полупроводника. При небольшой концентрации примесей их атомы расположены в
полупроводнике на таких больших расстояниях друг от друга, что не
взаимодействуют между собой. Поэтому нет расщепления примесных уровней. Вероятность
непосредственного перехода электронов от одного примесного атома к другому
ничтожно мала, т.е. с точки зрения зонной теории ничтожно мала вероятность
перехода электрона с одного дискретного примесного уровня на другой.
При большой концентрации примесей в
результате взаимодействия примесных атомов между собой примесные уровни одного
типа расщепляются в энергетическую примесную зону. Электроны, находящиеся в
примесной зоне, так же как в зоне проводимости и в валентной зоне при неполном
их заполнении, могут переходить с уровня на уровень, приобретая необходимую для
этого энергию за счет ускорения во внешнем электрическом поле на длине
свободного пробега.
Примеси могут быть донорного и
акцепторного типа.
Донор - это примесный атом или дефект
кристаллической решетки, создающий в запрещенной зоне энергетический уровень,
занятый в невозбужденном состоянии электроном и способный в возбужденном
состоянии отдать электрон в зону проводимости.
Акцептор - это примесный атом или дефект
кристаллической решетки, создающий в запрещенной зоне энергетический уровень,
свободный от электрона в невозбужденном состоянии и способный захватить
электрон из валентной зоны в возбужденном состоянии.
Доноры и акцепторы в полупроводнике могут
быть ионизированы под действием энергии, поступающей в кристалл в виде квантов
света, теплоты и т.д.
Под энергией ионизации донора понимают
минимальную энергию, которую необходимо сообщить электрону, находящемуся на
донорном уровне, чтобы перевести его в зону проводимости.
Энергия ионизации акцептора - это
минимальная энергия, которую необходимо сообщить электрону валентной зоны,
чтобы перевести его на акцепторный уровень.
Энергия ионизации примесных атомов
значительно меньше энергии ионизации собственных атомов полупроводника или
ширины запрещенной зоны. Поэтому в примесных полупроводниках при низких
температурах преобладают носители заряда, возникшие из-за ионизации примесей.
Если электропроводность полупроводника обусловлена электронами, его называют
полупроводником п-типа, если электропроводность обусловлена дырками -
полупроводником р-типа.
Обычно в полупроводниках присутствуют как
доноры, так и акцепторы. Полупроводник, у которого концентрация доноров равна
концентрации акцепторов, называют скомпенсированным.
Соотношения для концентрации электронов и дырок можно
преобразовать, приняв 
 и учтя соотношения (1.4.7) и (1.4.8):
и учтя соотношения (1.4.7) и (1.4.8):

 (1.5.1)
(1.5.1)

 (1.5.2)
(1.5.2)
Из преобразования соотношения для концентрации электронов и дырок
следует:

 (1.5.3)
(1.5.3)
т.е. в невырожденном полупроводнике произведение концентраций
свободных электронов и дырок при термодинамическом равновесии есть постоянная
величина, равная квадрату собственной концентрации при данной температуре.
Соотношение (1.5.3) справедливо для невырожденного полупроводника,
т.е. для полупроводника, у которого уровень Ферми расположен в запрещенной зоне
достаточно далеко (на 2-3 kT) от дна зоны проводимости или от потолка валентной
зоны, так как только при этих условиях можно пользоваться функцией
распределения Максвелла - Больцмана.
Соотношение (1.5.3) обычно называют законом действующих масс в
соответствии с терминологией химической термодинамики (константа химического равновесия
выводится из закона действующих масс).
1.6
Определение удельного сопротивления полупроводников
Удельное сопротивление полупроводника является одним из
важных электрических параметров, который учитывается при изготовлении
полупроводниковых приборов. Для определения удельного сопротивления
полупроводников наиболее распространенными являются два метода: двух - и
четырехзондовый. Эти методы измерения принципиального отличия друг от друга не
имеют. Кроме этих контактных (зондовых) методов измерения удельного
сопротивления, в последние годы применяются бесконтактные высокочастотные
методы, в частности емкостный и индукционный, особенно для полупроводников с
высоким удельным сопротивлением.
В микроэлектронике для определения удельного сопротивления
широко используют четырехзондовую методику в связи с ее высокими
метрологическими показателями, простой реализации и широкого круга изделий, в
которых можно контролировать данную величину (полупроводниковые пластины,
объемные монокристаллы, полупроводниковые слоистые структуры).
Метод основан на явлении растекания тока в точке контакта
металлического острия зонда с полупроводником. Через одну пару зондов
пропускается электрический ток, а вторая используется для измерения напряжения.
Как правило, используются два типа расположения зондов - в линию или по
вершинам квадрата.
Соответственно, для данных типов расположений зондов
используются следующие расчетные формулы:
. Для расположения зондов в линию на равных
расстояниях:

 (1.6.1)
(1.6.1)
2. Для расположения зондов по вершинам квадратов:

 (1.6.2)
(1.6.2)
В случае, если необходимо учитывать геометрические размеры
образцов (если не выполняется условие d,l,h>>s), в формулы вводятся
поправочные коэффициенты, приведенные в соответствующих таблицах.
Если в полупроводнике создать градиент температуры, в нем будет
наблюдаться градиент концентраций носителей заряда. В результате возникнет
диффузионный поток носителей заряда и связанный с ним диффузионный ток. В
образце возникнет разность потенциалов, которую принято называть термоЭДС.
Знак термоЭДС зависит от типа проводимости полупроводника. Так как
в полупроводниках два типа носителей заряда, диффузионный ток складывается из
двух составляющих, а знак термоЭДС зависит от преобладающего типа носителей
заряда.
Установив знак термоЭДС с помощью гальванометра, можно сделать
вывод о типе проводимости данного образца.
1.7
Температурная зависимость электропроводности полупроводников
Электропроводность полупроводников зависит от концентрации носителей
заряда и их подвижности. Учитывая зависимость концентрации и подвижности
носителей заряда от температуры, удельную электропроводность собственного
полупроводника можно записать в виде

 (1.7.1)
(1.7.1)
Множитель 
 медленно меняется с температурой, тогда как множитель
медленно меняется с температурой, тогда как множитель 
 сильно зависит от температуры, если
сильно зависит от температуры, если 
 . Следовательно, для не слишком высоких температур можно считать,
что
. Следовательно, для не слишком высоких температур можно считать,
что

 (1.7.2)
(1.7.2)
и выражение для удельной электропроводности собственного
полупроводника заменить более простым

 (1.7.3)
(1.7.3)
В примесном полупроводнике при достаточно высоких температурах
проводимость является собственной, а при низких температурах примесной. В
области низких температур для удельной электропроводности примесной
проводимости можно записать выражения:
для примесного полупроводника с одним типом примеси

 (1.7.4)
(1.7.4)


для примесного полупроводника с акцепторной и донорной примесями

 (1.7.5)
(1.7.5)
где 
 - энергия активации примесного полупроводника.
- энергия активации примесного полупроводника.
В области истощения примеси концентрация основных носителей
остается постоянной и проводимость меняется вследствие изменения подвижности с
температурой. Если основным механизмом рассеяния носителей в области истощения
примеси является рассеяние на тепловых колебаниях решетки, то проводимость
уменьшается с ростом температуры. Если же основным механизмом рассеяния
является рассеяние на ионизированных примесях, то проводимость будет
увеличиваться с ростом температуры.
Практически при исследовании температурной зависимости
проводимости полупроводников часто пользуются не проводимостью, а просто сопротивлением
полупроводника. Для тех областей температур, когда формулы (1.7.3), (1.7.2) и
(1.7.3) справедливы, можно записать для сопротивления полупроводников следующие
выражения:
для собственного полупроводника

 (1.7.6)
(1.7.6)
для полупроводника n-типа

 (1.7.7)
(1.7.7)
для полупроводника p-типа

 (1.7.8)
(1.7.8)
для примесного полупроводника с акцепторными и донорными примесями

 (1.7.9)
(1.7.9)
Измерив температурный ход сопротивления полупроводника в
определенном интервале температур, можно из выражения (1.7.6) определить ширину
запрещенной зоны 
 , из формул (1.7.7), (1.7.8) - энергию ионизации донорной
, из формул (1.7.7), (1.7.8) - энергию ионизации донорной 
 или акцепторной
или акцепторной 
 примеси, из уравнения (1.7.9) - энергии активации полупроводника
примеси, из уравнения (1.7.9) - энергии активации полупроводника 
 .
.
Зависимость сопротивления полупроводников от температуры
значительно резче, чем у металлов: температурный коэффициент сопротивления у
них в десятки раз выше, чем у металлов, и имеет отрицательный знак.
Теплоэлектрический полупроводниковый прибор, использующий зависимость
электрического сопротивления полупроводника от температуры, предназначенный для
регистрации изменения температуры окружающей среды, называется термистором или
терморезистором. Он представляет собой объемное нелинейное полупроводниковое
сопротивление с большим отрицательным температурным коэффициентом
сопротивления. Материалами для изготовления терморезисторов служат смеси
окислов различных металлов: меди, марганца, цинка, кобальта, титана, никеля и
др.
Из числа отечественных терморезисторов наиболее распространены
кобальто-марганцевые (КМТ), медно-марганцевые (ММТ) и
медно-кобальто-марганцевые (СТЗ) терморезисторы.
Область применения каждого типа терморезистора определяется его
свойствами и параметрами: температурной характеристикой, коэффициентом
температурной чувствительности B, температурным коэффициентом
сопротивления α,
постоянной времени τ,
вольт-амперными характеристиками.
Зависимость сопротивления полупроводникового материала
терморезистора от температуры называется температурной характеристикой, она
имеет вид

 (1.7.10)
(1.7.10)
Коэффициент температурной чувствительности B может быть
определен по формуле:

 (1.7.11)
(1.7.11)
Энергия активации полупроводникового материала терморезистора
определяется по формуле:

 (1.7.12)
(1.7.12)
1.8
Фотопроводимость
Важной особенностью полупроводников является способность
увеличивать электропроводность под действием света. Полупроводник, меняющий
свою проводимость при освещении его светом, называется фотосопротивлением (фоторезистором).
Уменьшение сопротивления полупроводника, обусловленное поглощением света,
объясняется увеличением числа свободных носителей заряда. Квантовым выходом
(вероятностью), рассчитанным на поглощённый световой поток, называется
отношение числа неравновесных фотоносителей заряда к общему числу поглощенных
квантов света:

 (1.8.1)
(1.8.1)
Фототоком 
 фотосопротивления при данном напряжении называется разность тока
при освещении полупроводника
фотосопротивления при данном напряжении называется разность тока
при освещении полупроводника 
 и темнового тока
и темнового тока 
 :
:

 (1.8.2)
(1.8.2)
Если фотосопротивление не освещено, то его величина очень большая.
Его называют темновым сопротивлением, а ток, соответствующий ему
- темновым током. Величина темнового сопротивления определяется температурой и
чистотой полупроводника. При освещении прибора его сопротивление уменьшается и
тем значительнее, чем больше световой поток.
Благодаря внутреннему фотоэффекту фоторезистор непосредственно
преобразует световую энергию в электрическую энергию.
Световой (энергетической) характеристикой фотосопротивления
называется зависимость фототока от светового потока при данном напряжении. Эта
зависимость, показана на рис. 1.8.1.

Рис. 1.8.1 Зависимость фототока от
светового потока
Вольтамперная характеристика фотосопротивления имеет линейный
характер при постоянном световом потоке и выражает зависимость фототока от
приложенного напряжения.
Важной характеристикой фотосопротивления также является удельная
чувствительность, т.е. отношение фототока 
 к световому потоку Ф и к величине приложенного напряжения U:
к световому потоку Ф и к величине приложенного напряжения U:

 (1.8.3)
(1.8.3)
Из фотометрии известно, что световой поток
Ф = ES (1.8.4)
где E - освещенность поверхности; S - площадь
светочувствительного слоя фотосопротивления.
В случае малых световых потоков Ф, когда кванты света идут на
образование избыточных носителей, количество образующихся носителей, а,
следовательно, и величина фототока пропорциональны падающему световому потоку (
 ~ Ф, т.е.
~ Ф, т.е. 
 = a* Ф =
a * ES, где а - некоторая постоянная). При этом фотосопротивление
выражается как
= a* Ф =
a * ES, где а - некоторая постоянная). При этом фотосопротивление
выражается как

 (1.8.5)
(1.8.5)
При больших световых потоках наступает насыщение и линейная
зависимость фототока от светового потока нарушается (
 ~
~ 
 ).
).
Принимая во внимание, что темновой ток ( (
 ~ Ф0)) и темновое сопротивление являются постоянными
для данного фоторезистора, и учитывая (6) - (7) перепишем формулу (8) в виде
~ Ф0)) и темновое сопротивление являются постоянными
для данного фоторезистора, и учитывая (6) - (7) перепишем формулу (8) в виде

 (1.8.6)
(1.8.6)
где A= Iт/aS - некоторая неизвестная
постоянная.
Учитывая линейную зависимость фототока от светового потока, из
формулы (9) следует описание зависимости фотосопротивления от освещенности:

 (1.8.7)
(1.8.7)
1.9
Определение толщины диффузионного слоя
При исследованиях и разработке ИС контролируется большое
число параметров и применяется большое число разнообразных методов. Вследствие
того, что диффузионные слои могут быть очень тонкими - порядка единиц
микрометров и менее, для контроля их толщины изготовлены косой и сферический
шлифы.
Для изготовления косого шлифа контрольный образец
сошлифовывается под небольшим углом 1-5° (рис.1.9.1). В последствии проводится
окрашивание шлифа. Окрашивание р - области происходит в растворе, состоящем из
0,05 - 0,1 % азотной (70% -ной) кислоты в плавиковой (48% -ной) кислоте.
Возникающее при этом потемнение обусловлено образованием моноокиси кремния
вследствие окисления р-области.
Окрашенный шлиф позволяет при наблюдении под микроскопом измерить
с помощью шкалы окуляры не истинную толщину диффузионного слоя хi, а
существенно большую величину l. Глубина залегания примесей рассчитывается по
формуле: 
 (1.9.1)
(1.9.1)

Рис. 1.9.1 Косой шлиф
Для изготовления шарового шлифа металлический шар диаметром 25-150
мм вращается на поверхности пластины. В место соприкосновения подается
образивная суспензия. Образовавшаяся лунка сферической кривизны должна быть
глубже p-n перехода, тогда после окрашивания (если диффузионный слой p-типа) в
лунке образуется темное кольцо. Окрашивание производится в том же растворе, что
и окрашивание косого шлифа.
Глубину p-n перехода (xi) можно определить из рис. 1.9.2
Глубина залегания примесей рассчитывается по формуле: 
 (1.9.2)
(1.9.2)

Рис. 1.9.2 Сферический шлиф
К преимуществам этого метода относится точное определение
положения края и хорошее окрашивание, так как сферические шлифы окрашиваются
лучше косых. Измерение простое, производится с помощью тубуса микроскопа с
калиброванным окуляром.
1.10
Определение толщины окисного слоя
В технологии производства ИС на основе кремния операция
окисления стоит на первом месте, в ходе изготовления ИС эта операция
повторяется несколько раз. При термическом окислении происходит диффузия
кислорода из газовой среды в материал пластины, сопровождаемая химической
реакцией окисления. Получаемый при этом диэлектрик SiO2 представляет
собой чистое кварцевое стекло, обладающее маскирующей способностью. Толщина
слоя окисла кремния редко превышает 1 мкм и обычно находится в пределах 0,1-0,6
мкм. Для контроля таких пленок эффективны оптические методы измерения толщины,
использующие явление интерференции в пленке.
Один из методов определения толщины окисного слоя -
визуальный цветовой метод контроля, который заключается в наблюдении цвета
пленки. Цветовой метод контроля основан на свойстве тонких прозрачных пленок,
нанесенных на отражающую подложку, изменять свой цвет в зависимости от толщины.
В основе этого свойства лежит интерференция световых лучей, отраженных от
границы раздела окружающая среда - пленка и пленка - подложка. Данный метод
нашел широкое применение в микроэлектронном производстве благодаря простоте и
оперативности. Если падение луча на поверхность пленки близко к нормальному и
пленки достаточно тонкие (менее 1 мкм), то расстояние между соседними
интерференционными максимумами столь велико, что вся пленка окрашивается
равномерно в один цвет. Для измерения толщины пленки по ее цвету нужно знать не
только соответствующую данному цвету длину волны, но и порядок интерференции m.
Показатель преломления окисной пленки n≈1,7. Так как цвет пленки
наблюдали в отраженном свете, то

 ,
,
откуда 
 (1.10.1)
(1.10.1)
2. Физические
основы наноэлектроники
2.1
Физические основы наноструктур
Согласно существующим представлениям об электропроводности
твердых тел, между зоной проводимости и валентной зоной находится запрещенная
зона энергий. У одних полупроводников она может быть шире, а у других - более
узкой. На рис. 2 приведена схема, иллюстрирующая случай, когда в контакт
приведены два полупроводника с различными запрещенными зонами. Граница таких
полупроводников называется гетероструктурой. Другими словами, гетероструктуры
можно определить как неоднородные полупроводниковые структуры, изготовленные из
двух или более различных материалов таким образом, что переходный слой, или
граница раздела двух материалов играет важную роль в любом протекающем в
приборе процессе. Можно даже сказать, что техническим устройством является сама
граница раздела.
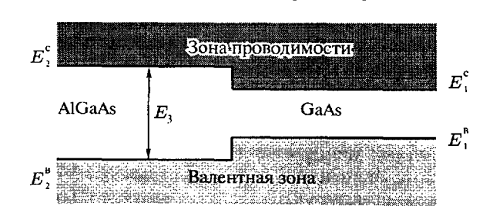
Рис. 2. Энергетические зоны на границе двух полупроводников
Все материалы, из которых делаются гетероструктуры, относятся
к центральной части Периодической системы элементов. В середине находится
кремний - основа современной электроники. Под кремнием находится германий. Хотя
сам германий используют крайне редко, сплавы Ge-Si разного состава играют все
возрастающую роль в современной технологии гетероструктур. Исторически это было
первое технически эффективное устройство с гетероструктурой, хотя его
практическая разработка потребовала больших усилий из-за 4% -го различия
постоянных решетки Si и Ge.
Кремний играет такую же важную роль в технологии электронных
материалов, как и сталь среди материалов конструкционных. Но, подобно тому, как
современная металлургия занимается кроме стали и другими материалами,
электроника, помимо кремния, имеет дело, например, с полупроводниковыми
твердыми растворами. Каждый элемент III группы может вступать в соединение с
любым элементом V группы. При этом возникают соединения этих групп - соединения
типа AIIIBV. Можно создать 12 различных соединений.
Наиболее часто используемое в технике соединение - арсенид галлия GaAs, однако
любое из этих соединений может применяться в гетероструктурах - это зависит от
конкретной цели. Фактически сегодня соединения AIIIBV
используются, как правило, не в чистом виде, а в составе гетероструктур.
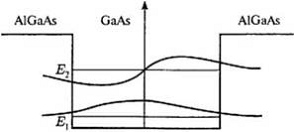
Рис. 3. Квантовая яма, сформированная в слое полупроводника с
узкой запрещенной зоной, заключенном между двумя полупроводниками, обладающими
более широкой запрещенной зоной
На рис. 3 Ес и Ев - границы
зоны проводимости и валентной зоны, Ез - ширина запрещенной
зоны.
Для электронов, движущихся в узкозонном полупроводнике и
имеющих энергию меньше Ез (пунктирная линия на рис. 2),
граница будет играть роль потенциального барьера. Два гетероперехода
ограничивают движение электрона с двух сторон и как бы образуют потенциальную
яму. Практически это достигается путем помещения тонкого слоя полупроводника с
узкой запрещенной зоной между двумя слоями материала с более широкой
запрещенной зоной. В результате электрон оказывается запертым в одном
направлении, что и приводит к квантованию энергии в одном направлении, в то
время, как в двух других движение электронов будет свободным. Поэтому можно
считать, что электронный газ в квантовой яме становится двумерным. Таким же
образом можно приготовить структуру, содержащую квантовый барьер, для чего
следует поместить тонкий слой полупроводника с широкой запрещенной зоной между
двумя полупроводниками с узкой запрещенной зоной.
Одной из наиболее удачных пар для выращивания квантовых ям
является полупроводник GaAs (арсенид галлия) и твердый раствор AlхGa1-х
As (арсенид алюминия-галлия), в котором часть атомов галлия замещена
атомами алюминия. Величина х обычно изменяется от 0,15 до 0,35. Ширина
запрещенной зоны в арсениде галлия составляет 1,5 эВ, а в твердом растворе AlхGa1-хAs
она растет с ростом х. Так, в соединении AlAs (этот случай соответствует
значению х - 1) ширина запрещенной зоны составляет 2,2 эВ. Чтобы
вырастить квантовую яму, необходимо во время роста менять химический состав
атомов, летящих на растущий слой. Сначала нужно вырастить слой полупроводника с
широкой запрещенной зоной, т.е. AlхGa1-х As, затем слой
узкозонного материала GaAs и, наконец, снова слой AlхGa1-х As.
Энергетическая схема приготовленной таким образом квантовой ямы показана на
рис. 3. Глубина ее - порядка нескольких десятых долей электронвольта. В такой
яме разрешенными оказываются два уровня, а волновые функции на границе не
обращаются в нуль.
Поэтому, согласно законам квантовой механики, электрон может
покинуть квантовую яму (благодаря туннельному эффекту), т.е. оказаться в
области, где его полная энергия меньше потенциальной (меньше глубины
потенциальной ямы).
Вышеизложенное относительно квантовых ям позволяет понять (по
крайней мере, в принципе) процесс создания квантовых точек и нитей. Такие
структуры можно сформировать на границе двух полупроводников, где находится
двумерный электронный газ. С точки зрения физики речь идет о создании
дополнительных барьеров, ограничивающих движение электронов в двух или трех
направлениях. Квантовые нити формируются в нижней точке V-образной канавки,
образованной на полупроводниковой подложке. Если в основание этой канавки
осадить полупроводник с меньшей шириной запрещенной зоны, то электроны этого
полупроводника будут заперты в двух направлениях. Что касается квантовых точек,
то рис.4.5 иллюстрирует один из способов их формирования, на котором показаны
квантовые точки, создаваемые на границе раздела арсенида галлия и арсенида
алюминия-галлия. В процессе роста в полупроводник AlGaAs вводятся
дополнительные примесные атомы, донирующие электроны в полупроводник GaAs, т.е.
в область с меньшей энергией. Практически все такие электроны сосредотачиваются
у самой гетерограницы со стороны GaAs и образуют двумерный газ.
Процесс формирования квантовых точек начинается с нанесения
на поверхность AlGaAs ряда масок, каждая из которых имеет форму круга. После
этого производится глубокое травление, при котором удаляется весь слой AlGaAs и
частично слой GaAs (это видно на рис.4). В результате электроны оказываются
запертыми в образовавшихся цилиндрах (на рис.4 область, где находятся
электроны, окрашена в более темный цвет). Диаметры цилиндров равны по порядку
500 нм, что соответствует плотности их расположения порядка 108 см-2.
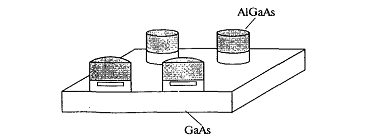
Рис. 4. Квантовые точки, сформированные в двумерном
электронном газе на границе двух полупроводников.
Как уже отмечалось выше, в квантовой точке движение
ограничено в трех направлениях и энергетический спектр полностью дискретный,
как в атоме. Поэтому квантовые точки называют еще искусственными атомами, хотя
каждая такая точка может состоять из тысяч и даже сотен тысяч реальных атомов
(по сути это кластеры нанометровых размеров). Подобно индивидуальному атому,
квантовая точка может содержать один или несколько свободных электронов. Если
она содержит один такой электрон, то это как бы искусственный атом водорода,
два - атом гелия и т.д. Это, в частности, стало поводом дня появления
представлений об атомноподобных характеристиках обсуждаемых здесь квантовых
объектов. Например, низшее по энергии состояние электрона в нанокристалле
соответствует 5-состоянию электрона в атоме, а следующее - p-состоянию.
Заполнение состояний двумя или шестью электронами в квантовой точке наиболее
выгодно по энергии, в атоме это соответствует полностью заполненным электронным
оболочкам.
Метод избирательного травления поверхности, в результате чего
образуются квантовые точки - не единственный и не самый совершенный. К
настоящему времени уже отработаны методики выращивания квантовых точек или
ансамблей наноостровков (островков нанометровых размеров) предельно малых
размеров (10-100 нм) с плотностью
более 1010-1011.
2.2 Квантовые
основы наноэлектроники
С позиций квантовой механики электрон может быть представлен
волной, описываемой соответствующей волновой функцией. Распространение этой
волны в наноразмерных твердотельных структурах контролируется эффектами,
связанными с квантовым ограничением, интерференцией и возможностью туннелирования
через потенциальные барьеры.
Волна, соответствующая свободному электрону в твердом теле,
может беспрепятственно распространяться в любом направлении. Ситуация
кардинально меняется, когда электрон попадает в твердотельную структуру, размер
которой L, по крайней мере в одном направлении, ограничен и по своей
величине сравним с длиной электронной волны. Классическим аналогом такой
структуры является струна с жестко закрепленными концами. Колебания струны
могут происходить только в режиме стоячих волн с длиной волны λn =2L/n, n= 1,2, 3,.
Аналогичные закономерности поведения характерны и для
свободного электрона, находящегося в твердотельной структуре ограниченного
размера или области твердого тела, ограниченной непроницаемыми потенциальными
барьерами. На рис. 5 такая ситуация проиллюстрирована на примере квантового
шнура, у которого ограничены размеры сечения а и b. В этих
направлениях возможно распространение только волн с длиной, кратной
геометрическим размерам структуры. Разрешенные значения волнового вектора для
одного направления задаются соотношением к = 2п/ λn = пπ/L (n = 1, 2, 3,.), где L
в соответствии с рис. 5 может принимать значения, равные а или b.
Для соответствующих им электронов это означает, что они могут
иметь только определенные фиксированные значения энергии, то есть имеет место
дополнительное квантование энергетических уровней. Это явление получило
название квантового ограничения. Вдоль же шнура могут двигаться электроны с
любой энергией.
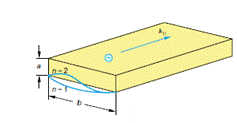
Рис. 5. Возможности для движения электрона в наноразмерной
ограниченной структуре.
Запирание электрона с эффективной массой m*. по крайней мере
в одном из направлений, в соответствии с принципом неопределенности приводит к
увеличению его импульса на величину ћ/L. Соответственно увеличивается и
кинетическая энергия электрона на величину ДЕ = ћ2k2/2m*
= (ћ 2/2m*) (n2/L2). Таким образом,
квантовое ограничение сопровождается как увеличением минимальной энергии
запертого электрона, так и дополнительным квантованием энергетических уровней,
соответствующих его возбужденному состоянию. Это приводит к тому, что
электронные свойства наноразмерных структур отличаются от известных объемных
свойств материала, из которого они сделаны.
Взаимодействие электронных волн в наноразмерных структурах
как между собой, так и с неоднородностями в них может сопровождаться
интерференцией аналогичной той, которая наблюдается для световых волн.
Отличительная особенность такой интерференции состоит в том, что благодаря
наличию у электронов заряда имеется возможность управлять ими с помощью
локального электростатического или электромагнитного поля и таким образом
влиять на распространение электронных волн.
Уникальным свойством квантовых частиц, в том числе и
электронов, является их способность проникать через преграду даже в случаях,
когда их энергия ниже потенциального барьера, соответствующего данной преграде.
Это было названо туннелированием. Схематически оно представлено на рис.6. Будь
электрон классической частицей, обладающей энергией E, он, встретив на своем
пути преграду. требующую для преодоления большей энергии U, должен был
бы отразиться от этой преграды. Однако как волна он хотя и с потерей энергии,
но проходит через эту преграду. Соответствующая волновая функция, а через нее и
вероятность туннелирования рассчитываются из уравнения Шрёдингера


Рис. 6. Туннелирование электрона с энергией E через потенциальный
барьер высотой U, U>E
Эта вероятность тем выше, чем геометрически тоньше барьер и меньше
ратина между энергией падающего электрона и высотой барьера.
Квантовое ограничение, проявляясь в наноразмерных структурах,
накладывает специфический отпечаток и на туннелирование. Так, квантование
энергетических состояний электронов в очень тонких, периодически расположенных
потенциальных ямах приводит к тому, что туннелирование через них приобретает
резонансный характер, то есть туннельно просочиться через такую структуру могут
лишь электроны с определенной энергией.
Другим специфическим проявлением квантово - го ограничения
является одноэлектронное туннелирование в условиях кулоновской блокады (рис.
7). Чтобы объяснить этот термин, рассмотрим иллюстрируемый рис. 7 пример
прохождения электроном структуры металл-диэлектрик-металл. В качестве наглядной
иллюстрации параллельно проводится аналогия с каплей, отрывающейся от края
трубки. Первоначально граница раздела между металлом и диэлектриком
электрически нейтральна. При приложении к металлическим областям потенциала на
этой границе начинает накапливаться заряд. Это продолжается до тех пор, пока
его величина не окажется достаточной для отрыва и туннелирования через
диэлектрик одного электрона. После акта туннелирования система возвращается в
первоначальное состояние. При сохранении внешнего приложенного напряжения все
повторяется вновь. Таким образом, перенос заряда в такой структуре
осуществляется порциями, равными заряду одного электрона. Процесс же накопления
заряда и отрыва электрона от границы металла с диэлектриком определяется
балансом сил кулоновского взаимодействия этого электрона с другими подвижными и
неподвижными зарядами в металле.
Рассмотренные квантовые явления уже используются в разработанных к
настоящему времени наноэлектронных элементах для информационных систем. Однако
следует подчеркнуть, что ими не исчерпываются все возможности приборного
применения квантового поведения электрона. Активные поисковые исследования в
этом направлении продолжаются и сегодня.
2.3 Методы и
средства изучения свойств наноструктур
Появление наноструктур потребовало новых методов и средств,
позволяющих изучать их свойства. С момента изобретения Г. Биннингом и Г.
Рорером первого варианта сканирующего туннельного зондового микроскопа в 1982
г. прошло всего 20 лет, но за это время из остроумной игрушки он превратился в
один из мощнейших инструментов нанотехнологии. Сейчас известны десятки
различных вариантов зондовой сканирующей микроскопии (SPM - scanning probe
microscopy).
Как видно из названия, общее у этих методов - наличие зонда
(чаще всего это хорошо заостренная игла с радиусом при вершине ~10 нм) и
сканирующего механизма, способного перемещать его над поверхностью образца в
трех измерениях. Грубое позиционирование осуществляют трехкоординатными
моторизированными столами. Тонкое сканирование реализуют с помощью
трехкоординатных пьезоактюаторов, позволяющих перемещать иглу или образец с
точностью в доли ангстрема на десятки микрометров по х и y и на единицы
микрометров - по z. Все известные в настоящее время методы SPM можно условно
разбить на три основные группы:
сканирующая туннельная микроскопия; в ней между
электропроводящим острием и образцом приложено небольшое напряжение (~0.01-10
В) и регистрируется туннельный ток в зазоре, зависящий от свойств и
расположения атомов на исследуемой поверхности образца;
атомно-силовая микроскопия; в ней регистрируют изменения силы
притяжения иглы к поверхности от точки к точке. Игла расположена на конце
консольной балочки (кантилевера), имеющей известную жесткость и способной
изгибаться под действием небольших ван-дер-ваальсовых сил, которые возникают
между исследуемой поверхностью и кончиком острия. Деформацию кантилевера
регистрируют по отклонению лазерного луча, падающего на его тыльную
поверхность, или с помощью пьезорезистивного эффекта, возникающего в самом
кантилевере при изгибе;
ближнепольная оптическая микроскопия; в ней зондом служит оптический
волновод (световолокно), сужающийся на том конце, который обращен к образцу, до
диаметра меньше длины волны света. Световая волна при этом не выходит из
волновода на большое расстояние, а лишь слегка "вываливается” из его
кончика. На другом конце волновода установлены лазер и приемник отраженного от
свободного торца света. При малом расстоянии между исследуемой поверхностью и
кончиком зонда амплитуда и фаза отраженной световой волны меняются, что и
служит сигналом, используемым при построении трехмерного изображения
поверхности.
В лучших модификациях туннельной и атомно-силовой микроскопии
удается обеспечить атомное разрешение, за которое пучковая электронная
микроскопия боролась более полувека и сейчас достигает ее в крайне редких
случаях. Размеры и стоимость зондовых микроскопов значительно ниже, чем у
традиционных электронных, а возможностей даже больше: они могут работать при
комнатной, повышенной и криогенной температуре, на воздухе, в вакууме и в
жидкости, в условиях действия сильных магнитных и электрических полей, СВЧ - и
оптического облучения и т.п. Зондовыми методами можно исследовать самые
разнообразные материалы: проводящие, диэлектрические, биологические и другие -
без трудоемкой подготовки образцов. Они могут использоваться для локального
определения атомных конфигураций, магнитных, электрических, тепловых,
химических и других свойств поверхности. Особенно интересны попытки
зарегистрировать спин-зависимые явления, определяющие величину туннельного тока
в зависимости от поляризации одного-единственного электрона в атоме на
исследуемой поверхности. Это прямой путь к решению задач одноэлектроники и
спинтроники.
Очень важно, что помимо исследовательских функций сканирующая
туннельная микроскопия может выполнять еще и активные - обеспечивать захват
отдельных атомов, перенос их в новую позицию, атомарную сборку проводников
шириной в один атом, локальные химические реакции, манипулирование отдельными
молекулами.
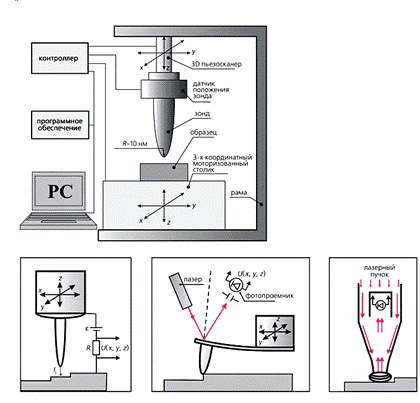
Типовая схема осуществления сканирующих зондовых
методов исследования и модификации поверхности в нанотехнологии (а) и три
основных типа приборов: б - туннельный микроскоп, в - атомно-силовой микроскоп
и г - ближнепольный оптический микроскоп.
Обычно используют два основных способа манипуляции атомами с
помощью иглы - горизонтальный и вертикальный. Процесс вертикальной манипуляции
отличается от горизонтальной тем, что после захвата нужный атом отрывают от
поверхности, поднимая зонд на несколько ангстрем. Это, разумеется, требует больших
усилий, чем "перекатывание" атома по поверхности, но зато потом
процесс переноса не зависит от встречающихся на ней препятствий (ступеней, ям,
адсорбированных атомов). Процесс отрыва атома от поверхности контролируют по
скачку тока. После перемещения в необходимое место его "сбрасывают”,
приближая острие к поверхности и переключая напряжение на игле. В сущности это
пока лишь демонстрация возможности достижения теоретического предела в
оперировании веществом при конструировании полезных человеку устройств.
Осуществление атомных манипуляций в массовом масштабе, пригодном для
производства, требует преодоления многих сложностей: необходимости криогенных
температур и сверхвысокого вакуума, низкой производительности и надежности и
т.д.
Гораздо больших успехов зондовые методы достигли в
нанолитографии - "рисовании" на поверхности различных наноструктур с
характерными размерами в десятки нм. Ближе всего к практическим приложениям
подошли процессы трех типов: химического окисления поверхности, индуцируемого
движущимся острием; осаждения с острия наноостровков металла на поверхность за
счет скачка напряжения; контролируемого наноиндентирования и наноцарапания.
Минимальные размеры элементов, создаваемых этими способами, составляют около 10
нм, что позволяет в принципе осуществлять очень плотную запись, но
производительность и надежность оставляют желать много лучшего. Диапазон от 1
до 10 нм пока не освоен для литографии даже в лабораторных условиях.
Развитие зондовых методов в направлении силового нанотестинга
поверхности дает возможность исследовать механические свойства тонких
приповерхностных слоев в нанообъемах, атомные механизмы наноконтактной
деформации при сухом трении, абразивном износе, механическом сплавлении и др.
Усовершенствование зондов для сканирующей микроскопии вызвало
к жизни поток публикаций о разработке и применении миниатюрных механических,
химических, тепловых, оптических и других сенсоров для различных задач.
Кантилеверы, создававшиеся первоначально для нужд
атомно-силовой микроскопии, демонстрируют высокую чувствительность не только к
приложенным силам, но и к химическим реакциям на поверхности, магнитному полю,
теплу, свету. Массивы кантилеверов из кремния, получаемые хорошо разработанными
в полупроводниковой промышленности технологиями и содержащие несколько десятков
(а иногда и сотен) отдельных датчиков, позволяют реализовать на одном чипе
функции "электронного носа” или "электронного языка" для
химического анализа газов и жидкостей, воздуха, продуктов питания. Так,
разработан сенсор, представляющий собой кантилевер с "пришитой” химически
биомолекулой на кончике острия. Эта молекула (например, антитело или энзим)
может селективно вступать в химическое взаимодействие только с избранными
веществами, которые могут находиться в многокомпонентном растворе. Захват определенной
молекулы из раствора и связывание ее на кончике острия приводит к изменению
резонансной частоты кантилевера на известную величину, что расценивается как
доказательство присутствия детектируемых молекул в пробе. Легко понять, что
чувствительность и избирательность таких сенсоров позволяет обнаруживать и
регистрировать отдельные молекулы в растворе!
Отметилась зондовая техника и среди претендентов, обещающих
повысить плотность записи информации. В частности, компания IBM финансирует
проект "Millipede" (от лат. - тысяченожка), возглавляемый одним из
нобелевских лауреатов 1986 г. Биннингом. Первоначально в качестве прототипа
использовали модифицированный атомно-силовой микроскоп, который наносил на
поверхность пластика отпечатки путем наноиндентирования. Однако для этого нужен
весьма жесткий и массивный кантилевер, что делает процесс записи и считывания
малопроизводительным. В проекте для увеличения производительности предлагается
использовать одновременно несколько тысяч кантилеверов, собранных в матрицу
(опытный образец имеет 1024 острия, размещенных на площади 3ґ3 мм2).
Каждый кантилевер имеет длину 70 мкм, ширину 10 мкм и толщину 0.5 мкм. На его
свободном конце сформировано острие высотой 1.7 мкм и радиусом в вершине менее
20 нм. Для уменьшения требуемых при наноиндентировании усилий, снижения массы
кантилевера и увеличения стойкости острия последнее нагревают короткими
импульсами тока до 300-400°С, что локально размягчает пластиковую пленку, на
которую записывается информация. В процессе доводки - матрица 64ґ64 острия на
площади около 7 мм2. Она имеет общую производительность несколько
сотен Мбайт/с как при записи, так и при считывании.
Биннинг с оптимизмом заявляет, что за несколько лет группа
надеется преодолеть терабитный барьер (имеется в виду ~Тбайт/дюйм2)
и приблизиться к атомной плотности записи (~103 Тбайт/см2), что в
принципе достижимо методами атомно-силовой микроскопии. Заметим, что помимо IBM
и другие компании ("Hewlett-Packard”, "Hitachi”, "Philips”,
"Nanochip”) ведут интенсивные разработки устройств со сверхвысокой
плотностью записи. Так что сейчас трудно сказать, какие из этих продуктов ждет
коммерческий успех. Но интуиции нобелевских лауреатов, видимо, стоит доверять,
как это делают такие гиганты, как IBM.
Итак, зондовые методы стали универсальным средством
исследования, атомарного дизайна, проведения химических реакций между двумя
выбранными атомами (молекулами), записи и хранения информации с предельно
возможным в природе разрешением ~10-10 м (для атомарных структур), а
также последующего ее считывания.
2.5
Применение наноструктур
Физические процессы в устройствах на основе квантовых точек
можно проиллюстрировать с помощью схемы работы одноэлектронного транзистора.
Возьмем для определенности сферический нанокристалл и поместим его в среду с
диэлектрической проницаемостью е. Его емкость будет С = eR,
а потенциал U = q/C, где q - электрический заряд. Для
нанокристалла диаметром R в несколько нанометров величина емкости
составляет примерно 10-18 Ф. Если поместить в него электрон (с
зарядом 1,6*10-19 Кл), то его потенциал изменится примерно на 0,1 В
и будет увеличиваться пропорционально 1/R.
Этого потенциала вполне достаточно, чтобы воспрепятствовать
движению других электронов. Схематическое изображение транзистора с
нанокристаллом CdSc в качестве активного элемента приведено на рис. 7.
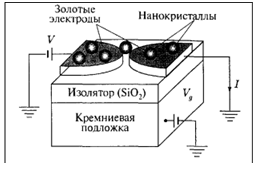
Рис. 7. Схема транзистора с нанокристалом CdSe в качестве
активного элемента.
Прибор изготовляется на кремниевой подложке, на которую можно
подать напряжение Vg для изменения положения уровня энергии в
нанокристалле. Подложка отделена слоем окиси кремния Si02 от золотых
электродов, на которые высажены нанокристаллы. Один из нанокристаллов замыкает
электроды. Если приложить небольшое (несколько милливольт) напряжение V
между электродами, то при определенном напряжении Vg электрон
попадает в нанокристалл на соответствующий энергетический уровень. При этом
наблюдается всплеск тока, составляющий 10-12 А. Очередное изменение Vg
вновь приведет к всплеску тока. Количество таких всплесков зависит от числа
уровней размерного квантования и, в принцип, определяется размерами
нанокристалла. Сопротивление прибора, схема которого представлена на рис.7,
обычно составляет около 10 МОм. Появились уже сообщения о создании
одноэлектронной памяти, работающей при комнатной температуре. Прибор основан на
транзисторе, в котором один электрон, захватываемый в нанокристалл, приводит к
запиранию одного из каналов транзистора.
Наиболее успешно квантовые структуры используются дня
создания лазеров. Схема такого лазера представлена на рис. 8.

Рис. 8. Энергетическая схема лазера на квантовой яме.
Предварительно уместно будет напомнить, что для работы лазера
необходимо создать инверсную заселенность энергетических уровней. Другими
словами, на более высоком уровне должно находиться больше электронов, чем на
низком, в то время как в состоянии теплового равновесия ситуация обратная.
Далее, каждому лазеру необходим оптический резонатор, или система зеркал,
которая задерживает электромагнитное излучение в рабочем объеме.
Для того чтобы квантовую яму превратить в лазер, нужно ее
подсоединить к двум контактам, через которые электроны могут непрерывно
поступать в рабочую область. Пусть через один контакт электроны поступают в зону
проводимости. Далее, совершая скачки из зоны проводимости в валентную зону, они
будут излучать кванты энергии (рис.8). Затем через валентную зону носители тока
должны уходить на другой контакт.
В соответствии с теорией частота излучения и
определяется условием

где Ес1 и Ев1
- энергии первых энергетических уровней в зоне проводимости и валентной
зоне, Е3 - ширина запрещенной зоны.
Электромагнитное излучение, генерируемое лазером, нужно
сконцентрировать в центральной, рабочей области прибора. Для этого показатель
преломления внутренних слоев должен быть больше, чем внешних. Можно сказать,
что внутренняя область играет роль волновода. На границе этого волновода
нанесены зеркала, которые образуют резонатор.
Лазеры на квантовых ямах обладают преимуществами по сравнению
с обычными полупроводниковыми лазерами. В частности, эти приборы можно
перестраивать, управляя параметрами энергетического спектра. Действительно,
меняя размеры квантовой ямы, можно изменять, согласно выражению (), частоту
излучения. Далее, подбирая толщину квантовой ямы, можно добиться, чтобы
затухание волны в оптической линии связи, в которую поступает излучение, было
минимальным. Кроме того, в двумерном электронном газе легче создать инверсную
заселенность. Поэтому лазеры на квантовых структурах достаточно экономны, дают
больше света на единицу потребляемой энергии - до 60% электрической мощности
преобразуется в свет.
Полупроводниковые квантовые точки также перспективны для
создания полупроводниковых лазеров. Электрон в квантовой точке переходит с
одного уровня в зоне проводимости на другой в валентной зоне с испусканием
фотона с энергией ћν, равной разности уровней
размерного квантования. Если в структуре с множеством одинаковых квантовых
точек инициировать согласованные переходы электронов, то возникает лазерное
излучение, генерация которого обычно является следствием пропускания тока через
структуру. Такая генерация уже получена. Перед учеными сейчас стоит задача
технологического характера - уменьшать разброс размеров квантовых точек при
росте структур.
Практическая важность лазеров общеизвестна. Отсюда огромная
потребность в них, и следовательно, стремление улучшать технико-экономические
показатели названных устройств. Проводимые последние примерно тридцать лет
исследования квантовых эффектов в полупроводниковых структурах позволяют уже
сейчас считать, что наноструктуры станут основными элементами больших
интегральных схем, способных с высокой скоростью перерабатывать и хранить
огромные объемы информации. Возможно, что уже в недалеком будущем наступит эра
квантовой полупроводниковой электроники. Данное обстоятельство можно
проиллюстрировать на примере полупроводниковых лазеров инфракрасного (ИК)
диапазона (2-5 мкм). Интерес к ним связан с широкими возможностями их научного
и практического применения в различных областях науки и техники. С помощью
ИК-лазеров как элементов полупроводниковых газоанализаторов осуществляют
химический контроль выбросов в атмосферу, так как в диапазоне длин волн 2-5 мкм
лежат полосы поглощения многих вредных (токсичных) промышленных газов. Длины
волн излучения современных ИК-лазеров попадают в окна прозрачности атмосферы
3,5-5 и 8-13 мкм. Это означает, что они могут находить широкое применение в
области телекоммуникации и локации. Широкое применение находят длинноволновые
лазеры в ИК-спектроскопии и медицине. Известно, что высокоэнергетические лазеры
используют в качестве хирургического инструмента - это так называемый световой
скальпель. Низкоэнергетические лазеры используются для
· избирательного разрушения клеток раковой
опухоли - фотодинамическая терапия,
· облучения плохо заживающих ран или крови
человека - лазеротерапия.
Однако создание ИК-лазеров, эффективно работающих при
комнатной температуре в непрерывном режиме, затруднено на сегодня, главным
образом, из-за заметного преобладания процессов безизлучательной рекомбинации
неравновесных носителей над процессом излучательной рекомбинации. Кроме того, в
ИК-лазерах заметно усилены потери, связанные с внутризонным поглощением излучения.
И наконец, у длинноволновых лазеров усилены процессы разогрева носителей и
решетки, что приводит к срыву генерации. Выполненные к настоящему времени
исследования показали, что для решения указанных проблем с целью создания
эффективных ИК-лазеров следует использовать полупроводниковые гетероструктуры с
глубокими квантовыми ямами.
Всего за несколько последних лет разработаны сотни
наноструктурированных продуктов конструкционного и функционального назначения и
реализованы десятки способов их получения и серийного производства. Можно
выделить несколько основных областей их применения: высокопрочные
нанокристаллические и аморфные материалы, тонкопленочные и гетероструктурные
компоненты микроэлектроники и оптотроники следующего поколения, магнитомягкие и
магнитотвердые материалы, нанопористые материалы для химической и
нефтехимической промышленности (катализаторы, адсорбенты, молекулярные фильтры
и сепараторы), интегрированные микроэлектромеханические устройства, негорючие
нанокомпозиты на полимерной основе, топливные элементы, электрические
аккумуляторы и другие преобразователи энергии, биосовместимые ткани для
трансплантации, лекарственные препараты.
Наиболее крупнотоннажным (после строительных) является
производство высокопрочных конструкционных материалов, главным образом металлов
и сплавов. Потребность в них и материалоемкость изделий из них зависят от
механических свойств: упругости, пластичности, прочности, вязкости разрушения и
др. Известно, что прочность материалов определяется химическим составом и реальной
атомарной структурой (т.е. наличием определенной кристаллической решетки - или
ее отсутствием - и всем спектром ее несовершенств). Высоких прочностных
показателей можно добиваться двумя прямо противоположными способами: снижая
концентрацию дефектов структуры (в пределе приближаясь к идеальному
монокристаллическому состоянию) или, наоборот, увеличивая ее вплоть до создания
мелкодисперсного нанокристаллического или аморфного состояния. Оба пути широко
используют в современном физическом материаловедении и производстве.
Разработаны составы и технологии нанесения сверхтвердых
покрытий толщиной около 1 мкм, уступающих по твердости только алмазу. При этом
резко увеличивается износостойкость режущего инструмента, жаростойкость,
коррозионная стойкость изделия, сделанного из сравнительно дешевого материала.
По пленочной технологии можно создавать не только сплошные или островковые
покрытия, но и щетинообразные, с упорядоченным расположением нановорсинок
одинаковой толщины и высоты. Они могут работать как сенсоры, элементы экранов
высокого разрешения и в других приложениях.
Способность углерода образовывать цепочки - С-С-С -
используется Природой для создания биополимеров, а человеком - синтетических
полимеров и разнообразных пластмасс. В 1985 г.Х. Крото с сотрудниками
обнаружили в парах графита, полученных его испарением под лазерным пучком,
кластеры (или многоатомные молекулы) углерода. Наиболее стабильными из них
оказались С60 и С70. Как выяснилось в результате
структурного анализа, первый из них имел форму футбольного, а второй -
регбийного мяча. Позднее их стали называть фуллеренами в честь американского
архитектора Р. Фуллера, получившего в 1954 г. патент на строительные
конструкции в виде многогранных сфероидов для перекрытия больших помещений.
Шарообразные (или дынеобразные) молекулы имеют необычную симметрию и уникальные
свойства. Все ковалентные связи в них насыщены, и между собой они могут
взаимодействовать только благодаря слабым ван-дер-ваальсовым силам. При этом
последних хватает, чтобы построить из сферических молекул кристаллические
структуры (фуллериты). К каждой такой молекуле можно "привить" другие
атомы и молекулы, можно поместить чужеродный атом в центральную полость
фуллереновой молекулы, как в суперпрочный контейнер, или полимеризовать их,
раскрыв внутренние связи, и т.д.
Впоследствии научились выращивать однослойные и многослойные
углеродные нанотрубки. Крайне важно, что свойствами нанотрубок удается
управлять, изменяя их хиральность - скрученность решетки относительно
продольной оси. При этом легко можно получить проволоку нанометрового диаметра
как с металлическим типом проводимости, так и с запрещенной зоной заданной
ширины. Соединение двух таких нанотрубок образует диод, а трубка, лежащая на
поверхности окисленной кремниевой пластинки, - канал полевого транзистора.
Такие наноэлектронные устройства уже созданы и показали свою работоспособность.
Нанотрубки с регулируемым внутренним диаметром служат основой идеальных
молекулярных сит высокой селективности и газопроницаемости, контейнеров для хранения
газообразного топлива, катализаторов. Кроме того, нанотрубки могут
использоваться как сенсоры, атомарно острые иголки, элементы экранов дисплеев
сверхвысокого разрешения.
Основные методы создания тонкопленочных структур можно
разбить на два больших класса, базирующихся на физическом (в первую очередь,
молекулярно-лучевой эпитаксии) и химическом осаждении. При малой толщине (до
нескольких атомных слоев) двумерная подвижность осаждаемых на подложку атомов
может быть очень высокой. В результате быстрой диффузии по поверхности
происходит самосборка нанообъектов, обладающих ярко выраженными квантовыми
свойствами: образуются квантовые точки, квантовые ямы, квантовые проволоки,
кольца и др. Если систему квантовых точек покрыть слоем инертного материала, а
затем снова напылить активный материал, то опять образуются островки,
самоупорядочивающиеся на поверхности и даже скоррелированные с положением их
предшественников. Повторяя такие процедуры множество раз, можно получить
объемно упорядоченные структуры (квазирешетки) из квантовых ям или точек,
называемые гетероструктурами, и сделать на их основе лазерные источники света,
фотоприемники (в том числе инфракрасного излучения в области длин волн 8-14
мкм, соответствующей максимуму теплового излучения человеческого тела),
накопители информации. Вся современная микроэлектроника базируется на планарных
полупроводниковых технологиях, которые дают возможность создавать самые
разнообразные многослойные тонкопленочные структуры с функциями сенсоров,
логической и арифметической обработки сигнала, его хранения и передачи по
электронным или оптическим линиям связи.
3.
Экспериментальное исследование электрофизических параметров полупроводниковых
материалов
Данная глава посвящена исследованию
электрофизических параметров полупроводниковых материалов. В ходе экспериментов
определялись удельное сопротивление с использованием четырехзондовой методики,
тип электропроводности, температурная зависимость электрического сопротивления
полупроводников, вольт-амперные характеристики фоторезисторов, определение
толщины диффузионного слоя методом косого шлифа, определение толщины окисного
слоя методом наблюдения цвета пленки.
3.1 Измерение
удельного сопротивления четырехзондовым методом и определение типа
электропроводности
Цель работы:
Определить удельное сопротивление полупроводникового образца
с использованием четырехзондовой методики, а также определить тип
электропроводности полупроводникового образца с использованием термозонда.
Оборудование: потенциометр, мультиметр MY-64, магазин
сопротивлений, универсальный мост, реостат 5000 Ом, держатель образца,
полупроводниковые образцы произвольной формы, источники постоянного тока, ключи
и переключатели.
Схема экспериментальной установки:
Для определения удельного сопротивления образцов:
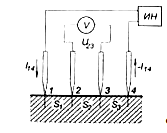
Для определения типа проводимости образцов:
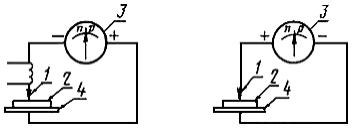
Экспериментальные данные:
1. Определение типа проводимости:
|
№ образца
|
1
|
2
|
3
|
4
|
|
Тип проводимости
|
электронный
|
электронный
|
электронный
|
дырочный
|
. Определение удельного сопротивления:
|
n=5 α=0,9 t=2,1
|
|
Образец №1
|
|
№
|
I, мА
|
U, В
|
U/I
|
, Ом*м
|
, (Ом*м) 2
|
S, Ом*м
|
, Ом*м
|
|
|
1
|
2
|
0,06
|
0,03
|
2,4492
|
-0,073476
|
0,005398723
|
0,013
|
0,0281711
|
1, 19
|
|
2
|
2
|
0,06
|
0,0295
|
2,40838
|
-0,032656
|
0,001066414
|
|
|
|
|
3
|
2
|
0,06
|
0,0285
|
2,32674
|
0,048984
|
0,002399432
|
|
|
|
|
4
|
2
|
0,06
|
0,0295
|
2,40838
|
-0,032656
|
0,001066414
|
|
|
|
|
5
|
2
|
0,06
|
0,028
|
2,28592
|
0,089804
|
0,008064758
|
|
|
|
|
ср. знач
|
|
|
|
2,37572
|
-3,553E-16
|
0,003599148
|
|
|
|
|
Образец №2
|
|
№
|
I, мА
|
U, В
|
U/I
|
, Ом*м
|
, Ом*м
|
, (Ом*м) 2
|
S, Ом*м
|
, Ом*м
|
|
|
1
|
2
|
0,06
|
0,0295
|
2,40838
|
-0,032656
|
0,001066414
|
0,083
|
0,1745869
|
6,46
|
|
2
|
2
|
0,07
|
0,0355
|
2,89822
|
-0,522496
|
0,27300207
|
|
|
|
|
3
|
2
|
0,06
|
0,032
|
2,61248
|
-0,236756
|
0,056053404
|
|
|
|
|
4
|
2
|
0,07
|
0,0335
|
2,73494
|
-0,359216
|
0,129036135
|
|
|
|
|
5
|
2
|
0,07
|
0,035
|
2,8574
|
-0,481676
|
0,232011769
|
|
|
|
|
ср. знач
|
|
|
|
2,70228
|
-0,32656
|
0,138233958
|
|
|
|
|
Образец №3
|
|
№
|
I, мА
|
U, В
|
U/I
|
, Ом*м
|
, Ом*м
|
, (Ом*м) 2
|
S, Ом*м
|
, Ом*м
|
|
|
1
|
2
|
7,86
|
3,93
|
320,845
|
-318,46948
|
101422,8071
|
49,98
|
104,95215
|
47,8
|
|
2
|
2
|
5,33
|
2,665
|
217,571
|
-215, 19488
|
46308,83466
|
|
|
|
|
3
|
2
|
4,32
|
2,16
|
176,342
|
-173,96668
|
30264,40436
|
|
|
|
|
4
|
2
|
4,5
|
2,25
|
183,69
|
-181,31428
|
32874,86668
|
|
|
|
|
5
|
2
|
4,89
|
2,445
|
199,61
|
-197,23408
|
38901,28074
|
|
|
|
|
ср. знач
|
|
|
|
219,612
|
-217,23588
|
49954,43872
|
|
|
|
|
Образец №4
|
|
№
|
I, мА
|
U, В
|
U/I
|
, Ом*м
|
, Ом*м
|
, (Ом*м) 2
|
S, Ом*м
|
, Ом*м
|
|
|
1
|
2
|
6,7
|
3,35
|
273,494
|
-271,11828
|
73505,11958
|
82,98
|
174,25773
|
47,3
|
|
2
|
2
|
10,8
|
5,4
|
440,856
|
-438,48028
|
192264,9524
|
|
|
|
|
3
|
2
|
10,6
|
5,3
|
432,692
|
-430,31628
|
185172,0974
|
|
|
|
|
4
|
2
|
8,7
|
4,35
|
355,134
|
-352,75828
|
124438,4013
|
|
|
|
|
5
|
2
|
8,3
|
4,15
|
338,806
|
-336,43028
|
113185,3306
|
|
|
|
|
ср. знач
|
|
|
|
368, 196
|
-365,82068
|
137713,1803
|
|
|
|
Вывод:
В ходе выполнения данной работы были определены тип электропроводности
и удельное сопротивление для четырех полупроводниковых образцов. В результате
установлено, что для каждого образца эти величины имеют следующие значения:
|
Образец
|
Тип проводимости
|
ρ, Ом∙см
|
|
1
|
Электронный
|
0,024
|
|
2
|
Электронный
|
0,027
|
|
3
|
Электронный
|
2, 19
|
|
4
|
Дырочный
|
3,68
|
Сопоставляя полученные значения удельного сопротивления с
табличными, с учетом определенного типа проводимости можно сделать вывод, что
исследованные образцы под номерами 1,2 принадлежат к марке монокристаллического
кремния КЭФ 3В, образец №3 к марке КЭФ 1А, а образец №4 к марке КДБ 1А.
В ходе исследования была снята температурная зависимость
удельного сопротивления при комнатной температуре t=23°C и при температуре
t=-8°C. В результате установлено, что с понижением температуры удельное
сопротивление уменьшается, что соответствует теории.
3.2
Исследование температурной зависимости электрического сопротивления
полупроводников
Цель работы: ознакомление с классическим методом измерения
сопротивления при помощи резистивного моста; вычисление удельного
сопротивления.
Оборудование: мост постоянного тока, нагреватель,
измеритель температуры, терморезисторы, мультиметр MY-64.
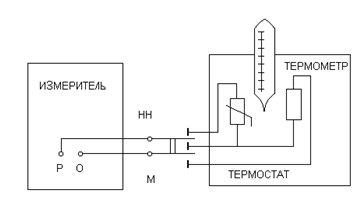
Схема экспериментальной установки
Экспериментальные данные: ММТ-8
|
№
|
t,°C
|
T, K
|
1/T*10Ї⁵
|
R, Ом
|
LnR
|
DE*10Іі, Дж/К
|
DR, Ом
|
DRІ, ОмІ
|
S
|
DR, Ом
|
e
|
|
1
|
20
|
293
|
341,297
|
117,85
|
4,769413
|
55,96605634
|
-0,9412
|
0,88595
|
0,07
|
0,1291
|
0,1
|
|
2
|
40
|
313
|
319,489
|
117,33
|
4,76499
|
|
-0,4213
|
0,17745
|
|
|
|
|
3
|
50
|
323
|
309,598
|
117,21
|
4,763967
|
|
-0,3012
|
0,09075
|
|
|
|
60
|
333
|
300,3
|
116,98
|
4,762003
|
|
-0,0713
|
0,00508
|
|
|
|
|
5
|
70
|
343
|
291,545
|
116,77
|
4,760206
|
|
0,13875
|
0,01925
|
|
|
|
|
6
|
80
|
353
|
283,286
|
116,51
|
4,757977
|
|
0,39875
|
0,159
|
|
|
|
|
7
|
90
|
363
|
275,482
|
116,39
|
4,756947
|
|
0,51875
|
0,2691
|
|
|
|
|
8
|
100
|
373
|
268,097
|
116,23
|
4,755571
|
|
0,67875
|
0,4607
|
|
|
|
|
ср. знач
|
|
|
|
116,9088
|
|
|
-2E-15
|
0,25841
|
|
|
|

ММТ-8
|
№
|
t,°C
|
T, K
|
1/T*10Ї⁵
|
R, Ом
|
LnR
|
DE*10Іі, Дж/К
|
DR, Ом
|
DRІ, ОмІ
|
S
|
DR, Ом
|
e
|
|
1
|
20
|
293
|
341,297
|
20,62
|
3,026261
|
1719,798835
|
-7,405
|
54,834
|
0,62
|
1,1815
|
8,9
|
|
2
|
40
|
313
|
319,489
|
18
|
2,890372
|
|
-4,785
|
22,8962
|
|
|
|
|
3
|
50
|
323
|
309,598
|
16
|
2,772589
|
|
-2,785
|
7,75623
|
|
|
|
|
4
|
60
|
333
|
300,3
|
14,3
|
2,66026
|
|
-1,085
|
1,17723
|
|
|
|
|
5
|
70
|
343
|
291,545
|
12
|
2,484907
|
|
1,215
|
1,47623
|
|
|
|
|
6
|
80
|
353
|
283,286
|
10,8
|
2,379546
|
|
2,415
|
5,83223
|
|
|
|
|
7
|
90
|
363
|
275,482
|
8
|
2,079442
|
|
5,215
|
27, 1962
|
|
|
|
|
8
|
100
|
373
|
268,097
|
6
|
1,791759
|
|
7,215
|
52,0562
|
|
|
|
|
ср. знач
|
|
|
|
13,215
|
|
|
0
|
21,6531
|
|
|
|

КМТ-12
|
№
|
t,°C
|
T, K
|
1/T*10Ї⁵
|
R, Ом
|
LnR
|
DE*10Іі, Дж/К
|
DR, Ом
|
DRІ, ОмІ
|
S
|
DR, Ом
|
e
|
|
1
|
14
|
287
|
348,432
|
590
|
6,380123
|
8035,673521
|
-111,25
|
12376,6
|
8,85
|
16,815
|
3,5
|
|
2
|
16
|
289
|
346,021
|
550
|
6,309918
|
|
-71,25
|
5076,56
|
|
|
|
|
3
|
18
|
291
|
343,643
|
520
|
6,253829
|
|
-41,25
|
1701,56
|
|
|
|
|
4
|
20
|
293
|
341,297
|
490
|
6, 194405
|
|
-11,25
|
126,563
|
|
|
|
|
5
|
22
|
295
|
338,983
|
450
|
6,109248
|
|
28,75
|
826,563
|
|
|
|
|
6
|
24
|
297
|
336,7
|
430
|
6,063785
|
|
48,75
|
2376,56
|
|
|
|
|
7
|
26
|
299
|
334,448
|
410
|
6,016157
|
|
68,75
|
4726,56
|
|
|
|
|
8
|
28
|
301
|
332,226
|
390
|
5,966147
|
|
88,75
|
7876,56
|
|
|
|
|
ср. знач
|
|
|
|
478,75
|
|
|
0
|
4385,94
|
|
|
|

Вывод:
В ходе выполнения данной работы были cняты температурные
характеристики, вычислена ширина запрещённой зоны полупроводника. В результате
установлено, что зависимость сопротивления полупроводника от температуры имеет
экспоненциальный характер.
3.3 Изучение
фотопроводимости полупроводников
Цель работы: исследовать вольт-амперные характеристики
фоторезисторов.
Оборудование: мультиметр MY-64, реостат 5000 Ом,
источник постоянного тока, источник питания, люксметр Ю116, фоторезистор ФСК-1,
осветитель, проектор на 2000 лк.
Схема экспериментальной установки:
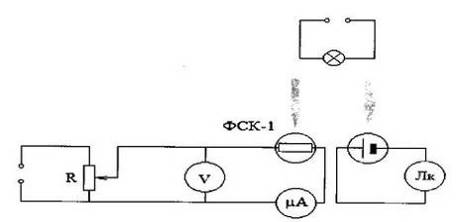
Экспериментальные данные: ВАХ ФСК-1
|
E=100 Лк
|
n=16
|
α=0,9
|
t=1,8
|
|
№
|
U, В
|
Ic, мА
|
Iт, мА
|
Iф, мА
|
I, мА
|
I, мА
|
|
S
|
I, мА
|
|
|
1
|
1
|
0,005
|
0
|
0,005
|
0,0101
|
0,0051
|
0,00002601
|
0,001
|
0,002
|
0,7
|
|
2
|
0,012
|
0,001
|
0,011
|
0,02222
|
0,01122
|
0,000125888
|
|
|
|
|
3
|
3,5
|
0,021
|
0,001
|
0,02
|
0,03535
|
0,01535
|
0,000235623
|
|
|
|
|
4
|
5,5
|
0,036
|
0,001
|
0,035
|
0,05555
|
0,02055
|
0,000422303
|
|
|
|
|
5
|
7,9
|
0,06
|
0,001
|
0,059
|
0,07979
|
0,02079
|
0,000432224
|
|
|
|
|
6
|
9,9
|
0,079
|
0,002
|
0,077
|
0,09999
|
0,02299
|
0,00052854
|
|
|
|
|
7
|
15
|
0,137
|
0,002
|
0,135
|
0,1515
|
0,0165
|
0,00027225
|
|
|
|
|
8
|
20,2
|
0, 191
|
0,002
|
0,189
|
0, 20402
|
0,01502
|
0,0002256
|
|
|
|
|
9
|
25,2
|
0,248
|
0,002
|
0,246
|
0,25452
|
0,00852
|
7,25904E-05
|
|
|
|
|
10
|
30
|
0,29
|
0,002
|
0,288
|
0,303
|
0,015
|
0,000225
|
|
|
|
|
11
|
34,8
|
0,342
|
0,003
|
0,339
|
0,35148
|
0,01248
|
0,00015575
|
|
|
|
|
12
|
40,1
|
0,408
|
0,003
|
0,405
|
0,40501
|
1E-05
|
1E-10
|
|
|
|
|
13
|
44,9
|
0,463
|
0,003
|
0,46
|
0,45349
|
-0,00651
|
4,23801E-05
|
|
|
|
|
14
|
50
|
0,515
|
0,003
|
0,512
|
0,505
|
-0,007
|
4,9E-05
|
|
|
|
|
15
|
55
|
0,568
|
0,003
|
0,565
|
0,5555
|
-0,0095
|
9,025E-05
|
|
|
|
|
16
|
60,3
|
0,625
|
0,003
|
0,622
|
0,60903
|
-0,01297
|
0,000168221
|
|
|
|
|
ср. знач
|
|
|
|
|
0,255972
|
0,007971875
|
0,000255528
|
|
|
|
|
E=200 Лк
|
n=14
|
α=0,9
|
t=1,8
|
|
№
|
U, В
|
Ic, мА
|
Iт, мА
|
Iф, мА
|
I, мА
|
I, мА
|
|
S
|
I, мА
|
|
|
1
|
1
|
0,011
|
0
|
0,011
|
0,0173
|
0,0063
|
0,00003969
|
0,001
|
0,002
|
0,4
|
|
2
|
2
|
0,023
|
0,001
|
0,022
|
0,0346
|
0,0126
|
0,00015876
|
|
|
|
|
3
|
5,5
|
0,081
|
0,001
|
0,08
|
0,09515
|
0,01515
|
0,000229523
|
|
|
|
|
4
|
10,5
|
0,162
|
0,002
|
0,16
|
0,18165
|
0,02165
|
0,000468723
|
|
|
|
|
5
|
15,2
|
0,241
|
0,002
|
0,239
|
0,26296
|
0,02396
|
0,000574082
|
|
|
|
|
6
|
20
|
0,336
|
0,002
|
0,334
|
0,346
|
0,012
|
0,000144
|
|
|
|
|
7
|
25
|
0,419
|
0,002
|
0,417
|
0,4325
|
0,0155
|
0,00024025
|
|
|
|
|
8
|
30
|
0,5
|
0,002
|
0,498
|
0,519
|
0,021
|
0,000441
|
|
|
|
|
9
|
35,2
|
0,606
|
0,003
|
0,603
|
0,60896
|
0,00596
|
3,55216E-05
|
|
|
|
|
10
|
40,1
|
0,693
|
0,003
|
0,69
|
0,69373
|
0,00373
|
1,39129E-05
|
|
|
|
|
11
|
45,2
|
0,784
|
0,003
|
0,781
|
0,78196
|
0,00096
|
9,216E-07
|
|
|
|
|
12
|
50
|
0,874
|
0,003
|
0,871
|
0,865
|
-0,006
|
3,6E-05
|
|
|
|
|
13
|
55,1
|
0,961
|
0,003
|
0,958
|
0,95323
|
-0,00477
|
2,27529E-05
|
|
|
|
|
14
|
60,1
|
1,064
|
0,003
|
1,061
|
1,03973
|
-0,02127
|
0,000452413
|
|
|
|
|
ср. знач
|
|
|
|
|
0,487984
|
0,007626429
|
|
|
|
|
E=500 Лк
|
n=14
|
α=0,9
|
t=1,8
|
|
№
|
U, В
|
Ic, мА
|
Iт, мА
|
Iф, мА
|
I, мА
|
I, мА
|
|
S
|
I, мА
|
|
|
1
|
1
|
0,018
|
0
|
0,018
|
0,0311
|
0,0131
|
0,00017161
|
0,002
|
0,003
|
0,4
|
|
2
|
2,2
|
0,048
|
0,001
|
0,047
|
0,06842
|
0,02142
|
0,000458816
|
|
|
|
|
3
|
5,1
|
0,129
|
0,001
|
0,128
|
0,15861
|
0,03061
|
0,000936972
|
|
|
|
|
4
|
10
|
0,271
|
0,002
|
0,269
|
0,311
|
0,042
|
0,001764
|
|
|
|
|
5
|
15,1
|
0,428
|
0,002
|
0,426
|
0,46961
|
0,04361
|
0,001901832
|
|
|
|
|
6
|
20
|
0,59
|
0,002
|
0,588
|
0,622
|
0,034
|
0,001156
|
|
|
|
|
7
|
25
|
0,753
|
0,002
|
0,751
|
0,7775
|
0,0265
|
0,00070225
|
|
|
|
|
8
|
30
|
0,908
|
0,002
|
0,906
|
0,933
|
0,027
|
0,000729
|
|
|
|
|
9
|
34,8
|
1,067
|
0,003
|
1,064
|
1,08228
|
0,01828
|
0,000334158
|
|
|
|
|
10
|
39,8
|
1,239
|
0,003
|
1,236
|
1,23778
|
0,00178
|
3,1684E-06
|
|
|
|
|
11
|
45,2
|
1,413
|
0,003
|
1,41
|
1,40572
|
-0,00428
|
1,83184E-05
|
|
|
|
|
12
|
50,6
|
1,592
|
0,003
|
1,589
|
1,57366
|
-0,01534
|
0,000235316
|
|
|
|
|
13
|
55,4
|
1,749
|
0,003
|
1,746
|
1,72294
|
-0,02306
|
0,000531764
|
|
|
|
|
14
|
59,7
|
1,885
|
0,003
|
1,882
|
1,85667
|
-0,02533
|
0,000641609
|
|
|
|
|
ср. знач
|
|
|
|
|
0,875021
|
0,013592143
|
0,000869376
|
|
|
|
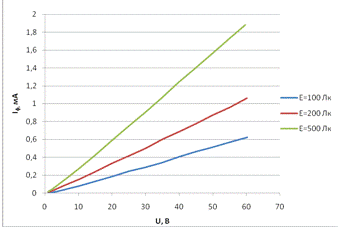
Вывод: Вольт-амперная характеристика прибора нелинейная
при малых освещенностях и линейная при больших, т.е. выполняется закон Ома в
широкой области изменения напряжения. В области слабых электрических полей
фоторезисторы являются омическими сопротивлениями.
3.4 Измерение
толщины диффузионного слоя методом шарового шлифа
Цель работы:
Определить толщину диффузионного слоя эпитаксиальной
структуры методом шарового шлифа (R=20 см).
Оборудование: микроскоп
Экспериментальные данные:
Таблица 2.4.1 Определение толщины
диффузионного слоя.
|
№ образца
|
R, мм
|
х, мм
|
у, мм
|
хi, мкм
|
|
1
|
200
|
0,28
|
1,96
|
1,4
|
|
2
|
200
|
0,18
|
1,02
|
0,46
|
|
3
|
200
|
0,77
|
2,48
|
4,7
|
Вывод: мы получили разумные значения толщины
диффузионного слоя. Данное исследование проводилось для более полного понимания
технологии изготовления полупроводниковых приборов.
3.5 Измерение
толщины окисного слоя визуальным цветовым методом контроля наблюдения цвета
пленки
Цель работы: определить толщину окисного слоя
эпитаксиальной структуры визуальным цветовым методом контроля наблюдения цвета
пленки.
Экспериментальные данные:
Таблица 2.4.1 Определение толщины окисного
слоя.
|
№ образца
|
Цвет пленки
|
m
|
d, мкм для разных порядков интерференции
|
|
1
|
фиолетовый
|
1
|
0,3
|
|
|
2
|
0,46
|
|
|
3
|
0,63
|
|
2
|
фиолетовый
|
1
|
0,3
|
|
|
2
|
0,46
|
|
|
3
|
0,63
|
|
3
|
Зелено-голубой
|
1
|
0,32
|
|
|
2
|
0,5
|
|
|
3
|
0,72
|
Вывод: мы получили разумные значения толщины окисного
слоя. Зная порядок интерференции можно выбрать соответствующее значение толщины
пленки. Данное исследование проводилось для более полного понимания технологии
изготовления полупроводниковых приборов, т.к. большое значение при изготовлении
полупроводниковых приборов играет формирование окисного слоя на кремниевой
подложке и его параметры.
3.6 Оценочные
расчеты теоретического предела минимального размера изображения при различных
видах литографии
Теоретически достижимая минимальная ширина линии lmin рисунка
в зависимости от длины волны λ облучения, применяемого
для экспонирования, в соответствии с критерием Рэлея определяется соотношением:

 (2.6.1)
(2.6.1)
Рассмотрим, как изменяется lmin в зависимости от λ.
Таблица 2.6.1 Оценка теоретического предела минимального
размера изображения, получаемого при литографии.
|
Метод литографии
|
λ, нм
|
n
|

|
  , нм , нм
|
|
Фотолитография
|
Ртутная лампа
|
400
|
1
|
0,95
|
256,84
|
|
Эксимерный лазер KrF
|
248
|
|
|
158,72
|
|
Эксимерный лазер ArF
|
193
|
|
|
123,52
|
|
Эксимерный лазер F2
|
157
|
|
|
100,48
|
|
EUV-литография
|
13
|
|
|
8,32
|
|
Рентгеновская литография
|
0,1
|
|
|
0,06
|
|
Электронная литография
|
<1
|
|
|
<0,06
|
Из таблицы видно, что чем меньше длина волны используемого
излучения, тем меньше минимальная ширина линии рисунка при изготовлении ИС. На
размер рисунка кроме длины волны используемого излучения оказывают влияние
множество факторов, например, разрешающая способность резиста, возможности
проекционной аппаратуры, отражение от подложки и др.
Проведенная оценка теоретического предела минимального размера
изображения, получаемого при различных видах литографии показывает, что
рентгенолитография отличается большей разрешающей способностью, чем
фотолитография. Так же сегодня осуществляется переход к EUV-литографии, что
делает возможной печать линий гораздо меньшей ширины - до 30 нм.
Заключение
Подводя итоги по данной работе, следует отметить, что были
выполнены все поставленные цели:
· углубить знания раздела дисциплины,
касающегося основных свойств полупроводниковых материалов;
· рассмотреть и изучить свойства
полупроводниковых материалов.
В работе были исследованы полупроводниковые приборы:
· получены зависимости проводимости,
сопротивления от температуры
· определена ширина запрещенной зоны
· получены вольт-амперные характеристики
· определена величина удельного
сопротивления эпитаксиальных структур
· определена толщина диффузионного слоя
· определена толщина окисного слоя пленки
В процессе выполнения работы была изучена зонная теория
твердого тела, теория, описывающая концентрацию носителей заряда в полупроводниках,
динамика образования и движения носителей заряда в полупроводниковых
материалах, изучены физические основы наноэлектроники. Освоены методы
исследования вольт-амперных характеристик полупроводниковых приборов,
четырехзондовый метод измерения удельного сопротивления, зависимости
сопротивления от температуры, определения толщины диффузионного слоя
эпитаксиальных структур, определения толщины окисного слоя пленки
эпитаксиальных структур.
Полупроводниковые материалы применяются для изготовления полупроводниковых
приборов и устройств микроэлектроники. Особенности электрофизических свойств
полупроводников определяются природой сил связи. Пригодность полупроводникового
материала зависит от его кристаллической структуры, ширины запрещенной зоны, положения
примесных уровней и однородности распределения примеси по объему. Оптическими,
термическими, термоэлектрическими, и электрическими свойствами
полупроводниковых материалов определяются эксплуатационные характеристики
готовых изделий. Особые требования предъявляют к таким свойствам, как тип
электропроводности, концентрация введенной примеси, подвижность и время жизни
носителей заряда.
В заключение хотелось бы еще раз подчеркнуть, что развитие
современной электронной техники идёт по пути микроминиатюризации электронного
оборудования. Только развитие полупроводниковой электроники открыло перед
электронной техникой эту возможность. Таким образом, главнейшей задачей,
стоящей перед полупроводниковой техникой, является обеспечение возможности
создания микроминиатюрного высоконадежного и дешевого электронного
оборудования.
Список
использованной литературы
1. Федотов
Я.А. Основы физики полупроводниковых приборов. - М.: Советское радио, 1969.
2. Епифанов
Г.И., Мома Ю.А. Физические основы конструирования и технологии РЭА и ЭВА. - М.:
Советское радио, 2009.
. Епифанов
Г.И. Физика твёрдого тела. - М.: В.Ш. 1977.
. Рымкевич
П.А. Курс физики. - М.: В.Ш. 1977.
. Пасынков
В.В., Сорокин В.С. Материалы электронной техники. - Учеб. Для студентов по
спец. ”Полупроводники и диэлектрики" - 2-е изд., перераб. и доп. - М.:
Высшая школа, 1986.
. Пасынков
В.В., Чиркин Л.К. Полупроводниковые приборы. М.: Высшая школа, 1987.
. Пасынков
В.В., Богородицкий Н.П. Электротехнические материалы. - М.: Высшая школа, 1977
. Шалимов
К.В. Физика полупроводников: Учебник для вузов. - 3-е изд., перераб. и доп. -
М.: Энергоатомиздат, 1985.
. Шалимов
К.В. Практикум по полупроводникам и полупроводниковым приборам. - М.: Высшая
школа, 1968.
. Лысов
В.Ф. Практикум по физике полупроводников - М.: Просвещение, 1976.
11. http://elib.
ispu.ru/library/lessons/Egorov/HTML/Index.html
<http://elib.ispu.ru/library/lessons/Egorov/HTML/Index.html>