Особенности электронной литографии при низких ускоряющих напряжениях
Особенности
электронной литографии при низких ускоряющих напряжениях
Оглавление
Введение
1. Представление об основах
литографии
2. Почему 5 кэВ. Постановка
задачи
Глава 1. Установки и технология
изготовления образцов
1. Подготовка подложки
2. Нанесение резиста, отжиг
. Экспонирование
. Проявление полученной
структуры
. Нанесения металла, lift
off
Глава 2. Чувствительность резиста
1.
Взаимодействие
электронов с резистом. Приближение непрерывных потерь
2.
Чувствительность
и контрастность
3.
Проявление
полимерных резистов
4.
Экспериментальное
определение чувствительности. Дозовый клин
Глава 3. Определение эффективного
диаметра электронного луча при первичном прохождении через резист (α
)
1. Метод определение α
с
помощью α-теста.
Описание структуры
2. Результаты определения α
для разных ускоряющих напряжений и толщин резиста
. Вклад рассеяния в резисте в
уширение электронного луча
Заключение. Выводы
Список литературы
Введение
1. Одной из основных методик создания микро- и
нано- структур является электронная литография. Наиболее широко она
востребована в современной микроэлектронике, где с ее помощью создают небольшие
экспериментальные партии или единичные структуры. Основными достоинствами
электронной литографии является очень высокое разрешение, гибкость в создании
разных типов структур и способность работать с разнообразными материалами. К
недостаткам относится то, что данная методика гораздо менее производительная и
более медленная, чем оптическая литография, а так же довольно трудоемкая и требует
сложного и дорогого оборудования. При электронной литографии пучок электронов
скользит по поверхности покрытой материалом чувствительным к электронам. Такой
материал называют электронным резистом. Электронные резисты делятся на
позитивные и негативные. У позитивного резиста увеличивается растворимость
областей проэкспонированных электронных пучком, а значит, при проявлении именно
с облученной области резист будет удаляться легче. Для негативного резиста -
наоборот, растворимость экспонированной области негативного резиста понижается,
а значит именно она остаётся на подложке после процесса проявления. Позитивные
резисты имеют гораздо более широкое применение, чем негативные. Это связано с
тем, что у них более высокая разрешающая способность, они требуют меньше
технологических операций и менее чувствительны к изменению параметров
литографического процесса.
Постановка задачи.
Безусловно, одним основных требований в
электронной литографии является максимально возможное разрешение. Разрешение
определяется многими факторами, зависящими как от свойств используемых резиста
и подложки, так и от возможностей литографа и опыта оператора. Чем меньше
энергия электронов, тем сильнее уширяется пучок в резисте и существеннее эффект
близости. Поэтому до сих пор наибольшего успеха удавалось достичь при
ускоряющих напряжениях в диапазоне 20 - 50 кэВ, а на практике обычно
используется максимальное напряжение, выдаваемое литографом. Соответственно, и
интерес исследователей был обращен именно в эту область. Исследования в области
низких энергий луча (3-10 кэВ) стали проводиться относительно недавно. Дело в
том, что начали появлятся компактные, “настольные” РЭМы от novelx,
FEI, Hitachi
с небольшим максимальным рабочим напряженим (~ 5кэВ), а следовательно, и
потребность доработки их до литографов. Также стимулом для проведения
исследования низковольтовой литографии послужил успешный проект Mapper
по созданию пятикиловольтного высокопроизводительного многопучкового литографа
[1]. Цель данной работы - исследовать особенности электронной литографии при
ускоряющем напряжении V0=5кэВ.
Для достижения цели необходимо определить основные параметры коррекции
распределения дозы. Во-первых, это чувствительность резиста, ее необходимо
сравнить с оной для 25-30 кэВ. Получить экспериментальное подтверждение
обратной зависимости чувствительности резиста от V0
(Доза ~ V0)
Во-вторых, это эффективный диаметр луча при первичном прохождении. Определению
этого параметра нужно уделить особое внимание, поскольку именно он по большей
части определяет предельно возможное разрешение. По результатам работы сделать
вывод об основных преимуществах и недостатках литографии при ускоряющем
напряжении в 5кеВ по сравнению с 25-30кеВ.
Глава 1. Технология изготовления образцов и
методика эксперимента
литография электронная
низкое напряжение
Процесс создания любой электронной литографии
можно разделить на следующие этапы:
1. Подготовка
подложки
2. Нанесение
резиста, отжиг
3. Экспонирование
4. Проявление
полученной структуры
5. Нанесения
металла, lift
off.
1. Подготовка
подложки
В качестве подложки использовались полированные
кремниевые пластины. Перед нанесением резиста подложку необходимо очистить от
разного рода загрязнений. Это может быть пыль, остатки резиста, микропленки
спиртов, использовавшихся при предыдущем проявлении. Для удаления резиста и
других органических загрязнений в лабораторных условиях используется ацетон или
диметиловый спирт. Для усиления эффекта образец в растворителе необходимо
прогреть и потрясти в ультразвуковой ванне. Недостатком этих растворителей
является то, что они плохо стекают с образца и оставляют разводы при высыхании.
Поэтому после их применения образец моется в изопропиловом спирте, который при
температуре кипения хорошо стекает с образца и испаряется без остатка.
2. Нанесение
резиста, отжиг
В работе использовался позитивный резист ПММА
950К, который является высококонтрастным резистом с чувствительностью порядка
140мкКл/см2 (25кэВ). Проявителем для него является раствор ИПС-H2O
18:1.
Резист наносится на подложку методом центрифугирования.
Скорость вращения центрифуги задает толщину резиста. Определить толщину (h0)
можно по окрашиванию пленки за счет интерференции в ней одной из составляющих
белого цвета, длина волны, которой кратна h0/2.
В экспериментах, проводимых в данной работе точное значение толщины пленки не
принципиально, но для α-тестов она
должна быть минимальной. Далее образец обжигается на хотплэйте при температуре
выше температуры плавления резиста (при 130-170 С0) для уменьшения
остаточного содержания растворителя, а также снятия напряжения в пленке
получившихся в результате ухода растворителя.
3. Экспонирование
Экспонирование осуществлялось на сканирующем
электронном микроскопе Carl
Zeiss EVO-50,
переделанном в литограф с помощью аппаратно-программного комплекса NanoMaker.
Программная часть комплекса позволяет задавать в графическом редакторе
необходимую геометрию образца, а также производит подготовку структуры к
экспонированию. После помещения образца в РЭМ и откачки камеры необходима
настройка пучка электронов, которая включает в себя задание ускоряющего
напряжения, тока, регулировку резкости и астигматизма. При этом нежелательно
использовать экспонируемый образец, т. к это приведет к нежелательной засветке
резиста. Скорость и успех данного этапа сильно зависит от опыта оператора и
требует повышенной осторожности и внимания. Для расчета распределения дозы и
управления пучком электронов используется програмно-аппаратный комплекс NanoMaker.
Хотя диаметр электронного пучка для данного
микроскопа составляет ~20 нм, минимальный размер деталей структур,
изготавливаемых с помощью этого оборудования, составляет около 80 нм. Такое
уширение определяется толщиной резиста и энергией электронов и связано с
рассеянием электронов в резисте, а также с эффектом близости. В работе [2]
изложен метод учета эффекта близости, применяемый в программно-аппаратном
комплексе NanoMaker.
Для этого используется модель, в которой нормированная на единицу поглощенная
доза на расстоянии r от центра
пучка представляется в виде суммы двух гауссианов:
 (1.1)
(1.1)
Физический смысл параметров α, β,
η следующий:
α
- размер
первичного пучка с учетом рассеяния его в резисте при прямом прохождении
(берется радиус, где плотность этих электронов уменьшается в ‘е’ раз относительно
первоначальной); β
- характерный
размер области рассеяния электронов в материале подложки; η - интегральная
характеристика вклада, который вносят обратнорассеянные электроны в суммарную
дозу. Структура разбивается на изодозовые области. То есть структура, при
подготовке ее к экспонированию, делится на области, с фиксированными дозами. В
электронной литографии экспонирование областей и линий производится по точкам.
‘Попав’ в некоторую точку, электронный луч задерживается в ней на рассчитанный
интервал времени для сообщения резисту необходимой поглощенной дозы. Потом он
перемещается в следующую точку, и т.д. Временем перехода между точками можно
пренебречь, так как оно много меньше времени, которое пучок затрачивает на
точку. Интервал рассчитывается программой исходя из заданной дозы и шага между
точками. Следовательно, фиксированная доза при экспонировании области означает,
что в пределах этой области электронный зонд будет задерживаться в каждой точке
на одинаковое время. Для произведения такой коррекции необходимо определить
значения параметров α,
β, η. Существующая
серия тестов позволяет сделать это с достаточной степенью точности [3,4]. Из
того, что было выше сказано об этих параметрах, становится очевидно, какие
именно условия проведения экспонирования оказывают на них влияние: α - не зависит
от материала подложки и определяется ускоряющим напряжением, толщиной резиста и
качеством настройки фокуса микроскопа (опытом оператора); η - параметр,
определяющийся материалом подложки, β - материалом подложки и
ускоряющим напряжением. Ряд тестов по определению α для
соответствующего напряжения был проведен в ходе данной работы.
1. Проявление
Проявление необходимо для удаления резиста с
экспонированных областей (позитивный резист). В качестве проявителя использовался
раствор изопропилового спирта и воды в отношении 18:1.
В основном, как позитивные, так и негативные
электронные резисты являются полимерами. При взаимодействии полимерных резистов
с электронным пучком у них может происходить структурирование или деструкция
полимерной цепи, либо, как это происходит у большинства полимеров, оба процесса
идут одновременно. В случае преобладания структурирования резист является
негативным, а деструкции позитивным. Это связано с тем, что скорость
растворения зависит от молекулярной массы резиста. Вообще, скорость проявления
резиста зависит многих факторов, в том числе от условий сушки, концентрации,
типа проявителя и его температуры [1]. Скорость проявления линейно
растворяющегося резиста может быть описана степенной зависимостью [5-8]:
(1.2)
где а - число молей растворенного
вещества. Формула (1.1) верна для позитивных резистов, в случае негативных
резистов она применима для неэкспонированных областей.
Для удаления остатков резиста в проявленных
областях применялось деликатное плазменное травление.
1. Напыление
металла, lift
off
Для упрощения наблюдения границы проявленных
областей на образец был напылён слой алюминия (30-40нм). Напыление алюминия
осуществлялось на вакуумной модифицированной установке ВУП-4, в которой в
отличие от стандартной комплектации диффузионный насос заменен
турбомолекулярным (ТМ), и добавлена вторая азотная ловушка. После полного
растворения резиста (lift
off) остается только
металл, напыленный непосредственно на подложку.
Глава 2. Чувствительность резиста
. Взаимодействие электронов с резистом.
Приближение непрерывных потерь
Поглощение излучения высоких энергий происходит
в результате взаимодействия падающих лучей с электронами в атомах. Электроны
теряют энергию под действием фотоэффекта путем возбуждения атомных электронов.
Электронный пучок, при плотностях тока
используемых в современных установках (до 10 А/см2 в электронной
литографии, в СЭМ плотности тока существенно меньше), можно считать
разреженным, т.е. электроны пучка не взаимодействуют между собой в процессе
рассеяния в образце, поэтому рассеяние каждого электрона будем рассматривать по
отдельности.
При моделировании прохождения электрона через
вещество можно считать, что большую часть времени электрон проводит в свободном
полёте, скачкообразно изменяя направление полёта и/или энергию в процессе
упругого или неупругого взаимодействия с атомами вещества. Вероятность
рассеяния электрона в веществе описывается при помощи сечения рассеяния,
которое вычисляется отдельно для каждого типа взаимодействия.
Таким образом, материал образца, в котором
рассматривается поведение электрона, представляется смесью составляющих его
атомов. Такое приближение верно лишь для аморфных и (в некотором смысле)
поликристаллических веществ, не позволяя рассматривать эффекты специфичные для
рассеяния в кристаллических телах, например каналирование (изменение тормозной
способности в зависимости от направления движения электрона).
Существует несколько подходов к моделированию
потерь энергии в процессе прохождения электронов сквозь вещество. Наиболее
строгий подход к проблеме взаимодействия электронов с мишенью заключается в
использовании модели однократного рассеяния 20,21], в сочетании с одной или
несколькими из моделей торможения, учитывающей потери энергии первичных и
вторичных частиц за счёт наиболее высокоэнергетических механизмов. В этой
модели, в частности, вычисляют средний свободный пробег частицы между двумя
столкновениями и используют далее выражения сечения рассеяния для розыгрыша
угла отклонения в процессе взаимодействия. Число соударений, испытываемых
электроном вдоль траектории в среднем более 104, поэтому модельные
расчёты методом Монте-Карло, основанные на учёте однократных процессов
рассеяния требуют огромных затрат машинного времени.
Метод непрерывных потерь (МНП) - одна из
разновидностей метода однократного рассеяния наиболее часто применяемая и
простая для реализации. В качестве шага алгоритма берётся расстояние между
упругими соударениями. Считается, что между ними электрон равномерно теряет
энергию, количество которой определяется тормозной способностью вещества.
Первое универсальное выражение для
дифференциальных потерь энергии электронов было получено Бёте [22,23]:
 (2.1)
(2.1)
здесь Е -
энергия налетающего электрона,  - заряд электрона, Z - атомный
номер, С - эффективная энергия ионизации. Для константы b
предсказываются значения b = 1 в классической теории.
Неупругие каналы рассеяния учитываются при помощи введения эффективной энергии
ионизации С. Этот параметр был измерен экспериментально методами атомной
физики. В качестве аналитической аппроксимации была предложена формула:
- заряд электрона, Z - атомный
номер, С - эффективная энергия ионизации. Для константы b
предсказываются значения b = 1 в классической теории.
Неупругие каналы рассеяния учитываются при помощи введения эффективной энергии
ионизации С. Этот параметр был измерен экспериментально методами атомной
физики. В качестве аналитической аппроксимации была предложена формула:

Следовательно, область применимости
формулы Бете лежит в области энергий частиц >> С (~400-800 эВ, в
зависимости от материала образца).
Закон Бете даёт хорошо согласующееся
с экспериментом значение тормозной способности. Вычисляемые с его помощью
потери энергии включают в себя все потери, в том числе и связанные с генерацией
вторичных электронов.
Рассмотрим формулу Бёте (2.1)
Пренебрегая изменением логарифма в толще резиста ввиду малости изменения
энергии пучка при прохождении пленки резиста мало, получим:
 (2.2)
(2.2)
где h0
- толщина резиста. Таким образом, энергия, воспринятая резистом, обратно
пропорциональна ускоряющему напряжению. Соответственно чувствительность S будет
пропорциональна V.

2.Чувствительность и контрастность
Для успешного применения резистов на практике,
необходимо знание нескольких параметров, называемых еще дозовыми
характеристиками. Дозовыми характеристиками электронных резистов являются
чувствительность и контрастность. Чувствительность позитивного резиста - это
минимальная необходимая для проявления резиста до дна доза экспонирования [6].
Чувствительность позитивного резиста характеризует дозу, которую необходимо
передать участку этого резиста для его полной проявки за приемлемое время
(обычно 1-2 минуты). Чувствительность, как и дозу экспонирования электронного
резиста обычно измеряют в Кл/см2. Для определения чувствительности
обычно используют тестовую структуру, состоящую из массива одинаковых элементов
(например, квадратов) с различной дозой экспонирования. Задаётся определённый
шаг дозы от одного элемента к следующему. После экспонирования и проявления
тестовой структуры, для позитивного резиста ищут среди проявившихся до дна
элементов, тот который был проэкспонирован с минимальной дозой. Эту дозу и
принимают равной чувствительности позитивного резиста. В настоящей работе в
качестве такой структуры выступает дозовый клин, доза экспонирования которого
меняется слева на право в 10 раз.
Другой важной характеристикой электронного
резиста является контрастность. Она является характеристикой крутизны рельефа
резиста после проявления. В литературе контрастность для позитивного резиста
определяют несколькими способами [6,7]. В качестве контрастности для позитивного
резиста, можно предложить использовать параметр растворимости. Действительно,
обратная молекулярная масса полимерного резиста линейно зависит от дозы
экспонирования [7]. Таким образом, можно записать, что
.
(2.4)
Тогда используя формулы (1.2) и
(2.4) можно получить зависимость скорости проявления резиста от дозы
экспонирования.
 , (2.5)
, (2.5)
где v
это скорость проявления области проэкспонированной с дозой D,
а v0
- скорость проявления области проэкспонированной с дозой D0.
параметр γ принимается за
контрастность.
. Проявление полимерных резистов
Теперь более подробно рассмотрим процесс
проявления полимерного резиста. В самом общем случае проявление описывается
законом Фика для диффузии или законом Брюнера для растворения твердого
вещества. На рис.2.1 дана картина распределения молекул полимера,
растворяющегося без набухания (таким полимером, например, является ПММА).
Растворение идет до тех пор, пока не насыщается слой жидкости, непосредственно
примыкающий к полимеру. Растворенные молекулы полимера диффундируют из
насыщенного слоя в соседние слои с меньшей концентрацией. Таким образом,
скорость растворения есть по сути дела скорость самой диффузии.
Коэффициент диффузии проявителя Q
(около 10-6-10-8 см2/с) связан с вязкостью
проявителя η соотношением Стокса
- Эйнштейна.
(2.6)
где КМа - зависимость
вязкости (Марк-Хаувинк) от молекулярной массы (M). При
изотропном растворении за 1 с молекула переместится в среднем на
 (2.7)
(2.7)
Энергия активации для
диффузионно-контролируемого проявления имеет величину порядка 2-8 ккал/моль
[11].
Если жидкий проявитель энергично перемешивается,
то диффузия молекул от поверхности твердой фазы ускоряется, но тонкий
градиентный слой толщиной 100-10 мкм при этом прочно держится у поверхности.
Если Σ - толщина
статического слоя (рис.2.1), As
- концентрация при насыщении и С - концентрация растворенного полимера,
однородная из-за перемешивания, то закон Фика для растворения массы полимера dm
за время dt с
поверхности S имеет вид
(2.8)
Толщина слоя Σ убывает с
улучшением перемешивания, и общая скорость растворения от этого возрастает
(рис.2.1)
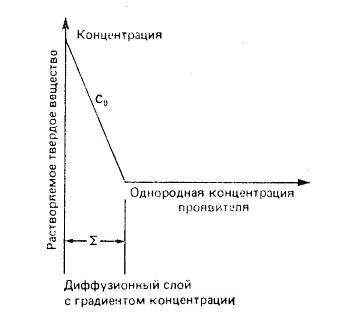

Прирост концентрации dC
зависит от объема жидкости V
и молекулярной массы полимера М
 (2.9)
(2.9)
Интегрирование уравнения (2.8)
дает
 (2.10)
(2.10)
что эквивалентно реакции первого
порядка. Подстановка плотности ρ и толщины dz в выражение
для массы dm или концентрации
dC дает
экспоненциальную зависимость для скорости растворения
 (2.11)
(2.11)
Закон Фика, предполагающий, что
коэффициент диффузии Q проявителя не зависит от
молекулярного веса полимера, не выполняется для многих стекловидных полимеров,
в которых набухание препятствует растворению [12-15].
В общем случае из закона Фика
видно, что скорость растворения полимера обратно пропорциональна его
молекулярной массе (1.2) [2,3]:
В резистах наблюдаются два
основных типа растворения:
-й случай: растворение
экспонированного и неэкспонированного резиста практически линейно, если
поглощение света или другого вида энергии в пленке однородно по толщине
(рис.2.2а). Это наблюдается в низкомолекулярном ПММА (Мn<104).
При ЭЛ-экспонировании поглощение энергии в тонких пленках (<300 нм)
однородно, а в более толстых пленках возрастает с глубиной из-за большего
вклада обратного рассеяния. Случай 1 относится к простому послойному
растворению пленки.
-й случай: растворение
неэкспонированных участков резиста замедляется в меру длительности
индукционного периода (рис.2.2б) [11,17]. Случай 2 учитывает проникновение
проявителя в пустоты, но быстрого растворения не происходит из-за образования
набухающего гель-слоя или поверхностной адсорбции продуктов растворения.
Образование нескольких физических слоев при растворении поверхности полимера
было промоделировано Юберейтером с сотрудниками [2]. Растворение может также
сопровождаться шелушением или растрескиванием, ослабляющим внутренние
напряжения при набухании [3].

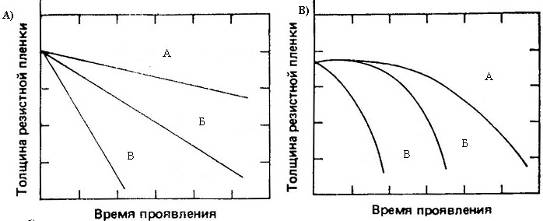
Образование гель-слоя очень
выгодно при наличии индукции, так как растворение неэкспонированного резиста
задерживается на несколько минут, в течение которых изображение частично
проявляется.
4. Экспериментальное определение
чувствительности. Дозовый клин
В данной работе проводилось исследование
чувствительности резиста ППМА_950К (полиметилметакрилат) при проявлении в
растворе изопропилового спирта (ИПС) с водой в отношении 18:1. Как уже
говорилось в п. 2.3, в качестве тестовой структуры для определения
чувствительности использовался дозовый клин. Предполагаемое значение
чувствительности лежало в области 140-180 мкКл см2 для ускоряющего
напряжения в 25 keV.
Соответственно, для 5keV
ее значение в 5 раз меньше. В соответствии с этим доза экспонирования клина
выбиралась так, чтобы предполагаемая граница проявления до дна была ближе к его
середине. Определение чувствительности проводилось для шести разных ускоряющих
напряжениях (от 5 до 30 keV)
и для двух разных толщин резиста - 200нм и 275нм. Результирующий график
представлен на (рис. 2.4).
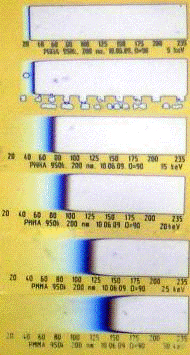
Рис. 2.3. Изображение проявленных тестовых
структур, снятое с помощью цифровой камеры в оптическом микроскопе. Резист ПMMA
толщиной 200 нм. Структуры проэкспонированы при ускоряющих напряжениях в 5,
10, 15, 20, 25, 30 keV.
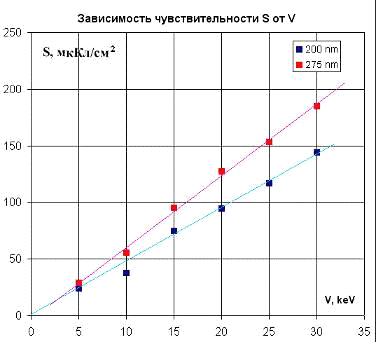
Рис.2.4 График
зависимости чувствительности S
от ускоряющего напряжения V
для двух толщин резиста - 200 нм и 275 нм.
По графику на рис.2.4 видно, что полученные
данные хорошо согласуются с теоретической оценкой (2.3) и подтверждают линейную
зависимость чувствительности от ускоряющего напряжения. Таким образом, чем
меньшее ускоряющее напряжение используется при экспонировании, тем лучше
чувствительность резиста. Одной из основных проблем электронной литографии
является низкая производительность. На экспонирование структуры размером
порядка 1 см2 требуется до нескольких часов. К тому же, на протяжении
такого времени трудно гарантировать неизменность внешних условий (комнатная
температура, случайная вибрация микроскопа). Использование низкого напряжения
(5keV) заметно облегчает
эти проблемы, ведь время экспонирования уменьшается в 5-6 раз (по сравнению с
30keV).
Следует
отметить, что чувствительность резистов тоже зависит от параметров проявления.
При повышении температуры, чувствительность увеличивается, поэтому необходимо
при смене температуры проявления определить чувствительность резиста, чтобы не
допустить перепроявления.
Глава 3. Определение эффективного диаметра
электронного луча при первичном прохождении через резист (α)
Диаметр электронного луча определяет максимально
возможное разрешение в литографии. Также параметр α
используется
при коррекции дозы экспонирования (1.1). Поэтому для определения границ
применимости электронной литографии просто необходимо определять α
для
используемых ускоряющих напряжений. В силу малости α
(десятки
нанометров) его сложно определить какими-либо прямыми измерениями. В [19] был
предложен метод подгонки перед экспонированием для определения α

Тестовый рисунок является структурой
прямоугольников, доза облучения которых рассчитана так, чтобы прямоугольники
одном горизонтальном ряду проявились одновременно. Слева на право увеличивается
ширина рядов (от размеров менее a до 5a),
а снизу вверх уменьшается доза (например, в 0,95 раз) При расчете дозы
используется предполагаемое значение a. Таким образом,
при проявлении нижние ряды оказываются перепроявленными, а верхние -
недопроявленными. Если предполагаемое a совпало с
действительным, то граница будет горизонтальной. Если же действительное a
оказалось больше, то граница повышаться слева на право, и наоборот. Отличие от
корректировки обычной структуры заключается в том, что доза равна 100 % не на
границе прямоугольника, а в его центре. Благодаря этому ряд, где в центре
прямоугольников доза 100% проявится полностью на всей протяженности.
Соответственно следующий ряд, экспонированный с меньшей дозой будет
недопроявленным. Для определения a используется
каскад таких структур, рассчитанных для разных a
в нужном диапазоне.
С помощью этого метода в ходе данной работы были
определены a для разных напряжений и толщин
резиста. В эксперименте использовался резист ПММА 950к, нанесенный на
кремниевую подложку методом центрифугирования. Использовавшиеся толщины резиста
h0
- 340нм, 200нм и 175нм. При этих h0
проводилось определение a для следующих ускоряющих
напряжений V: при h0=340
для V=5keV,
при h0
= 200nm для V
= 5; 15; 30 keV, и при h0
= 175nm для 15, 30 keV.
Результирующий график представлен на рис.3.2.

Рис.3.1. Определение a
методом подгонки перед экспонированием при ускоряющем напряжении 5кэВ, толщина
резиста (ППМА 950к) 340нм. Lift
off. Ближайшее
значение a - 85 нм. Снимок сделан в
электронном микроскопе при V
= 10keV.
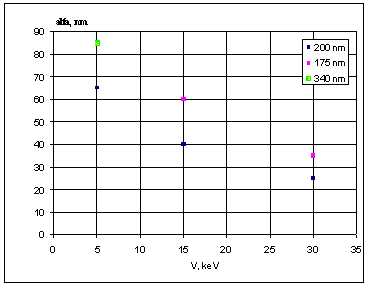
Рис.3.2. Результаты определения a.
Из полученных результатов видно, что, во-первых,
a
нарастает с уменьшением напряжения, а во-вторых для 5кэВ ширина электронного
луча еще достаточно мала для проведения литографии. Величина a
определяется многими факторами, основными из которых являются точность
фокусировки и уширение луча в резисте вследствие малоуглового рассеяния.
Поскольку распределение электронов в пучке как
над резистом, так и в его толще хорошо описывается распределением Гаусса,
уширения луча складываются как квадраты:
 (3.1)
(3.1)
где  - эффективный диаметр пучка, d - уширение
пучка в резисте,
- эффективный диаметр пучка, d - уширение
пучка в резисте,  - диаметр пучка
над резистом.
- диаметр пучка
над резистом.
Точность фокусировки ограничивается
как возможностями оптики микроскопа, так и квалификацией оператора. Уширение
луча в резисте увеличивается с уменьшением V и при
напряжении в 5кэВ становится весьма существенным. Оценка такого рассеяния
реализована в программе NanoMaker с помощью
метода Монте-Карло. Таким образом, с помощью программы NanoMaker можно
определить вклад рассеяния в эффективную ширину пучка и, соответственно,
диаметр луча до попадания в резист (a0) (рис.
3.3).
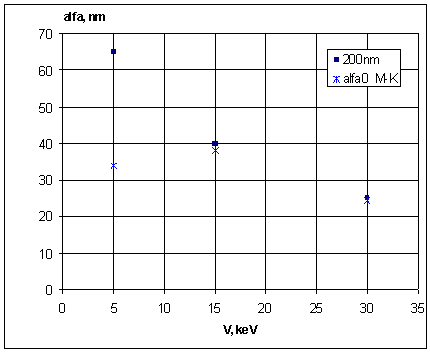
Рис. 3.3. Сравнение эффективной a и a0 до
попадания в резист. Уширение в резисте рассчитывается методом Монте-Карло,
реализованном в программе NanoMaker. Резист
ПММА 950к, толщиной 200нм.
Из рис. 3.3 видно, что при 15 и 30 keV уширение в
резисте составляет всего несколько процентов от начального a0. Для этих
напряжений пучок рассеивается слабо и его эффективный размер определяется в
большей степени точностью фокусировки. В тоже время, для 5 keV рассеяние в
резисте почти удваивает эффективную ширину луча. Расчет показывает, что даже
при a0 = 0 на
глубине 200 нм в резисте a = 55 нм.
Разрешение более 55 нм при таких условиях получить почти невозможно. Его можно
повысить, к примеру, уменьшением толщины резиста.
Из полученных результатов можно
сделать следующие выводы:
. При ускоряющем напряжений в 5кэВ
на используемом оборудовании удается сфокусировать электронный луч до 35 нм.
. При напряжении в 5кэВ и толщине
резиста 200нм и более предельное значение a определяется в основном уширением электронного
луча в резисте, поскольку оно заметно (почти в 2 раза при h0 = 200нм)
превышает диаметр первичного луча. Поэтому для улучшения разрешения в первую
очередь следует использовать более тонкий резист.
Заключение. Выводы
По результатам данной работы можно
сделать весьма оптимистичные выводы. Основной недостаток этого режима -
относительно низкое разрешение - не будет накладывать особых ограничений в
большинстве прикладных задач. При a = 65 нм, определенном в главе 3 вполне можно
создавать планарные структуры с разрешением ~100 нм (рис.4.1). К примеру, при
создании шаблонов для фотолитографии требуется разрешение всего лишь около
микрона.
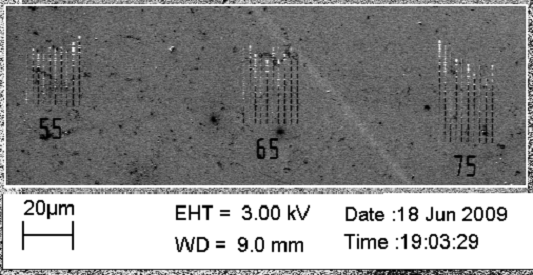
Рис. 4.1 Альфа-тест, lift off. Структуры
экспонированы при V=5keV.
Изображение получено в электронном микроскопе. Ширина крайних левых линий в
каждой структуре менее 100нм.
Теперь перейдем к достоинствам и
перспективам низковольтовой литографии. Прежде всего, стоит упомянуть
миниатюрные РЭМы, выпускаемые novelx, FEI, Hitachi. Эти
микроскопы гораздо меньше и дешевле классических РЭМов, но рабочее ускоряющее
напряжение у них ограничивается сверху 3-5 кеВ. Доработка их до полноценных
литографов является логичной, своевременной и востребованной задачей.
Многократное увеличение
чувствительности резиста по сравнению с 25-30 кэВ существенно увеличивает
производительность. Кроме того, задерживаясь меньшее время в каждой точке, электронный
луч меньше разогревает подложку, что способствует уменьшению локальных
изменений чувствительности резиста и тем самым улучшает достоверность коррекции
дозы.
При низких ускоряющих напряжениях
электроны быстро теряют свою энергию в резисте и подложке. Расчеты методом
Монте-Карло показывают, что при V=5keV и толщине
резиста 350нм электроны, дошедшие до подложки и отразившиеся от нее уже не
долетают до верхней поверхности резиста, а значит верхний слой экспонирован
только первичным пучком. Этот вывод имеет колоссальное значение в электронной
литографии. В этом режиме после проявления в резисте образуется полость с узкой
горловиной вверху, диаметр которой близок к диаметру первичного пучка (рис
4.2). Это позволяет создавать планарные структуры с разрешением, ограниченным
лишь фокусировкой микроскопа и освобождает от необходимости учета эффекта
близости, рассеяния луча в резисте и, следовательно, коррекции дозы. Кроме
того, отрицательный наклон стенок полости облегчает процедуру lift off.

Рис. 4.2. Профиль линии,
экспонированной в толстом резисте при низком ускоряющем напряжении.
1. www.mapperlithography.com.
2. K.
Ueberreiter. “Diffusion
in Polymers”// edited by J. Crank and G. Park, “Academic Press”, New York, ,
Chapter 5, p. 219-257 (1968).
3. K. Ueberreiter and F. Asmussen.
“Velocity of dissolution of polystyrene”// J. Pol. Sci
<http://www3.interscience.wiley.com/journal/103527684/home>., vol.
23 Issue 103 <http://www3.interscience.wiley.com/journal/104039109/issue>
, p. 75-81 (1957).
. K. Ueberreiter and F. Asmussen.
“Velocity of dissolution of polymers. Part I”// J. Pol. Sci
<http://www3.interscience.wiley.com/journal/103527684/home>., vol.
57 Issue 165 <http://www3.interscience.wiley.com/journal/104041423/issue>,
p. 187-198 (1962).
. K. Ueberreiter and F. Asmussen.
“Velocity of dissolution of polymers. Part II”// J. Pol. Sci
<http://www3.interscience.wiley.com/journal/103527684/home>., vol.
57 Issue 165 <http://www3.interscience.wiley.com/journal/104041423/issue>,
p. 199-208 (1962).
. “Handbook of Microlithography,
Micromachining and Microfabrication”// edited by P. Rai-Choudhury
<http://www.amazon.com/exec/obidos/search-handle-url/105-8646515-6451608?_encoding=UTF8&search-type=ss&index=books&field-author=P.
Rai-Choudhury>, SPIE, Chapter 2, (1997).
7. У. Моро, “Микролитография.
Принципы, методы, материалы”// «Мир», стр. 135, 622 (1990).
8. С.Н. Никифорова-Денисова, Е.Н.
Любушкин. «Термические процессы»// «Высшая школа», стр. 40-43 (1989).
9. I. Haller, M. Hatzakis, R.
Srinivasan. "High-resolution positive
resists for electron-beam exposure"// IBM J. Res. Develop., vol. 12, p.
251-256 (1968).
10. D. Macintyre. S. Thoms.
"High resolution electron beam lithography studies on Shipley chemically
amplified DUV resists"// Microelectronic Engineering, vol. 35 Issues 1-4,
p. 213-216 (1997).
. P.D. Blais. “Edge acuity and
resolution in positive type photo-. resist systems”// Solid-state Technol.,
vol. 20, p. 76-79 (1977).
12. H.
Frish. “Sorption and transport in glassy polymers-a review”// Polym. Eng. Sci.,
vol. 20 Issue 1, p. 2-13 (1980).
. S. Chen
and J. Edin. “Fickian diffusion of alkanes through glassy polymers: Effects of
temperature, diffusant size, and polymer structure”// Polym. Eng. Sci., vol.
20, p. 40-50 (1980).
. G. Park.
“Diffusion in Polymers”// edited by J. Crank and G. Park, Academic Press, New
York, Chapter 5, p. 140-162 (1968).
. L. Thomas
and J. Windle. “A theory of case II diffusion”// Polymer, vol. 23 Issue 4, p.
529-542 (1982).
16. F. Billmeyer. “Textbook of
Polymer Science”// “Wilcv”, New York, p. 33, 74, 84 (1971).
17. D. Kim,
W. Oldham, and A. Neureuther. ”Development of Positive Photoresist”// IEEE
Trans. Electron Devices, vol. 31 Issue 12, p. 1730-1736 (1984).
. B. Grant,
N. Clecak, R. Tweig, and G. Wilson. “Deep UV photoresists I. Meldrum's diazo
sensitizer”// IEEE Trans Electron Devices, vol.28 Issue 11, p. 1300-1305
(1981).
19. L.I. Aparshina, S.V
Dubonos, S.V. Maksimov, A.A. Svintsov, and S.I. Zaitsev. “Energy dependence of
proximity parameters investigated by fitting before measurement test”// Journal
of Vacuum Science & Technology B, vol.15 №6, p. 2298-2302 (1997).
20. (3-1) Друкарёв Г.Ф.
«Столкновение электронов с атомами и молекулами» 1978 М. «Наука»
21. (3-18)D. C. Joy, “Monte
Carlo Modeling for Electron Microscopy and Microanalysis”, Oxford University
Press, 1995.
22. (3-4) Бёте «Квантовая
механика»
. (3-5) Л.Д. Ландау Е.М.
Лившиц «Теоретическия физика. Том III.
Квантовая механика. Нерелятивистская теория» 1989 М. Наука.