Радиационные эффекты в диэлектриках
ВВЕДЕНИЕ
Вопреки сложившимся представлениям о том, что
проникающая радиация вызывает в полупроводниках и полупроводниковых приборах
только радиационные повреждения, приводящие их в негодность, во многих случаях
радиация может служить эффективным технологическим инструментом, который
позволяет получать качественные полупроводниковые материалы, существенно
усовершенствовать и удешевить производство многих типов полупроводниковых
приборов, улучшить их качество, а также экономить драгоценные металлы, используемые
при их производстве. В технологических процессах изготовления полупроводниковых
приборов перспективно использование большинства видов проникающих излучений:
быстрых электронов, гамма-квантов, нейтронов, протонов, альфа-частиц и др. В
технологии ядерного легирования полупроводниковых материалов используются
медленные нейтроны и высокоэнергетичные электроны (Е.50 МэВ). Применение
радиации в технологических процессах базируется на радиационных эффектах,
которые они вызывают в полупроводниках и структурах с р-n-переходами. Это,
главным образом, радиационные эффекты: эффекты смещений, ядерные превращения,
ионизационные эффекты.
1. РАДИАЦИОННЫЕ ЭФФЕКТЫ
.1 Эффекты смещений и радиационное
дефектообразование
Эффекты смещений приводят к образованию в кристалле
радиационных дефектов. Радиационный дефект может возникнуть в том случае, если
энергия бомбардирующей частицы достаточна для смещения атома из узла
кристаллической решетки в междоузлие. Например, атом кремния смещается, если он
получит от бомбардирующей частицы энергию примерно 15-20 эВ. Эта энергия
называется пороговой энергией смещения (Еd). Для случая облучения
быстрыми электронами, наиболее часто применяемыми в радиационной технологии,
выражения для определения максимальной энергии, передаваемой атому быстрым
электроном, имеет вид:

где Еmax - наибольшая кинетическая энергия
смещенного атома; Еэ - кинетическая энергия электрона; m - масса покоя
электрона; с - скорость света, M - масса ядра атома полупроводника. Энергия
электрона, при которой возможно начало смещения атомов, в кремнии составляет
около 150 кэВ и в германии - 300 кэВ. При облучении проводников гамма-квантами,
которые также используются в радиационной технологии, вероятность образования
смещений в результате непосредственного взаимодействия гамма-кванта с ядром
атома очень мала. Смещения в данном случае будут возникать за счет электронов,
образующихся в полупроводнике главным образом в результате комптон-эффекта. В
кремнии при облучении гамма-квантами Со60 со средней энергией ~1,25
МэВ комптоновские электроны возникают с энергией ~0,59 МэВ. Если энергия
первичносмещенного атома значительна, то он может сам производить вторичные
смещения и т.д.
Надо отметить, что первичные радиационные
дефекты (междоузельный атом и вакансия) весьма подвижны и при комнатных
температурах нестабильны. Они вступают во взаимодействие друг с другом -
аннигилируют или взаимодействуют с имеющимися в кристалле примесями и
несовершенствами - дислокациями и др. Так образуются более сложные вторичные
радиационные дефекты, например, для кремния n-типа проводимости, легированного
фосфором и наиболее характерны такие радиационные дефекты как вакансия + атом
фосфора (Е-центр), вакансия + атом кислорода (А-центр), дивакансия (соединение двух
вакансий) и другие. В настоящее время определено большое количество различных
типов радиационных дефектов в зависимости от примесного состава полупроводника,
вида радиационного воздействия, которые характеризуются различной энергией в
запрещенной зоне, термической стабильностью и способностью влияния на
электрические и оптические свойства полупроводника и полупроводниковых приборов
(табл.1). Радиационные дефекты проявляют себя в полупроводниках как центры
рекомбинации, изменяя время жизни неосновных носителей заряда, как центры
захвата, снижая концентрацию основных носителей, и как центры рассеяния,
уменьшая подвижность.
Таким образом, введением определенных строго
дозируемых концентраций термостабильных радиационных дефектов в полупроводники
и полупроводниковые приборные структуры можно регулировать их свойства и
характеристики порой с точностью, недостижимой при использовании диффузии
химических примесей. Это положено в основу разрабатываемых радиационных
технологий для конкретных типов полупроводниковых приборов.
1.2 Ядерные превращения
Известно, что при облучении веществ нейтронами и
другими высокоэнергетичными частицами происходят ядерные реакции, приводящие к
образованию атомов химических элементов, ранее отсутствовавших в материале.
Легирование некоторых полупроводников при помощи медленных нейтронов (имеют
большое сечение ядерной реакции) можно осуществить при равномерности
распределения примесей ~3% в отличие от химическо-технологического легирования
- 10÷15
%. Впервые
предложил идею ядерного легирования и провел эксперимент на германии К.
Ларк-Горовиц.
Особый интерес в настоящее время ядерное
легирование представляет для кремния и арсенида галлия, наиболее широко
применяемых в производстве полупроводниковых приборов и интегральных микросхем.
Таблица 1 Радиационные дефекты в кремнии и их
параметры

Выращенный чистый кристалл кремния состоит в
основном из трех его изотопов - Si28 (92,21 %), Si29(4,7%)
и Si30(3,09%). Оказывается, что только изотоп Si30 может
захватывать нейтрон, превращаясь в стабильный изотоп фосфора Р31,
являющийся донором в кремнии. Ядерная реакция превращения атома кремния в атом
фосфора записывается как,

Изотопы кремния Si28 и Si29
при ядерных реакциях не дают других стабильных химических элементов, поэтому не
изменяют свойства кремния. Надо отметить , что ядерная реакция очень эффективно
протекает на медленных нейтронах (Ен.200 кэВ), плотность которых в обычном
атомном реакторе велика. Концентрацию атомов фосфора, являющегося донором в
кремнии, вследствие ядерной реакции, можно подсчитать по формуле:

где Фt- флюенс медленных нейтронов (н
/см2), σ - эффективное
сечение реакции (1,1∙10-25см2), N - концентрация атомов
в кремнии (5∙1022см-3), Pi-
содержание изотопа в кристалле (3,09 %).
Таким образом, концентрацию атомов фосфора в
кристалле кремния можно регулировать дозой нейтронного облучения. После
ядерного легирования кристаллы подвергаются термическому отжигу при температуре
около 1350 К для устранения радиационных нарушений.
Возможность ядерного легирования арсенида галлия
потоком реакторных нейтронов была впервые показана экспериментально. Ядра
галлия и мышьяка (изотопы Ga69, Ga71, As75),
захватившие нейтроны, превращаются в нестабильные изотопы, в результате распада
которых образуются стабильные изотопы Ge70, Ge72 и Se76
согласно реакциям:

Реакции эффективно идут на медленных нейтронах
атомного реактора. Суммарная концентрация трансмутационно-вводимых примесей
может быть рассчитана по формуле (3). Подставляя соответствующие значения в
(3), получаем суммарную концентрацию атомов Ge и Se:

Соотношение концентраций трансмутационно
вводимых примесей Se и Ge составляет:

При этом обеспечивается высокая однородность и
точность в распределении вводимых примесей.
Облученные в реакторе полупроводники обладают
остаточной радиоактивностью, поэтому работа с ними возможна лишь после снижения
удельной активности ниже определенного предела. В соответствии с рекомендациями
МАГАТЭ по радиационной защите, радиоактивным считается любой материал, имеющий
удельную активность 2∙10-3мкКи/г. Уровень наведенной радиоактивности
определяется временем и условиями облучения, а также зависит от примесного
состава облучаемого материала. В нелегированных полуизолирующих кристаллах
GaAs, выращенных методом Чохральского, оптимально эффект трансмутационного
легирования проявляется при облучении флюенсом медленных нейтронов в пределах
1016÷1018
н/см2.
Ядерно-легированными кристаллами кремния можно
пользоваться через сутки после облучения, арсенида галлия - через значительно
большее время.
.3 Ионизационные эффекты
В кристалле полупроводника или диэлектрика в
результате воздействия радиации образуются свободные электроны и положительно
заряженные ионы (дырки). Таким образом, возникают избыточные
электронно-дырочные пары, которых ранее в материале не было. Концентрацию таких
неравновесных пар можно подсчитать по формуле 16]:

где е - заряд электрона, φ-
мощность
дозы радиации; с - коэффициент преобразования, зависящий от вида радиации и ее
энергетического спектра, τ- время
жизни неравновесных носителей заряда.
Эффекты ионизации, с точки зрения использования
в технологии, могут играть существенную роль в структурах
металл-диэлектрик-полупроводник. Под воздействием излучения в диэлектрике
накапливается заряд и там может сохраняться сколь угодно долго или
нейтрализовать уже имеющийся в нем заряд другого знака. Этот эффект можно
использовать для регулирования параметров приборов на МДП-структурах.
2. РАДИАЦИОННЫЕ ЭФФЕКТЫ В ТЕХНОЛОГИИ
.1 Ядерное легирование арсенида галлия
Применение и развитие традиционных методов
металлургического легирования выявили ряд ограничений технологий, связанных с
однородностью распределения легирующих примесей в объеме растущего кристалла,
что обусловлено, главным образом, термодинамическими причинами. Альтернативой этому
является ядерное легирование (ЯЛ) полупроводников. Мы здесь приведем некоторые
полученные нами результаты по арсениду галлия .Удачное сочетание свойств
данного материала (прямая структура энергетических зон, высокая эффективность
излучательной рекомбинации, малая эффективная масса и высокая подвижность
электронов) позволило создать на его основе многие приборы СВЧ, опто- и
функциональной электроники, а также интегральные схемы. Исследования
проводились на монокристаллах и эпитаксиальных слоях арсенида галлия. Ядерное
легирование осуществлялось в различных каналах ядерного реактора, различающихся
соотношениями плотностей медленных и быстрых (Е>0,1 МэВ) нейтронов фt/фf
в
диапазоне 50-185. Температура образцов в процессе облучения была около 700С.
Флюенс медленных нейтронов варьировался в
пределах 5∙1016 ÷ 5∙1017
н/см2 . Отжиг образцов проводился в различных атмосферах
(водород, азот) в ампулах в диапазоне температур 100÷1000
0С
в течение 1 часа с шагом в 50 0С и последующим медленным охлаждением
до комнатной температуры. После образцы подвергались травлению в полирующем
травителе с целью удаления нарушенного слоя и промывке в деионизованной воде.
Для измерения проводимости и эффекта Холла использовались образцы размером 5 х
5 мм2.
Характер восстановления свойств кристаллов ЯЛ
арсенида галлия (ЯЛАГ) зависит как от характеристик исходного материала, так и
от условий облучения рисунок 1. Анализ зависимостей удельного сопротивления от
температуры отжига p(Тотж)
позволяет выделить несколько стадий отжига. Основной отжиг радиационных
дефектов происходит в диапазоне температур 420÷520 0С.
Удельное сопротивление в результате отжига образцов снизилось на шесть
порядков.

Рисунок 1- зависимость удельного сопротивления
ЯЛ n-GaAs от температуры изохронного отжига. Исходная концентрация носителей
заряда до облучения 2∙10 16 (1) и 3∙10 15 см -3(2).
Доза облучения Фt=5∙10
17 см -2, φt/φf=50.
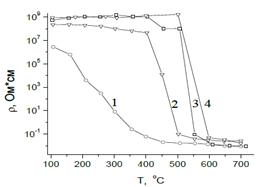
Рисунок 2- зависимость удельного сопротивления
ЯЛ полуизолирующего и n-типа GaAs от температуры изохронного отжига. Исходный
материал: 1,3- n=2∙10 16
см-3; 2,4- полуизолирующий, p>10
7 Ом.см
При отжиге образцов ЯЛАГ, облученных медленными
нейтронами флюенсом Фt=5∙10
17 см -2, φt/φf=185,
было установлено: чем выше исходная концентрация носителей заряда, тем с
меньших температур начинает протекать процесс отжига (рис. 2). Соотношение φt/φf
также влияет на характер кривых отжига p(Тотж)
по сравнению с рис. 1. Происходит некоторый сдвиг кривых отжига в низкотемпературную
область, и проявляются ряд стадий отжига.
Окончательное восстановление свойств происходит
при несколько меньших температурах, чем в первом случае (рис. 1). Исследовалось
изменение p, n, µ в результате
отжига эпитаксиальных слоев (ЭС) арсенида галлия, облученных флюенсом медленных
нейтронов Фt=5∙10
16 см -2, φt/φf=185
(рис. 3). Исходные эпитаксиальные слои GaAs (n=1∙10 15 см -3)
были выращены методом хлоридной эпитаксии на подложках полуизолирующего
арсенида галлия.
Характер отжига эпитаксиальных слоев во многом
схож с отжигом объемных кристаллов. Однако есть и отличия. На зависимостях
µ(Тотж) и n(Тотж) наблюдаются лишь две стадии отжига. Восстановление свойств
эпитаксиальных слоев происходит при более низких температурах (~500 0С),
чем у массивных образцов. Исследованиями было установлено, что
ядерно-легированные слои GaAs являются более однородными по своим электрическим
свойствам по сравнению со структурами аналогичного уровня легирования,
полученными методами газофазной эпитаксии.
Сделаем краткий анализ экспериментальных
результатов. Процесс ядерного легирования сопровождается введением
значительного числа радиационных дефектов в образцы, источником которых
являются как реакторные излучения (нейтроны, γ-кванты),
так и первично смещенные атомы матрицы облучаемого вещества и продукты ядерных
реакций. Известно, что при реакторном облучении GaAs вводятся как точечные
радиационные дефекты, так и сложные дефектные ассоциаты (области
разупорядочения). Введенные облучением радиационные дефекты обусловливают появление
в запрещенной зоне GaAs энергетических уровней, являющихся центрами захвата для
электронов в зоне проводимости. Захват носителей на уровне РД приводит к
смещению уровня Ферми к середине запрещенной зоны и выражается в сильном
снижении концентрации носителей заряда, росте удельного сопротивления
кристалла, снижении подвижности, что и наблюдается в эксперименте.
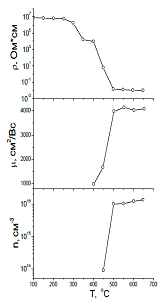
Рисунок 3 - зависимости n,p,µ
ЯЛ ЭС GaAs от температуры отжига
При равных дозах облучения этот эффект сильнее
проявляется в образцах с более высоким исходным удельным сопротивлением, так
как концентрация основных носителей у них ниже. Увеличение в облучающем спектре
составляющей быстрых нейтронов, являющихся наиболее интенсивным источником
дефектообразования, усиливает компенсацию образцов. При пострадиационной
термообработке происходит отжиг радиационных нарушений и активация введенных
трансмутационных примесей. Уровень Ферми перемещается в сторону зоны
проводимости, стремясь к положению, определяемому уровнем ядерного легирования
образцов. Изменение относительных концентраций различных типов вводимых РД,
отличающихся своей термостабильностью и обусловливает наблюдаемые особенности
отжига облученных кристаллов. Образцы восстанавливаются, приобретая заданную
концентрацию носителей заряда, при температурах 450-600 0С.
2.2 Увеличение быстродействия полупроводниковых
приборов
Большинство полупроводниковых приборов в
настоящее время изготавливается на основе кремния. Полученные по обычной
диффузионной технологии или с помощью ионной имплантации биполярные кремниевые
полупроводниковые приборы обладают значительной инерционностью. Это снижает их
быстродействие и не позволяет применять в быстродействующей аппаратуре. Во
время эксплуатации таких приборов также велики энергопотери при их коммутации.
В основе эффекта инерционности, низкого быстродействия, лежит физический
процесс накопления и рассасывания заряда неравновесных носителей в базе
р-n-структуры (основы большинства полупроводниковых приборов: диодов, транзисторов,
тиристоров и др.) при прохождении электрического тока.
При этом, чем чище и совершеннее исходный
полупроводниковый кристалл, на основе которого изготовлен прибор, чем больше
токи, тем выше инерционность.
Например, полупроводниковый диод, изготовленный
на кремнии обычным методом, имеет время переключения из открытого состояния в
закрытое порядка 10-4 - 10-6 c,
а для использования в современной быстродействующей аппаратуре, а также для
снижения коммутационных энергопотерь при работе прибора необходимо время
переключения порядка 10-7 - 10-9 c.
Для увеличения быстродействия обычно используется введение в р-n-структуры
приборов диффузионным способом химических примесей (золота, платины),
являющихся эффективными центрами рекомбинации неравновесных носителей заряда и
уменьшающих скорость рассасывания накопленного заряда. Как показал мировой
опыт, лучшие результаты дает использование золота, обусловливающего появление в
запрещенной зоне кремния двух глубоких энергетических уровней: Еc-0,54
эВ и Еv+0,35
эВ. Здесь следует отметить, что операция диффузии золота в кристаллы кремния
плохо контролируема и трудоемка. Диффузия золота в кремнии с р-n-переходами
осуществляется при температуре около 1100 0С и процесс идет около
часа. Незначительные отклонения от температурного режима, а также отклонения в
параметрах исходного кремния приводят к значительному разбросу характеристик
приборов и браку. Причем, пределы растворимости золота в кремнии не позволяют
добиться максимального быстродействия приборов и микросхем, а способность
золота скапливаться на неоднородностях и дислокациях может приводить к
электрическим пробоям приборов, особенно работающих при больших импульсных
токах. Кроме того, экономия золота или платины также является важным фактором,
особенно для Республики Беларусь, которая не добывает этих металлов.
Изучение свойств радиационных дефектов показало,
что некоторые их типы термически устойчивы и влияют на электрические свойства
кремния подобно рекомбинационным центрам, обусловленным золотом. Эти свойства радиационных
дефектов лежат в основе использования их в технологии быстродействующих
полупроводниковых приборов вместо золота или платины.
С точки зрения радиационной технологии,
практический интерес представляют дефекты с температурой отжига выше 250 0С.
Это обусловлено необходимостью обеспечить в рабочем диапазоне температур (-60 -
+125 0С) стабильность параметров полупроводниковых приборов,
созданных с использованием радиационной технологии. Как показали наши
исследования, подбирая режимы облучения и термической обработки в кремниевые
р-n-структуры, можно вводить отдельные типы радиационных дефектов с
термостабильностью 450 0С, что важно для силовых быстродействующих
приборов.
Кроме того, радиационные дефекты, являющиеся
эффективными центрами рекомбинации, в меньшей степени влияют на снижение
концентрации основных носителей, поскольку дают, в отличие от золота,
сравнительно мелкие энергетические уровни в запрещенной зоне кремния, что очень
важно, так как при существенном улучшении динамических параметров не будет
происходить заметных ухудшений статических характеристик приборов и,
следовательно, больших внутренних энергопотерь.
Особо следует отметить простоту введения в
кристаллы с р-n-переходами и приборы на стадии технологического цикла
радиационных дефектов нужной концентрации при высокой равномерности их
распределения по структуре. Скорость введения радиационных дефектов зависит от
вида и энергии излучения, температуры облучения, примесей в образце. Поэтому
для каждого типа изделий важно подобрать вид радиации и режим радиационной
обработки.
При облучении быстрыми электронами или
гамма-квантами Со60 радиационные дефекты вводятся равномерно по
объему образца. Эти излучения целесообразно использовать для облучения
р-n-структур, имеющих достаточно обширные активные области, куда следует
вводить дефекты. Это структуры транзисторов, диодных матриц, силовых
полупроводниковых приборов и др.
Применение в радиационной технологии тяжелых
частиц (протонов и альфа-частиц) целесообразно в тех случаях, когда необходимо
локальное введение радиационных дефектов, главным образом в приповерхностном
слое структур. Это позволяет уменьшить время жизни неосновных носителей заряда
только в тех областях, где происходит их накопление, снижающее быстродействие
приборов. Энергия протонного или альфа-излучения выбирается, исходя из глубины
слоя, в который требуется ввести радиационные дефекты. Например, пробег
протонов в кремнии составляет около 1,2 мкм на каждые 100 кэВ (при Еp≤
1 МэВ). Локальное облучение протонами применяется также для создания с помощью
радиационных дефектов полуизолирующих областей, где снижена концентрация
основных носителей.
Облучение быстрыми электронами (Еe=4
МэВ) уменьшает накопленный заряд Q неравновесных носителей в базе р-n-структуры
на основе кремния с удельным сопротивлением 0,5 Ом∙см - рисунок 4. В
результате облучения диодных структур дозой 5∙10 15 эл/см 2
произошло снижение накопленного заряда более чем на порядок и, таким образом,
увеличение быстродействия при неизменности статических параметров. Увеличение
прямого падения напряжения (cтатический параметр) на диоде начинает происходить
при большей дозе (6∙10 15 эл/см 2). Поэтому
оптимальную дозу и режим облучения подбирают таким образом, чтобы достигалось
максимальное увеличение быстродействия, но статические параметры заметно не
ухудшились.
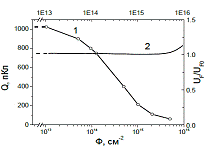
Рисунок 4- изменение накопленного заряда Q (1) и
падения напряжения U (2) р-n-структуры в зависимости от величины флюенса Ф
быстрых электронов
Р-n-структуры на стадии изготовления или готовые
приборы после радиационно-технологической обработки подвергаются
стабилизирующему термическому отжигу (~300 0С), во время которого
устраняются нетермостабильные радиационные дефекты. Облучение может вестись при
повышенных температурах («горячее» облучение), тогда нет необходимости в
стабилизирующем термическом отжиге после облучения.
Исследовалось процентное распределение диодов по
времени восстановления обратного сопротивления, пропорционального времени
переключения (рисунок 5, изготовленных с введением золота (а), без золота (б,г)
и после облучения (в) быстрыми электронами (Е e
=
4 МэВ, Ф=5 ∙ 10 15эл/см 2). В случае изготовления
диодов без золота время их восстановления находится в пределах 50-110 нс. При
введении золота оно снизилось до 12-30 нс. Использование радиационной
технологии позволило снизить время восстановления диодов до 4-14 нс и, таким
образом, существенно увеличить их быстродействие. При этом большинство из них в
процентном отношении имеет повышенное быстродействие (4-7 нс).

Рисунок 5 - гистограммы процент-ного
распределения диодных матриц по быстродействию.

Рисунок 6 - соотношение между временем обратного
восстановления trr
диодных структур и временем жизни ННЗ при trr≤0,3
мкс.
Мощные диоды, тиристоры, биполярные транзисторы,
в том числе новый их тип - с изолированным затвором - широко применяются в
различной промышленной и бытовой аппаратуре (в мощных переключающих
устройствах, источниках питания, автомобильной электронике и других областях),
нуждаются в повышении их быстродействия и минимизации коммутационных
энергетических потерь. Наиболее эффективным способом решения этой задачи
является использование в технологии их изготовления проникающих излучений
(быстрых электронов, гамма-квантов).
Было установлено, что прямое падение напряжения
p-n-структур монотонно возрастает с увеличением флюенса электронного облучения,
а время жизни неосновных носителей заряда - уменьшается - рисунок 7.
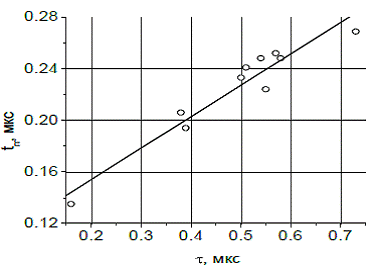
Рисунок 7 - зависимости времени жизни ННЗ и
прямого падения напряжения диодных структур от флюенса электронов с Е = 4 МэВ.
При больших флюенсах быстрых электронов значение
UF начинает выходить за пределы ТУ (Uf
≤1,3
В при значении прямого тока 2 А). Как следует из рис. 8, минимально достижимое
значение τ облучаемых диодных
структур равно 0,15÷0,17 мкс,
так как при этом величина Uf
становится равной 1,3 В. Эти значения исследуемых параметров достигаются при Фe=7,5∙10
14 см -2.
Аналогичный характер поведения τ
и
Uf
наблюдается и при облучении диодных структур гамма-квантами Со 60.
Однако здесь минимально достижимое значение τ облучаемых
диодных структур гамма-квантами равно 0,3÷0,32 мкс,
что соответствует Фγ= (1,4 ÷1.5)1017кв/см
2 - рисунок 8.Сравнение этих значений с аналогичными данными,
полученными при электронном облучении, показывает, что радиационная обработка
диодных структур электронами эффективнее, чем гамма-квантами. Данный
экспериментальный факт может быть обусловлен различием во вводимых типах
радиационных дефектов. В случае гамма-облучения практически не вводятся
дивакансии. Значения обратных токов диодных структур не выходят за нормы ТУ в
исследуемом диапазоне флюенсов электронного облучения. Для исследования термической
стабильности параметров проводился изохронный (20 мин) отжиг облученных диодных
структур при Тотж = 373÷623 К
- рисунок 9.
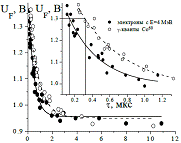
Рисунок 8 - зависимость U
F(τ)
для
диодных структур, облучаемых электронами с Е = 4 МэВ и гамма-квантами Сo
60
При отжиге все параметры приборов испытывают
обратные изменения, т.е. значение прямого падения напряжения уменьшается, а
значение времени обратного восстановления возрастает.
Однако до Тотж = 523 К эти изменения весьма
незначительны. Наиболее эффективное восстановление τ
и
UF
начинается
при более высоких температурах. При Тотж= 623 К значение времени жизни ННЗ
выходит за пределы ТУ.
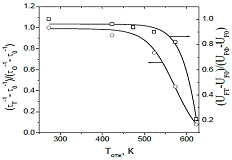
Рисунок 9 - изменение в процессе изохронного
отжига времени жизни ННЗ и прямого падения напряжения диодных структур,
облученных флюенсом электронов Фe=7∙1014
см -2. UFT;
UF0;
UFФ
- значение прямого падения напряжения после отжига, до и после облучения
соответственно. Обозначения для τ аналогичны.
Результаты нестационарной емкостной
спектроскопии глубоких уровней - DLTS-спектроскопии (Deep Layer Transient
Spectroscopy) диодных структур показали, что при перезарядке ловушек основными
носителями заряда на спектре облученных электронами образцов возникают пики Е1-Е4,
а при перезарядке неосновными - минимум H1- рисунок 10-а. Пику Е1 соответствует
глубокий уровень с Ес-0,19 эВ и сечением захвата σ
= 2,7∙10
-14 см 2 (комплекс вакансия-кислород), Е2 - Ес-0,25
эВ σ
= 6,7∙10
-15см 2 (комплекс вакансия-вакансия), Е3 - Ес-0,36
эВ σ
= 8,1∙10
-16 см 2 и минимуму H1 - донорный уровень с Еv+0,36
эВ σ
= 2,3∙10
-15 см 2 (комплекс углерод внедрения-кислород внедрения).
Наложение пиков Е3 и Е4 не позволяет определить параметры ловушки Е4. Отжиг
облученных р-n-структур при Тотж = 573 К приводит к исчезновению пиков Е2 и Е4-
рисунок 10-б, что позволяет соотнести оба пика с комплексом вакансия-вакансия.
Обращает на себя внимание также значительное уменьшение амплитуды пиков Е1 и
Н1. Все это объясняет резкое восстановление параметров облученных образцов при
данных температурах отжига -рисунок 9. Природа термостабильной ловушки Е3 на
данный момент остается до конца не выясненной. Можно предположить, что этот
уровень относится к более сложным кислородосодержащим комплексам.

Рисунок 10 -DLTS-спектры облученных (а) и
отожженных при Тотж= 573 К в течение 30 минут (б) диодных структур. Штриховая
линия - перезарядка ловушек неосновными носителями, а сплошная - основными.
Следует отметить, что электронное облучение
можно применять и для улучшения динамических параметров диодов, изготовленных
на кремнии р-типа. Так, исследуемые диоды изготавливались на кремниевых
пластинах р-типа с удельным сопротивлением 18 Ом∙см. Р-n-переход
формировался диффузией фосфора на глубину 8 мкм. После создания омических
контактов все количество приборов было разделено на три группы. Первая и вторая
облучались разными флюенсами электронов при комнатной температуре и отжигались
при 700 К в течение 8 минут. Третья группа не подвергалась
радиационно-термической обработке.
В таблице 2 представлены результаты
радиационно-термической обработки диодных n+-p-p+-структур. Отжиг облученных
структур проводился в течение 8 минут. Исследования необлученных образцов
показали, что средние значения времени обратного восстановления диодных
структур составляли 920 нс, прямого падения напряжения - 917 мВ, обратного
напряжения - 233 В.
С ростом флюенса электронного облучения Ф
происходит уменьшение trr. Так, уже при Ф=6∙10 15 см -2
среднее значение trr составляет 165 нс. Следует отметить при этом
некоторый рост прямого падения напряжения и деградации обратной ВАХ диодов.
Однако при указанном флюенсе электронов значения статических параметров
остаются в пределах Ur
≥200
В и Uf≤1,2
В.
Таблица 2 Влияние радиационно-термической
обработки на параметры мощных диодов, изготовленных на кремнии р-типа:

Из анализа полученных данных следует, что в
результате проведенной радиационно-термической обработки значение trr
уменьшилось в 5÷8 раз.
При этом значения Uf
остаются не только в нормативных рамках, но еще имеется достаточный запас (~0,2
В) для еще большего повышения флюенса электронного облучения. После облучения
n+-р-p+-структур электронами на DLTS-спектрах возникают пики, соответствующие
перезарядке глубоких уровней, расположенных в нижней половине запрещенной зоны
кремния- рисунок 11. Пик Е1 соответствует ловушке с глубоким уровнем Ev+0,20
эВ и сечением захвата σ = 8,1∙10-16см2(комплекс
дивакансия), пик Е2 - Ev+0.31
эВ и σ=
4,9∙10-14
см 2 и пик Е3 - Ev+0,35
эВ и σ=
4,5∙10
-15см2(комплекс углерод внедрения - кислород внедрения
СiOi). Природа ловушки Е2 на сегодняшний день остается пока до конца не
выясненной. Она отжигается при температуре отжига Тотж = 650 К.
Результаты DLTS-спектроскопии показывают, что
основным рекомбинационным центром в облученных образцах является комплекс СiOi.
Согласно литературным данным он отжигается при 673 К 23]. Это подтверждается и
нашими измерениями. Так, при Тотж = 673 К в течение 30 минут амплитуда пика Е3
уменьшилась более чем в 10 раз - рисунок 11. В то же время, как отмечалось
выше, после стабилизирующего отжига облученных диодов при 700 К в течение 8
минут trr
остается значительно меньше исходного значения.

Рисунок 11- DLTS-спектры облученных и отожженных
при Т = 623 и 673 К в течение 30 минут образцов на кремнии р-типа .
Следует отметить, что в процессе изохронного
отжига образцов при 650-690 К возникает ряд более термостабильных ловушек
Е4-Е7. Пик Е4 соответствует ловушке с глубоким уровнем Ev+0,24
эВ и сечением захвата σ= 1,3∙10
-12 см 2 и Е7 - Ev+0,58
эВ и σ=
1,9∙10
-14 см 2. Параметры ловушек Е5 и Е6 определить не удается
из-за перекрытия пиков Е5, Е6 и Е3. Большие значения сечений захвата у ловушек
Е4 и Е7 позволяют их отнести к термостабильным - рисунок 11 и весьма
эффективным центрам рекомбинации неосновных носителей заряда в базовой области
исследуемых диодов, что и объясняет высокую термическую стабильность параметров
облученных диодов.
Таким образом, полученные результаты
свидетельствуют о возможности использования радиационно-термической обработки в
технологии изготовления мощных кремниевых диодов. Эффективность использования
радиационной технологии полупроводников можно также продемонстрировать на
примере изготовления мощных кремниевых тиристоров, в том числе выключаемых по
электроду управления (запираемых).
Исследовались зависимости остаточного падения
напряжения на тиристоре Ut
от времени выключения tq
для двух различных способов радиационной обработки - рисунок 12.
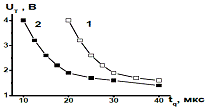
Рисунок 12 - зависимость Ut
(tq)
для мощных кремниевых тиристоров (номинальный ток 50 А, блокируемое напряжение
<2000 B). 1- обычное облучение; 2- локальное облучение .
Кривая 1 соответствует зависимости при обычном
облучении тиристоров электронами с энергией 4 МэВ при комнатной температуре
флюенсами 1∙1014-1∙1015 см-2.
Аналогичная зависимость (кривая 2) получена при облучении тиристоров через
специальную маску, позволяющую создавать в объеме полупроводниковой структуры
изолированные сквозные участки с малым временем жизни неосновных носителей
заряда. За счет этого удается сместить кривую зависимости UT(tq)
в сторону больших значений времени выключения, обеспечивая таким образом более
высокий уровень быстродействия при тех же значениях потерь в проводящем
состоянии. Это обусловлено тем, что при введении зон повышенной рекомбинации в
базовые области p-n-p-n-структуры, основной ток в проводящем режиме протекает
по участкам структуры с низкой концентрацией радиационных дефектов. При
выключении прибора рекомбинация заряда, оставшегося в базовой области структуры
после закрытия центрального р-n-перехода, протекает более эффективно за счет
ухода неравновесных носителей в зоны повышенной рекомбинации.
Как видно на рисунке 12, за счет этого удается
добиться почти двукратного увеличения быстродействия при тех же значениях
остаточного падения напряжения (по ТУ не более 2,5 В).
Одним из наиболее перспективных способов
выключения тиристоров является подача в одну из базовых областей (обычно
p-типа) управляющего импульса отрицательной полярности (запирание). Коэффициент
запирания Кзап, определяемый как отношение амплитуды запираемого
анодного тока к амплитуде импульса запирающего тока, является основным параметром,
влияющим на эффективность процесса запирания. Очевидным является стремление
разработать структуры и приборы на их основе с высокими значениями Кзап.
Однако, предлагаемые для этого технологические методы усложняют процесс
изготовления структуры. Было установлено, что параметры Кзап и Ut
при облучении возрастают, однако скорости их роста различны - рисунок 13. Так,
при Ф= (2-3)∙1014 см-2 Кзап
увеличивается в 3-4 раза, при этом Ut
растет заметно меньше (в полтора-два раза).
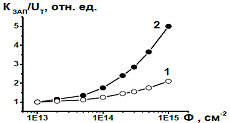
Рисунок 13 - зависимость коэффициента запирания
Кзап и остаточного напряжения в открытом состоянии Ut
запираемого тиристора (номинальный ток 2 А, максимальное блокируемое напряжение
<1000 В) от флюенса электронного облучения. 1- Ut;
2 - Кзап
Таким образом, очевидно, что с помощью
радиационного облучения можно существенно увеличивать эффективность запирания
тиристоров, выключаемых по электроду управления, не допуская при этом выхода
значения остаточного напряжения за пределы, указанные в ТУ. Наиболее
перспективным силовым полупроводниковым прибором в настоящее время является
биполярный транзистор с изолированным затвором (БТИЗ). Этот прибор
изготавливается, в отличие от биполярных транзисторов, на p+-подложке, служащей
коллектором, с последующим эпитаксиальным наращиванием дрейфового слоя n-типа;
управляющая МОП-структура формируется затем на этом слое с помощью процессов,
аналогичных используемым при изготовлении мощных МОП-транзисторов. Такая
структура позволяет получить высокие параметры - большие рабочие напряжения и
плотности прямого тока. Однако вовлечение неосновных носителей в процесс
передачи тока обусловило сравнительно низкое их быстродействие, что существенно
ограничивает область применения этих приборов. Достичь его увеличения нам удалось
благодаря использованию в технологии их изготовления только проникающих
излучений . В данном случае радиационной технологии нет альтернативы.
Транзисторы (БТИЗ) изготавливались на НПО
«Интеграл», радиационная обработка проводилась в Институте физики твердого тела
и полупроводников НАН Беларуси на ускорителе электронов ЭЛУ-4. Определены
оптимальные режимы радиационной и термической обработки БТИЗ с напряжением на
коллекторе 500 В и токе 10 А, которые позволили достичь время переключения 130
нс (зарубежные аналоги имеют 200 нс) при дозе Ф ~8∙10 14см-2,
энергии электронов 4 МэВ, температуре отжига Тотж.=400 0С.
Следует в качестве примера указать еще на один
тип cоставного транзистора, собранного по схеме Дарлингтона, быстродействие
которого удалось существенно повысить, используя электронное облучение . Дело в
том, что мощные биполярные транзисторы при высоких плотностях тока имеют, как
правило, низкое значение коэффициента усиления по току β.
Для
исключения этого недостатка мощный составной транзистор образуется из двух
транзисторов, соединенных по схеме Дарлингтона, что дает значительное
увеличение β. Однако при этом
скорость переключения составного транзистора снижается. Опытная партия
транзисторов была изготовлена на НПО «Интеграл», радиационная обработка
проводилась в ИФТТП НАН Беларуси. Были отработаны режимы радиационной и
термической обработки, которые позволили повысить быстродействие составных
транзисторов в 2 раза при сохранении коэффициента усиления в пределах нормы.
Были определены экспериментальные значения
времени выключения - рисунок 14 и коэффициента усиления по току - рисунок 15,
усредненные по 10 образцам для 5 групп составных транзисторных структур с
различными исходными β0,
в зависимости от флюенса электронов, а также от длительности отжига при 433 К.
В результате облучения при Ф = (2-5)∙1013 см-2
время выключения снижается в область норм ТУ (t
выкл≤2,5 мкс).

Рисунок 14 - изменение времени выключения
составных транзисторных структур в зависимости от флюенса электронов (Е=6 МэВ)
и длительности отжига при 433 К
Последующий отжиг в течение 1-2 ч приводит к
дальнейшему уменьшению величины tвыкл, но более длительный отжиг ухудшает
быстродействие транзисторов. Величина β уменьшается
после облучения и частично восстанавливается после отжига в течение 1-8 ч, но
при этом остается с двойным запасом в пределах ТУ. Были изучены изменения
динамических (время рассасывания tp, время жизни неосновных
носителей заряда в коллекторе τк)
и статических (напряжение насыщения коллектор-эмиттер Uкэн, коэффициент
передачи тока базы β) параметров
мощных биполярных транзисторных n+-n-p-n+-структур в зависимости от дозы
гамма-излучения Со60 и электронов с энергией Ее = 4 МэВ с учетом влияния
доминирующих радиационных дефектов.
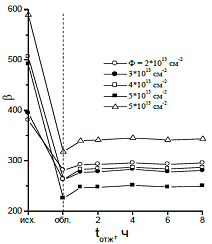
Рисунок 15 - влияние электронного облучения с
Е=6 МэВ и отжига при 433 К в течение 1-8 ч на коэффициент усиления по току
составных транзисторных структур
Транзисторные структуры изготавливались на
основе ядерно-легированного кремния n-типа с удельным сопротивлением 70÷90
Ом∙см
(коллектор), р-база создавалась ионным легированием бором, n+-эмиттер-
диффузией фосфора. Структуры облучались электронами на линейном ускорителе
ЭЛУ-4 флюенсами Фе=1012÷3∙1013
см-2, а также флюенсами гамма-квантов Фγ=3∙1014÷6∙1015см-2
на установке «Исследователь».
Исследования изменений основных параметров
мощных транзисторных структур при электронном облучении показали - рисунке 16,
что в диапазоне Фе=1010÷1013см-2
зависимости обратных значений трех параметров от флюенса электронов
аппроксимируются линейными функциями:


где tp.o
= 7,4∙10-6 с, τk.o
= 1,8∙10 -5с, β0
= 9,0 -значения параметров до облучения; Kt
= 1,8∙10 -8см 2 ∙с-1, Кτ
= 7,0∙10-9 см 2∙с -1, Кβ=
1,3∙10 -14 - коэффициенты радиационного изменения
соответствующих параметров.
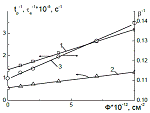
Рисунок 16 - изменения параметров tp
-1 (1), τk-1
(2) и β-1(3)
транзисторных структур в зависимости от флюенса электронов
Аналогичные зависимости параметров транзисторных
структур были также получены и от флюенса гамма-квантов Фγ.
Кроме
того, было установлено, что изменение напряжения насыщения при электронном или
гамма-облучении - рисунок 17 с достаточной точностью можно представить
квадратичной зависимостью от флюенсов излучений:

где Uкэн.о=
0,2 ÷0,4 В - величина напряжения насыщения до
облучения, Кu= 1,3∙10 -25В∙см4 или
1,4∙10-31 В∙см4 - коэффициенты его радиационного
изменения при воздействии электронов или гамма-квантов соответственно.
Анализ полученных результатов показал, что
радиационные изменения параметров мощных транзисторных структур определяются
процессами дефектообразования в основном в высокоомном n-коллекторе (tp,
τк, Uкэн)
и частично в р-базе (β).
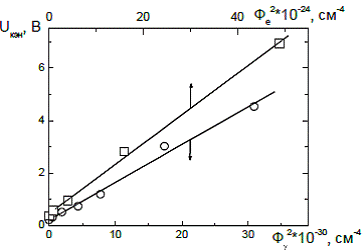
Рисунок 17 - изменение напряжения насыщения
транзисторных структур в зависимости от Фе2 или Фγ2
С помощью DLTS-спектроскопии были определены
концентрации доминирующих радиационных дефектов (А-центров) NA в коллекторном
слое транзисторных структур. Установлено ,что зависимости NA от флюенса частиц
подчиняются линейному закону:

где КN = 2,7∙10-2 см-1
или 1,4∙10 -4см-1- коэффициент радиационного
изменения концентрации дефектов, возникших при электронном или гамма-облучении
соответственно. Отсюда можно выявить взаимосвязь изменений электрических
параметров транзисторных структур и параметров радиационных дефектов. Например,
используя зависимости (8) и (12), получим:

Соответствующие изменения времени рассасывания
от концентрации А-центров, образующихся при воздействии электронов или
гамма-квантов, показаны на - рисунке 18. В случае электронного облучения
подобная зависимость выражена значительно сильнее, чем при облучении
гамма-квантами. Это связано с тем, что при электронном облучении наряду с
А-центрами вводятся еще и другие радиационные дефекты (VV, V-P), влияющие на
быстродействие транзисторных структур.
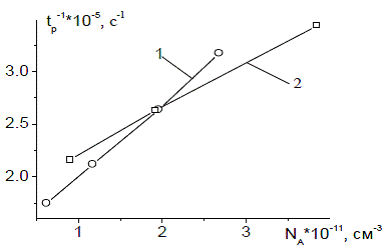
Рисунок 18 - зависимости tp-1
(NA) при облучении транзисторных структур электронами (1) или гамма-квантами
(2)
3.СПЕЦИФИКА МЕХАНИЗМОВ РАДИАЦИОННОГО ВОЗДЕЙСТВИЯ
.1 Радиационная стойкость материалов
Физические механизмы
радиационных воздействий на материалы и элементы оборудования КА зависят от
вида и энергии воздействующего излучения, типа облучаемого материала, условий
облучения - интенсивности воздействующего излучения (мощности дозы),
температуры материала и ряда других факторов. Поскольку ионизирующее излучение
космического пространства является многокомпонентным по составу и энергии,
причем его составляющие могут воздействовать на КА в различных сочетаниях и в
разной временной последовательности, то возникающие в материалах КА
радиационные эффекты имеют весьма сложный характер.
Радиационными
эффектами принято называть любые изменения структуры,
свойств, состояния вещества или материала, вызываемые действием излучения.
Трудность анализа радиационных эффектов усугубляется также сложностью состава и
структуры многих материалов, используемых в конструкции КА: композитов,
полимеров, многослойных тонкопленочных структур и т.д.
Обратимые и необратимые
изменения свойств материалов происходят за счет всех процессов преобразования
энергии ионизирующего излучения в веществе.
Электронно-дырочные пары,
генерируемые в твердом теле тормозящимися заряженными частицами в результате
ионизационных потерь энергии, вызывают радиационную проводимость,
радиолюминесценцию, радиационное окрашивание и радиационно-химические
превращения.
Радиационная проводимость и
радиолюминесценция определяются в основном мощностью дозы излучения и
относительно быстро исчезают после прекращения облучения. Время релаксации
составляет ~10-9-10-1 с в зависимости от типа материала.
Эти явления характеризуют типичную картину обратимых радиационных процессов.
Радиационное окрашивание диэлектриков и радиационно-химические превращения в
основном зависят от суммарной поглощенной дозы излучения. Время релаксации
таких явлений достигает 1∙10-7с и более. Носители заряда,
образующиеся в облучаемом веществе, создают стационарные и нестационарные токи
и приводят к накоплению объемного заряда в диэлектриках, который может
сохраняться в течение длительного времени. Последний процесс, как мы увидим
далее, может быть причиной возникновения электрических разрядов в диэлектрических
материалах КА.
Образование радиационных
дефектов под действием ионизирующего излучения космического пространства имеет
ряд особенностей. Дефекты, создаваемые различными компонентами излучения,
сложным образом взаимодействуют между собой и с исходными дефектами облучаемой
структуры, в результате чего могут возникать синергетические эффекты,
заключающиеся в том, что при одновременном или последовательном воздействии на
материалы КА нескольких факторов конечный эффект не равен сумме эффектов от
воздействия отдельных факторов. При этом комплексное воздействие факторов
космического пространства может как усиливать, так и ослаблять повреждение
материалов. Применительно к воздействию космической среды на материалы КА
синергетические эффекты исследованы совершенно недостаточно, их изучению
уделяется большое внимание.
Важно отметить, что воздействие
космического ионизирующего излучения на материалы КА происходит на фоне
воздействия других факторов: солнечного электромагнитного излучения, горячей и
холодной космической плазмы и т.д., в условиях невесомости и знакопеременной
температуры, диапазон изменения которой для материалов, находящихся на
поверхности КА, составляет от -150 до +100°C. Это еще более усложняет характер
процессов, протекающих в материалах и элементах оборудования КА.
Для описания радиационной
стойкости материалов и элементов оборудования используется ряд строго
определенных терминов:
♦ радиационная
стойкость материалов - их способность выполнять определенные функции и
сохранять заданные характеристики и параметры в пределах, установленных
техническими требованиями, во время и после воздействия ионизирующих излучений;
♦ предел радиационной
стойкости - доза или флюенс ионизирующего излучения, при которых изменения
основных наиболее важных технических характеристик материалов не превышает
допустимых значений;
♦ радиационный отказ -
нарушение работоспособности материала, элемента, изделия за счет воздействия
ионизирующих излучений.
Усредненные данные о
радиационной стойкости некоторых материалов и элементов оборудования,
используемых при создании КА, приведены в таблице 3.
Таблица 3 Радиационная
стойкость материалов и элементов оборудования КА.
|
Материал,
изделие
|
Доза,
Гр
|
Изменение
характеристик, характер воздействия
|
|
Полупроводниковые
приборы
|
103-104
|
увеличение
обратных токов, снижение усиления
|
|
Микропроцессоры
БИС
|
102-103
|
обратимые
и необратимые перемежающиеся отказы, радиационные сбои
|
|
Солнечные
элементы
|
103-104
|
снижение
КПД
|
|
Оптические
стекла
|
103-104
|
ухудшение
прозрачности за счет радиационного окрашивания
|
|
Волоконная
оптика
|
102-103
|
снижение
амплитуды передаваемого сигнала за счет радиационного окрашивания
|
|
Интегральная
оптика
|
102-103
|
снижение
КПД, радиационная окраска световодов
|
|
Полимерные
материалы
|
104-106
|
деградация
оптических, механических и электроизоляционных характеристик
|
Из рассмотрения таблицы 3
видно, что в наибольшей степени подвержены воздействию космической радиации
полупроводниковые и оптические материалы, в меньшей степени - полимерные
материалы и терморегулирующие покрытия, а наиболее высокую стойкость к
воздействию радиации имеют металлы.
Использование таких усредненных
данных позволяет классифицировать материалы по уровню радиационной стойкости и
производить предварительный выбор элементов оборудования КА для различных
условий эксплуатации. Окончательный выбор материалов осуществляется на
основании результатов комплексных лабораторных и натурных испытаний и сведений
о поведении материалов в космической среде, получаемых методами математического
моделирования.
3.2 Воздействие ионизирующих
излучений
Одним важным эффектом,
обусловленным воздействием ионизирующих излучений космического пространства,
является радиационная электризация диэлектрических материалов, под которой понимают
накопление электрического заряда на их поверхности или в объеме. Соответственно
различают поверхностную и объемную (внутреннюю) электризацию. В условиях
космического пространства поверхностная электризация диэлектриков внешней
оболочки КА вызывается воздействием горячей магнитосферной плазмы, электроны
которой с характерными энергиями до 50−100 кэВ проникают в материал на
глубину ~20−30 мкм, а объемная электризация - воздействием электронов РПЗ
(1) с энергиями ~2−10 МэВ, способных проникнуть в толщу диэлектрика на
0,5−2 см.
Причиной разделения
радиационной электризации диэлектриков на поверхностную и объемную является не
только отличие глубин локализации внедренного электрического заряда, но также и
существенное отличие в указанных двух случаях физических процессов накопления
заряда, потоков первичных заряженных частиц, приводящих к его накоплению, и
временных характеристик процессов.
При заряжении в горячей
магнитосферной плазме характерные величины первичных токов составляют
~10-10-10-8 А⋅см-2, а продолжительность
заряжения изменяется от долей секунды до десятков минут. Большие
времена относятся к реальным КА, на которых в процессе заряжения происходит
перераспределение зарядов. Поверхностная электризация диэлектриков внешней
оболочки КА в значительной степени определяется вторично- эмиссионными
процессами включая фотоэлектронную эмиссию.
Объемное заряжение
диэлектрических материалов КА под действием электронов РПЗ характеризуется
следующими параметрами: ток электронов, ~10-13-10-11 А см-2, характерные времена
заряжения измеряются часами. Вторично-эмиссионные токи в этом случае не
оказывают влияния на процесс формирования внедренного объемного заряда.
Существуют два подхода к описанию и анализу явления поверхностной радиационной
электризации диэлектриков. При рассмотрении поверхностной электризации реальных
КА, когда главной целью является получение картины распределения потенциала и
напряженности электрического поля на поверхности аппарата и в прилегающем
пространстве, вычисляется суммарный заряд на элементе поверхности без описания
его распределения в приповерхностном слое диэлектрика. В этом случае уравнение
для полного тока J, текущего
через элемент поверхности, записывается в виде
= Je − Ji−
(δJe
−
ηJe
+ γJi+
Jph) ± Jcond,
где Je и Ji
- электронный и ионный токи плазмы; δ, η, γ
- коэффициенты
истинной вторичной электронной эмиссии, отражения электронов, ионно-электронной
эмиссии; Jph - ток фотоэлектронной эмиссии; Jcond - токи
утечки на металлический корпус КА и соседние элементы поверхности за счет объемной
и поверхностной проводимости диэлектрика.
Величины первичных и вторичных
токов, входящих в уравнение, зависят от потенциала КА относительно окружающей
космической плазмы, причем для вторичных токов эта зависимость проявляется и
через изменение значений вторично-эмиссионных коэффициентов, обусловленное
изменением энергии первичных электронов и ионов. Равновесное значение
потенциала КА определяется из решения уравнения при условии J =0. Для
реальных КА сложной конфигурации с неоднородной поверхностью потенциалы
отдельных ее участков могут значительно отличаться из-за различия
электрофизических свойств находящихся на них диэлектрических материалов,
различия условий попадания первичных частиц окружающей плазмы на эти участки,
неодинакового освещения их Солнцем и т.д. При этом потенциал металлического
корпуса КА не остается постоянным в процессе заряжения.
Во втором подходе, используемом
в ряде случаев для анализа и интерпретации результатов лабораторных
экспериментов по облучению диэлектриков электронами с энергией ~10-100 кэВ,
предполагается возникновение в приповерхностной области двойного электрического
слоя за счет ухода вторичных электронов из непосредственно примыкающего к
поверхности слоя толщиной ~10-50 нм и локализации первичных электронов на глубине
в несколько десятков микрометров.
Объемная электризация
диэлектриков при их облучении электронами с энергиями ~1−10 МэВ,
определяется следующими основными процессами:
♦ торможением первичных
электронов в диэлектрике за счет ионизационных и радиационных потерь энергии;
♦ термализацией
электронов в веществе с захватом их на ловушки разных типов;
♦ стоком электронного
заряда из объема диэлектрика к облучаемой поверхности и подложке за счет токов,
обусловленных собственной и радиационной проводимостью диэлектрика.
По мере накопления внедренного
заряда в объеме диэлектрика возникает внутреннее электрическое поле,
оказывающее воздействие на движение носителей заряда в диэлектрике. Токи и
электрические поля в заряжаемом диэлектрике могут быть описаны общей системой
уравнений, основанных на уравнении непрерывности, законе Ома в дифференциальной
форме и уравнении Пуассона для данного вещества:
где ρ
- плотность
объемного заряда; j - вектор плотности тока; ji - вектор
плотности тока инжектируемых носителей; σE
- составляющая тока в электрическом поле с напряженностью E, определяемая
проводимостью диэлектрика σ; ϕ
- потенциал, создаваемый внедренным зарядом.
В свою очередь, проводимость
диэлектрика σ c учетом ее
радиационной составляющей описывается выражением, приведенным в предыдущем
разделе.
Характерные модельные
распределения по глубине диэлектрика z напряженности электрического поля
E и потенциала ϕ, рассчитанные для электронов с энергией 1 МэВ без
учета собственной и радиационной проводимости диэлектрика, показаны на рисунке
1.
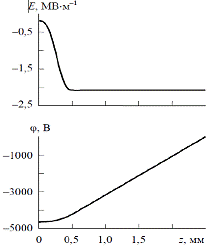
Рисунок 1 - распределение по
глубине диэлектрика z напряженности электрического поля E и
потенциала ϕ
Экспериментальными и расчетными
методами исследовалась также динамика накопления объемного заряда в облучаемых
диэлектриках.
На рисунке 1 приведена
зависимость потенциала поверхности образца эпоксидного материала толщиной 725
мкм от времени при его облучении электронами со спектром, характерным для РПЗ в
области ГСО. Данные лабораторных измерений (кривая 1) показаны вместе с
результатами расчетов, выполненных при различных значениях темновой
проводимости и коэффициента радиационной электропроводности. Видно, что без
учета радиационной проводимости (кривая 2, Am = 0) при стандартной
величине σ0=5∙10-17
Ом-1∙см-1 рассчитанный потенциал примерно в 2,5
раза превосходит экспериментальное значение. Наилучшее согласие с экспериментом
наблюдается при Am=1∙10-14 (кривая 3), а при Am=6.5∙10-14
(кривая 5) рассчитанный потенциал значительно меньше полученного экспериментально.
Кривая 4 показывает результаты расчета при σ0=5∙10-15
Ом-1∙см-1 и Am = 0, которые также близки к
экспериментальным данным.
Таким образом, возникновение
радиационной проводимости в рассматриваемом случае эквивалентно увеличению
собственной проводимости примерно на 2 порядка.
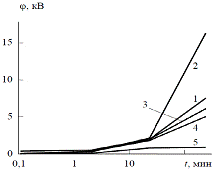
Рисунок 2 - зависимость от
времени облучения потенциала поверхности эпоксидного образца: 1 -
экспериментальные данные; 2-5 - результаты расчетов
Приведенные данные
свидетельствуют об отмечавшемся выше существенном влиянии радиационной
проводимости на процессы накопления объемного заряда в диэлектриках. Следствием
поверхностной и объемной электризации диэлектрических материалов под действием
космического излучения является возникновение электрических разрядов на КА,
которые вызывают сбои в работе бортовых систем за счет создаваемых
электромагнитных помех, а также могут приводить к необратимым повреждениям
элементов оборудования. Возникновение электрических разрядов в диэлектриках КА
может инициироваться воздействием других факторов космического пространства, в
частности высокоскоростными ударами твердых микрочастиц естественного и
искусственного происхождения.
ЗАКЛЮЧЕНИЕ
полупроводник ядерный легирование
Рассмотрены физические основы и практические
результаты использования проникающих излучений в технологии ядерного
легирования полупроводниковых материалов (Si, GaAs), а также в производстве
полупроводниковых приборов, в том числе мощных кремниевых диодов, тиристоров и
транзисторов. Показана высокая эффективность применения радиационной технологии
для повышения быстродействия изделий электронной техники, исключения операции
диффузии золота или платины, улучшения качества, снижения себестоимости и
повышения выхода годных приборов.
СПИСОК ИСПОЛЬЗОВАННЫХ ИСТОЧНИКОВ
1 Ф.П. Коршунов. Вестник Академии
наук СССР, 11, 80 (1982).
Вопросы радиационной технологии
полупроводников. Под ред. Л.С.
Смирнова. Наука, Новосибирск (1980).
296 с.
Д. Динс. Радиационные эффекты в
твердых телах. Изд-во иностранной литературы, М. (1960). 243 с.
Ф.П. Коршунов, Ю.В. Богатырев, В.А.
Вавилов. Воздействие радиации на интегральные микросхемы. Наука и техника,
Минск (1986). 254 с.
И.Б. Козлов, А.Г. Литвинко, П.Ф.
Лугаков, С.В. Мищук, В.Д. Ткачев. ФТП 6, 10, 2048 (1972).
К. Ларк-Горовиц. Кн.
«Полупроводниковые материалы». Под ред. В.М. Тучкевича. ИЛ, -М. (1954). С.62.
Ф.П. Коршунов. Радиация и
полупроводники. Наука и техника, Минск (1979). 83 с.
Л.С. Смирнов, С.П. Соловьев, В.Ф.
Стась, В.А. Харченко. Легирование полупроводников методами ядерных реакций.
Наука, Новосибирск (1981). 182 с.
Ф.П. Коршунов, Л.М. Карпович, Е.С.
Солодовников, В.И. Утенко, В.Ф.
Шох. Известия АН Беларуси, серия
физ.-мат. наук, 2, 50 (1995).
Л.М. Карпович, Ф.П. Коршунов, Е.С.
Солодовников, В.И. Утенко, А.В. Фотин, В.Ф. Шох. Доклады АНБ 36, 11, 982
(1992).
В.С. Вавилов, В.Ф. Киселев, Б.Н.
Мукашев. Дефекты в кремнии и на его поверхности. Наука, М. (1990). 216 с.
Ф.П. Коршунов, В.Я. Красницкий, А.В.
Мудрый, Ю.В. Богатырев, В.И.
Кульгачев, С.Б. Ластовский.
Материалы Междунар. сем. «Конверсия научн. исслед. в Беларуси в рамках
деятельности МНТЦ». Ч.2. Минск (май 1999 г.). С.178.
Ф.П. Коршунов, Ю.В. Богатырев, А.И.
Дударчик, Н.Ф. Голубев, В.И. Кульгачев, С.Б. Ластовский. Известия НАНБ, серия
физ.-техн. наук, 2, 80 (2000).
Ф.Л. Хауэр. ТИИЭР 76, 4, 36 (1988).
Ф.П. Коршунов, Ю.В. Богатырев, С.Б.
Ластовский и др. Труды Х Межнационального совещания «Радиационная физика
твердого тела». М. (2000). С.470.