Полупроводниковые квантовые наноструктуры и сверхрешетки
Контрольная работа
Полупроводниковые квантовые
наноструктуры и сверхрешетки
Содержание
1. Гетеропереходы
2. Квантовые ямы
3. Сверхрешетки
Литература
1.
Гетеропереходы
Гетеропереходы, представляющие собой поверхности раздела между
двумя полупроводниками с различными запрещенными зонами, являются чрезвычайно
важными и разнообразными блоками электронных приборов, особенно создаваемых на
основе полупроводниковых соединений А3В Наиболее изученной в
настоящее время гетероструктурой является структура, образованная (n-типа) и почти беспримесным или слаболегированным GaAs p-типа.
Внутри GaAs очень близко к поверхности раздела GaAs-AlGaAs образуется инверсный слой электронов. Приборы, создаваемые
на основе AlGaAs, обычно используются при значительно
более высоких частотах, чем приборы на основе кремния, в силу большей
подвижности электронов в GaAs.
Поскольку поверхности раздела оксидов и изоляторов, осаждаемых на поверхности GaAs, являются недостаточно качественными, в
большинстве важных технических применений используются структуры Шоттки типа
металл-AlGaAs - GaAs (рис. 1.).
(n-типа) и почти беспримесным или слаболегированным GaAs p-типа.
Внутри GaAs очень близко к поверхности раздела GaAs-AlGaAs образуется инверсный слой электронов. Приборы, создаваемые
на основе AlGaAs, обычно используются при значительно
более высоких частотах, чем приборы на основе кремния, в силу большей
подвижности электронов в GaAs.
Поскольку поверхности раздела оксидов и изоляторов, осаждаемых на поверхности GaAs, являются недостаточно качественными, в
большинстве важных технических применений используются структуры Шоттки типа
металл-AlGaAs - GaAs (рис. 1.).

Рис. 1.
В этом разделе мы будем рассматривать в основном, физические
свойства и зонные диаграммы для гетероперехода  - GaAs, показанного на рис. 2.
- GaAs, показанного на рис. 2.
Прежде всего, следует обсудить качественную картину возникновения
электронной наноразмерной ямы на поверхности раздела AlGaAs - GaAs. Предположим, как показано на рис. 3, что в
рассматриваемом гетеропереходе AlGaAs - GaAs слева
располагается полупроводник арсенид галлия, легированный алюминием, а справа -
почти беспримесный материал GaAs.

Рис. 2.
Такая структура называется гетеропереходом с модулированным
легированием, а метод ее создания модулированным легированием. Рассмотрим
сначала гипотетическую ситуацию рис.2. (левая часть) до момента контакта двух
описанных полупроводников. На рисунке для простоты схематически показаны только
дно зон проводимости и уровень Ферми, который для n-типа AlGaAs
располагается очень близко к зоне проводимости, а для слаболегированного GaAs p-типа расположен почти в середине запрещенной зоны. Очевидно, что
зоны являются плоскими, поскольку материал в целом является электрически
нейтральным, а легирование носит однородный характер.
Высота барьера между материалами (обозначенная на рисунке через Ес)
может быть приблизительно оценена по так называемому правилу Андерсона, в
соответствии с которым при соединении двух полупроводниковых материалов их
уровни в вакууме должны выровняться.
Обозначив через χΑ и χΒ электронное сродство материалов AlGaAs и GaAs соответственно, легко получить поскольку электронное сродство в
полупроводниках определяется как энергия, необходимая для переноса электрона со
дна зоны проводимости во внешнее по отношению к твердому телу пространство,
т.е.
поскольку электронное сродство в
полупроводниках определяется как энергия, необходимая для переноса электрона со
дна зоны проводимости во внешнее по отношению к твердому телу пространство,
т.е.  Исходя из правила Андерсона, можно
вычислить, что для легированного
Исходя из правила Андерсона, можно
вычислить, что для легированного (при значении χ около 0,3) значение
(при значении χ около 0,3) значение  составляет 0,35 эВ.
составляет 0,35 эВ.
Ситуация изменяется, когда описываемые полупроводниковые материалы
AlGaAs и GaAs вступают в контакт. При этом часть электронов от доноров
материалаа n-типа пересекают поверхность раздела и
попадают в нелегированный GaAs, в
результате чего (как и в случае р-п переходах) возникает внутреннее
электрическое поле, которое направлено от нескомпенсированных доноров в AlGaAs в сторону GaAs с дополнительным отрицательным зарядом. Такое поле
приводит к искривлению (изгибу) зоны, как показано рис. 2. В равновесном
состоянии оба уровня Ферми должны совпадать, в результате чего изгиб зоны очень
напоминает изгиб для упомянутых р-п переходов, а разница заключается
лишь в наличии дополнительного барьера . Отметим также,
что по мере удаления от поверхности раздела дно зоны проводимости вновь
становится плоским, причем ее расстояние до уровня Ферми ЕF совпадает с величиной, показанной на рис.
3, а.
. Отметим также,
что по мере удаления от поверхности раздела дно зоны проводимости вновь
становится плоским, причем ее расстояние до уровня Ферми ЕF совпадает с величиной, показанной на рис.
3, а.
Поэтому можно довольно легко нарисовать зонную диаграмму,
приведенную на рис. 4, б, на которой квантовая яма для электронов формируется
слева потенциальной стенкой высотой а справа -
кривой потенциальной энергии для электронов в GaAs.
а справа -
кривой потенциальной энергии для электронов в GaAs.
Форма квантовой ямы для электронов, образующейся на поверхности
раздела AlGaAs - GaAs, близка к треугольной.
Действительно, если мы обозначим в качестве оси z перпендикулярное к поверхности раздела
направление, то инверсный слой будет представлять собой двумерную электронную
систему, в которой электроны могут свободно перемещаться в плоскости (х, у),
однако их движение вдоль оси z будет квантоваться в соответствии с ограничениями, создаваемыми
условиями квантовой ямы.

Рис. 3.
Наиболее важной физической особенностью описываемых
гетеропереходов выступает то, что носители заряда локализуются в некоторой
области (в основном в GaAs),
которая пространственно отделена от полупроводника AlGaAs, в котором и возникают свободные электроны. Электроны в
такой яме должны обладать очень высокой подвижностью в плоскости (х, у),
так как они двигаются внутри GaAs, в
котором практически отсутствуют легирующие примеси (известно, что именно
рассеяние на таких примесях ограничивает подвижность носителей заряда, особенно
при низких температурах).
Прикладывая к затвору разность потенциалов, мы можем регулировать
число носителей в канале (а, следовательно, и его проводимость). Для того чтобы
подчеркнуть значение модулированного легирования, такие структуры называют
модулированно-легированными полевыми транзисторами (MODFET) или полевыми транзисторами с высокой подвижностью электронов
(НЕМТ). Благодаря высокой подвижности электронов в канале НЕМТ-транзисторы
часто используются в свехвысокочастотных (СВЧ) приборах.
Длительное время гетероструктуры типа SiGe не привлекали особого внимания исследователей, что
объясняется значительной разницей в значениях постоянных кристаллических
решеток германия и кремния, доходящей до 4%. Такая разница подразумевала, что
выращенные на подложке слои всегда будут напряженными, вследствие чего их
толщина будет ограничена определенным критическим значением или же образующиеся
двухслойные структуры будут непрочными. Более того, поскольку разница в энергии
запрещенных зон этих материалов также достаточна мала (энергия Eg составляет для германия и кремния 1,12 и
0,66 эВ соответственно), высота возникающего на контактной поверхности барьера
также должна быть малой. Однако, несмотря на эти кажущиеся недостатки и
сложности, гетероструктуры типа SiGe
нашли ряд интересных технических применении, связанных, прежде всего, с
высокочастотными транзисторами и инфракрасными фотодетекторами. Поскольку,
такие структуры всегда являются механически напряженными, в них снимается
вырождение зон легких и тяжелых дырок, а их зонная структура имеет в целом вид,
показанный на рис. 4.12.
На рис. 4 показаны два типичных примера гетероструктур SiGe. Подложкой структуры рис. 4, а является Si с ориентацией поверхности <001> (Εg=1,17
эВ), на которой образован активный напряженный слой материала  с Εg = 0,78 эВ.
с Εg = 0,78 эВ.
В такой структуре разрыв зон проводимости очень мал, в отличие от
разрыва валентных зон. В такой системе формируется двумерный дырочный газ в
сплаве SiGe, в котором подвижность дырок достигает 2
м2В-1с-1, что соответствует примерно половине
значения подвижности электронов в типичных полевых транзисторах. На рис.4, б
представлена как бы обратная ситуация, в которой напряженный слой на подложке
образован кремнием. В этой ситуации разрыв между зонами проводимости является
достаточно большим, и двумерный газ образуют электроны, которые могут свободно
двигаться в плоскости контакта.

Рис. 4.
Такому движению соответствует эффективная масса электрона в
кремнии, равная малой поперечной массе  , что обеспечивает высокую подвижность (порядка 20 м2 В-1
с-1), в несколько раз превышающую подвижность электронов в полевых
МОП-транзисторах.
, что обеспечивает высокую подвижность (порядка 20 м2 В-1
с-1), в несколько раз превышающую подвижность электронов в полевых
МОП-транзисторах.
Гетероструктуры на основе SiGe нашли также применение для создания биполярных кремниевых
транзисторов. Дляповышения эффективности работы биполярных транзисторов
является использование материалов с узкой запрещенной зоной в области базы, что
позволяет значительно повысить эффективность работы кремниевой области
эмиттера. Преимущества в данном случае возникают вследствие низких значений
запрещенной зоны в сплавах SiGe (по
сравнению с чистым кремнием). Важно отметить, что механические напряжения в
гетероструктурах также способствуют понижению ширины запрещенной зоны. Кроме
этого, большие разрывы зон позволяют использовать высоколегированные материалы
с низким сопротивлением, что также дает возможность эффективно использовать
кремниевые транзисторы в СВЧ диапазоне.
2. Квантовые
ямы
Часто, особенно в структурах с множественными квантовыми
ямами, желательно было бы иметь дело с примерно симметричными и прямоугольными
ямами, а не с треугольными, типа тех, которые рассматривались в предыдущем
разделе для простых модулированно-легированных гетеропереходов. Пример
реализации такой структуры представлен на рис. 5, а, где показана симметричная
квантовая яма, образованная двумя примыкающими друг к другу (но противоположно
направленными) гетеропереходами на основе рассмотренной выше системы AlGaAs-GaAs.

Рис. 5
Полупроводники с широкой запрещенной зоной ( ) в этой структуре располагаются на краях,
a GaAs - в центральной части. Пусть расстояние между двумя
поверхностями раздела становится достаточно малым. В такой ситуации образуется
практически прямоугольная квантовая яма (рис. 5, б) для дырок и для электронов,
с одинаковой высотой барьера на обеих сторонах, равной показанной на рис. 5, а.
) в этой структуре располагаются на краях,
a GaAs - в центральной части. Пусть расстояние между двумя
поверхностями раздела становится достаточно малым. В такой ситуации образуется
практически прямоугольная квантовая яма (рис. 5, б) для дырок и для электронов,
с одинаковой высотой барьера на обеих сторонах, равной показанной на рис. 5, а.
сверхрешетка квантовая яма наноструктура
Надо отметить, что в такой яме отсутствуют ионизированные доноры,
которые располагаются внутри барьеров  , вследствие чего электроны внутри ямы (возникающие в прилегающем
донорном материале
, вследствие чего электроны внутри ямы (возникающие в прилегающем
донорном материале  ) могут двигаться в яме
) могут двигаться в яме  или канала с очень высокой подвижностью.
Как и в случае модулированно-легированных гетеропереходов, это обстоятельство
может быть использовано для изготовления высокочастотных полевых транзисторов
при создании соответствующих контактов стока и истока.
или канала с очень высокой подвижностью.
Как и в случае модулированно-легированных гетеропереходов, это обстоятельство
может быть использовано для изготовления высокочастотных полевых транзисторов
при создании соответствующих контактов стока и истока.
Структуры из квантовых ям с высокой или низкой подвижностью
электронов могут быть созданы введением в материалы регулируемых количеств
примесей. Например, на основе двойных квантовых ям (с высокой и низкой
подвижностью электронов) могут быть созданы транзисторы с модуляцией скорости,
в которых переключение из одного состояния в другое управляется электрическим
полем, приложенным поперечно к слоям полупроводниковых материалов, в результате
чего происходит перераспределение потока носителей заряда, а значит, и тока
между ямами. Такие транзисторы с модуляцией скорости могут работать при очень
высоких частотах.
Очень трудно найти точные решения системы уравнений для волновых
функций и энергетических уровней электронов и дырок в описываемых системах квантовых
ям, поскольку потенциал дна ямы не является плоским и сильно зависит от
неоднородности границы раздела. Обычно такие задачи решают численно, однако для
описания поведения систем в общих чертах можно воспользоваться теорией
возмущений, рассматривая в качестве возмущения изменения потенциала дна зоны
проводимости. Потенциал возмущения должен иметь симметричный вид, т.е.
представлять собой четную функцию (по переменной z), а получаемые решения должны соответствовать комбинации состояний с
одинаковой четностью. Из этого условия, например, сразу следует, что если мы
предполагаем существование в яме лишь трех уровней, то внутренние связи и
переходы в такой системе могут происходить лишь между первым и третьим
уровнями, а поскольку заселенность уровней зависит от концентрации электронов в
яме, то чаще всего заполненным оказывается лишь первый уровень.
Сигналы, поступающие от отдельной квантовой ямы, обычно настолько
слабы, что их трудно использовать для создания каких-либо твердотельных
приборов, поэтому обычно в оптоэлектронных приборах (например, в фотодиодах)
применяются структуры, формируемые из целых наборов или массивов отдельных
квантовых ям, которые, естественно, получили общее название множественных
квантовых ям (MQW). Имеются два разных типах таких структур.
Если ямы, соответствующие электронам и дыркам, имеют одинаковую
пространственную локализацию (т.е. располагаются в одной и той же области, как
показано на рис.6, а), то соответствующие структуры называют MQW типа I. В том случае, когда эти ямы располагаются
поочередно (как показано на рис.6, б), структуры MQW относят к типу II.
Предполагается, что в MQW-структурах
соседние квантовые ямы не взаимодействуют, поскольку разделяющие их барьеры
являются достаточно протяженными (обычно порядка и больше 10 нм). Однако
иногда, когда стенки барьеров становятся достаточно тонкими, квантовые ямы
оказываются связанными друг с другом процессами туннельных переходов электронов
из одной в другую. Далее будет показано, что при туннельном эффекте дискретные
уровни энергии квантовых ям превращаются в энергетические зоны. Такие ΜQW-структуры (их называют сверхрешетками)
представляют очень большой практический интерес, так как их энергетические
спектры демонстрируют много очень интересных особенностей.
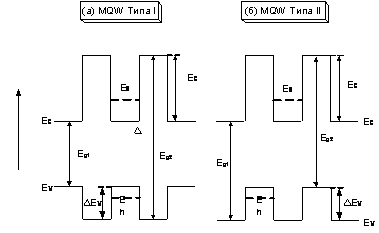
Рис. 7.
Чаще всего в оптоэлектронике изготовляют и применяют MQW структуры, содержащие примерно 50
отдельных квантовых ям. Периодичность такой структуры (ширина ямы + толщина
барьера) составляет около 20 нм, в результате чего полный размер структуры
равен примерно 1 мкм. Это значение обычно и считают пределом толщины, поскольку
в противном случае любое излучение будет в значительной степени поглощаться и
не сможет достигать внутренних квантовых ям. Кроме того, следует учитывать, что
спектр полного оптического сигнала от системы с такими ямами, конечно, не
совпадает точно со спектром отдельной ямы, так как ширина ям не является
абсолютно одинаковой.
ИК-фотодиоды обычно работают на длинах волн в диапазоне 10 мкм,
поэтому, если требуется зафиксировать такое длинноволновое излучение, обычным
объемным полупроводником, то понадобился бы материал с очень малой шириной
запрещенной зоны (-0,1 эВ), вследствие чего гораздо проще зарегистрировать
такие сигналы, возбуждая переходы между подзонами в квантовых ямах. Используя
гетеропереходы для создания таких детекторов, можно не только менять высоту
барьера Ес (варьируя, например, значение χ для структуры /GaAs), но и даже положение энергетических уровней (меняя ширину
ямы). Как показано на рис.7, уровни могут быть рассчитаны таким образом, чтобы
второй уровень располагался лишь чуть ниже нижней границы зоны проводимости материала
с широкой запрещенной зоной (в данном случае
/GaAs), но и даже положение энергетических уровней (меняя ширину
ямы). Как показано на рис.7, уровни могут быть рассчитаны таким образом, чтобы
второй уровень располагался лишь чуть ниже нижней границы зоны проводимости материала
с широкой запрещенной зоной (в данном случае ).
).
Кроме того, легирование полупроводника может осуществляться таким
образом, чтобы уровень n =1 был
заполнен, а уровень n = 2 -
пустым. С учетом всех этих соображений можно создать структуру, где после
попадании в нее фотона с энергией hω (равной Е1 - Е2) высвобождаются
электроны, которые начинают двигаться вдоль оси z под воздействием слабого приложенного электрического поля.
3.
Сверхрешетки
Сама концепция или идея сверхрешеток, предложенная Лео Эсаки
в конце 60-х годов, была реализована позднее с использованием метода
молекулярно-лучевой эпитаксии (МЛЭ). В настоящее время сверхрешетки - один из
важнейших искусственных материалов, созданных человечеством. Они образуются
периодическими наборами MQW, в которых расстояние между отдельными ямами
достаточно мало. По мере уменьшения ширины барьеров возрастает степень
перекрывания волновых функций состояний в ямах из-за туннелирования, вследствие
чего дискретные уровни энергии в ямах уширяются и на их месте возникают
энергетические зоны. Это процесс очень похож на возникновение энергетических
зон из состояний отдельных атомов, помещенных в кристаллическую решетку.
Наиболее важным моментом в создании сверхрешеток выступает возникновение новой
периодичности в материале с периодом d, равным сумме ширины ямы
а и ширины барьера b (обычно значения а и b лежат в диапазоне от 4
до 2 нм соответственно). Рассмотрение процессов возникновения энергетических
зон в сверхрешетках обычно начинают с задачи перекрытия волновых функций
электронов в системе из двух ям. Эта проблема классическая для квантовой
механики, поскольку она многим напоминает задачу об уровнях в двухатомной
молекуле. На рис.8, а показаны две квантовые ямы, соответствующие так
называемой двойной системе связанных квантовых ям, для которой
квантово-механическое решение может быть получено на основе теории возмущений.

Рис. 8.
В соответствии с теорией, при разделении квантовой ямы с заданным
уровнем (Ех) на две разных, с уровнями энергии (как показано
на рис.8, б)
 (4)
(4)
интеграл перекрытия имеет вид
 (5)
(5)
причем два образующихся уровня разделены интервалом 2|V12|, где величина V12 в уравнении (5) является показателем того, насколько одна
яма может воздействовать на уровни в соседней, вследствие чего ее называют
интегралом перекрытия.
Для описания структуры электронных зон в сверхрешетках можно
воспользоваться некоторыми положениями из физики твердого тела, т.е.
представить сверхрешетку кристаллической решеткой и считать потенциалы
квантовых ям аналогами потенциалов атомов в кристалле. В соответствии с этим
можно рассматривать зонную структуру сверхрешеток в рамках двух используемых в
физике твердого тела приближений - модели Кронига - Пенни и приближения сильной
связи соответственно.
Крониг и Пенни [3] предложили в теории твердого тела модель, в
которой электроны двигались в периодическом потенциале из строго прямоугольных
ям (рис. 9), поразительно напоминающем представленный выше потенциал для
сверхрешеток.

Рис. 9.
Предложенный ими периодический одномерный потенциал описывался
следующими параметрами: ширина ямы а, ширина барьера b, высота барьера V0. Периодичность такого потенциала составляла d = а + b. Даже с
учетом явной упрощенности потенциала рис. 10 по сравнению с потенциалами
реальных систем он позволяет получить много очень интересных результатов,
относящихся к структуре уровней, запрещенных зон, размеров зон и др. Для
внутренних областей ямы (0 < z < а),
где V = 0, из уравнения (2.11) можно получить решения для волновых
функций в виде
 (6)
(6)
где
 (7)
(7)
Вследствие эффектов туннелирования волновые функции могут быть
продолжены и внутрь энергетического барьера с высотой VB и шириной b, в результате чего для области (-b < z < 0)
справедливо соотношение
 (8)
(8)
в котором волновой вектор и энергия связаны уравнением
 (9)
(9)
Из условия непрерывности волновых функций и их производных при z = 0 и z = а (переменная по оси z отсчитывается
от левого края ямы) после некоторых преобразований можно получить соотношения
 (10), (11)
(10), (11)
В соответствии с теоремой Блоха, приводящей к уравнению (2.40),
волновые функции в двух разных координатах могут быть связаны как
где k - волновой вектор блоховской волновой
функции. Используя это уравнение для волновых функций, соответствующих яме и
барьеру, можно переписать уравнения (10) и (11) в виде
 (12-13)
(12-13)
Четыре уравнения (10) - (13) для четырех амплитуд (А, В, С, D) могут иметь общее решение лишь при условии равенства нулю
детерминанта коэффициентов, что, после некоторых вычислений приводит к важному
соотношению [4]:
 (14)
(14)
На рис.10 приведены вычисленные значения разрешенных и запрещенных
энергий в сверхрешетке с разрывом зон 0,3 эВ и эффективной массой  , что соответствует системе AlGaAs/GaAs при Ε < V0 [5].
, что соответствует системе AlGaAs/GaAs при Ε < V0 [5].

Рис. 10.
Из представленных зависимостей легко заметить, что при значениях а
выше 10 нм энергии электронов четко определены и соответствуют отдельным
квантовым ямам. Однако как только ширина барьера доходит до или становится ниже
6 нм, ситуация изменяется и в структуре возникают зоны, включая запрещенные. На
рис. 11 представлены наиболее характерные особенности зависимостей (k) для сверхрешеток в рамках модели Кронига - Пенни, которые (после
замены постоянных периода сверхрешеток на привычные постоянные решетки) очень
похожи на кривые для электронов в объемных твердых телах. Параболическая кривая
для свободных электронов разрывается на несколько зон и щелей на границах зон
Бриллюэна при значениях k = +πn/d, как показано на рис. 11 для диаграммы расширенных зон. Часть зон
может быть перенесена в приведенную зону (-n/d < z <+ n/d). Особо
следует отметить, что все происходит таким образом, как будто потенциал
сверхрешетки расщепляет зону квазисвободных электронов твердого тела в центре
приведенной зоны. Поскольку обычно а << d, ширина таких разрешенных и запрещенных
зон в сверхрешетках всегда намного меньше, чем ширина зоны полупроводника,
вследствие чего их часто даже называют мини-зонами и мини-щелями.

Рис. 11.
Такой эффект получил название расщепления зон, так как в
результате отдельные участки зон в расширенной зоне расщепляются на меньшие
зоны со значениями k меньше 2π/α.
Эффект расщепления зон может оказывать принципиальное влияние на
характер прямых и непрямых переходов в полупроводниковых структурах. На рис. 13
представлена энергетическая диаграмма для типичного полупроводника с непрямыми
переходами с минимумом зоны проводимости на краю зоны.
Пусть, есть сверхрешетка из чередующихся монослоев двух типов
полупроводников, обладающих похожими электронными характеристиками и хорошо
согласованными значениями постоянных решеток, и зона проводимости одного из них
имеет вид, показанный на рис. 12. В этом случае, как показано на рисунке
штрихованной линией, минимум зоны проводимости вследствие описанного
расщепления зоны смещается к значению k = 0.
Поэтому данная полупроводниковая структура будет обладать запрещенной зоной с
прямыми оптическими переходами в области k = 0 такой
же ширины, что зона с непрямым переходом.

Рис. 12.
Пользуясь представлением об эффекте расщепления зон, можно
создавать сверхрешетки из GaAs и AlAs, обладающих запрещенными зонами с прямыми
и с непрямыми оптическими переходами, которые будут демонстрировать квазипрямые
оптические переходы.
Еще одним путем развития является создание сверхрешеток из SinGem на основе гетероструктур SiGe. В таких сверхрешетках (обычно они
делаются симметричными, n = m) минимум зоны проводимости кремния вблизи
края зоны может быть приведен в положение k, близким к k=О последовательным расщеплением зон.
Очевидно, при возрастании числа монослоев η поведение такой сверхрешетки будет все больше напоминать
полупроводниковую структуру, обладающую запрещенной зоной с прямыми оптическими
переходами.
Следует особо подчеркнуть, что сверхрешетки находят множество
применений в инфракрасной оптике благодаря малой ширине энергетичесих зон и
щелей, а также квазипрямым оптическим переходам.
Рассмотрим сверхрешетку как набор из N слабосвязанных квантовых
ям, расположенных вдоль оси z (по
аналогии с потенциалами, воздействующими на электроны в твердых телах).
Блоховская волновая функция основного состояния сверхрешетки ψg. s должна
представлять собой линейную комбинацию волновых функций для каждой из квантовых
ям ψ
(z - nd) с потенциальной энергией V (z - nd), где предполагается, что центр каждой из ям располагается точно
при координате z - nd. Такая линейная комбинация записывается в виде

В соответствии с методами приближения сильной связи следует
записать гамильтониан в уравнении Шрёдингера для волновой функции в виде суммы
Н0 + Н1,
где член Н0 относится к одной изолированной
квантовой яме, а Н1 описывает возмущение (в нашем случае это
потенциал, создаваемый всеми остальными ямами). Решая эту задачу с учетом
воздействия ближайших соседей по методу, использованному ранее для вывода
уравнения (2.49), получим формулу
 , (16)
, (16)
из которой следует, что форма зоны описывается синусоидой (рис.
14, а) напоминает аналогичную зависимость для зон в твердых телах [6].
Из уравнения (16) следует, что ширина зоны равна  , т.е. зависит от интеграла переноса t, который вводится для учета
взаимодействия между ближайшими соседями и сам зависит от параметров
сверхрешетки. На рис. 13, б приведена зависимость ширины зоны от ширины барьера
между ямами. Как и следовало ожидать, при значительном увеличении ширины
барьера (т.е. при переходе к t = 0) мы
получаем решение для системы из многих отдельных квантовых ям с отдельными
уровнями энергии.
, т.е. зависит от интеграла переноса t, который вводится для учета
взаимодействия между ближайшими соседями и сам зависит от параметров
сверхрешетки. На рис. 13, б приведена зависимость ширины зоны от ширины барьера
между ямами. Как и следовало ожидать, при значительном увеличении ширины
барьера (т.е. при переходе к t = 0) мы
получаем решение для системы из многих отдельных квантовых ям с отдельными
уровнями энергии.
Необходимо подчеркнуть еще одно важное обстоятельство, связанное с
периодичностью сверхрешетки в z-направлении,
поскольку реальные сверхрешетки являются все же трехмерными структурами.
Поэтому понятно, что выражение для полной энергии должно учитывать
и кинетическую энергию движения электронов в плоскостях (х, у).

Рис. 13, а
С учетом этого полная энергия электронов в i-й подзоне должна складываться из
кинетической энергии и энергии, соответствующей движению поперек плоскости
сверхрешетки.
Полное выражение имеет вид
 (17)
(17)
где нижние индексы kиm относятся к двумерному движению через
поверхность раздела. Функция плотности состояний может быть вычислена методом,
описанным ранее для отдельной квантовой ямы, где был получен множитель  для каждой зоны.
для каждой зоны.

Рис. 13, б
Используя полученное выражение и интегрируя по q от  до
до  , после очевидных вычислений [4] можно
получить выражение для функции плотности состояний в явном виде
, после очевидных вычислений [4] можно
получить выражение для функции плотности состояний в явном виде
 (18)
(18)
На рис. 14. представлена функция плотности состояний для
сверхрешетки и для отдельной квантовой ямы [5]. Для сравнения приведена также
соответствующая функция плотности состояний для трехмерной структуры. Отметим,
что при Ε = Еп (т.е. при значениях энергии, совпадающих с энергией подзон)
функция плотности состояний для сверхрешетки равна половине энергии для
отдельной квантовой ямы. Стоит также подчеркнуть, что по мере возрастания
значения интеграла переноса t отклонение от
спектра квантовой ямы также возрастает.
Рассматриваемые до сих пор сверхрешетки представляли собой лишь
периодические структуры из отдельных квантовых ям, формируемые чередованием
двух полупроводниковых материалов с различными запрещенными зонами. Как
предлагали еще Эсаки и Тцу, существует альтернативный метод получения
сверхрешеток из периодически упорядоченных р-п гомопереходов, когда
разрыв зон отсутствует, так как р - или п-тип материалов
(например, кремния) не приводит к изменению ширины запрещенной зоны.

Рис. 14.
Такой тип структур называется легированными или nipi сверхрешетками. В аббревиатуре nipi буква i означает собственный полупроводник (intrinsic), который в этом случае всегда (даже при
очень малой толщине слоя) разделяет области р - и n-типа проводимости. В некоторых случаях в
системы специально вводят и дополнительные слои собственного полупроводника. В
отличие от сверхрешеток квантовых ям (где пространственное модулирование
электрического потенциала вдоль направления роста достигается за счет разрывов
в зоне проводимости и валентной зоне), структуры nipi позволяют модулировать потенциал вводом ионизированных
доноров или акцепторов, которые и создают заряженные р-п области вблизи
поверхностей контакта.
На рис. 15, а представлена гипотетическая ситуация для р - и
п - областей, в которых доноры и акцепторы ранее не были. Учитывая
электростатику р-п переходов, представляется очевидным, что амплитуда
модуляции Ем зависит от концентрации легирующих атомов (Nd, Nа).
Как легко понять из рис. 16, б, ширина запрещенной зоны для
сверхрешетки (т.е. разность энергий Ес и Еч)
равна разности ширины запрещенной зоны основного вещества ЕG (формирующего гомопереход) и энергии Ем,
т.е.
 (19)
(19)

Рис. 15
Из сказанного ясно, что ширину запрещенной зоны для сверхрешетки
можно регулировать, меняя концентрацию примесей. Из рис.15, б также следует,
что потенциальные ямы для электронов располагаются в n-областях. Вблизи минимума ямы ее потенциал можно аппроксимировать
параболой. Квантование энергии электронов в зоне проводимости можно рассчитать
в рамках модели гармонического осциллятора, пользуясь уравнением (4.11). Из
решения уравнения Пуассона для р-п перехода можно найти значения Еп
для квантовых уровней энергии:
 (20)
(20)
которые зависят от основных характеристик полупроводникового
материала (эффективной массы электронов, диэлектрической постоянной и
концентрации примесей). Из других особенностей сверхрешеток типа nipi следует выделить следующие:
. Подвижность электронов в них обычно ниже, чем в композиционных
сверхрешетках, поскольку носители заряда в них пространственно не разделены с
атомами примесей.
. Оптическое поглощение в них обычно слабее, чем в композиционных,
из-за того, что переходы из валентной зоны в зону проводимости происходят с
меньшей вероятностью, так как электроны и дырки располагаются пространственно
разделены.
. По этой же причине, т.е. вследствие пространственного разделения
неравновесных носителей заряда, их время жизни в сверхрешетках типа nipi существенно превышают привычные значения.
. Сверхрешетки типа nipi
найдут применение при создании оптических вычислительных устройств на основе
квантово-размерного эффекта Штарка.
Литература
1. НИУ
БелГУ, Каф. информационно-телекоммуникационных систем и технологий; сост.: Е.П.
Пеньков, В.Е. Пеньков; рец.: Г.А. Травин, И.А. Сидоренко: Схемотехника для
бакалавров. - Белгород: ПОЛИТЕРРА, 2012
2. НИУ
БелГУ, Каф. информационно-телекоммуникационных систем и технологий; авт. -
сост.: Е.П. Пеньков, В.Е. Пеньков; рец.: Г.А. Травин, В.П. Коновалов: Основы
схемотехники. - Белгород: НИУ БелГУ, 2011
. Ямпурин
Н.П.: Электроника. - М.: Академия, 2011
. Коваленко
А.А.: Основы микроэлектроники. - М.: Академия, 2010
. под
ред. Г.Г. Раннева; рец.: В.Н. Малиновский, В.Л. Шкуратник:
Информационно-измерительная техника и электроника. - М.: Академия, 2009
. Лебедев
А.И.: Физика полупроводниковых приборов. - М.: Физматлит, 2008
. Коваленко
А.А.: Основы микроэлектроники. - М.: Академия, 2006
. Горошков
Б.И.: Электронная техника. - М.: Академия, 2005
. Пасынков
В.В.: Полупроводниковые приборы. - СПб.: Лань, 2002
. Драгунов
В.П.: Основы наноэлектроники. - Новосибирск: НГТУ, 2000
. Ильин
В.И.: Варизонные полупроводники и гетероструктуры. - СПб.: Наука, 2000
. Под
ред. А.Ф. Хохлова: Физика твёрдого тела. - Н. Новгород: ННГУ, 2000
. Под
ред. А.Ф. Хохлова: Физика твёрдого тела. - Н. Новгород: ННГУ, 2000
. Перельман
Б.Л.: Полупроводниковые приборы. - М.: Солон: Микротех, 1996
. Иванов
В.И.: Полупроводниковые приборы. - М.: Энергоатомиздат, 1988
. А.В.
Баюков, А.Б. Гитцевич, А.А. Зайцев и др.; Под общ. ред.Н. Н. Горюнова:
Полупроводниковые приборы. - М.: Энергоатомиздат, 1987