Полупроводниковые квантовые наноструктуры и сверхрешетки
Полупроводниковые
квантовые наноструктуры и сверхрешетки
1. Структуры с квантовым ограничением за
счет внутреннего электрического поля
Ограничение движения электронов (дырок) в
низкоразмерной структуре, приводящее (вследствие их квантово-волновой природы)
к ненулевой минимальной энергии и к дискретности энергии разрешенных состоянии,
называют квантовым ограничением, реализуемым в трех направлениях.
Донорные и акцепторные примеси в
полупроводниках, так же как и гетеропереходы, образованные различными п/п,
индуцируют локальное перераспределение зарядов. Возникшее в результате этого
электрическое поле используют для создания потенциальных барьеров,
ограничивающих движение электронов в наноразмерных областях -
"электронное" формирование наноструктур. Среди структур с квантовым
ограничением, создаваемым внутренним электрическим полем наибольшее
распространение получили квантовые колодцы (ямы), модуляционно-легированные и
дельта-легированные структуры.
1.1 Квантовые ямы
Структура, состоящая из п/п с различной шириной
ЗЗ ΔEg,
в которой наноразмерная область из материала с меньшей ΔEg
находится между областями из материала с большей ΔEg
ведет себя как КЯ для подвижных НЗ. Материал с меньшей ΔEg
образует квантовую яму, а соседние области создают потенциальные барьеры,
играющие для этой ямы роль стенок. Рассмотрим одиночный гетеропереход м/у двумя
п/п А и В. имеющими различную ширину ЗЗ. (рис.1)

В обеих случаях ЗЗ материала В располагается
внутри А, а движение электронов и дырок из В в А ограничено потенциальными
барьерами, высота которых равна соответственно ΔEc
и ΔEv.
В таких структурах электроны и дырки
локализуются в одной области пространства - в слое В (в квантовых ямах).
Д гетеропереходов 2-го типа представлены на
рис.2 (а,б - с перекрывающимися ЗЗ и в,г - с неперекрывающимися).
В первом случае электроны и дырки локализуются в
различных областях (соответственно в слое В и А(рис. 2а) или А и В (рис. 2б)).
Во втором случае электроны валентной зоны одного материала будут
беспрепятственно переходить в зону проводимости другого материала (из А-слоя в
В-слой на рис.2в. и из В-слоя в А-слой на рис.2г).
Возникающее в результате этого
электростатическое поле (диффузионное) исказит зонную диаграмму, а сам
гетеропереход будет эквивалентен гетеропереходу металл-полупроводник.
КЯ являются одним из наиболее важных
элементов большинства наноэлектронных и оптоэлектронных приборов.
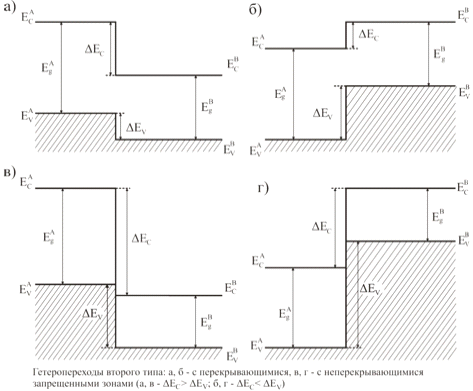
1.2 Модуляционно - легированные
структуры
Традиционный путь создания в п/п-ах областей с
требуемым типом ОНЗ (электроны и дырки) предлагает легирование этих областей
донорными или акцепторными примесями. Когда электроны или дырки покидают
примесные атомы, они оставляют их в ионизированном состоянии. При этом по мере
увеличения концентрации образующихся свободных НЗ их подвижность снижается
из-за усиления рассеяния НЗ на ионизированных примесях за счет кулоновского
взаимодействия с ними. Поэтому необходимость достижения большой концентрации
свободных НЗ вступает в противоречие с возможностью обеспечить их высокую
подвижность. Между тем высокочастотные п/п приборы требуют больших концентрации
НЗ с максимально возможной подвижностью .
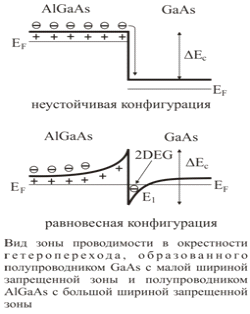
Эта проблема решается в модуляционно- легированных
структурах, в которых область п/п-ка где генерируются НЗ, и область где
осуществляется их перенос, пространственно разделены. Для этого используются
гетероструктуры, образованные п/п с различной шириной запрещенной зоны.
Рассмотрим качественную картину возникновения
электронной наноразмерной ямы на поверхности раздела AlGaAs-GaAS.
Пусть в рассматриваемом гетеропереходе AlGaAs-GAs
слева располагается арсенид галлия, легированный алюминием, а справа - почти
беспримесный материал GaAs.
Такая структура называется гетеропереходом с модулированным легированием
(Рис.3) Очевидно, что зоны являются плоскими, поскольку материал в целом
является электрически нейтральным, а легирование носит однородный характер.
Структура сохраняет свою электрическую
нейтральность до тех пор, пока электроны находятся у своих донорных атомов. Как
только электроны покидают донорные атомы (из-за тепловой активации при
Т>0К), они пересекают границу раздела и переходят в соседнюю область с более
низкой потенциальной энергией.
Там электроны теряют свою энергию и оказываются
захваченными в приграничной области, т.к. не могут преодолеть потенциальный
барьер и вернуться обратно. Эти электроны оказываются пространственно
отделенными от сильно легированной донорной примесью области п/п, откуда они
поступили. Скатившись в потенциальную яму, электроны индуцируют
электростатический потенциал, который (наряду с притяжением положительно
заряженными ионами примеси) "прижимает" их к границе м/у материалами AlGaAs
и GaAs. В результате на
границе гетероперехода для электронов образуется квантовая яма с треугольным
профилем распределения потенциала. Ширина КЯ имеет порядок нескольких
нанометров. В нем энергетические уровни для поперечного (вдоль оси у) движения
электронов оказывается квантованными, как и в прямоугольных КЯ. Заняты только
нижние энергетические уровни. Однако электроны на этих уровнях могут двигаться
в двух других направлениях (x
и z). Каждый такой
уровень представляет собой дно одной из двумерных подзон размерного
квантования. Так в слаболегированном узкозонном п/п у границы гетероперехода
образуется двухмерный электронный газ (2 ДЭГ). Электроны в нем заполняют
делокализованные в двух направлениях состояния.
Для формирования 2ДЭГ достаточно одного
локализованного в поперечном направлении уровня. Модуляционное легирование дает
два важных преимущества:
) электроны оказываются отделенными от донорных
примесей, что ослабевает их рассеяние ионизированными примесями
) у границы гетероперехода образуется двухмерный
электронный газ
Во внешнем электрическом поле электроны в таких
структурах движутся очень быстро из-за малости m*
в GaAs и отсутствия
рассеяния на примесях внутри КЯ.
1.3 Дельта - легированные
структуры
П/П структуру с существенно неравномерным
профилем распределения примеси, характеризующимся локализацией примесных атомов
в очень тонком внутреннем слое (в идеале - в пределах одного монослоя),
называют дельта - легированной (δ - легированной)
структурой. Энергетическая диаграмма на рис.3. Носители заряда в сильно
легированной области связаны кулоновским взаимодействием с пораждающими их
примесными атомами, поэтому они не уходят далеко от области локализации
примесей. Электрическое поле ионизированных примесных атомов экранируется полем
свободных НЗ. Для подвижных носителей образуется V
- образная квантовая яма с пространственным распределением потенциала.
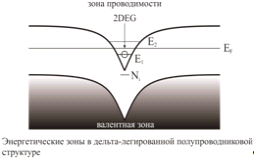
Энергетические состояния в яме квантуются в соответствии
с эффектом квантового ограничения, что приводит к образованию двумерных подзон,
которые заполняются электронами вплоть до высоких концентраций.
Одним из примеров -легированных структур
является структура, содержащая моноатомный слой кремния, нанесенный на
монокристалл GaAs и затем
покрытый эпитаксиальным слоем GaAs.
Донорные атомы Si,
хотя и перераспределяются вследствие диффузии, остаются в окрестности исходного
моноатомного слоя. Область квантового ограничения для электронов составляет
~10нм. Концентрация электронов в двумерном ЭГ достигает высоких значений (~1014см-2),
но ценой уменьшения подвижности.
Структуры, состоящие из периодически
расположенных δ -легированных слоев
с n-типом и р-типом
проводимости в металле с собственной проводимостью (i)
известны как n-i-p-i
структуры. Когда концентрация доноров в n-слое
равна концентрации акцепторов в р-слое, свободные носители заряда не имеют
возможности двигаться в равновесных условиях. Неравновесные же носители заряда,
генерируемые, например, светом, оказываются разделенными внутренним
электрическим полем. Их заряд изменяет энергетическую зонную диаграмму точно
так же, как это происходит в случае равновесных НЗ. Такой же эффект достигается
за счет приложения внешнего смещения к n-и
р-областям. Все это дает возможность эффективно управлять энергетической
диаграммой структуры, что важно для определенных приборных применений.
Баллистический транспорт носителей заряда
Особенности транспорта НЗ в ТТ определяются
процессами их рассеяния при движении из одной области в другую. Электрон,
сталкиваясь с другим электроном или рассеиваясь на колебаниях решетки,
дефектах, границе раздела изменяет свое состояние. Среднее расстояние, которое
электрон проходит между двумя последовательными актами рассеяния называют средней
длиной свободного пробега LL.
В макроскопических средняя длина свободного
пробега электронов LL
намного меньше размера этих систем L
и транспорт осуществляется по диффузионному механизму. В наноструктурах условия
для транспорта НЗ существенно отличаются. В них LL.>L
и перенос НЗ происходит без рассеяния.. Такой перенос называют баллистическим
транспортом. В п/п-ах LL.>L
и электрон пролетает от одного контакта до другого практически без столкновения
с атомами кристаллической решетки(рис.1б ).В металлах LL
не превышает 10 нм (LLм>L)
и перенос в них осуществляется по диффузионному механизму(рис.а).
2. Структуры с квантовым ограничением за счет
внешнего электрического поля
Электрическое смещение п/п структур внешним
напряжением, приложенным ч/з металлический затвор, широко используется для
управления потенциальными барьерами на границах металл-п/п и п/п/диэлектрик.
Полярность на затворе позволяет формировать в п/п области, обогащенные или
обедненные НЗ вблизи этих границ. Размер таких областей существенно зависит от
величины приложенного к затвору напряжения. Электроны или дырки могут
испытывать в них квантовое ограничение. Эти структуры являются
электростатически индуцированными наноразмерными структурами.
.1 Структуры металл/окисел/полупроводник полевых
МОП-транзисторов (MOS
FET)
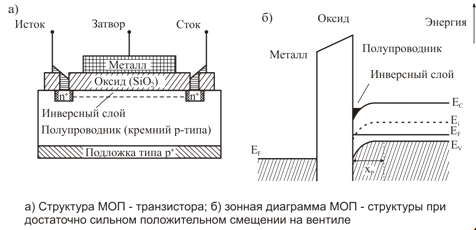
.2 Структуры с расщепленным затвором
Электростатический подход используют также для
того, чтобы "вырезать" квантовые проволоки и точки из двумерного
электронного газа, образующегося, например, при модуляционном и дельта -
легировании. Для этого используют структуры с расщепленным затвором (рис. 5).
Металлические электроды затвора наносят на поверхность п/п со скрытым слоем
двумерного электронного газа. При подачи на них внешнего отрицательного
смещения находящаяся под ними область п/п обедняется электронами. Свободные
электроны остаются только в узкой области, не подверженной воздействию
электрического поля под затвором.
Увеличение обратного смещения на затворе
приводит к расширению обедненной электронами области в окрестности расщепленных
электродов, что дает возможность управлять геометрией индуцированной
низкоразмерной структуры. Конструируя расщепленные электроды соответствующим
образом, можно сформулировать одномерные (полосковыми электродами) или
нульмерные (кольцевыми электродами) структуры. Наиболее эффективно это
получается в модуляционно-легированных образцах. Это связано с тем, что для
обеднения областей имеющих высокую слоевую концентрацию электронов (~ 1013
см-2), необходимо прикладывать напряжения, которые > напряжения
пробоя барьера Шоттки на границе М-П.
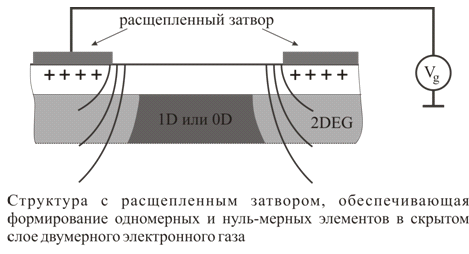
3. Квантовые ямы
.1 Модулированно - легированные КЯ
Очень часто, особенно в структурах с
множественными квантовыми ямами, желательно было бы иметь дело с примерно
симметричными и прямоугольными ямами, а не с треугольными как в модулировано -
и дельта - легированных гетеропереходах. Пример реализации такой структуры
представлен на рис. 6 а, где показана симметричная квантовая яма, образованная
двумя примыкающими друг к другу (но противоположно направленными)
гетеропереходами на основе рассмотренной выше системы AlGaAs
- GaAs. Полупроводники с
широкой запрещенной зоной (AlxGa1-xAs)
в этой структуре располагаются на краях, а GaAs
- в центральной части. Предположим, что расстояние между двумя поверхностями
раздела становится достаточно малым. В такой ситуации образуется практически
прямоугольная квантовая яма (рис. 6. б) для дырок и для электронов, с
одинаковой высотой барьера на обеих сторонах ΔEC
и ΔEV.

Особо следует отметить, что в такой яме отсутствует
ионизированные доноры, которые располагаются внутри барьеров AlGaAs,
вследствие чего электроны внутри ямы (возникающие в прилегающем донорном
материале AlGaAs) могут
двигаться в яме GaAs
или канала с очень высокой подвижностью. Как и в случае модулировано-легированных
гетеропереходов, это обстоятельство может быть использовано для изготовления
высококачественных полевых МОП - транзисторов при создании соответствующих
контактов стока и истока.
Структуры из квантовых ям с высокой или низкой
подвижностью электронов могут быть созданы введением в материалы регулируемых
количеств примесей. Например, на основе двойных квантовых ям (с высокой и
низкой подвижностью электронов) могут быть созданы транзисторы с модуляцией
скорости, в которых переключение из одного состояния в другое управляется
электрическим полем, приложенным поперечно к слоям полупроводниковых
материалов, в результате чего происходит перераспределение потока носителей
заряда, а значит, и тока между ямами. Такие транзисторы с модуляцией скорости
могут работать при очень высоких частотах.
.2 Множественные КЯ
Сигналы, поступающие от отдельной квантовой ямы,
обычно настолько слабы, что их трудно использовать для создания каких либо
твердотельных приборов, поэтому обычно в реальных оптоэлектронных приборах
(например, в фотодетекторах) применяются структуры, формируемые из целых
наборов или массивов отдельных квантовых ям, которые получили общее название
множественных квантовых ям (MQW).
Обычно говорят о двух разных типах таких
структур (рис.7.). Если ямы, соответствующие электронам и дыркам, имеют
одинаковую пространственную локализацию т.е. располагаются в одной и той же
области, как показано на рис. 7 а, то соответствующие структуры называют MQW
типа I. В том случае,
когда эти ямы располагаются поочередно (рис. 7 б), структуры MQW
относят к типу II.
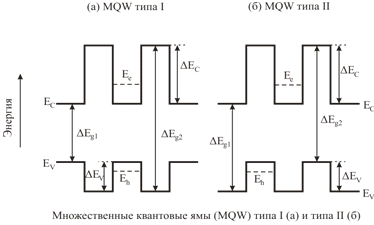
В большинстве случаев предполагается, что в MQW-структурах
соседние квантовые ямы не взаимодействуют, поскольку разделяющие их барьеры
являются достаточно протяженными (~10 нм). Однако иногда, когда стенки барьеров
становятся достаточно тонкими, квантовые ямы оказываются связанными друг с
другом процессами туннельных переходов электронов из одной в другую. Можно
показать, что при туннельном эффекте дискретные уровни энергии квантовых ям
превращаются в энергетические зоны. Такие MQW-структуры
(их принято называть сверхрешетками) представляют очень большой практический
интерес, так как их энергетические спектры демонстрируют много очень интересных
особенностей.
В оптоэлектронике изготавливают и применяют MQW-структуры,
содержащие 50 отдельных КЯ. Период такой структуры (ширина ямы+толщина барьера)
составляет около 20 нм, в результате чего полный размер структуры ~1мкм. Это
значение обычно и считают пределом толщины, т.к. любое излучение будет
поглощаться и не сможет достигать внутренних КЯ.
4. Полупроводниковые сверхрешетки
.1 Сверхрешетки (СР)
квантовый электрический заряд
сверхрешетка
Сверхрешетки - это кристаллические структуры, в
которых кроме периодического потенциала кристаллической решетки имеется другой
периодический потенциал, период которого значительно превышает постоянную
решетки, но соответствует наномасштабам.
Используют два типа полупроводниковых
сверхрешеток: композиционные и легированные.
Композиционные сверхрешетки - это
гетероструктуры из чередующихся слоев различного состава и ширины запрещенной
зоны, но с близкими значениями постоянной решетки. Например, АlxGa1-xAs-GaAs;
InxGa1-xAs-GaAs;
InxGa1-xAs-InP;
ZnS-ZnSe
и др. Здесь дополнительный периодический потенциал создается за счет
периодического изменения ширины запрещенной зоны.
Легированные сверхрешетки - это периодическая
последовательность слоев n-
и р-типа одного и того же полупроводника. Донорные атомы в n-слоях
отдают электроны, которые связываются акцепторными атомами в р-слоях.
Дополнительный периодический потенциал создают чередующиеся заряды
ионизированных акцепторов и доноров. Существуют также сверхрешетки из металлов,
сверхпроводников и диэлектриков.
Дополнительный периодический потенциал
сверхрешетки изменяет зонную структуру исходных полупроводников. Поэтому
сверхрешетку можно рассматривать как новый, синтезированный полупроводник, не
существующий в природе и обладающий необычными свойствами. Подбором материала и
состава чередующихся слоев можно в широких пределах варьировать зонную
структуру сверхрешетки. Совокупность методов получения материалов с
модифицированной зонной структурой лежит в основе так называемой "зонной
инженерии".
.2 Энергетические диаграммы СР
На рис. 8 а. показана энергетическая диаграмма
(потенциальный профиль) композиционной сверхрешетки АlxGa1-xAs-GaAs
в направлении, перпендикулярном слоям. Вследствие периодического изменения
ширины запрещенной зоны ΔЕg=
ЕC1,2-
EV1,2
создается последовательность прямоугольных квантовых ям, разделенных барьерами.
Ямы образуются в узкозонном полупроводнике GaAs:
для электронов - в зоне проводимости, для дырок - в валентной зоне.
На рис 8 б показан потенциальный профиль
модулировано-легированной композиционной сверхрешетки. В рассматриваемом случае
легируется донорной примесью только широкозонный материал. Электроны с донорных
уровней переходят в квантовые ямы, пространственно разделяясь с ионизованными
донорами. Чередование зарядов вызывает периодические изгибы краев зон. На рис.
8 а,б штриховкой показаны минизоны, на которые разбиваются валентная зона и
зона проводимости.


На рис. 9 показан потенциальный профиль
легированной сверхрешетки. Чередующиеся заряды ионизированных доноров и
акцепторов создают последовательность потенциальных ям для электронов и дырок.
Электроны и дырки оказываются пространственно разделенными: дырки находятся в
потенциальных ямах валентной зоны р-слоя, электроны - в потенциальных ямах зоны
проводимости n-слоя. ΔЕg
- ширина запрещенной зоны исходного полупроводника, ΔЕgэф
- эффективная ширина запрещенной зоны сверх решетки. Для получения легированных
сверхрешеток час то используют GaAs.
.3 Свойства электронного газа в СР
В легированных сверхрешетках электроны и дырки
пространственно разделены (рис. 9). Генерируемые светом пары электрон-дырка
(неравновесные носители) также пространственно разделяются, что подавляет
рекомбинацию и увеличивает их время жизни до ~103с.
В модулировано-легированных композиционных
сверхрешетках широкозонный полупроводник (например, AlGaAs)
легируется донорной примесью. Электроны с донорных уровней барьера переходят в
ямы зоны проводимости узкозонного полупроводника (например, GaAs),
(рис. 8.) В барьерах остаются ионизованные доноры (примесные центры), в ямах
образуется 2D
электронный
газ с высокой плотностью и подвижностью электронов.
Высокая подвижность обусловлена тем, что
плотность электронов в узкозонном слое больше плотности центров рассеяния, а
донорные примесные центры заключены в широкозонных слоях. Эффект увеличения
подвижности особенно значителен при низких температурах, когда главный вклад в
рассеяние движущихся электронов вносит их рассеяние на примесях. Высокая
подвижность электронов позволяет создавать на сверхрешетках быстродействующие
приборы, например транзисторы с проводящими каналами, параллельными слоям.
Время переключения таких
.4 Устройства на основе СР транзисторов может
составлять пикосекунды
Сверхрешетки используются в ряде
полупроводниковых приборов, например в лазерах, светодиодах, фотоприемниках, а
также в транзисторах и других устройствах с отрицательным дифференциальным
сопротивлением. Принципы действия подобных приборов основаны на специфических
для сверхрешеток явлениях: квантовом ограничении носителей заряда в
потенциальных ямах, пространственном разделении электронов и дырок (большие
времена жизни неравновесных носителей) или электронов и доноров (высокие
подвижности), резонансном туннелировании; малых временах туннельных переходов,
возможности перестройки энергетического спектра.
Рассмотрим некоторые применения сверхрешеток в
оптоэлектронике. К ним относятся, в частности, ИК - фотоприемники и лазеры.
Инфракрасные фотоприемники.
Фотоприемники предназначены для регистрации и измерения оптических сигналов и
для получения изображений во всех областях спектра, в том числе ИК- и УФ -
диапазонах. Наибольшие средства вкладываются в разработки ИК - фотоприемников,
используемых в аппаратуре и системах наблюдения, ночного видения,
самонаведения, тепловидения и др., а также в волоконно-оптических линиях связи.
Для ИК - фотоприемников используются как легированные сверхрешетки, так и
многослойные гетероструктуры.
Рабочий диапазон легированных сверхрешеток на
основе GaAs - 0,8-1,4
мкм. Слои легируются так, что число доноров в п- слое равно числу акцепторов в
р- слое. При этом в равновесном состоянии практически отсутствуют свободные
носители, и решетка представляет собой полностью обедненный, высокоомный
материал. Квант света

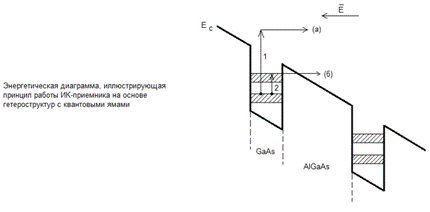
Так как ΔЕgэф
< ΔЕg
то рабочий диапазон λ лежит за
краем поглощения GaAs
в ИК - области; λ можно
изменять с помощью изменения толщины слоев.
Генерируемые светом электроны и дырки сразу
оказываются пространственно разделенными, поэтому рекомбинация подавлена и
время жизни τ велико.
К внешним слоям структуры прикладывается
напряжение, которое "вытягивает" на электроды неравновесные носители,
регистрируя сигнал. Темновой ток мал, так как практически нет равновесных
носителей. Генерируемые электроны при переходе должны туннелировать сквозь
барьер высотой ΔЕg-ΔЕgэф,
что уменьшает вероятность поглощения, но при этом τ.возрастает.
На рис. 9. приведена энергетическая диаграмма
зоны проводимости структуры с квантовыми ямами.. Ширина ям составляет ~ 4 -5
нм, ширина барьеров составляет ~ - 40 - 50 нм. Штриховкой показаны размерные
подзоны. В равновесии электроны занимают нижние подзоны. Барьеры относительно
широкие, туннельных переходов между размерными уровнями ям нет, поэтому ток
через структуру в отсутствие освещения (темновой ток) очень мал.
Освещение вызывает переходы электронов типа 1
или 2 (см. рис. 10), при этом в цепи появляется ток (явление фотопроводимости).
Переход 1 - это переход с основного уровня в свободное состояние над барьером в
зоне проводимости; переход 2 - с основного уровня на возбужденный, с
последующим туннелированием в состояния над барьером (стрелка б на рис.9).
Изменением толщины слоев можно в широких
пределах регулировать спектральные характеристики фотоприемника.
Для тепловизионных систем, работающих в
диапазоне 8-20 мкм, в настоящее время наряду с фотоприемниками на основе CdHgTe
и других материалов используются также детекторы ИК - излучения на основе
многослойных гетероструктур GaAs-AlGaAs
с квантовыми ямами. Тепловидение - это визуализация слабонагретых объектов по
их собственному ИК - излучению. Для тел с температурой, близкой к комнатной,
максимум интенсивности излучения приходится на λ = 10 мкм.
Например, человека в полной темноте можно увидеть на расстоянии ~ 30 м в ручной
тепловизор. Объекты военной техники просматриваются на расстоянии 2-3 км.
Тепловидение может быть широко использовано в авиации, машиностроении,
строительстве, микроэлектронике, медицине, геологии.
Перспективность гетероструктур GaAs-AlGaAs
связана с разработанностью методов формирования тонких слоев, возможностью
обеспечить высокий уровень интеграции фотоприемных элементов и элементов
обработки фотосигнала.
Сверхрешетки в лазерных структурах. Кроме
ИК-фотоприемников, сверхрешетки используются в лазерных структурах - в качестве
активных областей и пассивных элементов (волноводы). Принцип работы
инжекционных лазеров на сверхрешетках такой же, как для ДГС-лазеров на
квантовых ямах. Ступенчатый вид графика плотности состояний (см. тему II
рис. 5) и узкие области локализации носителей, участвующих в генерации,
обеспечивают низкий пороговый ток и высокий КПД лазеров на сверхрешетках и на
квантовых ямах. Если в гетеролазерах на сверхрешетках наращивать слои с
различной концентрацией компонентов, можно получить генерацию излучения
одновременно на нескольких длинах волн λ. Разработан
лазер на четырех активных слоях с четырьмя различными λ.
Сверхрешетки и квантовые ямы имеют более крутой
спад края оптического поглощения, чем исходные полупроводники и классические
ДГС-структуры. Это уменьшает поглощение генерируемого излучения как в активной,
так и в волноводной областях. В лазерах на квантовых ямах сверхрешетки
используются в качестве волноводов. Они обеспечивают профиль показателя
преломления, позволяющий получать оптимальный волноводный эффект. С каждой из
двух сторон активной области располагаются сверхрешетки, содержащие ~200
периодов. Всего в лазере может быть до 1000 слоев.
Особый интерес представляют лазеры на
сверхрешетках и на системах квантовых ям, излучающие в среднем ИК-диапазоне (λ
= 2 - 12 мкм). В диапазоне 2-5 мкм лежат полосы
поглощения многих вредных промышленных газов, и с помощью ИК-лазеров этого
диапазона можно осуществлять контроль выбросов в атмосферу. В спектре
поглощения самой атмосферы имеются "окна прозрачности". Для
тепловидения наиболее важны окна 3-5 мкм и 8-12 мкм. Излучение тел с
температурой 300 К лежит в диапазоне 8-12 мкм. Длины волн излучения современных
ИК-лазеров попадают в окна прозрачности. Эти лазеры могут найти широкое
применение в телекоммуникации и локации.
Создание ИК-лазеров с излучением в нужном
диапазоне волн во многом стало возможным благодаря методам зонной инженерии,
лежащей в основе получения материалов и наноструктур с заданными значениями
ширины (ΔEg)
и эффективной ширины (ΔEgэф)
запрещенной зоны, расстояний между мини-зонами или размерными подзонами. Как
уже говорилось выше, эти величины можно регулировать подбором состава
полупроводниковых соединений, концентрации компонентов состава, ширины и высоты
потенциальных ям и барьеров в наногетероструктурах. Длины волн оптического
излучения определяются перечисленными величинами.