Процессы микро- и нанотехнологии
Министерство
образования и науки Российской Федерации
НОВОСИБИРСКИЙ ГОСУДАРСТВЕННЫЙ
ТЕХНИЧЕСКИЙ УНИВЕРСИТЕТ
ПРОЦЕССЫ
МИКРО-
И
НАНОТЕХНОЛОГИИ
Методическое
руководство
к
лабораторным работам для студентов III курса РЭФ
(направление
210100) заочной и дневной форм обучения
Составитель:
канд. техн. наук В.А. Илюшин
Рецензент:
канд. физ.- мат. наук, доц. Е.А. Макаров
Новосибирск
Лабораторная работа № 1. Химическое травление пластин кремния
химический термический кремний полупроводниковый
Цель работы - практическое освоение технологических приемов химического
травления и контроля качества поверхности пластин кремния.
. Химическое травление полупроводниковых материалов
Большинство процессов или реакций, используемых для получения или
обработки полупроводниковых материалов, являются гетерогенными, т. е. протекают
на границе раздела двух различных фаз. Условия равновесия определяются законом
действующих масс: в равновесном состоянии отношение произведений концентраций
начальных веществ к произведению концентраций конечных веществ - постоянная
величина. Однако при проведении гетерогенных процессов достижение состояния
равновесия часто менее существенно, чем возможность управления кинетикой
процессов, которая определяет производительность процесса и качество
получаемого материала.
Гетерогенные процессы многостадийны. Например, в случае взаимодействия
полупроводникового материала с любым травителем должны наблюдаться следующие
стадии:
) доставка компонентов травителя к поверхности полупроводника;
) адсорбция компонентов травителя поверхностью;
) поверхностная диффузия адсорбированных компонентов и химические
реакции;
) десорбция продуктов реакции;
) удаление десорбированных продуктов от поверхности.
При последовательно протекающих стадиях общая скорость обычно
лимитируется скоростью самой медленно протекающей стадии. Если в какой-либо из
последовательно протекающих стадий имеет место ряд параллельных процессов, то
скорость этой стадии будет определяться наиболее быстрым из них. Для ускорения
процесса в целом необходимо выявить лимитирующую стадию и найти способ ее
интенсификации. При этом произойдет смена лимитирующей стадии.
Таким образом, в гетерогенных системах реакции протекают на границе
раздела фаз и процесс в целом состоит не менее чем из трех этапов. Кинетика
реакции может быть относительно простой, если максимальная скорость одного из
приведенных этапов значительно меньше скорости любого другого. При таком
допущении можно разделить гетерогенные процессы на два основных класса: на
процессы, протекающие в диффузионном режиме, и на процессы, протекающие в
кинетическом режиме. Лимитирующая стадия оказывает влияние не только на
кинетику процесса травления, но и на окончательный результат. Так, если
лимитирующими являются поверхностные процессы, то заметно влияние ориентации
поверхности подложки и ее морфологии.
Жидкостное травление полупроводников может рассматриваться как процесс
окисления поверхности полупроводника с образованием растворимых в травителе
продуктов окисления. Например, при травлении германия перекисью водорода по
реакции
 (1)
(1)
возникающая двуокись германия растворяется в воде с образованием
метагерманиевой кислоты:
 (2)
(2)
Результирующая реакция окисления германия с образованием жидкофазных
продуктов записывается в виде
 (3)
(3)
В
тех случаях, когда образующийся окисел нерастворим в воде, например в случае  , появлющегося при травлении кремния в азотной
кислоте, в состав травителя наряду с окислителем вводят также растворитель
окисла, например фтористоводородную кислоту. Она растворяет
, появлющегося при травлении кремния в азотной
кислоте, в состав травителя наряду с окислителем вводят также растворитель
окисла, например фтористоводородную кислоту. Она растворяет  с образованием жидкофазного соединения
с образованием жидкофазного соединения 
 . (4)
. (4)
В
результате атомы кремния переходят в водный раствор в форме устойчивых
комплексных ионов  , возникающих за счет гидролитической диссоциации
соединения по реакции
, возникающих за счет гидролитической диссоциации
соединения по реакции  .
.
В
этот травитель часто вводят в качестве разбавителя уксусную кислоту. Она
замедляет процесс травления, что облегчает контроль процесса и обеспечивает бóльшую однородность.
Для выяснения общих закономерностей кинетики жидкостного травления
запишем химическую реакцию (3) в обобщенном виде:
 (5)
(5)
Реакция приведена к одному молю жидкого травителя Х. Схематически
процесс травления показан на рис. 1.
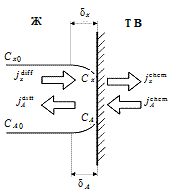
Рис. 1. Распределение в жидкой фазе концентраций травящего компонента Х и
одного из продуктов (А) химической реакции при травлении твердого
вещества s
Будем считать, что процесс травления проходит в три последовательные
стадии:
-
подвод химического травителя  к
поверхности
к
поверхности  (диффузионный поток
(диффузионный поток  );
);
гетерогенная
химическая реакция на поверхности  (химические
потоки
(химические
потоки 


 для всех
участников реакции S, X, A, B,...);
для всех
участников реакции S, X, A, B,...);
отвод
продуктов реакции 
 ... от
поверхности
... от
поверхности  (диффузионные потоки
(диффузионные потоки  ,
,  ,...).
,...).
Относительно быстрые сорбционные процессы на поверхности (адсорбция,
поверхностная миграция, десорбция) включены во вторую стадию.
Для каждого жидкофазного участника реакции плотность диффузионного потока
может быть представлена в виде
 (6)
(6)
где
 - коэффициент массопереноса i-го
компонента в жидкой фазе;
- коэффициент массопереноса i-го
компонента в жидкой фазе;  - коэффициент диффузии;
- коэффициент диффузии;  - толщина диффузионного слоя.
- толщина диффузионного слоя.
В
стационарном режиме травления диффузионный поток должен быть равен химическому
потоку для каждого компонента, тогда

 (7)
(7)

Условие стехиометрии для реакции травления устанавливает следующее
соотношение между химическими потоками:
 (8)
(8)
В соответствии с основным законом химической кинетики
 (9)
(9)
где
 - константа скорости травления.
- константа скорости травления.
Подстановкой
(9) в первое уравнение (7) получаем концентрацию травителя  на реакционной поверхности
на реакционной поверхности  :
:
 (10)
(10)
Формулы
(8)-(10) дают окончательное выражение для плотности потока травления твердого
вещества  :
:
 (11)
(11)
где
введена эффективная константа травления  , такая
что
, такая
что
 (12)
(12)
Чтобы
найти скорость травления, определяемую как  (мкм/мин),
используем соотношение
(мкм/мин),
используем соотношение
 (13)
(13)
где
 - число молекул в единице объема твердого вещества
- число молекул в единице объема твердого вещества  .
.
 (14)
(14)
Воспользовавшись аналогией с электрическими цепями, выражение (11) можно
представить в виде
 (15)
(15)
Подобно
электрическому току, протекающему через сопротивление под действием
электродвижущей силы, поток  создается
заданной концентрацией травителя
создается
заданной концентрацией травителя  в объеме
жидкой фазы, которая играет роль «движущей силы» процесса травления. Система
оказывает сопротивление протеканию потока
в объеме
жидкой фазы, которая играет роль «движущей силы» процесса травления. Система
оказывает сопротивление протеканию потока  ,
складывающееся из диффузионного
,
складывающееся из диффузионного  и
химического
и
химического  сопротивлении. В зависимости от соотношения между
этими сопротивлениями различают диффузионную и кинетическую области процесса
травления.
сопротивлении. В зависимости от соотношения между
этими сопротивлениями различают диффузионную и кинетическую области процесса
травления.
Диффузионная
область травления реализуется при  или
или  В этом
случае из двух последовательных стадий процесса - диффузионного массопереноса и
собственно химической реакции - наиболее медленной (лимитирующей) стадией
является диффузия. Именно она управляет процессом травления в целом, при этом
В этом
случае из двух последовательных стадий процесса - диффузионного массопереноса и
собственно химической реакции - наиболее медленной (лимитирующей) стадией
является диффузия. Именно она управляет процессом травления в целом, при этом  и
и  .
Скорость травления ограничивается скоростью диффузионной доставки молекул
травителя
.
Скорость травления ограничивается скоростью диффузионной доставки молекул
травителя  к реакционной поверхности
к реакционной поверхности  . Поскольку диффузионная константа
. Поскольку диффузионная константа  для жидкой фазы является изотропной, все
кристаллографические грани кристалла и дефекты травятся с одинаковой скоростью,
что обеспечивает достаточно гладкую зеркально полированную поверхность
пластины. Иными словами, в диффузионной области реализуется режим полирующего
травления. Увеличение полирующих свойств травителя может быть достигнуто за
счет усиления неравенства
для жидкой фазы является изотропной, все
кристаллографические грани кристалла и дефекты травятся с одинаковой скоростью,
что обеспечивает достаточно гладкую зеркально полированную поверхность
пластины. Иными словами, в диффузионной области реализуется режим полирующего
травления. Увеличение полирующих свойств травителя может быть достигнуто за
счет усиления неравенства  . Следовательно, введение вязких добавок в травящий
раствор и понижение температуры должны улучшать полирующее действие травителя
за счет снижения коэффициента диффузии
. Следовательно, введение вязких добавок в травящий
раствор и понижение температуры должны улучшать полирующее действие травителя
за счет снижения коэффициента диффузии  , в то
время как интенсивное перемешивание раствора может оказать обратное действие в
результате уменьшения эффективной толщины диффузионного слоя
, в то
время как интенсивное перемешивание раствора может оказать обратное действие в
результате уменьшения эффективной толщины диффузионного слоя  .
.
Кинетическая
область травления реализуется при  или
или  . В этом случае
из двух стадий процесса наиболее медленной (лимитирующей) стадией является
собственно химическая реакция, при этом
. В этом случае
из двух стадий процесса наиболее медленной (лимитирующей) стадией является
собственно химическая реакция, при этом  и
и  . Процесс травления протекает в кинетической области,
так как его скорость ограничивается скоростью химической реакции, а быстрая
диффузионная доставка молекул травителя
. Процесс травления протекает в кинетической области,
так как его скорость ограничивается скоростью химической реакции, а быстрая
диффузионная доставка молекул травителя  обеспечивает
практически постоянную их концентрацию на поверхности
обеспечивает
практически постоянную их концентрацию на поверхности  , равную
, равную  . Так как
константа травления
. Так как
константа травления  чувствительна к дефектности поверхности и имеет
различные значения для разных граней кристалла, для кинетической области
протекания процесса характерно селективное и анизотропное травление.
чувствительна к дефектности поверхности и имеет
различные значения для разных граней кристалла, для кинетической области
протекания процесса характерно селективное и анизотропное травление.
Селективность
травления проявляется в преимущественном вытравливании дефектных мест на
поверхности в форме ямок травления (например, в районе выходов дислокаций).
Здесь активационный барьер для константы  понижен,
что увеличивает локальную скорость травления. Анизотропность травления связана
с различной скоростью травления разных кристаллографических граней,
характеризуемых различными индексами Миллера. Обычно (например, для Si и GaAs)
выполняются неравенства
понижен,
что увеличивает локальную скорость травления. Анизотропность травления связана
с различной скоростью травления разных кристаллографических граней,
характеризуемых различными индексами Миллера. Обычно (например, для Si и GaAs)
выполняются неравенства  . В результате этого даже на бездефектных
поверхностях, ориентированных по плоскостям {100} или {111}, при локальном
травлении через специальные окна в защитной маске можно получить профилированные
углубления, ограниченные плоскостями, характеризующимися малыми скоростями
травления.
. В результате этого даже на бездефектных
поверхностях, ориентированных по плоскостям {100} или {111}, при локальном
травлении через специальные окна в защитной маске можно получить профилированные
углубления, ограниченные плоскостями, характеризующимися малыми скоростями
травления.
. Порядок выполнения работы
Получить у преподавателя пластины кремния, пинцет, резиновые перчатки.
Ознакомиться с рабочим местом: оборудованием, приборами, приспособлениями,
инструментом, материалами.
Все работы с использованием травителей выполнять в резиновых
перчатках в вытяжном шкафу при включенной вытяжной вентиляции.
1.
Знакомство с видом поверхности пластин после резки, шлифовки, полировки.
.1. Рассмотреть в светлом поле микроскопа МБИ-6 (или БИОЛАМ-М, МЕТАМ)
пластины кремния после резки слитка, после шлифовки и после полировки.
.2. Описать в отчете особенности внешнего вида каждой пластины.
2.
Исследование воздействия травителя CP4A на пластины кремния.
2.1. Рассмотреть в светлом поле микроскопа шлифованную и полированную
пластинки кремния. Отметить различие их внешнего вида.
.2. Поместить обе пластинки во фторопластовый стакан, налить травитель
CP4A в минимальном количестве так, чтобы пластинки были покрыты травителем,
выдержать 2 мин. Затем, не извлекая пластинок, травитель аккуратно слить в
слив, набрать проточной воды, слить ее, снова набрать и слить.
.3. Осушить пластинки на бумажном фильтре и вновь рассмотреть их под
микроскопом. Описать в отчете изменение внешнего вида пластинок.
3. Определение зависимости скорости травления от времени.
.1. Измерить толщину второй шлифованной пластинки при помощи индикатора.
.2. Поместить пластинку в стакан, залить в него травитель состава 15:2:5
так, чтобы травитель только покрывал пластинку, и выдержать в течение 2 мин.
.3. Вынуть пластинку из травителя фторопластовым пинцетом, поместить в
стакан с проточной водой и промыть несколько раз, набирая и сливая воду.
.4. Осушить пластинку на бумажном фильтре, измерить ее толщину
индикатором и определить скорость травления по формуле

где
 - толщина пластинки до травления;
- толщина пластинки до травления;  - толщина пластинки после травления;
- толщина пластинки после травления;  - время травления.
- время травления.
.5.
Поместить эту же пластинку в тот же травитель и выдержать в нем 4 мин.
3.6. Повторить пп. 3.3 и 3.4.
.7. Повторить пп. 3.3 - 3.5 еще два раза, после чего слить травитель в
слив, промыть стаканчик в потоке воды.
.8. Построить диаграмму зависимости скорости травления от времени.
4. Определение зависимости скорости травления от состава
травителя.
4.1. Измерить индикатором толщину полированной пластинки.
.2. Поместить пластинку в стакан, налить в него травитель состава 1:9
так, чтобы травитель только покрывал пластинку, и выдержать в течение 10 с.
Затем слить травитель в слив и промыть пластинку 2-4 раза, набирая и сливая из
стакана воду.
.3. Осушить пластинку на бумажном фильтре, измерить ее толщину
индикатором и определить скорость травления по формуле, приведенной в п. 3.4.
.4. Повторить пп. 4.1 - 4.3, используя травитель 1:4 и другую пластинку
(полированную).
.5. Повторить пп. 4.1 - 4.3, используя травитель 1:1 и третью
полированную пластинку.
.6. Повторить пп. 4.1 - 4.3, используя травитель 4:1 и четвертую
полированную пластинку.
.6. Построить график зависимости скорости травления от содержания азотной
кислоты в травителе.
5. Оценка влияния перемешивания травителя.
5.1. Измерить индикатором толщину полированной пластинки.
.2. Поместить пластинку в стакан, налить в него травитель состава 15:2:5
так, чтобы травитель только покрывал пластинку, и выдержать в течение 3 мин,
слить травитель в слив, пластинку в стаканчике промыть в протоке воды,
несколько раз набирая и сливая воду.
.3. Осушить пластинку на бумажном фильтре, измерить ее толщину
индикатором и определить скорость травления по формуле, приведенной в п. 3.4.
.4. Повторить пп. 5.1 - 5.3 с другой полированной пластинкой. При
травлении стакан с пластиной и должен вращаться в приспособлении для вращения.
.5. Объяснить в отчете наблюдаемые различия.
6. Оценка чистоты поверхности пластины по светящимся точкам.
6.1. Рассмотреть круглую полированную пластину в светлом и темном полях
микроскопа МБИ-6.
.2. Подсчитать количество светящихся точек в поле зрения микроскопа.
.3. Поместить пластину в стакан, налить из колбы дистиллированной воды,
промыть поверхность пластины кистью, высушить пластину в центрифуге (по
инструкции).
.4. Повторить пп. 6.1 и 6.2.
.5. Записать в отчете результаты. Объяснить различия пп. 6.2 и 6.4.
Оборудование, приборы, инструмент, оснастка, материалы
. Шкаф вытяжной 2Ш-НЖ.
. Установка очистки и сушки пластин с центрифугой.
. Микроскоп МБИ-6, Микроскоп Метам-Р.
. Секундомер электронный.
. Индикатор - измеритель толщины.
. Приспособление для вращения.
. Пинцет металлический.
. Пинцет фторопластовый.
. Кисть беличья.
. Перчатки резиновые.
. Стакан фторопластовый.
. Пластины кремниевые.
. Шлифованные и полированные пластинки кремния с площадью поверхности ~1
кв. см.
. Фильтры бумажные.
. Вода дистиллированная.
. Вода водопроводная.
Состав применяемых травителей
|
Травитель
|
Количество объемных частей
кислоты
|
|
Азотная
|
Фтористоводородная
|
Уксусная
|
|
CP-4A
|
5
|
3
|
3
|
|
1:9
|
1
|
9
|
-
|
|
1:4
|
1
|
4
|
-
|
|
1:1
|
1
|
1
|
-
|
|
4:1
|
4
|
1
|
-
|
|
15:2:5
|
15
|
2
|
5
|
Контрольные вопросы
1. В чем заключается цель работы?
. Каковы роль и цели химической обработки полупроводниковых
пластин в производстве полупроводниковых приборов и интегральных схем?
. Назовите особенности диффузионного и кинетического режимов
протекания гетерогенного процесса.
. При каких условиях реализуются селективный и полирующий режимы
травления?
. Какие травители используются для травления кремния?
6. Каким
образом свойства травителя  зависят
от относительного содержания компонентов?
зависят
от относительного содержания компонентов?
. Какие
факторы влияют на скорость травления?
. Объясните
полученные в пп. 2 -5 результаты.
Лабораторная работа № 2. Термическое окисление кремниевых
пластин в сухом и влажном кислороде
Цель работы - ознакомиться с технологией и освоить процесс термического
окисления кремния в атмосфере «сухого» и «влажного» кислорода.
1. Применение пленок диоксида кремния в технологии
интегральных схем
Диоксид кремния - одно из повсеместно встречающихся веществ.
Кристаллический диоксид кремния, существующий в нескольких формах: кварц,
кристобалит, тридимит - важная составляющая очень многих полезных ископаемых и
драгоценных камней. Песок, состоящий главным образом из кварца, служит основой
для производства стекла (обычно с добавлением оксида натрия для понижения
температуры плавления). Развитие планарной технологии электроники и современной
промышленности интегральных схем повлекло за собой открытие уникальных свойств
диоксида кремния:
материал устойчив в воде;
при высоких температурах является превосходным электрическим изолятором;
способен к формированию почти совершенной электрической границы раздела с
подложкой.
В
диоксиде кремния удачно сочетаются такие качества, как высокая химическая
стойкость в окислительной среде и склонность к стеклообразованию,
способствующая формированию беспористых пленок. Он легко растворяется в
плавиковой кислоте  . Это дает возможность изготовления из
. Это дает возможность изготовления из  масок с использованием технологии фотолитографии. В
то же время по отношению к смеси
масок с использованием технологии фотолитографии. В
то же время по отношению к смеси  такие
маски из диоксида кремния практически стабильны, что позволяет использовать их
при селективном травлении кремния. Кроме того, маски из диоксида кремния
применяются при проведении диффузионного или ионно-лучевого легирования,
обеспечивая локальное по поверхности легирование только не защищенных маской
участков подложки. Другой важной функцией, которую выполняют слои
такие
маски из диоксида кремния практически стабильны, что позволяет использовать их
при селективном травлении кремния. Кроме того, маски из диоксида кремния
применяются при проведении диффузионного или ионно-лучевого легирования,
обеспечивая локальное по поверхности легирование только не защищенных маской
участков подложки. Другой важной функцией, которую выполняют слои  на поверхности кремниевой подложки, является защита р-n-переходов,
активных и пассивных элементов интегральной схемы. Кроме перечисленных
применений, слои
на поверхности кремниевой подложки, является защита р-n-переходов,
активных и пассивных элементов интегральной схемы. Кроме перечисленных
применений, слои  служат изолирующим основанием для контактных площадок
и проводящих коммутирующих металлических соединений.
служат изолирующим основанием для контактных площадок
и проводящих коммутирующих металлических соединений.
Пленки
 на кремнии могут быть получены термическим или
катодным распылением кремния в разреженной кислородной атмосфере, катодным
распылением диоксида кремния, различными методами химического осаждения из
газовой фазы (пиролизом силана или кремнийорганических соединений в
окислительной атмосфере, гидролизом галогенидов кремния). К методам собственно
окисления кремния относится электрохимическое (анодное) оксидирование, а также
окисление в кислородной плазме тлеющего разряда при относительно низких
температурах (порядка 300...400 °С). В этой лабораторной работе пленки
на кремнии могут быть получены термическим или
катодным распылением кремния в разреженной кислородной атмосфере, катодным
распылением диоксида кремния, различными методами химического осаждения из
газовой фазы (пиролизом силана или кремнийорганических соединений в
окислительной атмосфере, гидролизом галогенидов кремния). К методам собственно
окисления кремния относится электрохимическое (анодное) оксидирование, а также
окисление в кислородной плазме тлеющего разряда при относительно низких
температурах (порядка 300...400 °С). В этой лабораторной работе пленки  получаются методом термического окисления кремния.
Такие пленки используются, например, в качестве подзатворного диэлектрика в
технологии изготовления интегральных схем металл -окисел - полупроводник (МОП).
получаются методом термического окисления кремния.
Такие пленки используются, например, в качестве подзатворного диэлектрика в
технологии изготовления интегральных схем металл -окисел - полупроводник (МОП).
Структурное
качество пленок термического  определяется
содержанием микродефектов трех видов: 1) пор, причинами которых могут быть
загрязнения или дефекты на окисляемой поверхности кремния; 2) границ
кристаллов, возникающих вследствие склонности стеклообразной пленки к
рекристаллизации; 3) микротрещин, формирующиеся из-за несоответствия
коэффициентов термического расширения подложки и пленки. Наличие дефектов
осложняет использование оксидной пленки в качестве маскирующего, изолирующего
или пассивирующего слоя (поскольку поры являются каналами для диффузии, снижают
пороговое напряжение пробоя вследствие возможных замыканий, не обеспечивают
герметичность структуры).
определяется
содержанием микродефектов трех видов: 1) пор, причинами которых могут быть
загрязнения или дефекты на окисляемой поверхности кремния; 2) границ
кристаллов, возникающих вследствие склонности стеклообразной пленки к
рекристаллизации; 3) микротрещин, формирующиеся из-за несоответствия
коэффициентов термического расширения подложки и пленки. Наличие дефектов
осложняет использование оксидной пленки в качестве маскирующего, изолирующего
или пассивирующего слоя (поскольку поры являются каналами для диффузии, снижают
пороговое напряжение пробоя вследствие возможных замыканий, не обеспечивают
герметичность структуры).
Некоторые
важнейшие свойства  :
:
плотность
2,0...2,3 г/см3;
ширина
запрещенной зоны больше 8 эВ;
электрическая
проводимость изменяется в широких пределах: поле пробоя больше  В/см в термическом
В/см в термическом  и около
и около  В/см в
В/см в  ,
полученном химическим осаждением из газовой фазы;
,
полученном химическим осаждением из газовой фазы;
теплопроводность
 Вт/(см
Вт/(см K) (в
объеме);
K) (в
объеме);
коэффициент
диффузии  см
см /с (в
объеме);
/с (в
объеме);
коэффициент
термического расширения  1/K;
1/K;
коэффициент
преломления  (термический оксид);
(термический оксид);
относительная
диэлектрическая проницаемость  .
.
2. Кинетика высокотемпературного окисления кремния
Окисление поверхности кремния принято осуществлять с помощью следующих
химических реакций:
 ,
,

при температуре в интервале 900...1200 °C. Окисление может производиться в сухом кислороде по
первой реакции, в парах воды - по второй реакции, либо во влажном кислороде - с
использованием обеих реакций. Наиболее качественные пленки получаются при
окислении в сухом кислороде, тогда как окисление в парах воды обеспечивает
наибольшую скорость формирования пленки. Часто применяется комбинированное
окисление: сначала в сухом кислороде формируется совершенная граница раздела с
минимальной плотностью поверхностных состояний, затем в увлажненном кислороде
толщина пленки доводится до требуемого значения. Возможно уплотнение полученной
таким образом пленки при окислении на заключительной стадии в сухом кислороде.
Схематически
процесс окисления изображен на рис. 2. Собственно окисление происходит на
внутренней границе  . В процессе можно выделить три основные стадии,
протекающие последовательно.
. В процессе можно выделить три основные стадии,
протекающие последовательно.
. Диффузионный
перенос частиц окислителя из объема газовой фазы на внешнюю поверхность  и растворение окислителя в приповерхностном слое
диоксида кремния.
и растворение окислителя в приповерхностном слое
диоксида кремния.

Рис. 2. Распределение молекул окислителя в газовой фазе и в растущем слое SiO2 в процессе окисления кремния
2. Диффузионный
перенос частиц окислителя через пленку  к
границе раздела диоксид-кремний.
к
границе раздела диоксид-кремний.
. Химическая
реакция на границе раздела с кремнием, приводящая к образованию  .
.
Введем
обозначения: - поток окислителя, определяемый как количество
молекул окислителя, пересекающих единичную площадь одной из границ раздела фаз
в единицу времени;
- поток окислителя, определяемый как количество
молекул окислителя, пересекающих единичную площадь одной из границ раздела фаз
в единицу времени;  - концентрация молекул окислителя на одной из границ
раздела системы
- концентрация молекул окислителя на одной из границ
раздела системы  ,
,  -
толщина слоя диоксида. Трем стадиям процесса окисления соответствуют потоки
-
толщина слоя диоксида. Трем стадиям процесса окисления соответствуют потоки  , которые в стационарных условиях должны быть равными
, которые в стационарных условиях должны быть равными

В
промышленных условиях для процесса термического окисления кремния используется
принудительный поток окислителя, проходящий через рабочую камеру с определенной
скоростью. Внутри газовой фазы концентрация молекул окислителя соответствует
парциальному давлению  В процессе роста
В процессе роста  происходит
непрерывное растворение молекул окислителя в окисле, сопровождающееся
обеднением приповерхностной области газа этими молекулами. По этой причине
концентрация молекул окислителя на границе раздела фаз при
происходит
непрерывное растворение молекул окислителя в окисле, сопровождающееся
обеднением приповерхностной области газа этими молекулами. По этой причине
концентрация молекул окислителя на границе раздела фаз при  всегда меньше, чем в объеме газовой фазы. В
приповерхностном диффузионном слое толщиной
всегда меньше, чем в объеме газовой фазы. В
приповерхностном диффузионном слое толщиной  возникает
градиент концентрации молекул окислителя, который создает диффузионный поток
окислителя по направлению к границе, определяемый выражением
возникает
градиент концентрации молекул окислителя, который создает диффузионный поток
окислителя по направлению к границе, определяемый выражением 
 ,
,
где
 - константа скорости газообразного массопереноса
окислителя;
- константа скорости газообразного массопереноса
окислителя;  - коэффициент диффузии окислителя в газовой фазе;
- коэффициент диффузии окислителя в газовой фазе;  и
и  -
равновесная концентрация окислителя в объеме газовой фазы и концентрация
окислителя в газовой фазе у поверхности оксида соответственно. В случае
ламинарного потока окислителя можно принять, что
-
равновесная концентрация окислителя в объеме газовой фазы и концентрация
окислителя в газовой фазе у поверхности оксида соответственно. В случае
ламинарного потока окислителя можно принять, что  где
где  . Окислитель, адсорбированный поверхностью оксида,
растворяется в
. Окислитель, адсорбированный поверхностью оксида,
растворяется в  . Соотношение между концентрациями окислителя в
газовой
. Соотношение между концентрациями окислителя в
газовой  и твердой
и твердой  фазах
устанавливается коэффициентом распределения. Движущей силой процесса
растворения является градиент концентраций, поэтому может быть введен
соответствующий ему поток растворителя
фазах
устанавливается коэффициентом распределения. Движущей силой процесса
растворения является градиент концентраций, поэтому может быть введен
соответствующий ему поток растворителя

равный
 , однако, поскольку процесс растворения не был выделен
в отдельную стадию, а включен в первую, необходимо поток
, однако, поскольку процесс растворения не был выделен
в отдельную стадию, а включен в первую, необходимо поток  выразить через
выразить через  . Процесс
растворения подчиняется закону Генри. Поэтому
. Процесс
растворения подчиняется закону Генри. Поэтому

где
 - коэффициент растворимости молекул окислителя в
диоксиде кремния;
- коэффициент растворимости молекул окислителя в
диоксиде кремния;  - парциальное давление окислителя при
- парциальное давление окислителя при  . Очевидно, что должно быть верным и уравнение
. Очевидно, что должно быть верным и уравнение

Введенная
формально величина  определяет концентрацию растворенных в
определяет концентрацию растворенных в  молекул окислителя, если в законе Генри вместо
давления
молекул окислителя, если в законе Генри вместо
давления  подставить
подставить  . Тогда
. Тогда

где
 - коэффициент массопереноса молекул окислителя в
газовой фазе, приведенный к твердой фазе.
- коэффициент массопереноса молекул окислителя в
газовой фазе, приведенный к твердой фазе.
В
стационарном режиме производная по времени в диффузионном уравнении равна нулю.
Следовательно, и  . Тогда концентрация окислителя линейно зависит от
. Тогда концентрация окислителя линейно зависит от  . Диффузионный поток окислителя от поверхности
диоксида к границе раздела диоксид-кремний
. Диффузионный поток окислителя от поверхности
диоксида к границе раздела диоксид-кремний

где
 - концентрация молекул окислителя на границе раздела
диоксид-кремний;
- концентрация молекул окислителя на границе раздела
диоксид-кремний;  - коэффициент диффузии окислителя в
- коэффициент диффузии окислителя в  .
.
Химический
поток  следует понимать как убыль молекул окислителя
вследствие их превращения в молекулы
следует понимать как убыль молекул окислителя
вследствие их превращения в молекулы  .
Скорость реакции окисления пропорциональна концентрации окислителя, поэтому
.
Скорость реакции окисления пропорциональна концентрации окислителя, поэтому

где
 - константа скорости реакции окисления.
- константа скорости реакции окисления.
В
стационарном режиме окисления концентрации не зависят от времени и все потоки
равны  :
:

Решение
этой системы относительно неизвестных  и
и  дает
дает
 ,
,

Скорость
роста слоя  определяется величиной химического потока
определяется величиной химического потока  . За время
. За время  на
единицу площади поверхности кремния посту-пает количество молекул окислителя,
равное
на
единицу площади поверхности кремния посту-пает количество молекул окислителя,
равное  В результате этого толщина слоя
В результате этого толщина слоя  увеличивается на величину, поэтому
увеличивается на величину, поэтому

где
 - число молекул окислителя, необходимое для
формирования единицы объема
- число молекул окислителя, необходимое для
формирования единицы объема  . В
единице объема диоксида кремния содержится
. В
единице объема диоксида кремния содержится  молекул
молекул  , где
, где  г/см
г/см - массовая плотность
- массовая плотность  ,
,  г/моль - молярная масса
г/моль - молярная масса  ,
,  моль
моль - число
Авогадро. Приведенные значения дают
- число
Авогадро. Приведенные значения дают  см
см , тогда
, тогда  см
см для окисления в сухом кислороде и
для окисления в сухом кислороде и  см
см для
окисления в парах воды.
для
окисления в парах воды.
Дифференциальное
уравнение для нахождения 

После
разделения переменных и интегрирования с граничным условием  получаем
получаем

где
 и
и  .
.
Это
уравнение имеет единственный неотрицательный корень

Проведем анализ данного решения для двух частных случаев.
1.
Начальная стадия роста, когда  а
а  Воспользуемся соотношением
Воспользуемся соотношением  при
при  . Тогда
. Тогда

Этой стадии соответствует линейный по времени закон роста.
 .
.
Обычно
 . Это означает, что лимитирующей стадией,
ограничивающей скорость роста диоксида, является химическая реакция, и процесс
окисления протекает в кинетической области. В этом случае константа линейного
роста
. Это означает, что лимитирующей стадией,
ограничивающей скорость роста диоксида, является химическая реакция, и процесс
окисления протекает в кинетической области. В этом случае константа линейного
роста  пропорциональна парциальному давлению
пропорциональна парциальному давлению  окислителя в газовой фазе, коэффициенту растворимости
окислителя в газовой фазе, коэффициенту растворимости
 молекул окислителя в диоксиде кремния и не зависит от
коэффициента диффузии
молекул окислителя в диоксиде кремния и не зависит от
коэффициента диффузии  :
:

Таким образом,

Отметим,
что скорость роста линейно возрастает с увеличением давления окислителя. С
увеличением температуры молекулярная растворимость газов, как правило, падает
по экспоненциальному закону, однако этот спад компенсируется увеличением
константы скорости реакции  и
константа скорости линейного роста
и
константа скорости линейного роста  с ростом
температуры всегда увеличивается.
с ростом
температуры всегда увеличивается.
На
поверхности кремния всегда присутствует естественный окисел толщиной  3...5 нм. Для учета этого окисла необходимо изменить
граничное условие
3...5 нм. Для учета этого окисла необходимо изменить
граничное условие  . В этом случае решение дифференциального уравнения
для начальной стадии роста имеет вид
. В этом случае решение дифференциального уравнения
для начальной стадии роста имеет вид  , где
, где  Влияние этого параметра заметно только в начальный
момент окисления.
Влияние этого параметра заметно только в начальный
момент окисления.
.
Конечная стадия роста, когда  а
а  В этом случае
В этом случае

где
 - коэффициент проницаемости диоксида кремния
молекулами окислителя;
- коэффициент проницаемости диоксида кремния
молекулами окислителя;  - коэффициент растворимости молекул окислителя в
диоксиде кремния;
- коэффициент растворимости молекул окислителя в
диоксиде кремния;  - коэффициент диффузии окислителя в
- коэффициент диффузии окислителя в  . Поскольку
. Поскольку
 ,
,
рост на данной стадии называется параболическим.


Температурная
зависимость  определяет влияние температуры на процесс
параболического роста
определяет влияние температуры на процесс
параболического роста  . Как и
. Как и  , с
ростом температуры
, с
ростом температуры  всегда увеличивается. Константа параболического роста
не включает константу скорости химической реакции, поэтому процесс роста на
конечной стадии протекает в диффузионной области. Лимитирующей стадией является
процесс массопереноса через слой
всегда увеличивается. Константа параболического роста
не включает константу скорости химической реакции, поэтому процесс роста на
конечной стадии протекает в диффузионной области. Лимитирующей стадией является
процесс массопереноса через слой  . С
увеличением парциального давления
. С
увеличением парциального давления  константа
константа
 возрастает как
возрастает как  .
.
Зависимость толщины пленки диоксида от времени представлена графически на
рис. 3. Область I соответствует кинетическому режиму окисления, область II -
диффузионному, область III - диффузионно-кинетическому. В последнем случае
скорости диффузионного массопереноса и химической реакции сравнимы.
3. Технология термического окисления кремния
Установка для термического окисления кремния - четырехтрубная печь
горизонтального типа с газораспределительной системой, включающей кислородный
баллон с редуктором, трубопроводы, краны и ротаметры. Окисление производится в
двух реакторах (кварцевые трубы) одновременно. Через одну из труб пропускают
поток сухого кислорода, через другую - влажного. Во втором случае газовый поток
для насыщения парами воды пропускают через барботер, поддерживаемый при
температуре 90... 100 °С. Газовые потоки контролируют ротаметрами. Пластины
кремния помещают в реакторы в вертикальном положении перпендикулярно к потоку
газа. Температуру окисления контролируют термопарой.
. Порядок выполнения работы
1. Получить у преподавателя необходимые приборы и инструменты.
Диффузионная печь заранее подготовлена к проведению лабораторной работы
преподавателем или лаборантом. Запрещается включать и выключать оборудование,
изменять режим работы диффузионной печи, регулировать газовые потоки. Студенты
выполняют только операции, указанные в настоящем перечне.
. Произвести измерение температур в каналах диффузионной печи.
Убедиться, что разность температур составляет не более 5 °C. Для проведения измерений извлечь
термопару из контейнера, подключить к клеммам милливольтметра и поместить поочередно
в каждый канал. Считывание показаний милливольтметра производить после
установления стационарного состояния (через 3...5 мин). После проведения
измерений термопару немедленно поместить обратно в контейнер.
Соблюдайте осторожность. Температура кварцевого чехла термопары близка к
1000 °C. По калибровочной таблице термопары
определить температуры в каналах.
. Пинцетом поместить кремниевые пластины вертикально в кварцевые
лодочки по 4 шт. в каждую. Одну лодочку поместить в канал окисления в сухом, другую
- в канал окисления во влажном кислороде. Кварцевой штангой медленно (3 мин)
переместить лодочки в центральные области каналов. Штангу убрать в контейнер.
Запустить таймер.
. Через 20 мин кварцевой штангой переместить лодочки из
центральной части каналов к краям. Убрать штангу в контейнер. Пинцетом снять по
одной пластине с каждой лодочки и поместить в металлические контейнеры, так как
пластины горячие. Кварцевой штангой переместить лодочки в центральную область
каналов. Убрать штангу в контейнер.
. Повторить п. 4 еще три раза.
. Определить толщину пленок диоксида кремния. Для этого
химическим травлением сформировать в слоях диоксида ступеньки с клиновидным
профилем: нанести фторопластовой палочкой каплю концентрированной плавиковой
кислоты на край окисленной пластины кремния. Кислота смачивает поверхность
оксида и не смачивает поверхность кремния. В момент изменения типа смачивания
смыть кислоту водой. Высушить пластины бумажными фильтрами. Толщину определять
по цвету оксида при нормальном падении света, пользуясь таблицей, приведенной
ниже и учитывая порядок интерференции, определяемый по числу повторений темного
фиолетово-красного цвета на вытравленном клине.
. Построить графики зависимости толщины пленки диоксида кремния
от времени при окислении в сухом и влажном кислороде.
Оборудование, приборы, инструменты
. Диффузионная печь.
. Баллон с кислородом.
. Милливольтметр.
. Термопара ППР5-20.
. Кварцевая штанга.
. Кварцевые лодочки.
. Пинцет металлический.
. Игла стальная.
. Таймер.
10.
Фторопластовый стакан для  .
.
.
Стакан для воды.
.
Фильтры бумажные.
Материалы
1. Полированные пластины кремния n-типа с удельным сопротивлением
0,50... 4,5 Ом×см,
разрезанные на 4 части. Перед проведением работы пластины должны быть
обезжирены кипячением в толуоле в течение 5 мин и подвергнуты химической
обработке, включающей кипячение в концентрированной азотной кислоте, промывку в
дистиллированной воде, обработку плавиковой кислотой (20 мин) для удаления
оксида и финишную промывку дистиллированной водой.
2. Кислота плавиковая концентрированная.
Определение толщины пленок методом цветовых оттенков
|
d, мкм
|
Порядок интерференции
|
Цвет последней полосы
|
|
0,050
|
|
Бежевый
|
|
0,0700
|
|
Коричневый
|
|
0,0960
|
|
Темно-коричнево-красный
|
|
0,1020
|
|
Индиго
|
|
0,1433
|
|
Голубовато-серый
|
|
0,1500
|
|
Светло-голубой
|
|
0,1688
|
|
Зелено-голубой
|
|
0,1700
|
|
Металлический
|
|
0,1786
|
|
Бледно-зеленый
|
|
0,1836
|
I
|
Желто-зеленый
|
|
0,1883
|
|
Светло-зеленый
|
|
0,1916
|
|
Зелено-желтый
|
|
0,1963
|
|
Золотисто-желтый
|
|
0,2000
|
|
Светло-золотистый
|
|
0,2200
|
|
Золотистый
|
|
0,2216
|
|
Оранжевый
|
|
0,2490
|
|
Светло-красный
|
|
0,2500
|
|
Красный
|
|
0,2700
|
|
Красно-фиолетовый
|
|
0,2753
|
|
Пурпурный
|
|
0,2810
|
|
Пурпурно-
|
|
0,2886
|
|
фиолетовый
|
|
0,3000
|
|
Фиолетовый
|
|
0,3033
|
|
Фиолетово-голубой
|
|
0,3100
|
|
Индиго
|
|
0,3160
|
|
Голубой
|
|
0,3200
|
II
|
Темно-голубой
|
|
0,3400
|
|
Зелено-голубой
|
|
0,3500
|
|
Светло-зеленый
|
|
0,3760
|
|
Зеленый
|
|
0,3830
|
|
Желтовато-зеленый
|
Окончание таблицы
|
d, мкм
|
Порядок интерференции
|
|
0,3900
|
|
Грязно-зеленый
|
|
0,4100
|
|
Желтый
|
|
0,4193
|
|
Светло-оранжевый
|
|
0,4200
|
|
Телесный
|
|
0,4400
|
|
Красный
|
|
0,4476
|
|
Фиолетово-красный
|
|
0,4586
|
|
Фиолетовый
|
|
0,4600
|
|
Красно-фиолетовый
|
|
0,4757
|
|
Голубовато-фиолетово-серый
|
|
0,4800
|
|
Голубовато-фиолетовый
|
|
0,4900
|
|
Голубой
|
|
0,4983
|
|
Зелено-голубой
|
|
0,5000
|
|
Голубовато-зеленый
|
|
0,5200
|
|
Зеленый
|
|
0,5403
|
|
Тускло-зеленый
|
|
0,5526
|
III
|
Желто-зеленый
|
|
0,5606
|
|
Зелено-желтый
|
|
0,5703
|
|
Желто-серый
|
|
0,5800
|
|
Светло оранжевый
|
|
0,5813
|
|
Сиреневато-серовато-красный
|
|
0,6000
|
|
Темно-розовый
|
|
0,6088
|
|
Карминово-красный
|
|
0,6300
|
|
Фиолетово-красный
|
|
0,6423
|
|
Серовато-красный
|
|
0,6690
|
|
Голубовато-серый
|
|
0,6800
|
|
Голубоватый
|
|
0,6826
|
|
Голубовато-зеленый
|
|
0,7200
|
IV
|
Зеленый
|
|
0,7700
|
|
Желтоватый
|
|
0,7793
|
|
Бледно-розовый
|
|
0,8000
|
|
Оранжевый
|
|
0,8200
|
|
Желтовато-розовый
|
|
0,8500
|
|
Светло-красновато-фиолетовый
|
|
0,8600
|
|
Фиолетовый
|
|
0,8700
|
V
|
Голубовато-фиолетовый
|
|
0,8893
|
|
Бледно-зелено-голубоватый
|
|
0,8900
|
|
Голубой
|
|
0,9200
|
|
Голубовато-зеленый
|
|
0,9500
|
|
Желто-зеленый
|
|
0,9700
|
|
Желтый
|
Контрольные вопросы
1. Какие
методы применяются для получения пленок  ?
?
. Применение
пленок  в полупроводниковом производстве.
в полупроводниковом производстве.
. Структурные
дефекты пленок термического диоксида кремния.
. Основные
свойства  .
.
. Кинетика
процесса термического окисления.
. Как
зависит толщина пленки от времени окисления?
. Какими
технологическими параметрами определяется скорость окисления?
. Влияние
примесей, содержащихся в кремнии на процесс окисления.
. Способы
контроля толщины диэлектрических пленок.
Лабораторная работа № 3. Метод вакуумного напыления
Цель работы - ознакомиться с процессом термического вакуумного напыления
алюминия на полупроводниковую подложку.
. Метод термического нанесения пленок в вакууме
Процесс нанесения тонких пленок в вакууме состоит в создании
направленного потока атомов или молекул и последующей их конденсации на
подложке. При этом одновременно протекают три основных процесса: генерация
направленного потока частиц осаждаемого вещества; пролет частиц в
вакууме от источника к подложке; осаждение (конденсация) частиц на
поверхности с образованием тонкопленочных слоев. При нанесении тонких пленок
используют два метода генерации потока частиц в вакууме: термическое испарение
и ионное распыление. В этой лабораторной работе изучается метод термического
испарения.
Зависимость
давления  равновесного (насыщенного) пара вещества от
температуры
равновесного (насыщенного) пара вещества от
температуры  определяется из условия термодинамического равновесия
пар - твердое тело, пар - жидкость и выражается формулой
определяется из условия термодинамического равновесия
пар - твердое тело, пар - жидкость и выражается формулой

где
 и
и  -
константы, характеризующие природу вещества. Температура, при которой давление
насыщенного пара составляет приблизительно 1,3 Па, называется условной
температурой испарения. Условная температура испарения большинства элементов
выше их температуры плавления, т. е. испарение происходит из жидкого состояния.
Некоторые вещества имеют условную температуру испарения ниже температуры
плавления. Они достаточно интенсивно испаряются из твердого состояния. Процесс
перехода вещества из твердого состояния в парообразное, минуя жидкую фазу,
называют сублимацией (или возгонкой).
-
константы, характеризующие природу вещества. Температура, при которой давление
насыщенного пара составляет приблизительно 1,3 Па, называется условной
температурой испарения. Условная температура испарения большинства элементов
выше их температуры плавления, т. е. испарение происходит из жидкого состояния.
Некоторые вещества имеют условную температуру испарения ниже температуры
плавления. Они достаточно интенсивно испаряются из твердого состояния. Процесс
перехода вещества из твердого состояния в парообразное, минуя жидкую фазу,
называют сублимацией (или возгонкой).
Для
определения скорости испарения, т. е. количества вещества, покидающего
поверхность исходного вещества в единицу времени, необходимо воспользоваться
максвелловским распределением молекул по скоростям, показывающим, какая доля
частиц  из общего количества
из общего количества  обладает
скоростями в диапазоне от
обладает
скоростями в диапазоне от  до
до  :
:

Здесь
 - компонент скорости, перпендикулярный к границе
раздела;
- компонент скорости, перпендикулярный к границе
раздела;  - число молекул в единице объема исходного вещества, м3;
- число молекул в единице объема исходного вещества, м3;
 - масса молекулы, кг;
- масса молекулы, кг;  -
постоянная Больцмана, Дж/К;
-
постоянная Больцмана, Дж/К;  -
температура испарения, K.
-
температура испарения, K.
Число
молекул  , испаренных с единицы площади поверхности в единицу
времени, т. е. скорость испарения с единичной площади поверхности, можно
определить интегрированием
, испаренных с единицы площади поверхности в единицу
времени, т. е. скорость испарения с единичной площади поверхности, можно
определить интегрированием  в
пределах от
в
пределах от  до
до  . Здесь
. Здесь  - скорость молекулы, при которой она покинет
поверхность и перейдет в газовую фазу. Поскольку этот параметр неизвестен, для
расчета скорости испарения применяется другой подход.
- скорость молекулы, при которой она покинет
поверхность и перейдет в газовую фазу. Поскольку этот параметр неизвестен, для
расчета скорости испарения применяется другой подход.
Рассмотрим
случай, когда испаряемое вещество находится в термодинамическом равновесии со
своим паром, который в этом случае называется насыщенным. При этом температура
одинакова во всех точках системы и равна  .
Распределение молекул пара по скоростям также можно считать максвелловским,
описываемым приведенной выше формулой, однако при нахождении скорости
конденсации интегрировать необходимо от 0 до
.
Распределение молекул пара по скоростям также можно считать максвелловским,
описываемым приведенной выше формулой, однако при нахождении скорости
конденсации интегрировать необходимо от 0 до  . В
результате получаем
. В
результате получаем

где
 - число молекул в единице объема паровой фазы.
- число молекул в единице объема паровой фазы.
Воспользуемся для пара уравнением состояния идеального газа. Для
единичного объема

где
 - давление насыщенного пара, Па. Тогда
- давление насыщенного пара, Па. Тогда

В
состоянии равновесия  , поэтому скорость испарения с единицы площади
поверхности равна
, поэтому скорость испарения с единицы площади
поверхности равна

Оценим
скорость испарения алюминия при  . Масса
атома, определяемая произведением относительной атомной массы элемента (27 для
алюминия) на величину атомной единицы массы (
. Масса
атома, определяемая произведением относительной атомной массы элемента (27 для
алюминия) на величину атомной единицы массы ( кг),
равна
кг),
равна
 кг,
кг,  Дж/К и
Дж/К и  = 1423
K. Тогда
= 1423
K. Тогда  кг/(м2 ×с).
кг/(м2 ×с).
При испарении сплавов, как правило, компоненты сплава испаряются
независимо один от другого, подобно чистым металлам. Однако следует учитывать,
что давления паров компонентов отличаются от давления паров чистых металлов при
той же температуре. При испарении соединений возможна диссоциация молекул с
преимущественным испарением более летучего компонента. Действие этих факторов
приводит к тому, что состав потока испаренных частиц будет изменяться во
времени. В связи с этим при напылении пленок сложного состава часто
используются индивидуальные источники для каждого компонента соединения. При
этом появляется возможность управления составом конденсирующейся пленки путем
изменения температур источников.

Скорость конденсации зависит от конфигурации испарителя и подложки. В
случае точечного источника вещество испаряется с одинаковой скоростью во всех
направлениях. В случае поверхностного испарителя количество испаренного
вещества зависит от направления испарения. Если частицы в потоке не испытывают
столкновений (такой поток называется молекулярным), то их движение
аналогично распространению лучистой энергии и может быть описано известными из
оптики соотношениями.
В
соответствии с законом косинуса Ламберта-Кнудсена количество вещества  , испаряемого элементом поверхности
, испаряемого элементом поверхности  , проходящего в телесном угле
, проходящего в телесном угле  по направлению
по направлению  ,
образующему угол
,
образующему угол  с нормалью к поверхности испарителя (рис. 4), равно
с нормалью к поверхности испарителя (рис. 4), равно  , где
, где  - общее
количество вещества, испаренного с испарителя
- общее
количество вещества, испаренного с испарителя  за время
за время
 .
.
Если
вещество поступает на площадку, наклоненную к направлению пучка на угол  , то количество вещества, осажденного на такую
площадку, равно
, то количество вещества, осажденного на такую
площадку, равно

Поскольку
 , где
, где  -
плотность,
-
плотность,  - толщина пленки, то
- толщина пленки, то

Скорость
конденсации  определяется как
определяется как  .
.
Если
подложка расположена параллельно поверхности испарителя и  - расстояние между ними, то
- расстояние между ними, то  , а
, а  (рис.
5).
(рис.
5).

Тогда для поверхностного испарителя

для точечного -

Если
площадка испарения не является бесконечно малой, то при определении толщины
пленки необходимо произвести интегрирование по 
Важным
параметром пленки является равномерность распределения ее толщины на
поверхности подложки. Из полученных формул следует, что при испарении из
источника малой площади толщина пленки не является однородной вследствие
неоднородности количества частиц, достигающих различных точек подложки в
единицу времени. Максимально различающимися по толщине являются участки пленки
в центре и на краю пластины. Отношение этих толщин для поверхностного
испарителя равно  для точечного -
для точечного -  где
где  - радиус подложки. Наиболее простым способом снижения
неравномерности является увеличение расстояния
- радиус подложки. Наиболее простым способом снижения
неравномерности является увеличение расстояния  . Однако
это уменьшает скорость конденсации пленки. В такой ситуации рационально проводить
одновременное напыление на партию пластин, размещенных на подложкодержателе
сферической формы. В некоторых системах подложки для повышения однородности
толщины совершают сложное планетарное движение.
. Однако
это уменьшает скорость конденсации пленки. В такой ситуации рационально проводить
одновременное напыление на партию пластин, размещенных на подложкодержателе
сферической формы. В некоторых системах подложки для повышения однородности
толщины совершают сложное планетарное движение.
Применение
«оптического» приближения при выводе выражения для скорости конденсации можно
считать обоснованным, если перенос вещества от источника к подложке происходит
в режиме молекулярного потока. При осуществлении такого режима обеспечивается
максимальная для системы заданной геометрии скорость роста пленки и снижаются
потери испаряемого материала. Режим молекулярного потока реализуется, если
исключены взаимные столкновения частиц потока друг с другом и их рассеивание
молекулами газа рабочей камеры. Для этого необходим достаточно глубокий вакуум.
Вакуум
принято условно разделять на низкий, средний, высокий и сверхвысокий. Критерием
разделения является отношение  , где
, где  - средняя длина свободного пробега молекул газа,
определяемая их взаимными столкновениями и соударениями со стенками, а
- средняя длина свободного пробега молекул газа,
определяемая их взаимными столкновениями и соударениями со стенками, а  - характерный линейный размер вакуумной камеры.
Очевидно, что значение
- характерный линейный размер вакуумной камеры.
Очевидно, что значение  зависит от концентрации молекул и, следовательно, от
давления. Для определенного газа при постоянной температуре произведение
зависит от концентрации молекул и, следовательно, от
давления. Для определенного газа при постоянной температуре произведение  является константой. Если единицы измерения
является константой. Если единицы измерения  и
и  - метр и
паскаль, то, например, для воздуха
- метр и
паскаль, то, например, для воздуха  при 20
°С.
при 20
°С.
При
низком вакууме  . Молекулы при этом испытывают постоянные столкновения
друг с другом, вследствие чего их пути представляют собой ломаные линии. На
стенках сосуда постоянно имеется слой адсорбированных молекул. Примерная
область давлений, соответствующая низкому вакууму -
. Молекулы при этом испытывают постоянные столкновения
друг с другом, вследствие чего их пути представляют собой ломаные линии. На
стенках сосуда постоянно имеется слой адсорбированных молекул. Примерная
область давлений, соответствующая низкому вакууму -  Па.
Па.
Высокий
вакуум характеризуется тем, что  .
Взаимодействие между молекулами из-за их малого количества практически
исчезает, и они движутся прямолинейно в пределах предоставленного объема,
сталкиваясь в основном со стенками сосуда. Примерная область давлений
.
Взаимодействие между молекулами из-за их малого количества практически
исчезает, и они движутся прямолинейно в пределах предоставленного объема,
сталкиваясь в основном со стенками сосуда. Примерная область давлений  Па. Средний вакуум характеризуется тем, что
Па. Средний вакуум характеризуется тем, что  . Ему соответствует область давлений
. Ему соответствует область давлений  Па. Сверхвысокий вакуум реализуется при давлениях
ниже
Па. Сверхвысокий вакуум реализуется при давлениях
ниже  Па.
Па.
Для
анализа процессов, происходящих при нанесении тонких пленок, большое значение
имеет соотношение длины свободного пробега частиц потока наносимого вещества  и расстояния от источника до подложки
и расстояния от источника до подложки  .
.
При
нанесении пленок в среднем вакууме часть частиц испаренного вещества попадает
на подложку без столкновений. Другая часть претерпевает большое количество
столкновений с молекулами газа, первоначальное направление движения полностью
нарушается. В результате некоторые частицы конденсируются на стенках камеры,
образуя равномерное пленочное покрытие, или даже осаждаются на обратной стороне
подложки.
При
нанесении пленок в высоком вакууме частицы осаждаемого вещества летят
независимо друг от друга по прямолинейным траекториям без взаимных столкновений
и столкновений с молекулами газа, не изменяя своего направления (молекулярный
поток), и конденсируются на стенках камеры и поверхности подложки.
Таким
образом, если вакуум недостаточно высокий, заметная часть частиц не попадает на
подложку. Однако уже при давлении р =  Па
Па  составляет 50 см, что превышает реальное расстояние
от испарителя до подложки (обычно не более 30 см). Таким образом, для создания
прямолинейных траекторий движения молекул вещества в пространстве между
испарителем и подложкой необходимо давление порядка
составляет 50 см, что превышает реальное расстояние
от испарителя до подложки (обычно не более 30 см). Таким образом, для создания
прямолинейных траекторий движения молекул вещества в пространстве между
испарителем и подложкой необходимо давление порядка  Па.
Па.
При
нанесении пленки на подложку падают два разных потока: полезный - атомы
осаждаемого вещества и фоновый - молекулы остаточных газов. Остаточные газы,
поглощаемые растущей пленкой, ухудшают электрофизические параметры пленки
(повышается ее сопротивление, уменьшается адгезия, возникают внутренние
напряжения и др.). Чем больше в остаточной атмосфере вакуумной камеры примеси
активных газов, тем сильнее их отрицательное влияние на качество наносимых
пленок. Для снижения этого влияния в некоторых случаях требуется понижение
давления до уровня  Па или ниже.
Па или ниже.
Все
вакуумные установки для нанесения тонких пленок состоят из следующих основных
элементов: источника потока частиц осаждаемого материала, вакуумной системы и
транспортно-позиционирующих устройств. Нанесение пленок производится в
вакуумной камере. В ней имеются источник наносимого материала и
подложкодержатель. В типовой установке вакуумная камера - это цилиндрический
колпак из нержавеющей стали, который может подниматься вверх для доступа к
подколпачным устройствам. В опущенном состоянии колпак герметизируется
прокладкой из вакуумной резины. Колпак оборудован краном для напуска в камеру
воздуха и датчиками для измерения вакуума.
. Контроль
параметров пленок и технологических режимов их нанесения
Измерение толщины пленок
Метод микровзвешивания состоит в определении приращения массы Dm подложки после нанесения на нее
пленки. В предположении, что вещество пленки равномерно распределено по
поверхности с плотностью, равной плотности массивного вещества, среднюю толщину
пленки определяют по формуле
 ,
,
где
 - площадь пленки на подложке;
- площадь пленки на подложке;  - удельная масса нанесенного вещества, которая может
изменяться в зависимости от условий проведения технологического процесса
(остаточного давления, загрязнений молекулами газа и др.). Чувствительность
метода взвешивания составляет 1...10 мкм/м
- удельная масса нанесенного вещества, которая может
изменяться в зависимости от условий проведения технологического процесса
(остаточного давления, загрязнений молекулами газа и др.). Чувствительность
метода взвешивания составляет 1...10 мкм/м и
зависит от чувствительности весов и площади пленки на подложке.
и
зависит от чувствительности весов и площади пленки на подложке.
Метод
многолучевой интерфермометрии,
применяемый для измерения толщины непрозрачных пленок, основан на наблюдении в
микроскоп интерференционных полос, возникающих при рассмотрении в
монохроматическом свете двух поверхностей, расположенных под углом друг к
другу. Перед измерением на образце получают ступеньку. Для этого маскируют
часть подложки при осаждении пленки или химически удаляют часть осажденной
пленки. В микроскоп наблюдают сдвиг интерференционных полос. Чередующиеся с
шагом  светлые и темные интерференционные полосы на границе
поверхностей пленки и подложки смещаются друг относительно друга на значение
светлые и темные интерференционные полосы на границе
поверхностей пленки и подложки смещаются друг относительно друга на значение  . Толщину пленки рассчитывают по формуле
. Толщину пленки рассчитывают по формуле

где
 - длина волны света, равная 0,54 мкм для микроскопа
МИИ-4;
- длина волны света, равная 0,54 мкм для микроскопа
МИИ-4;  - шаг между соседними интерференционными полосами;
- шаг между соседними интерференционными полосами;  - смещение интерференционной полосы. Точность этого
метода измерения толщины пленки составляет 15...30 нм. Если пленка прозрачная,
в месте ступеньки на нее и подложку осаждают дополнительно непрозрачную, хорошо
отражающую свет пленку (например, из алюминия), толщина которой, чтобы
уменьшить вносимую погрешность, должна быть много меньше толщины измеряемой
пленки.
- смещение интерференционной полосы. Точность этого
метода измерения толщины пленки составляет 15...30 нм. Если пленка прозрачная,
в месте ступеньки на нее и подложку осаждают дополнительно непрозрачную, хорошо
отражающую свет пленку (например, из алюминия), толщина которой, чтобы
уменьшить вносимую погрешность, должна быть много меньше толщины измеряемой
пленки.
Измерение
адгезии пленок
Сцепление
(прилипание) поверхностей разнородных тел называют адгезией. Адгезия пленки к
подложке зависит от материала пленки и скорости ее осаждения, а также от
чистоты поверхности и температуры подложки. Качество сцепления обычно
определяют путем сравни-тельного контроля, при котором измеряют усилие отрыва
пленки от под-ложки напаянным на ее поверхность металлическим цилиндром,
связанным с чашкой весов. Рассчитывают адгезию  по
формуле
по
формуле  где
где  - усилие
отрыва, а
- усилие
отрыва, а  - площадь контакта. Важно исключить перекос цилиндра.
Обычно площадь торца цилиндра около 1 мм2. Для получения надежных
данных следует измерить адгезию несколько раз, контролируя, не произошел ли
отрыв по месту спая и не растворилась ли пленка в припое. Разновидность этого
метода - контроль адгезии металлических пленок с помощью тонкой золотой или
алюминиевой проволоки, присоединяемой к пленке термокомпрессией. При этом площадь
контакта составляет 50...200 мкм2, что позволяет более точно
определять адгезию локальных участков пленки.
- площадь контакта. Важно исключить перекос цилиндра.
Обычно площадь торца цилиндра около 1 мм2. Для получения надежных
данных следует измерить адгезию несколько раз, контролируя, не произошел ли
отрыв по месту спая и не растворилась ли пленка в припое. Разновидность этого
метода - контроль адгезии металлических пленок с помощью тонкой золотой или
алюминиевой проволоки, присоединяемой к пленке термокомпрессией. При этом площадь
контакта составляет 50...200 мкм2, что позволяет более точно
определять адгезию локальных участков пленки.
Измерение скорости нанесения пленок
Наиболее распространен контроль скорости нанесения пленок
резонансно-частотным методом. При этом в качестве датчика используется
включенный в контур генератора частоты кварцевый элемент. Принцип действия
основан на зависимости частоты колебаний от изменения массы кварцевого элемента
при нанесении на его поверхность пленки. С увеличением массы кварцевого
элемента его резонансная частота падает. Для линейного участка зависимости
частоты от массы нанесенной пленки справедливо следующее соотношение:

где
 и
и  - масса
и резонансная частота кварцевого элемента до нанесения пленки;
- масса
и резонансная частота кварцевого элемента до нанесения пленки;  и
и  изменение
массы и резонансной частоты после нанесения пленки. Таким образом, скорость
роста пленки определяют по изменению скорости сдвига резонансной частоты.
изменение
массы и резонансной частоты после нанесения пленки. Таким образом, скорость
роста пленки определяют по изменению скорости сдвига резонансной частоты.
Основной частью кварцевого датчика является кварцевый кристалл в виде
пластины, на обе поверхности которой наносят контактные слои золота или
серебра. Кристаллы кварца очень чувствительны к изменениям температуры, поэтому
кварцевый элемент вставляется в массивный медный держатель, охлаждаемый
проточной водой. Это исключает повышение температуры кварцевого элемента,
вызванное потоками тепла от испарителя и нагревателя подложки. В кожухе имеется
сквозное отверстие для пропускания потока частиц наносимого материала к
кварцевому элементу.
Этим методом можно также измерить толщину нанесенной пленки, используя
следующую формулу:

где
 - площадь кварцевого кристалла, покрытая пленкой
наносимого вещества;
- площадь кварцевого кристалла, покрытая пленкой
наносимого вещества;  - плотность наносимой пленки. Точность измерения
толщины тонких металлических и диэлектрических пленок в интервале от 10 нм до 5
мкм составляет
- плотность наносимой пленки. Точность измерения
толщины тонких металлических и диэлектрических пленок в интервале от 10 нм до 5
мкм составляет  %. Для выполнения точных измерений приборы градуируют
отдельно для каждого материала. Максимально допустимая суммарная толщина
пленки, наносимой на кварцевый датчик, определяется максимальным сдвигом
частоты и примерно составляет 20 мкм алюминия. Существенным недостатком метода
является то, что помимо градуировки по осаждаемому материалу необходима также
периодическая чистка кварцевых элементов от осажденной пленки.
%. Для выполнения точных измерений приборы градуируют
отдельно для каждого материала. Максимально допустимая суммарная толщина
пленки, наносимой на кварцевый датчик, определяется максимальным сдвигом
частоты и примерно составляет 20 мкм алюминия. Существенным недостатком метода
является то, что помимо градуировки по осаждаемому материалу необходима также
периодическая чистка кварцевых элементов от осажденной пленки.
3. Порядок выполнения работы
. Получить у преподавателя необходимые приборы и инструменты.
. Взвесить на аналитических весах WA-31 согласно инструкции на
них: пластину кремния (с точностью до 10-4 г) и одновременно четыре
навески алюминия (с точностью до 10-3 г).
3. Измерить
расстояние  от испарителя до пластины. Рассчитать по формуле
от испарителя до пластины. Рассчитать по формуле  толщину пленки алюминия для точечного источника
испарения. Здесь
толщину пленки алюминия для точечного источника
испарения. Здесь  - вес всех навесок алюминия;
- вес всех навесок алюминия;  - удельный вес алюминия, равный 2,7 г/см
- удельный вес алюминия, равный 2,7 г/см .
.
. Рассчитать
по формуле  максимально допустимое давление
максимально допустимое давление  в момент напыления при условии
в момент напыления при условии  , где
, где  - длина
пути свободного пробега молекул воздуха, см;
- длина
пути свободного пробега молекул воздуха, см;  -
температура в объеме под колпаком;
-
температура в объеме под колпаком;  - давление
в миллиметрах ртутного столба.
- давление
в миллиметрах ртутного столба.
. Провести
напыление алюминия на пластину под руководством преподавателя. По показаниям
вакуумметра и градуировочной кривой для манометрического преобразователя ЛТ-2
определить порядок величины давления под колпаком установки в момент напыления,
сравнить его с давлением, рассчитанным по п. 4, оценить и объяснить различия.
. Взвесить
пластину с напыленным на нее алюминием. Измерить линейкой диаметр пластины. По
формуле  рассчитать среднюю толщину пленки алюминия на
пластине. Здесь
рассчитать среднюю толщину пленки алюминия на
пластине. Здесь  ,
,  - вес
пластины до и после напыления;
- вес
пластины до и после напыления;  - радиус
пластины.
- радиус
пластины.
. Прочертить
стальной иглой две царапины на пленке алюминия (по образцу).
. Определить
на микроскопе МИИ-4 толщину пленки алюминия
. в
области царапин согласно инструкции по эксплуатации МИИ-4. По виду царапин
оценить адгезию алюминия.
. Объяснить
причины различия результатов пп. 3, 6 и 8. Сформулировать предложения по
улучшению равномерности пленки алюминия.
Примерная последовательность операций при напылении
. Установить подложку на подложкодержателе при поднятом колпаке.
. Закрыть рабочую камеру, опустив колпак.
. Откачать из камеры воздух до требуемого вакуума. Для этого
выполнить операции в последовательности.
. Включить источник, создающий атомарный поток алюминия.
. Нанести пленку определенной толщины при постоянно работающих
источнике потока частиц и вакуумной системе.
. Выключить источник потока алюминия, дождаться охлаждения
подложки.
. Напустить воздух в рабочую камеру до атмосферного давления.
. Поднять колпак и снять подложку с подложкодержателя.
В некоторых случаях выполняют дополнительные операции (например,
предварительный нагрев подложек). Эффективность процесса характеризуется его
производительностью, чистотой и равномерностью толщины наносимой пленки.
Оборудование, приборы, инструменты, материалы
. Установка вакуумного напыления УРМЗ.279.017.
. Вакуумметр ионизационно-термопарный ВИТ-2.
. Микроинтерферометр Линника МИИ-4.
. Весы аналитические WA-31.
. Линейка.
. Пинцет металлический.
. Игла стальная.
. Пластина кремниевая.
. Навески из алюминиевой проволоки высокой чистоты.
. Фильтры бумажные.
Контрольные вопросы
. Принцип действия установок для нанесения тонких пленок.
. В чем отличие процессов испарения и сублимации?
. Чем определяется равномерность распределения толщины плен-ки по
подложке?
. Как определить толщину наносимых пленок микровзвешиванием?
. Каков принцип измерения толщины пленок методом лучевой
интерферометрии?
. Как определить адгезию пленок?
. В чем заключается влияние давления остаточных газов на процесс
напыления и электрофизические параметры пленок?
. Что такое молекулярный поток?
Лабораторная работа № 4. Фотолитография в производстве
полупроводниковых приборов и интегральных схем
Цель работы - изучение технологического процесса фотолитографии и получение
навыков работы на технологическом оборудовании.
. Общая характеристика процесса фотолитографии
В производстве интегральных схем литографией называется процесс
изготовления элементов заданной формы и размеров в слое металла, диэлектрика
или полупроводника путем травления через маску из химически стойкого
органического материала - резиста. Маска изготовляется с помощью локального
воздействия излучения того или иного рода на сплошной слой резиста,
предварительно нанесенного на обрабатываемую поверхность, и последующей
химической обработки - проявления. В зависимости от типа излучения различают:
фотолитографию (ультрафиолетовое излучение), ренгенолитографию (рентгеновское
излучение), электронолитографию (поток электронов) и ионолитографию (поток
ионов). Локальность действия излучения обеспечивается путем использования
шаблонов (фото-, рентено- и электронолитографии) либо растровым сканированием
сфокусированным пучком (электроно- и ионолитографии).
Литография
применяется как для формирования рисунка рабочих об-ластей, так и для создания
отдельных масочных слоев (например, в слое  на
на  ). Литографический процесс включает в себя следующие
основные операции: нанесение на подложку резиста; экспонирование резиста
излучением; проявление скрытого изображения в проявителе и получение защитного
рельефа. В процессе производства интегральных схем литографические процессы
применяются многократно. При этом используется комплект согласованных друг с
другом шаблонов.
). Литографический процесс включает в себя следующие
основные операции: нанесение на подложку резиста; экспонирование резиста
излучением; проявление скрытого изображения в проявителе и получение защитного
рельефа. В процессе производства интегральных схем литографические процессы
применяются многократно. При этом используется комплект согласованных друг с
другом шаблонов.
2. Основные свойства фоторезистов
Резисты - высокомолекулярные соединения, способные изменять свои
свойства, в частности растворимость, под действием излучения.
В фотолитографии применяются фоторезисты (ФР), в которых излучение
ультрафиолетового диапазона стимулирует фотохимические процессы, действие
которых приводит к уменьшению растворимости экспонированной области (негативные
фоторезисты) или повышению растворимости экспонированной области (позитивные
фоторезисты). При использовании негативного фоторезиста в облучаемых участках
протекает реакция фотополимеризации или инициированной сшивки линейных
полимеров. В случае позитивного фоторезиста в облучаемых участках происходит
реакция фотолиза (разложения) с образованием веществ, растворимых в проявителе.
После обработки экспонированного слоя фоторезиста в составе, удаляющем
растворимые участки, образуется рельефное изображение. Оставшиеся участки слоя
резиста устойчивы к воздействию агрессивных факторов - кислот, щелочей и т.д. В
состав фоторезистов входят следующие компоненты: светочувствительные
составляющие, пленкообразующие продукты и растворители.
Позитивные фоторезисты изготавливаются на основе нафтохинондиазидов.
Негативные фоторезисты можно разбить на три группы: на основе эфиров коричной
кислоты и поливинилового спирта - поливинил-циннаматы; на основе циклокаучуков;
на основе фотополимеризующихся композиций (акриловые или стирольные
сополимеры).
Фоторезисты характеризуются следующими параметрами: разрешающей
способностью, светочувствительностью, стойкостью к воздействию агрессивных
факторов, адгезией и стабильностью.
Разрешающая способность - число полос из фоторезиста, разделенных
промежутками такой же ширины на длине 1 мм (число линий на миллиметр).
Pазрешающая способность зависит от толщины фоторезистивного слоя и применяемого
фотолитографического оборудования. При толщине слоя позитивных фоторезистов
0,2...0,3 мкм достигается предельная разрешающая способность 1000...2000
лин./мм. Однако такой толщины пленки фоторезиста нельзя получить с малой
дефектностью. Поэтому обычно используют фоторезистивные слои толщиной не менее
0,7...1 мкм.
Светочувствительность - величина, обратная экспозиции, т.е. количеству световой
энергии, необходимой для облучения фоторезиста, чтобы перевести его в
нерастворимое (негативный ФР) или растворимое (позитивный ФР) состояние.
Химическая стойкость характеризует способность резиста защищать подложку от
действия травителя. Критерием стойкости является время, в течение которого
фоторезист выдерживает действие травителя до появления таких дефектов, как
частичное разрушение, отслаивание, локальное растравливание или подтравливание
его на границе с подложкой. Как правило, стойкость резиста оценивают по
величине бокового подтравливания при заданной глубине травления.
Адгезия фоторезиста характеризует его сцепление с подложкой. Адгезия определяет
уход размеров элементов в процессах проявления и подтравливания при последующем
формировании рельефа.
Стабильность эксплуатационных свойств фоторезистов во времени выражается
сроком службы при определенных условиях хранения и использования.
В отечественной практике в основном используются позитивные фоторезисты,
так как выпускаемые негативные резисты не позволяют получить такую же
разрешающую способность, как позитивные. При выборе резиста большое значение
имеют не только разрешающая способность, но и кислото- или щелочестойкость. Как
правило, позитивные резисты не выдерживают щелочных травителей, негативные
резисты устойчивы к воздействию кислот и щелочей, особенно резисты на основе
каучуков.
3. Фотошаблоны
Фотошаблон - плоскопараллельная пластина из прозрачного материала, на
которой имеется рисунок, состоящий из непрозрачных для света определенной длины
волны участков, образующих топологию одного из слоев структуры прибора,
многократно повторенного в пределах рабочего поля подложки.
Применяют эмульсионные, металлизированные и транспарентные (цветные)
фотошаблоны.
Эмульсионные фотошаблоны изготавливают на «безусадочной» фотопленке и
фотопластинах. Для изготовления металлизированных фотошаблонов используют
оптическое стекло с рисунком, выполненным в слое хрома. Они отличаются от
эмульсионных шаблонов более высокой износостойкостью, механической и
термической стабильностью, влагостойкостью, резко очерченными краями рисунка,
отсутствием вуали и др.
Транспарентный фотошаблон - фотошаблон, рисунок которого сформирован в
диэлектрическом слое, частично прозрачном для видимого излучения. Например,
слой оксида железа полупрозрачен для видимого излучения и непрозрачен для
ультрафиолетового.
При проведении нескольких последовательных процессов фотолитографии для
совмещения элементов рисунка на фотошаблоне с рисунком на поверхности подложки
используют реперные знаки совмещения, представляющие собой вписывающиеся друг в
друга фигуры.
. Схема технологического процесса фотолитографии
Нанесение
фоторезиста. Для нанесения
фоторезиста используют распыление, электростатическое нанесение, окунание,
полив и другие способы. Подготовка поверхности подложки включает ее очистку.
Чаще всего нанесение слоя фоторезиста осуществляется методом центрифугирования.
Пластина укрепляется на столике центрифуги с помощью механических фиксаторов
или вакуумного присоса. При включении центрифуги жидкий фоторезист растекается
под действием центробежных сил. Формирование слоя происходит в течение 20...30
с при скорости вращения центрифуги 1000...10 000 об/мин. Время между нанесением
на подложку дозированной порции жидкого резиста и включением центрифуги должно
составлять 0,5...1 с, чтобы вязкость фоторезиста не менялась в результате
испарения растворителя. Толщина слоя фоторезиста  зависит
от его вязкости
зависит
от его вязкости  и угловой скорости вращения
и угловой скорости вращения  центрифуги:
центрифуги:

При центрифугировании с малой угловой скоростью слой фоторезиста
получается неровным и на краю подложки возникает утолщение (валик), ширина и
высота которого зависят от вязкости резиста и скорости вращения центрифуги.
Толщину слоя фоторезиста выбирают из условий, обеспечивающих наименьшее
количество дефектов и наибольшую разрешающую, способность. Более толстые слои
фоторезиста содержат меньше «проколов», но при этом их разрешающая способность
уменьшается.
Сушка фоторезистивного слоя. Назначение сушки - удаление из
нанесенного слоя фоторезиста растворителя, повышение его адгезии к подложке и
обеспечение стойкости фоторезиста в проявителе. После сушки фoтocлoй не должен
быть липким при контакте с фотошаблоном. При проведении сушки опасны перепады
температур, создающие внутренние напряжения, и слишком быстрый нагрев.
Существуют три способа сушки: конвективный, инфракрасным излучением и
СВЧ-полем.

Конвективная сушка обычно производится при 90...100 °C в течение 15-30 мин. Поскольку
сушка начинается с поверхности, уплотненный поверхностный слой препятствует
полному удалению растворителя из глубины фоторезиста, что ухудшает его
светочувствительность.
При инфракрасной сушке фронт сушки перемещается от нагреваемой излучением
ИК-лампы подложки к поверхности. Это позволяет существенно улучшить качество
сушки и уменьшить ее длительность до 5...10 мин.
Время сушки СВЧ-полем - несколько секунд.
Экспонирование. Основными методами оптического экспонирования являются
контактный и проекционный. В слу-чае контактной фотолитографии пластина,
покрытая резистом, находится в непосредственном контакте с фотошаблоном (рис.
6). Ограничение минимального размера элемента в этом случае обусловлено в
основном дифракционными эффектами, возникающими из-за наличия зазора между
шаблоном и подложкой, который достигает иногда десятка микрометров.
Вследствие отражения света от подложки область негативного ФР
полимеризуется и удерживается при проявлении за счет сил сцепления с подложкой.
В результате этого в негативных фоторезистах образуется ореол, ухудшающий
разрешающую способность ФР. В позитивных ФР при проявлении вымывается только
верхняя часть рисунка, что не влияет на разрешающую способность. Отсюда
следует, что разрешающая способность позитивного фоторезиста будет лучше, чем
негативного (рис. 7).
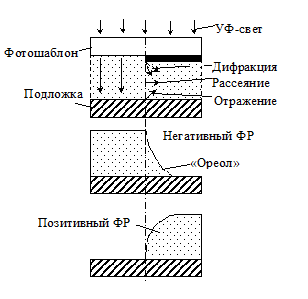
Рис.
7. Прохождение света в негативном (а)
и позитивном (б) фоторезистах
С
целью уменьшения дифракции надо использовать для экспонирования более
коротковолновое излучение и минимизировать толщину слоя фоторезиста. Кроме
того, при контактной фотолитографии следует использовать фотошаблоны с
маскирующим слоем, обладающим малой отражающей способностью, а зазор между ними
и подложками должен быть минимален. Основной недостаток контактной
фотолитографии - изнашивание фотошаблона при его многократном использовании.
При
использовании проекционной литографии изображение рисунка фотошаблона
проецируется на всю площадь пластины или часть ее с последующим пошаговым
экспонированием.
Минимальная ширина линии, соответствующая предельной разрешающей
способности процесса проекционной фотолитографии, определяется критерием Рэлея:


где
 - длина волны излучения;
- длина волны излучения;  - коэффициент преломления среды в пространстве
изображения;
- коэффициент преломления среды в пространстве
изображения;  - апертурный угол;
- апертурный угол;  -
технологический фактор. Выражение в знаменателе называется числовой апертурой
объектива
-
технологический фактор. Выражение в знаменателе называется числовой апертурой
объектива  . Числовой коэффициент
. Числовой коэффициент  зависит
от параметров оптической системы (рис. 8), а также от свойств фоторезиста,
режимов его обработки и др. Желательно, чтобы
зависит
от параметров оптической системы (рис. 8), а также от свойств фоторезиста,
режимов его обработки и др. Желательно, чтобы  был по
возможности меньшим. Если сделать
был по
возможности меньшим. Если сделать  , то
, то  . Однако это труднодостижимо. Чаще всего для систем с
дифракционными ограничениями
. Однако это труднодостижимо. Чаще всего для систем с
дифракционными ограничениями  .
Возможность уве-личения
.
Возможность уве-личения  также ограничена, так как числовая апертура связана с
глубиной резкости
также ограничена, так как числовая апертура связана с
глубиной резкости  проекционной системы, определяемой как
проекционной системы, определяемой как

Для
компенсации влияния аберраций оптической системы, искривления поверхности
подложек и изменения толщины слоя фоторезиста необходима наибольшая глубина
резкости. Это ограничивает апертуру линз и, следовательно, разрешающую
способность метода. Таким образом, для повышения разрешающей способности
необходимо уменьшать  .
.
Время
экспонирования определяется интенсивностью излучения и толщиной
фоторезистивного слоя и подбирается экспериментально. Для каждой партии
фоторезиста подбирают режим экспонирования и проявления. Эти операции
неразрывно связаны между собой. Время экспонирования считается оптимальным,
если после проявлении толщина рельефа фоторезиста составляет не менее 90 %
толщины нанесенного слоя. При правильном подборе времени экспонирования край
изображения должен быть четким, а рисунок фоторезиста должен геометрически
соответствовать рисунку фотошаблона.
Проявление. Проявление негативных фоторезистов проводится в органических
растворителях: толуоле, бензоле, трихлорэтилене и др. Для проявления позитивных
фоторезистов используют водные щелочные растворы: 0,3...0,5%-ный раствор едкого
калия 1...2%-ный раствор тринатрийфосфата, органические щелочи - этаноламины.
При проявлении контролируют температуру и величину рН проявителя. При изменении
величины рН всего лишь на десятую долю возможно изменение размера элемента
примерно на 10 %. Время проявления фотослоя зависит от его толщины.
Для
каждого резиста существуют оптимальные сочетания времен экспонирования  и проявления
и проявления  ,
обеспечивающие наилучшую воспроизводимость размеров проявленных элементов
рисунка. Увеличение экспозиции уменьшает время проявления, но приводит к
изменению размеров проявленных элементов рисунка (в позитивных резистах размеры
увеличиваются, в негативных - уменьшаются). Увеличение времени проявления
повышает пористость и растравливание границ рисунка по контуру. Времена
проявления и экспонирования связаны между собой обратно пропорциональной
зависимостью
,
обеспечивающие наилучшую воспроизводимость размеров проявленных элементов
рисунка. Увеличение экспозиции уменьшает время проявления, но приводит к
изменению размеров проявленных элементов рисунка (в позитивных резистах размеры
увеличиваются, в негативных - уменьшаются). Увеличение времени проявления
повышает пористость и растравливание границ рисунка по контуру. Времена
проявления и экспонирования связаны между собой обратно пропорциональной
зависимостью

где
 - технологический фактор. Если известно время
проявления для одной толщины фоторезиста
- технологический фактор. Если известно время
проявления для одной толщины фоторезиста  , то
можно определить время проявления для другой толщины
, то
можно определить время проявления для другой толщины  при заданном времени экспо-нирования:
при заданном времени экспо-нирования:

При проявлении негативных фоторезистов происходит набухание и затем
растворение неэкспонированных участков. При этом набухают и растворяются и
экспонированные участки, но в значительно меньшей степени. Поэтому для
получения четкого рисунка подбирают такой проявитель, который бы минимально
воздействовал на экспонированные участки. При недостаточной экспозиции
облученные участки растворяются почти так же, как и необлученные, что приведет
к очень некачественному рисунку. Механизм проявления позитивных ФР заключается в
образовании при химической реакции растворимых в воде солей, которые вымываются
при проявлении. В отличие от негативных фоторезистов в позитивных отсутствует
набухание, что повышает их разрешающую способность.
После проявления подложки промывают и сушат на центрифуге или в потоке
очищенного воздуха.
Задубливание фоторезистивного слоя (вторая сушка). Эта операция производится для
повышения адгезии фоторезиста к пластине,
а также для повышения стойкости фоторезистивной маски к агрессивным
травителям. В процессе задубливания проявитель удаляется и осуществляется
дополнительная полимеризация слоя фоторезиста. От температуры, характера ее
изменения и времени задубливания зависит точность передачи размеров элементов.
Ограничивающим фактором является трудность удаления задубленного фоторезиста.
Задубливание может осуществляться обработкой инфракрасными лучами или
СВЧ-полем. Температура сушки 150...240 °C, продолжительность 0,5...1 ч.
Локальное травление. Способ, состав среды и режим травления выбирают в зависимости
от профилируемого материала и требований к точности воспроизведения геометрии
топологического рисунка.
Снятие фоторезистивного слоя. Для удаления фоторезиста чаще всего
используют обработку в органических растворителях и плазмохимическую обработку
в кислородной плазме. Применяют такие органические растворители, как
диметилформамид, дибутилфталат, четыреххлористый углерод, трихлорэтилен,
толуол, изопропиловый спирт и др., часто с последующим механическим удалением
разбухшего рельефа. Качество удаления в органических растворителях существенно
зависит от температуры второй сушки. Желательно, чтобы эта температура была не
слишком высокой, так как глубокая полимеризация фоторезиста усложняет удаление
рельефа с подложки даже при дополнительном механическом воздействии.
5. Методы получения элементов с помощью процесса
фотолитографии
В
технологии полупроводниковых интегральных микросхем используются контактные
маски, которые формируются применением последовательной селективной и обратной
фотолитографий. Метод последовательной фотолитографии представлен на рис. 9, а.
Сначала на подложку наносится тонкопленочный слой из рабочего материала,
(например,  ), затем контактной фотолитографией формируется
фоторезистивная маска, через которую далее производится травление. Травитель
для рабочего материала (
), затем контактной фотолитографией формируется
фоторезистивная маска, через которую далее производится травление. Травитель
для рабочего материала ( ) не должен разрушать и травить маску, т.е. должен
быть селективным. После травления рабочего слоя ФР-маска удаляется. Для
травления в составах, воздействия которых резист не выдерживает, используется
фотолитография с подслоем. На подложку наносят слой металла, обладающего к ней
хорошей адгезией и нетравящегося в составе, используемом для травления
подложки. Далее проводят фотолитографию и вытравливают окна в металлическом
подслое одним травителем, а окна в подложке - другим.
) не должен разрушать и травить маску, т.е. должен
быть селективным. После травления рабочего слоя ФР-маска удаляется. Для
травления в составах, воздействия которых резист не выдерживает, используется
фотолитография с подслоем. На подложку наносят слой металла, обладающего к ней
хорошей адгезией и нетравящегося в составе, используемом для травления
подложки. Далее проводят фотолитографию и вытравливают окна в металлическом
подслое одним травителем, а окна в подложке - другим.
В
обратной фотолитографии (литографии «взрывом») маска формируется в пленке из
вспомогательного металла, который легко травится, например из меди (рис. 9, б).
Пленка меди напыляется непосредственно на подложку. С помощью фоторезистивного
защитного рельефа в нем формируется рисунок - негативный (обратный) по
отношению к требуемому изображению. Фоторезистивная маска удаляется, а на
металлическую маску наносится рабочий материал.

а б
Рис. 9. Методы последовательной (а) и обратной (б) фотолитографий:
1 -
подложка; 2 - слой SiO2; 3 - слой меди; 4 -
фоторезист;
5
- фотошаблон; 6 - излучение; 7 - фоторезистивная маска;
8
- обратная маска в слое меди; 9 - пленка рабочего материала;
10
- рисунок в рабочем слое
При травлении материала маски (меди), находящейся под рабочим слоем,
последний удаляется с подложки, за исключением мест, где он осажден
непосредственно на подложку. За счет этого получается рисунок в рабочем
материале. Такая последовательность операций называется обратной литографией с
подслоем. Возможен и упрощенный метод обратной фотолитографии, при котором на
подложку наносится фоторезист и на нем образуется негативный рисунок требуемой
конфигурации; далее наносится сплошной слой рабочей пленки, который удаляется с
подложки вместе с фоторезистом. Метод обратной фотолитографии исключает
действие сильных травителей на пленку, так как ФР удаляется органическим
растворителем. Однако в этом случае нельзя применять сильный нагрев, так как он
приводит к дополнительной полимеризации или разложению фоторезиста. В
процессах, в которых имеет место нагрев, следует применять обратную
фотолитографию с подслоем. Основная проблема обратной фотолитографии - адгезия
осаждаемого материала к подложке. Для улучшения адгезии применяют различные
методы обработки поверхности подложки: ионное травление, очистку в тлеющем
разряде, очистку в кислородной плазме.
. Виды брака при фотолитографии
Основные виды выявляемых дефектов:
некачественное удаление резиста (вызывается низкой адгезией из-за плохой
подготовки поверхности);
плохо проявленный рисунок (вызывается некачественным фоторезистом,
неправильным выбором температуры первой сушки и режимов экспонирования);
двойной край или большой клин по краю рельефа (вызывается неоптимальными
режимами экспонирования и проявления, большим зазором между подложкой и
фотошаблоном при экспонировании);
неровный (рваный) край рельефа (в основном из-за загрязненного
фотошаблона и несоблюдения режимов экспонирования);
проколы (из-за запыленности среды и фоторезиста, перепроявления,
уменьшения толщины, нарушения режимов экспонирования);
остатки фоторезиста в проявленных окнах (из-за недопроявления или
нарушения режимов экспонирования);
изменение размеров рисунка (из-за ошибки в экспозиции либо нарушения
режимов проявления).
Порядок
выполнения работы
1. Нанесение фоторезиста на пластину.
1.1. Открыть крышку тары, взять пластину за край пинцетом и поместить на
столик установки нанесения фоторезиста рабочей стороной вверх симметрично
относительно окружности прочерченной вокруг столика.
.2. Зафиксировать пластину на столике, для чего кран «вакуум» повернуть
на один-два оборота против хода часовой стрелки.
.3. Убедиться, используя пинцет, что пластина зафиксирована.
.4. Открыть склянку с фоторезистом, набрать в пипетку примерно на треть
ее длины фоторезист и вылить его из пипетки в центр пластины. Пипетку положить
на бумажный фильтр.
.5. Включить тумблер «Вращение». После того как вид поверхности
вращающийся пластины перестанет изменяться (15...20 с), вращение прекратить.
.6. Повернуть кран «Вакуум» по ходу часовой стрелки до упора, пинцетом за
край снять пластину со столика и поставить ее в прорезь фторопластовой тары.
.7. Повторить пп. 1.1 - 1.6 последовательно для остальных пластин.
2. Сушка фоторезиста.
2.1.
Надеть на руки тканевые перчатки, взять тару с пластинами с предыдущей операции
и поместить в сушильный шкаф, нагретый до температуры 85 10 °C.
10 °C.
.2.
Выдержать пластины в шкафу 20 мин.
2.3. Вынуть пластины из сушильного шкафа, пинцетом за край переложить
пластины в тару для пластин, закрыть тару красной (оранжевой) крышкой.
3. Экспонирование.
3.1. Отвести осветитель установки экспонирования влево до упора при
помощи рукоятки, не допуская при этом удара об упор.
.2. Открыть крышку тары для пластин, взять пластину пинцетом за край и
положить ее фоторезистом вверх на круглый столик установки экспонирования. Тару
с остальными пластинами закрыть крышкой.
.3. Положить на пластину фотошаблон металлизацией или эмульсией вниз так,
чтобы область рисунка на нем находилась над пластиной.
.4. Установить осветитель над фотошаблоном, повернув его за рукоятку
вправо до упора, не допуская при этом удара об упор.
.5. Включить освещение, нажав последовательно кнопки «Сброс» (слева от
осветителя), «Пуск» и «Вверх» (справа от осветителя). Осве-щение включится на
время, установленное на реле времени ВЛ-17 (слева).
.6. После автоматического отключения освещения снять фотошаблон, затем
снять пластину пинцетом и положить ее в тару для пластин.
4. Проявление фоторезиста.
4.1. Во фторопластовый стакан налить примерно на 1/3 часть его объема
проявитель, в другой стакан налить водопроводную воду более чем на половину
объема.
.2. Пинцетом положить пластину в стакан с проявителем фоторезистом вверх,
наблюдать за ходом проявления.
.3. Держать пластину в проявителе до тех пор, пока не перестанет
растворяться засвеченный фоторезист. (О его растворении свидетельствует
появление помутнения в растворе.)
.4. Пластину пинцетом переложить в стакан с водой, выдержать ее в воде
несколько секунд, а затем пинцетом положить на бумажный фильтр рабочей стороной
вверх.
.5. Воздухом из резиновой груши сдуть с поверхности пластины воду,
поставить пластину пинцетом в фторопластовую тару для сушки пластин.
.6. Повторить пп. 4.1 - 4.5 для остальных пластин.
5. Задубливание фоторезиста. (Вторая сушка).
5.1.
Надеть на руки тканевые перчатки, поместить фтороплас-товую тару с пластинами
после проявления в сушильный шкаф, нагретый до температуры 130 10 °C.
10 °C.
5.2. Выдержать пластины в шкафу 20 мин, после чего достать тару с
пластинами из шкафа.
6. Травление.
Операцию выполнять
в резиновых перчатках в вытяжном шкафу при включенной вытяжной вентиляции
6.1. Травление окисла кремния.
.1.1. Пластину с окислом взять пинцетом и положить во фторопластовый
стакан рабочей стороной вверх.
.1.2. Налить в стакан с пластиной буферный травитель в минимальном
количестве, но так, чтобы пластина полностью находилась в травителе.
.1.3. Выдержать пластину в травителе примерно две минуты, но до полного
стравливания окисла кремния в тех местах, где он не закрыт фоторезистом, о чем
будет свидетельствовать появление так называемой вафельной поверхности.
.1.4. Слить травитель в бутыль, из которой его наливали, придерживая
пластину в стакане пинцетом.
.1.5. Промыть пластину в стакане водопроводной водой, несколько раз
набирая и сливая воду, промыть водой пинцет.
.1.6. Положить пластину пинцетом на бумажный фильтр рабочей стороной
вверх, воздухом из резиновой груши сдуть воду с поверхности пластины.
.1.7. Повторить пп. 6.1.1 - 6.1.6 для остальных пластин.
.2. Травление алюминия.
.2.1. Положить пластину с алюминием пинцетом в кварцевый стакан (ковш)
рабочей стороной вверх.
.2.2. Налить в стакан с пластиной травитель для алюминия в минимальном
количестве, но так, чтобы пластина полностью находилась в травителе. Налить во
фторопластовый стакан водопроводную воду примерно до половины.
.2.3. Поставить кварцевый стакан на разогретую электрическую плитку и
наблюдать за поверхностью пластины. После стравливания алюминия, не закрытого
фоторезистом на всей поверхности пластины, снять стакан с плитки.
.2.4. Пинцетом извлечь пластину из стакана с травителем и положить ее во
фторопластовый стакан с водой.
.2.5. Промыть пластину в стакане водопроводной водой, несколько раз
сливая и набирая воду, промыть водой пинцет.
.2.6. Положить пластину пинцетом на бумажный фильтр, воздухом из
резиновой груши сдуть воду с поверхности пластины.
.2.7. Повторить пп. 6.2.1 - 6.2.6 для остальных пластин.
.2.8. Слить травитель из кварцевого стакана в бутыль, из которой его
наливали.
7. Снятие фоторезиста.
Операцию
выполнять в вытяжном шкафу при включенной вытяжной вентиляции.
7.1. Пластину положить пинцетом во фторопластовый стакан рабочей стороной
вверх.
.2. Налить в стакан с пластиной ацетон в минимальном количестве, но так,
чтобы пластина полностью находилась в ацетоне, в другой стакан налить воды
примерно наполовину.
.3. Выдержать пластину в ацетоне 10 мин.
.4. Извлечь пластину пинцетом из стакана с ацетоном и положить в стакан с
водой.
.5. Промыть пластину в стакане водопроводной водой, несколько раз сливая
и набирая воду.
.6. Положить пластину пинцетом на бумажный фильтр рабочей стороной вверх,
воздухом из резиновой груши сдуть воду с поверхности пластины.
.7. Повторить пп. 7.1 - 7.6 для остальных пластин.
8. Оценка результатов работы.
Под микроскопом рассмотреть полученный на пластине рисунок в нескольких
областях. Обратить внимание на дефекты, определить их виды, указать причины
возникновения.
7. Содержание отчета
. Цель работы.
. Схема технологического процесса контактной фотолитографии.
. Анализ полученных результатов.
. Выводы по работе.
Оборудование, приборы, инструмент, оснастка, материалы
. Установка нанесения фоторезиста УНФ.
. Установка экспонирования ЭМ-526.
. Шкаф вытяжной 2Ш-НЖ.
. Шкаф сушильный СНОЛ-2,5.
. Плитка электрическая.
. Микроскоп МЕТАМ-Р, Биолам-М.
. Часы.
. Фотошаблон.
. Пинцет металлический.
. Пинцет фторопластовый.
. Пипетка.
. Стакан кварцевый (ковш).
. Тара фторопластовая для сушки.
. Тара полистироловая для хранения пластин.
. Перчатки тканевые.
. Перчатки резиновые.
. Пластина кремниевая с окислом кремния.
. Пластинка кремниевая, окисленная с пленкой алюминия.
. Фоторезист позитивный ФП-383 в склянке.
. Проявитель: 0,5 % раствор гидроокиси калия в воде.
. Травитель буферный для окисла кремния: фтористоводородная кислота 100
мл, фтористый аммоний 110 г, вода дистиллированная 220 мл.
. Травитель для алюминия: ортофосфорная кислота 50 %,вода
дистиллированная 50 %.
. Ацетон.
. Вода питьевая водопроводная.
Литература
1. Барыбин А.А., Сидоров В.Г. Физико-технологические основы
электроники. - СПб.: Лань, 2001.
. Процессы микро- и нанотехнологии / Т.И. Данилина К.И.
Смирнова, В.А. Илюшин, А.А. Величко А.А. - Томск: ТУСУР, 2005.
. Курносов А.И., Юдин В.В. Технология производства
полупроводниковых приборов и интегральных схем. - М.: Высш. шк., 1986.