Расчет профиля распределения примеси при диффузии
Министерство
образования и науки Российской Федерации
Новосибирский
государственный технический университет
Кафедра
Полупроводниковых Приборов и Микроэлектроники
Расчет
профиля распределения примеси при диффузии
Новосибирск
. Построить профиль распределения примеси при
изготовлении p-n перехода диффузией из постоянного источника
Дано:
Подложка Si n-типа
Легирующая примесь: бор





Табличные значения:=3.7эВ - энергия
активацииB=11.5см2с-1 - кажущийся коэффициент диффузии
k= 0.86 ×10-4эВ/К - постоянная
Больцмана
Решение:
Диффузия - перенос вещества, обусловленный
хаотическим тепловым движением атомов, возникающий при наличии градиента
концентрации данного вещества и направленный в сторону убывания этой
концентрации.
Диффузия из неограниченного (постоянного)
источника предполагает такое состояние системы, когда количество примеси,
уходящей из приповерхностного слоя полупроводника в его объем, равно количеству
примеси, поступающей в приповерхностный слой. Это возможно, когда концентрация
примеси источника не изменяется в процессе диффузии.
Диффузия из неограниченного источника
представляет первый этап диффузии, задача которого - введение в кристалл
определенного количества примеси. В результате образуется тонкий
приповерхностный слой, насыщенный примесью. В производстве этот этап называется
загонкой примеси.
Распределение концентрации примеси по глубине,
полученное при решении уравнения

при граничных условиях

имеет вид
 ,
,
где  -
концентрация примеси на поверхности пластины;
-
концентрация примеси на поверхности пластины;  -
функция ошибок;
-
функция ошибок;  - коэффициент
диффузии при температуре загонки;
- коэффициент
диффузии при температуре загонки;  - время загонки
[3. стр. 138].
- время загонки
[3. стр. 138].
Концентрация примеси на поверхности пластины.
Поверхностная концентрация бора  определяется
по кривым зависимости растворимости атомов примеси в кремнии для
определяется
по кривым зависимости растворимости атомов примеси в кремнии для  .
[1. стр. 182]
.
[1. стр. 182]

Коэффициент диффузии при температуре загонки
Температурная зависимость коэффициент диффузии D
определяется уравнением Аррениуса [3. стр. 136]:
 K
K
 см2с-1
см2с-1
Концентрация исходной примеси
Вводимая примесь внедряется в
монокристаллическую однослойную или двухслойную с эпитаксиальной пленкой
подложку, исходная примесь в которой распределена равномерно, Nисх определяется
по кривым зависимости удельного сопротивления от концентрации примеси.

Распределение концентрации примеси по глубине

Расчетные профили распределения бора после
загонки
Глубина залегания p-n-перехода, определенная по
графику


Рассчитанная теоретически
 мкм
мкм
. Построить профиль распределения примеси при
изготовлении p-n перехода диффузией из ограниченного источника
Дано:
Подложка Si р-типа
Легирующая примесь: фосфор






Табличные значения:

Решение:
Диффузия из ограниченного источника представляет
собой второй этап диффузии - этап разгонки. На этапе разгонки примесь,
введенная при загонке, распределяется вглубь проводника.
Распределение концентрации примеси по глубине,
полученное при решении уравнения

при граничных условиях

имеет вид
 [3. стр. 140]
[3. стр. 140]
Коэффициент диффузии при температуре загонки
Температурная зависимость коэффициент диффузии D
определяется уравнением Аррениуса [3. стр. 136]:
 K
K
 см2с-1
см2с-1
Концентрация примеси на поверхности пластины
 с
с
 см-3
см-3
Концентрация исходной примеси
Вводимая примесь внедряется в
монокристаллическую однослойную или двухслойную с эпитаксиальной пленкой
подложку, исходная примесь в которой распределена равномерно, Nисх определяется
по кривым зависимости удельного сопротивления от концентрации примеси.

Распределение концентрации примеси по глубине


Расчетные профили распределения фосфора после
загонки:
Глубина залегания p-n-перехода, определенная по
графику

Рассчитанная теоретически
 см
см
. Построить профиль распределения примеси при
получении p-n-перехода двухстадийной диффузией
Дано:
Подложка Si n- типа
Легирующая примесь: бор
Загонка примеси:


Разгонка примеси:





Табличные значения:=4.4 эВ - энергия
активацииP=1400 см2с-1 - кажущийся коэффициент диффузии
k= 0.86 ×10-4эВ/К
Решение:
Концентрация примеси на поверхности пластины
Поверхностная концентрация бора  определяется
по кривым зависимости растворимости атомов примеси в кремнии для
определяется
по кривым зависимости растворимости атомов примеси в кремнии для  .
[1. стр. 182]
.
[1. стр. 182]

рис. 1 Растворимость атомов примеси в кремнии
при различных температурах

Коэффициент диффузии при температуре загонки
Температурная зависимость коэффициент диффузии D
определяется уравнением Аррениуса [3. стр. 136]:
 К
К
 см2с-1
см2с-1
Концентрация исходной примеси
Вводимая примесь внедряется в
монокристаллическую однослойную или двухслойную с эпитаксиальной пленкой
подложку, исходная примесь в которой распределена равномерно, Nисх определяется
по кривым зависимости удельного сопротивления от концентрации примеси.

рис. 2 Зависимость удельного сопротивления
кремния от концентрации примесей при 300 К

Распределение концентрации примеси по глубине на
этапе загонки

Коэффициент диффузии при температуре разгонки
Температурная зависимость коэффициента диффузии
D определяется уравнением Аррениуса [3. стр. 136]:
 К
К
 см2с-16)
см2с-16)
Доза легирования Q1
Доза легирования Q1, т.е. число атомов примеси,
введенное в кристалл на этапе загонки за время диффузии через площадку в 1 см2.
[3. стр. 144]
 с
с
 см-3
см-3
Концентрация примеси на глубине p-n-перехода
после разгонки[3.стр.146]
На глубине p-n- перехода выполняется равенство
концентраций введенной и исходной примесей

Количество примеси Q2, которое вводится для
получения заданной поверхностной концентрации Ns2
 см-3,
см-3,
где  коэффициент
сегрегации.
коэффициент
сегрегации.
Тогда концентрация примеси на глубине p-n-перехода
после разгонки определяется как
 с
с
 см-3
см-3
Распределение концентрации примеси по глубине на
этапе разгонки

Расчетные профили распределения примеси фосфора
после загонки N1(x) и разгонки N2(x):
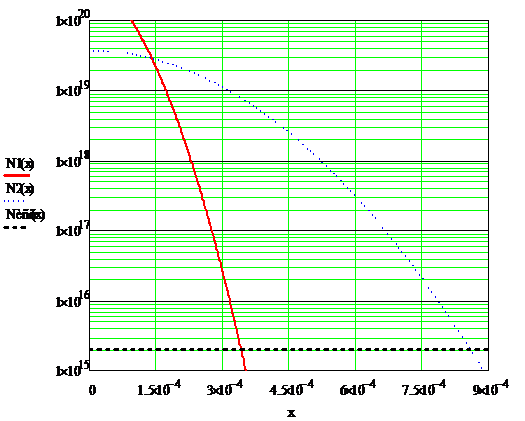
Глубина залегания p-n-перехода, определенная по
графику

Рассчитанная теоретически ,см
 см
см
4. Построить профиль распределения примеси при
получении диффузионной транзисторной структуры n-p-n и p-n-p
Дано:
Структура Si: n-p-n и p-n-p
Легирующие элементы: бор и фосфор
База.
Загонка примеси:


Разгонка примеси: 

Эмиттер.





Табличные данные:
k= 0.86 ×10-4эВ/К -
постоянная Больцмана
Бор=3.7эВ - энергия активацииB=11.5см2с-1 -
кажущийся коэффициент диффузии
Фосфор=4.4 эВ - энергия активацииP=1400 см2с-1 -
кажущийся коэффициент диффузии
Решение:
При изготовлении диффузионных транзисторов
активную структуру получают путем последовательной диффузии примесей, создающих
слои с различным типом электропроводности.
Первая диффузия является более глубокой,
последующая - более мелкой, но с более высокой концентрацией, поэтому при
двойной последовательной диффузии будут получены структуры n-p-n согласно
формуле

или p-n-p:
 ,
,
где  -
профиль распределения примеси в коллекторе;
-
профиль распределения примеси в коллекторе;  -
профиль распределения примеси в базе;
-
профиль распределения примеси в базе;  -
профиль распределения примеси в эмиттере.
-
профиль распределения примеси в эмиттере.
Подобное распределение является типичным для
получения структуры диффузионного транзистора. Первую диффузию с низкой
поверхностной концентрацией и большой глубиной называют базовой. Она служит для
создания базовой р - области. Вторую диффузию с высокой поверхностной
концентрацией и малой глубиной называют эмиттерной. Она предназначена для
получения эмиттерной области с электропроводностью n- типа. [1. стр. 185]
p-n
Концентрация примеси в коллекторе
Пусть коллектор изготовлен на основе
эпитаксиальной пленки, которая равномерно легирована по глубине, тогда
концентрация примеси в коллекторе равна концентрации эпитаксиальной пленки  и
не зависит от
и
не зависит от  :
:
 . [3. стр. 151]
. [3. стр. 151]
Найдем концентрацию донорной примеси в исходной
пластине кремния. [1.стр.186]

рис. 1 Зависимость удельного сопротивления
кремния от концентрации примесей при 300 К

Концентрация примеси в базе
Базовую диффузию осуществляют в две стадии,
поэтому её вклад в суммарное распределение отражен в виде кривой Гаусса

где  -
поверхностная концентрация в базовом слое;
-
поверхностная концентрация в базовом слое;  -
коэффициент диффузии примеси при температуре разгонки базы;
-
коэффициент диффузии примеси при температуре разгонки базы;  -
время разгонки при температуре диффузии базы.
-
время разгонки при температуре диффузии базы.

а)
рис.1Растворимость атомов примеси в кремнии при
различных температурах
Поверхностная концентрация бора  на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для
на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для  .
.

б) Температурная зависимость коэффициент
диффузии DBz определяется уравнением Аррениуса (при температуре загонки базы):
 К
К
 см2с-1
см2с-1
в) Доза легирования Q1 за время загонки [3. стр.
144]
 см-1
см-1
г) Коэффициент диффузии DBr при температуре
разгонки базы:
 К
К
 см2с-1
см2с-1
д) Количество примеси Q2, которое вводится для
получения заданной поверхностной концентрации Nsbr [3. стр. 148]
 см-1,
см-1,
где  коэффициент
сегрегации.
коэффициент
сегрегации.
е) Концентрация примеси на глубине p-n-перехода
после разгонки
 с
с
 см-3
см-3
Итоговое распределение примеси в базе:


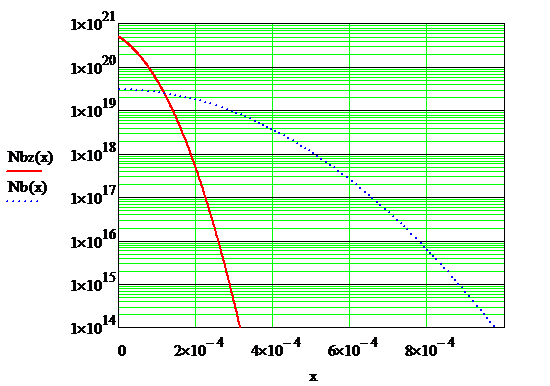
Концентрация примеси в эмиттере
Поскольку эмиттер чаще всего получают
одностадийной диффузией, то распределение примеси в нем подчиняется закону
интеграла функции ошибок

где  -
поверхностная концентрация в эмиттерной области; DE - коэффициент диффузии
примеси при температуре диффузии эмиттера;
-
поверхностная концентрация в эмиттерной области; DE - коэффициент диффузии
примеси при температуре диффузии эмиттера;  -
время диффузии эмиттера. [3. стр. 152]
-
время диффузии эмиттера. [3. стр. 152]
а) Поверхностная концентрация фосфора  на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для
на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для
 . [1. стр. 182]
. [1. стр. 182]


б) При высоких уровнях легирования, которые
имеют место в эмиттерной области биполярного транзистора, коэффициент диффузии
помимо температуры зависит ещё и от концентрации. Как показали эксперименты,
можно принять, что среднее значение коэффициента диффузии в этом случае
описывается выражением
 К
К
 см2с-1
см2с-1
Распределение примеси в эмиттере:
 с
с
 см-3
см-3
Расчетные профили распределения примеси в n-p-n-
транзисторе, полученном двойной последовательной диффузией:

см-3
Глубина залегания коллекторного перехода,
определенная по графику

Рассчитанная теоретически
 см
см
Глубина залегания эмиттерного перехода, определенная
по графику

,смn-p
Концентрация примеси в коллекторе
Пусть коллектор изготовлен на основе
эпитаксиальной пленки, которая равномерно легирована по глубине, тогда
концентрация примеси в коллекторе равна концентрации эпитаксиальной пленки  и
не зависит от
и
не зависит от 
 . [3. стр. 151]
. [3. стр. 151]
Найдем концентрацию акцепторной примеси в
исходной пластине кремния. [1. стр.186]

рис. 1 Зависимость удельного сопротивления кремния
от концентрации примесей при 300 К

Концентрация примеси в базе
Базовую диффузию осуществляют в две стадии,
поэтому её вклад в суммарное распределение отражен в виде кривой Гаусса
 ,
,
где  -
поверхностная концентрация в базовом слое;
-
поверхностная концентрация в базовом слое;  -
коэффициент диффузии примеси при температуре разгонки базы;
-
коэффициент диффузии примеси при температуре разгонки базы;  -
время разгонки при температуре диффузии базы.
-
время разгонки при температуре диффузии базы.
а) Поверхностная концентрация фосфора  на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для
на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для  . [1. стр. 182]
. [1. стр. 182]

рис. 1 Растворимость атомов примеси в кремнии
при различных температурах

б) Температурная зависимость коэффициент
диффузии DBz определяется уравнением Аррениуса (при температуре загонки базы):
 К
К
 см2с-1
см2с-1
в) Доза легирования Q1 за время загонки [3. стр.
144]
 см-2
см-2
г) Коэффициент диффузии DBr при температуре разгонки
базы:
 К
К
 см2с-1
см2с-1
д) Количество примеси Q2, которое вводится для
получения заданной поверхностной концентрации Nsbz [3. стр. 148]
 см-2,
см-2,
где  коэффициент
сегрегации.
коэффициент
сегрегации.
е) Концентрация примеси на глубине p-n-перехода
после разгонки
 с
с
 см-3
см-3
Итоговое распределение примеси в базе:
 см-3
см-3
 см-3
см-3
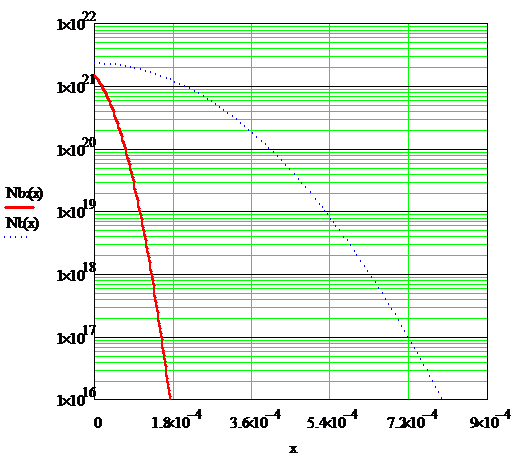
см-3
Концентрация примеси в эмиттере
Поскольку эмиттер чаще всего получают
одностадийной диффузией, то распределение примеси в нем подчиняется закону
интеграла функции ошибок

где  -
поверхностная концентрация в эмиттерной области; DE - коэффициент диффузии
примеси при температуре диффузии эмиттера;
-
поверхностная концентрация в эмиттерной области; DE - коэффициент диффузии
примеси при температуре диффузии эмиттера;  -
время диффузии эмиттера.
-
время диффузии эмиттера.
а) Поверхностная концентрация бора  на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для
на
этапе загонки определяется по кривым зависимости растворимости атомов примеси в
кремнии для
 . [1. стр. 182]
. [1. стр. 182]

рис. 1 Растворимость атомов примеси в кремнии
при различных температурах

б) При высоких уровнях легирования, которые
имеют место в эмиттерной области биполярного транзистора, коэффициент диффузии
помимо температуры зависит ещё и от концентрации. Как показали эксперименты,
можно принять, что среднее значение коэффициентов диффузии в этом случае
описывается выражением
 К
К
 см2с-1
см2с-1
Распределение примеси в эмиттере:
 с
с
 см-3
см-3
Расчетные профили распределения примеси в p-n-p
транзисторе, полученном двойной последовательной диффузией:
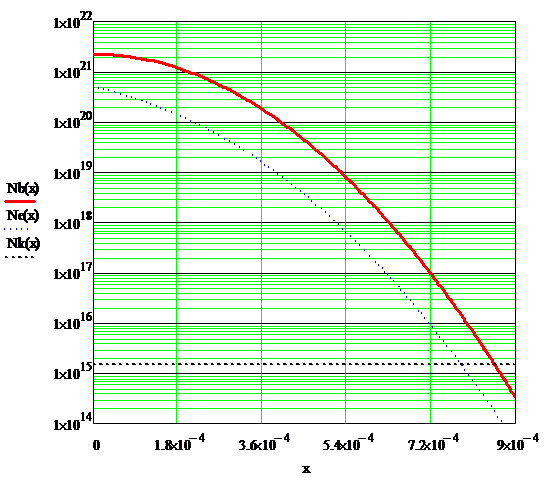
Графики распределения примеси в базе Nb(x) и
эмиттере Ne(x) не имеют точки пересечения, поэтому в условиях данной задачи
образование эмиттерного перехода p-n-p транзистора не возможно.
Список литературы
. Матсон
Э.А., Крыжановский Д.В. Справочное пособие по конструированию микросхем.- Мн.:
Выш. школа, 1982.- 224с., ил.
. Процессы
микро- и нанотехнологии: учеб. пособие/ Т.И. Данилина, К. И. Смирнова, В.А.
Илюшин, А.А. Величко; Федер. агентство по образованию, Томск. гос. ун-т систем
упр. и радиоэлектроники.- Томск: Томск. гос. ун-т систем упр. и
радиоэлектроники, 2004.- 257 с.