Метод молекулярно-лучевой эпитаксии для получения наноразмерных структур БГУИР Кр 1-41 01 04 010 Пз
Министерство
образования Республики Беларусь
Учреждение
образования «Белорусский государственный университет
информатики
и радиоэлектроники»
Факультет
радиотехники и электроники
Кафедра
микро- и наноэлектроники
Дисциплина:
Наноэлектроника
Пояснительная
записка
к
курсовой работе №10 на тему
Метод
молекулярно-лучевой эпитаксии для получения наноразмерных структур БГУИР Кр
1-41 01 04 010 Пз
Выполнил Николаенко
С.А.,
студент гр.143301
Проверил Волчёк
С.А. доц.,
канд.физ-мат.наук
Минск
2015
Введение
лучевой эпитаксия наноструктура
пленка
Данная работа посвящена методу
молекулярно-лучевой эпитаксии (МЛЭ) и тому, как с помощью него можно получать
различные наноструктуры.
В истории часто наступает такой момент, когда
воплощение идеи создания прибора на полупроводниках ограничивается предельными
возможностями технологий. Такой момент наступил и тогда, когда размерность
создаваемых структур достигла сотен ангстрем. Реализация структур таких
масштабов с помощью жидкофазной эпитаксии или газотранспортными методами
оказалась весьма затруднительной. Тут и пришёл на помощь метод МЛЭ. По сути,
это значительно улучшенный метод вакуумного испарения. Обычный метод вакуумного
испарения порой применяется для создания металлических плёнок. Но с помощью МЛЭ
удаётся осуществлять гетероэпитаксию разнородных материалов, выращивая,
например, соединения АIIIBV на кремниевых или диэлектрических подложках, что
чрезвычайно важно для монолитной интеграции оптоэлектронных и
интегрально-оптических систем на арсениде галлия с вычислительными модулями или
другими системами обработки информации на кремнии. Таким образом, можно
получать многослойные и периодические структуры (типа квантовых сверхрешёток) с
заданными параметрами, что даёт фантастические возможности управления энергетическим
спектром носителей заряда.
1. Метод молекулярно-лучевой эпитаксии
.1 Основы метода и оборудование для его
осуществления
Как было уже сказано, МЛЭ является улучшенной
версией вакуумного напыления и получила широкое распространение в начале 70-х, когда
появилось промышленное вакуумное оборудование. Степень усложнения определяется
только целями, поставленными в конкретном исследовании. Рост плёнок при МЛЭ
определяется в основном кинетикой взаимодействия пучков с поверхностью
кристалла, в отличие от других методов, таких как жидкостная эпитаксия или
химическое осаждение, которые происходят в условиях близких к равновесным.
Рабочий объём (РО) установки для проведения МЛЭ
(рисунок 1.1[2]) делается из нержавеющей стали. Для создания сверхвысокого
вакуума (P=10-10Торр) РО обезгаживается многочасовым прогревом до температур
около 300 - 400 оС. Для прогрева стенки РО окружены резистивными нагревателями,
покрытыми сверху асбестовым теплоизолятором и алюминиевыми защитными кожухами.
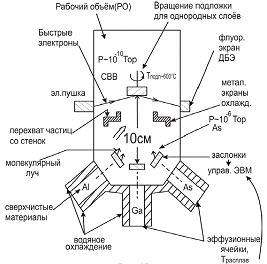
Рисунок 1.1 - Схема установки для проведения
молекулярно-лучевой эпитаксии
Образующиеся за счёт испарения особо чистых
исходных веществ в эффузионных ячейках (рисунок 1.1) в условиях сверхвысокого
вакуума пучки атомов и (или) молекул сходятся на поверхности чистой и точно
ориентированной вращающейся подложки. Вращение необходимо для однородности
роста слоёв. Иногда применяются источники с металлоорганикой, источники с
газообразными гидридами или некоторой комбинацией таких источников. Первоначально
попадающие на поверхность атомы и молекулы адсорбируются и десорбируются, а
молекулы могут диссоциировать. Для перехвата частиц, испаряющихся со стенок,
внутри РО стоят металлические экраны, охлаждаемые жидким азотом.
Иногда, чтобы избежать возврата испарившихся
частиц в эффузионную ячейку, применяются ячейки Кнудсена (рисунок 1.2[2]).
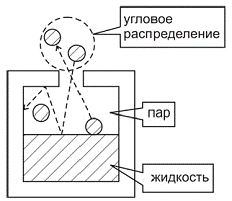
Рисунок 1.2 - Ячейка Кнудсена.
Здесь излучающая поверхность расплава окружена
экраном с маленьким отверстием, которое и является источником испаряемых
частиц. Это отверстие в экране должно быть меньше длины свободного пробега
частиц при заданном давлении и толщина стенок отверстия должна быть как можно
меньше. При этих условиях влетающие в отверстие частицы не смогут влететь
обратно. Это позволяет избежать неопределённости в расчёте потока частиц и
усилить контроль над ним.
Постоянная интенсивность потока атомов
обеспечивается строгим контролем температуры. Для этого применяются термопары,
ИК-датчики и оптический пирометр. Для легирующих элементов обычно применяются
источники с резистивным нагревом. Нагреватели располагаются так, чтобы
максимумы интенсивностей потоков от источников пересекались на подложке.
При правильно выбранном отношении интенсивностей
падающих пучков и температуре подложки на поверхности из адсорбированных атомов
образуется сплошная монокристаллическая плёнка, растущая слой за слоем и
имеющая заданный стехиометрический состав. Эпитаксия идёт успешно, если
параметры решётки подложки и растущего слоя совпадают. Чтобы между слоями
сохранялось соответствие кристаллических решеток, важно точно контролировать
скорости роста моноатомных слоев.Поскольку процесс МЛЭ происходит в
сверхвысоком вакууме на чистой поверхности, его можно контролировать с помощью
таких диагностических методов, как дифракция отражённых быстрых электронов
(ДОБЭ), электронная оже-спектрометрия (ЭОС), рентгеновская фотоэлектрическая
спектроскопия (ФЭС) и т.д., поместив в систему соответствующую аппаратуру
вместе с устройством для контроля интенсивности пучков и ионной пушкой для
очистки поверхности.
Расстояние от источника до подложки составляет
примерно 10 см в лабораторных установках МЛЭ с малым размером подложек. В
промышленных установках это расстояние больше, так как там подложки больше и
требуется большая степень однородности слоя вдоль их поверхности.
В работах Эсаки и Цу было предложено создавать
потенциал сверхрешётки посредством периодического изменения состава или
легирования в процессе эпитаксиального роста. Теоретические расчёты показали,
что дополнительный сверхрешёточный потенциал видоизменяет зонную структуру
основного материала.
Принято считать, что молекулярно-лучевая
эпитаксия обычно происходит так далеко от равновесия, что применение
термодинамики для описания процесса едва ли уместно. Однако, при условиях,
когда получаются слои наилучшего качества, оказалось, что влияние кинетических
барьеров на термодинамические предсказания незначительны. Концентрация
неравновесных дефектов может быть уменьшена до величины порядка 10-9.
Потенциальные примеси и примеси, которые нельзя использовать, могут быть
определены без обращения к МЛЭ из существующих данных по химической
термодинамике. Кинетические барьеры редко затрагивают стадию внедрения
примесей.
Причиной столь хорошего приближения к равновесному
состоянию является малая скорость роста при МЛЭ. В случае GaAs при 600 оС и при
энергии активации для поверхностной диффузии, равной 1 эВ, атом сменит 106
мест, прежде чем встроится в решётку. Для создания резких переходных областей
скорость роста плёнки должна быть несколько ангстрем в секунду, а объёмная
диффузия должна быть пренебрежимо мала.
Основные физические свойства некоторых
используемых элементов при МЛЭ можно найти в приложении А.
.2 Преимущества и недостатки метода
МЛЭ обеспечивает предельно высокое качество и
самих плёнок и границ между ними; тем самым она удовлетворяет требованиям,
необходимым для создания совершенных полупроводниковых гетероструктур:
одиночных гетеропереходов, изолированных потенциальных ям, периодических и
многослойных систем. МЛЭ позволяет выращивать плёнки любой толщины - вплоть до
моноатомных - с заданным химическим составом и концентрацией примесей. Как уже
было сказано, с помощью этого метода можно также осуществлять гетероэпитаксию
разнородных материалов, что весьма важно для оптики. Целый спектр возможностей
анализа и контроля, устраняющие большую часть сомнений, дают МЛЭ существенные
преимущества перед другими технологическими методами. Перечислим важнейшие
задачи, решение которых обеспечивается специфическими чертами МЛЭ:
Получение монокристаллов высокой чистоты - за
счёт роста в сверхвысоком вакууме и высокой чистоты потоков веществ;
Выращивание сверхтонких структур с резкими
изменениями состава на границах - за счёт относительно низких температур роста,
препятствующих взаимной диффузии;
Получение гладких бездефектных поверхностей для
гетероэпитаксии - за счёт ступенчатого механизма роста, исключающего
возможности зародышеобразования;
Получение сверхтонких слоёв с контролируемой
толщиной - за счёт точности управления потоками и относительно малых скоростей
роста;
Создание структур со сложными профилями состава
и (или) легирования;
Создание структур с заданными внутренними
напряжениями растяжения или сжатия, локально модифицирующими зонную диаграмму,
- «зонная инженерия»;
Получение прямозонных сверхрешёток из
непрямозонных материалов за счёт дробления зоны Бриллюэна под влиянием нового
периода сверхрешётки.
Однако низкая скорость роста плёнки и
дороговизна метода не позволяет применять этот метод в массовом производстве. К
недостаткам также можно отнести небольшую площадь загрузки и то, что в данном
методе сложно поддерживать высокий вакуум.
2. Создание наноструктур с помощью
молекулярно-лучевой эпитаксии
.1 Подготовка подложек
Подложку GaAs сначала кипятят в трихлорэтилене,
промывают в ацетоне и метаноле, а затем обрабатывают фильтровальной бумагой,
пропитанной бромметанольным полирующим травителем. После промывки в метаноле и
деионизованной воде подложку в течение 10 мин травят в отстоявшейся смеси
H2SO4:H2O2:H2O (4:1:1) при 60 оС, вновь промывают в деионизованной воде, а
затем травят в течение 5 мин в HCl для удаления с поверхности любого окисла или
органического вещества. В заключение подложку для пассивации промывают в
деионизованной воде и сушат в потоке очищенного азота. После этого подложка
крепится на прогретый (160 оС) молибденовый держатель с помощью индиевого
припоя и немедленно помещается в установку МЛЭ.
Подготовка подложек InP во многом сходна с GaAs.
Поскольку InP значительно «мягче», чем GaAs, небольшое давление на подложку
может создать дислокации. Процедура обработки начинается с обезжиривания путём
кипячения в трихлорэтилене и ацетоне с последующей промывкой в метаноле и
травлением в КОН. Дефекты механической обработки (резки) удаляют полировкой подложки
до зеркального состояния фильтровальной бумагой, пропитанной смесью 0,5% Br2 -
метанол. Затем подложку травят в растворе H2SO4:H2O2:H2O (4:1:1) в течение 10
мин, после чего в течение 3 мин в смеси 0,3% Br2 - метанол. В течение 1 мин
подложку вновь пассивируют в воде и сушат очищенным азотом. Было установлено,
что в отличие от подложек GaAs оксид на подложках InP не испаряется даже при
температуре разложения подложки. Поэтому очистка подложки InP включает в себя
дополнительно облучение пучком As или P, направленным на подложку с целью
предотвратить её разложение при высокой температуре.
Для контроля чистоты подложки применяется
электроннаяоже-спектроскопия.
.2 Анализ в ходе роста
На раннем этапе развития МЛЭ основную роль для
понимания процессов роста играл анализ поверхности в процессе нанесения плёнки.
По мере совершенствования технологии и в связи с использованием современных
систем МЛЭ в производстве приборов существенными остались лишь дифрактометр
быстрых электронов и датчик ионов в камере роста. Масс-спектрометр остаётся
удобным средством обнаружения течи в вакуумной системе или измерителем
остаточного давления водяных паров.
В первое время масс-спектрометр применялся для
изучения кинетики адсорбции-десорбции атомов на твёрдых поверхностях. Он
позволял определить время жизни адсорбированного атома, коэффициент прилипания
и энергию активации для некоторых элементов на поверхности.
Однако в камере роста обязательно должна
находиться аппаратура ДБЭ (дифракция быстрых электронов), так как она даёт
информацию о чистоте подложки и условиях роста. Она используется в течение
первых пяти минут каждого из циклов роста. Электронная пушка не должна
действовать в течение всего процесса роста, потому что она может создать
избыточные водяные пары и другие загрязнения. Слишком большой поток электронов
может даже полимеризовать остаточные углеводородные газы, приводя к углеродному
загрязнению подложки.
Анализируя картину ДБЭ, мы можем считать
кристалл как совокупность параллельных плоскостей, в которых находятся атомы.
Хорошо известный закон Брэгга, связывающий длину волны и угол дифракции
электронного пучка, может быть записан в виде:
 ,
,
где  -
расстояние между плоскостями,
-
расстояние между плоскостями,  - угол падения,
- угол падения,  -
дебройлевская длина волны электрона:
-
дебройлевская длина волны электрона:
 .
.
 ,
,
где  -
расстояние между подложкой и флуоресцирующим экраном (постоянное для прибора),
а
-
расстояние между подложкой и флуоресцирующим экраном (постоянное для прибора),
а  -
удвоенное расстояние между дифракционными точками на экране.
-
удвоенное расстояние между дифракционными точками на экране.
Электронная оже-спектроскопия полезна при
изучении поверхности с концентрацией примеси, превосходящей 1% от общего числа
поверхностных атомов. Она недостаточно чувствительна для изучения типичных
уровней легирования в полупроводниковых приборах, где концентрация примесей
порядка одной миллионной. На начальном этапе оже-спектроскопия использовалась
при очистке поверхности от кислородных и углеродных загрязнений.
.3Выращивание методом молекулярно-лучевой
эпитаксииплёнок из соединений AIIIBV
Эпитаксиальный рост соединений AIIIBV с помощью
МЛЭ включает следующую последовательность событий:
Адсорбция соответствующих атомов и молекул;
Миграция на поверхности и диссоциация
адсорбированных молекул;
Присоединение атомов к подложке, приводящее к
зародышеобразованию и росту.
Выращенная тонкая плёнка имеет
кристаллографическую структуру, определяемую структурой подложки.
Для соединений AIIIBV пассивирующий слой служит
защитой свежетравлёной подложки от атмосферных загрязнений перед эпитаксиальным
ростом. После того, как система МЛЭ откачана, экран охлаждён жидким азотом и
эффузионная ячейка выведена на требуемую температуру, начинается нагрев
подложки. В случае GaAs оксид на подложке десорбируется в интервале 580 - 600
оС, а в случае InP - приблизительно при 520 оС, после чего подложка становится
почти атомно чистой и пригодной для эпитаксиального роста.
Чтобы между слоями сохранялось соответствие
кристаллических решеток, важно точно контролировать скорости роста моноатомных
слоев. Для калибровки этих скоростей роста применяются несколько способов:
.Измерение скорости роста с помощью счета
монослоев по колебаниям интенсивности на экране ДБЭ пятна зеркального отражения
пучка от поверхности подложки. Для создания многих приборов СВЧ-электроники и
оптоэлектроники требуются структуры с определёнными кинетическими
характеристиками и такими скачками ширины запрещённой зоны и коэффициента
преломления на гетерограницах, которые бы обеспечивали зарядовое и оптическое
ограничения. Для высококачественных слоёв, которые могут использоваться в
производстве приборов, гетеропереходы должны образовываться веществами с
согласующимися периодами решётки. Этим требованиям удовлетворяют многие системы
AIIIBV, некоторые из них представлены на рисунке 2.1 [1]. На этом рисунке
показана зависимость ширины запрещённой зоны от постоянной решётки для
некоторых тройных и четверных твёрдых растворов. Линии, соединяющие точки,
отвечающие бинарным соединениям, показывают ширину запрещённой зоны и
постоянную решётки тройных соединений с переменным составом.
Поведение частиц при росте AlxGa1-xAs.Когда
частицы из пучка достигают подложки, перед ними есть 5 путей дальнейшего
поведения: 1) адсорбироваться на поверхности, 2) мигрировать по поверхности, 3)
взаимодействовать с другими атомами, 4) проникнуть вглубь подложки, 5)
десорбироваться с поверхности (рисунок 2.2 [2]). Есть 3 основных контролируемых
параметра, влияющих на выбор одного из этих путей: 1) тип поверхности, 2)
температура подложки, 3) плотность потока падающих частиц.
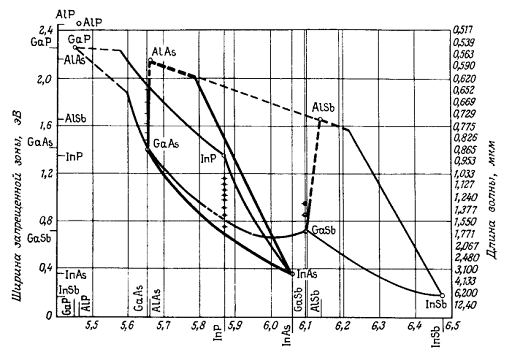
Рисунок 2.1 - Ширина запрещённой зоны и
постоянная решётки для ряда соединений AIIIBV.

Рисунок 2.2 - Пути поведения частиц, достигших
подложки.
При обычных для выращивания GaAs температурах
подложки 580 оС - 650 оС частицы мышьяка As преимущественно следуют по пути
десорбции с поверхности.Поэтому во избежание избытка Ga в растущем слое
приходится повышать плотность потока As в пучке, то есть проводить процесс в
условии избыточного давления Аs. С другой стороны, известен факт, сильно
облегчающий рост слоя со стехиометрическим составом GaAs. Присутствие атомов
Ga, адсорбированных на поверхности, сильно увеличивает вероятность адсорбции молекул
As2. Коэффициент прилипания КAs частиц As к подложке пропорционален потоку Ga и
достигает КAs=1 для частиц As2 и КAs=0,5 для частиц As4. Этот эффект (близкий к
ныне популярной «самоорганизации» молекул) приводит к стехиометрическому росту
GaAs слоя в широком диапазоне температур подложки и избыточного давления A
На качестве AlxGa1-xAs слоя сильно сказывается
поверхностная подвижность атомов Al и Ga. Если атомы диффундируют по
поверхности до края моноатомной ступеньки и к ней присоединяются, то рост слоя
происходит «гладко», без образования отдельных островков. Подвижность атомов Al
и Gaзависит от наличия других атомов Al и Ga на поверхности, от типа
поверхности, от её темературы и от величины избыточного давления As. Чем выше
температура и чем меньше избыточное давление, тем больше поверхностная
подвижность атомов Al и Ga. Поэтому желательно для «гладкого» роста AlxGa1-xAs
слоя процесс проводить при повышенной температуре подложки (но не выше
максимальной температуры единичного коэффициента прилипания) и при пониженном
избыточном давлении As (но не ниже минимального давления As для равновесия с
Ga). Для гладкого роста AlxGa1-xAs слоя желательно увеличение поверхностной
подвижности атомов Al и Ga, чтобы они присоединялись к краям одной моноатомной
ступеньки, а не образовывали отдельные AlGaAs островки (рисунок 2.3 [2]).
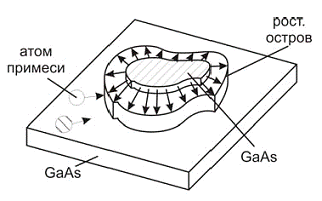
Рисунок 2.3 -AlGaAs островок.
Кроме повышения температуры подложки и понижения
избыточного давления As для получения такого эффекта опробованы еще три
способа:
Чтобы медленно диффундирующие по поверхности
атомы добрались до края моноатомной ступеньки, можно предоставить им большее
время, то есть проводить процесс на малых скоростях роста порядка 0,1
GaAsмонослой/c. Но при таком замедлении роста увеличивается вероятность
загрязнения растущего слоя примесными атомами из атмосферы рабочего объема,
несмотря на сверхвысокий вакуум.
Чтобы атомы As не препятствовали поверхностной
диффузии атомов Al и Ga, можно на время этой диффузии закрывать заслонку As.
Этот способ опробован и получил название «эпитаксия с усиленной миграцией», но
требует очень сложного быстродействующего (менее 0,1 с) механического
устройства заслонки Asэффузионной ячейки.
Чтобы атомы Al и Gaбыстрее добрались до края
ближайшей моноатомной ступеньки, можно увеличить поверхностную плотность этих
ступенек. Для этого при изготовлении подложки её вырезают из полупроводникового
кристалла не поперек кристаллографического направления (100), а под небольшим
углом к нему. На поверхности такой подложки всегда много моноатомных ступенек,
и рост слоя идет без образования островков. Но именно по этой причине
становится невозможным счёт монослоёв по колебанию интенсивности зеркального
пятна на экране ДБЭ.
Пленки нитридов AlN, GaN, InN перспективны как
барьерные слои туннельных гетероструктур благодаря своей большой ширине
запрещенной зоны, а также для акустооптических гетероструктур. Для их
выращивания нужно иметь газообразный азот N2 в активной форме возбуждённых
молекул (радикалов) N2*, чтобы облегчить разделение молекулы N2 на два атома N
для химических связей с остальными реагентами. В МЛЭ для получения активного
азота применяют гидразин, активацию при столкновении с быстрыми частицами и
плазменную активацию (рисунок 2.4 [2]). Для плазменной активации можно
использовать все вышерассмотренные комбинации ионно - плазменных источников,
включая магнетроны, например, источники с электронным циклотронным резонансом и
ВЧ - разряд. Из-за необходимости поддерживать давление ниже 10-4Торр поток
азота нельзя сделать большим, поэтому скорости роста оказываются меньше 0,1
мкм/час, что на порядок ниже обычных скоростей МЛЭ. Чтобы в пленке не было
дефектов, при активации следует избегать образования частиц с энергией больше
десятка эВ, либо не допускать их попадания на пленку.
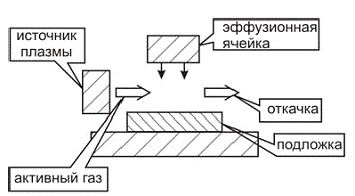 Рисунок 2.4 - Схема
плазменной активации.
Рисунок 2.4 - Схема
плазменной активации.
Пленки GaN выращивались на подложках GaAs при
550 - 630 оС и на подложках Al2O3 (сапфир) при 550 - 800 оС. Для активации
азота применялся магнетронный коаксиальный источник (межэлектродный промежуток
сантиметровой ширины и 5 см длины) с высокочастотным (ВЧ) - емкостным
возбуждением разряда на частоте 13,56 МГц мощностью до 100 Вт в аксиальном
магнитном поле с индукцией 0,8 Тл, создаваемом электромагнитными водоохлаждаемыми
катушками. В рабочий объем активированный азот поступал через диафрагму из
пиролитического нитрида бора с сотней отверстий по 0,5 мм и удалялся
турбомолекулярным насосом с производительностью около 350 л/c. Разряд стабильно
горел в разрядной камере источника при давлении от 10-3 до 1 Торр, индукции
магнитного поля 0,5 Тл и минимальной вводимой ВЧ - мощности 5 Вт. Перед началом
выращивания подложка выдерживалась в потоке активированного азота. Во время
роста наблюдалась дифракционная картина поверхностной структуры GaN (2х2) на
экране ДБЭ.
Для выращивания пленки AlN на подложках Si
применяли аналогичный ВЧ - источник плазмы с мощностью 500 Вт. Расход азота N2
составлял 1см3/мин при рабочем давлении 10-5Торр с откачкой турбомолекулярным
насосом с максимальной производительностью 1500 л/с. Подложки Si(111) p - типа
проводимости с удельным сопротивлением 5*103 Ом*см очищались от окисного слоя в
рабочей камере нагревом до 920 оС. При температуре 780оС на экране ДБЭ
появлялась дифракционная картина поверхностной структуры Si(111) типа (7х7), а
при температуре 830 оС картина типа (1х1). При уменьшении температуры структура
типа (7х7) восстанавливалась.
Выращивание AlN начиналось с осаждения 1/3
монослояAl из стандартной эффузионной Al ячейки на поверхность Si(111) типа
(7х7) при 700 оС. Далее включался источник плазмы для нитридизации этой
поверхности, пока ее структура не становилась типа (1х1) с линейными рефлексами
(полосами или тяжами) на экране ДБЭ. Затем температура подложки постепенно
повышалась до конечной температуры эпитаксии (850 - 900 оС). При дальнейшем
росте потока Al картина ДБЭ тускнеет, и на подложке появляются алюминиевые
капли и трещины глубиной около 1 нм, измеренные атомно - силовым микроскопом.
Проверена и другая последовательность шагов
начала выращивания AlN, когда вместо осаждения 1/3 монослояAl поверхность
Si(111) типа (7х7) сразу нитридировалась в течение 2 - 3 с, в результате чего
появлялась структура типа (3х3), а затем открывалась заслонка Al ячейки. Если
такую нитридизацию проводить дольше, чем 2 - 3 с, то структура (3х3) пропадает
и появляется слой поликристаллического кремния.
Для выращивания пленки InGaAsN на подложках GaAs
применяли источник плазмы на источнике постоянного напряжения 3 кВ, 100 мА с
расходом азота от 0,1 до 5 см3/мин. На полуизолирующей подложке GaAs (100)
после выращивания буферного слоя GaAs при температуре 580 оС толщиной 100 нм
делали перерыв роста 5 мин, в течение которого уменьшали температуру подложки
до 450 оС, поджигали и стабилизировали азотную плазму. Выращенные слои InGaAsN
закрывали сверху защитным слоем GaAs толщиной 20 нм. Скорость роста составляла
1 монослой/c, а давление As по ионному датчику (ионизационной лампе)
поддерживалось 2*10-5Торр.
При малом токе плазменного источника менее 10 мА
поверхность пленки гладкая, и дифракционная картина на экране ДБЭ состоит из
полос (тяжей) в течение всего роста, что говорит о двумерном (плоском,
безостровковом) росте пленки. При умеренном токе 20 - 30 мА поверхность пленки
по-прежнему гладкая, но картина ДБЭ штриховая - смесь полос и точек (тяжей и
пятен), что говорит о появлении зерен (островков). Наконец при большом токе
плазменного источника 45 мА поверхность пленки матовая и шероховатая, и
дифракционная картина ДБЭ состоит из точек (пятен), то есть пленка не образует
сплошного слоя, а состоит из отдельных зерен. Эта зернистость здесь появляется
сразу, с самого начала выращивания, а не после прохождения некоторого
переходного слоя, как это получается в случае роста напряженных InAs квантовых
точек (КТ) на GaAs или при выращивании Ge КТ на подложках Si или CaF2/Si.
Нелегированный GaAs обычно имеет проводимость
р-типа с концентрацией дырок при 300 и 78 К, равной 7,8*1013 и 2*1013 см-3
соответственно. Первые выращенные методом МЛЭ слои GaAs имели при 78 К
подвижность выше 105 см2/В*с; слои легировались Sn и имели концентрацию
носителей 4*1014 см-3. Позднее при использовании в качестве источника AsH3 были
выращены чистые нелегированные слои GaAs, имевшие концентрацию электронов
2*1014 см-3 и подвижность 133000 см2/В*с при 55 К. Чистые слои GaAs,
выращиваемые на промышленной установке МЛЭ с твёрдым источником As, в
отсутствие преднамеренного легирования являются полуизолирующими.
Интенсивность фотолюминесценции GaAs растёт с
температурой эпитаксиального роста.
Были изучены явления переноса на слоях
AlxGa1-xAs, легированных Sn и Si. Обнаружена резкая зависимость подвижности от
температуры подложки в процессе роста. Более низкая температура подложки
приводила к меньшей подвижности электронов. Было установлено также, что при
постоянном потоке примеси Sn концентрация электронов уменьшается по мере роста
молярной доли AlAs. При увеличении доли AlAs от 0,17 до 0,375 энергия связи
доноров растёт от значения менее 3 мэВ до 40 мэВ.
Как и в случае GaAs, интенсивность
фотолюминесценции в AlxGa1-xAs растёт с повышением температуры эпитаксиального
роста.
Система GaxIn1-xAs имеет высокую подвижность и
большую дрейфовую скорость, что делает этот материал перспективным для создания
высокочастотных полевых транзисторов и приборов быстродействующей логики.
Подвижность электронов в Ga0.47In0.53As, легированном как Sn, так и Si, при 77
и 300 К хорошо согласуется с теоретическими значениями, учитывающими сильное
рассеяние. Нелегированные слои имели проводимость n-типа с концентрацией
2,4*1015см-3; темновая подвижность для них лежала в интервале от 7800 до 8800
см2/В*с при 300 К и от 35000 до 40000 см2/В*с при 77 К. Освещение увеличивало
максимальное значение подвижности до 45000 см2/В*с при температуре жидкого
азота.
Примеси, концентрацию которых можно измерить при
температуре 300 или 77 К с помощью стандартного метода Холла, называются
мелкими.
Типичный нелегированный GaAs, выращенный в
установках МЛЭ, имеет p-тип проводимости. Общепринято, что ответственной за это
фоновой примесью является выступающий в роли акцептора замещения углерод,
который имеет энергию связи 25 мэВ.
Точные сведения относительно источника углерода
отсутствуют, однако наиболее вероятной является реакция оксида или диоксида
углерода с поверхностными атомами мышьяка или галлия, приводящая к выделению
кислорода в виде летучих оксидов мышьяка или галлия и свободных атомов
углерода.
Чтобы уменьшить внедрение примесей,
обусловленных остаточной атмосферой, необходимо понизить до минимума плотность
молекул остаточной атмосферы и степень их возбуждения. Для этого должны быть
выключены все нити накала, не необходимые в ходе эпитаксии. Помогает также
уменьшение температур ячеек, находящихся в статическом состоянии и не
используемых в данном эпитаксиальном процессе. Также обязательным является
отсутствие во время роста временных или пространственных колебаний температуры
на поверхностях, охлаждаемых жидким азотом, так как это приводит к изменениям
адсорбции и десорбции компонент остаточной атмосферы.
Другими мелкими акцепторами являются кремний и
марганец, но кремний проявляет преимущественно донорные свойства (кремний
амфотерен). В процессе МЛЭ отсутствует источник кремния. Но если в качестве
источника As2 используется объёмныйGaAs, то температура ячейки достаточно
высока, чтобы из GaAs наряду с As2 поступал и Si, приводящий к легированию
эпитаксиальных плёнок. Использование GaAs в качестве источника имеет то
преимущество, что при этом образуется поток двухатомных молекул As2, а не
четырёхатомных As4, которые находятся в термодинамическом равновесии с
элементарным мышьяком при ~ 300 - 350 оС. Переход в различных лабораториях к
использованию источником с термическим разложением As4 снял необходимость
применения GaAs для получения пучка As2 и, таким образом, кремний как фоновый
акцептор в типичных условиях более не наблюдается. Использование As2 может
привести к уменьшению концентраций глубоких уровней.
Нагретые детали установки из нержавеющей стали
выделяют Mn, который затем встраивается в растущие плёнки. Было обнаружено, что
при термообработке объёмного легированного хромом полуизолирующегоGaAs на
поверхности образуется проводящий слой, причиной которого является увеличение
поверхностной концентрации Mn (p-типа) и в некоторых случаях Sin-типа.
Известно, что Mn имеет высокий коэффициент диффузии в GaAs, но в случае роста
при температурах ниже 620 оС диффузия Mn несущественна. Таким образом, можно
полагать, что Mn в плёнках, полученных методом МЛЭ, появляется вследствие
накопления его на поверхности подложки в ходе её термообработки перед эпитаксией.
На основе современного понимания процессов внедрения фоновых примесей в GaAs
были разработаны методы наращивания объёмного GaAs с высоким сопротивлением, не
содержащего хрома и сопутствующего марганца. Таким образом, теперь
накапливающиеся на поверхности концентрации Mn обычно незначительны.
Наряду с кремнием свинец и сера тоже являются
фоновыми донорными примесями (рисунок 2.5 [1]). Но присутствие свинца
проявляется лишь в образцах, выращенных с использованием источников AsH3.
Количественные оценки дать трудно, но высокие значения подвижности при
температуре азота показывают, что концентрации чрезвычайно малы (ниже 1014
см-3), поскольку в нормальных условиях основными носителями являются дырки.
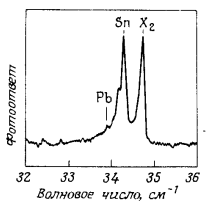
Рисунок 2.5 - Спектр фотометрической ионизации
образца GaAs, выращенного методом МЛЭ; В=4,92 Тл. Видны пики, обусловленные Sn,
Pbи неизвестным донором.
Также довольно часто встречаются фоновые
глубокие центры (глубокие уровни), которые выступают в роли ловушек для
носителей заряда. В этих ловушках происходит безызлучательная рекомбинация
зарядов. Первыми и наиболее постоянными источниками глубоких уровней являются
подложки. Например, в плёнках, выращенных на полуизолирующем GaAs, присутствуют
хром, медь и в некоторых случаях железо, которые выступают в качестве ловушек
для дырок.Электронными ловушками могут быть стехиометрические дефекты. Обычно
концентрация ловушек для дырок превосходит концентрацию ловушек для электронов
на два порядка.
В твёрдых растворах, выращенных методом МЛЭ и
содержащих AlAs, довольно часто встречается единственный глубокий уровень,
обусловленный кислородом. Чтобы избежать его появления, необходимо выращивать
данные растворы при температурах выше 650 оС. Но выращивать без разложения
твёрдые растворы, содержащие InAs, при температурах существенно выше 550 оС
можно лишь при использовании чрезвычайно больших избыточных потоков As4.
2.3 Выращивание методом молекулярно-лучевой
эпитаксии плёнок из соединений AIIBVI и AIVBVI
Выращивание соединений AIIBVI и AIVBVI и их
твёрдых растворов методом МЛЭ обусловлено как прикладными интересами, так и
предоставляемой данной технологией возможностью получения наноструктур с
квантовыми ямами, которые позволяют исследовать физические свойства узкозонных
полупроводников. Материалы, образованные элементами Zn, Cd, Hg, S, Se, Te,
представляют полупроводники с кристаллической решёткой цинковой обманки,
обладающие различными значениями ширины запрещённой зоны. Соединения AIVBVI
составляют материалы или твёрдые растворы, образованные элементами групп IVA и
VIA, в частности халькогениды олова и свинца. Эти материалы и некоторые
халькогениды редкоземельных элементов представляют собой полупроводники с
кристаллической решёткой каменной соли с различными значениями ширины запрещённой
зоны.
Причины быстрого развития технологических
методов по выращиванию и исследованию соединений AIIBVI и AIVBVI:
Фотодетекторы на основе Hg1-xCdxTe для устройств
получения тепловых изображений. Диоды на гетеропереходах CdTe/Hg1-xCdxTe.
Лазеры на основе соединений AIVBVI для
перестраиваемых инфракрасных источников.
Электролюминесцентные приборы - панели на
соединениях ZnS, ZnSe, ZnTe1-xSex на переменном или постоянном токе.
Солнечные элементы на соединениях AIIBVI: CdTe,
CdS.
СверхрешёткиHgTe - CdTe и др.
Помимо приборных применений данный метод можно
использовать для получения структур с квантовыми ямами, поскольку их можно
рассматривать в качестве особого класса с новыми оптическими и электрическими
свойствами.
Широкозонные полупроводники AIIBVI (Zn, Cd:S,
Se, Te) очень перспективны в с точки зрения применения в оптоэлектронных
приборах, таких как коротковолновые (видимого света) излучающие диоды,
электролюминесцентные панели, оптические волноводы и фотоэлектрические
солнечные элементы.
Узкозонный полупроводниковый твёрдый раствор
Hg1-xCdxTe обладает почти идеальными электрическими свойствами для
использования в качестве детектора инфракрасного излучения. Хотя он и заменил в
этой области соединения группы AIVBVIPb1-xSnxTe и подобные им соли свинца, эти
материалы ещё сохраняют своё значение для использования в перестраиваемых путём
изменения температуры инфракрасных лазерах, используемых в спектроскопии и для
регистрации загрязнений. Основной причиной предпочтения, которое следует отдать
Hg1-xCdxTe в качестве универсального материала для детекторов, является большое
различие в коэффициентах теплового расширения между соединениями AIVBVI и
кремнием.
Скорость диссоциации эпитаксиальной плёнки
устанавливает жёсткий верхний предел температуры роста при данной интенсивности
первичных осаждающихся пучков. Кроме того, если рост происходит из отдельных
элементарных составляющих, один из которых может быть димером (или тетрамером),
то необходимость диссоциации димера на поверхности роста может в принципе
устанавливать нижний температурный предел роста соединения стехиометрического
состава. К нестехиометрическому росту могут приводить также флуктуации потока
исходных веществ, если оба компонента обладают единичным коэффициентом
прилипания, как это имеет место при низкой температуре подложки. Последнюю
проблему можно решить, если в качестве источника использовать соединение,
которое при заданной температуре ячейки Кнудсена испаряется конгруэнтно.
Кроме соединения HgSe (которое разлагается на Hg
и в основном полимерные молекулы высокого порядка Sem) все соединения
AIIBVIдиссоциируют в соответствии с уравнением:
МХ(тв) → М(газ) + 1/2Х2(газ),
где М - металл, а Х - элемент 6-й группы.
Для выращивания соединений AIIBVI и их твёрдых
растворов использовались раздельные источники входящих в соединение элементов.
Но вследствие неизбежных в этом случае флуктуаций отношения интенсивностей
первичных пучков плёнки удовлетворительного качества получались только при
высоких температурах роста, когда действует механизм саморегуляции. Этот режим
имеет место при такой температуре роста, когда оба элемента летучи и
единственной возможностью для встраивания атомов является реакция на
поверхности с образованием соединений типа AIIBVI.
Испарение соединений AIVBVI происходит в
основном в виде молекул:
МХ(тв) → МХ(газ)
Образование сильных внутримолекулярных связей
IV-VI происходит вследствие эффекта «инертной пары электронов», при котором
электроны внешней S-оболочки металла IV группы не участвуют в образовании
внутримолекулярной связи. Это является причиной большего перекрытия
р-электронов внешних оболочек атомов как IV, так и VI группы. Тот же эффект
лежит в основе слабости внутримолекулярной связи II-VI. В небольших количествах
наблюдаются также неосновные составляющие разложения паров М, Х, Х2, М2Х, М2Х2.
Это иллюстрирует представленный на рисунке 2.6 масс-спектр модулированного
пучка, возникающего при кнудсеновском испарении PbTe:

Рисунок 2.6 - Масс-спектр модулированного пучка,
полученного кнудсеновским испарением PbTe (энергия электронов 17 эВ, ток
эмиссии 2,252 мА, разрешение 2,000). Температура ячейки Кнудсена 750 оС. При
этой температуре и большем коэффициенте усиления (60 дБ) в диапазоне больших
масс хорошо разрешаются пики, принадлежащие молекулярным блокам исходного
вещества.
Рост происходит путём обычного процесса
сублимации как в условиях молекулярной, так и газофазной эпитаксии.
Использование раздельных источников исходных элементов не даёт преимуществ по
сравнению с сублимацией молекул выращиваемого вещества. Для халькогенидов
редкоземельных элементов (Eu, Yb:S, Te) также характерна конгруэнтная
сублимация молекул.
Оптимальным для выращивания методом МЛЭ твёрдых
растворов соединений AIVBVI, таких как Pb1-xSnxTe, PbTe1-xSex или Pb1-xSnxSe,
является использование двойной изотермической ячейки, содержащей бинарные
составляющие твёрдого раствора.
О выращивании методом МЛЭ плёнок CdTe на
подложках CdTe с ориентацией (111) и (001) сообщалось в 1981 г. Процесс роста
исследовался в диапазоне температур от комнатной до 250 оС с использованием
одного источника CdTe и подложки с ориентацией (111). Исследования на
сканирующем электронном микроскопе показали, что поверхность слоёвыращенных при
200 оС, является гладкой и бездефектной. При выращивании плёнок при более
высоких температурах картины ДБЭ ухудшаются, а поверхность становится
шероховатой. В случае ориентации подложки (001) эпитаксиальный рост наблюдался
в температурном диапазоне 80 - 200 оС. Ниже 80 оС происходит переход к
поликристаллическому росту.
В исследованиях многослойных структур HgTe-CdTe
обнаружено, что при сипользовании одного источника CdTe качество плёнок выше
при температуре роста 200 оС. Но при этом возрастает кол-во дислокаций и
малоугловых границ зёрен, проникающих из подложки ввиду очень низкого
структурного совершенства объёмных кристаллов CdTe.
Один из путей решения этой проблемы -
использование идеального совпадения параметров решётки InSb и CdTe
(6,48 Å, 25 oC) для получения
гетероэпитаксиальных согласованных по параметру решётки плёнок CdTe с высоким
совершенством структуры.
Одно из лидирующих мест среди материалов для
изготовления инфракрасных фотоприемников (ФП) занимают твердые растворы
кадмий-ртуть-теллур (КРТ). Это обусловлено физическими свойствами КРТ (большим
быстродействием, возможностью изменения ширины запрещенной зоны КРТ в широких
пределах и высокой квантовой эффективностью в диапазонеперекрываемых длин
волн).
ГетероструктурыHgCdTe можно получать на Si и
GaAs подложках с буферными слоями из CdTe и CdZnTe. Буферные слои необходимы
из-за сильного различия параметров кристаллических решеток растущей пленки и
подложки (14% рассогласование между HgCdTe и GaAs, 19% - между CdTe и Si, 12% -
между ZnTe и Si). Ориентация растущей пленки CdTe на GaAs подложке зависит от
температуры подложки. Молекулярно-лучевая эпитаксия (МЛЭ) превосходит другие
эпитаксиальные методы выращивания слоев КРТ на альтернативных подложках
благодаряв первую очередь низким температурам роста (∼
180◦C), что предотвращает диффузию примесей из подложки и снижает фоновое
легирование примесями. При температуре ниже 300 оС рост начинается с появления
сильного диффузного фона вместо дифракционной картины на экране ДБЭ, что
говорит об аморфном состоянии растущей пленки CdTe. Далее на этом фоне
появляются тяжи, говорящие о монокристаллическом безостровковом состоянии
пленки CdTe, причем с ориентацией (111). Если же рост начать при температуре
выше 320 оС, то диффузного фона на экране ДБЭ не появляется. Вместо него видна
дифракционная картина от GaAs подложки и пятна от пленки CdTe, причем пленка
имеет ориентацию (001) и растет с образованием островков, так как вместо полос
(тяжей) дифракционная картина ДБЭ состоит из отдельных пятен. Чтобы получить
хорошую однородность пленки по толщине на всей площади вместо традиционного
вращения подложки применялся специальный кольцевой рассекатель потока из
эффузионной ячейки. Таким образом, в МЛЭ контроль за картиной на экране ДБЭ
позволяет выяснить, какая температура нужна для получения заданной структуры
пленки.
Физические проблемы при гетероэпитаксии КРТ на
подложках из GaAs и Si обусловлены не только большими различиями в параметрах
решеток сопрягаемых материалов, но и различной природой химической связи,
низкой скоростью диссоциации и реиспарения молекул двухатомного теллура. Это
приводит к ухудшению структурного совершенства и увеличению плотности
дислокаций в гетероэпитаксиальных структурах КРТ примерно на один-два порядка
по сравнению с объемными кристаллами.
Известно о выращивании методом МЛЭ на подложках
GaAs плёнок ZnSe, легированных Ga. В данном случае рассогласование постоянных
решётки практически отсутствует. После отжига в камере роста
полуизолирующихGaAs подложек с целью очистки их поверхности плёнки ZnSe
выращивались при температуре Т = 360 оС с использованием отдельных источников
Zn и Se и источника Gaдля легирования. Скорость роста составляла 0,8 мкм/ч и
слои выращивались при различных температурах ячейки Ga в диапазоне 300 - 600 оС
в целях исследования оптических и электрических свойств слоёв, легированных Ga.
При температуре свыше 475 оС был превышен предел
растворимости Ga в качестве примеси замещения, что привело к образованию
преципитатов Ga и других дефектов решётки.
Выращивание проводилось из трёх источников: CdTe
из источника CdTe, а HgTe выращивался из отдельных источников Hg и Te. Подложки
CdTe с ориентацией (111) перед выращиванием плёнок отжигались при 300 оС.
Структуры HgTe-CdTe выращивались при трёх температурах роста, указанных в
таблице 2.1:
|
Образец
|
Температура
подложки,oC
|
CdTe
|
HgTe
|
|
|
n
|
e,
Å
|
n
|
e,
Å
|
|
1
|
120
|
7
|
600
|
7
|
1600
|
|
2
|
160
|
13
|
150
|
14
|
400
|
|
3
|
200
|
100
|
44
|
100
|
100
|
Исследование ДБЭ во время роста показывает, что,
хотя эпитаксиальный рост происходил и при 120 oC, качество структур существенно
выше при 200 oC. Особенно чувствительно к температуре роста качество плёнок
CdTe. При 120 oC и 160 oC качество плёнок ухудшалось с увеличением толщины
слоёв CdTe. Исследование профилей многослойных структур, выращенных при 160 oC
показывают, что взаимная диффузия соседних слоёв ограничена толщиной 40 Å,
но
нет данных для 200 oC.
Выращивание слоёв PbTe для получения
низкопороговых гомолазеров происходит с помощью одного источника, содержащего
PbTe. Источниками Bi и Tl для получения донорных и акцепторных примесей служат
Bi2Te3 и Tl2Te соответственно. Висмут и теллур встраиваются в узлы подрешётки
Pb в PbTe и их эффективность в качестве легирующих примесей почти не зависит от
присутствия избыточных количеств Pb и Te в кристаллической решётке. Разложение
Bi2Te3 происходит по реакции:
Te3 (тв) → 2BiTe (газ) + ½Te
(газ)
На поверхность роста попадают не только атомы Bi
в составе молекул, замещая в них Pb, но и небольшой избыточный поток Te2,
который образуется при диссоциации исходного вещества, вследствие чего на
поверхности слоя возникают вакансии Pb. В результате висмут внедряется в PbTe с
единичным коэффициентом встраивания.
Концентрация свободных электронов в легированном
висмутом PbTe практически не зависит от температуры роста.
Для согласования параметров кристаллических
решеток пленок, выращиваемых на GaAs подложке, от двойных и тройных составов
можно перейти к четверным. Цель таких исследований состоит в том, чтобы плавно
меняя содержание четвертого компонента, вырастить бездефектный переходной слой,
и на этом слое далее выращивать нужную многослойную гетероструктуру. Такой
подход был применен к выращиванию ZnSe и ZnMgSe на GaAs подложке, причем в
качестве четвертого «выравнивающего» компонента применялись сера S и бериллий
Be. В качестве переходного слоя исследовались также тонкие многослойные
структуры с чередованием слоев, имеющих рассогласование решеток
противоположного знака. Такую «противоположную» пару образуют ZnSSe и ZnCdSe.
Ее применение позволило избежать остановок процесса роста, происходивших ранее
при изменении содержания серы S путем изменения температуры подложки и при
изменении потока ZnSe (то есть при изменении температуры ZnSe ячейки).
Безостановочный рост устраняет нежелательный дрейф параметров и тем самым
улучшает качество гетероструктуры.
.4 Молекулярно-лучевая эпитаксия кремния
Ключевая проблема для МЛЭ кремния - очистка
кремниевых поверхностей, желательно при как можно меньших температурах. Как уже
отмечалось ранее, для очистки поверхности можно использовать травление её
пучком ионов аргона с энергией 1 кэВ и последующий отжиг при 1120 К для
рекристаллизации поверхности и высвобождения захваченных поверхностью атомов
аргона. Но травление кремниевой подложки, покрытой естественным оксидом,
приводит к сильному повреждению поверхности. Однако существует методика
воспроизводимого получения чистых кремниевых поверхностей высокого
кристаллографического совершенства. Методика включает 5-минутный прогрев при
870 K, двухминутный прогрев при 1170K, умеренное травление ионами аргона, отжиг
при 1370 - 1520 К в течение трёх минут с последующим охлаждением со скоростью
10 К/мин. Основной недостаток этого метода - сравнительно высокая температура
отжига, которая может отрицательно влиять на электрофизические свойства
пластин, а если в структуре содержится легированный слой, то привести к
размытию профилей легирования. Для преодоления этих трудностей существует два
способа подготовки поверхности. Прежде всего для получения атомно-чистых
упорядоченных поверхностей можно использовать импульсное лазерное облучение
поверхности. Другой низкотемпературный метод очистки заключается в химическом
взаимодействии SiO2 с молекулярным пучком кремния при 1120 К. Эта реакция
приводит к свободной от кислорода поверхности Si:
+ Si → SiO↑:
Удаление SiO2 возможно лишь в том случае, если
поверхность будет полностью очищена от углерода. Для скорости 0,1 нм/сбыли
определены приемлемые температуры эпитаксии в случае двух наиболее важных с
технологической точки зрения поверхностей кремния. На пластинах с ориентацией
(100) наименьшие температуры, необходимые для эпитаксиального роста, составляют
~ 470 К, в то время, как для поверхностей (111) требуются существенно более
высокие температуры роста (870 К).
МЛЭ кремния сама по себе является хорошим
методом для низкотемпературного получения чистых, хорошо упорядоченных
поверхностей Si.
Если во время роста сохраняются условия
сверхвысокого вакуума и рост осуществляется на чистых поверхностях кремния, для
МЛЭ кремния необходимы температуры 850 - 1100 К, т.е. существенно ниже
температур, необходимых для газофазной эпитаксии (ГФЭ) (1250 - 1450 К). Кроме
того, резко отличаются не только температуры ГФЭ и МЛЭ, но и закономерности
процесса роста. При ГФЭ скорость роста уменьшается при уменьшении температуры
роста, в случае же МЛЭ скорость роста постоянна в очень широком диапазоне
температур. Доказано, что рост осуществляется движением ступеней, высота
которых составляет два монослоя.
В процессе роста можно выделить два этапа. На
первом этапе атом кремния ударяется о поверхность Si, прилипает к ней и
термализуется. На втором этапе он диффундирует по поверхности к месту
встраивания, которое может быть, например, ступенью. Энергия активации для
поверхностной диффузии равна 1 эВ. Коэффициент конденсации, определяемый как
вероятность для атома кремния, ударяющегося о поверхность, не испариться с неё,
в широком диапазоне температур равен единице.
При наличии условий сверхвысокого вакуума
существуют два стабильных режима роста при МЛЭ Si на кремниевых подложках
(111): при температурах выше определённой наблюдается монокристаллический рост
посредством движения ступеней, а при температурах ниже определённой в
конкуренцию с этим механизмом вступает двумерное зародышеобразование и теряется
дальний порядок.
На поверхности (100) могут присутствовать только
моноатомные ступени, т.к. каждый монослой может давать только две оборванные
связи на один атом поверхности. Рост на плоскости с высокой симметрией
осуществляется посредством движения моноатомных ступеней, ориентированных в
направлениях высокой симметрии, таких как (100) и (110).
МЛЭ предоставляет возможность получения
сверхтонких слоёв с резкими профилями концентрации примесей на любой глубине.
Примеси могут путём совместного испарения или путём ионной имплантации. При
использовании метода совместного испарения возникают определённые трудности,
т.к. некоторые легирующие примеси испаряются из кнудсеновских испарительных
ячеек кластерами (например, As4, P8, Sb4), что может оказывать влияние на
эпитаксиальный процесс. Другая трудность заключается в том, что коэффициент
прилипания легирующих примесей к поверхности сильно зависит от температуры
подложки.
Другой способ внедрения примесей в растущий
слой: объединение ионной имплантации и МЛЭ. Резкие профили легирования были
получены добавлением установки ионной имплантации к сверхвысоковакуумной камере
МЛЭ. Коэффициенты прилипания ионов к подложке близки к единице и мало зависят
от температуры. Энергия имплантируемых атомов должна быть достаточно низкой,
чтобы не вызвать травления выращенного слоя. Это обуславливает необходимость
использование сложной ионной оптики для фокусировки ионного пучка низкой
энергии. Можно также использовать упрощённые схемы ионного легирования.
Этот метод связан с определёнными трудностями,
т.к. ионная имплантация в случае нагретых подложек приводит к образованию
протяжённых дефектов, которые трудно отжечь. Однако при использовании ионов
низких энергий и малых доз облучения эта проблема несущественна.
Есть и другая возможность сочетания ионной
имплантации и МЛЭ кремния. Было показано, что лазерное облучение поверхностей
(100) Si после ионной имплантации в системе, не связанной с установкой МЛЭ,
позволяет устранить радиационные нарушения и получить атомно-чистые
упорядоченные поверхности. Рост при температуре 870 К приводит к заращиванию
легированных мышьяком кремниевых слоёв эпитаксиальной плёнкой, в которой нет
автолегирования. Вместе с тем, в случае повторения лазерных импульсов
происходит диффузия примеси на расстояние в несколько сотен нанометров вглубь
слоя. В идеальном случае желательно в результате отжига устранить все
радиационные дефекты, очистить поверхность и сохранить профиль легирования.
Комбинация МЛЭ кремния и ионной имплантации
низкой энергии даёт возможность прецизионного контроля за профилями легирования
для получения сверхбыстрых переключающих приборов, таких как транзисторы на
горячих электронах.
Высокие степени концентрации легирующей примеси
требуются для работы многих оптоэлектронных приборов. Например, так получали концентрации
1018 см-3 редкоземельного элемента эрбия Er при сублимационном легировании Si
слоев. При этом для уменьшения эффекта сегрегации Er кроме подачи на подложку
отрицательного потенциала применялся напуск кислорода с давлением 3*10-8Торр.
Влияние кислорода возможно заключается в связывании с атомами примеси и тем
самым в препятствовании «всплытию» атомов примеси вслед за растущей
поверхностью.
Для получения рекордно малой концентрации
нежелательных примесей 2*1013 см-3 самое важное - понижать температуру всех
нагретых деталей камеры роста ниже 600 оС. Профиль концентрации Er поперек слов
при дельта-легировании, измеренный холловским методом при послойном травлении с
шагом 0,8 нм, имел высоту 4*1013 см-2 и полуширину 1 нм. Такие же результаты
были получены при дельта-легировании фосфором Р.
.5 Молекулярно-лучевая эпитаксия CaF2 и SrF2 на
GaAs
Эпитаксиальные диэлектрические слои фторидов
кальция и стронция представляют значительный интерес главным образом в связи с
возможностями их применения при создании трёхмерных интегральных схем и
МДП-структур. Величины относительного рассогласования постоянных решётки при
комнатной температуре и при температуре роста около 500 оС составляют несколько
процентов.
В работе [5] были выращены диэлектрические слои
CaF2 и SrF2 на GaAs (111), по картинам дифракции быстрых электронов на
отражение оценено их кристаллическое качество.
Подложками служили монокристаллические пластинки
арсенида галлия с размерами 6x15x0.35 мм. После стандартной механической и
химической обработок поверхности подложек обезжиривались в ацетоне, затем
кипятились в деионизованной воде и обрабатывались в
серноперекисномтравителеH2SO4:H2O2:H2O (3:1:1) и, наконец, обрабатывались в HF,
что приводило к снижению скорости роста собственного окисла на поверхности
арсенида галлия. После предварительной припайки подложек к молибденовым
спутникам и загрузки их в вакуумную установку, подложки прогревали до 150 - 200
оС. Затем производилось термическое испарение окислов в течение 20 - 30 мин при
температурах 530 или 580 оС. При этом происходило выглаживание кристаллической
поверхности и наблюдалось некоторое ослабление диффузионного фона.
Выращивание слоёв фторидов производилось при
температуре 530 оС. Скорость роста слоёв составляла от 2 до 5 нм/мин.; толщины
слоёв, исследованных в данной работе составляли 100 - 130 нм.
Если очистка проводилась при температуре 530 оС,
то картина ДБЭ во время эпитаксии указывала на рост монокристаллического и
гладкого в атомарном масштабе слоя фторида кальция или стронция. Деформация
растяжения была однородной и составляла порядка 0,6 - 0,8*10-2.
В том случае, когда очистка проводилась при
температуре 580 оС, картина ДБЭ имела иной вид. На начальных стадиях роста
можно было видеть только кольца поликристалла, а в конце опыта наблюдался
отчётливый эпитаксиальный рост. Деформация растяжения была мала: 0,18*10-2.
Это даёт возможность за счёт изменения режимов
очистки поверхности арсенида галлия изменять величины упругих деформаций в
монокристаллических диэлектрических слоях фторидов и может представлять интерес
для получения напряжённых и ненапряжённых слоёв.
.6 Молекулярно-лучевая эпитаксия
гетероструктурAIIIBV-AIIIBVи AIV-AIIIBV
Система GaAs-Ga1-xAlxAs имеет рассогласование
решёток ≤0,15% и наиболее широко из всех систем AIIIBV-AIIIBV
используется в различных структурах и приборах.
При выращивании GaAs и других материалов методом
МЛЭ обработка подложек оказывает значительное влияние как на качество растущей
плёнки, так и на перенос электронов через границу плёнка-подложка.
Свежеприготовленная путём обезжиривания и химического травления подложка GaAs,
помещаемая в установку МЛЭ, всегда содержит на поверхности кислород и углерод.
Кислород можно удалить путём прогрева подложки до 530 - 550 оС, очистка же от
углерода существенно зависит от условий на поверхности. В частности
установлено, что интенсивная бомбардировка поверхности подложки электронным
пучком оже-спектрометра, в особенности при нагреве ниже ~350 oC, резко
затрудняет термическое удаление углерода. Остающийся углерод может быть
распылён лишь с помощью быстрых ионов, после чего подложку необходимо отжечь
для залечивания образовавшихся дефектов. Было замечено однако, что такая
подложка содержит приповерхностный высокооомный слой, затрудняющий перенос
электронов через границу плёнка-подложка.
Перечисленные проблемы можно решить, либо
напыляя моно- или субмонослойSn на облучённую быстрыми ионами и оттожённую
подложку GaAs перед выращиванием на ней GaAs, либо минимизируя время
воздействия пучка на подложку и удаляя поверхностный углерод термически путём
нагрева до температуры ~350 оС.
Другим полезным способом улучшения качества
плёнок GaAs, GaAlAs и сверхрешётокGaAs-GaAlAs является использование в ходе МЛЭ
водорода. Направление пучка водорода на подложку в процессе роста увеличивает
подвижность электронов и выход фотолюминесценции в GaAs<Sn>, GaAlAs и
сверхрешёткахGaAs-GaAlAs, улучшает качество поверхности GaAlAs и
сверхрешётокGaAs-GaAlAs и эффективность вхождения Sn в GaAlAs.
Использование модулированного легирования и улучшение
конструкции аппаратуры МЛЭ привело в последние годы к необычайному электронной
подвижности в структурах GaAs-GaAlAs. В этой связи следует упомянуть о
повышении электронной подвижности в GaAs при использовании арсина в качестве
источника мышьяка, что связывают с более высоким ростовым совершенством,
обусловленным выделяющимся из арсина As1. Атомарный водород на поверхности
плёнки, выделяющийся при тепловом разложении арсина, может очень эффективно
удалять или связывать в процессе роста кислородсодержащие примеси, уменьшая их
влияние на растущую плёнку.
Были созданы и исследованы сверх
решёткиGaAs-Ga1-xAlxAs со слоями почти моноатомной толщины.
Рассогласование решёток InAs и GaAs составляет
7%. Системы InAs-GaAs и In1-xGaxAs-In1-yGayAs обладают рядом интересных
свойств, делающих их удобным объектом для изучения эффектов связанных с
рассогласованием. Этому способствуют следующие обстоятельства:
а) InAs имеет высокую электронную подвижность,
которая может зависеть от имеющихся в плёнке дефектов;
б) наличие у InAs и GaAs общего элемента V
группы As облегчает управление составом твёрдого раствора InGaAs по сравнению с
системами, содержащими разные элементы V группы;
в) указанные преимущества дают возможность
удобной проверки того, в какой степени новая технология роста ослабляет влияние
рассогласования решёток, что может быть применено и к другим
гетероэпитаксиальным системам.и InGaAs выращивались на подложках (100) GaAs при
температуре 400 - 600 оС. При выращивании InGaAs скорость роста и состав
твёрдого раствора определялись потоками In и Ga. Нелегированные плёнки InAs
имели проводимость n-типа с концентрацией носителей ~1*1016 см-3.
Как видно на рисунке 2.7 [1], подвижность
электронов в плёнках InAs весьма чувствительна к толщине плёнки, быстро падая с
её уменьшением.

Рисунок 2.7 - Измеренные и рассчитанные
подвижности электронов в плёнках InAsразличной толщины, выращенных на GaAs.
Сплошная кривая - расчёт для n = 5*1016см-3; крестики и кружки относятся к
плёнкам, выращенным непосредственно и с переходным слоем соответственно.

предполагающего диффузное рассеяние на
поверхности. Здесь  и
и  -
подвижности в плёнке и в массивном материале, l - длина свободного пробега, t -
толщина плёнки. l определяется по формуле:
-
подвижности в плёнке и в массивном материале, l - длина свободного пробега, t -
толщина плёнки. l определяется по формуле:

где m - эффективная масса,  -
средняя скорость, а
-
средняя скорость, а  - подвижность в
объёмномInAs (берётся из литературных данных).
- подвижность в
объёмномInAs (берётся из литературных данных).
Вычисленное также уменьшается для тонких плёнок, но не столь быстро, как в эксперименте.
Подобное различие связано с увеличением дефектности тонких плёнок InAs, что
подтверждается данными просвечивающей электронной микроскопии. Причиной
дефектности является рассогласование решёток.
также уменьшается для тонких плёнок, но не столь быстро, как в эксперименте.
Подобное различие связано с увеличением дефектности тонких плёнок InAs, что
подтверждается данными просвечивающей электронной микроскопии. Причиной
дефектности является рассогласование решёток.
Выращены твёрдые растворы In0.53Ga0.47As и
гетеропереходы In0.53Ga0.47As-In0.52Al0.48As, согласующиеся по постоянной
решётки с InP. Системы InGaAs-GaAs и In1-xGaxAs-In1-yGayAs также применяются в
сверхрешётках с напряжёнными слоями, где при создании структур допускается
различная степень рассогласования решёток.
Система GaSb-GaAs имеет рассогласование решёток
7,5%. С помощью метода МЛЭ при 450 - 600 оС выращивался GaSb как на подложках
GaAs, так и на подложках GaSb. Нелегированный GaSb имел p-проводимость с
концентрацией дырок ~1*1016 и 3*1015 см-3 при 300 и 77 К соответственно.
Легирование как оловом, так и германием давало также материал с проводимостью
p-типа и максимальным уровнем легирования (3 - 5)*1018 см-3.
Плёнки GaSb на GaAs имеют меньшую постоянную
решётки, чем массивный материал, в отличие плёнок InAs на GaAs. Релаксация
напряжений должна происходить с образованием высокой плотности дефектов.
Система InAs-GaSb вызывает интерес благодаря
особому характеру взаимного расположения зон в полупроводниках. Край зоны
проводимости InAs лежит ниже края валентной зоны GaSb. В твёрдых растворах
In1-xGaxAs и GaSb1-yAsy такое расположение зон сохраняется вплоть до x ~ y ~
0,2, после чего край зоны проводимости In1-xGaxAs поднимается выше края
валентной зоны GaSb1-yAsy и зонная диаграмма напоминает зонную диаграмму для
большинства p-n-переходов.
Выращивание GaSbAs методом МЛЭ отличается от
выращивания InGaAs. Здесь скорость роста определяется потоком Ga, а состав -
конкуренцией механизмов, обуславливающих встраивание в решётку атомов As и Sb.
Рисунок 2.8 [1] иллюстрирует закономерности роста GaSbAs при различных потоках
Sb и As и различных температурах подложки.При высоких температурах скорость
встраивания Sb резко падает, что, вероятно, связано с термодинамикой испарения
Sb и As.
Легирование оловом твёрдых растворов GaSb1-yAsy
демонстрирует переход вещества p-типа в вещество n-типа, поскольку Sn является
акцептором в GaSb и донором в GaAs. Переход происходит при y ~ 0,2. In1-xGaxAs
при легировании Sn во всей области составов свой тип проводимости не меняет.
Хотя рассогласование решёток InAs и GaAs
невелико (~ 0,7%), на гетерогранице могут существовать связи Ga-As и In-As,
длины которых меньше и больше соответственно, чем длины связей Ga-Sb и In-As,
на 7%. Соответствующие сжатия и растяжения в пограничном слое происходят вдоль
направления роста (100).
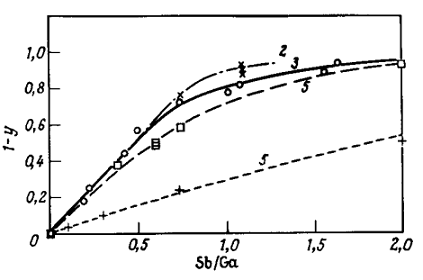
Рисунок 2.8 - Зависимость состава плёнок
GaSb1-yAsy от скорости поступления Sbпри различных скоростях поступления Asпо
отношению к скорости поступления Ga. На кривых указано отношение As/Ga. Три
верхние кривые соответствуют температуре 470 оС, нижняя кривая - температуре
подложки 560 оС.
Материалы AlSb и AlGaSb представляют интерес для
оптоэлектроники. Система AlSb особенно привлекательна в комбинации с парой
InAs-GaSb в силу большой ширины запрещённой зоны (1,6 эВ) и малого роста
рассогласования решёток, равного 0,6 и 1,3% по отношению к GaSb и InAs
соответственно.
Материал AlSb выращивался с помощью МЛЭ при температурах
от 400 до 550 оС. Нелегированные плёнки AlSb имели проводимость p-типа с
концентрацией носителей ~1014 см-3 и удельным сопротивлением 200 Ом*см.
Легирование германием обычно также даёт плёнки p-типа. При очень больших
потоках Sb наблюдался (Sb/Al>10) наблюдался рост n-AlSb. В этом случае
высокая концентрация Sb приводит к выталкиванию Ge в катионные узлы, где он,
как и в GaAs, ведёт себя как донор.
Во время роста AlSb на поверхности (100) GaAs
происходит образование трёхмерных зародышей, таких же, как при росте GaSb на
GaAs. Успешное выращивание гетеропереходов и сверхрешётокв системах AlSb-GaSb,
AlSb-InAs и GaSb-AlSb-InAs требует наличия гладких и резких границ раздела.
Рост как GaSb на AlSb, так и AlSb на GaSb приводит к гладкой и резкой границе.
Чего не скажешь о AlSb-InAs для обеих последовательностей роста.
Выращивание системы Ge-GaAs проводилось в
температурном интервале 350 - 550 оС, причём большая часть плёнок была получена
при температуре 400 оС, обеспечивающей лучшее качество эпитаксии при малой
взаимодиффузииGe и GaAs. Нелегированные плёнки Ge, выращиваемые на GaAs, имели
проводимость n-типа с концентрацией носителей 3*1018 см-3. Высокая концентрация
доноров в германии объясняется проникновением атомов As из подложки, на что
указывало наблюдение соединения GeAsx на поверхности германия, особенно
учитывая тот факт, что поверхностные слои GaAs обогащены As в силу особенностей
роста при МЛЭ. Концентрацию носителей в Ge можно снизить до 3*1017 см-3,
уменьшив парциальное давление As в ходе роста Ge до 10-9 мм.рт. ст. и уменьшив
температуру роста до 350 оС.
Рассогласование решёток в структуре Ge-GaAs
очень мало и составляет 0,07%. Также после прогрева этой структуры при 400 оС в
течение 4 часов приводит к взаимодиффузии на расстояние ~10Å.
При росте германия на (100) GaAs поверхность
является гладкой, а при росте GaAs на (100) Ge она шероховата в атомном
масштабе, но может быть сглажена путём выращивания слоя Ge толщиной 3 - 5 Å.
Поэтому
величину шероховатостей поверхности GaAs на германии можно оценить в 3 - 5 Å.
Аналогичная
морфология роста наблюдалась и на поверхности (111). Иная морфология имела
место при росте с ориентацией (110): наблюдалась гладкая поверхность в обоих
вариантах роста.
Выращивание GaP на подложках Si методом МЛЭ
производилось притемпературах 580 - 650 оС, причём в качестве источника фосфора
использовался либо элементарныйP, либо GaP. Подложки Si имели ориентацию (100),
(110), (111) или (211). Было установлено, что заметное влияние на рост плёнок
GaP оказывает обработка поверхности кремния. В некоторых случаях остатки оксида
Si на поверхности подложки приводили к росту поликристаллического GaP. При
использовании для очистки подложки ионной бомбардировки с последующим отжигом
был выращен при 580 оС эпитаксиальный GaP, обладающий достаточно высоким
кристаллическим совершенством. Однако при росте наблюдалось автолегирование
кремнием из подложки и при 650 оСуровень легирования достигал ~2*1018
см-3.Изучение ориентационных зависимостей показало, что при определённых
условиях ориентация (211) Si более благоприятна для роста, чем остальные.
Рассогласование решёток в даннойгетеропаре составляет 0,4%.
.7 Создание нанонитей с помощью
молекулярно-лучевой эпитаксии
На GaAs (111)-подложке можно вырастить «лес»
GaAs-нанонитей (НН) с участием Au-наночастиц (НЧ) в качестве катализатора по
механизму пар-жидкость-кристалл (рисунок 2.9 [2]):
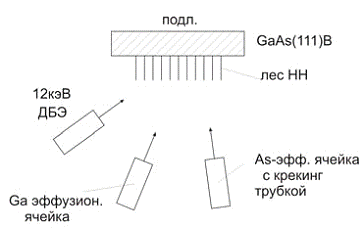
Рисунок 2.9 - Механизм выращивания
GaAs-нанонитей с участием Au-наночастиц в качестве катализатора.
Основные этапы роста таковы: 1) Подложка
термически очищается от окисла; 2) Выращивается 100 нмGaAs-буферный слой; 3)
При сверхвысоком вакууме структура переносится в другую камеру для напыления
Au; 4) Напыляется 1 нмAu при комнатной температуре; 5) Структура возвращается
обратно в МЛЭ-объем; 6) Структура отжигается 5 мин при 550 оС под потоком As,
чтобы образовались Au-НЧ в виде нанометровых капелек и стабилизировать
поверхность; 7) Устанавливается нужная температура подложки и производится рост
GaAs со скоростью 0,2 нм/с в течение 20 мин при соотношении потоков As/Ga =2
(это слабый переизбыток As по сравнению с типичным As/Ga =10).
Для изучения выросших GaAs-НН в электронном
микроскопе их надо отделить от подложки, не повредив. Для этого достаточно
прикоснуться подложки Cu-сеткой, покрытой ячеистой углеродной пленкой (она
входит в набор принадлежностей микроскопа). НЧ обладают объёмной
кристаллической фазой. Исследования в просвечивающем электронном микроскопе
показывают, что это твердые металлические НЧ. В их состав входит не только Au,
но и Ga - результат взаимодействия с GaAs-подложкой в ходе отжига.
Если опять нагревать подложку с AuGe-НЧ, то при
400 оС эти НЧ переходят из твёрдой фазы в жидкую.нанонити растут при
температуре подложки от 320 оС до 620 оС. При 300 оС наблюдается шероховатый
слой GaAs, полностью покрывающий напыленный слой Au. При 320 оС растет густой
лес НН средней длины 1 мкм. У НН есть 4 особенности.
) Диаметр НН неоднороден по длине НН. Вероятно,
это связано с тем, что температура роста 320 оС меньше температуры
затвердевания 340 оС.
) На концах коротких НН видны
GaAs-нанокристаллы(НК).
) Некоторые GaAs-НК вытягиваются горизонтально и
образуют мостики между соседними НН.
) На концах длинных НН видны Au-капельки
диаметром не более 3 нм. Капельки имеют полусферическую форму, что доказывает
их жидкое состояние в процессе роста НН. Предполагается, что капельки
уменьшаются по мере роста НН. Возможно, AuGa-НЧ могут терять устойчивость,
отчего Au уходит с вершин НН, и рост НН прекращается из-за отсутствия катализатора.
В диапазоне температур 370 оС - 420 оС число
GaAs-НК на вершинах НН уменьшается. В диапазоне 470 оС - 570 оС вообще нет
GaAs-НК, и все НН оканчиваются Au-капельками. Наконец, при температуре 620 оС
нет НН, а вся поверхность покрыта Au-капельками. Вокруг них видны вмятины,
видимо, процесс вместо осаждения GaAs из капли пошел в обратную сторону-
растворение GaAs-подложки в капле.
Для использования всех преимуществ разработанной
Si-технологии желательно совместить GaAs-НН с Si-подложкой. Основные этапы
роста таковы: 1) Si-подложка очищается в разбавленном (1%) растворе HF (это
делается для удаления естественного окисла и для пассивации водородом
оборванных связей Si, выступающих с поверхности); 2) Электронно-лучевое
нанесение 0,4 нмAu; 3) Перенос в МЛЭ рабочий объем и отжиг 10 мин при 540 оС
для образования Au-НЧ, играющих роль катализатора; 4) Рост GaAs около 5 мин при
580 оС и избытке As/Ga = 9 (рисунок 2.10 [2]). При калибровке установки эти
параметры давали эпитаксиальный рост GaAs-нанослоев на (100)GaAs-подложке с
типичной скоростью 1 мкм/час. 5) После остановки роста НН (прекращения потока
Ga) поток As оставляли включенным, пока температура подложки не падала ниже 300
оС.
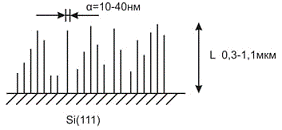
Рисунок 2.10 - Рост GaAsна Si (111)НН с типичной
средней длиной (1 мкм) и диаметром (30 нм) выращивали на (100)GaAs-подложке под
углом + 55 град и -55 град относительно направления <100>, т.е. вдоль
направления <111> (рисунок 2.11 [2]):

Рисунок 2.11 -ZnTe-нанонити на GaAs-подложке.
НН растут как на окисленных подложках, так и на
очищенных от окисла (обычным термическим способом в сверхвысоком вакууме).
Кристаллические решетки ZnTe и GaAs сильно рассогласованы (7 %). Это приводит к
дислокациям несоответствия при выращивании толстых (порядка 1 мкм) ZnTe-слоев
на GaAs-подложках, но не мешает росту ZnTe-НН нанометрового диаметра.
Для получения Au-НЧ катализатора применялось
напыление слоя Au толщиной от 0,3 нм до 2 нм при 200 оС в отдельной МЛЭ-системе
и последующий отжиг 10 мин при 590 оС. Этот отжиг не только образует Au-НЧ
катализатора, но и убирает остатки окисла (если подложка очищалась от окисла).
Рост ZnTe-НН проводился 30 мин при соотношении
потоков Zn/Te = 0,6 и температуре чуть выше 350 оС. Эта температура выбрана
потому, что Au-Ga-эвтектический сплав, из которого предположительно состоят
Au-НЧ катализатора, остается жидким примерно до 350 оС. По мере роста НН всё
больше изгибаются и перекручиваются.
Боковая поверхность НН волнообразна. Это может
быть связано с диффузией атомов по боковой поверхности между подложкой и
Au-каплей на вершине НН и с изменением размера Au-капли при изменении её
состава. Есть наблюдение, пока не нашедшее объяснения: тонкие НН растут быстрее
толстых.
.8 Создание наночастиц с помощью
молекулярно-лучевой эпитаксии
Нанесение слоев с разными параметрами
кристаллических решеток может привести к образованию устойчивых каплевидных
островков диаметром 10 - 100 нм - наночастиц (НЧ), называемых квантовыми
точками (КТ) из-за их специфического механизма электропроводности. Такие
германиевые КТ были получены в гетероструктуреCaF2-Ge-CaF2-Si.
На изображении в атомносиловом микроскопе (АСМ)
поверхности этой CaF2 пленки толщиной 10 нм видны атомно - гладкие террасы,
разделенные моноатомными ступенями. Видны также следы скольжения дислокаций в
виде системы прямых линий. Их плотность невелика (на поле 2 мкм всего десяток
линий), поэтому при толщине CaF2 пленки 10 нм релаксация напряжений таким
способом только начинается. Для улучшения электроизолирующих свойств
CaF2нанометровой пленки проводился ее рост до толщины 2 нм при температуре
подложки 520 оС, а затем следовал часовой отжиг при 700 - 750 оС. В результате
ее удельное сопротивление возрастало на 3 порядка до величины 109 Ом*см.
Для роста Ge-КТ на этой поверхности температуру
подложки понижали до 430 - 490 оС и начинали рост Ge пленки. До толщины 3 нм
эта пленка гладкая, что видно по картине ДБЭ, а далее появляются островки. На
изображении в атомно-силовом микроскопе поверхности этой Ge-CaF2гетероструктуры
всё поле покрыто шариками диаметром около 0,1 мкм.
Аналогичные процессы происходят при выращивании
InAs квантовых точек на поверхности GaAs. Островки InAs имеют форму конусов с
основанием 15 нм и высотой 5 нм и располагаются вдоль поверхности нижележащего
GaAs слоя с поверхностной плотностью 4*1010 см-2. Для получения заранее
заданных величин поверхностной плотности, размеров и форм таких КТ предлагается
выращивать разнообразные пироги InAlAs-InGaAs. Например, для увеличения высоты
конусов InAs-КТ на GaAs можно наносить несколько плоскостей КТ с
нанометровымиGaAs прослойками, так что их взаимодействие «вытягивает» конусы
InAs-КТ вверх. Замена материала прослойки с GaAs на InGaAs может увеличить
средний объем КТ, а если при этом заменить материал КТ с InAs на InAlAs, то
может увеличиться поверхностная плотность КТ.
. Устройства, созданные с помощью
молекулярно-лучевой эпитаксии и их применение
Использование структур со сверхрешётками,
квантовыми ямами, квантовыми точками позволяет создавать уникальные проборы
микро-, нано- и оптоэлектроники, принцип действия которых основан на волновой
природе электрона. Это, в первую очередь, полупроводниковые лазеры и
чувствительные фотодетекторы с квантовыми ямами, сверхрешётками и квантовыми
точками в активной области, транзисторы с высокой подвижностью электронов в
канале, нанотранзисторы, туннельно-резонансные диоды, одноэлектронные приборы и
т.п.
В настоящее время дополнительный импульс как
исследовательским, так и технологическим работам по МЛЭ придают идеи и
перспективы создания элементной базы для квантовых компьютеров.
МЛЭ в коммерческих целях используется в основном
для создания GaAs. Для устройств на основе GaAs требуется высокая скорость в
СВЧ диапазоне и поэтому требуется очень хорошее качество эпитаксиальных слоев.
С этой целью очень хорошо справляется процесс МЛЭ.
Так же с помощью МЛЭ выращивают слои GaAs на
кремниевых подложках. Они получаются на больших пластинах, имеют
лучшуютеплопроводимость и обходятся более дешево. Не смотря на проблемы такого
выращивания (довольно большое рассогласование постоянных решеток, что приводит
к образованию дислокаций), на их основе было сделано много транзисторов,
лазеров и светодиодов.
Сверхрешётки из элементов IIIи Vгрупп
применяются в светодиодах и лазерах (так же с излучением спектра синего цвета).
Так же из этих структур изготавливают инфракрасные датчики, требующие очень
малой ширины запрещенной зоны.
На основе соединений типа AIIIBV выпускают
полупроводниковые индикаторы и приборы двух категорий: светодиодные индикаторы
(LED) и микроволновые интегральные схемы.
Светодиоды изготавливают из монокристаллического
GaAs, в котором р-n переходы формируются путем добавления соответствующих
легирующих примесей. Обычно это теллур, цинк или кремний. Эпитаксиальные слои
трехкомпонентных и четырехкомпонентных материалов типа AIIIBV, таких как фосфид
арсенид галлия (GaAsP), наращиваются на подложку. Они дают полосу излучения
волн определенной длины в видимом спектре для индикаторов или в инфракрасном
спектре для источников излучения или датчиков.Диоды, излучающие зеленый свет,
как правило, изготавливаются из фосфида галлия (GaP).
Были попытки вырастить сплавы из магнитных
материалов Co-Pt и Fe-Pt для улучшения магнитного хранения данных.
Структуры кремний на сапфире (КНС) до сих пор
составляют основу радиационно-стойких, быстродействующих интегральных схем.
Кроме того, такие структуры могут быть использованы в оптоэлектронике. В связи
с необходимостью совершенствования известных и создания новых, все более
сложных, интегральных схем ужесточаются требования к слоям кремния на сапфире
по однородности электрофизических характеристик, уровню автолегирования и
концентрации донорных примесей, уменьшению влияния переходного слоя на границе
кремний-сапфир.Метод МЛЭ наиболее приемлем для гетероэпитаксии КНС-структур,
поскольку температуру роста в нем можно снизить до 650°С с сохранением высокого
структурного совершенства слоев и качества поверхности.

Рисунок 3.1 - Приборы на основе слоёв КНС [6].
Оптические свойства полупроводниковых
светоизлучающих приборов с активной областью на основе гетероструктур с
квантовыми точками определяются, в том числе, средним латеральным размером,
формой, однородностью по размерам, степенью пространственной упорядоченности и
поверхностной плотностью островков. Необходимость управления геометрическими
параметрами ансамблей квантовых точек за счет изменения технологически
контролируемых условий их выращивания стимулирует развитие теоретических и
экспериментальных исследований кинетики формирования когерентных островков.
В ряде работ обсуждался вопрос о возможности
получения излучения терагерцового диапазона за счет переходов электронов с
верхних расщепленных уровней квантовой молекулы (две квантовые точки, связанные
друг с другом за счет туннельных эффектов) на нижние. Таким образом, квантовые
молекулы могут рассматриваться в качестве излучателей терагерцового
излучения.Существует возможность создания перестраиваемого под ближний и
средний ИК диапазон фотодетектора с Ge квантовыми точками.
Пленки нитридов AlN, GaN, InN перспективны как
барьерные слои туннельных гетероструктур благодаря своей большой ширине
запрещенной зоны, а также для акустооптических гетероструктур.
Одним из основных применений структур на основе
нитридов металлов третьей группы является изготовления мощных полевых
СВЧ-транзисторов. Разработанные нитридные гетероструктуры для
СВЧ-микроэлектроники демонстрируют полное отсутствие эффекта коллапса (падение
мощности в СВЧ-режиме по сравнению со статическими характеристиками), что
характерно для нитридных транзисторов. На созданных гетероструктурах были
изготовлены транзисторы с удельной мощностью 3,8 Вт/мм при 10 ГГц, что близко к
предельным значениям для структур, выращенных на сапфире. Достижение указанных
результатов в значительной степени обусловлено возможностями ростового
оборудования. Возможность проведения процесса при ~1200оС позволяет растить
гетероструктуры с переходного слоя AlN, имеющего высокое кристаллическое
совершенство. Выращенный на таком слое объемный нитрид галлия демонстрирует
рекордные значения подвижности свободных носителей.
ИК фотоприёмники на основе КРТ различного
состава обеспечивают регистрацию ИК-излучения в широком диапазоне длин волн
(1-20 мкм и более). Тепловизионная техника, основанная на применении
фотоприемников ИК диапазона длин волн 3 - 12 мкм, требуется для применения как
в военной технике для систем ночного видения, обнаружения и наведения, так и в
народном хозяйстве для медицины, сельского хозяйства, химической, металлургической,
топливодобывающей промышленностей.
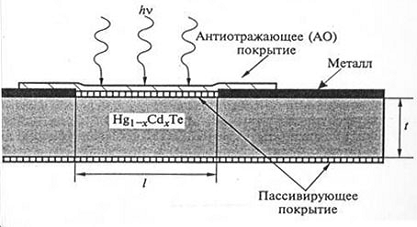
Рисунок 3.2 - Поперечное сечение типичного КРТ
фоторезистора.
В настоящее время проводится множество
исследования светодиодов, излучающих свет в ультрафиолетовом диапазоне, с
использованием нитрида галлия и сплава GaAlN. К областям использования AlN
можно отнести: оптоэлектронику; диэлектрические слои в оптических носителях;
высокотеплопроводные подложки; изготовление тиглей для роста арсенида галлия;
датчики поверхностно-акустических волн.
Высокая подвижность электронов в арсениде индия
и прямозонная структура позволяют использовать его для изготовления
быстродействующих транзисторов и интегральных схем, фотоприемных детекторов ИК
диапазона, инжекционных лазеров с длиной волны более 3,5 мкм.
На основе квантовых точек InGaAs-GaAs
изготавливают светодиоды и полупроводниковые лазеры поверхностного излучения с
вертикальным объемным резонатором (VCSEL). Последние характеризуется излучением
света в направлении перпендикулярно поверхности электродов. Эти лазеры проще в
изготовлении. Доступные в настоящее время лазеры VCSEL изготовляются из
арсенида галлия (GaAs) и излучают свет в волновом диапазоне примерно от 750 до
1000 нм. Длины волн этого диапазона недостаточно велики для того, чтобы можно
было передавать сигналы по волоконно-оптическим кабелям на большие расстояния,
поэтому VCSEL используют не столько для дальней связи, сколько в LAN,
развернутых в пределах одного здания, в которых интенсивный обмен информацией
осуществляется на небольших расстояниях.

Заключение
Молекулярно-лучевая эпитаксия может обеспечивать
исключительно точное управление профилями химического состава и легирования.
Монокристаллические многослойные структуры толщиной лишь в несколько атомных
слоёв заложили основу экспериментальной квантовой физики. Использование
возможностей получения резких гетерограниц и профилей легирования позволяет
создавать приборы с желаемыми и новыми кинетическими и оптическими свойствами,
такими как сверхвысокая подвижность носителей заряда, сосуществование
электронов и дырок, характерное для полуметаллов и др. Часто при МЛЭ
используются маски, которые наряду с «рисованием» молекулярными пучками
позволяет создавать на пластинке трёхмерные монолитные структуры. МЛЭ может
быть использована не только для выращивания полупроводниковых наноструктур, но
также и для металлических и диэлектрических. Также видно, что в рассмотренных
системах проявляются самые разнообразные свойства границ. Для ряда систем
показана возможность улучшения условий роста и качества плёнок.
Метод МЛЭ открыл новую степень свободы в
изучении наномира и позволил создавать самые разнообразные наноструктуры
высокого качества.
Список использованных источников
[1]
Л. Ченг, К. Плог. Молекулярно-лучевая эпитаксия и гетероструктуры. - Москва,
«Мир», пер. с англ.,1989 - 584 с.
[2]К.В.
Малышев,Б.В. Стрелков, С.А. Мешков. Молекулярно-лучевая эпитаксия нанослоёв,
нанонитей и наночастиц. - М.: Изд-во МГТУ им. Н.Э. Баумана, 2007. - 49 с.
[3]
В.М. Березин, Н.С. Забейворота. Методы формирования тонкоплёночных структур. -
Челябинск: Из-во ЮУрГУ, 2010. - 96 с.
[4]
Ю.Г. Сидоров, С.А. Дворецкий, В.С. Варавин, Н.Н. Михайлов, М.В. Якушев, И.В.
Сабинина. Молекулярно-лучевая эпитаксия твёрдых растворов кадмий-ртуть-теллур
на альтернативных подложках. - Новосибирск: Институт физики полупроводников
Сибирского отделения Российской академии наук, 2001. - 10 с.
[5]
Я.Г. Копьёв, С.В. Новиков, Н.С. Соколов, Н.Л. Яковлев. Молекулярно-лучевая
эпитаксия и фотолюминесцентное определение упругих деформаций слоёв CaF2 и SrF2
на GaAs (111). -Ленинград: Физико-технический институт им. А.Ф. Иоффе Академии
наук СССР, 1989 г. - 6 с.
[6]
Н.О. Кривулин. Ультратонкие слои кремния на сапфире. - Нижний Новгород:
Нижегородский госуниверситет, 2011 г. - 40 с.
Приложение А
(обязательное)
Таблица 1
Некоторые физические свойства основных
элементов, используемых при МЛЭ
|
Парамет-ры
|
Ge
|
Si
|
In
|
Ga
|
As
|
Al
|
|
Атомный
номер
|
32
|
14
|
49
|
31
|
33
|
13
|
|
Атомная
масса
|
72,64
|
28,09
|
114,82
|
69,72
|
74,92
|
26,98
|
|
Параметры
решётки, Å
|
5,647
|
5,430
|
a=3,252
с=4,946
|
a=4,519
b=7,658 c=4,526
|
a=4,123
α=54,17°
|
4,05
|
|
Кристаллическая
структура
|
алмазная
|
кубичес-кая,
алмазная
|
тетраго-
нальная
|
ортором-
бическая
|
триго-
нальная
|
кубичес-каягранецен.
|
|
Кол-во
атомов в 1 см3
|
4,52*1022
|
4,99*1022
|
3,83*1022
|
5,10*1022
|
4,60*1022
|
6,02*1022
|
|
Плотность
при н.у., г/см3
|
5,32
(298 К)
|
2,33
(298 К)
|
7,31
|
5,91
|
5,73
(серый)
|
2,70
|
|
Температура
плавления, оС
|
940
|
1415
|
156
|
30
|
-
|
660
|
2700
|
2350
|
2080
|
2204
|
613
(сублим.)
|
2519
|
|
Удельная
теплоём-кость, Дж/(кг*К)
|
321
|
710
|
233
|
371
|
328
|
904
|
|
Коэффициент
теплового расширения, К-1
|
6*10-6
|
2,6*10-6
|
3,21*10-5
|
1,2*10-4
|
4,7*10-6
|
2,3*10-5
|
|
Коэффици-ент
теплопро-водности, Вт/(м*К)
|
60
|
150
|
82
|
29
|
50
|
235
|
Приложение Б
(обязательное)

Спектр пропускания CaF2

Элементарная ячейка кристаллической решётки
CaF2и SrF2

Спектр свечения кристаллов SrF2

Элементарная ячейка кристаллической решётки GaAs
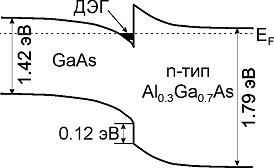
Гетеропереход GaAs/AlGaAs(ДЭГ - двумерный
электронный газ)
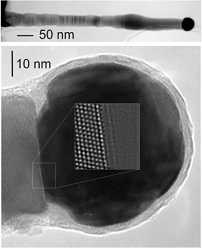 нанонить
нанонить
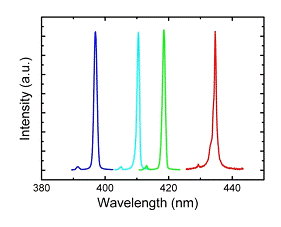
Эмиссионный спектрGaNлазерного диода