Исследование свойств многослойных нанокомпозитных сегнетоэлектрических пленок в диапазоне СВЧ
МИНОБРНАУКИ РОССИИ
Санкт-Петербургский государственный
электротехнический университет “ЛЭТИ” им. В.И. Ульянова (Ленина)
Направление 211000.68 Конструирование
и технология электронных средств
Магистерская программа 211051.68
Информационные технологии проектирования радиоэлектронных средств
Кафедра микрорадиоэлектроники и
технологии радиоаппаратуры (МИТ)
К защите
допустить:
Заведующий
кафедрой
Тупик В.А.
МАГИСТЕРСКАЯ ДИССЕРТАЦИЯ
Тема: Исследование свойств
многослойных нанокомпозитных сегнетоэлектрических пленок в диапазоне СВЧ
Студент
Шмахтенков И.Д.
Руководитель
Иванов А.А.
Санкт-Петербург
Содержание
Введение
. Отработка
технологии получения тонких пленок BST с воспроизводимыми характеристиками
.1 Описание
основных элементов базовой технологии получения слоистых структур, содержащих
тонкую сегнетоэлектрическую пленку с аномально высокой диэлектрической
проницаемостью и воспроизводимыми характеристиками тангенса угла
диэлектрических потерь, управляемостью, диэлектрической проницаемостью
.2 Технология
изготовления сегнетоэлектрических керамических мишеней.
.3
Оборудование и методика технологического процесса
.3.1
Установка для формирования металлических пленок
.3.2
Установка для напыления пленок BSTO
.4 Выбор
технологических режимов получения BST пленок с наиболее высокими
диэлектрическими характеристиками Выращивание пленок и рентгеновский
дифракционный анализ
.5 Отработка
технологии тонких пленок BSTO с воспроизводимыми характеристиками:
диэлектрической проницаемостью, тангенсом угла диэлектрических потерь и
нелинейностью.
.5.1 Влияние
легирования на диэлектрические характеристики BSTO пленок
.5.2
Диагностика BSTO пленок методом рассеяния ионов средних энергий (MEIS)
.5.3
Определение содержания кислорода в BSTO пленках с помощью метода рентгеновского
излучения, возбуждаемого ионами (РИВИ).
.5.4
Определение степени легирования пленок BSTO
. Отработка
методик измерения диэлектрической проницаемости, управляемости, тангенса угла
диэлектрических потерь сегнетоэлектрической пленки, напыленной на диэлектрическую
подложку
.1 Отработка
методик измерения диэлектрической проницаемости, управляемости, тангенса угла
диэлектрических потерь сегнетоэлектрической пленки
.1.1 Расчет
погонной емкости в плоскопараллельном конденсаторе, образованном на поверхности
диэлектрической структуры
.2
Определение параметров сегнетоэлектрических пленок по измерениям в объемном
резонаторе
.2.1
Определение параметров сегнетоэлектрических пленок по измерениям в щелевом
полуволновом резонаторе
.
Экспериментальные измерения емкости в планарных структурах
.1
Автоматизированная установка для измерений C, tg, их температурных зависимостей
и электропроводности
.2
Экспериментальные результаты измерений ёмкости планарного встречно щелевого
конденсатора на многослойной сегнетоэлектрической плёнке
.
Электродинамический анализ щелевой линии на нанокомпозитной
сегнетоэлектрической плёнке
.1 Модель
зависимости диэлектрической проницаемости сегнетоэлектроника от температуры
.2 Расчет
постоянной распространения электромагнитного поля в зависимости от температуры
и напряженности электрического поля
.2.1
Численный расчет зависимости постоянной распространения электромагнитного поля
от температуры и напряженности электрического поля
Заключение
Список
использованной литературы
Введение
Активное развитие радиоэлектроники требует надежных и недорогих
компонентов. Повышаются требования к характеристикам радиоэлектронных средств:
увеличение добротности, снижение потерь и энергоемкости, улучшение
управляемости, повышение мобильности, перенос рабочего диапазона на сверх- и
крайне высокие частоты.
Сегнетоэлектрик - это диэлектрик или полупроводник, обладающий в
определенном диапазоне температур спонтанной поляризацией. При понижении
температуры (до температур называемой точкой Кюри) в таком веществе происходит
фазовый переход, связанный с искажением кристаллической структуры, что и
приводит к появлению спонтанной поляризации. Спонтанная поляризация
сегнетоэлектрика легко изменяется под влиянием внешних воздействий, в
частности, при приложении электрического поля.
Сегнетоэлектричество зародилось в 1920 году, когда физик Джозеф Валашек
заметил, что вектор поляризации натрий-калиевого тетраттетрагидрата, более
известного как сегнетова соль, может изменить свое направление под действием
электрического поля. Сложности исследования сегнетоэлектричества заключались в
том, что малейшее отклонение от правильного химического состава сегнетовой соли
приводило к полному исчезновению этого явления. Сегнетова соль была детально
изучена в работах И.В.Курчатова и его сотрудников в Физико-техническом
институте Академии наук СССР в 1930-1934 гг.
В 1938 г. появились сообщения об обнаружении сегнетоэлектрических свойств
у фосфатов и арсенатов калия, но эти свойства имеют место только при весьма
низких температурах (точка фазового перехода дигидрофосфата калия 122К), что
делает невозможным их практическое применение.
Первый практически важный сегнетоэлектрик - титанат бария - был открыт в
1944 г. в Физическом институте им. П.Н.Лебедева Академии наук СССР Б.М.Вулом и
И.М.Гольдманом. Еще в 1925 г. Было обнаружено, что двуокись титана в виде
керамики обладает высокой диэлектрической проницаемостью, и логично было
изучить ее модификации с целью получения еще более высокой восприимчивости.
Характерная зависимость диэлектрической проницаемости от температуры и наличие
диэлектрического гистерезиса позволили Б.М. Вулу отнести титанат бария к новому
виду сегнетоэлектриков. Титанат бария стал наиболее интенсивно исследуемым
сегнетоэлектрическим материалом благодаря ряду свойств, полезных для практического
применения: механическая и химическая устойчивость, проявление
сегнетоэлектрических свойств при комнатной температуре (ТК=120ºС), простота изготовления. Еще одна
интересная особенность титаната бария - этот кристалл является многоосным
сегнетоэлектриком, т.е. в нем существует несколько возможных направлений
спонтанной поляризации. Поэтому его можно использовать для технический
применений в виде поликристаллов (керамики), а не в виде дорогостоящих
монокристаллов. При воздействии электрического поля на такой кристалл в нем
происходит ориентация доменов, которая сохраняется и после снятия поля. Кроме
того, используя обычную керамическую технологию, из поликристаллического
титаната бария можно изготовить изделия практически любой формы и размеров из достаточно
дешевых окислов и солей соответсвующих металлов.
Вскоре после открытия титаната бария В.Л. Гинзбург, эффективно применив
теорию фазовых переходов Л.Д. Ландау, создал феноменологическую теорию
сегнетоэлектричества, которая до сих пор лежит в основе всех термодинамических
описаний сегнетоэлектриков. Затем были созданы модельные теории, которые
привели к разделению сегнетоэлектриков на два класса: сегнетоэлектрики типа
смещения и сегнетоэлектрики типа порядок-беспорядок. Чёткой границы между этими
двумя типами систем не существует, поскольку в любом случае речь идёт об
усреднённой по времени структуре. Фактически системы типа порядок - беспорядок
можно выделить тем, что в них имеются ионы, для которых среднеквадратичное
отклонение от среднего положения аномально велико. В сегнетоэлектриках такого
типа при переходе в сегнетоэлектрическую фазу происходит упорядочение имевшихся
в исходной фазе диполей.
Джон Кларк Слэтер предположил, что сегнетоэлектрическое поведение
титаната бария вызвано дальнодействующими дипольными силами, которые стремятся
дестабилизировать высокосимметричную конфигурацию, устанавливающуюся благодаря
короткодействующим силам. Это объяснение стало основной моделью переходов типа
смещение и имело значительный успех, хотя оно и страдало от большого числа
параметров, пока не были сделаны допущения, касающиеся того, какой ион в первую
очередь отвечает за ионную неустойчивость. После получения приемлемых
результатов при учете движения только иона титана в жестком окружении остальной
решетки стала популярной концепция «болтающегося» титанового иона. Проблемы
такого представления были преодолены после того как Андерсон и Кокрен поняли,
что теорию следует строить в рамках динамики решетки и ограничиться при этом
рассмотрением одной из решеточных мод, включающей движение всех атомов и
описывающей неустойчивость решетки относительно смещения.
После открытия титаната бария некоторое время считалось, что среди
перовскитов титанат бария является единственным сегнетоэлектриком. Но затем в
результате исследований физиков было доказано, что в действительности многие
перовскиты переходят в сегнетоэлектрическое состояние. Множество
сегнетоэлектриков было обнаружено в многокомпонентных системах, для изучения
которых требуется много времени. Для преодоления этих трудностей были
предложены некоторые простые принцип «конструирования» сложных соединений. Эти
принципы позволили в сравнительно сжатые сроки синтезировать большое число
сегнетоэлектриков сложного состава.
В 60-е годы продолжался поиск и исследование кислородно-октаэдрических
сегнетоэлектриков с поливалентными ионами, находящимися в одинаковых
кристаллографических положениях в решетке. Были открыты сегнетоэлектрики с
размытыми фазовыми переходами и новый класс веществ с одновременно
электрическим и магнитным упорядочением, названными сегнетомагнетиками.
Сегнетоэлектрики с размытым фазовым переходом относятся к неупорядоченным и
неравновесным системам и получили широкое применение в конденсаторостроении.
В настоящее время в СВЧ-электронике, в основном, применяются твердые
растворы титаната бария-стронция (BaxSr1-xTiO3), благодаря высокому значению
диэлектрической проницаемости в широком температурном и частотном интервале и
низкому значению тангенса угла диэлектрических потерь.
Изучение сегнетоэлектриков - это не только фундаментальные исследования,
расширяющие наши знания о природе твердых тел.Сегнетоэлектрики и родственные им
материалы находят широкое применения во многих разделах техники. Они
используются для изготовления радиотехнических конденсаторов, пьезоэлектрических
преобразователей и фильтров и являются практически единственными материалами
для гидроакустических устройств, пироэлектрических приемников инфракрасного
излучения, в устройствах обработки и хранения информации, а радио-, акусто- и
оптоэлектронике. Сегнетоэлектрики особенно эффективны при работе в условиях,
требующих высокой радиационной стойкости.
Интерес к сегнетоэлектрическим материалам не случаен. Во многом он
определяется тем особым положением, которое занимают сегнетоэлектрики среди других
диэлектрических кристаллов. Среди 32 кристаллических классов есть 20 классов
(полярные и полярно-нейтральные кристаллы), которые поляризуются под действием
механических напряжений, то есть являются пьезоэлектриками. Из этих 20 классов
кристаллов, без центра симметрии и имеющих полярные оси, можно выделить 10
классов, обладающих особенными полярными направлениями - пироэлектрические
кристаллы. Сегнетоэлектрики - это подгруппа пироэлектриков с переключаемой
внешним электрическим полем поляризацией. Таким образом, сегнетоэлектрики
обязательно обладают пироэлектрическими и пьезоэлектрическими свойствами.
Основные характерные особенности сегнетоэлектрических кристаллов:
) наличие спонтанной поляризации в определенном диапазоне температур,
ограниченном температурой Кюри (TK);
) нелинейная гистерезисная зависимость поляризации от поля;
) диэлектрическая проницаемость в полярной фазе и вблизи TK достигает
огромных величин, вплоть до 104-105;
) величина диэлектрической проницаемости сильно зависит от напряженности
электрического поля;
) наличие доменной структуры при температурах ниже TK;
) высокие значения пироэлектрических коэффициентов;
) большие величины пьезоэлектрических модулей.
К фундаментальным особенностям сегнетоэлектриков относится их способность
в полярной фазе (ниже точки Кюри) разбиваться на большое число крошечных
областей с постоянной, возникающей самопроизвольно электрической поляризацией,
называемых доменами. Однако при обычных условиях направления поляризации в
отдельных доменах различны, и поэтому во всем образце дипольные моменты доменов
компенсируют друг друга и суммарная поляризация равна нулю. Образец становится
поляризованным лишь после того, как внешнее электрическое поле выстроит домены
в определенном направлении. Домены отделены друг от друга доменными стенками -
переходными областями, в которых электрические дипольные моменты изменяют свое
направление, характерное для одного домена, на направление в другом.
Что управляет образованием и структурой доменов? Если бы образец
сегнетоэлектрика был полностью поляризован и представлял собой один большой
домен, то он создавал бы сильное внешнее поле, направленное противоположно
поляризации и называемое деполяризующим полем. Разделение сегнетоэлектрика на
домены приводит к уменьшению деполяризующего поля. Однако процесс разбиения на
домены не может идти беспредельно, так как на образование доменных стенок
затрачивается определенная энергия. По-видимому, равенство энергии
деполяризующего поля и энергии доменных стенок ставит предел дальнейшему разбиению
образца на домены и определяет равновесный размер доменов.
При помещении образца сегнетоэлектрика во внешнее электрическое поле, то
в нем происходит перемещение доменных стенок, увеличивающее те домены, в
которых направление спонтанной поляризации наиболее близко к направлению
внешнего поля. Домены эти растут за счет доменов с менее выгодно
ориентированным дипольным моментом, и последние сокращаются.
Управляемость сегнетоэлектриком осуществляется внешним электрическим
полем и сохраняется в широком диапазоне частот. Электрический способ управления
параметрами радиоэлектронных компонентов отличается высокой скоростью, малыми
энергетическими затратами и малыми габаритами электрических систем. Поэтому
сегнетоэлектрики представляют интерес для исследования.
Значительным потенциалом для разработки СВЧ-управляемых устройств нового
поколения обладают слоистые композиции на основе сегнетоэлектрических пленок
(СЭП).
Для изготовления управляемых приборов (полосно-пропускающих фильтров,
фазовращателей, фазированных антенных решеток, перестраиваемых генераторов
СВЧ-излучения и др.) на основе планарных СЭП-структур применяется интегральная
технология формирования матриц компонентов, не требующая дополнительного
монтажа, сварки и соединения отдельных элементов в электронную цепь.
Структуры, состоящие из диэлектрической подложки с нанесенными на нее
сегнетоэлектрическими пленками, обладают возможностью управления фазовой
скоростью электромагнитной волны. Электродинамический анализ таких структур
должен проводиться с позиций требований к управлению фазовой скоростью.
Постоянная распространения электромагнитной волны (а, следовательно, и ее
фазовая скорость) в СЭП зависит от температуры. РЭС проектируются для
достаточно широкого температурного диапазона, поэтому необходимо добиться
стабилизации фазовой скорости. Последняя зависит от толщины пленки, ее
диэлектрической проницаемости и толщины подложки.
Методы получения сегнетоэлектрических пленок непрерывно развиваются и
совершенствуются. Получение качественных тонких пленок довольно сложная задача.
В настоящее время в технологии изготовления пленок развиваются два основных
направления:
разработка химических методов. В этих методах источниками являются
химические соединения (в основном металлоорганические), а процесс переноса атомов
происходит в форме сложных химических комплексов;
разработка физических методов. В этих методах поток частиц на подложку
создается с помощью физических процессов (испарение, распыление), а
формирование пленки происходит на поверхности подложки в результате конденсации
атомов и молекулярных комплексов.
Из химических методов активно применяются золь-гель-метод и газофазное
осаждение, а из физических - лазерное испарение, ионно-плазменное распыление и
термическое испарение.
Лазерное испарение - процесс быстрого плавления и испарения материала
мишени, при использовании высокоэнергетического лазерного излучения, с
последующим переносом материи от мишени к подложке в вакууме. Лазерное
излучение обеспечивает самую высокую плотность энергии на распыляемой поверхности.
Этот метод позволяет получать сложные оксидные системы, в состав которых входят
элементы с различными коэффициентами распыления. При интенсивном лазерном
облучении мишени и высокой плотности потока частиц на поверхности подложки
происходит осаждение кластеров материала за короткое время. При этом за период
осаждения кластеров следует период паузы и окисления осажденного материала.
Взаимодействие между выращиваемой пленкой и подложкой слабое, поэтому
характеристики подложки не играют столь существенной роли, как в более
равновесных технологических процессах атомного осаждения материала.
Достоинства лазерного испарения:
высокая скорость конденсации
возможность быстрой смены мишени в ходе технологического процесса,
расположение источника энергии за пределами технологической камеры.
Ионно-плазменное распыление (ИПР) объединяет большую группу ионно-лучевых
и плазменных методик на постоянном токе и на высокой частоте. Технологические
направления: раздельное распыление компонентов и распыление композитных керамических
или порошковых мишеней. Перовскитные пленки чаще всего получают в смеси аргона
с кислородом при температуре осаждения не менее 600ºС.
Сложность осаждения пленки при раздельном распылении компонентов связана
с мишенью из бария, который является предельно активным элементов и в
нормальных условиях не существует в свободном состоянии. Это приводит к
необходимости использовать оксид бария. Получаемые таким способом пленки
требуют дополнительного отжига при высокой температуре в среде кислорода.
Для снижения воздействия отрицательных ионов на растущую пленку
необходимо высокое давление рабочего газа при параллельном расположении
подложки и плоскости мишени, что накладывает серьезные ограничения на работу
распыляющих устройств и значительно снижает скорость осаждения.
Другой способ заключается в перпендикулярном расположении плоскости
подложки и мишени (модифицированные схемы магнетронного распыления).
В высокочастотных магнетронных распылителях возрастает концентрация
отрицательных ионов кислорода. Для улучшения качества получаемых пленок мишени
располагают друг напротив друга, а подложку в перпендикулярной плоскости.
Получается симметричная система с практически одинаковыми фазами ВЧ-напряжения
на обоих мишенях. В результате электроны, способствующие ионизации ионов, не
покидают пространство между мишенями.
Термическое испарение (ТИ). Важными достоинствами этого метода являются
высокая чистота, точность управления технологическим процессом и возможность
послойного, атомного осаждения компонентов при выращивании пленок сложных
соединений. Метод активно применяется для исследования влияния концентрации
кислорода на электрофизические и структурные характеристики пленок.
Основные недостатки метода:
сложность насыщения пленок кислородом;
дорогостоящий и трудоемкий метод.
Метод газофазного осаждения разработан для промышленного синтеза пленок
полупроводниковых и интерметаллических соединений. Газофазное химическое
осаждение из металлоорганических соединений позволяет выращивать эпитаксиальные
слои сегнетоэлектрический пленок толщиной от 10 нм. Преимущества этой
технологии заключаются в высокой однородности осаждения пленки на площади до
150 мм в диаметре, высокой однородности микроструктуры, в возможности
прецизионного контроля состава и высокой производимости. Основные недостатки
метода газофазного осаждения: необходимость применения сложных исходных
химических соединений, обладающих высокой летучестью, сложное технологическое
оборудование, высокая стоимость.
В последние годы для синтеза СЭП активно применяется золь-гель-метод. В
качестве исходных продуктов используются ацетаты бария и стронция, изопропоксид
титана, которые растворяются в уксусной кислоте. В основе метода лежат реакции
гидролиза и поликонденсации металлоорганических соединений, главным образом алкоголятов
металлов, ведущие к образованию металл-кислородного каркаса, постепенное
разветвление которого вызывает последовательные структурные изменения по схеме
раствор-золь-гель-оксид. Такой метод обеспечивает возможность очень точного
управления структурой получаемого вещества на молекулярном уровне, получение
многокомпонентных оксидных соединений с точным соблюдением стехиометрического
соотношения элементов, высокой гомогенностью и низкой температурой образования
оксидов.
Достоинства метода:
хорошая однородность пленок на большой площади,
сравнительно низкая стоимость.
Целью данной работы является исследование нескольких вариантов структур
на основе СЭП и получения температурной стабилизации на разных частотах в
пленках с различным числом слоев.
1. Отработка
технологии получения тонких пленок BST с воспроизводимыми характеристиками
1.1 Описание
основных элементов базовой технологии получения слоистых структур, содержащих
тонкую сегнетоэлектрическую пленку с аномально высокой диэлектрической
проницаемостью и воспроизводимыми характеристиками тангенса угла
диэлектрических потерь, управляемостью, диэлектрической проницаемостью
Полный технологический цикл проектирования и изготовления
радиоэлектронных компонентов на основе сегнетоэлектрических пленок представлен
на рис. 1.1.
Приведенная последовательность операций может быть условно разделена на
следующие группы или технологические стадии:
(А) Операции 1, 2 и 3. Электродинамический расчет и разработка САПР.
(В) Операции 4 - 7. Выращивание пленочных структур. Основной
технологический метод выращивания оксидных пленок ВЧ катодное распыление
(операции 5,6). Магнетронное распыление на постоянном токе (операция 7)
используется для нанесения электродных слоев. Для уменьшения эффекта
гистерезиса и для низкотемпературных применений (около 77 К) СЭП структур
возможно применение проводящих оксидных слоев SrRuO3, YBa2Cu3O7-x с
перовскитоподобной кристаллической структурой.
(С) Операции 8 - 10. Микропрофилирование СЭП слоистых структур. На этой
стадии технологического процесса применяется фотолитография. На следующей
операции можно применять химическое или ионное травление. Высокую разрешающую
способность обеспечивает ионное травление (10), однако, в том случае, когда
топологические размеры составляют более 10 мкм, химическое травление более
предпочтительно, вследствие меньшего повреждения поверхностного слоя СЭП.
(D) Операции 11, 12 связаны с
электрическими измерениями, физическими исследованиями СЭП и слоистых структур,
и аналитической диагностикой. Результаты исследований пленок используются на
стадии (А), т.е. при разработке топологии СВЧ устройств, в порядке обратной
связи: топология - измерения - исправления топологии.
(E) Операции 15- 17 связаны с
разработкой низкочастотных цепей на основе микропроцессорного контроллера для
приложения управляющего напряжения к электродам МЩЛ. Электронная схема
обеспечивает фазовый сдвиг и управление СВЧ устройств. Микроэлектронная схема
фазовращателей соединяется со схемой управления.
На последней стадии технологического процесса (операции 18 - 20)
выполняется сборка металлического прямоугольного волновода, СВЧ
микроэлектронного устройства и микропроцессорной схемы управления. После
тестовых испытаний проводится корректировка проектных топологий СВЧ устройств,
технологических режимов и последовательности операций изготовления. Результаты
испытаний прототипов фазовращателей, резонаторов, фильтров анализируются и
сравниваются с характеристиками СВЧ устройств-аналогов. На основе
сравнительного анализа вырабатываются рекомендации для серийного производства.
`
Рис. 1.1. Технологическая схема процесса изготовления радиоэлектронных
компонентов на основе сегнетоэлектрических пленок
1.2
Технология изготовления сегнетоэлектрических керамических мишеней
Керамические материалы для применений в СВЧ технике имеют
многокомпонентный состав и сложную, иногда многофазную структуру, а образцы
должны иметь заданные форму, размеры и низкую пористость. При спекании керамики
из смеси оксидов, солей и других исходных веществ, взятых в заданных
пропорциях, происходит ряд физико-химических превращений: реакции в твердой
фазе, разложение солей с выделением газов и т.п. Эти процессы приводят к
чрезмерно высокой усадке при спекании, вызывающей недопустимые деформации
изделий, и к повышению их пористости. Поэтому необходимо, чтобы до
окончательного обжига происходило как можно больше физико-химических
превращений, происходящих в керамических материалах в процессе обжига,
связанных с образованием соединений и твердых растворов из оксидов и солей, в
особенности сопровождающихся разложением исходных компонентов с выделением
газов. Предварительный синтез проводят, в том числе, для получения (Ba,Sr)TiO3.
Одним из способов синтеза исходных соединений является термический синтез
- образование соединений в процессе твердофазной реакции при высоких
температурах. Титанат бария синтезируют путем обжига смеси карбоната бария и
диоксида титана.
Схема технологического процесса следующая. Карбонат бария и диоксид
титана смешивают мокрым способом в шаровой мельнице, футерованной износостойкой
резиной, высокоглиноземистыми мелющими телами. Одновременно со смешением
происходит измельчение - помол смеси. Для ускорения реакций, происходящих при
синтезе, и снижения температуры синтеза необходимо применять мелкодисперсное
сырье, поэтому предпочтительно использование диоксида титана в кристаллической
модификации анатаза, имеющего большую, чем рутил, дисперсность.
Размолотая смесь (шликер) сливается из шаровой мельницы в контейнер, где
непрерывно перемешивается во избежание расслоений. Из контейнера шликер
мембранным насосом перекачивается в расходный бачок, снабженный устройством,
регулирующим постоянный уровень шликера. Отсюда шликер дозирующим насосом
подается во вращающуюся печь (рис. 1.2). В противоположную часть печи подается
топливо (керосин), которое сгорает в смеси с воздухом. Вращающая печь имеет
некоторый наклон (≈4° к горизонту), поэтому шликер, подаваемый в
загрузочную чать печи, постепенно движется навстречу горящему факелу керосина,
проходя интервал температур от комнатной до максимальной температуры обжига.
Вращение печи вокруг своей оси способствует движению и перемешиванию обжигаемых
материалов.

Рис. 1.2. Принцип термического синтеза во вращающейся печи.
диэлектрический пленка подложка емкость
Образование метатитаната бария по реакции
BaCO3
+ TiO2 → BaTiO3 + CO2
начинается при температуре ≈800˚С. При дальнейшем повышении
температуры (≈1000˚С) эта реакция сопровождается образованием
ортотитаната бария
BaCO3
+ BaTiO3 → Ba2TiO4 + CO2.
При температуре начиная с 1100˚С, при реакции метатитаната бария с
диоксидом титана образуется “трититанат бария”, точнее, Ba6Ti17O40. Далее
ортотитанат и “трититанат” взаимодействуют между собой с образованием конечного
продукта - метатитаната бария (1200˚С). При необходимости спек титаната
бария может быть дополнительно размолот сухим способом.
Изготовленный спек характеризуют следующими параметрами: насыпной массой
(кг/л), молярным отношением оксидов BaO/TiO2, содержанием “свободного” оксида
бария, количеством остатка, нерастворимого в соляной кислоте, содержанием
примесей, удельной поверхностью.
Насыпная масса (вес) свидетельствует о надлежащей степени синтеза
титаната бария, который по мере увеличения температуры синтеза спекается в
относительно крупные гранулы (»10 мкм). В зависимости от назначения спека его насыпная масса
устанавливается в пределах 1,2-1,5кг/л. Определение насыпной массы,
производимое непосредственно на выходе печи, является эффективным
экспресс-методом контроля качества спека.
Соотношение оксидов BaO/TiO2, характеризующее стехиометрию
полученного продукта, необходимо поддерживать в пределах 1,00±0,02, однако для большинства
современных материалов стехиометрия должна быть соблюдена более точно. Как
правило, BaO/TiO2=0,99-1,00 или 1,00-1,01 в зависимости от назначения
спека.
Остаток, нерастворимый в HCl,
является косвенным показателем содержания в спеке полититанатов, а также
соединений бария с анионными примесями (например, сульфата бария, образующегося
при наличии в исходном сырье серы в количестве нескольких десятых процента).
Обычно стремятся к минимуму содержания в спеке нерастворимого остатка. Наличие
посторонних фаз в спеке может быть также определено рентгенофазовым анализом.
Как показывает опыт, особенно заметно влияние на качество материалов
таких примесей в спеке, как SrO, Fe2O3, Al2O3 и Na2O. Примеси Fe2O3, SrO, и
Na2O встречаются в исходном сырье, а Al2O3 - результат
некоторого намола материала высокоглиноземистых мелющих тел. Колебания в
содержании этих примесей могут привести к колебаниям в положении температуры
точки Кюри материалов, значений их диэлектрической проницаемости и
температурной стабильности. Содержание примесей в спеке во многом определяется
качеством исходного сырья и не поддается регулированию в процессе производства,
а степень их влияния на параметры керамики сравнима с влиянием специально
вводимых добавок. Поэтому необходимо стремиться к минимальному содержанию
примесей в сырье.
По аналогичной технологической схеме во вращающихся печах изготавливаются
спек титаната кальция и некоторые другие крупнотоннажные спеки. Путем реакции в
твердой фазе синтезируются такие соединения, как BaZrO3, CaZrO3,
BaSnO3, CaSnO3, SrTiO3,
сложные свинецсодержащие соединения и твердые растворы. При относительно малых
количествах потребляемых продуктов их синтез проводят не во вращающихся печах,
а в электрических печах туннельного и камерного типа. Для уменьшения
занимаемого объема при обжиге из смеси предварительно прессуются брикеты при
сравнительно невысоком удельном давлении (200-400кг/см2).
Разновидностью термического синтеза можно считать самораспространяющийся
высокотемпературный синтез (СВС), или технологическое горение. Сущность этого
метода заключается в том, что в качестве исходных берутся активные компоненты,
приводящие к экзотермической реакции получения требуемого соединения.
Работы по получению исходных веществ для керамики BaTiO3, BaZrO3, CaTiO3,
PbTiO3 и других - показали возможность
применения метода СВС для их синтеза. Синтез BaTiO3 из смеси BaO2, Ti и TiO2 проходит при одновременном протекании трех
экзотермических реакций:
BaO2 + 0,5TiO2 → BaTiO3 + 563кал/г;(BaO + TiO2) → yBaTiO3 + 160,5кал/г;(BaO2 + TiO2) →
x(BaTiO3 + 0,5O2) + 74,7кал/г.
Соответствия состава и структуры получаемых продуктов заданным значениям
можно добиться рациональным выбором соотношения компонентов и режима синтеза.
Однако продукты получаются грубодисперсными и не имеют преимуществ против
термически синтезированных соединений; в то же время для СВС необходимо
применять более дорогое сырье.
1.3
Оборудование и методика технологического процесса
.3.1
Установка для формирования металлических пленок
В состав технологической установки входят следующие основные системы:
Вакуумная и газовая система: механический форвакуумный насос,
турбомолекулярный насос, вентили и затворы, устройства для измерения вакуума,
натекатели, бустерный объем, баллон.
Электрическая система: устройства, обеспечивающие электропривод насосов,
гидропривод колпака, устройство, обеспечивающее нагрев подложки.
Высоковольтный источник.
Подколпачное устройство: два магнетрона, нагреватель подложки.
В качестве базовой технологической установки для получения пленок платины
была выбрана вакуумная установка УВР-3М. Блок схема переоборудованной
технологической установки приведена на рис. 1.3.
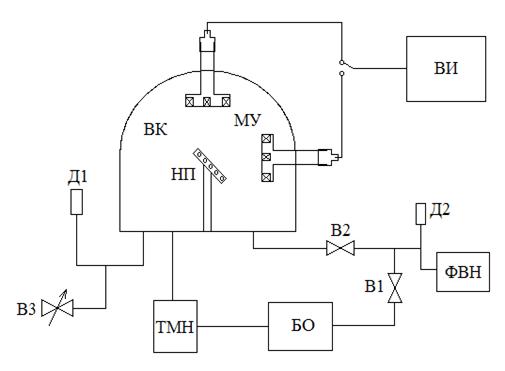
Рис. 1.3. Блок-схема вакуумной установки для напыления платины
Д1, Д2 - измерительные лампы; В1, В2, В3 - натекатели; ФВН - форвакуумный
насос; БО - бустерный объем; ТМН - турбомолекулярный насос; ВК - вакуумная
камера; МУ - магнетронное устройство; НП - нагреватель подложки; ВИ -
высоковольтный источник.
Вакуумная система.
Форвакуумный насос обеспечивал предварительный вакуум, затем
турбомолекулярным насосом достигался высокий вакуум (до 10 Па). Контроль
вакуума и давление рабочего газа выполнялись термопарными датчиками ПМТ-6
(105…10 Па) и ПМТ-4 (10…0,1 Па). Система водяного охлаждения включала медную
трубку для охлаждения рабочего объема (вакуумного колпака). Газовая система
включала баллон аргона, точный натекатель газа в рабочий объем.
Электрическая система.
Все устройство питается от трехфазной сети с заземленной нейтралью и
включается общим пускателем. Далее каждое устройство электрической системы
запускается своим электромагнитным пускателем, кроме электромагнитного клапана
гидропривода подъема колпака. Цепь нагревателя подложек состоит из мощного
понижающего трансформатора, напряжение на первичной обмотке которого
регулируется вручную с помощью автотрансформатора типа - 9 А, что позволяет
подавать напряжение на нагреватель подложек от 0 до 20 В при токе 40 А. Все
электрооборудование смонтировано внутри каркаса вакуумной установки, и
управление электрической системы выведено на переднюю панель.
Магнетронный узел.
Магнетрон является основным технологическим узлом экспериментальной
установки для выращивания пленок хрома, титана, меди, золота, платины. Его
конструкция определяет диапазон возможного регулирования технологических
факторов процесса формирования пленки. На рис. 1.4 представлен эскиз
магнетрона.

Рис. 1.4. Устройство магнетрона.
- изолирующее кольцо; 2 - трубка охлаждающей системы; 3 - шайба; 4 -
гайка; 5 - шпилька; 6 - трубка охлаждающей системы; 7 - шпилька; 8 - гайка; 9 -
установочное кольцо; 10 - стакан; 11 - установочное кольцо; 12 - крепежный
болт; 13 - установочное кольцо; 14 - уплотнительное кольцо; 15 - корпус
магнетрона; 16 - уплотнительное кольцо; 17 - штуцер; 18 - штуцер; 19 -
магнитопровод; 20 - кольцевые магниты; 21 - центральный магнит; 22 - мишень (Ti); 23 - уплотнительное кольцо; 24 -
крепежный болт.
С помощью установочных колец 9, 11 и 13 магнетрон крепится в колпаке
вакуумной установки. Установочное кольцо 13 выполненное из диэлектрического
материала (органическое стекло) обеспечивает электрическую изоляцию корпуса
магнетрона от стенок камеры. С помощью кольца 1, которое также служит
изолятором, шайбы 3, гайки 4 и шпильки 5, которая выполняет функции токовода,
стакан крепится к основному корпусу магнетрона. Установочное кольцо 9 имеет
резьбовые отверстия со шпильками 7, которые позволяют регулировать расстояние
мишень-подложка и фиксируют магнетрон в окне вакуумного колпака. Титановая
мишень крепится к корпусу магнетрона болтами и уплотняется резиновым кольцом
для поддержания вакуума, а платиновая, выполненная в виде фольги,
устанавливается на латунной оправке. Охлаждение магнетрона производится с
помощью медных трубок 2 и 6 впаянных в медные штуцера 17 и 18 корпуса
магнетрона. Боковая поверхность магнетрона защищена пермалоевым экраном,
экранирующим магнитное поле магнетрона. Рабочий режим магнетрона - ток до 1А,
напряжение разряда 200-500В.
.3.2
Установка для напыления пленок BSTO
В состав технологической установки входят следующие основные системы:
вакуумная и газовая система, включающая механический форвакуумный насос,
вентили, затворы; устройства для измерения вакуума; натекатели, смеситель
газов, расходомеры, баллон;
электрическая система: устройства, обеспечивающие электропривод
двигателей механического насоса, гидропривода колпака, устройства,
обеспечивающие нагрев подложек;
ВЧ - генератор и приборы, обеспечивающие его согласование с
распылительным устройством;
подколпачное устройство, включающее ВЧ - распылительное устройство,
нагреватель подложек, термопару.
В качестве базовой технологической установки для выращивания
сегнетоэлектрических пленок BSTO была выбрана вакуумная установка УРМ
3.279-014. Блок-схема переоборудованной технологической вакуумной установки
приведена на рис. 1.5.
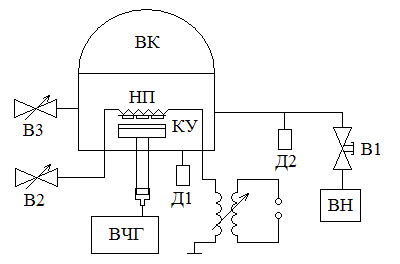
Рис.1.5. Блок схема технологической установки ВЧ ИПР.
ВК - вакуумная камера; ВН - вакуумный насос (механический); В1 - клапан
коммутационный; В2 - натекатель атмосферы; В3 - натекатель рабочего газа; Д1 -
датчик термопарный ПМТ - 6; Д2 - датчик термопарный ПМТ - 4; ВЧГ - высокочастотный
генератор; КУ - катодный узел; НП - нагреватель подложек; ТР - трансформатор
регулирующий
Вакуумная и газовая система.
Механический насос ВН обеспечивал необходимый вакуум (менее 1Па), потому
паромасляный высоковакуумный насос, входящий в состав установки, не
применяется. Контроль вакуума и давление рабочего газа выполнялись термопарными
датчиками ПМТ- 6 (105...10Па) и ПМТ- 4 (10...0.1Па). Система водяного
охлаждения включала медную трубку для охлаждения рабочего объема (вакуумного
колпака) и коаксиальный ввод для охлаждения распылительного устройства
(катодного узла). Газовая система включала баллоны аргона и кислорода высокой
чистоты, устройство для смешивания газа, содержащее манометры и расходомеры,
точный натекатель газа в рабочий объем.
Электрическая система.
Все устройство питается от трехфазной сети с заземленной нейтралью и
включается общим пускателем. Далее каждое устройство электрической системы
запускается своим электромагнитным пускателем, кроме электромагнитного клапана
гидропривода подъема колпака. Цепь нагревателя подложек состоит из мощного
понижающего трансформатора, напряжение на первичной обмотке которого
регулируется вручную с помощью автотрансформатора типа - 9 А, что позволяет
подавать напряжение на нагреватель подложек от 0 до 20 В при токе 40 А. Все
электрооборудование смонтировано внутри каркаса вакуумной установки, и
управление электрической системы выведено на переднюю панель.
Высокочастотный генератор ВЧД - 2.5/13 (СД-Л01) состоит из трех блоков:
шкафа генератора, переключателя нагрузки с согласующей выходной индуктивностью,
пульта управления. Рабочая частота - 13,56 МГц, максимальная мощность - 2,5
кВт, потребляемая мощность - 6 кВт, анодное напряжение 5 кВ.
Внутри шкафа генератора размещены: генераторная лампа с устройством
воздушного охлаждения и трех-фазным электродвигателем; генераторный блок с
элементами LC-контуров, анодный трансформатор, высоковольтный выпрямитель,
пусковая аппаратура.
Согласующее устройство содержит переменные емкости и индуктивность
нагрузочного контура и позволяет согласовать генератор с нагрузкой. Управление
подстроечным согласующим конденсатором осуществляется электрически, с помощью
реверсивных электродвигателей. При подстройке конденсатора происходит изменение
зазоров между обкладками свободного конденсатора. На блоке согласования
находится пульт управления с приборами контроля, сигнализации и пуска.
Вакуумная установка присоединяется к генератору посредством коаксиального
фидера из медных труб - наружная - диаметром 90 мм ; внутренняя - диаметром 30
мм. Общая длина фидера - 1,5 м; в месте перпендикулярного соединения труб
имеется балластная емкость - 40пФ. Установка генератора полностью экранирована,
благодаря чему уровень внешнего ВЧ-излучения не превышает действующих норм.
Характерной особенностью ВЧ - распыления является необходимость
согласования ВЧ - генератора с распылительной системой, импеданс которой может
меняться в широких пределах в зависимости от давления рабочего газа, размеров
электродов, а также в результате запыления элементов конструкции. В
согласованном режиме генератор должен иметь следующие показания приборов:
При режиме 100% мощности:
анодный ток при распылении - 0,3 ¸ 0,75 А
сеточный ток при распылении -0,1 ¸ 0,3 А
рабочая частота - 13,56 ± 0,14 МГц
Катодный узел ВЧ - распыляющего устройства и подложкодержатель.
Катодный узел (КУ) является основным технологическим узлом
экспериментальной установки для выращивания СЭП. Его конструкция определяет
диапазон возможного регулирования технологических факторов процесса формирования
пленки. На рис. 1.6 представлен эскиз катодного узла ВЧ распыляющего
устройства.
1. подложка на
подложкодержателе;
2.
подложкодержатль (цилиндр из кварца и пластины);
3. экран мишени
катодного узла (Ti);
4. изоляторы
(кварц);
5. ограничительное
кольцо мишени (Ti);
. керамическая
мишень;
7. держатель
керамической мишени;
8. боковой экран
катодного узла;
9. платформа
катодного узла;
10. нижний экран;
11. трубка
катодного узла;
12. верхняя втулка
(фторопласт);
13. цилиндр -
экран;
14. заземляющая
гайка;
15. плита
вакуумной установки;
16. нижняя втулка
(фторопласт);
17. поджимающая
гайка;
18. медная входная
трубка;
19. резиновые
уплотнители;
20. водяной
штуцер;
21. ВЧ подвод;
22. держатель
нагревателя;
23. нагреватель;
24. шайба.

Рис.1.6. Эскиз конструкции катодного узла ВЧ распыляющего устройства.
С помощью нижней и верхней фторопластовых втулок, которые одновременно
служат изоляторами, а также нижней гайки, катодный узел крепится на плите вакуумного
устройства. КУ содержит керамическую мишень, которая с помощью держателя
устанавливается на платформе катодного узла. ВЧ - энергия подается с помощью ВЧ
- подвода к трубке катодного узла, на которой крепится платформа КУ.
Приведенная конструкция КУ позволяет прикладывать высокую мощность к
поверхности мишени, соответствующую плотности ВЧ - разряда до 20вт/см2.
“Нижнее” расположение КУ относительно подложкодержателя имеет свои
преимущества, поскольку в этом случае существует возможность применения порошковых
мишеней.
В данной работе была разработана новая, “порошковая” технология
изготовления мишени, вместо керамической пластины, для проведения процесса ВЧ
распыления. Специальная оправка, изготовленная из дюралюминия, имевшая форму
тонкой дисковой пластины (толщиной ~ 3 мм) с верхними и нижними бортиками,
закреплялась на поверхности охлаждаемой платформы КУ. Нижние бортики оправки
позволяли применять метод плотной посадки оправки и обеспечивать хороший
тепловой контакт. Верхние бортики высотой 1 - 1.5 мм позволяли равномерно
распределять порошок на поверхности оправки. Порошковая смесь синтезированных
составов BaxSr1-xTiO3 укладывалась на верхнюю поверхность, выравнивалась и
прессовалась слабым давлением. После прогрева и предварительного распыления (в
течение не менее 2 часов) мишень применялась для осаждения пленок.
Для устойчивого распыления мишени и устранения пробоев применяется
система электрических экранов. Ближайший к боковой поверхности платформы КУ
цилиндрический экран имел зазор 1 - 2 мм. Внешним экраном являлась кварцевая
труба. На верхней торцевой поверхности трубы располагалась заслонка с наружным
механическим управлением, что позволяло в каждом технологическом процессе
проводить предварительное распыление и стабилизацию режимов перед началом
осаждения пленки на подложки.
Подложки закреплялись на нижней поверхности кварцевой пластины
подложкодержателя - нагревателя с помощью тонких поликоровых пластин.
Нагревательный элемент, изготовленный из ленты высокотемпературного материала -
"Сплав-2", размещался между пластинами из плавленного кварца, которые
скреплялись держателем с верхним металлическим экраном, снижавшим постороннее
тепловое излучение. Подложкодержатель подвешивался над поверхностью мишени на
заданном расстоянии с помощью кронштейна. Температура подложкодержателя
контролировалась по показаниям термопары и регулировалась посредством тока
через нагревательный элемент.
1.4 Выбор
технологических режимов получения BST пленок с наиболее высокими диэлектрическими характеристиками Выращивание
пленок и рентгеновский дифракционный анализ
Среди известных сегнетоэлектрических материалов твердый раствор BaxSr1-xTiO3 (BSTO)
наиболее соответствует требованиям СВЧ применений, поскольку данное соединение
обеспечивает максимальное изменение диэлектрической проницаемости под действием электрического поля,
при минимальных диэлектрических потерях [2, 3, 4]. Фазовый переход из
параэлектрической в сегнетоэлектрическую фазу происходит при температуре Кюри
TС, соответствующей максимальному значению диэлектрической проницаемости. Для
работы устройств при комнатной температуре величина x должна быть равна 0.5 - 0.6. Пленки BSTO, выращенные на различных подложках, отличаются
структурными микродеформациями и напряжениями, которые оказывают влияние на
температурную зависимость диэлектрической проницаемости. В реальных кристаллах
и пленках фазовый температурный переход и диэлектрический отклик СЭП зависят от
множества факторов, таких как качество кристаллической структуры, дефицит
кислорода, размера зерна, величина микродеформаций, плотность заряженных
состояний на интерфейсе и свойств подложек. Поэтому наблюдается отличие между
TC и Tm -температуры, соответствующей максимуму зависимости e(T).
В данной работе для формирования СЭП были использованы следующие
подложки: MgO; LаAlO3 (LAO), NdGaO3 (NGO); сапфир a-Al2O3 [1012] - (a) и поликор. Параметр рассогласования
кристаллической структуры подложек и пленок определялся следующим образом: =
2(aS - aF)/( aS + aF), где aS, aF - параметры решетки подложки и пленки,
соответственно. Таким образом, для BaSrTiO3 пленки: a-Al2O3» ; MgO» ; LAO) » -3.7%; (NGO) » -1.5%. Ромбические структурные
искажения на поверхности подложки сапфира увеличивают несоответствие с
перовскитной пленкой. Температурный коэффициент расширения должен также
учитываться в расчете. Коэффициент увеличивается в следующем ряду соединений:
MgO; BSTO; NGO, LAO. Значения отношениий (BSTO)/ и (BSTO)/MgO) составляют около
1.5. Отношение коэффициентов для структуры BSTO/LAO в несколько раз больше по сравнению с другими
композициями СЭП/подложка, которые применялись в данной работе, поэтому
структура BSTO/LAO отличалась
наличием высоких структурных напряжений на интерфейсе.
В процессе изготовления пленок (состав порошковой мишени BaxSr1-xTiO3 x =
0.50 ¸ 0.65) были использованы следующие
технологические режимы: давление кислорода во время процесса распыления 5-20
Па; расстояние между пленкой и подложкой 15-50 мм; мощность ВЧ разряда 6 -10 Вт
/ см2; температура подложки 650 - 850 0С; скорость роста пленки составляла 1,5
- 2 нм / мин. Технологические карты образцов характеризующих проведенную работу
приведены в Приложении. Исследование начальных стадий роста пленок BSTO
показал, что эпитаксиальный рост может быть реализован только на подложках LAO
и MgO. При температуре подложки больше, чем 700 0С и достаточно высоком
давлении кислорода (более 20 Па) были получены высоко-ориентированные пленки на
подложках обоих типов. Рентгено-дифракционные анализ (РДА) BSTO/MgO, BSTO/a и BSTO/LAO структур использовался
для характеристики кристаллической ориентации, деформационного сдвига и
микронапряжений (Da/a)
(см. рис.1.6 ). Рентгеновские дифрактограммы содержат только (k00) пики,
примесные фазы отсутствуют. Наименьший (Da/a) параметр (~ 10-4) был определен для структур BSTO/NGO и
BSTO/LAO. На рис.1.7 (a, b, c) представлены рентгено-дифрактограммы BSTO пленок
на различных монокристаллических подложках (сапфир, LAO, MgO, соответственно),
выращенных в едином технологическом процессе .
На рис. 1.7 (d, e) представлены рентгенограммы BSTO пленок, выращенных на
подложках сапфира и поликора (поликристаллическая форма корунда Al2O3).
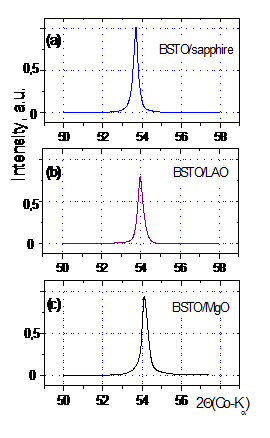


Рис. 1.7. Дифрактограммы BSTO пленок, выращенных на различных подложках:
(a) высокоориентированная BSTO пленка (h~ 300 нм) подложка сапфир; (b)
эпитаксиальная BSTO пленка (h~ 300 нм) подложка LAO №267_2; (c) эпитаксиальная
BSTO пленка (h~ 300 нм) подложка MgO №267_3; (d) текстурированная BSTO (100)
пленка (h~ 700 нм) подложка поликор; (e) высокоориентированная (110) BSTO
пленка (h~ 700 нм) подложка сапфир
Подложка из поликора широко применяется в СВЧ электронике, так как
поликор обладает низкими диэлектрическими потерями, высокими механическими
свойствами и малой стоимостью. Возможность формирования СЭП топологий на
недорогих поликоровых подложках, которые обладали бы низкими диэлектрическими
потерями, высокой управляемостью, и также высокой электрической, температурной
и временной стабильностью, открывает промышленные перспективы для создания
гибридных СЭП ИС, обладающих высокой конкурентоспособностью.
РДА анализ показал, что кристаллографическая ориентация BSTO пленок,
выращенных на подложках из поликора зависит от режима технологического
процесса. Если температура подложки составляла менее 7000C, давление кислорода
не более 20 Па и обеспечивалась достаточно высокая скорость осаждения, то
происходило формирование BSTO пленки с ориентацией [100]. Пленки альтернативной
ориентации [110] формируются при высоком давлении кислорода (выше, чем 20 Па),
температуре подложки более 8000C и скорости осаждения ниже 1.5 нм/мин.
Дифрактограмма пленки, представленная на рис. 1.7 (d, e), включает
рефлексы двух фаз, которые были идентифицированы как перовскитная BSTO фаза и
Al2O3 поликристаллическая фаза. На рис. 1.7.d вместе с основными пиками {k00}
наблюдаются пики BSTO (110) и (111) слабой интенсивности. Другая дифрактограмма
BSTO/поликор (Рис. 1.7.e) показывает только рефлексы перовскитной BSTO фазы
(110), а другие пики соответствуют поликристаллическому корунду.
В таблице 1 представлены значения параметра кристаллической решетки
перовскитной фазы пленок BSTO, обладающих различной кристаллографической
ориентацией. Наряду со структурными данными, в таблице приведены диэлектрические
характеристики пленок, измеренные на частотах 1 МГц и 30 ГГц.
Таблица 1.1.
|
BSTO пленка
|
Толщина, нм
|
Параметр решетки, Å
|
e (Т = 300K; U = 0 В)
|
tgd (Т=300K, U = 0 В)
|
Управляемость K ,
T = 300 K ; E»10 В/мкм)
|
|
|
|
|
1 МГц
|
30 ГГц
|
|
|
№275 [100]
|
1000
|
3.966
|
1300
|
0,007
|
0,03
|
2,2
|
|
№276 [101]
|
700
|
3.981
|
880
|
< 5·10-4
|
~ 0,01
|
1,1
|
.5 Отработка
технологии тонких пленок BSTO с
воспроизводимыми характеристиками: диэлектрической проницаемостью, тангенсом
угла диэлектрических потерь и нелинейностью
На данном этапе выполнения работы нам необходимо провести исследования
связанные с влиянием различных легирующих добавок на диэлектрические свойства
пленок BSTO. Это, с одной стороны, может позволить создать материал с новыми
уникальными диэлектрическими свойствами, а с другой дает представление о
влиянии добавки линейных диэлектрических фаз на свойства исследуемых пленок.
Оценка влияния технологических факторов на свойства формируемых пленок
проводилась на основе исследования начальных стадий роста. Пленки исследовались
методом рассеяния ионов средних энергий как с точки зрения стехометричности их
катионного состава, так и с точки зрения дефектности кислородной подрешетки.
.5.1 Влияние
легирования на диэлектрические характеристики BSTO пленок
В работе было исследовано влияние на диэлектрические характеристики
легирующих примесей. Используемые в работе порошковые мишени позволяют
оперативно менять их состав и тем самым вводить в пленку легирующую примесь.
Проводились сравнения ВЧ и СВЧ диэлектрические параметров пленок
легированных Mg и Mn со свойствами нелегированных образцов.
Примеси соответствующих оксидов добавлялись в BSTO порошок. Содержание
примеси варьировалось для Mn от 0.1 до 2.0 весовых %; и для Mg от 0.1 до 8.0
весовых %. Фазовый состав контролировался методом рентгеновского дифракционного
анализа (РДА). Метод аналитической диагностики рассеяния ионов средних энергий
(РИСЭ) использовался для характеристики структуры и состава BSTO пленок.
Аналитические данные сравнивались с результатами электрических измерений.
Результаты структурного анализа BSTO пленок, содержащих MgO и BSTO:Mg
пленок приведена на рис. 1.8. РДА показал, что пленки BSTO, выращенные на подложках поликора с ориентацией [001]
имеют хорошо ориентированную структуру и низкое содержание конкурирующих фаз. В
пленках BSTO:Mg была обнаружена фаза MgTiO4 , а в образцах BSTO:Mn была найдена
перовскитная фаза Ba0,5Sr0,5 (Mn0,33,Ti0,67)O3¸2,84 . В высоко-ориентированных и
эпитаксиальных пленках BSTO, выращенных на подложках LAO или MgO, было
невозможно идентифицировать содержание Mg, и была найдена только однородная
перовскитная фаза.
В таблице 2 приведены результаты исследования структуры, фазового состава
как для легированных, так и для чистых образцов, имеющих значение x = 0.5 -
0.6. При концентрации Mg 2.7 ат.% в BSTO пленках с толщиной более 1 мкм была
обнаружена отдельная фаза MgTi2O4 (рис. 1.8.a). При небольшом количестве
примеси Mg или толщине пленки меньше, чем 1 мкм невозможно обнаруживать фазы,
содержащие Mg.

Рис.1.8. Спектры рентгеновского дифракционного анализа для легированных BSTO пленок, выращенных на подложке
поликора (a) - Ba0,6Sr0,4TO3 пленки, легированные 2,7 ат.% Mg. Толщина пленки 3 мкм. Образец
№243_1 см. Приложение 2. Зафиксировано небольшое количество Mg2TiO4 фазы; (b) - Фазовый состав BSTO
пленки, легированной Mn 2
ат.%. Толщина 0,7 мкм Образец №241
Таблица 1.2.
|
Образец
|
235
|
237
|
239
|
240
|
244
|
|
Содержание Mg
(весовые %)
|
0
|
0,4
|
1,0
|
2,7
|
7,0
|
|
Толщина пленки, h,
мкм
|
1.0
|
0.9
|
1.0
|
3.0
|
0.9
|
|
Отношение Ba/Sr,
х
|
0.6
|
0.55
|
0.55
|
0.5
|
0.55
|
|
Постоянная решетки, a0
, A
|
3.968
|
3.956
|
3.958
|
3.946
|
-
|
|
Температура max,
Tm, K
|
250
|
-
|
210
|
270-275
|
270
|
|
e(300K, 0 В)
|
1200
|
949
|
900
|
607
|
566
|
|
tand(300K, 0 В)
|
0.011
|
0.009
|
0.007
|
0.005
|
0,00
|
|
Управляемость K
(300K, 10 В/мкм)
|
1.86
|
1.66
|
1.65
|
1.41
|
1.58
|
|
Присутствие других фаз
|
|
MgO
|
|
Mg2TiO4
|
|
Исследование температурных зависимостей диэлектрических характеристик
пленок BSTO, легированных Mg, проводилось с применением варакторов. Зависимость
температуры Tm, от концентрации Mg имела немонотонный характер. Параметр Tm
образца № 235 понижался от значения 250К до 210К соответствующего варактору № 1
на основе нелегированной пленки BSTO. Однако, увеличение концентрации Mg до 1
ат.% в BSTO пленке приводило к повышению Tm до 270К - 275К. Дальнейшее увеличение
концентрации примеси Mg существенно не изменяло значение Tm.
В таблице 3 представлены экспериментальные результаты, полученные на BSTO
пленках, легированных марганцем. Параметр решетки образца, легированного Mn немного
увеличивается по сравнению с нелегированной BSTO пленкой.
Таблица 1.3.
|
BSTO образец
|
252
|
255
|
258
|
|
Содержание Mn
(весовые %)
|
0
|
1
|
2
|
|
Толщина пленки, h,мкм
|
0.5
|
0.65
|
0.65
|
|
Отношение Ba/Sr,
х
|
0.5
|
0.5
|
0.5
|
|
Постоянная решетки a, Å
|
3.947
|
-
|
3.951
|
|
Температура максимума, Tm
, K
|
260
|
250
|
230
|
|
e (300K, 0 В)
|
1500
|
2000
|
900
|
|
tand (300K, 0 В)
|
0.010
|
0.012
|
0.003
|
|
Управляемость K
(300K, 10 В/мкм)
|
1.74
|
1.67
|
1.3
|
|
Присутствие других фаз
|
|
|
(Ba,Sr)(Mn,Ti)O3-z
|
В пленках, приготовленных из BSTO мишеней, содержащих Mn примерно 2
весовых % была зафиксирована смешанная фаза (Ba0,6Sr0,4) (Mn0,33Ti0,67) O3-z.
методом рентгеновского дифракционного анализа (рис. 1.8. b). Параметр Tm
пленок, легированных Mn снизился на 30 - 40К по сравнению с нелегированными
образцами того же состава, что показано на рис. 1.8. Наименьшее значение
диэлектрических потерь (tg
£ 0.003) наблюдалось при концентрации
MnO2 ~ 1.75 весовых %. Изменение и tg BSTO пленок в зависимости от концентрации Mn имело
немонотонный характер схожий с BSTO пленками, легированными Mg, однако, в
случае BSTO:Mn пленок управляемость уменьшалась сильнее (Таблица 1.2, Таблица
1.3).
На рис. 1.9 приведены вольт-амперные характеристики нелегированной BSTO
пленки (образец 252), пленки № 258, содержащей 2 вес. % примеси Mn и BSTO пленки
№ 2, содержащая 0.4 весовых % Mg.
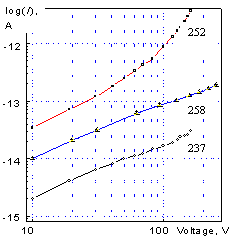
Рис. 1.9. Вольтамперные характеристики BSTO варакторов. Номера зависимостей соответствуют
пленкам, приведенным в Таблице 2 и Таблице 3.
Нелегированный образец характеризовался большими токами утечки и
нелинейным поведением зависимости I(U). Пленки BSTO, легированные Mg (пленка 2)
обладали практически линейной характеристикой I(U) и малыми токами утечки.
Оценка сопротивления этих образцов дала значение 5´1015. Каждому уровню легирования
соответствовала определенная степень структурной упорядоченности СЭП, что
обусловлено эффектом компенсации избыточного заряда. Указанный эффект в
планарных конденсаторах является также причиной немонотонной зависимости tg
(U), приведенной на рис. 1.10.
Зависимость tg(U) для BSTO пленок на сапфире приведена на рис.1.10.а.
Кривая имеет два участка с различным характером зависимости. На начальном
участке, при малых значениях напряжения, наблюдается понижение tg, но затем
наблюдается участок роста tg. Пленки BSTO/LAO показывали другую зависимость tg(U), при которой d(tg)/dU
> 0 для всего диапазона напряжений, что можно объяснить более высокой
структурной упорядоченностью образцов BSTO/LAO. Для образцов BSTO/alumina,
выращенных в том же технологическом процессе, зависимость tand (U) имела только участок, где
d(tg)/d < 0. Рис. 1.6.б) представляет вольт-амперные характеристики для
варакторов, сформированных на BSTO пленках различного типа структуры. Можно
видеть, что текстурированная пленка BSTO/поликор характеризовалась довольно
низкими токами утечки (~ 10-14 А).
Ион Mg+ 2 имеет радиус близкий к ионному
радиусу иона Ti+ 4. Увеличение содержания Mg+ 2 вызывает уменьшение постоянной
кристаллической решетки BSTO
пленки, что приводит к появлению деформации сжатия в пленке. Этот эффект влияет
на температуру максимума Tm
легированных образцов. Для BSTO
пленок, содержащих около 3 вес. % примеси Mg, наблюдается смещение Tm в область более высоких температур по сравнению с
нелегированными BSTO пленками того
же самого катионного состава. Радиус Mn+ 2 почти на 40 % больше чем радиусу иона Ti+ 4. Следовательно, увеличение постоянной кристаллической
решетки приводит к появлению деформаций растяжения BSTO пленки, что вызывает смещение Tm в область низких температур, по
сравнению с нелегированными образцами. Ион Mn+ 2, встраивается в кристаллическую решетку BSTO и формирует новую перовскитную фазу
(Ba0,6 Sr0,4) (Mn2+, Ti4+) O3-x, обнаруженную на
дифрактораммах, у которой постоянная кристаллической решетки a0 больше, чем для нелегированной фазы
BSTO с x = 0,6. Присутствие различных фаз в пленках приводит к
появлению растягивающих деформации, что подтверждается зависимостью C(T).
Ионы Mg+ 2 и Mn+ 2 действуют как заряженные акцепторы в BSTO пленке, которые компенсируют
положительный заряд кислородных вакансий в кристаллической решетке.

Рис. 1.10. Зависимости диэлектрических характеристик варактора на основе
пленки BSTO образцы №259_1, _2, _3
Присутствие вакансий кислорода влияет на проводимость пленочных структур.
Генерация и ионизация вакансий кислорода в подрешетке кислорода происходит
согласно следующему уравнению:
 .
.
Окись
магния связывает свободные электроны, образованные вакансиями кислорода, и
препятствует образованию дополнительных вакансий:
 .
.
Присутствие
кислородных вакансий оказывает существенное воздействие на проводимость СЭП. В
нелегированных BSTO пленках нелинейный характер I(U)
обусловлен как наличием локальных барьеров Шоттки на интерфейсе пленка BSTO/электрод, так и прыжковым механизмом носителей заряда в зоне
проводимости. Отсутствие нелинейных участков на I(U)
характеристикaх легированных BSTO пленок
подтверждает присутствие механизма компенсации донорских центров вакансий
кислорода благодаря введению ионов акцептора Mg+ 2 или Mn+
2.
Практически
важным результатом является то, что лучшие параметры BSTO пленок были
получены для образцов с легированием Mg+ 2 (3 мол. %) и Mn+ 2
(2 мол. %). Использованные легирующие элементы оказывают схожее влияние на
процесс дефектообразования в BSTO пленках и на их диэлектрические характеристики.
Следует отметить, что легирование примесью Mg
предпочтительно в том случае, когда необходимо уменьшение tgd, но при этом
коэффициент управляемости снижается незначительно. Легирование примесями Mn
обеспечивает большее понижение tgd , при сравнимом количестве легирующей примеси в пленках BSTO,
но и управляемость К испытывает более значительное уменьшение.
1.5.2
Диагностика BSTO пленок методом рассеяния ионов
средних энергий (MEIS)
Диагностика рассеяния ионов средних энергии (РИСЭ) использовалась для
исследования состава и структуры BSTO
пленок[6]. Метод РИСЭ является модификацией метода Резерфордовского обратного
рассеяния (РОР), в котором энергия первичных ионных пучков, воздействующих на
мишень, находится в диапазоне (1-5 MэВ). Пониженная по сравнению с РОР энергия ионного пучка в методе РИСЭ
позволяет увеличивать разрешение по глубине и уменьшить радиационную нагрузку
на образцы. Начальная энергия H+, He+ и N+ ионных пучков в применяемой диагностике составляла 190 и
234 кэВ. Схема диагностической установки РИСЭ, которая была изготовлена в ФТИ
им. Иоффе до начала выполнения проекта приведена на рис.1.11. Угол рассеяния
полупроводникового детектора ППД-1 и электростатического анализатора ЭСА
составлял 120o.
Определение толщины и состава пленочных образцов проводилось на основе
сравнения РИСЭ моделируемых спектров с экспериментальными энергетическими
спектрами рассеянных ионов. Толщина пленки определялась величиной Q = nh [атом (молекула) /см2], где n - атомная или молекулярная концентрация, и h - физическая глубина (толщина
пленки). Режим каналирования ионов в ориентированных образцах использовался для
структурного анализа высокоориентированных пленок. Кристаллическое качество характеризовалось
параметром минимального (толщина пленки). Режим каналирования ионов в
ориентированных образцах использовался для анализа структуры ориентированных
пленок. Параметр минимального относительного выхода ионов характеризовал
кристаллическое качество. Определение cS проводилось как отношение интенсивности потока рассеянных ионов в режиме
каналирования к аналогичной интенсивности потока ионов в режиме случайной
ориентации направления первичного потока ионов и оси одного из малоиндескных
кристаллографических направлений в ориентированном образце мишени, cS = Ya/Yr .

Рис. 1.11. Блок-схема экспериментальной установки диагностики РИСЭ.
Одним из преимуществ РИСЭ является возможность использования
высокоразрешающих, чувствительных электростатических анализаторов (ЭСА).
Благодаря применению ЭСА диагностика РИСЭ способна обнаруживать положение и
толщину переходных слоев, определить размер границ раздела; оценивать
структурное качество отдельных слоев в многослойных структурах, устанавливать
положение атомов примеси в решетке. Дополнительную возможность в определении
состава и особенностей структуры соединений на основе РИСЭ предоставляет анализ
рентгеновского излучения, возбуждаемого ионами (РИВИ или PIXE). Точность определения состава,
чувствительность и надежность диагностики определяется возможностями
рентгеновских детекторов рассеянного излучения мишени.
Результаты сравнительного исследования начальных стадий роста BSTO пленок на различных подложках,
полученные с использованием РИСЭ диагностики приведены в таблице 4, где указаны
толщина пленок, относительный выход различных ионов (H+; Не+; N+) и
процент покрытия поверхности. Для тонких пленок нанометровой толщины вкладом
ионной дезориентации Га можно пренебречь. Значение cS пропорционально концентрации
дефектов пленки. Для текстурированных пленок величина Га уменьшается с
увеличением массы иона. Лучшее структурное качество сверхтонких пленок BSTO было получено на подложках STO(100).
Таблица 1.4.
|
No
|
Подложка
|
Толщина пленки, нм
|
Покрытие подложки, %
|
S (H+)
|
S (He+)
|
S (N+)
|
|
289
|
SrTiO3
|
40
|
100
|
0.12
|
-
|
0.13
|
|
294
|
LaAlO3
|
12
|
100
|
0.55
|
0.35
|
0.22
|
|
295
|
LaAlO3
|
27
|
100
|
0.65
|
0.42
|
0.20
|
|
297
|
MgO
|
15
|
70
|
-
|
0.85
|
0.75
|
|
298
|
MgO
|
29
|
100
|
0.25
|
-
|
0.15
|
|
299
|
MgO
|
200
|
100
|
0,03
|
0,03
|
-
|
|
302
|
-Al2O3
|
11
|
100
|
-
|
0.95
|
0.9
|
|
303
|
-Al2O3
|
27
|
100
|
-
|
0.9
|
0.7
|
Относительный выход составлял cS » 0,12 для пленки BSTO/STO толщиной 40 nm как при воздействии ионов H+, так и ионов He+,
что указывает на эпитаксиальный характер формирования пленки и отсутствие
текстурирования. Гладкая поверхность и малый рельеф (приблизительно 0,85 nm) указывают на послойный механизм BSTO роста пленки на подложке STO . Спектры РИСЭ пленки 289
представлены на рисунке 1.12.

Рис. 1.12. Спектры РИСЭ пленки BSTO, выращенной на подложке титаната стронция (пленка 289, параметры которой
приведены в таблице 4.
.5.3
Определение содержания кислорода в BSTO пленках с помощью метода рентгеновского излучения, возбуждаемого ионами
(РИВИ)
Для определения содержания кислорода применялись два различных подхода,
основанных на использовании различных детекторов:
(A) полупроводниковый детектор,
изготовленный из кремниевой пластины предельно высокой чистоты;
(B) детектор на основе многослойного W/Si цилиндрического
зеркала.
В процессе диагностики РИВИ посредством полупроводникового детектора типа
(A) обычно применяется внешнее
расположение детектора, за пределами аналитической камеры, что предполагает
использование бериллиевого окна толщиной более 30 мкм, сильно поглощающего
рентгеновские кванты с энергией ниже 1 кэВ.
Основная особенность методики, разработанной в рамках данного проекта,
состояла в том, что криогенно охлаждаемый кремниевый детектор располагался вместе
с образцом для исследования в той же самой вакуумной камере.
Пленка бериллия толщиной 2 мкм защищала Si детектор от обратно рассеянных протонов и одновременно
пропускала 23.5 % излучения Ka линии кислорода (525 эВ). Эффективность регистрации кислорода кремниевым
датчиком оценивалась на уровне 15 % с учетом поглощения квантов в золотом
электроде, расположенном на поверхности Si детектора. Эффективность данной схемы регистрации была
подтверждена хорошим соответствием (в пределах 5 %) экспериментальных результатов
и моделируемых РИВИ спектров, полученных на SrTiO3 монокристаллах.
При проведении анализа РИВИ учитывалось, что используемые подложки, MgO, LAO, STO,
сапфир являются хорошими изоляторами. Применение минимального тока ионных
пучков (~ 1 nA) и защитных диафрагм,
предотвращающих заряд поверхности мишени, не приводило к полному устранению
заряда, аккумулируемого образцом, и поверхностный заряд создавал на поверхности
образцов потенциал до 5-10 кВ. Вследствие заряда поверхности появлялся
значительный фон тормозного излучения, вызванного электронной радиацией. Для
исключения влияния тормозного излучения был разработан метод регистрации РИВИ
спектров, возбужденных пучком нейтральных атомов H0. Пучок H0 был
получен в результате перезарядки ионов H+ в газе N2.
Для создания атома H0
использовалась реакция H+ + N2 ® H0, которая
происходила в специальной камере нейтрализации. Энергия нейтрального пучка
атомов H0 отличалась от энергии начального
ионного пучка H+ (230 кэВ) не более чем на 15 эВ.
Контроль стехиометрии по кислороду проводился по катионному соотношению
компонентов (Ti, Sr, Ba), полученных из
РИСЭ спектров. При известном x в
формуле BaxSr1-xTiOy значение y могло быть определено из отношения амплитуд пиков O (K) и Sr (L). Результаты расчетов приведены на
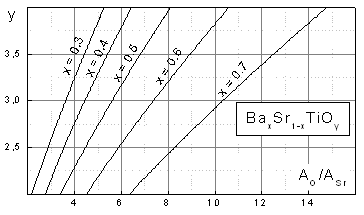
Рис. 1.13. Расчетные данные для определения содержания кислорода в
пленках BaxSr1-xTiOy
Второй метод регистрации Ka линии кислорода был основан на использовании цилиндрического
многослойного рентгеновского зеркала (РЗ) W/Si, обладавшего
периодом 4,19 нм. Конструкция спектрометра была выполнена по схеме Иоганна,
радиус перемещения РЗ составлял 175 мм (половина радиуса кривизны поверхности
зеркала). Для регистрации квантов применялась система электронный эмиттер - вторичный
электронный умножитель. Электроны ускорялись, проходя разность потенциалов
между электронным эмиттером и входом электронного умножителя. Для увеличения
коэффициента фотоэлектронной эмиссии поверхность эмиттера была покрыта слоем CuJ. Вход регистрирующего устройства был
защищен органической пленкой толщиной 1 мм, поверх которой наносилась пленка Al толщиной 0.1 мм. Этот фильтр
использовался с целью поглощения квантов с энергией менее 100 эВ. Эффективность
регистрации Ka линии кислорода регистрирующим
устройством, полученная в испытаниях на экспериментальной установке РИСЭ, была
оценена в 10 %.
Измерение разрешения детектора по энергии было проведено для квантов,
падающих на зеркало в диапазоне углов от 120 до 200, что соответствовало
энергии от 750 эВ до 450 эВ, соответственно. Ширина максимума была равна 2.050,
что более чем в 3 раза превосходило требуемое значение 0.70. Эксперименты с
рентгеновским зеркалом показали, что причиной недостаточного разрешения
является слишком широкая апертура зеркала (выбранная для достижения
максимальной светосилы) и, возможно, отклонение формы поверхности зеркала от
цилиндрической с радиусом 350 мм.
Эксперименты показали пригодность разработанной диагностической установки
на основе многослойного детектора рентгеновского излучения для проведения
комплексного анализа состава и структурных особенностей оксидных пленок.
Разработанная методика моделирования спектров энергии рассеянных ионов и
характеристического рентгеновского излучения вполне адекватно описывала
экспериментальные результаты. Для улучшения разрешающей способности
рентгеновской диагностики, применяющей цилиндрическое РЗ, необходимо провести
усовершенствование его конструкции. Таким образом, сравнение двух методов
регистрации рентгеновской Ka линии кислорода в пленках BSTO
показало, что в настоящий момент диагностика, применяющая охлаждаемый
кремниевый детектор, является более эффективной.
.5.4
Определение степени легирования пленок BSTO
Содержание легирующих компонентов в пленках BSTO определялось по спектрам РИВИ. Было исследовано
влияние уровня легирования Mg на
свойства BSTO пленок. Чувствительность методики
РИВИ к определению Mg+2 в BSTO пленках иллюстрируется спектрами на
рис.1.14, соответствующие трем образцам 235, 237, 240 с различным содержанием
примеси 0%, 0.4% и 2.7%.
Из приведенных на рис. 1.14. зависимостей следует, что содержание Mg до 0.4 мол.% надежно регистрируется BSTO пленках посредством РИВИ метода.
Рис. 1.15 показывает РИВИ спектры Ba0.5Sr1-0.5TiO3 пленки, измеренные в режиме каналирования и случайной
ориентации ионного пучка, при облучении ионами H+ с энергией E0 =
230 кэВ. Пленка BSTO, легированная
Mg, была выращена на подложке SrTiO3. Толщина пленки составляла около
7.3 нм, а параметр cS =
0.07, что соответствовало высокому структурному качеству BSTO пленки. С учетом зависимости выхода Ka излучения Mg от глубины, было определено содержание Mg в пленке, составившее 12 %.
Сравнение РИВИ спектров при различной ориентации ионного пучка в области
линии Mg (1250 эВ) на рис. 1.15 показало, что
отношение интенсивности сигналов близко к 1.0. Это означает, что атомы примеси Mg с данной концентрацией полностью не
встраиваются в решетку BSTO.
Диагностика РИВИ применялась также для анализа BSTO пленок, легированных марганцем, однако в данном
случае возникали трудности с тем, чтобы отделить сигнал линии марганца (LMn ) от сигнала K линии кислорода, поэтому достоверных
результатов для таких пленок получить не удавалось.
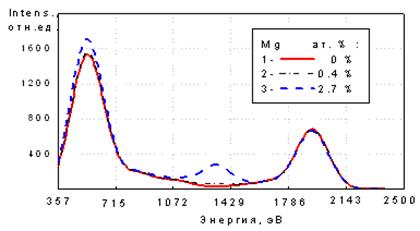
Рис. 1.14. Спектры РИВИ пленок BSTO, легированных примесью Mg
различной концентрации

Рис. 1.15. PIXE - спектры
пленки Ba0,5Sr0,5TiO3
289, выращенной на подложке SrTiO3
(100). . Облучениие проводилось атомами H с энергией 230 кэВ.
Результаты
Практически важным результатом является то, что лучшие параметры BSTO пленок были получены для образцов с
легированием Mg+ 2 (3 мол. %) и Mn+ 2 (2 мол. %). Использованные
легирующие элементы оказывают схожее влияние на процесс дефектообразования в BSTO пленках и на их диэлектрические
характеристики. Следует отметить, что легирование примесью Mg предпочтительно в том случае, когда
необходимо уменьшение tgd,
но при этом коэффициент управляемости снижается незначительно. Легирование
примесями Mn обеспечивает большее понижение tgd , при сравнимом количестве
легирующей примеси в пленках BSTO,
но и управляемость К испытывает более значительное уменьшение. Однако для
легированных образцов было обнаружено значительное снижение воспроизводимости
технологического процесса. Это может быть объяснено появлением дополнительного
фактора технологического процесса, требующего прецизионной регулировки.
В процессе изготовления пленок (состав порошковой мишени BaxSr1-xTiO3 x =
0.03 ¸ 0.65) были использованы следующие
технологические режимы: давление кислорода во время процесса распыления 5-80
Па; расстояние между пленкой и подложкой 15-50 мм; мощность ВЧ разряда 6 -10 Вт
/ см2; температура подложки 650 - 850 0С; скорость роста пленки составляла 1,5
- 2 нм / мин.
Обнаружено, что если температура подложки составляла менее 7000C,
давление кислорода не более 20 Па и обеспечивалась достаточно высокая скорость
осаждения, то происходило формирование BSTO пленки с ориентацией [100]. Пленки
альтернативной ориентации [110] формируются при высоком давлении кислорода (выше,
чем 20 Па), температуре подложки более 8000C и скорости осаждения ниже 1.5
нм/мин.
В работе было исследовано влияние перегрева подложек высокоэнергетичными
частицами плазмы. Максимально данный эффект проявлялся при давлениях рабочего
газа 15Па. Разогрев составлял 100 градусов сверх температуры подложкодержателя.
В дальнейшем это учитывалось при проведении технологических процессов.
Исследование начальных стадий роста пленок BSTO показало, что
эпитаксиальный рост может быть реализован только на подложках LAO и MgO. При
температуре подложки больше, чем 700 0С и достаточно высоком давлении кислорода
(более 20 Па) были получены высоко-ориентированные пленки на подложках обоих
типов.
2. Отработка
методик измерения диэлектрической проницаемости, управляемости, тангенса угла
диэлектрических потерь сегнетоэлектрической пленки, напыленной на
диэлектрическую подложку
Поставленная в работе задача является комплексной.
Поэтому, вопросы отработки технологии получения сегнетоэлектрических пленок с
требуемыми физическими параметрами должны быть тесно связаны с методиками
расчета слоистых структур и способов их измерения. В конечном итоге
правильность постановки эксперимента и адекватные математические модели
описывающие реальные физические структуры, позволят с высокой точностью дать
ответ о диэлектрической проницаемости сегнетоэлектрической пленки и ее
добротности по полученным результатам измерений, и соответствующим образом
внести корректировки в технологический процесс получения пленок.
2.1 Отработка
методик измерения диэлектрической проницаемости, управляемости, тангенса угла
диэлектрических потерь сегнетоэлектрической пленки
Определить диэлектрическую проницаемость
сегнетоэлектрической пленки можно различными инструментальными способами.
Одним из них является метод, позволяющий по измерению
значения погонной емкости плоскопараллельного конденсатора, образованного
системой металлических электродов напыленных на структуру “диэлектрическая
подложка - сегнетоэлектрическая пленка” используя метод конформных отображений
определить с достаточно высокой точностью значение диэлектрической
проницаемости сегнетоэлектрической пленки.
Так же определить параметры сегнетоэлектрической
пленки, возможно используя результаты измерения значений резонансной частоты и
добротности в полуволновом объемном резонаторе или в щелевом полуволновом
резонаторе. Данный метод определения диэлектрической проницаемости
сегнетоэлектрической пленки в отличие от метода измерения емкости, позволяет
определять их свойства в широком частотном диапазоне, вплоть до 100 ГГц.
2.1.1 Расчет
погонной емкости в плоскопараллельном конденсаторе, образованном на поверхности
диэлектрической структуры
При
использовании сегнетоэлектрических пленок в устройствах СВЧ плоскопараллельные
системы проводников в виде тонких металлических пленок, наносятся на
поверхность сегнетоэлектрического слоя. Металлические электроды образуют вместе
с диэлектрической структурой "диэлектрическая подложка -
сегнетоэлектрическая пленка" плоскую замедляющую структуру, фазовая скорость
волны в которой изменяется за счет изменения диэлектрической проницаемости
пленки. Анализ электродинамических характеристик таких структур выполняется
независимо от расчета емкости, которую образуют проводники. Расчет
электрической емкости проводников структуры позволяет, с одной стороны, оценить
требуемые энергетические затраты источника, создающее управляющее напряжение,
а, с другой стороны, оценить значение диэлектрической проницаемости
сегнетоэлектрической пленки по результатам измерения емкости проводников на
низких частотах. Топологические особенности рассматриваемых замедленных
структур заключаются в двух обстоятельствах: толщина сегнетоэлектрических
пленок не превышает 1 мкм, а ширина проводников и расстояние между ними, по
крайней мере, на порядок больше толщины пленки. Поэтому эффект проникновения
низкочастотного поля в подложку должен быть оценен количественно. Таким
образом, на практике расчет электрической емкости проводников замедленной
структуры должен быть выполнен в условиях неоднородной диэлектрической среды,
что представляется достаточно сложной задачей. Однако, аномально большая
диэлектрическая проницаемость (>103) сегнетоэлектрической пленки по
сравнению с  подложки (
подложки ( ) позволяет
прогнозировать относительно слабое влияние подложки на значение емкости и, с
другой стороны, предложить относительно простые приемы количественной оценки
этого эффекта.
) позволяет
прогнозировать относительно слабое влияние подложки на значение емкости и, с
другой стороны, предложить относительно простые приемы количественной оценки
этого эффекта.
Расчет
емкостей плоскопараллельных проводников удобно выполнить методом конформных
отображений.
Формула
для расчета емкости конденсатора без учета эффекта проникновения поля в
подложку
 ,
,  .
.
Сравнение
этих формул дает количественную оценку ошибки в интерпретации значения
диэлектрической проницаемости пленки:
 ,
,
где
ε
- значение диэлектрической проницаемости
пленки, без учета проникновения поля в подложку.
Таким
образом при  ошибка будет находиться в пределах (45...50) %.
ошибка будет находиться в пределах (45...50) %.
.2
Определение параметров сегнетоэлектрических пленок по измерениям в объемном
резонаторе
Структура “диэлектрическая подложка - сегнетоэлектрическая пленка” может
быть использована в качестве диэлектрического заполнения объемного резонатора.
Резонансная частота резонатора зависит от диэлектрической проницаемости
сегнетоэлектрической пленки и эта зависимость, может быть математически точно
найдена для конкретного типа резонатора. Собственная добротность объемного
резонатора с сегнетоэлектрической пленкой определяется в основном tgd пленки. Поэтому по экспериментальным
значениям резонансной частоты f0 и собственной добротности Q0 резонатора можно
рассчитать e и tgd сегнетоэлектрической пленки. Эти же
параметры можно определить, используя измерения и расчет в полуволновом
щелевом, многощелевом резонаторе, образованном структурой “сегнетоэлектрическая
пленка - диэлектрическая подложка” с нанесенными на ее поверхность
металлическими электродами.
Известно, что добротность объёмного резонатора, рассчитывается из
соотношения:
 . (2.1)
. (2.1)
Реальный
резонатор находится в режиме вынужденных колебаний, и он связан с возбуждающей
линией и нагрузкой, но обычно его рассматривают как систему изолированную,
обладающую максимальной энергией в момент резонанса. В этом случае максимальная
запасённая энергия на частоте резонанса равна энергии электрического или
магнитного поля:
 . (2.2)
. (2.2)
Однако,
соотношение для реального резонатора приблизительно, так как фазовый сдвиг
между векторами  и
и  отличается
от
отличается
от  , в связи с влиянием элементов связи, обеспечивающих
реальный вынужденный режим резонатора. Поэтому соотношение для
, в связи с влиянием элементов связи, обеспечивающих
реальный вынужденный режим резонатора. Поэтому соотношение для  на самом деле относится к случаю идеального
резонатора, в котором колебания происходят на собственных частотах.
на самом деле относится к случаю идеального
резонатора, в котором колебания происходят на собственных частотах.
Средняя
мощность потерь складывается из двух видов: собственных потерь, вызванных
потерями в металле резонатора  и
диэлектрических потерь
и
диэлектрических потерь  , а также потерь на излучение
, а также потерь на излучение  через элементы связи. Таким образом, средняя мощность
потерь в резонаторе равна:
через элементы связи. Таким образом, средняя мощность
потерь в резонаторе равна:
 . (2.3)
. (2.3)
Следовательно,
из (2.1-2.4) следует, что добротность резонатора может быть представлена в
виде:
 . (2.4)
. (2.4)
где
 ,
,  ,
,  .
.
При
этом можно ввести понятие собственной добротности резонатора:
 . (2.5)
. (2.5)
Очевидно,
что потери всех видов находятся во взаимосвязи через возмущения полей
резонатора, вызванные соответствующими источниками потерь. Обычно потери малы и
поэтому  вычисляют исходя из распределения поля в отсутствие
потерь, а
вычисляют исходя из распределения поля в отсутствие
потерь, а  и
и  находят
независимо друг от друга. Таким образом, расчёт добротности можно выполнить при
известном решении задачи о собственных колебаниях объёмного резонатора.
находят
независимо друг от друга. Таким образом, расчёт добротности можно выполнить при
известном решении задачи о собственных колебаниях объёмного резонатора.
Рассмотрим
сначала собственную добротность резонатора только за счёт потерь в металле.
Модель резонатора для расчёта  представим
в следующем виде: полуволновой резонатор с произвольной формой поперечного
сечения находится в режиме собственных колебаний. Иначе говоря, резонатор образован
двумя идеальными короткозамыкающими плоскостями, образующими короткозамкнутый с
обеих сторон полуволновой отрезок линии передачи. В таком резонаторе существует
колебательный процесс, который можно трактовать как периодическое отражение
потока мощности от идеальных закорачивающих плоскостей.
представим
в следующем виде: полуволновой резонатор с произвольной формой поперечного
сечения находится в режиме собственных колебаний. Иначе говоря, резонатор образован
двумя идеальными короткозамыкающими плоскостями, образующими короткозамкнутый с
обеих сторон полуволновой отрезок линии передачи. В таком резонаторе существует
колебательный процесс, который можно трактовать как периодическое отражение
потока мощности от идеальных закорачивающих плоскостей.
Обозначим
через  - мощность распространяющуюся по длине резонатора.
Последовательные отражения от идеальных отражающих плоскостей приводят к
колебательному режиму, который затухает во времени за счёт конечной собственной
добротности резонатора. Время «пробега» по длине резонатора определяется
очевидным соотношением
- мощность распространяющуюся по длине резонатора.
Последовательные отражения от идеальных отражающих плоскостей приводят к
колебательному режиму, который затухает во времени за счёт конечной собственной
добротности резонатора. Время «пробега» по длине резонатора определяется
очевидным соотношением
 ,
,
где
 - полуволновая длина резонатора,
- полуволновая длина резонатора,  - групповая скорость распространения энергии в
резонаторе. Поэтому запасённую энергию можно определить как
- групповая скорость распространения энергии в
резонаторе. Поэтому запасённую энергию можно определить как  . Коэффициент «два» определяет, что в резонаторе
существует два равноправных потока энергии распространяющихся навстречу друг
другу от одной отражающей стенки к другой. Используя соотношение для
. Коэффициент «два» определяет, что в резонаторе
существует два равноправных потока энергии распространяющихся навстречу друг
другу от одной отражающей стенки к другой. Используя соотношение для
 ,
,
запишем
запасённую энергию на резонансной частоте  в виде:
в виде:
 . (2.6)
. (2.6)
Потери
в металле резонатора определяются коэффициентом затухания в линии  по соответствующему типу волны. Таким образом,
мощность потерь, возникающая в резонаторе за один период колебания равна:
по соответствующему типу волны. Таким образом,
мощность потерь, возникающая в резонаторе за один период колебания равна:
 . (2.7)
. (2.7)
Подставив
в соотношение (2.1) соотношения (2.6) и (2.7), найдем собственную добротность
(2.8), вызванную конечной проводимостью в стенках металлического объемного
резонатора:
 . (2.8)
. (2.8)
Очевидно,
что в этом соотношении следует сделать замену  и
тогда:
и
тогда:
 . (2.9)
. (2.9)
Аналогичное
соотношение можно получить исходя из иного подхода к расчёту собственной
проводимости резонатора.
Рассмотрим
резонансный отрезок линии передачи, закороченный с обеих сторон (рис. 2.1).
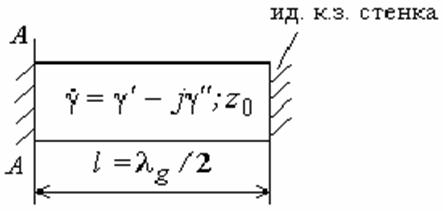
Рис.
2.1.
Мнимую
часть постоянной распространения  будем
считать обусловленной потерями в металле. Входное сопротивление линии в
плоскости короткого замыкания АА:
будем
считать обусловленной потерями в металле. Входное сопротивление линии в
плоскости короткого замыкания АА:  , где
, где  - волновое сопротивление линии. В этом соотношении
- волновое сопротивление линии. В этом соотношении  , следовательно,
, следовательно,  можно
записать, заменив
можно
записать, заменив  на
на  в виде:
в виде:
 (2.10)
(2.10)
Вблизи
резонанса возможно упрощение, так как  и
и  , значит
, значит  и в
знаменателе следует пренебречь квадратом малой величины, что преобразует (2.10)
к виду:
и в
знаменателе следует пренебречь квадратом малой величины, что преобразует (2.10)
к виду:
 . (2.11)
. (2.11)
Введём
малую частотную расстройку  и это
приведет к увеличению резонансной длины резонатора на
и это
приведет к увеличению резонансной длины резонатора на  , то есть на частоте
, то есть на частоте  длина
длина  .
.
Тогда
 . А так как
. А так как  ,
следовательно,
,
следовательно,  . С другой стороны
. С другой стороны  . Поэтому
окончательно
. Поэтому
окончательно  в соотношении (2.11) можно представить в виде:
в соотношении (2.11) можно представить в виде:
 . (2.12)
. (2.12)
Последовательный
колебательный контур при расстройке  имеет
входное сопротивление
имеет
входное сопротивление  . Значит, входное сопротивление резонатора в плоскости
АА (2.12) и входное сопротивление последовательного колебательного контура
имеют одинаковый вид. Следовательно, объёмный резонатор, образованный
полуволновым отрезком линии передачи, закороченной с обеих сторон, можно
представить в виде последовательного колебательного контура с эквивалентными
параметрами: сопротивлением потерь
. Значит, входное сопротивление резонатора в плоскости
АА (2.12) и входное сопротивление последовательного колебательного контура
имеют одинаковый вид. Следовательно, объёмный резонатор, образованный
полуволновым отрезком линии передачи, закороченной с обеих сторон, можно
представить в виде последовательного колебательного контура с эквивалентными
параметрами: сопротивлением потерь  и
эквивалентной индуктивностью
и
эквивалентной индуктивностью  . Тогда
собственная добротность резонатора, определённая из его эквивалентных
параметров, будет равна:
. Тогда
собственная добротность резонатора, определённая из его эквивалентных
параметров, будет равна:
 . (2.13)
. (2.13)
Очевидно,
при  соотношение (2.13) переходит в формулу (2.9).
соотношение (2.13) переходит в формулу (2.9).
Рассмотрим
составляющую собственной добротности резонатора, вызванную диэлектрическими
потерями. В этом случае, если диэлектрик включен частично в объём резонатора,
то есть диэлектрическое заполнение резонатора неоднородно, то в соответствие с
общим определением собственной добротности  можно
представить в виде:
можно
представить в виде:
 ,
,
где
в числителе формулы  является функцией координат,
является функцией координат,  - объём, занимаемый диэлектриком с потерями,
определяемыми значением
- объём, занимаемый диэлектриком с потерями,
определяемыми значением  .
.
С
другой стороны, потери, возникающие в объёме резонатора, приводят к комплексной
резонансной частоте  . Постоянная затухания контура
. Постоянная затухания контура  , где
, где  - период
собственных резонансных колебаний, а собственная добротность равна
- период
собственных резонансных колебаний, а собственная добротность равна  . Полагая
. Полагая  ,
получим, что
,
получим, что  . Оценивая собственную добротность только за счёт
. Оценивая собственную добротность только за счёт  диэлектрика, частично включённого в резонатор, можно
записать
диэлектрика, частично включённого в резонатор, можно
записать  . Таким образом,
. Таким образом,  ,
получаем (2.14):
,
получаем (2.14):
 . (2.14)
. (2.14)
К
аналогичному результату можно придти, подставив соотношение  определяющее потери в линии за счёт
определяющее потери в линии за счёт  , в формулу для собственной добротности (2.9):
, в формулу для собственной добротности (2.9):
 . (2.15)
. (2.15)
Можно
записать (2.15), имея в виду правило дифференцирования сложной функции 
 , что приведет в свою очередь к виду (2.14).
, что приведет в свою очередь к виду (2.14).
Используя
переход к эквивалентным  и
и  параметрам,
объёмного резонатора можно, на основании формулы (2.12) получить, что эквивалентное
емкостное сопротивление объёмного резонатора представлено в виде эквивалентного
последовательного колебательного контура и равно
параметрам,
объёмного резонатора можно, на основании формулы (2.12) получить, что эквивалентное
емкостное сопротивление объёмного резонатора представлено в виде эквивалентного
последовательного колебательного контура и равно  .
Сопротивление потерь по-прежнему определяется формулой
.
Сопротивление потерь по-прежнему определяется формулой  . Подставляя сюда
. Подставляя сюда  получим
получим  . Из эквивалентных параметров собственная добротность
контура, определяемая только потерями в диэлектрике конденсатора, как известно
равна
. Из эквивалентных параметров собственная добротность
контура, определяемая только потерями в диэлектрике конденсатора, как известно
равна  . Подставляя в эту формулу требуемые величины, учтя,
что
. Подставляя в эту формулу требуемые величины, учтя,
что  , сразу получим соотношение (2.15).
, сразу получим соотношение (2.15).
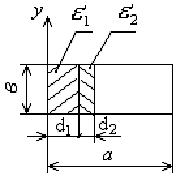
Рис. 2.2. Поперечное сечение волновода с диэлектрическим заполнением
Добротность
резонатора, вызванная затуханием в его стенках за счет конечной проводимости  равна:
равна:
 , (2.16)
, (2.16)
где
V - объем резонатора, S - поверхность стенок резонатора,  - поверхностное сопротивление;
- поверхностное сопротивление;  - глубина скин-слоя в металле стенок резонатора.
- глубина скин-слоя в металле стенок резонатора.
Для
LE10 найдем распределение Еy, Hх, Нz на поперечном сечении решив уравнение
(2.17)
 , (2.17)
, (2.17)
с
учетом граничных условий на металле и диэлектрических границах. В области 0 £ х £ d1  ; на поперечном сечении пленки d1£х£d12
; на поперечном сечении пленки d1£х£d12  ; в свободной от диэлектрика области поперечного
сечения d12£ х £ а
; в свободной от диэлектрика области поперечного
сечения d12£ х £ а  . Из уравнений Максвелла найдем составляющие
магнитного поля:
. Из уравнений Максвелла найдем составляющие
магнитного поля:
 ;
;  ,
,
 , (2.18)
, (2.18)

 ,
,
 .
.
Непрерывность
Еy и Hz на диэлектрических границах дает возможность выразить произвольные
постоянные C, D и F положив А=1, найдем, что
 ,
,
 , (2.19)
, (2.19)
 .
.
Поле
резонатора отличается от поля волновода зависимостью от координаты z. В
соответствующих областях поле резонатора определяется следующими соотношениями:
 , (2.20)
, (2.20)
где
i = 1, 2, 3;  - функции, определяющие зависимость от координаты х в
соответствующих областях поперечного сечения;
- функции, определяющие зависимость от координаты х в
соответствующих областях поперечного сечения;
 ,
,  , (2.21)
, (2.21)
где
 и
и  -
функции от х в соответствующих областях.
-
функции от х в соответствующих областях.
Используя
соотношение (2.18-2.21) подставим их в (2.16) и после интегрирования и
преобразований, найдем:
 (2.22)
(2.22)
где
 , J2
, J2 ,
,
 ;
;  ,
, ;
; 
С,
D, и F -определены соотношением (2.19),- длина резонатора (для полуволнового
резонатора  ),
),
 -
постоянная распространения для волны LE10, определяемая решением дисперсионного
уравнения, которое для структуры представленной на рис. 2.2., выводится посредством
метода поперечного резонанса, в результате получаем:
-
постоянная распространения для волны LE10, определяемая решением дисперсионного
уравнения, которое для структуры представленной на рис. 2.2., выводится посредством
метода поперечного резонанса, в результате получаем:
 ,
,
где
 ,
,  ,
,  ,=w2e0m0, d12 = d1 +d. В случае волны LE10 - n=0,
для остальных LEn0 - n≠0.
,=w2e0m0, d12 = d1 +d. В случае волны LE10 - n=0,
для остальных LEn0 - n≠0.
Аналогичное
дисперсионное уравнение можно получить для LM волн,
распространяющихся в структуре с расположением диэлектрической подложки с
сегнетоэлектрической пленкой вдоль широкой стенки волноводного резонатора (рис.
2.3).

Рис. 2.3. Поперечное сечение полуволнового волноводного резонатора с
подложкой вдоль широкой стенки.
Используя метод поперечного резонанса, получаем:
 , (2.23)
, (2.23)
где
 ,
,  ,
,
 ,
,  , d’=d1+d2.
, d’=d1+d2.
В
случае волны LМ11 - n=0, для остальных LМ1n+1 -
n≠0.
Решение
дисперсионного уравнения (2.22), позволяет определить зависимость постоянной
распространения от величины диэлектрического заполнения резонатора. Полученная
зависимость показывает рис. 2.4., что в диапазоне значений  , поле наиболее возмущено при d1=0.95(мм). Это
означает, сегнетоэлектрическая пленка максимально включена, и определение ее
диэлектрической проницаемости будет наиболее точным.
, поле наиболее возмущено при d1=0.95(мм). Это
означает, сегнетоэлектрическая пленка максимально включена, и определение ее
диэлектрической проницаемости будет наиболее точным.
На
рис. 2.5. построена зависимость резонансной частоты полуволнового резонатора (l
=  @ 3,6 мм) в зависимости от e2 d2. Там же приведена кривая соответствующая пологому участку
зависимости g(d1) рис. 2.4. Крутизна зависимости f0(e2) остается приблизительно постоянной в диапазоне предполагаемых
значений e2. Так при f0 = 30 ГГц: e2 = 1000
крутизна
@ 3,6 мм) в зависимости от e2 d2. Там же приведена кривая соответствующая пологому участку
зависимости g(d1) рис. 2.4. Крутизна зависимости f0(e2) остается приблизительно постоянной в диапазоне предполагаемых
значений e2. Так при f0 = 30 ГГц: e2 = 1000
крутизна  равна 2,15×106 Гц, а при e2 = 2000 крутизна
равна 2,15×106 Гц, а при e2 = 2000 крутизна  равна 2,015×106 Гц, для f0
= 28 ГГц и e2 =1000, ее значение 1,989×106 Гц, а для e2 = 2000
равна 2,015×106 Гц, для f0
= 28 ГГц и e2 =1000, ее значение 1,989×106 Гц, а для e2 = 2000  равна 1.877×106 Гц.
равна 1.877×106 Гц.
Таким образом, можно сделать оценку точности определения диэлектрической
проницаемости сегнетоэлектрической пленки при заданной точности измерения
резонансной частоты исходя из соотношения:
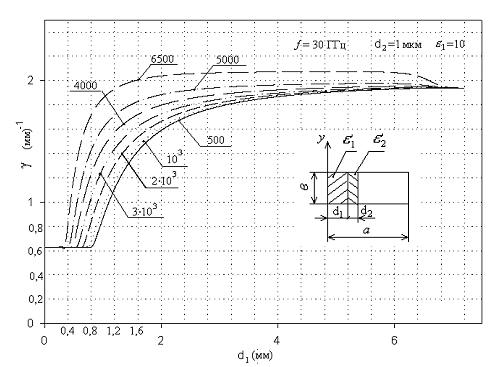
Рис. 2.4. Зависимость постоянной распространения от толщины
диэлектрической подложки с сегнетоэлектрической пленкой в полуволновом объемном
резонаторе.
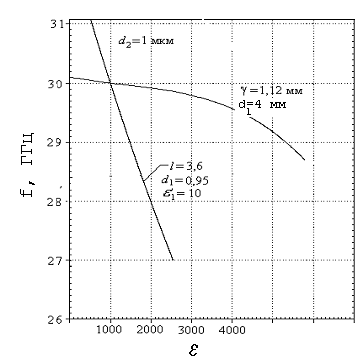
Рис. 2.5. Зависимость резонансной частоты от (e2d2) резонатора (7,2´3,4´3,6)мм.
 . (2.24)
. (2.24)
Из
(2.24) следует, что при f0 = 30 ГГц и  5×10-3
5×10-3  0,069;
при f0 =28 ГГц
0,069;
при f0 =28 ГГц  0,037 и, следовательно, среднюю точность определения (e2d2) в данном диапазоне значений можно оценить в ±5%.
0,037 и, следовательно, среднюю точность определения (e2d2) в данном диапазоне значений можно оценить в ±5%.
На
рис. 2.6. показана зависимость постоянной распространения в полуволновом
резонаторе от величины диэлектрического заполнения при различных значениях e2 d2, с горизонтальным расположении подложки с пленкой. Из рис. 2.7.
видно, что зависимость резонансной частоты от диэлектрической проницаемости
сегнетоэлектрической пленки при различных значениях толщины подложки, имеет
крутизну  @1.4×106 Гц для e2 = 2000 и это
характеризует слабое (по сравнению с вертикальным) включение пленки в
резонаторе. Расчеты показывают, погрешность измерения диэлектрической
проницаемости сегнетоэлектрической пленки в диапазоне частот 28-30 ГГц при ее
ожидаемых значениях 1000-2000, составляет ±6%.
@1.4×106 Гц для e2 = 2000 и это
характеризует слабое (по сравнению с вертикальным) включение пленки в
резонаторе. Расчеты показывают, погрешность измерения диэлектрической
проницаемости сегнетоэлектрической пленки в диапазоне частот 28-30 ГГц при ее
ожидаемых значениях 1000-2000, составляет ±6%.
Определим
точность измерения tgd пленки. Запишем соотношение (2.14.) в виде:
d= , (2.25)
, (2.25)
где
 - коэффициент включения пленки в резонатор.
- коэффициент включения пленки в резонатор.
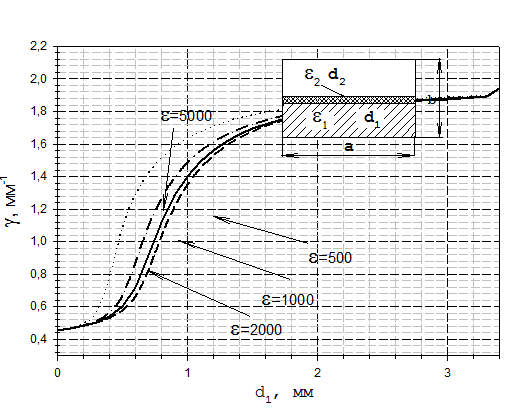
Рис.
2.6. Зависимость постоянной распространения от толщины диэлектрической подложки
с сегнетоэлектрической пленкой в полуволновом объемном резонаторе с
горизонтальным расположением, f=30 ГГц, d2=1 мкм, 1=10. Размер резонатора
7.2´3.4´3.6 мм.
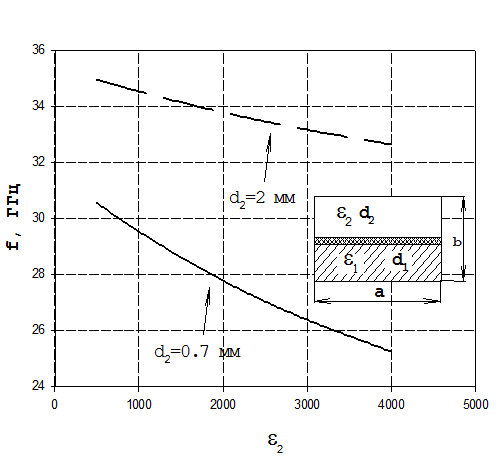
Рис.
2.7. Зависимость частоты в полуволновом объемном резонаторе от толщины
диэлектрической подложки с сегнетоэлектрической пленкой при горизонтальном
расположении, d2=1 мкм, 1=10. Размер резонатора
7.2´3.4´3.6 мм.
Очевидно,
что частичное включение пленки в резонатор обязательно приведет к значению x < 1. Исходя из предыдущих оценок, x в
рассматриваемом резонаторе в диапазоне измеряемых значений e2 = (1000 ¸ 2000) измеряется от x = 0,14 при
f0 = 30 ГГц (e2 = 103) до x = 0,26 при f0 = 28
ГГц (e2 = 2× 103).
Положим,
что ошибка значения tgd пленки вызвана только ошибкой в определении
коэффициента включения. Исходя из соотношения (2.25) получим, что:
 . (2.26)
. (2.26)
Относительную
ошибку в определении x находим из соотношения:
x+ x=2
x=2
 . (2.27)
. (2.27)
 . (2.28)
. (2.28)
В
соответствии c ранее принятые численные оценки приводят к
 0,032 при
f0 = 30 ГГц (e =103),
0,032 при
f0 = 30 ГГц (e =103),  = 5×10-3,
= 5×10-3,
 0,064 при
f0 = 28 ГГц (e = 2×103),
0,064 при
f0 = 28 ГГц (e = 2×103),  = 5×10-3.
= 5×10-3.
Следовательно, средняя ошибка в определении тангенса диэлектрических
потерь в сегнетоэлектрической пленке составляет ±5%.
Измерения параметров пленок проводились двумя способами, на проход и на
отражение. И в том и другом случае, производился подбор диафрагм с заданными
диаметрами, обеспечивающими в первом случае, приемлемый коэффициент прохождения
(20-40 дБ), во втором, максимальный коэффициент стоячей волны (»1.15) на резонансной частоте. В
таблице 2.1. представлены данные измерений и расчетов в полуволновом объемном
резонаторе на СВЧ, и сделано их сравнение с экспериментальными данными при
измерениях на низкой частоте 1МГц.
Таблица 2.1.
|
№ образца
|
M12213
|
M122313
|
M122513
|
M122713
|
|
dподл, мм
|
0.34
|
0.34
|
0.5
|
0.5
|
|
подл
|
9.8
|
9.8
|
9.8
|
9.8
|
|
dпл, мкм
|
0.89
|
0.9
|
0.89
|
0.9
|
|
fрез, Ггц
|
40.1
|
40.3
|
27
|
29
|
|
Qизм
|
261
|
260
|
77
|
275
|
|
Qмет
|
1953
|
2114
|
2102
|
1815
|
|
Qдиэл
|
302
|
295.9
|
76.3
|
324
|
|
пл
|
1230
|
1200
|
1150
|
1150
|
|
tan
|
0.024
|
0.026
|
0.044
|
0.014
|
|
пл 1МГц
|
1215
|
1170
|
1130
|
1130
|
|
tan 1Мгц
|
1*10-4
|
1*10-4
|
1*10-4
|
5*10-4
|
2.2.1
Определение параметров сегнетоэлектрических пленок по измерениям в щелевом полуволновом
резонаторе
Измерения диэлектрической проницаемости и тангенса угла диэлектрических
потерь в сегнетоэлектрической пленке можно проводить, используя полуволновой
резонатор, образованный щелевой или многощелевой линией на слоистой
диэлектрической подложке рис. 2. 8. Возбуждающей линией в этом случае служит
микрополосковая линия, согласованная с коаксиально-полосковым переходом.
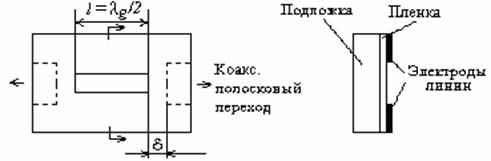
Рис. 2. 8. Щелевой резонатор с возбуждением микрополоском.
Щелевой резонатор возбуждается полем рассеяния открытого конца
микрополосковой линии. Ширина полоска и ширина щели в реальном эксперименте
будут незначительно отличаться друг от друга, тем не менее, набегающая по
полоску волна может возбудить поверхностную волну за счет излучения, расходящегося
на стенке щели и полоска. Основными модами поверхностной волны являются ТЕ1 и
ТМ1. В рассматриваемом случае поверхностная волна будет возбуждаться в
двухслойной диэлектрической структуре. Однако сегнетоэлектрическая пленка
окажет весьма слабое влияние на дисперсионные свойства поверхностных модов,
т.к. она расположена между проводящим экраном и диэлектрической подложкой.
Поэтому оценку критической толщины слоя можно сделать без учета
сегнетоэлектрической пленки. Известно, что критическая толщина слоя для модов
ТЕ1 и ТМ1 определяется формулой:
 .
.
Для
рассматриваемого случая критическая толщина подложки dПОДЛ должна подчиняться
условию
 .
.
Таким
образом, при длинах волн l=7.5-10 мм , e=9.5, толщину
подложки необходимо выбирать dПОДЛ <0.64 мм, обеспечив тем самым
запредельность для поверхностных модов, что дает возможность не опасаться
нежелательных паразитных резонансов.
Как
известно, частотная зависимость коэффициента отражения или прохождения
полуволнового резонатора, слабо связанного с входной и выходной питающими
линиями, аналогична зависимости коэффициента передачи от частоты параллельного
колебательного контура, включённого в линию параллельно. Коэффициент передачи по
мощности проходного полуволнового резонатора равен
 ,
,
где
 - нагруженная добротность,
- нагруженная добротность,  - расстройка частоты относительно резонансной
- расстройка частоты относительно резонансной  . Нагруженная добротность определяется соотношением
. Нагруженная добротность определяется соотношением
 .
.
Поэтому
из частотной зависимости  нагруженная добротность определяется по полосе частот
половинной мощности.
нагруженная добротность определяется по полосе частот
половинной мощности.
Формулу
(2.2.4) можно переписать пологая, что металлическая добротность выше
QM>>(QДИЭЛ+QS), следовательно нагруженная добротность щелевого
резонатора с учетом доминирующих диэлектрических потерь в сегнетоэлектрической
пленке имеет вид:
 .
.
Рассмотрим
качественные оценки QS. Определим эквивалентную схему щелевого резонатора,
учитывая элементы связи с микрополосковой линией, и будем считать, что
элементами связи являются емкости между торцом щелевой линии и микрополоском
возбуждения. С учетом симметричного расположения щели между торцами полосок
эквивалентную схему резонатора на частотах близких к резонансной можно
представить в виде, показанном на рис. 2.9.а.

а)
б)
Рис.
2.9. Эквивалентное представление перехода микрополосок - щелевая линия -
микрополосок.
Вычислим
QS , составляющую нагруженной добротности, вызванную
потерями энергии за счет излучения в полосковую линию. Условие слабой связи
требует выполнения условия 
 . Поэтому
вносимое реактивное сопротивление в последовательный LCr контур будет
определяться удвоенной емкостью связи, а вносимое сопротивление потерь
. Поэтому
вносимое реактивное сопротивление в последовательный LCr контур будет
определяться удвоенной емкостью связи, а вносимое сопротивление потерь  . 2.2. Следовательно, добротность QS будет равна:
. 2.2. Следовательно, добротность QS будет равна:
 . (2.29)
. (2.29)
Подставив
в QS выражение  получим:
получим:
 , (2.30)
, (2.30)
где
Z0,S - волновое сопротивление щелевой линии; Z0 - волновое сопротивление
микрополосковой линии.
Соотношение
(2.30) позволяет найти ССВ по известной из эксперимента QS, или по известной ССВ найти QS. Поэтому оценку QS, а, следовательно, и ССВ можно получить исходя из экспериментального
значения нагруженной добротности резонатора на щелевой линии с однослойной
диэлектрической подложкой, диэлектрическая проницаемость и tgd которой заранее известны, а QS точно
рассчитывается. Следовательно для однослойной щелевой линии:
 . (2.31)
. (2.31)
Щелевой
резонатор на подложке с сегнетоэлектрической пленкой, при сохранении геометрии
включения резонатора на однослойной подложке, имеет ССВ очень близкую по
значению к щелевому резонатору на однослойной подложке.
Помимо
инструментальных ошибок измерения w0 (которые могут
быть сделаны очень малыми при усреднении w0) возникают ошибки,
связанные с погрешностями определения геометрических размеров: длины и ширины
резонатора, с погрешностью диэлектрической проницаемости подложки и разной
степенью их влияния на расчетное значение e пленки. Поэтому
целесообразно ввести чувствительность в виде производной функции F по
соответствующему параметру h:
 .
.
(Заметим,
что модуль  меньше или равен единице). Чувствительность
меньше или равен единице). Чувствительность  определяет изменение функции при вариации одного из
параметров. Очевидно, наибольший интерес представляет оценка изменения функции
F, которая является функцией нескольких параметров. Приращение DF при бесконечно малых вариациях всех параметров определяется полной
производной:
определяет изменение функции при вариации одного из
параметров. Очевидно, наибольший интерес представляет оценка изменения функции
F, которая является функцией нескольких параметров. Приращение DF при бесконечно малых вариациях всех параметров определяется полной
производной:
 . (2.32)
. (2.32)
Введем
относительную вариацию: поделим обе части (2.32) на F, а каждое слагаемое суммы
умножим на hi, следовательно:
 ,
,
где
 .
.
Переходя
к малым конечным приращениям, получим:
 . (2.33)
. (2.33)
Для
определения погрешности диэлектрической проницаемости пленки, используя (2.33)
находим:
 .(2.34)
.(2.34)
Отсутствующие
производные вычисляются численным дифференцированием исходя из дисперсионного
уравнения, которое в данном случае может быть интерпретировано как уравнение
вида eПЛ=f(w0, S, lg, eПОДЛ).
Как
видно из расчетов ,при различных длинах резонаторов крутизна изменения частоты
от диэлектрической проницаемости сегнетоэлектрической пленки высока и
составляет, при lрез=1.658 мм, w=0.1 мм, f0 =
30 ГГц, e3 = 1000

равна
7.71×106 Гц, погрешность определения диэлектрической
проницаемости с учетом  5×10-3 равна
5×10-3 равна  0.019. При длине резонатора lрез=1.309 мм, w=0.1
мм, f0 = 30 ГГц, e2 = 2000
0.019. При длине резонатора lрез=1.309 мм, w=0.1
мм, f0 = 30 ГГц, e2 = 2000  равна
5.24×106 Гц, а погрешность определения
равна
5.24×106 Гц, а погрешность определения  0.014. При более широких зазорах щели W=0.35
мм, погрешность определения диэлектрической проницаемости пленки не превышает
3%. Точность определения tgd, как следует из расчетов,
составляет при w=0.35 мм, f0 = 30 ГГц, (e =103),
0.014. При более широких зазорах щели W=0.35
мм, погрешность определения диэлектрической проницаемости пленки не превышает
3%. Точность определения tgd, как следует из расчетов,
составляет при w=0.35 мм, f0 = 30 ГГц, (e =103),  = 5×10-3,
= 5×10-3,  0.025, для более узких щелей точность определения
возрастает.
0.025, для более узких щелей точность определения
возрастает.
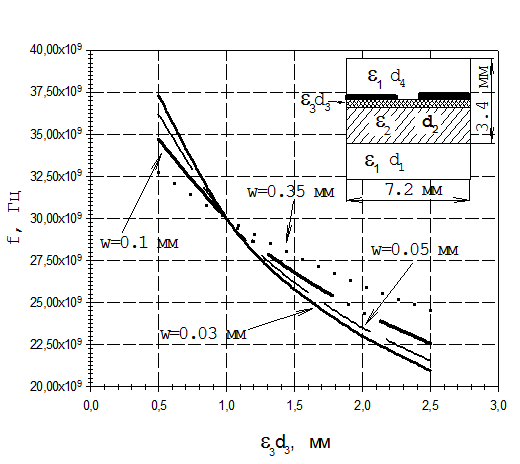
Рис.
2.10. Зависимость частоты в щелевом резонаторе от диэлектрической проницаемости
сегнетоэлектрической пленки при различной ширине зазора щели, d2=0.3
мм, 2=9.8.
3.
Экспериментальные измерения емкости в планарных структурах
3.1
Автоматизированная установка для измерений C, tgd,
их температурных зависимостей и электропроводности
Для измерений диэлектрических характеристик и тангенса угла
диэлектрических потерь сегнетоэлектрических керамических образцы
изготавливались в виде плоскопараллельных конденсаторов. Сегнетоэлектрические
керамические диски покрывались с двух сторон медными электродами толщиной около
3 мкм.
Экспериментальные исследования диэлектрических свойств
сегнетокерамических конденсаторов выполнялись методом измерения импеданса
образца на частоте 1 МГц. Внешний вид и блок-схема экспериментальной установки
приведены на рис. 3.1 и рис. 3.2, соотвтетвенно. Установка содержит цифровой
измеритель L, C, R - Е7-12
специальный защитный держатель образца (4), который можно опускать в криогенный
охладитель; термометр (RT) с
источником питания и микровольтметром (5,6), вольтметр-электрометр
универсальный В7-30. Управление измерениями осуществляется с помощью компьютера
(7). Для снятия вольт-фарадных характеристик и для получения зависимости tgδ(U) с помощью компьютера задается интервал и шаг напряжения,
прикладываемого к исследуемому образцу. Все результаты измерений поступали в компьютер
в упакованном двоично-десятичном формате «8-4-2-1».
Импеданс исследуемого конденсатора (реактивная и активная составляющие
проводимости) измерялся прибором "Измеритель - R,L,C" типа Е7-12.
Принцип действия Е7-12 основан на четырёхзондовом методе. Два зонда подключают
исследуемый конденсатор к генератору переменного тока частотой f=1МГц; два
других зонда, также подключенные к обкладкам конденсатора, используются для
измерения разности потенциалов переменного электрического поля между его
электродами. Входящие в состав Е7-12 синхронные детекторы обеспечивают
получение информации о амплитуде переменного сигнала как синфазного, так и
сдвинутого на p/2 относительно
начальной фазы тока. Дальнейшая цифровая обработка сигналов с синхронных
детекторов даёт информацию о реактивной (wC) и активной (G) составляющих проводимости конденсатора.
Постоянное смещающее электрическое поле, прикладываемое к электродам
конденсатора, создавалось с помощью управляемого источника напряжения). При
проведении температурных исследований использован релаксационный метод
изменения температуры конденсатора. Для технической реализации этого метода
применялся держатель образца, помещаемый в сосуд с криогенной жидкостью (азот).
Значение температуры контролировалось с помощью термопреобразователя
сопротивления ТСМФ-Д, принцип действия которого основан на температурной
зависимости электрического сопротивления металлической жилы микропровода. При
температурных измерениях частота измерения температуры автоматически задается с
помощью компьютера.

Рис. 3.2. Блок-схема автоматизированной установки для измерения
диэлектрических характеристик и электропроводности:
Е7-12 - измеритель L, C, R - цифровой
В7-30 - вольтметр-электрометр универсальный
В7 27А/1 - цифровой вольтметр
ИТ - источник тока
ФНЧ - фильтр низких частот
RT -
термосопротивление
Сх - измеряемая емкость
Rх -
измеряемое сопротивление
Изоляция объекта измерения от воздействия внешнего случайного
электрического поля и проникновения влаги достигается применением латунного
экрана, который устанавливается на измерительной трубке посредством резьбового
соединения.
Электроды исследуемого конденсатора подключаются к двум узлам, в которых
соединены попарно четыре коаксиальных кабеля от прибора Е7-12. Показания
прибора Е7-12 отражают суммарную ёмкость, включающую ёмкость планарного
конденсатора и паразитную ёмкость подводящих кабелей и прижимных контактов.
Минимизация паразитной емкости достигается применением экранированных кабелей
минимальной длины и их распайкой на прижимных контактах. Оставшаяся
незначительная паразитная ёмкость может быть скомпенсирована при калибровке
прибора Е7-12. Достоверность измерения температуры достигается расположением
термопреобразователя на держателе, изготовленном из материала с большим
коэффициентом теплопроводности (медь), которая обеспечивает изотермичность её
поверхности. Следует учитывать, что теплоёмкость исследуемого образца
существенно меньше теплоёмкости изотермической пластины.
На блок-схеме установки образец для измерения вольт-амперных
характеристик (ВАХ) показан в виде эквивалентного сопротивления Rx. Устройство для измерения ВАХ - I(U) - В7-30, вольтметр-электрометр универсальный, обозначено
цифрой 8. При снятии ВАХ последнее измеряемое значение соответствовало времени
релаксации 3.
Пределы погрешности измерения емкости ±0.02%. Точность измерения тангенса
угла диэлектрических потерь ±2·10-4. Пределы допускаемых значений основной
погрешности измерения тока равны значениям d в амперах, определяемым формулой: d=±(А+0.005Ix), где А - погрешность дискретности электрометра, равная 2
единицам младшего разряда в амперах, Ix - действительное значение измеряемого тока в амперах.
С помощью автоматизированной установки были измерены следующие
характеристики:
·
температурная
зависимость емкости С(Т) и тангенса угла диэлектрических потерь tgδ(Т);
·
вольт-фарадные
характеристики C(U) и зависимость тангенса угла
диэлектрических потерь от приложенного напряжения tgδ(U); по результатам измерения вольт-фарадных характеристик
проводилась оценка диэлектрической проницаемости образцов по формуле планарного
конденсатора
 ;
;
·
фактор
управляемости был получен из следующего выражения К=С(0)/C(Umax), где Umax -
максимальное смещение напряжения приложенное к электродам конденсатора;
·
вольтамперные
характеристики (ВАХ); по омическим участкам ВАХ проводилась оценка
сопротивления образцов.
.2
Экспериментальные результаты измерений ёмкости планарного встречно щелевого конденсатора
на многослойной сегнетоэлектрической плёнке
Многослойная нанокомпозитная СЭП формировалась на сапфировой
диэлектрической подложке методом магнетронного распыления из мишеней с
различным компонентным и элементным составами. Технологические режимы напыления
слоёв структуры СЭП из твёрдотельных составов мишеней (минимальное количество
используемых мишеней - семь) стандартные.
На рис.3.5, представлены экспериментальные зависимости ёмкости
конденсатора на нанокомпозитной СЭП от температуры при различном управляющем
напряжении. Конденсатор содержит 25 нанокомпозитных слоёв СЭП, толщина
сегнетоэлектрической структуры равна 850 нм. Из рисунка видно, что максимальное
отклонение ёмкости в широком диапазоне температур не превышает 7%, без
управляющего напряжения, а с приложенным напряжением практически исчезает.
Эффект температурной стабилизации достигается за счёт применения в процессе
распыления из мишеней с комбинацией разнокомпонентных составов с близкими
фазовыми переходами и кратными значениями постоянных решёток. Влияние этих
параметров существенно при получении качественных плёнок с малыми
диэлектрическими потерями в широком частотном диапазоне и приемлемым
коэффициентом перестройки эффективной диэлектрической проницаемостью. Рис.3.6
иллюстрирует разброс семисот планарных ёмкостей одного номинала сформированных
на подложке размером 30х48мм2. Следует отметить, что величина значения ёмкости
обусловлена качеством поверхности получаемой многослойной СЭП, рис.3.7, а также
точностью повторения топологических размеров встречно щелевых структур
конденсатора.
Зависимость
распределения изменения коэффициента управления ёмкостью конденсатора ( ) по подложке показана на рис.3.8. На величину
коэффициента управления ёмкостью помимо точности повторения топологии встречно
штыревой структуры и качества поверхности плёнки, влияет буферный материал,
между поверхностью СЭП и электродами конденсатора. Распределение значений
тангенса угла диэлектрических потерь планарных сегнетоэлектрических
конденсаторов на частоте 1 МГц, показана на рис. 3.8.
) по подложке показана на рис.3.8. На величину
коэффициента управления ёмкостью помимо точности повторения топологии встречно
штыревой структуры и качества поверхности плёнки, влияет буферный материал,
между поверхностью СЭП и электродами конденсатора. Распределение значений
тангенса угла диэлектрических потерь планарных сегнетоэлектрических
конденсаторов на частоте 1 МГц, показана на рис. 3.8.
На
рис.3.9, показаны экспериментальные частотные зависимости основных параметров
планарного конденсатора. Из рисунка видно, что на частоте 3ГГц, тангенс угла
диэлектрических потерь составляет 35×10-3, такое
высокое значение обусловлено низким качеством электродов конденсатора, и их
топологическим расположением. Для данного типа многослойной нанокомпозитной СЭП
используемой в исследуемой конденсаторной структуре, значение добротности на
частоте 34ГГц по измерениям в волноводном резонаторе составило величину 107,
что подтверждает сделанное выше утверждение.
На
основании полученных экспериментальных данных, можно сделать вывод о том, что
созданные перестраиваемые конденсаторы на нанокомпозитных СЭП, могут найти
широкое практическое применение в современной РЭА работающей в широком
частотном диапазоне.
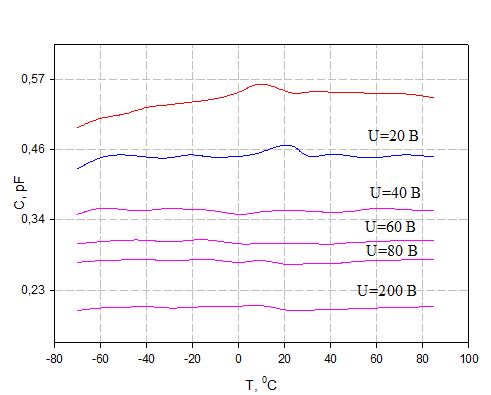
Рис.3.5.

Рис.3.6.

Рис.3.7.

Рис.3.8.

Рис.
3.9.
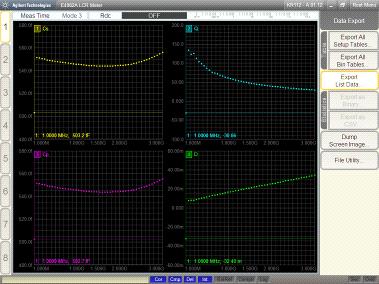
Рис. 3.10.
4. Электродинамический
анализ щелевой линии на нанокомпозитной сегнетоэлектрической плёнке
Целью задачи является расчет постоянной распространения электромагнитного
поля в зависимости от температуры и напряженности электрического поля.
На
рис.4.1 представлено сечение рассматриваемой щелевой линии, окруженной
прямоугольной областью с идеально проводящими стенками. Сегнетоэлектрическая
пленка (область 1 на рис.4.1) образована N слоями
различного химического состава, то есть с разным процентным содержанием бария в
твердом растворе  (BST).
(BST).

Рис.4.1.
В
такой линии электромагнитное поле локализовано около узкой щели. Поэтому линия
может быть окружена идеальными электрическими или магнитными стенками. В этом
случае приходим к прямоугольному волноводу, поперечное сечение которого
переставляет собой щелевую линию в окружении стенок. Влияние стенок исчезающе
мало при их достаточном удалении от щели.
В
качестве базиса разложения щелевого мода можно выбрать поля Е- и Н-типов
пустого прямоугольного волновода. В этом случае надо задать магнитный и
электрический векторные потенциалы вдоль оси волновода. Альтернативный подход
заключается в использовании базиса LE- и LM-полей,
частично заполненного диэлектрическим слоем на поперечном сечении
прямоугольного волновода. Совокупность LE - и LM-полей,
образующих полный ортогональный базис в описываемой структуре, ближе к щелевому
моду, чем поля пустого волновода. При ширине щели, стремящейся к ширине
волновода, мы приходим к частично заполненному прямоугольному волноводу.
Анализ
дисперсионных характеристик планарных структур с направляющими электродами
приводит к парным интегральным уравнениям или к парным сумматорным рядам,
относительно распределения тока на электродах, либо распределения поля на щели.
Популярной численной процедурой решения интегральных уравнений является метод
Галеркина.
4.1 Модель
зависимости диэлектрической проницаемости сегнетоэлектроника от температуры
В настоящее время в СВЧ-электронике применяются разнообразные составы
твердого раствора BaxSr1-xTiO3. Диэлектрическая проницаемость
сегнетоэлектрика зависит от температуры (T), внешнего поля (E), толщины слоя (di) и
концентрации в нем бария (xi).
Точно вид зависимости ε(Т) неизвестен, но существуют различные модели этой
зависимости.
Рассмотрим одну из таких моделей зависимости диэлектрической
проницаемости от температуры.
Модель температурной и полевой зависимости диэлектрической проницаемости
в каждом нанослое BaxSr1-xTiO3 была принята в виде
 ,
,
где
x=(0,…,1) - концентрация бария,
 ,
,  ,
,  ,
,
где
Е - напряженность электрического поля, ЕН - нормирующее поле,  - температура Дебая, а концентрационная зависимость
постоянной Кюри С(х) и температуры Кюри-Вейса Тс(х) была принята в виде
- температура Дебая, а концентрационная зависимость
постоянной Кюри С(х) и температуры Кюри-Вейса Тс(х) была принята в виде
 ,
,  .
.
На рис.4.2 представлены зависимости диэлектрической проницаемости от
температуры для сегнетоэлектриков с различной концентрацией бария (х).
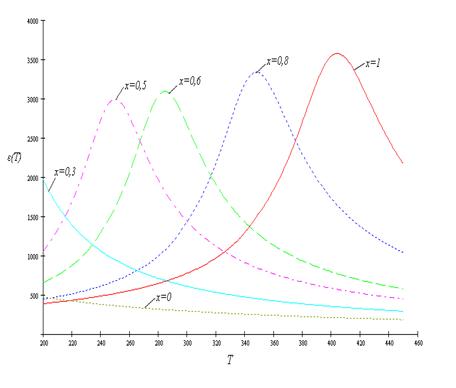
Рис.4.2.
4.2 Расчет
постоянной распространения электромагнитного поля в зависимости от температуры
и напряженности электрического поля
Зададим два векторных потенциала

 ,
,
где
 и
и  -
комплексные амплитуды.
-
комплексные амплитуды.
Уравнения
Максвелла сводятся к уравнениям Гельмгольца относительно  и
и  в каждой
области поперечного сечения.
в каждой
области поперечного сечения.
Представим
его в виде
 , (4.1)
, (4.1)
где:
 ;
;  ;
;  -относительная диэлектрическая проницаемость
соответствующей области.
-относительная диэлектрическая проницаемость
соответствующей области.
Первая
область поперечного сечения образована из N нанослоев.
Толщина i-го нанослоя равна ∆i , где i -
номер нанослоя, начиная с нижнего. Обозначим  -
координату верхней границы i - го нанослоя. Тогда
-
координату верхней границы i - го нанослоя. Тогда
 -
координата верхней границы первого нанослоя.
-
координата верхней границы первого нанослоя.
 ,
,  ,
,  .
.
Уравнения
(4.1) должны быть дополнены граничными условиями
 ,
,  - на горизонтальных стенках,
- на горизонтальных стенках,
 ,
,  - на вертикальных стенках.
- на вертикальных стенках.
На
диэлектрических границах областей должны быть выполнены условия
 (4.2)
(4.2)
В
этих соотношениях  - номер области поперечного сечения. Решения уравнения
(4.1) в каждой области поперечного сечения и нанослоя с учетом граничных
условий на металлических стенках имеют одинаковый вид
- номер области поперечного сечения. Решения уравнения
(4.1) в каждой области поперечного сечения и нанослоя с учетом граничных
условий на металлических стенках имеют одинаковый вид
 , (4.3)
, (4.3)
где: - для каждой области сечения;
- для каждой области сечения;  - координата нижней границы каждой области и нанослоя.
В пределах нанослоя в силу малой толщины изменения
- координата нижней границы каждой области и нанослоя.
В пределах нанослоя в силу малой толщины изменения  и
и  по
координате y можно считать линейным.
по
координате y можно считать линейным.
Запишем
на основании (4.3) потенциалы в соответствующих областях поперечного сечения.
В
области над щелью ( , где
, где  )
)
 (4.4)
(4.4)
В
нанослоях первой области ( )
)

Исходя
из того, что  порядка 0.1 мкм перепишем
порядка 0.1 мкм перепишем
 (4.5)
(4.5)
где:
 ;
;  -
диэлектрическая проницаемость i-го нанослоя.
-
диэлектрическая проницаемость i-го нанослоя.
В
области 
 (4.6)
(4.6)
В
нижней области  , где
, где 
 (4.7)
(4.7)
Условия
непрерывности на границах областей и нанослоев (4.2) приводят к связи
произвольных коэффициентов  ,
, ,…,
,…, в
соотношениях 4.4
÷ 4.7.
в
соотношениях 4.4
÷ 4.7.
При
y= - d2 из (4.2), (4.6) и (4.7) найдем

Запишем
систему в матричном виде
 , (4.8)
, (4.8)
где
матрица  имеет вид
имеет вид

На
границе первого нанослоя и диэлектрической области (y=0) условия
сшивания (4.2) приводят к соотношениям
 ,
,
откуда находим

Перепишем
эти соотношения в матричном виде
 , (4.9)
, (4.9)
где
матрица  имеет вид
имеет вид
 ,
,
где:
 ;
;  ;
;  ;
;
 ;
;  ;
; ;
;
 ;
;  .
.
На
границе k-го и (k+1)-го нанослоя условия сшивания полей приведут к
соотношениям

 ,
,
отсюда находим

 ,
,
Перепишем
эти соотношения в матричном виде
 , (4.10)
, (4.10)
где
матрица  имеет вид
имеет вид
 ,
,
где:
 ,
,  ,
,  ,
,  .
.
Граница
между верхней областью и N-ым нанослоем первой области
(y=d1)
имеет смешанный характер граничных условий. На металлизированной части границы
касательные составляющие электрического поля равны нулю, а на ширине щели они
непрерывны. Очевидно, что на ширине щели непрерывны и касательные составляющие
магнитного поля.
Соотношения
между векторными потенциалами и составляющими поля следуют из уравнений
Максвелла. В каждой области поперечного сечения и нанослое выполняются
соотношения
 (4.11)
(4.11)

 (4.12)
(4.12)
 (4.13)
(4.13)
 (4.14)
(4.14)
Из
этих соотношений следует, что условия непрерывности  и
и  составляющих
на ширине щели одинаковы с условиями непрерывности
составляющих
на ширине щели одинаковы с условиями непрерывности  и
и  составляющими.
Поэтому можно выбирать произвольную пару для выполнения условий непрерывности.
Выберем в качестве такой пары непрерывность
составляющими.
Поэтому можно выбирать произвольную пару для выполнения условий непрерывности.
Выберем в качестве такой пары непрерывность  и
и  . Таким образом при y=d1
должны быть выполнены условия
. Таким образом при y=d1
должны быть выполнены условия
 и
и  .
.
Подставим соотношения (4.4)

Найдем
 и
и 

Перепишем
эти соотношения в матричном виде
 , (4.15)
, (4.15)
где
матрица  имеет вид
имеет вид

С
другой стороны, результирующее касательное электрическое поле на щели должно
удовлетворять условию

В
этих соотношениях представлены касательные составляющие полей в верхней области
и в нанослое, расположенном под щелью.


 .
.
Выберем

Подставив соотношения (4.11) и (4.12), получим


Подставив соотношения (2.4),
получим


Выполним
преобразование Фурье
 (4.16)
(4.16)
 (4.17)
(4.17)

Тогда
выражения (4.16) и (4.17) перепишутся в виде


Обозначим

 ,
,
где

тогда


Получили
систему

Определитель
системы равен

где

Система
невырожденная. Найдем решение этой системы по формуле Крамера 


 (4.18)
(4.18)
Перейдем
к выполнению граничных условий непрерывности касательных составляющих
магнитного поля щелевой линии на свободном участке границы между нулевой и
первой областями.

По
формулам (4.13) и (4.14)

Подставив
сюда соотношения (4.4) и (4.5) при y=d1, получим
 (4.19)
(4.19)
Перепишем
(4.19) в виде
 (4.20)
(4.20)
Подставим
в (4.20) коэффициенты  и
и  выраженные
через
выраженные
через  и
и  из
соотношений (4.8), (4.9), (4.10) и (4.15). Получим систему уравнений вида
из
соотношений (4.8), (4.9), (4.10) и (4.15). Получим систему уравнений вида
 (4.21)
(4.21)
(подробный
алгоритм вычисления  ,
, ,
, ,
, ,
, ,
,  приведен
в шестом пункте данной пояснительной записки).
приведен
в шестом пункте данной пояснительной записки).
В
системе уравнений (4.21) неизвестны распределения полей  и
и  на
свободной от металла поверхности первой области. Но так как неизвестные
распределения f(x) и g(x) входят в Fn и Gn под
интегралами, то система уравнений (4.21) представляет собой парные интегральные
уравнения. Их можно решить методом Галеркина.
на
свободной от металла поверхности первой области. Но так как неизвестные
распределения f(x) и g(x) входят в Fn и Gn под
интегралами, то система уравнений (4.21) представляет собой парные интегральные
уравнения. Их можно решить методом Галеркина.
Как
известно, эффективность вычислительной процедуры определяется скоростью
сходимости. В методе Галеркина она определяется выбором системы
аппроксимирующих функций для токов на электродах или выбором полей на щелях.
Аппроксимирующие функции на линии сшивания должны учитывать особенности
поведения поля на краях тонких (бесконечно тонких) металлических электродов.
Обратимся
к граничным условиям на остром ребре. Наличие края электрода приводит к
неоднозначности решения уравнений Максвелла. Для обеспечения единственности
решения вводят дополнительное физическое ограничение на поведение поля. Оно
заключается в требовании конечности энергии электромагнитного поля, запасенного
в любом конечном объеме окрестности ребра. Из этого условия следует, что в
окрестности ребра ни одна составляющая электромагнитного поля  не может возрастать быстрее, чем
не может возрастать быстрее, чем  при
при  (где τ>0, а
(где τ>0, а  -
расстояние до ребра). Поэтому
-
расстояние до ребра). Поэтому
 Исходя из того, что диэлектрическая проницаемость
первой области примерно в 1000 раз больше диэлектрической проницаемости нулевой
области, можем утверждать, что нормальная составляющая электрического поля на
границе y=d1 практически равна нулю. Переходим к структуре,
изображенной на рис.3.10.
Исходя из того, что диэлектрическая проницаемость
первой области примерно в 1000 раз больше диэлектрической проницаемости нулевой
области, можем утверждать, что нормальная составляющая электрического поля на
границе y=d1 практически равна нулю. Переходим к структуре,
изображенной на рис.3.10.

Рис.4.3.
Введем
вектора Герца  и
и 
Уравнение
Гельмгольца для  и
и  в
полярной системе координат имеет вид
в
полярной системе координат имеет вид
 . (4.22)
. (4.22)
Решаем
это уравнение методом разделения переменных. Представим  в виде
в виде
 .
.
Подставив
 в (4.22), получим
в (4.22), получим
 . (4.23)
. (4.23)
Поделим
(4.23) на 
 . (4.24)
. (4.24)
Представим (4.24) в виде
 .
.
Получили два уравнения
 (4.25)
(4.25)
 . (4.26)
. (4.26)
Ищем
решение уравнения (4.25) в виде
 .
.
Расположим
магнитную стенку по  . Тогда граничные условия для
. Тогда граничные условия для  на электрической и магнитной стенках примут вид
на электрической и магнитной стенках примут вид
 и
и  .
.
Первое
условие приводит к  , второе условие приводит к
, второе условие приводит к  , откуда
, откуда

Таким образом
 .
.
 и
и 
Из
первого условия следует, что  , а
второе условие дает
, а
второе условие дает  , откуда
, откуда

Таким образом
 .
.
Ищем
решение уравнения (2.26) в виде

Таким образом, векторы Герца в области ребра имеют вид
 (4.27)
(4.27)
 . (4.28)
. (4.28)
В
соответствии с граничным условием на ребре при  сингулярность
поля имеет порядок
сингулярность
поля имеет порядок  , где
, где  . Поэтому
. Поэтому
 и
и  . В
суммах (4.27) и (4.28) следует оставить члены
. В
суммах (4.27) и (4.28) следует оставить члены  и
и  при n=0.
при n=0.
Введем
весовую функцию для  в виде
в виде  , а для
, а для  в виде
в виде  .
.
Этим
весовым функциям соответствуют ортогональные полиномы Чебышева первого рода
нулевого и четных порядков  и
второго рода нечетных порядков
и
второго рода нечетных порядков  .
.
Исходя
из этого, представим f(x) и g(x) на интервале [-1,1] в виде

 .
.
Тогда
 (4.29)
(4.29)

 .
.
Введем
 , отсюда
, отсюда  .
.
Перепишем (4.29) в виде

Интегралы в этих соотношениях вычисляются в аналитическом виде. После
интегрирования получим
 ,
,
где:
 и
и  - функции
Бесселя первого рода.
- функции
Бесселя первого рода.
Обозначим

тогда
 (4.30)
(4.30)
По
методу Галеркина умножим первое и второе уравнения системы (4.21) на  и
и  соответственно
и проинтегрируем по ξ
на интервале [-1,1]. Под интегралом будет
соответственно
и проинтегрируем по ξ
на интервале [-1,1]. Под интегралом будет

Аналогично (3.30) получим

Сведем
систему (4.21) к матричному виду. Получим систему линейных алгебраических
уравнений (СЛАУ).

 (4.31)
(4.31)
где:



Однородная
система линейных уравнений имеет нетривиальные решения, если
 . (4.32)
. (4.32)
Приближенное
значение постоянной распространения γ находиться численным решением дисперсионного уравнения (4.32).
Рассматриваемая
щелевая линия образована на слоистой диэлектрической структуре. Поэтому плоская
граница между сегнетоэлектрической пленой и диэлектрической подложкой не
совпадает с координатной поверхностью полярной системы координат, в которой
удобно вести анализ электромагнитного поля вблизи края электрода. Таким
образом, строгое обоснование порядка сингулярности трудно выполнить. Тем не
менее, можно с очень малой ошибкой считать, что касательные составляющие
электрического поля на поверхности СЭП и на границе с подложкой. На толщине
пленки порядка 10-3 мм не может произойти заметное изменение касательного поля.
Следовательно, порядок сингулярности можно сохранить тем же, что и в обычных
щелевых линиях, образованных на однослойных диэлектрических подложках с ε ~ 10. поэтому в качестве базиса были использованы полиномы
Чебышева.
4.2.1
Численный расчет зависимости постоянной распространения электромагнитного поля
от температуры и напряженности электрического поля
Зададим числовые параметры для структуры, изображенной на рис.3.8:
• ширина щели - w=0.1
мм;
• толщина подложки - d2 =
0.5 мм;
• диэлектрическая проницаемость подложки - ε = 20;
• диэлектрическая проницаемость воздуха - ε0 =
8.854·10-15 Ф/мм;
• расстояние d0 = d3 =100 мм;
• толщина пленки - d1 ≈
1..2 мкм;
• количество нанослоев - N=4;
• рабочий диапазон температур - 263..313 К;
• напряженность электрического поля - Е0=0 В/мм, Е1=100 В/мм.
В связи с тем, что в процессе изготовления пленки точность при получении
таких параметров как толщина - в пределах 10%, концентрация бария - в пределах
1%, зададим в случайном порядке эти отклонения.
(Расчет проводился в программной среде MathCAD-14).
) • рабочая частота - f = 20
ГГц;
• толщины нанослоев: ∆1=0.2 мкм, ∆2=0.3 мкм, ∆3=0.15
мкм, ∆4=0.24 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.3.11.

Рис.4.4.
При отклонении параметров:
• толщины нанослоев: ∆1=0.21 мкм, ∆2=0.315 мкм, ∆3=0.15
мкм, ∆4=0.25 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.5.

Рис.4.5.
• толщины нанослоев: ∆1=0.19 мкм, ∆2=0.29 мкм, ∆3=0.145
мкм, ∆4=0.228 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.6.

Рис.4.6.
• толщины нанослоев: ∆1=0.2 мкм, ∆2=0.3 мкм, ∆3=0.15
мкм, ∆4=0.24 мкм;
• концентрация бария: x1=
0.502, x2= 0.402, x3= 0.603, x4=
0.703.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.7.

Рис.4.8.
• толщины нанослоев: ∆1=0.2 мкм, ∆2=0.3 мкм, ∆3=0.15
мкм, ∆4=0.24 мкм;
• концентрация бария: x1= 0.498,
x2= 0.398, x3= 0.598, x4=
0.697.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис4.9.

Рис.4.9.
) • рабочая частота - f = 30
ГГц;
• толщины нанослоев: ∆1=0.4 мкм, ∆2=0.6 мкм, ∆3=0.3
мкм, ∆4=0.48 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.10.

Рис.4.10.
При отклонении параметров:
• толщины нанослоев: ∆1=0.42 мкм, ∆2=0.63 мкм, ∆3=0.315
мкм, ∆4=0.5 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.11.

Рис.4.11.
• толщины нанослоев: ∆1=0.38 мкм, ∆2=0.57 мкм, ∆3=0.285
мкм, ∆4=0.46 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4= 0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.12.

Рис.4.12.
• толщины нанослоев: ∆1=0.4 мкм, ∆2=0.6 мкм, ∆3=0.3
мкм, ∆4=0.48 мкм;
• концентрация бария: x1=
0.502, x2= 0.402, x3= 0.602, x4=
0.703.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.13.

Рис.4.13.
• толщины нанослоев: ∆1=0.42 мкм, ∆2=0.6 мкм, ∆3=0.315
мкм, ∆4=0.46 мкм;
• концентрация бария: x1=
0.502, x2= 0.402, x3= 0.602, x4=
0.703.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.14.

Рис.4.14.
) • рабочая частота - f = 40
ГГц;
• толщины нанослоев: ∆1=0.4 мкм, ∆2=0.6 мкм, ∆3=0.3
мкм, ∆4=0.48 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.15.

Рис.4.15.
При отклонении параметров:
• толщины нанослоев: ∆1=0.42 мкм, ∆2=0.63 мкм, ∆3=0.315
мкм, ∆4=0.5 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.16.

Рис.4.16.
• толщины нанослоев: ∆1=0.38 мкм, ∆2=0.57 мкм, ∆3=0.285
мкм, ∆4=0.46 мкм;
• концентрация бария: x1=
0.5, x2= 0.4, x3= 0.6, x4=
0.7.
Зависимость постоянной распространения от температуры при двух значениях
напряженности электрического поля показана на рис.4.17.

Рис.4.17.
Из графиков видно, что при 10% отклонении в процессе изготовления толщины
пленки от заданного значения отклонение значения постоянной распространения γ
от рассчитанного
незначительно. А 1% разброс значения концентрации бария практически не изменяет
значения γ.
Заключение
Основные результаты диссертационной работы заключаются в следующем:
. Разработан метод расчёта постоянной распространения электромагнитной
волны в планарных слоистых диэлектрических структурах, образованных тонкими
электродами, расположенными на поверхности СЭП.
. На основе модели температурной и полевой зависимости диэлектрической
проницаемости сегнетоэлектриков типа твердого раствора BaxSr1-xTiO3,
выполнен численный анализ свойств планарных структур на основе многослойной нанокомпозитной
СЭП.
. Обоснована возможность расширения температурного интервала для
планарных структур на основе СЭП до значений ± 40 0С относительно рабочей температуры при сохранении
значений постоянной распространения в интервале единиц процентов.
. Выполнен анализ ёмкости планарных структур с управляющими электродами.
Список
использованной литературы
1. Сегнетоэлектрические
пленки и устройства на сверх- и крайне высоких частотах. Иванов А.А.,
Карманенко С.Ф., Мироненко И.Г., Назаров И.А., Семенов А.А. СПб.: ООО
"Техномедиа"/ изд-во "Элмор", 2007. - 162с.
. Сегнетоэлектрики
и родственные им материалы. М. Лайнс, А. Гласс. М.: изд-во "Мир",
1981. - 736с.
. Техническая
электродинамика. Пименов Ю.В., Вольман В.И., Муравцов А.Д. Под ред. Ю.В.
Пименова: Учеб. пособие для вузов. - М.: Радио и связь, 2000. - 536с.: ил.
. Физика:
Проблемы. История. Люди: Сб. статей /Сост.: В.М. Тушкевич, Ред. колл.: В.Я.
Френкель (пред.) и др. - М.: Наука, 1986.
. Сегнетоэлектрики
и ферромагнетики .Сб. статей /Сост.: П.П. Пугачевич Калинин, 1973.