|
АК
|
активный контакт
|
|
ПОС
|
положительной обратной
связи
|
|
БИСПИН
|
бисмещенный переход с
инжекционной неустойчивостью
|
|
ВАХ
|
вольт-амперная
характеристика
|
|
ТСРП
|
Транзисторные структуры,
имеющие распределенный по всей площади кристалла эмиттерный p+-n - переход
|
|
МТОП
|
металл - туннельно -
прозрачный - окисел - полупроводник
|
|
СРП
|
структура с распределенным
p+-n-переходом
|
|
НТ
|
неустойчивость тока
|
|
ОС
|
отрицательное сопротивление
|
|
ПС
|
поверхностных состояний
|
|
ПБНТ
|
поверхностно-барьерный
неустойчивый ток
|
|
ПОСН
|
Положительно обратноя связью
по напряжению
|
|
ОПЗ
|
область пространственного
заряда
|
|
ЛК
|
локальный транзистор
|
|
ПДС
|
полное дифференциальное
сопротивление
|
Введение
В последние время все больше внимание уделяется исследованию
транзисторные структуры обычно содержат эмиттерный переход, площадь которого
существенно меньше площади коллекторного. Все процессы, протекающие в таких
структурах, изучены практически полностью. Но процессы происходящие в
транзисторных структурах в которых площадь эмиттерного перехода которых
превышает площадь коллекторного изучены не так хорошо. Исследования такого рода
ведутся на кафедре радиофизики и нанотехнологии Кубанского госуниверситета.
Отличительной особенностью структур с распределенным p+-n-переходом
(СРП), кроме распределенного эмиттерного перехода, является то, что
коллекторный переход выполнен в виде локального контакта
металл-туннельно-прозрачный окисел-полупроводник (МТОП), называемого активным
контактом (АК).
Транзисторные структуры, имеющие распределенный по всей площади кристалла
эмиттерный p+-n - переход (ТСРП), на n - области (база) которого
выполняется локальный контакт (активный контакт), представляют собой структуры
металл - туннельно - прозрачный - окисел - полупроводник (МТОП). Главная
характерная черта характеристик МТОП структур заключается в том, что начиная с
определенного напряжения на активном контакте (АК) по отношения к базе Uак
даже при "разомкнутом" эмиттерном переходе в этой структуре
появляются импульсные колебания тока через АК и пилообразные колебания
потенциала на p+ - области эмиттера. Исследования показали, что
возникновение этих колебаний является следствием одного из видов
рекомбинационной неустойчивости тока - поверхностно - барьерной неустойчивости
тока и характеризуется
В результате недавних исследований причин появления неустойчивоститока в
n - канальном МОП - транзисторе установили, что они также связаны с
перезарядкой ловушечных состояний. Структуры с АК, созданныевышеуказанным
путем, имеют высокую стабильность электрических и фотоэлектрических
характеристик, что дало возможность разработать на их базе стабильно работающие
не имеющие аналогов функциональные приборы.
Еще одним типом структур ТСРП являются БИСПИН - приборы.
Бисмещенный переход с инжекционной неустойчивостью - приборы являются
полупроводниковыми структурами с БИСмещенным переходом и инжекционной
неустойчивостью.
Бисмещенный переход с инжекционной неустойчивостью - приборы
преобразовывают аналоговый сигнал на входе в периодическую последовательность
импульсов тока или напряжения.
Рабочей средой этих приборов является полупроводниковая структура с
распределенным p+-nили n+-pпереходом. На
поверхности слаболегированной n- или
p+-области создают нелинейный Aи омический Bконтакты. Нелинейным контактом может служить также встроенный
локальный n+-p-nили p’-n-p-транзистор.
Для достижения поставленной цели решались следующие задачи:
. Изучить неравновесные электронные процессы в структурах различными
активными контактами (МТОП и БИСПИН).
2. Выявить особенности семейства ВАХ структуры с распределенным p+-n-переходом.
. Экспериментальное исследовать влияния режима распределенного p+-n-перехода
на вольт-амперные характеристики структур с распределенным p+-n-переходом
с АК МТОП и локальным n+-p-диодом.
. Выявить зависимость полного дифференциального сопротивления
структур с распределеннымp+-n-переходом от напряжения на активном
контакте.
В данной курсовой работе проведено исследование физических процессов
протекающих в транзисторных структурах с распределеннымp-nпереходом,
характеристик ВАХ этих структур и рассмотрены методы их расчета.
1. Литературный обзор
.1 Неравновесные электронные процессы в структурах металл - туннельно -
прозрачный - окисел - полупроводник
Возникновение неустойчивости тока (НТ) в структурах МТОП, а также
связанные с ней особенности их электрофизических и фотоэлектрических
характеристик в значительной мере обусловлены неравновесными электронными
процессами, протекающими в АК структуры.
Электронные квазистационарные процессы, приводящие к усилению тока, которое
играет важную роль в механизме возникновения НТ, впервые подробно рассмотрены в
работах [1, 2]. Как следует из результатов этих работ, при толщине диэлектрика
меньше некоторой критической (3,0-3,5 нм) резко возрастает экстракция
неосновных носителей из приповерхностной области полупроводника. Так как
скорость, с которой дырки поставляются к границе раздела, ограничена, с ростом
обратного смещения на металлическом электроде происходит обеднение ими
приповерхностного слоя. Поскольку интенсивность термической генерации
становится недостаточной для поддержания инверсионного слоя, концентрация дырок
падает ниже ее равновесного значения. В работе [3] также показано, что при
введении в приповерхностный слой дополнительных дырок, напряженность поля у
поверхности полупроводника может сильно возрасти. Авторы на основе анализа
процессов в структуре делают вывод, что усиление тока можно получить лишь на
тех образцах, у которых поверхность полупроводника в исходном состоянии
обогащена основными носителями. При увеличении обратного напряжения на
МТОП-контакте происходит последовательный переход его состояния от обогащения к
обеднению, а затем к неравновесному обеднению, поскольку ограниченная
интенсивность термической генерации не позволяет создать инверсионный слой на
поверхности полупроводника. При переходе от обогащения к обеднению все большая
часть напряжения приходится на диэлектрик. Поскольку сохраняется условие
равновесия на поверхности полупроводника, это приводит к смещению уровня Ферми
в металле к краю зоны проводимости. При инжекции неосновных носителей в
приповерхностную область полупроводника поле в диэлектрике увеличивается, и
уровень Ферми металла смещается выше края зоны проводимости, что приводит к
резкому увеличению электронного тока из металла, причем увеличение тока
основных носителей может значительно превышать инжекционный ток неосновных
носителей.
Аномально большой коэффициент передачи тока кремниевой транзисторной
структуры МТОП с плоскостным диффузионным или сплавным p+-n-переходом
в схеме с общей базой наблюдался также авторами работы [4]. Коэффициент
передачи тока a = DIa/DIp (Ia -
обратный ток активного контакта, Ip - прямой ток p+-n-перехода)
определялся по семейству статических ВАХ, снятых в режиме генератора тока как в
цепи обратно смещенного МТОП-контакта, так и в цепи p+-n-перехода.
Обнаружено, что с некоторого напряжения Ua на АК величина a превышает единицу. Причем было
установлено, что начало этого возрастания a происходит при напряжениях, соответствующих критическому
напряжению возникновения ПБНТ. Значения a, превышающие единицу, наблюдаются на тех контактах, на
которых в определенных условиях обнаруживается НТ.
Наблюдаемые закономерности находятся в хорошем согласии с моделью,
предложенной авторами работы. При небольших обратных напряжениях ток через
МТОП-контакт переносится в основном инжектированными из p+-n-перехода
дырками. Ввиду малой площади и небольшой эффективности контакта с ростом тока
инжекции происходит обогащение области полупроводника вблизи контакта
аккумулируемыми дырками. Это приводит к значительному снижению толщины барьера,
усилению поля в ОПЗ и даже при достаточно низких напряжениях на контакте
вызывает туннельную эмиссию электронов с ПС, контролирующих барьер, которая
из-за снижения высоты барьера приводит к резкому возрастанию тока
термоэлектронной эмиссии из металла. Для компенсации избыточного заряда
эмиттированных электронов из p+-области в базу вытягивается
значительное количество дырок, и она приобретает отрицательный потенциал.
Количество дырок, достаточное для «запуска» процесса туннельной эмиссии из ПС
контакта, приводящей к умножению носителей на нем, зависит от площади контакта
и достигается притем меньших токах Ip, чем меньше площадь контакта.
Таким образом, причины возникновения аномально больших значений a и, наблюдаемые при этом
закономерности, обнаруженные в структурах МТОП, становятся понятными на основе
модели, объясняющей умножение тока на контакте эмиссией электронов из металла,
которая «запускается» туннельной эмиссией с ПС.

Рисунок
1-Осциллограммы колебаний тока и напряжения: а - Осциллограммы колебаний тока
АК (а), б - напряжения на p+-области МТОП-структуры (б)
В
работе [5] подробно рассмотрены неравновесные электронные процессы,
определяющие обнаруженные экспериментально особенности ПБНТ в структурах МТОП.
При приложении к МТОП-контакту обратного напряжения дырки из n-области через
трапецевидный барьер окисла (Рисунок 3) туннелируют в металл, и дырочный
компонент тока через структуру вначале преобладает. Поскольку толщина базы
существенно меньше длины диффузии дырок (d<<Lp), процесс
экстракции захватывает всю область базы. Вдоль базы возникает отрицательный
градиент концентрации в направлении к МТОП-контакту. В результате нарушается
равновесный поток дырок из базы в p+-область и встречный поток из p+-области
оказывается неуравновешенным. Это вызывает появление в базе избыточного заряда
дырок, а p+-область приобретает равный по величине отрицательный
заряд. При большой концентрации дырок в приповерхностной области полупроводника
заряд в ПС компенсируется не ионизованными донорами, а дырками. В результате
ширина ОПЗ АК уменьшается, а поле в ней возрастает.
Наиболее
вероятным процессом, определяющим возрастание тока с увеличением напряжения,
приложенного к структуре, является туннельная эмиссия электронов из ПС в зону
проводимости через барьер ОПЗ. Этот процесс самоподдерживается возникающей
динамической положительной обратной связью по току. Действительно, эмиссия
электронов из ПС, контролирующих барьер в контакте, приводит к уменьшению его
высоты j и одновременному сужению ОПЗ, а, следовательно,
увеличению поля в ней, что еще сильнее стимулирует эмиссию и увеличение
проводимости приповерхностной области полупроводника.
Снижение
j приводит к увеличению тока термоэлектронной эмиссии
из металла. Это вызывает увеличение проводимости и сужение ОПЗ за счет
втягивания в приповерхностную область дырок, компенсирующих заряд электронов,
эмиттированных из металла. В результате идет опустошение ПС, спрямление зон
полупроводника и резкое возрастание тока в течение времени t1 (участок
1 осциллограммы колебаний тока, см. Рисунок 1). В итоге напряжение источника
распределяется по образцу и на сопротивлении внешней цепи. Поле в ОПЗ
уменьшается, и начинается рекомбинация и захват на ПС избыточных неравновесных
электронов (участок 2, см. Рисунок 1). Если скорость поступления дырок из p+-области
невелика, через время t2 захват
электронов на ПС начинает преобладать над рекомбинацией ток резко спадает за
время t3 (участок
3, см. Рисунок 1). Причем спад тока поддерживается возникающей динамической
положительной обратной связью по напряжению (ПОСН). Действительно, захват
электронов на ПС вызывает уменьшение проводимости приповерхностной области
полупроводника, при этом происходящее в результате заполнения ПС восстановление
барьера приводит к расширению ОПЗ, уменьшению в ней поля и, кроме того, резкому
ограничению термоэлектронного тока из металла. Все это поддерживает уменьшение
проводимости приповерхностной области полупроводника и тем самым создает ПОСН.
После
заполнения ПС до начального квазиравновесного значения напряженность поля в ОПЗ
остается еще ниже критического значения до тех пор, пока концентрация дырок в
приповерхностной области полупроводника не достигнет значения, соответствующего
началу туннельной эмиссии электронов из ПС. При этом напряженность поля в ОПЗ
вновь достигает критического значения и через промежуток времени t4 после
окончания спада тока через структуру процессы повторяются.
Предложенная
в работах [6, 7, 8-10] модель возникновения ПБНТ лишь в общих чертах объясняет
физические процессы, связанные с токопереносом через структуры МТОП. Так,
наличие большого начального тока через МТОП-контакт (превышающего 0,1 мА), как
показали проведенные нами исследования, не оказывает существенного влияния
непосредственно на процесс накопления дырок вблизи него. Однако его протекание
по распределенному сопротивлению n-области вдоль границы n- и p+-областей
должно приводить к изменению высоты потенциального барьера в различных частях
распределенного p+-n-перехода, что не может не влиять на величину
потока дырок из p+-области, а значит и на процесс их накопления.
Возможность такого влияния отмечается в работах [11, 12], но детального его
исследования не проводилось.
В
соответствии с рассмотренной моделью при увеличении обратного смещения
МТОП-контакта время накопления дырок до критической концентрации, а значит и
период колебаний, должно уменьшаться. Однако в работе [13] отмечается
увеличение периода колебаний. Таким образом, из приведенного анализа работ,
посвященных исследованиям неравновесных электронных процессов в структурах
МТОП, видно, что механизм накопления неосновных носителей в этих структурах еще
не достаточно изучен и требует более детальных исследований
.2 Семейства ВАХ структуры с распределенным p+-n-переходом
и активным МТОП-контактом
Для выяснения роли распределенного p+-n-перехода в механизме
возникновения НТ в структурах с АК различных типов нами впервые были проведены
исследования зависимости вида ВАХ МТОП- и БИСПИН-структур от режима p+-n-перехода,
а для МТОП-структуры и от величины распределенного сопротивления n-области rб’.
ВАХ структур с АК обоих типов исследовались в режиме генератора тока в цепи АК
на установке, изображенной на Рисунок 6, по методике, описанной в 2.2, а
распределенные сопротивления на той же установке по методике, описанной в 2.4.
При исследовании ВАХ МТОП-структуры использовался образец с омическими
контактами, расположенными на разном расстоянии от АК.
На Рисунок 2-4 приведены типичные семейства ВАХ МТОП-структуры с
распределенным сопротивлением базы rб’ между АК и омическими
контактами 2,36, 3,58, 4,75 кОм, снятые при следующих режимах распределенного p+-n-перехода:
1) на p+-n-переходе задавалось обратное смещение (U = 5 В), (режим
отсечки); 2) на p+-n-переход не подавалось смещение (режим
"оборванной" p+-области); 3) режим задавался перемыканием
p+-n-перехода резисторомRp-n= 100 кОм и Rp-n=
20 кОм; 4) режим задавался освещением n-области инфракрасным излучением
мощностью 0,5 мВт.
Как видим из Рисунок 2, а в режиме отсечки НТ не возникает. При Uа>
7 В наблюдается слабая зависимость вида ВАХ от распределенного сопротивления
базы.
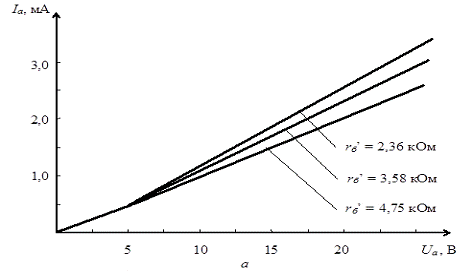
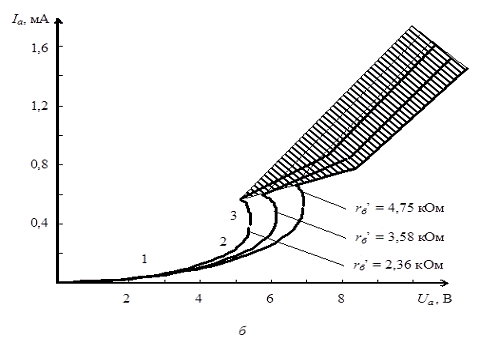
Рисунок 2-Типичные семейства ВАХ МТОП-структур с различными
распределенными сопротивлениями базы в режиме отсечки (а) и в режиме
«оборванной» p+-области (б)
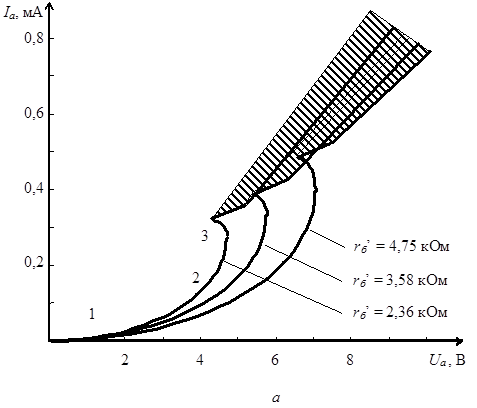
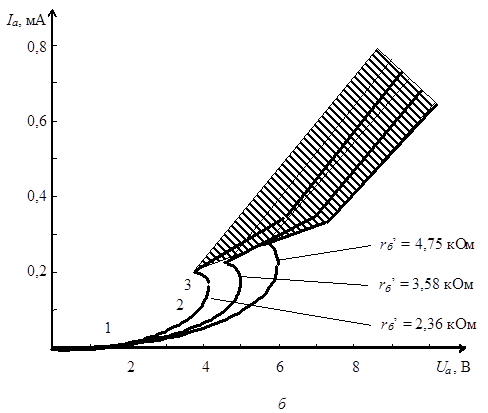
Рисунок 3-Типичные семейства ВАХ МТОП-структур с различными
распределенными сопротивлениями базы при Rp-n = 100 кОм (а) и Rp-n
= 20 кОм (б)

Рисунок
4 - Типичные семейства ВАХ МТОП-структур с различными распределенными
сопротивлениями базы при подсветке n-области (P = 1 мВт)
В
режиме «оборванной» p+-области (Рисунок 2, б) участок 1 ВАХ,
соответствующий Uа < 5 В, не зависит от rб’. На
следующих участках кривые имеют различие - с ростом rб’
дифференциальное сопротивление на участке 2 увеличивается. На участке 3
наблюдается отрицательное сопротивление (ОС), что свидетельствует о наличии
ПОСТ [14]. Критическое напряжение возникновения участка ОСUкр
незначительно увеличивается с ростом rб’. После появления участка ОС
возникает НТ (характерное размытие на ВАХ, показанное штриховкой).
Включение
перемыкающего сопротивления Rp-n приводит к изменению вида ВАХ и
характера его зависимости от rб’ по сравнению с режимом «оборванной»
p+-области. Как видно из Рисунок 3, участок 1, соответствующий Uа
< 3 В, для всех значений rб’ приблизительно одинаков. На
следующих участках кривые различаются - с ростом rб’
дифференциальное сопротивление на участке 2 уменьшается, абсолютное значение ОС
на участке 3 увеличивается, а напряжение Uкр заметно уменьшается,
тогда как в режиме «оборванной» p+-области оно незначительно увеличивается.
Причем значение тока, соответствующее этому напряжению, уменьшается с ростом rб’.
Кроме того, при Rp-n = 20 кОм Uкр меньше, а абсолютное
значение ОС больше, чем при Rp-n = 100 кОм и тем более чем в режиме
«оборванной» p+-области. После появления участка ОС также возникает
НТ.
ВАХ
МТОП-структуры, снятые при освещении образца, по своему виду сходны с ВАХ,
снятыми при перемыкающем сопротивлении, однако влияние rб’ их вид
аналогично случаю «оборванной» p+-области. Из Рисунок 4 видно, что
также как и в режиме «оборванной» p+-области, Uкр
увеличивается с увеличениемrб’, а соответствующее ему значение тока
не изменяется. Однако величина этого напряжения существенно меньше, чем в
режиме «оборванной» p+-области. ОС имеет абсолютное значение такое
же, как и в режиме «оборванной» p+-области.
Рассмотрим,
используя энергетическую диаграмму (см.Рисунок 3), а также низкочастотную
эквивалентную схему структуры с распределенным p+-n-переходом,
возможные физические процессы, определяющие обнаруженные особенности ВАХ
МТОП-структуры.
Отсутствие
НТ в режиме отсечки хорошо согласуется с моделью физических процессов в
МТОП-структуре, в соответствии с которой НТ возникает при достижении
концентрацией дырок в ОПЗ АК за счет накопления некоторого критического
значения psк. Однако в режиме отсечки возросший потенциальный
барьер, обратносмещенногоp+-n-перехода, препятствует поступлению
дырок из p+-области. Тепловая же генерация дырок в базе и ОПЗ АК не
в состоянии обеспечить их накопление до критической концентрации. Это легко
показать, если учесть, что в режиме отсечки дырочный ток АК, обусловленный
тепловой генерацией носителей вего ОПЗ,
ip= Senil/2tp, (1)
где S » 10-3
cм2 - площадь АК; e - элементарный заряд; i= 1,6 ∙
1010 см-3 - собственная концентрация носителей;- ширина
ОПЗ,
tp» 10-5
c - время жизни дырок в базе)
ip= 1/4epsvpDpS, (2)
где ps - концентрация дырок в ОПЗ АК;p - тепловая
скорость дырок равная при комнатной температуре 7,5 ∙ 106
см/с; p - коэффициент прозрачности окисла для дырок, величина
которого при толщине окисла 2-2,5 нм по расчетам составляет 10-8-10-7.
Величину l можно рассчитать по известному соотношению
 , (3)
, (3)
где j0= 0,3-0,4 эВ - высота барьера
МТОП-контакта. Учитывая, что Nd =1/emnrn = 1,7 ∙ 1015 см-3 дляUа
= 5 В, имеем l = 2 мкм. Подставляя в (2) вычисленное по формуле (1) значение
дырочного тока АК, можно найти величину ps.
Критическая концентрация psк связана c критической
напряженностью поля Eк в ОПЗ АК, при которой начинается туннельная
эмиссия электронов из ПС и соответствующей этой напряженности шириной lк
ОПЗ АК. Учитывая, чтоEк = Uа/ lк из выражения
(1.3), получим:
 . (4)
. (4)
Величина Eк, соответствующая началу приводящей к развитию НТ
туннельной эмиссии электронов из ПС с глубиной залегания 0,3-0,4 эВ по данным
[15] лежит в пределах 3 ∙ 105- 7 ∙ 105 В/см.
Вычислим критическую концентрацию psк при предельно допустимом
напряжении на структуре Uа= 30 В и сравним ее с реальной
концентрацией дырок ps в ОПЗ АК при этом же напряжении. Расчет по
формулам (1.1-1.4) дает psк= 4 ∙ 1016 -2 ∙ 1017
см-3 и ps = 1011-1012 см-3.
Как видим, реальное значение концентрации дырок примерно на пять порядков
меньше критического значения, что явно свидетельствует о невозможности
возникновения НТ в режиме отсечки.
Переход от режима отсечки к режиму «оборванной» p+-области
приводит к возникновению НТ. Из этого однозначно следует, что в накоплении
дырок существенную роль начинает играть их поступление из p+-области,
поскольку, как показано выше, тепловая генерация дырок не обеспечивает
критической концентрации. Рассмотрение механизма накопления с точки зрения
модели [14], позволяет непротиворечиво объяснить как появление участка ОС на
ВАХ, так и возникновение НТ. Однако объяснить зависимость вида ВАХ от
распределенного сопротивления базыrб’ и, особенно, различный
характер этой зависимости при различных режимах распределенного p+-n-перехода
при помощи этой модели не представляется возможным. На наш взгляд, это связано
с тем, что в этой модели не учитывается влияние протекания начального тока АК
по rб’ вдоль распределенного p+-n-перехода, на высоту его
барьера.
Рассмотрим механизм этого влияния при «оборванной» p+-области.
Начальный ток АК Iа, протекая по распределенному сопротивлению базы
rб’ вдоль границы n- и p+-областей, создает падение
напряжения наrб’, что приводит к зависимости потенциала n-области от
координаты. Поскольку p+-область можно считать эквипотенциальной
поверхностью, смещение распределенного p+-n-перехода также зависит
от координаты. Допустим, что в начальный момент потенциал p+-области
равен потенциалу локального участка базы вблизи АК (точка D на эквивалентной
схеме). Тогда смещение p+-n-перехода окажется обратным, а его
величина будет изменяться от нуля вблизи АК до значения, равного Iа rб’
вблизи омического контакта. Обратное смещение p+-n-перехода вызовет
экстракцию дырок из базы в p+-область, что приведет к появлению в
ней положительного заряда дырок. А поскольку p+-область «оборвана»,
ее потенциал станет больше потенциала точки D. В результатеnвозникнет прямое смещение p+-n-перехода
под АК, которое будет увеличиваться до тех пор, пока величина прямого тока Iпрp+-n-перехода
под АК не станет равной величине обратного тока Iобр в остальной его
части. Таким образом, распределенный p+-n-переход будет находиться в
двух пространственно разделенных состояниях с противоположными уровнями
смещения. Такое состояние p+-n-перехода так же, как и в работе [15],
будем называть бисмещенным.
Существование бисмещенного состояния подтверждается сравнением разности
потенциалов Up-n между p+-областью и выводом базы с
падением напряжения Iаrб’ на распределенном сопротивлении
базы (Таблица. 1).
Таблица 1 Сравнение разности потенциалов Up-nс падением
напряжения Iаrб’

Сравнение показывает, что при любых значениях начального тока АК Iа
и сопротивлениях базы rб’ Up-n <Iаrб’,
то есть потенциал p+-области остается больше потенциала точки D, а
значит имеет место бисмещенное состояние.
1.3 Вольт-амперные характеристики БИСПИН-структуры
Исследования ВАХ БИСПИН-структур проводились для образцов двух партий,
изготовленных по технологии, описанной в гл. 2, и отличающихся толщиной
локального участка n-области структуры dnл между АК и распределенным
p+-n-переходом.
На Рисунок 5-7 приведены ВАХ БИСПИН-структур обеих партий, снятые в
режиме генератора тока в цепи АК по методике, описанной в гл. 2, при следующих
режимах распределенного p+-n-перехода: 1) на p+-n-переход
не подавалось смещение от внешних источников (режим «оборванной» p+-области);
2) режим задавался перемыкающими сопротивлениямиRp-n= 100 кОм и Rp-n=
20 кОм; 3) режим задавался освещением n-области инфракрасным излучением при
мощности излучения 0,2 и 1 мВт.

Рисунок
5-Типичная ВАХ БИСПИН-структуры 1-й и 2-й партии при отсутствии подсветки
n-области, а также 2-й партии при перемыкании p+-n-перехода
Проанализируем
приведенные ВАХ. Как видно изРисунок5, в режиме «оборванной» p+-области
ВАХ БИСПИН-структур обеих партий имеют одинаковый вид. На участке 1 очень
малому (0,1 мкА) значению тока соответствует значительное (0-23 В) изменение
напряжения на структуре.

Рисунок
6-Типичная ВАХ БИСПИН-структуры первой партии при перемыкании распределенного p+-n-перехода
(Rp-n = 20 кОм иRp-n = 200 кОм)
На
участке 2 наблюдается ОС. На участке 3 при значительном (12-330 мкА) изменении
тока напряжение практически постоянно. При отсутствии освещения n-области в
режиме «оборванной» p+-области НТ в БИСПИН-структуре не возникает.
Включение перемыкающего резистора приводит к уменьшению критического напряжения
Uос возникновения участка ОС и возникновению НТ (характерное
размытие на ВАХ, показанное штриховкой) в образцах 1-й партии при напряжении на
АК Uа >Uк = 9 В. Уменьшение Rp-nприводит к
исчезновению участка ОС, однако величина Uк не изменяется. На вид
ВАХ образцов 2-й партии включение Rp-n не влияет. При освещении
n-области в образцах обеих партий возникает НТ при Uк = 1 В, причем
также как и в режиме «оборванной» p+-области ВАХ, имеют одинаковый
вид. Увеличение интенсивности света приводит к исчезновению участка ОС.
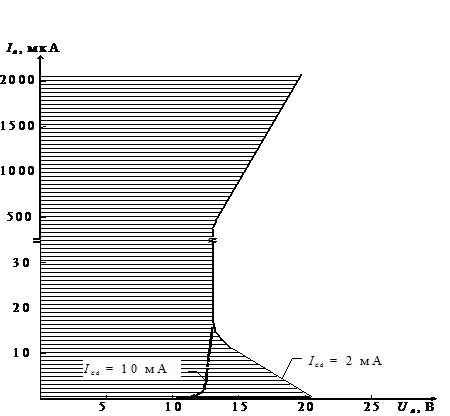
Рисунок
7-Типичные ВАХ БИСПИН-структур 1-й и 2-й партий при подсветке n области при
токе светодиода Iсв = 2 мА и Iсв = 10 мА
металл транзисторный полупроводник амперный
2.
Экспериментальная часть
2.1
Исследование влияния распределенного p+-n-перехода на параметры
колебаний в структурах с распределенным p+-n-переходом
Колебания, возникающие в СРП, являются разрывными и для их возникновения
кроме положительной обратной связи необходимо наличие в системе быстрых и
медленных процессов, способных быстро выводить систему из равновесия и медленно
возвращать. Для МТОП-структуры быстрыми процессами являются установление
прозрачности барьера за время t1 и
восстановление барьера за время t3.
Медленными процессами являются рекомбинация неравновесных носителей за время t2 и накопление дырок в ОПЗ АК за время t4. Процесс накопления связан с экстракцией дырок
активным контактом из базы и p+-области, кроме того, накопление
также может быть обусловлено инжекцией дырок из p+-области, т.е.
распределенный p+-n-переход играет важную роль в процессе
накопления. Однако динамика накопления дырок за счет инжекции ранее не
исследовалась.
В БИСПИН-структуре также имеют место быстрые и медленные процессы. Однако
их механизм однозначно не выяснен. Так, в работе [16] отмечается, что эти
процессы полностью аналогичны процессам в МТОП-структуре. В работах [17]
быстрые процессы связываются с зарядкой барьерной емкости распределенногоp+-n-перехода,
а медленные - с рекомбинацией накопленных в базе в результате инжекции из p+-области
дырок и разрядкой барьерной емкости распределенного p+-n-перехода.
Из анализа работ, посвященных исследованию электрофизических характеристик
МТОП- и БИСПИН-структур, можно сделать вывод, что распределенный p+-n-переход
должен оказывать существенное влияние на параметры колебаний в этих структурах.
Для выяснения механизма влияния распределенного p+-n-перехода
на параметры колебаний в СРП были проведены исследования осциллограмм колебаний
тока, протекающего через структуру, и колебаний напряжения на p+-области
при различных режимах p+-n-перехода.
На Рисунок 8 приведены типичные осциллограммы колебаний тока АК (а),
колебаний напряжения на p+-области МТОП-структуры при токе через p+-n-переход,
Ip = 50 мкА (б) и перемыкающем резисторе Rp-n = 20 кОм
(в). Началу координат на осциллограммах соответствует момент подачи напряжения
на АК и тока Ip-n. Снятые аналогичным образом осциллограммы для
БИСПИН-структуры приведены на Рисунок 9.
Рисунок
8 - Осциллограммы колебаний: а - тока АК МТОП-структуры; б - напряжения на p+-области
при токе через p+-n-переход Ip = 50 мкА; в - перемыкающем
сопротивлении Rp-n= 20 кОм

Рисунок
9-Осциллограммы колебаний: а - тока АК БИСПИН-структуры; б - напряжения на p+-области
при токе через p+-n-переход Ip = 50 мкА; в - перемыкающем
сопротивлении Rp-n= 20 кОм (только для 1-й партии при Uпит
= 10 В)
Анализ
осциллограмм позволяет выделить следующие характерные участки: 1 -
незначительное увеличение тока АК при почти неизменном напряжении на p+-области
в течение времени t0; 2 -
резкое возрастание тока через АК при резком увеличении отрицательного
напряжения на p+-области за время t1; 3 - быстрый спад тока за время t2.1; 4 -
медленное уменьшение тока за время t2.2 при почти неизменном напряжении на p+-области;
5 - быстрый спад тока за время t3 при резком уменьшении отрицательного напряжения на p+-области;
6 - сохранение квазистационарного значения тока при плавном уменьшении
отрицательного напряжения на p+-области за время t4.1; 7 -
незначительное увеличение тока АК за время t4.2 при почти неизменном напряжении на p+-области.
Измерения показали, что форма колебаний напряжения на p+-областизависит
от способа задания режима p+-n-перехода. Так, при задании режима
генератором тока зависимость напряжения на p+-области от времени на
участке 6 близка к квадратичной, тогда как при задании режима перемыкающим
сопротивлением - зависимость имеет явно выраженный экспоненциальный характер.
Исследование
зависимости параметров колебаний от напряжения Ua на АК показало,
что длительность импульса t2 = = t2.1 + t2.2, переднего t1 и заднего t3 фронтов, а также время задержки начала колебаний t0 от
момента подачи напряжения на АК для БИСПИН-структуры от напряжения на АК
практически не зависят. Тогда как длительность паузы между импульсами t4 = = t4.1+ t4.2 и
время задержки t0 для
МТОП-структуры зависят от напряжения на АК. Причем на характер этих
зависимостей влияет режим p+-n-перехода. Кроме того, в случае
БИСПИН-структуры, он различен для образцов разных партий.
На
Рисунок 10-14 приведены зависимости t0 (Ua) и t4 (Ua), а также t4.1 (Ua)
и t4.2 (Ua),
снятые для МТОП-структуры при режимах распределенного p+-n-перехода,
задаваемых перемыкающим резистором (Rp-n= 20 кОм и Rp-n =
200 кОм) и генератором тока (Ip = 5 мкА и Ip = 50 мкА).
Включение генератора тока осуществлялось одновременно с подачей напряжения на
АК.

Рисунок
10 - Зависимости временных интервалов τ0, τ4, τ4.1, τ4.2 в
структурах МТОП от напряжения на АК Ua при Rp-n = 20 кОм

Рисунок
11-Зависимости временных интервалов t0 , t4 , t4.1 , t4.2 в структурах МТОП от напряжения на АК Ua
при Rp-n = 200 кОм

Рисунок
12-Зависимости временных интервалов t0 , t4 , t4.1 , t4.2 в структурах МТОП от напряжения на АК Ua
при Ip = 50 мкА

Рисунок
13-Зависимости временных интервалов t0 , t4 , t4.1 , t4.2 в структурах МТОП от напряжения на АК Ua
при Ip = 5 мкА
При
таких же режимах были сняты зависимости t4 (Ua) для образцов БИСПИН-структуры 1-й
партии (Рисунок 14).

Рисунок
14-Зависимость длительности паузы между импульсами t4в
структурах БИСПИН первой партии от напряжения на АК Uaпри различных
режимах p+-n-перехода
При
снятии зависимостей t4(Ua)
для образцов 2-й партии использовался только 2-й режим (Рисунок 15), поскольку,
как было показано в 3.2, без подсветки или подачи тока через p+-n-переход
НТ в таких образцах не возникает.

Рисунок
15-Зависимость длительности паузы между импульсами t4в
структурах БИСПИН второй партии от напряжения на АК Uaпри различных
режимах p+-n-перехода
Из
рисунков видно, что при задании режима p+-n-перехода МТОП-структуры
перемыкающим резистором все перечисленные временные величины монотонно убывают
с ростом Ua. При задании режима генератором тока t0 и t4.2
практически не зависят от Ua, а t4.1 и t4 при Ip = 50 мкА монотонно возрастают, а
при Ip = 5 мкА вначале возрастают, а при Ua> 9 В -
убывают. Причем при обоих режимах p+-n-перехода кривые t0(Ua)
и t4.2(Ua)
совпадают, а t4.2< t4.1. В
случае БИСПИН-структуры при задании режима p+-n-перехода генератором
тока длительность паузы между импульсами t4 при любом значении Ip для образцов 2-й
партии с ростомUa монотонно возрастает, а для образцов 1-й партии -
вначале возрастает, а при Ua > 9 В убывает. При задании режима
перемыкающим резистором для образцов 1-й партии величина t4
монотонно убывает с ростом Ua.
Рассмотрим
возможные физические процессы, определяющие особенности обнаруженных
зависимостей. Для этого обратимся к модели механизма возникновения НТ в
структурах МТОП и БИСПИН, созданной на основе анализа низкочастотной
эквивалентной схемы структур (см. Рисунок 16) с учетом взаимной связи
процессов, протекающих в активном контакте и распределенном p+-n-переходе.
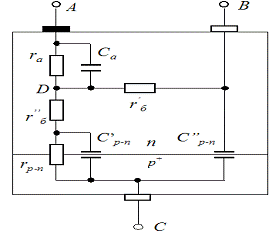
Рисунок
16 - Обобщенная эквивалентная схема структуры с распределеннымp+-n-переходом
В
момент подачи напряжения на АК МТОП-структуры падение напряжения на
распределенном сопротивлении базы, вызванное протеканием начального тока АК Ia0
приводит к возникновению описанного выше бисмещенного состояния распределенного
p+-n-перехода. Ток Ip через p+-n-переход
увеличивает смещение его прямосмещенной части, что вызывает локальную инжекцию
дырок из p+-области в расположенную под АК часть базы и их
накопление в ней, а также и в ОПЗ АК, поскольку толщина базы много меньше
диффузионной длины дырок. Время перераспределения заряда и накопления дырок до
концентрации, необходимой для развития НТ, соответствует промежутку t0 от
момента включения питания до начала первого импульса тока через АК (участок 1
осциллограммы). Накопление дырок приводит к увеличению проводимости ОПЗ АК и
плавному росту тока через него.
По
мере накопления дырок в ОПЗ АК, их концентрация достигает значения,
достаточного для возникновения усиления тока, приводящего к увеличению
электронной составляющей тока АК. Это вызывает увеличение падения напряжения на
распределенном сопротивлении базы, т. е. рост отрицательного значения
потенциала точки D (см. Рисунок 16). В результате под АК понижается
потенциальный барьер p+-n-перехода, что приводит к увеличению потока
дырок из p+-области в базу. Вследствие этого отрицательный заряд
акцепторов в p+-области оказывается нескомпенсированным, и ее
потенциал приобретает более отрицательное по сравнению с начальным состоянием
значениеЭто вызывает увеличение смещения обратносмещенной части p+-n-перехода,
что приводит к изменению ее барьерной емкости C”p-n. Ток перезарядки
емкости C”p-n, протекая через прямосмещенную часть p+-n-перехода,
увеличивает инжекцию дырок, что еще сильнее стимулирует туннельную эмиссию и
вызывает еще более быстрое нарастание тока через АК (участок 1 осциллограммы
колебаний тока, см. Рисунок 17), т. е. возникает ПОСТ.
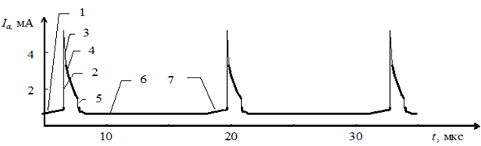
Рисунок
17 - Осциллограммы колебанийтока АК МТОП-структуры
Первый
этап процесса развития НТ в БИСПИН-структуре протекает иначе. Поскольку
начальный ток ЛТ очень мал и не вызывает бисмещенное состояние распределенного
p+-n-перехода, в момент одновременной подачи напряжения на АК и тока
через p+-n-переход возникает прямое смещение на всем p+-n-переходе
и инжекция дырок из p+-области в базу. При этом часть дырок попадает
в коллекторную область ЛТ, экстрагируется в его p-базу и накапливаются в ней.
Это приводит к понижению барьера эмиттерного n+-p-перехода и
инжекции электронов из эмиттера в p-базу, после пролета которой они оказываются
в n-области структуры. Благодаря этому возникает электронный ток, протекающий
по n-области вдоль распределенного p+-n-перехода к омическому
контакту. Величина этого тока в bл раз больше тока дырок (bл - коэффициент передачи тока ЛТ): Iа = bлIp.
Возникшее
в следствие этого падение напряжения на распределенном сопротивлении базы
приводит к снижению потенциала точки D (см. Рисунок 16). Поскольку потенциал p+-области
вследствие ее высокой проводимости можно считать независящим от координаты, то
смещение на распределенном p+-n-переходе в направлении вдоль него
изменяется. Прямое смещение этого перехода под АК увеличивается, а в остальной
его части сначала уменьшается и затем становится обратным, т. е. возникает
бисмещенное состояние p+-n-перехода. В результате понижается
потенциальный барьер, расположенной под АК, части p+-n-перехода, что
приводит к увеличению потока дырок из p+-области в n-базу, а значит
и в p-базу ЛТ. Величина протекающего через него тока при этом растет, а поскольку
из-за наличия барьерной емкости p+-n-перехода потенциал p+-области
изменяется медленнее, чем потенциал точки D, это вызывает еще больший перекос в
смещении p+-n-перехода. Вследствие возникающей положительной
обратной связи, процесс развивается лавинообразно и приводит транзистор в
насыщение. Время перераспределения заряда и накопления дырок в p-базе до
концентрации, необходимой для развития лавинообразного процесса, соответствует
промежутку t0 от
момента включения питания до начала первого импульса тока через АК (участок 1
осциллограммы). Накопление дырок в p-базе приводит к увеличению проводимости ЛТ
и плавному росту тока через него, что подтверждается осциллограммой на Рисунок
17.
Таблица
2 Рассчитанные и полученные экспериментально значения длительности паузы между
импульсами
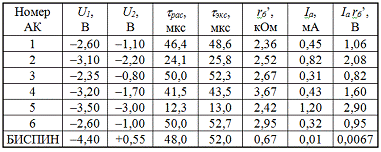
Как
следует из результатов исследований, рассмотренных в настоящей главе, при
анализе неравновесных электронных процессов в структурах с распределенным p+-n-переходом
с обоими типами активных контактов необходимо учитывать взаимное влияние
процессов, протекающих в активном контакте и распределенном p+-n-переходе.
Анализ
этих процессов, проведенный на основе экспериментальных данных, свидетельствует
о необходимости учета влияния протекания начального тока АК вдоль
распределенного p+-n-перехода на высоту его барьера, вследствие
которого p+-n-переход может находиться в двух пространственно
разделенных состояниях с противоположными уровнями смещения (бисмещенным
состояние).
Бисмещенное
состояние приводит к локальной инжекции дырок из p+-области в базу и
их накопление вблизи АК. Это подтверждается исследованием полного
дифференциального сопротивления структур с распределенным p+-n-переходом.
Анализ зависимости дифференциальной емкости от напряжения на АК МТОП-структуры
показал, что концентрация дырок в ОПЗ АК может значительно превышать
концентрацию доноров. Накопление дырок в базе БИСПИН-структуры незначительно и
начинает оказывать заметное влияние только при достаточно большом уровне
локальной инжекции. Дополнительным механизмом возрастания дифференциальной
емкости является эффект динамического умножения емкости.
Накопление
дырок в базе структуры с распределенным p+-n-переходом в условиях
отклонения от квазиравновесия приводит к возникновению положительной обратной
связи по току. Исследование механизмов этой связи показало, что существует два
механизма ПОСТ: первый обусловлен физическими процессами в АК, второй -
изменением уровня инжекции дырок из p+-области за счет изменения
тока АК, протекающего по распределенному сопротивлению базы при наличии
умножения тока на АК. Причем в БИСПИН-структуре второй механизм является
преобладающим.
Наличие
ПОСТ приводит к возникновению неустойчивости тока, а процесс изменения
барьерной емкости распределенного p+-n-перехода при протекании тока
по распределенному сопротивлению базы способствует ее значительному усилению. В
отличие от МТОП-структуры, резкое возрастание тока через АК БИСПИН-структуры в
процессе развития НТ связано не с его туннельным пробоем, а с лавинообразным
открыванием ЛТ, обусловленным действием ПОСТ.
Длительность
t4 паузы
между импульсами, определяющая период колебаний, и связанная с процессом
накопления дырок в базе после эмиссии электронов из АК, может быть определена
по времени изменения барьерной емкости p+-n-перехода.
2.2 Зависимость полного дифференциального сопротивления
структур с распределенным p+-n-переходом от напряжения на активном
контакте
Для выяснения возможности накопления в ОПЗ дырок проводилось исследование
полного дифференциального сопротивления (ПДС). ПДС структур с обоими типами АК
измерялась мостовым методом, описанным в гл. 2. Измерения проводились при
различных режимах p+-n-перехода и частоте зондирующего переменного
напряжения f0 = 4,5 кГц.
На Рисунок 18, 19 приведены зависимости дифференциальной емкости Cд
(C-V-характеристики) и активной составляющей rд ПДС МТОП- и
БИСПИН-структур от обратного напряжения на АК Uа, снятые: 1) в
режиме «оборванной» p+-области и 2) при перемыкании распределенного
p+-n-перехода сопротивлением Rp-n = 100 кОм.
Проанализируем приведенные зависимости. Как видно из Рисунок 21,
зависимости дифференциальной емкости Cд и дифференциального
сопротивления rд МТОП-структуры имеют четыре характерных участка: 1
- емкость Cд и сопротивление rд убывают с ростом Uа,
2 - емкость Cд незначительно возрастает с ростом Uа, а
убывание rд несколько замедляется, 3 - емкостьCд и
сопротивление rдостаются постоянными, 4 - емкость Cд
уменьшается до нуля, а сопротивление rд резко возрастает. Дальнейшее
увеличение напряжения (на рисунке не показано) приводит к тому, что реактивная
составляющая ПДС структуры изменяет свой характер с емкостного на индуктивный,
и при некотором значении Uа возникает НТ.

Рисунок
18 - Зависимости дифференциальной емкости Cди дифференциального
сопротивления rд структур МТОП от напряжения на АК Ua без
подсветки n-области при различных режимах p+-n-перехода
При
включении перемыкающего сопротивления Rp-n наблюдается более быстрый
рост емкости на участке 2, увеличение емкости и уменьшение сопротивления на
участке 3, а также сдвиг влево участков 3 и 4.

Рисунок
19 -Зависимости дифференциальной емкости Cди дифференциального
сопротивления rд структур БИСПИН от напряжения на АК Ua
без подсветки n-области при различных режимах p+-n-перехода
Из
Рисунок 19 видно, что зависимости дифференциальной емкости Cди
дифференциального сопротивления rд БИСПИН-структуры существенно
отличаются от аналогичных зависимостей для МТОП-структуры. Так на C-V-характеристиках
БИСПИН-структуры отсутствует участок, на котором емкость Cд
постоянна, на начальном участке характеристики емкость уменьшается значительно
медленней, а протяженность этого участка значительно больше по сравнению с
аналогичным участком C-V-характеристики МТОП-структуры, а вид участка, на
котором наблюдается рост емкости для образцов 2-й партии, не зависит от
перемыкающего сопротивления.
Для
образцов 1-й партии характерно резкое увеличение емкости при величине
напряжения, превышающей некоторое значение, совпадающее с напряжением смыкания
Uсм ОПЗ коллекторного перехода ЛТ и p+-n-перехода. Причем
включение перемыкающего сопротивления приводит к еще более резкому возрастанию
емкости, однако протяженность этого участка значительно уменьшается, и в конце
его возникает НТ.
Заключение
В
ходе проведенного исследования особенностей электрофизических характеристик
транзисторных структур с распределенным p+-n-переходом с различными
активными контактами и выяснения роли распределенного p+-n-перехода
в неравновесных процессах, протекающих в этих структурах, были получены
результаты. Основные выводы по результатам исследований можно сформулировать
следующим образом.
Проведенный
анализ вольт-амперных характеристик транзисторных структур с распределенным р+-n-переходом
и активными контактами двух типов (в виде МТОП и в виде локального n+-p-диода)
показывает, что их особенности во многом обусловлены взаимным влиянием
процессов, протекающих в активном контакте и распределенном p+-n-переходе,
а для объяснения возникновения неустойчивости тока необходимо учитывать влияние
протекания начального тока активного контакта вдоль распределенного p+-n-перехода
на высоту его барьера. Установлено, что распределенный p+-n-переход
находится в двух пространственно разделенных состояниях с противоположными
уровнями смещения (бисмещенное состояние).
Проведенный
анализ вольт-амперных характеристик транзисторных структур с распределенным р+-n-переходом
и активными контактами (АК) двух типов (в виде МТОП и в виде локального n+-p-диода)
показывает, что их особенности во многом обусловлены взаимным влиянием
процессов, протекающих в АК и распределенном p+-n-переходе, а для
объяснения возникновения неустойчивого тока необходимо учитывать влияние
протекания начального тока АК вдоль распределенного p+-n-перехода на
высоту его барьера. Установлено, что распределенный p+-n-переход
находится в двух пространственно разделенных состояниях с противоположными
уровнями смещения (бисмещенное состояние). А также исследована зависимость
дифференциальной полной проводимости структур МТОП и БИСПИН от напряжения на АК
при различных режимах распределенного p+-n-перехода.
металл транзисторный полупроводник амперный
Список
использованных источников
1 Барышев М.Г. Фотоэффект в эпитаксиальной p+-n-структуре
с n-областью переменной толщины и контактом туннельный окисел-металл / М.Г.
Барышев, Б.С. Муравский, И.Л. Яманов // ФТП. 1995. Т. 29. № 1. С. 91-95.
2 Барышев М.Г. Исследования электрофизических
характеристик органических полупроводниковых пленок / М.Г. Барышев, Г.П.
Ильченко, И.В. Сидоров // Известия высших учебных заведений. Физика. 2007. № 6.
С.80-83.
Константинов О.В. Условия существования медленных и
быстрых рекомбинационных волн в полупроводниках / О.В. Константинов, В.И.
Перель, Г.В. Царенков // ФТП. 1976. Т. 10, вып. 8. С. 1576-1578.
Косман М.С. Возникновение колебаний тока в кремнии
при высоких импульсных напряжениях / М.С. Косман, Б.С Муравский // Физика
твердого тела. 1961. Т. 3, № 11. С. 2504-2506.
Латышева А.П. Электрический транспорт в структурах с
кремниевыми нанокристаллами / А.П. Латышева, А.С. Гаврилюк // Сборник тезисов
международной конференции студентов, аспирантов и молодых ученых по
фундаментальным наукам «Ломоносов-2006», МГУ, 14 апреля 2006. М., 2006.
Муравский Б.С. и др. Исследование кинетики
поверхностно-барьерной неустойчивости тока / Б.С. Муравский, В.Г. Долуденко//
Физика и техника полупроводников. 1972. Т. 6, № 11. C. 2114-2122.
Барышев М.Г. Исследования электрофизических
характеристик органических полупроводниковых пленок /М.Г. Барышев,
Г.П.Ильченко, И.В. Сидоров // Известия высших учебных заведений. Физика. 2007.
№ 6. С.80-83.
Барышев М.Г.Фотоэффект в эпитаксиальной p+-n-структуре
с n-областью переменной толщины и контактом туннельный окисел-металл / М.Г.
Барышев, Б.С. Муравский, // ФТП. 1995. Т. 29. № 1. С. 91- 95.
Барышев М.Г. Размерные эффекты в слоистых
полупроводниковых структурах: дис. … канд. физ.-мат. наук. Краснодар, 1995.
Богданов В.Д. Устройство для синхронного
детектирования АМ сигналов /В.Д. Богданов // Радио. 1990. № 3. С. 53-55.
Богданович М.И. и др. Цифровые интегральные
микросхемы. Минск, 1991.
Булгаков С.С. БИСПИН - новый прибор микроэлектроники
/О.Д. Кнаб, С.С.Булгаков, А.П. Лысенко // Обзоры по электронной технике. Сер.
2, Полупроводниковые приборы. 1990. Вып. 6. С. 53-77.
Ильченко Г.П. Использование Туннелистора и БИСПИНа
для системы автоматического управления технологическими процессами в сельском
хозяйстве /Г.П. Ильченко, Б.С. Муравский, В.В. Магеровский // Электрификация
сельскохозяйственного производства: сб. тр. КГАУ. Краснодар, 1995. С. 130-137.
Ильченко Г.П. Использование функционального датчика
с частотным выходом для контроля режимов обработки плодов и овощей
/Г.П.Ильченко, Б.С. Муравский // Современные технологии и оборудование в
области переработки и хранения сельскохозяйственной продукции: сб. тр. КНИИХП.
Краснодар, 1997. С. 68-72.
Кнаб О.Д. Применение БИСПИН-структур /О.Д.Кнаб,С.С.
Булгаков // Электронная промышленность. 1989. Вып. 9. C. 26-30.
Сидоров И.В. Использование эффекта неустойчивости
тока в тонких пленках анилина расположенного на поверхности водного раствора
фуксина для создания функциональных приборов / И.В. Сидоров, М.Г. Барышев, А.Н.
Коржов // Современные наукоемкие технологии. 2006. № 4. С. 92-93.