Атомно-сканирующая микроскопия
Введение
атомный микроскопия пленка
Атомно-силовая микроскопия (АСМ) - тип сканирующей зондовой микроскопии с
высоким пространственным разрешением, основанный на взаимодействиях зонда с
поверхностью образца. К основным преимуществам АСМ можно отнести: сравнительную
легкость приготовления образцов, возможность анализа проводящих, непроводящих,
хрупких, эластичных, легкоразрушаемых материалов, высокую разрешающую
способность, возможность анализа локальных свойств поверхности.
Несмотря на широкий спектр возможностей, атомно-силовая микроскопия
преимущественно используется для анализа поверхностных характеристик.
Существенный интерес представляют изучение возможностей анализа шероховатости и
структуры пленок.
Цель курсовой работы - изучение возможностей атомно-силовой микроскопии
для анализа структуры, свойств и характеристик пленок.
1. Атомно-силовая микроскопия
.1 Метод атомно-силовой микроскопии
Атомно-силовая микроскопия - один из видов сканирующей зондовой
микроскопии, основанный на взаимодействиях зонда с поверхностью образца. В
основном АСМ используется для получения топографии поверхности образца.
Метод АСМ обладает рядом существенных преимуществ относительно других
методов микроскопии. Атомно-силовая микроскопия позволяет исследовать
поверхности любых материалов - проводящих, полупроводников и непроводящих
электрический ток, не требует сложных методов приготовления образцов. Кроме
того, помимо получения топографии поверхности образца, возможно исследование
структурных и микромеханических свойств (твердость, адгезия и эластичность)[1].
Однако у АСМ есть и недостатки, наличие на получаемых при их помощи
изображениях многочисленных «артефактов», не имеющих отношения к рельефу
измеряемой поверхности. Кроме того, на качество полученных изображений существенное
влияние могут оказывать шумы. Источники шумов бывают внешние и внутренние. К
внешним относят механические колебания, акустические шумы. К внутренним относят
шумы исходящие из самого микроскопа, контуры управления, высоковольтные
усилители.
На рис. 1.1 представлено схематическое устройство атомно-силового
микроскопа. Основной принцип работы АСМ заключается в воздействии сил со
стороны поверхности образца на острие сканирующей иглы. Образец последовательно
сканируется в двух направлениях (i j) с использованием силоизмерительного
зонда (рис. 1.2), состоящего из иглы, присоединенной к кантилеверу, или
являющейся его частью.
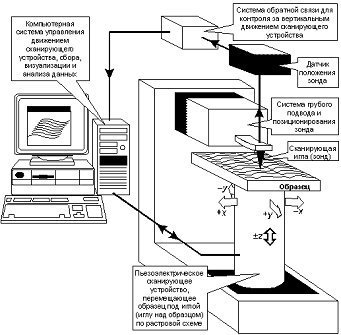
Рисунок 1.1 - Схематическое устройство атомно-силового микроскопа
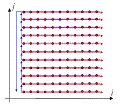
Рисунок 1.2 - Схематическое изображение процесса сканирования
Важнейшей составляющей AСM являются сканирующие
зонды - кантилеверы, свойства микроскопа напрямую зависят от свойств
кантилевера. Кантилевер представляет собой гибкую балку с определенным
коэффициентом жесткости, на конце которой находится микро игла (рис 1.3).
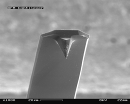
Рисунок 1.3 -Изображение зонда для АСМ
Это основной измерительный элемент многих типов зондовых микроскопов.
Правильный выбор кантилевера является одним из важнейших условий получения
отличных АСМ изображений.
В отношении контакта между острием сканирующей иглы и поверхностью
исследуемого образца работа атомно-силового микроскопа обычно проходит в одном
из режимов: контактный и бесконтактный режимы.
При контактном режиме острие сканирующей иглы АСМ приходит в мягкий
«физический контакт» с образцом. В этом случае на кантилевер действует
отталкивающая межатомная сила, которая уравновешивается за капиллярной и
консольной сил.
Капиллярная сила - это воздействие на острие сканирующей иглы со стороны
тонкого слоя влаги, обычно присутствующего на поверхностях, находящихся в
обычной среде (рис. 1.4). Капиллярная сила возникает, когда адсорбированная на
поверхности влага приподнимается вокруг острия. Оказываемое на острие сильное
притягивающее воздействие (около 10-8 Н) удерживает его в контакте с
поверхностью. Ввиду того, что острие находится в контакте с образцом,
капиллярная сила должна быть постоянной, поскольку расстояние между острием и
образцом фактически не изменяется. Другое условие, позволяющее считать
капиллярную силу постоянной, это предположение о достаточной однородности слоя
влаги.
Рисунок 1.4 - Схема возникновения капиллярной силы
Воздействие со стороны самой измерительной консоли подобно усилию в
сжатой пружине. Величина и знак (отталкивающая или притягивающая) «консольной»
силы зависит от отклонения консоли и ее константы упругости. Сила, прилагаемая
измерительной консолью контактного атомно-силового микроскопа, в отличие от
капиллярной является переменной.
Общее усилие, прикладываемое со стороны острия сканирующей иглы к
образцу, это сумма капиллярной и консольной сил. Величина суммарной силы
варьируется от 10-8 Н (когда измерительная консоль отводится от образца почти с
таким же усилием, как вода притягивает острие к его поверхности) до более
типичного рабочего диапазона в пределах 10-7...10-6 Н.
В бесконтактном режиме атомно-силовой микроскоп отслеживает притягивающие
Ван-дер-Ваальсовы силы между острием сканирующей иглы и образцом. Зазор между
острием и образцом обычно составляет 5-10 нм. На таком расстоянии электронные
орбитали атомов острия сканирующей иглы начинают синхронизироваться с
электронными орбиталями атомов образца. В результате возникает слабое
притяжение, потому что в любой момент времени атомы острия и образца
поляризованы в одном и том же направлении. В свободном пространстве эти атомы
будут сближаться до тех пор, пока сильное электростатическое отталкивание не
станет преобладающим.
В бесконтактном режиме работы атомно-силового микроскопа суммарная сила
между острием и образцом небольшая - обычно ~10-12 Н. Эта малая сила является
преимуществом при исследовании мягких и упругих образцов. Еще одно преимущество
заключается в том, что такие образцы, как, например, кремниевые подложки не
загрязняются при контакте с острием.
При исследовании жестких образцов, изображения, полученные в контактном и
бесконтактном режимах, могут выглядеть одинаково. Однако если на поверхности
жесткого образца лежат, к примеру, несколько монослоев конденсированной влаги,
то эти изображения могут значительно различаться. Атомно-силовой микроскоп,
работающий в контакте, будет проникать через слой жидкости, отображая
нижележащую поверхность, тогда как в бесконтактный - будет давать изображение
поверхности слоя влаги (рис. 1.5).
В отношении возбуждения вынужденных колебаний измерительной консоли
атомно-силового микроскопа различают два режима - статический и динамический.
Если в измерительной консоли атомно-силовые микроскопы модулируют колебания, то
такой режим называют динамическим, в противном случае - статическим.
В статическом режиме силы взаимодействия между острием иглы и
поверхностью образца вызывают отклонение измерительной консоли, изгибая ее до
достижения статического равновесия. В процессе сканирования образца (при
движении острия над неподвижным образцом или образца под неподвижным острием)
атомно-силовой микроскоп детектирует отклонения консоли, формируя набор данных
о топографии одним из двух способов. В первом, называемом режимом постоянной
высоты (его другое название - режим переменного отклонения), данные об
изменениях положения консоли в пространстве могут быть непосредственно
использованы для формирования образа топографии. Под постоянной высотой здесь подразумевается
неизменность расстояния между зондирующим узлом и образцом.

а - бесконтактный режим; б- контактный режим
Рисунок 1.5 - АСМ-профили при наличии на поверхности влаги
Режим постоянной высоты часто используется для получения изображений
атомноплоских поверхностей в атомном масштабе, где отклонения консоли и,
следовательно, изменения прикладываемой силы всегда будут малыми. Режим
постоянной высоты также важен для визуализации в реальном масштабе времени изменяющихся
поверхностей, когда нельзя пренебречь высокой скоростью сканирования.
В другом методе, который называют режимом постоянной силы, отклонение
измерительной консоли используется в качестве входного параметра для системы
обратной связи, которая поддерживает величину этого отклонения постоянной. В
данном случае сканирующее устройство передвигается вверх и вниз по оси z в
соответствии с текущими условиями микрорельефа поверхности образца, и на
основании данных об этих перемещениях формируется изображение топографии. Режим
постоянной силы обычно наиболее предпочтителен в большинстве приложений: хотя
скорость сканирования в этом случае ограничена скоростью реакции системы
обратной связи, но общее воздействие, оказываемое на образец острием
сканирующей иглы, хорошо контролируется. При поддержании постоянного отклонения
консоли суммарная сила, прикладываемая к образцу, остается постоянной.
Изображения, полученные в режиме постоянной силы, обычно достаточно легко
интерпретировать как образы топографии .
В динамическом режиме система атомно-силового микроскопа модулирует
механические колебания измерительной консоли на частоте, близкой к резонансной
(типичные значения находятся в пределах от 30 до 300 кГц), с амплитудой в
несколько нанометров. Величина самой резонансной частоты зависит от
прикладываемой внешней силы, и поэтому в процессе приближения острия
сканирующей иглы к поверхности образца она изменяется, поскольку при этом
изменяется и величина Ван-дер-Ваальсовой силы. Отталкивающая сила стабилизирует
упругую реакцию консоли и увеличивает резонансную частоту, тогда как при
воздействии притягивающей силы наблюдается обратная картина .
В процессе сканирования образца в динамическом режиме система обратной
связи атомно-силового микроскопа передвигает сканирующее устройство вверх и
вниз, сохраняя либо амплитуду, либо резонансную частоту измерительной консоли
постоянной, что позволяет поддерживать постоянным и среднее расстояние между
острием и образцом. Как и при работе в статическом режиме постоянной силы,
данные о передвижениях сканирующего устройства используются для визуализации
топографии. При таком методе измеряется и визуализируется поверхность
постоянного градиента сил.
2. Применение атомно-силовой микроскопии для определения МОРФОЛОГИИ
ТОНКИХ ПЛЕНОК
Атомно-силовая микроскопия самый распространенный метод для анализа
поверхностных характеристик тонких пленок. Таким методом были проведены
исследования шероховатости тонких титановых пленок [2] . Исследование
морфологии пленок (рис. 2.1) проводилось в контактном режиме


Рисунок 2.1 - АСМ изображение участка поверхности тонких титановых
пленок: а - пленка с Rq= 14.9 нм; б - наиболее гладкая пленка с Rq= 1.2 нм; в - пленка с наибольшей
шероховатостью Rq= 2.3
нм
Пленки были получены методом магнетронного осаждения титана на кремневые
подложки. АСМ исследования шероховатости поверхности выявили необходимость
оптимизации режима осаждения пленок по давлению распыляющего газа.

Рисунок 2.2 - Изображение поверхности пленки CdS полученное методом АСМ
С использованием атомно-силовой микроскопии исследована морфология
поверхности тонких пленок Cu-Ga-Se (рис. 2.3 полученных совместным
гидрохимическим осаждением селенидов меди (I) Cu2Se и галлия Ga2Se3.
С помощью фрактального анализа АСМ-изображений установлена зависимость между
условиями осаждения тонких пленок Cu-Ga-Se и их фрактальной размерностью,
рассчитанной методом подсчета кубов и методом триангуляции. Также предложен
механизм формирования и роста пленок при гидрохимическом осаждении диселенида
меди (I) и галлия. [4].
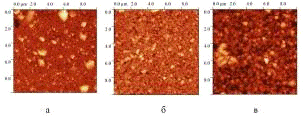

Рисунок 2.3 - АСМ-изображения поверхности пленок Cu-Ga-Se, синтезируемых
из реакционной смеси, содержащей различные концентрации Ga(NO3)3, моль/л: а -
0,025; б - 0,05; в - 0,10; г - 0,15; д - 0,20; е - 0,25.
По данным АСМ поверхности пленок Cu-Ga-Se, установлено, что структура
слоя сформирована из объемного конгломерата, состоящего как из пластинчатых,
так и из глобулярных агрегатов (рис. 2.4). При меньших концентрациях соли
галлия для полупроводникового слоя Cu-Ga-Se характерны агрегаты, имеющие более
пластинчатую форму, увеличение концентрации Ga(NO3)3
приводит к уменьшению пластинчатых и возрастанию числа глобулярных формирований
со средним размером частиц 135-240 нм.
В табл. 1 представлены параметры, описывающие шероховатость полученных
полупроводниковых слоев Cu-Ga-Se. Для всех образцов пленок характерны
достаточно резкие перепады высот рельефа, о чем свидетельствует значительная
разница между максимальной высотой профиля поверхности и параметром,
определяющим среднеквадратичную шероховатость (Rq)

Рисунок 2.4 - Трехмерные АСМ-изображения поверхности пленок Cu-Ga-Se,
синтезируемых из реакционной смеси, содержащей следующие концентрации Ga(NO3)3,
моль/л: а - 0,025; б - 0,25.
Таблица 1. Параметры, описывающие шероховатость пленок Cu-Ga-Se по
результатам обработки АСМ-изображений размером 10×10 мкм

Приведены результаты АСМ поверхности тонких пленок Al2O3, имплантированных ионами Si+, в зависимости от дозы облучения (5∙1016 -
3∙1017см-2) и температуры последующего
высокотемпературного отжига. На рисунке 2.5 приведены «трехмерные»
АСМ-топограммы поверхности необлученной и облученных Si+ пленок Al2O3 (не подвергнутых отжигу) в зависимости от дозы
облучения [5].
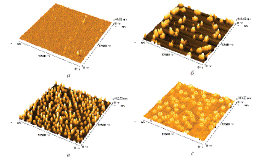
Рисунок 2.5 - Трехмерные АСМ-изображения пленок Al2O3, облученных ионами Si+ с дозами, см-2: а - 0; б - 5∙1016;
в - 1∙1017; г - 3∙1017
Полученные образцы пленок кремния толщиной 90 нм исследовались методом
атомно-силовой микроскопии (АСМ) в работе [6]. Все полученные пленки кремния
имели на поверхности характерные образования латеральными размерами от 10 до
300 нм и высотами от 5 до 70 нм (рис. 2.6). Причем количество образований явно
зависит от температуры роста пленки: при 300 0 С количество
образований минимально, при 500 0 С их количество резко возрастает,
а при дальнейшем увеличении температуры подложки до 650 0 С
количество образований вновь уменьшается (но не меньше чем при 3000
С). Дальнейшее увеличение температуры подложки на 1000 С приводит к
резкому снижению скорости роста, становится невозможным получение образца пленки
кремния нужной толщины.

Рисунок 2.6 - АСМ изображение пленок кремния толщиной 90 нм: a -
температура подложки 200 С, b - температура подложки 3000
С, c - температура подложки 5000 С, d - температура подложки 6500
С.
ЗАКЛЮЧЕНИЕ
АСМ позволяет исследовать поверхности материалов: проводящих,
полупроводников, не проводящих электрический ток. Помимо получения топографии
поверхности образца, возможно исследования таких свойств, как адгезия,
твердость и др. К недостаткам относится наличие на полученных изображениях так
называемых "артефактов", а также влияние шумов.
Метод АСМ часто используется для исследования механических свойств тонких
пленок, таких как шероховатость.
СПИСОК
ИСПОЛЬЗОВАННОЙ ЛИТЕРАТУРЫ
1. Быков, В.А. Сканирующая зондовая микроскопия для науки и
промышленности / В.А. Быков, М.И.Лазарев, С.А. Саунин // Электроника: наука,
технология, бизнес. - 1997. - № 5. с. 7 - 14.
. Ляхов, И.Г. Исследование режимов магнетронного напыления
тонких пленок титана для криогенных детекторов : / И.Г. Ляхов, А.А. Кузьмин,
А.С. Ильин, М.А. Ермакова, К.В. Булах // Труды МФТИ - 2013. - Том 5, № 1.
. Трегулов, В.В. Исследование с помощью атомно-силовой
микроскопии поверхности тонких пленок CdS, изготовленных методом химического осаждения / В.В. Трегулов [и др.] //
Вестник Рязанского государственного университета им. С.А. Есенина. - 2012. - №
35. - c. 83-91.
. Федорова, Е.А. Фрактальный анализ АСМ-изображений химически
осажденных пленок Cu-Ga-Se : заключительный отчет о НИР / Урал. федер. ун-т им.
первого Президента России Б. Н. Ельцина ; Руководитель Л. Н. Маскаева ;
Исполнители Е. А. Федорова, Л. Н. Маскаева, В. Ф. Марков, В. А. Мошников, Н. В.
Пермяков. - Екатеринбург, 2013. - 20 с.
5. Галлямов, М.О. Сканирующая зондовая микроскопия
нуклеиновых кислот и тонких органических пленок: автореф. дис. кандидат
физ.-мат. наук: 17.06.1999 / М.О. Галлямов; ГУ имени М.В. Ломоносова. 1999. -
23с.
. Рочева, В.В. Морфология тонких пленок аморфного Si, полученных при различных
температурах осаждения методом CBPLD [Электронный ресурс] / В.В. Рочева, Е.В.
Хайдуков, О.А. Новодворский, В.Я. Панченко // Труды X межвузовской научной школы Молодых специалистов
"концентрированные потоки энергии В космической технике Электронике,
экологии и медицине". 2009). - Режим доступа: http://nuclphys.sinp.msu.ru/school/s09/09_21.pdf,
свободный. - Загл. с экрана.