Строение полупроводников
Экзаменационный
реферат
По
микроэлектронике
Содержание
1. Структура полупроводниковых материалов
. Энергетические уровни и зоны
. Электропроводимость полупроводников
. Примесная проводимость полупроводников
. Виды движения носителей в полупроводниках
. Электронно-дырочный переход
Свойства электронно-дырочного перехода
. Электропроводимость полупроводников в сильных электрических
полях
. Туннельный эффект
Литература
полупроводниковый энергетический электрический поле
1. Структура полупроводниковых материалов
К полупроводниковым материалам относятся большое количество веществ
и элементов, которые по своим электрическим свойствам занимают промежуточное
положение между проводниками и диэлектриками.
Величина удельной электрической проводимости полупроводников может
принимать значение в пределах равной 10-10 - 104
1/(Ом·см), (удельная электрическая проводимость проводников 104 - 105
1/(Ом·см), а диэлектриков меньше 10-10 1/(Ом·см)).
Важнейшим свойством полупроводников является зависимость их электрических
свойств от внешних условий: температуры, давления, освещённости, внешних полей
и т.п.
Характерная особенность полупроводников заключается в уменьшении их
удельного сопротивления с увеличением температуры.
Широкое применение в полупроводниковой технике получили германий,
кремний, селен, а также полупроводниковые соединения типа арсенид галлия,
карбид кремния и др.
Для полупроводников, как и для любых твёрдых тел, характерно
кристаллическое строение, т.е. закономерное и упорядаченое расположение всех их
атомов в пространстве строго определенным образом и на одинаковых расстояниях
друг от друга по своеобразной кристаллической решётке.
Между атомами такой решётки существуют ковалентные связи. Они образуются
валентными электронами, которые взаимодействуют не только с ядром атома, но и с
соседними.
Кристаллическая решётка, в которой каждый электрон внешней орбиты связан
ковалентными связями с остальными атомами вещества, является идеальной. В таком
кристалле все валентные электроны прочно связаны между собой и свободных
электронов, которые могли бы участвовать в переносе зарядов, нет.
Такую кристаллическую решётку имеют все химически чистые беспримесные
полупроводники при температуре абсолютного ноля. В этих условиях полупроводники
обладают свойствами идеальных изоляторов, а с ростом температуры увеличивается
и их удельное электрическое сопротивление.
. Энергетические уровни и зоны
Как известно из курсов физики и химии, все электроны вращаются каждый на
своей орбите. Количество электронов и количество орбит для каждого вещества
совершенно определены. Так, на первой внутренней орбите могут разместятся не
более двух электронов, на второй и третьей по восемь, на четвёртой орбите -
десять, пятой - восемь и т.д.
Каждой орбите соответствует строго определённая энергия электрона,
или его разрешённый энергетический уровень.
Уровни энергии, которые не могут иметь электроны при переходе с одной
орбиты на другую, называются запрещёнными.
Таким образом, энергия каждого электрона может принимать лишь
определённые значения, называемые уровнями энергии или энергетическими
уровнями.
Электроны, расположенные ближе к ядру атома, обладают меньшими энергиями,
т.е. находятся на более низких энергетических уровнях, а удалённые от ядра
электроны обладают большими энергиями, т.е. находятся на более высоких
энергетических уровнях.
Когда электрон переходит с более высокого энергетического уровня на более
низкий, выделяется некоторое количество энергии, называемое квантом или
фотоном. Если атом поглощает атом поглощает один квант энергии, в условиях
воздействия тепла, света или каких-либо других внешних факторов приобретает
дополнительную энергию, то электрон переходит с более низкого энергетического
уровня на более высокий.
Распределение электронов по уровням энергии изображают схематически.
Горизонтальными линиями показаны уровни энергии электронов.
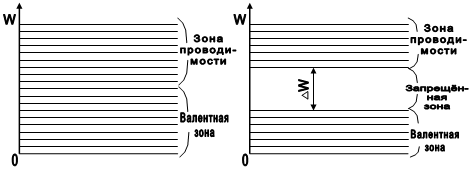
Рис. Схема уровней энергии для: а) металла; б) диэлектрика.
В соответствии с так называемой зонной теорией твёрдого тела
энергетические уровни объединяются в зону. Электроны, расположенные на внешних
орбитах атомов, называются валентными электронами, составляющих валентную
зону.
Они определяют химическую активность вещества, т.е. участвуют в создании
в создании химической связи между атомами.
В металлах и полупроводниках существует большое число электронов,
находящихся на более высоких энергетических уровнях. Эти уровни составляют зону
проводимости. Электроны этой зоны, освободившиеся от внутренних связей,
получили название свободных электронов или электронов проводимости.
Они хаотически перемещаются внутри вещества между атомами. При наличии
внешнего электрического поля беспорядочное движение свободных электронов
становится упорядоченным и направленным, в результате чего возникает
электрический ток.
У металлов зона проводимости непосредственно примыкает к валентной зоне
(практически каждый атом металла отдаёт в зону проводимости по крайней мере
один электрон), рисунок - а.
У диэлектриков между зоной проводимости и валентной зоной существует
запрещённая зона, соответствующая уровням энергии, на которых электроны не
могут находится, т.е. они не могут обладать этими уровнями энергии, рисунок -
б.
Ширина запрещённой зоны, т.е. разность между энергией нижнего уровня зоны
проводимости и верхнего уровня валентной зоны, составляет несколько
электрон-вольт. При номинальной температуре у диэлектриков в зоне проводимости
присутствует только очень небольшое количество электронов и поэтому диэлектрик
обладает ничтожно малой проводимостью. Но при нагревании некоторые электроны
валентной зоны, получая добавочную энергию, переходят в зону проводимости, и
тогда диэлектрик приобретает заметную проводимость.
У полупроводников зонная диаграмма подобна изображённой на рисунке - б,
но только ширина запрещённой зоны меньше чем у диэлектриков. К примеру, ширена
зоны равна: для германия - 0,7 эВ; для кремния - 1,1 эВ; для арсенида галлия -
1,4 эВ.
При низких температурах полупроводники являются диэлектриками, а при
нормальной температуре значительное число электронов переходит из валентной
зоны в зону проводимости.
. Электропроводимость полупроводников
Принцип работы полупроводников связан с тем, что в полупроводниках
существует электропроводность двух типов. Так же как и металлы, полупроводники
обладают электронной электропроводностью, которая обусловлена
перемещением электронов проводимости. (При обычных рабочих температурах в
полупроводниках всегда присутствуют электроны проводимости, которые очень слабо
связаны с ядрами атомов и совершают беспорядочное тепловое движение "колебания"
между атомами кристаллической решетки).
Полупроводники обладают также дырочной электропроводностью,
которая не наблюдается в металлах.
В атоме полупроводника под влиянием тепловых или других воздействий один
из более удаленных от ядра валентных электронов переходит в зону проводимости.
Тогда атом будет иметь положительный заряд, численно равный заряду электрона.
Такой атом можно назвать положительным ионом.
Отсутствие электрона в атоме полупроводника условно назвали дыркой.
Этим подчеркивают, что в атоме не хватает одного электрона, т. е.
образовалось свободное место. Дырки ведут себя, как элементарные положительные
заряды).
Следует отметить, что дырка может замещается электронами с соседних
уровней валентной зоны. Благодаря этому она приобретает подвижность, а сами
ионы не подвижны.
Проводимость чистого полупроводника зависит от концентрации свободных
носителей заряда - электронов и дырок при различных условиях. Эта задача
решается на основе закона Ферми - Дирака, согласно которому вероятность того,
что состояние с энергией W при
данной температуре Т будет занято электроном, выражается функцией:
Fn = (W,T) =1/((W - WF)/ekT +1) = 1/exp((W - WF)/kT + 1) ,
где k
- постоянная
Больцмана; Т - абсолютная температура; WF - уровень Ферми.
В полупроводник концентрация свободных электронов всегда равна
концентрации дырок, т.е. p = n и с увеличением температуры
концентрация свободных электронов в полупроводнике возрастает по
экспоненциальному закону
ni = no˙e(-ΔW / 2kT) = no˙exp(-ΔW / 2kT) ,
где ni - количество свободных электронов в 1 см3
химически чистого полупроводника;
ΔW - ширина запрещенной зоны;
no - коэффициент равный 5·1019 см-3 для
германия и 2·1020 см-3 для кремния; - постоянная
Больцмана;
Т -абсолютная температура.
Для чистого полупроводника можно записать:
WF = (Wc-Wn)/2,
где Wn - уровень потолка валентной зоны;
Wc -
уровень дна зоны проводимости.
То есть уровень Ферми в чистом полупроводнике располагается в близи
середины запрещенной зоны.
При подведении к кристаллу разности потенциалов электроны в зоне проводимости
приобретают направленное движение против направления напряженности поля, а
дырки в валентной зоне - по направлению поля.
Таким образом, собственная проводимость полупроводников обусловлена двумя
видами носителей заряда: электронами - электронная проводимость и дырками -
дырочная проводимость.
Так, как концентрация обоих видов носителей одинакова, то суммарная
электропроводимость, называется собственной проводимостью полупроводника и
определяется выражением:
s = q·(mn·n + mp·p),
где q - заряд электрона;
mp -
подвижность дырок;
. Примесная проводимость полупроводников
Существенное увеличение проводимости наблюдается при введении в кристаллы
незначительного количества примесей. В этом случае полупроводники называются примесными,
а проводимость - примесной.
В качестве примесей для германия и кремния используют трехвалентные
элементы: бор, алюминий, индий; а также пятивалентные: фосфор, сурьму, мышьяк.
Атомы этих элементов могут замещать атомы германия или кремния в
кристаллической решётке. Их валентные электроны имеют энергетические состояния,
выходящие за пределы разрешённых энергетических уровней основного кристалла.
Благодаря этому появляются дополнительные уровни для электронов в запрещённой
зоне полупроводника.
При введении пятивалентной примеси в кристалл германия, четыре валентных
электрона атома примеси вступают в ковалентную связь, а пятый электрон
оказывается свободным. Так как электрон слабо связан с атомом примеси, то он
легко может быть оторван от него.
Запрещённая зона, например, мышьяка в германии, составляет величину
порядка 0,1 эВ. Поэтому уже при нормальной температуре все примесные атомы
ионизированы.
Таким образом, число электронов в зоне проводимости увеличивается за счет
перехода последних с примесных уровней, расположенных у дна зоны проводимости.
Так как такой переход не сопровождается появлением свободных уровней
(дырок) в валентной зоне, то вероятность появления электронов в зоне
проводимости оказывается выше вероятности появления дырок в валентной зоне.
Поэтому уровень Ферми в таком полупроводнике смещается в направлении дна зоны
проводимости и приближённо может быть определён таким выражением:
WFn = WC - k × T × ln(NC/Ng),
где Ng - концентрация доноров;
Nc -
число разрешённых уровней в зоне проводимости.

Рис. Энергетическая диаграмма кристалла германия при введении
пятивалентной примеси.
Из рисунка видно, что электронам примеси на уровне намного легче перейти
в зону проводимости чем электронам основного кристалла. Поэтому число их будет
намного больше числа электронов основного кристалла. Следовательно, количество
свободных электронов будет значительно больше, чем дырок. То есть основными
носителями электрических зарядов в таком полупроводнике будут электроны.
Полупроводник, у которого основными носителями заряда являются электроны,
называются полупроводником n - типа.
Примесные атомы, которые сравнительно легко отдают свои электроны и
создают тем самым в кристалле электронную проводимость, называются донорными.
При введении в решётку германия трёхвалентной примеси, например индия,
одна из связей с ближайшим атомом германия остаётся незаполненной. Четвёртая,
незаполненная связь не обладает каким либо зарядом. При тепловых колебаниях
электрон одного из атомов германия может перейти в незаполненную связь атома
индия. Во внешней электронной оболочке атома индия при этом появится избыточный
электрон, т.е. атом индия превращается в отрицательный ион.
С энергетической точки зрения введение трёхвалентной примеси эквивалентно
появлению дополнительных уровней вблизи потолка валентной зоны (Wa). При этом происходит как бы
перехват электронов атомов германия на эти дополнительные уровни, а в валентной
зоне образуются дырки.

Рис. Энергетическая диаграмма кристалла германия при введении
трёхвалентной примеси.
Запрещенная зона трёхвалентной примеси в кристалле германия составляет
величину 0,16 эВ.
Поэтому уже при нормальной температуре в германии с трехвалентной
примесью создаётся значительная концентрация дырок.
Примесные атомы, которые могут захватить и удержать электроны, называются
акцепторами.
Полупроводник, в котором основными носителями являются дырки, называется полупроводником
p - типа.
. Виды движения носителей в полупроводниках
Электроны и дырки, которые могут перемещайся и поэтому создавать
электропроводность, называют подвижными носителями заряда или просто
носителями заряди.
Если к полупроводнику не приложено напряжение, то электроны и дырки
проводимости совершают хаотическое тепловое движение и никакого тока, конечно,
нет. Под действием разности потенциалов в полупроводнике возникает
электрическое поле, которое ускоряет электроны и дырки и сообщает им ещё
некоторое поступательное движение, представляющее собой ток проводимости.
Движение носителей заряда под действием электрического поля называют дрейфом
носителей, а ток проводимости - током дрейфа iдр.
Полный ток проводимости складывается из электронного и дырочного тока
проводимости:
iдр=inдр+ipдр,
Удобнее рассматривать не сам ток, а его плотность.
Jдр=Jnдр+Jpдр
Так как плотность тока равна количеству электричества, проходящему через
единицу площади поперечного сечения за 1 с, то можно записать:
Jnдр = ni×q× vn
где ni - концентрация электронов;
q - заряд электрона;
vn - средняя
скорость поступательного движения электронов под действием поля.
Аналогично
Jpдр = pi×q× vn
Средняя скорость учитывает беспорядочное тепловое движение с
многочисленными столкновениями электронов и атомов кристаллической решётки. От
одного столкновения до другого электроны ускоряются полем, и поэтому скорость vn пропорциональна напряженности поля Е:
v =
m ×E,
где m - подвижность
электронов (средняя скорость их поступательного движения под действием поля с
единичной напряжённостью).
То есть плотность полного тока:
Jдр = ni×q×mn×E +pi×q×mр×E = (sn+sp)×E ,
где sn
= ni×q×mn, sp = pi×q×mр - удельные проводимости.
Если рассматривать отдельно n и p проводимости, можно сказать, что:
Под действием ЭДС источника в проводах, соединяющих полупроводник n-типа с источником, и в самом
полупроводнике движутся электроны проводимости. В соединительных проводах
полупроводника p-типа по-прежнему движутся электроны, а в самом полупроводнике
ток следует рассматривать как перемещение дырок. Электроны с отрицательного
полюса поступают в полупроводник и заполняют пришедшие сюда дырки. К
положительному полюсу приходят электроны из соседних частей полупроводника, и в
этих частях образуются дырки, которые перемешаются в противоположную сторону.
В полупроводниках помимо тока проводимости (дрейфа носителей) может быть
еще диффузионный ток, причиной возникновения которого является не
разность потенциалов, а разность концентраций носителей.
Если носители
заряда распределены равномерно по полупроводнику, то их концентрация является равновесной.
Под влиянием каких-либо внешних воздействий в разных частях полупроводника
концентрация может стать неодинаковой, не равновесной.
Так как носители имеют собственную кинетическую энергию, то они всегда
переходят из мест с более высокой концентрацией в места с меньшей
концентрацией, т. е. стремятся к выравниванию концентрации.
Диффузионное движение подвижных носителей заряда (электроны и дырки)
называется диффузионным током. Этот ток, так же как ток проводимости, может
быть электронным или дырочным, и плотность его определяется следующими
формулами:
Jnдр = q×Dn×Δn /Δx и Jpдр = -q×Dp×Δp /Δx
где величины Δn /Δx и Δp
/Δx являются так называемыми градиентами
концентрации (скорость изменения скорости носителей);
Dn и Dp - коэффициентами диффузии
(интенсивность процесса диффузии).
Таким образом, в общем случае в полупроводнике следует рассматривать
четыре составляющих тока: дрейфовый и диффузионный для носителей каждого знака.
Общая плотность тока в полупроводнике:
J = Jnдр + Jnдиф + Jpдр +Jpдиф =e×n×mn×E +
+e×Dn×dn/dx + e×p×mp×E +e×Dp×dp/dx .
6. Электронно-дырочный переход
Область на границе двух полупроводников с различными типами
электропроводимости называется электронно-дырочным или n-р-переходом.
Работа большинства полупроводниковых приборов (диодов, транзисторов, ИС и
др.) основана на использовании свойств одного или нескольких n-р-переходов.
Рассмотрим более подробно физические процессы таком переходе.
А) Пусть внешнее напряжение на переходе отсутствует. Так как носители
заряда в каждом полупроводнике совершают беспорядочное тепловое движение, т.е.
имеют собственные скорости, то происходит их диффузия, за счет того, что
концентрация дырок в р - области больше концентрации дырок в n - области (pp >> pn), а концентрация электронов в n -
области больше концентрации в р - области (nn >> np).
Таким образом, из полупроводников n-типа в полупроводник p-типа диффундируют электроны, а в обратном направлении из
полупроводника p-типа в
полупроводник n-типа диффундируют дырки.
В результате диффузии носителей по обе стороны границы раздела двух
полупроводников с различным типам электропроводимости создаются объемные заряды
различных знаков. В области n
возникает положительный объемный заряд. Он образован главным образом
положительно заряженными атомами донорной примеси и в небольшой степени -
пришедшими в эту область дырками. Подобно этому в области p - возникает отрицательный объемный
заряд, образованный отрицательно заряженными атомами акцепторной примеси, и
отчасти, пришедшими сюда электронами.
Между образовавшимися объемными зарядами возникает так называемая
контактная разность потенциалов Uk = jn
- jp и электрическое поле (вектор
напряжёности Ек)
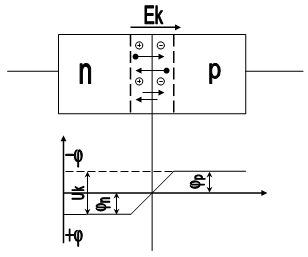
Контактное поле Ек приводит к появлению токов дрейфа не основных
носителей обеих областей. Токи дрейфа противоположно направлены по отношению к
диффузионным токам. Процесс окончательного формирования р-n-перехода заканчивается установлением
теплового равновесия, при котором результирующий ток через р - n переход
становится равный нулю, т.е.:
I = Inдиф + Iрдиф - Inдр - Iрдр = 0
Установление теплового равновесия означает что вероятность прохождения
носителей заряда через р-n - переход в обоих направлениях становится одинаковой.
При этом в р-n переходе возникает потенциальный барьер или другими
словами запирающий слой, обладающий большим сопротивлением и
препятствующий диффузионному переходу носителей.
Б) p-n - переход при прямом напряжении Uпр (+
источниками к р - области, - к n-области).
Полярность внешнего источника противоположна контактной разности
потенциалов, поэтому высота потенциального барьера р-n -переходе снижается на величину приложенного напряжения (Ек-Uпр). Это облегчает основным носителям
n и р областей преодолевать барьер, т.е. происходит увеличение диффузионных
токов - электронного и дырочного (Inдиф и Iрдиф ).
Результирующий диффузионный ток: Iдиф = Inдиф + Iрдиф, направленный из р- области в n -
область, называется прямым током р-n-перехода.
В) n-p переход при обратном напряжении Uобр (+ источника
питания к n области, - к p -области).
Это напряжение оказывается той же полярности, что и контактная резкость
потенциалов. В результате действия этого напряжения высота энергетического
барьера возрастает до Eк + Uобр. Диффузионные токи
основных носителей через переход уменьшаются, тогда, как дрейфовые токи
сохраняются постоянными. Поэтому при некоторых значениях Uобр
дрейфовые токи оказываются значительно больше диффузионных, и через p-n переход
протекает ток, равный
обр = Iдиф - Iдр = -Iдр.
Этот ток направлен из n- области в р- область. По величине он на много
меньше тока Iпр, так как создается движение не основных носителей.
Величина его практически постоянна. Это объясняется тем, что число не основных
носителей ограничено.
7. Свойства электронно-дырочного перехода
Свойства электронно-дырочного перехода наглядно иллюстрируются его
вольтамперной характеристикой показывающей зависимость тока через р-n переход
от величины и полярности приложенного напряжения.
Аналитическим выражением вольтамперной характеристики р-n перехода
является формула:
I = Iо×(еqU/kT - 1);
где Io - обратный ток насыщения p-n перехода;
k - постоянная
Больцмана;
q - заряд электрона;
U -
напряжение приложенное к переходу;
Т - абсолютная температура p-n перехода.

Рис. Характеристики p-n перехода: а - вольтамперная;
б - сопротивления.
При положительных напряжениях ток через р-n переход с увеличением
напряжения резко возрастает. При отрицательных - имеет величину порядка
микроампера.
Увеличение Uобр приводит к пробою р-n перехода при котором Iо
резко увеличивается. Различают два вида пробоя: электрический (обратимый) и
тепловой (необратимый).
При электрическом пробое в результате действия сильного электрического
поля электроны могут освобождаться из ковалентных связей и получать энергию,
достаточную для преодоления барьера на участке р-n перехода.
Тепловой пробой р-n перехода происходит вследствие вырывания валентных
электронов из связей в атомах при тепловых колебаниях кристаллической решётки.
Увеличение тока приводит к повышению температуры, и процесс нарастает
лавинообразно.
Свойства р-n перехода существенно зависят от температуры при повышении
которой прямой и обратные токи растут, а р-n перехода теряет своё основное
свойство - одностороннюю проводимость.

Рис. Характеристики p-n перехода при изменении температуры.
Примерно так же, но в меньшей степени, зависят свойства р-n перехода от
частоты приложенного напряжения, что объясняется наличием собственных емкостей
между слоями полупроводника с разными типами проводимости. При работе на
высоких частотах емкостное сопротивление Xс=1/wc уменьшается и обратный ток
может пройти через эту емкость и р-n переход теряет свойство односторонней
проводимости.
Оптические и фотоэлектрические свойства полупроводников.
В электронной технике широко используются полупроводниковые приборы,
основанные на принципах фотоэлектрического и электрооптического преобразования
сигналов.
Первый из этих принципов обусловлен изменением электрофизических свойств
вещества в результате поглощения в нём световой энергии (квантов света). При
этом изменяется проводимость вещества или возникает Э.Д.С., что приводит к
изменениям тока в цепи, в которую включен фоточувствительный элемент.
Второй принцип связан с генерацией излучения в веществе, обусловленной
приложенной к нему напряжением и протекающим через светоизлучающий элемент
током.
Всё многообразие оптических и фотоэлектрических явлений в полупроводниках
можно свести к следующим основным:
a) Поглощение света и фотопроводимость
(изменение электропроводимости полупроводника при поглощении им квантов света,
к примеру, в фоторезисторах).
b) Фотоэффект в p-n переходе
(появление Э.Д.С., доли вольта, при освещении p-n перехода, к
примеру, в фотодиодах, фототранзисторах).
c) Электролюминесценция (свечение
полупроводника при подаче на него напряжения, в светодиодах, в индикаторах).
d) Стимулированное когерентное
излучение, применяют в полупроводниковых лазерах.
8. Электропроводимость полупроводников в сильных электрических полях
В слабых электрических полях концентрация носителей заряда не зависит от
напряжёности поля Е, а зависимость тока через полупроводник подчиняется закону
Ома (т.е. с ростом Е растёт I).
При дальнейшем увеличении Е, начиная с некоторого момента Е1 нарастание
тока замедляется, а при Е = Екр полностью прекращается.
С дальнейшим увеличением Е ток через полупроводник начинает падать,
поскольку энергии поля ещё не достаточно для увеличения концентрации носителей
заряда, а подвижность электронов уменьшается из-за увеличения числа
столкновений с атомами кристаллической решётки.
Это падение продолжается до порогового значения напряжённости поля Епор,
после чего проводимость полупроводника резко возрастает из-за увеличения
концентрации носителей заряда.
Графически это можно представить таким образом.

Увеличение концентрации носителей заряда можно объяснить с помощью
эффекта Зинера, который заключается в том, что в сильных электрических полях
энергетические зоны полупроводника наклоняются.
При этом электрон может проходить через запрещенную зону двумя путями.
Вертикальный переход связан с затратой энергии. При горизонтальном переходе
энергия не затрачивается или затрачивается намного меньше, т.е. происходит
просачивание электронов сквозь потенциальный барьер запрещённой зоны. В связи с
этим резко возрастает концентрация носителей заряда и растёт ток.
Экспериментальные данные показывают, что эффект Зинера в германии начинает
появляться при напряжённости поля Е ≈ 2∙107В/м.

9. Туннельный эффект
В 1958г. японский учёный Лео Эсаки открыл явление туннельного эффекта в
полупроводниках.
Туннельный эффект заключается в том, что электроны проводимости через
потенциальный барьер p-n перехода проходит не изменяя своей
энергии.
Для получения туннельного эффекта используют вырожденные полупроводники,
отличающиеся от обычных повышенной концентрации примесей, достигающих величины
порядка 1018 - 1020 в см3.
Это приводит к целому ряду особенностей p-n перехода:
1. Происходит резкое смещение
энергетических уровней p- и n- областей и их взаимное перекрытие.
2. Переход характеризуется небольшим
удельным сопротивлением и малой толщиной.
3. Уровни Ферми смещаются из запрещённых
зон в разрешённые: в валентную зону p - области и в зону проводимости n - области.
В результате этого электроны, движутся в сторону очень узкого барьера,
проходят сквозь его (как через туннель) и займут свободные состояния с такой же
энергией по другую сторону от барьерного слоя. То есть необходимо, чтобы против
занятого электронного уровня по одну сторону барьера находился свободный
уровень по другую его сторону.
Результирующий ток через переход будет определяться двумя встречными
потоками электронов. Для упрощения примем, что все уровни ниже уровня Ферми
заполнены электронами, а расположенные выше свободны.
Из p - в n - область валентные электроны переходят на свободные уровни
в зону проводимости, а из n - в p - область электроны проводимости
переходят на свободные уровни валентной зоны.
Очевидно, что при отсутствии смещения суммарный ток перехода равен нулю.
Энергетическая диаграмма имеет вид.

При приложении обратного напряжения энергетическая диаграмма
полупроводника n - типа
опускается в низ, а полупроводника p - типа поднимается вверх. Вероятность туннельного перехода электронов из
p области в n - область возрастает, а из n - области в n -
область падает практически до нуля.
Возникающий обратный ток Iобр
будет расти с увеличением обратного напряжения Uобр.
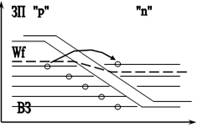


При прямом напряжении происходит смещение зон в обратном направлении и
течет прямой ток, который будет возрастать с увеличением прямого напряжения до
определённого момента соответствующего Uп. Дальнейшее увеличение Uпр приведёт к уменьшению тока, поскольку напротив уровней
электронов n - области, окажутся запрещённые
уровни p - области. Уменьшение тока через
переход будет продолжаться, пока не увеличится прямое напряжение до того, когда
потолок валентной зоны p -
области и дно зоны проводимости n -
области окажутся на одном уровне. При дальнейшем увеличении прямого напряжения
растёт и прямой ток через переход по обычным свойствам p - n
перехода. Вольтамперная характеристика туннельного эффекта имеет вид.
Литература
Основная литература
Ефимов И.Е., Козырь И.Я. Основы микроэлектроники. Изд-во
"Лань", 2008
Коваленко А.А. Основы микроэлектроники, 2010г.
Л.А. Коледов. Технология и конструкции микросхем,
микропроцессоров и микросборок. М.: Изд-во "Техносфера", 2009 г.
Дж.М.Мартинес- Дуарт, Р.Дж.Мартин- Палма, Ф. Агулло- Руеда.
Нанотехнологии для микро- и оптоэлектроники. Пер с англ. Техносфера, 2009,368
с.
Л.Фостер. Нанотехнологии, наука, инновации и возможности. М.,
Техносфера, с.348, 2008г.
Нанотехнологии. Наноматериалы. Наносистемная техника. Мировые
достижения. Сборник под редакцией д.т.н., профессора П.П.Мальцева. Москва:
Техносфера,2008. - 432с.
Дополнительная литература
И.И.Степаненко "Основы микроэлектроники", М.,
Изд-во Лаборатория базовых знаний, 2003 г.
А.А. Щука. Функциональная электроника. М.:, ЦНИИ
"Электроника ,1998 г.
И.М. Николаев и Н.А. Филинюк. Интегральные микросхемы и
основы их проектирования. М.: Изд-во "Радио и связь, 1992 г.
Л. Росадо. Физическая электроника и микроэлектроника. 1991 г.