Ультрафіолетова нанолітографія
МІНІСТЕРСТВО
ОСВІТИ І НАУКИ
ДЕРЖАВНИЙ
ВИЩИЙ НАВЧАЛЬНИЙ ЗАКЛАД
УЖГОРОДСЬКИЙ
НАЦІОНАЛЬНИЙ УНІВЕРСИТЕТ
ФІЗИЧНИЙ
ФАКУЛЬТЕТ
Курсова
робота на тему
Ультрафіолетова
нанолітографія
ВСТУП
Одним з визначальних технологічних
процесів в мікроелектроніці протягом більше 40 років продовжує залишатися
літографія. Літографія або мікролітографія, а зараз може бути доречним,говорити
про нанолітографію, призначена для створення топологічного малюнка на поверхні
монокристалічної кремнієвої пластини. Основним літографічним процесом в
сучасній мікроелектроніці є фотолітографія.
Нанолітографія - спосіб масового
виготовлення інтегральних схем з використанням в літографічному обладнанні
джерела екстремального ультрафіолетового випромінювання з довжиною хвилі 13,5
нм і проекційної оптичної системи на основі відбивають багатошарових MoSi
дзеркал. Таким способом передбачається досягнення розмірів елементів
інтегральних схем 30 нанометрів і менше.
1.
Нанолітографія
.1
Механічна нанолітографія
Прилади серії «НаноСкан » надають
широкі можливості для прецизійної механічної мікрообробки і нанолітографії.
Використання алмазних наконечників дозволяє різати практично будь-який з
відомих матеріалів. Контролюючи зусилля притиску в процесі різання з дозволом
від 10 мкн можна стійко отримувати подряпини шириною від 100 нм і глибиною у
кілька нанометрів. При цьому максимальна глибина подряпини може досягати кілька
мікрометрів. За рахунок використання прецизійних п’єзокерамічних
нанопозіціонерів і механічних лінійних трансляторів точність позиціонування
алмазного наконечника досягає 10 нм в полі 100х100 мкм і близько 100 нм в полі
100 х100 мм.
Результат мікрообробки поверхні може
бути проконтрольований тим же алмазним наконечником шляхом сканування в режимі
зондового мікроскопа або за допомогою цифрового оптичного мікроскопа.
Режим механічної нанолітографії може
використовуватися для створення регулярних структур на поверхні, видалення
окисних плівок, звільнення від покриттів в заданих областях, коригування
геометрії елементів мікроелектроніки, а також мікромеханічних систем ( МЕМС ).

Рис.1.1 Напис, отриманий царапанням
плавленого кварцу
1.2 Атомна
нанолітографія
В даний час напівпровідникові
прилади мікроелектроніки створюються головним чином методом оптичної
літографії. Створення структур з меншими розмірами є технологічною завданням,
що має як практичне значення, так і представляє фундаментальний інтерес,
оскільки створення структур з розмірами в області порядку 10 нм утворює міст
між класичним і квантовим світом [1]. Існує кілька підходів у реалізації
наноструктур з розмірами в декілька десятків нанометрів, кожен з яких володіє
як перевагами так і недоліками.
Серед багатьох застосувань атомної
оптики - атомна літографія - потенційно важлива для мікро і нанофабрікаціі
матеріальних структур. В атомній літографії внутрішні і зовнішні ступені
свободи індивідуальних атомів контролюються за нанометровою точністю зовнішніми
електромагнітними полями і нанооб'єкти "збирається " з індивідуальних
атомів, молекул, біологічних клітин і т.п.
Оскільки цей метод використовує
нейтральні атоми, то він має низку переваг у порівнянні з іншими методами.
Насамперед, у цьому методі дуже малим є фундаментальна межа просторового
дозволу, що накладається дифракцією, оскільки атоми мають відносно великі маси
і, відповідно, малі де- Бройлевскіе довжини хвиль. Крім того, оскільки
використовуються нейтральні атоми, то відсутні кулонівських сили
відштовхування. Нарешті, маніпулювання атомами може бути реалізовано
паралельно, що дозволяє одночасну обробку відносно великих поверхонь .
( а ) Атомна нанопір’яна
нанолитография. Нанопір’яна літографія - це спосіб побудови довільних структур
на поверхні, в точності аналогічний написання на папері чорнильною лінії за
допомогою пір'яної ручки. Щоб зробити такі лінії в наномасштабі, необхідно
створити наноручку. Перші наноручки в якості пера використовували зонди
атомного силового мікроскопа. У такому методі нанолітографії резервуар чорнила
- атомів зберігається на кінчику скануючого зонда, який пересувається по
поверхні, залишаючи за собою лінії атомних розмірів. Серйозним недоліком методу
є велика тривалість процесу створення наноструктур .
Запропоноване і реалізоване атомне
перо, являє собою нанометровий отвір в екрані на який падає атомний пучок.
Число отворів може бути дуже великим ( ~ 107 ), що дозволяє здійснювати
паралельну нанофабрикацію атомів. Переміщення наноотвору дозволяє створити
наноструктури довільного профілю. Було продемонстровано можливість створення
наноструктур з атомів Cr , Ag і In за допомогою атомного нанопера. Ширина
освічених наноструктур на напіввисоті становить 50 нм.
( b ) Атомна камера - обскура з
нанометровим дозволом. У лабораторії вперше експериментально реалізований інший
підхід до проблеми фокусування і побудови зображення в атомній оптиці,
заснований на ідеї « камери - обскури », яка використовується як в світловий
оптиці так і в сучасної експериментальної фізики в тих випадках, коли створення
фокусую чого потенціалу скрутно. В оптиці « камера - обскура » - це камера без
лінзи. Формуюче зображення світло проходить через малий отвір. Для отримання
досить чіткого зображення апертура такої камери повинна бути отвором малого
діаметру.
В атомній « камері - обскура » пучок
атомів пропускається через металеву маску, формуючи таким чином « світіння »
заданої геометрії (рис.1.2). Атоми, що пройшли через маску, надходять на
трекову мембрану, яка містить велику кількість ( 3 • 107 см - 2 ) отворів з
діаметром 50 нм. Кожне з отворів є « камерою-обскура », формує своє індивідуальне
зображення «об'єкта » на поверхні підкладки, розміщеної на відстані 5 мкм. В
результаті, на підкладці формується масив ідентичних наноструктур. На рис.1.2.
показана експериментальна установка - " атомна камера обскура ".
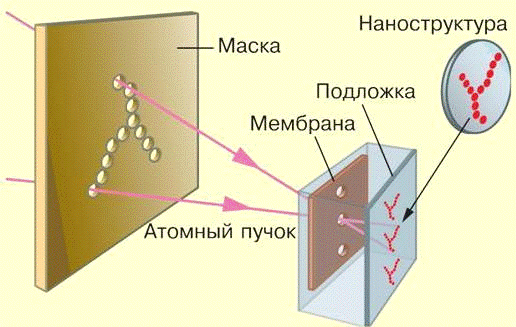
Рис.1.2
В атомній «камері-обскура» пучок
атомів пропускається через маску, формуючи таким чином «світився» заданої
геометрії. Кожне з отворів мембрани є «камерою-обскура», що формує зображення
«об'єкта» на поверхні підкладки

Рис.1.3 Фотографія атомної камери
обскура. На фотографії: (а) турбомолекулярний насос, (б) теплове джерело атомів
або молекул, (в) вимірювач вакууму, (г) високовакуумних камера з атомної
«камерою обскура»
На рис.1.3 представлені
наноструктури атомів In на поверхні кремнію отримані за допомогою атомної
«камери-обскури», в який «маска-об'єкт» була у вигляді смужок. Наноструктури
досліджувалися за допомогою скануючого атомно-силового мікроскопа [2]. Праворуч
показано детальне зображення одного із зображень. Ширина на напіввисоті
наноструктури становить значення 90 нм. Мінімальний розмір створюваних
наноструктур за допомогою атомної камери обскур становить величину порядку 30
нм.
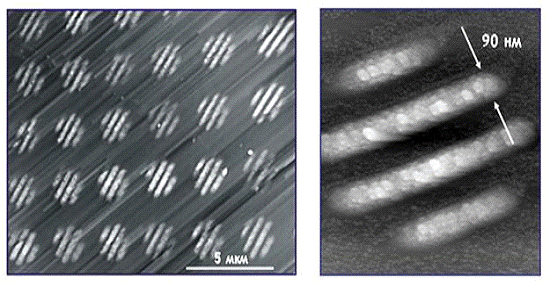
Рис.1.4 Наноструктури атомів In на
поверхі кремнію
.3
Ближньопольва оптична нанолітографія
Одним з найбільш
активно розвивающихся зараз розділів нанофотоніки є ближньопольова оптична
мікроскопія. Нанофотоніка дозволяє отримувати просторовий дозвіл, що перевищує
дифракційну межу, що, в свою чергу, відкриває широкі можливості для мікроскопії
( ближньопольової скануючої оптичної мікроскопії - БСОМ ) . При опроміненні
нанооб'єктів, поблизу нього виникає локалізоване поле, швидко зменшується з
відстанню. Є два способи для створення ближнього поля в БСОМ (див. Рис . 1.5 )
. У першому випадку Рис 1.5.а використовується мала апертура на кінці оптичного
волокна з металевим покриттям. Світло йде по волокну і опромінює невелику
область поблизу торця волокна. В останньому випадку просторовий дозвіл в цьому
випадку визначається діаметром апертури ( 10-100 нм). У другому (
безапертурному ) випадку (див. Рис .1.5.б ) ближнє поле створюється
опроміненням кінця металевої голки. Просторове дозвіл наближається до атомних
масштабами і визначається радіусом кривизни кінця голки ( 1-20 нм). Схема
установки для скануючої оптичної мікроскопії ближнього поля представлена на
рис. 1.6.
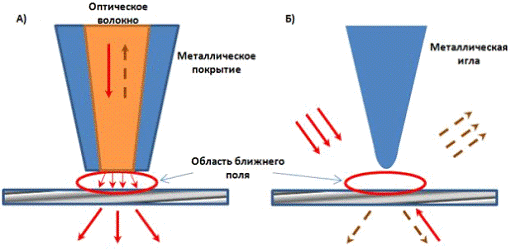
Рис. 1.5 Схема апертурного (а) і
безапертурного (б) бліжнеполевого скануючого оптичного мікроскопа. Стрілки з
суцільними лініями відповідають падаючому випромінюванню, а пунктирні лінії -
випромінюванню сигналу

Рис. 1.6 Схема установки для
скануючої оптичної мікроскопії ближнього поля
БСОМ має величезні перспективи для
різних застосувань в мікроскопії надвисокої роздільної здатності, в тому числі
в поєднанні з високою чутливістю і високим спектральним дозволом , в
нанолітографії для модифікації поверхні, в медицині та біології для локального
впливу на об'єкти, а також у багатьох інших областях.
Дослідження в області ближньополевї
оптичної мікроскопії є дуже актуальними всучаснійй нанооптиці, як з точки зору
фундаментальної науки, так і з прикладної точки зору. У даній роботі для
дослідження використовується метод комп'ютерного моделювання - метод кінцевих
різниць для рівняння Максвелла в тимчасовій формі ( Finite - DifferenceTime -
Domain - FDTD ) .
Електродинамічні рівняння Максвеллав
приватних похідних, сформульовані в 1873 р., є фундаментальним об'єднанням
електричних і магнітних полів. За допомогою рівнянь Максвелла вдалося
передбачити існування електромагнітних хвиль, Річард Фейнман назвав це
відкриття найвидатнішим досягненням науки XIX століття. В даний час чисельні
рішення рівнянь Максвелла виробляються в багатьох областях науки, в задачах про
проходження, відображенні і ламанні електромагнітних хвиль для різних додатків.
Основним методом чисельного рішення рівнянь Максвелла, який використовується в
даній роботі, є метод кінцевих різниць для рівнянь Максвелла в тимчасовій
області ( Finite - DifferenceTime - Domain FDTD ). FDTD відноситься до класу
сіткових методів розв'язання рівнянь [3]. Даний метод заснований на
нестандартній дискретизації простору з використанням центрально- різницевої
апроксимації за часом і просторовим координатам. Так як метод працює у
тимчасовій області, то він застосовний в широкому частотному спектрі, починаючи
від мікрохвиль і закінчуючи видимим частотним діапазоном. Завдяки своїй
універсальності FDTD може бути застосовний до багатьох задачам електродинаміки:
для моделювання резонаторів, хвилеводів, антен, нанооб'єктів в
електромагнітному полі, дослідження спектрів поглинання і віддзеркалення
неоднорідних і періодичних об'єктів і т. п. Розглянемо метод FDTD докладно.
Прогрес в нанофізиці і технологічний
прогрес в нано-та оптоелектроніці пов'язаний з просуванням в область все менших
просторових і часових масштабів.
Для цього потрібні принципово нові
методи створення наноструктур та їх неруйнівного контролю.
Одним з найважливіших завдань, що
стоять перед нанофізики, є розробка оптичних методів, що поєднують високу
просторову, тимчасове і спектральний дозвіл і дозволяють вивчати надшвидкі
процеси в одиничних наноструктурах, кластерах і молекулах. У цьому зв'язку ми
розглянемо ряд фізичних процесів, які можуть виникати поблизу голки скануючого
тунельного мікроскопа під дією зовнішнього електромагнітного поля. Основний
інтерес для нас представлятимуть ефекти посилення зовнішнього поля поблизу
вістря і просторова локалізація поля. Електричне поле в таких приладах як
скануючий тунельний мікроскоп ( СТМ ), зосереджено в околиці вістря, в області
з розмірами в декілька нанометрів, що і забезпечує їх надвисоке дозвіл. У
мікроскопії ближнього поля як джерело електромагнітного поля використовується
видиме світло, а основні фізичні процеси відбуваються в області з розмірами
менше довжини хвилі, тобто в ближній зоні, де структура поля може бути
визначена в рамках електростатичного наближення. У апертурному мікроскопі
ближнього поля граничний дозвіл визначається розміром отвори (і глибиною скін-
шару в металевому покритті голки) і становить десятки нм. Однак, при зменшенні
розмірів отвору різко зменшується інтенсивність виходить з скловолоконної голки
" тунелює " поля ( при зменшенні діаметра звужучуйогося
скловолоконного хвилеводу меншої інтенсивністі сильно втрачається, - довжина
хвилі світла). При цьому різко падає чутливість методу .
В даний час активно розвиваються
нові типи приладів, що використовуються для нанолокальної спектроскопії
поверхні. Цікаві можливості представляє безапертурний мікроскоп ближнього поля,
в якому голка скануючого тунельного мікроскопа поміщається в зовнішнє
електромагнітне поле. Це може бути випромінювання лазера, сфокусоване в область
під голкою, поле повного внутрішнього відображення, коли підсвічування
здійснюється знизу, поле поверхневого поляритону і так далі.
У безапертурном методі повинна
вимірюватися інтенсивність розсіяного поля в далекій зон , яка визначається
структурою поля на малих відстанях, при цьому проблема полягає у відновленні
правильної картини досліджуваної поверхні за вимірюваним полем в дальній зоні.
Перевагою безапертурного методу є відсутність вищезгаданого експоненціального
зменшення поля і пов'язаного з ним падінням чутливості.
Істотно, що локальне може поле різко
зростати поблизу вістря через ефект « громовідводу » або через резонансного
порушення власних (локальних) плазмових мод в двохзв'язної системі голка -
підкладка. При цьому керуючими параметрами, що визначають ефекти посилення
поля, є частота зовнішнього поля і відстань між голкою і підкладкою. Вістря
зондового мікроскопа може служити ефективним засобом для реєстрації поверхневих
плазмонів. Поверхневі плазмону грають дуже істотну роль в мікроскопії ближнього
поля не тільки через резонансне посилення поля, але і внаслідок малого
просторового масштабу області локалізації поля, порівнянного з розмірами
структур, на яких вони можуть збуджуватися. Вони також можуть служити
ефективним каналом перекачування енергії туннелюючих електронів у
випромінювання і так далі.
Сильне ближнє поле може бути
використане для дослідження лінійних і нелінійних властивостей наноструктур з
високим ( субхвилевим ) просторовим дозволом і модифікації поверхні на
наномасштабі, проведення фотоіндукованих нанолокальних хімічних реакцій і так
далі. Всі ці ефекти визначаються в першу чергу розподілом поля близько вістря,
причому для мікроскопії ближнього поля цей розподіл необхідно знати на частотах
оптичного діапазону.
В даний час відсутні аналітичні розрахунки
розподілу поля для вістря в реалістичній геометрії, і зазвичай розглядаються
прості модельні системи типу циліндра або сферичної частинки. Розрахунок полів
в реалістичній геометрії голки виявляється значно складнішим. Істотна
відмінність реальної голки від системи типу частинка над поверхнею полягає в
тому, що в голці можлива поява плазмових хвиль, що тікають від вістря. Спектр
плазмових хвиль в голці буде квазінепереривним, а відстань між рівнями буде
мало - обернено пропорційно довжині голки, в той час як для частинок спектр
плазмонів є дискретним. У цьому завданні є ряд принципових проблем, які не
мають повного рішення в даний час. Джерелом таких проблем є те, що завдання
дифракції електромагнітної хвилі на діелектричному вістрі ( наприклад, конусі)
поки не має рішення в аналітичній формі; рішення є тільки для ідеально
провідного вістря.
Голка зондового мікроскопа має
складну форму і не може, зрозуміло, бути описана в рамках простої модельної
системи. Мабуть, найкращим наближенням до реальної голцки могла б бути модель
тонкого, загостреного на кінці циліндра або конуса.
Метою даної роботи є розрахунок
спектра власних плазмових мод в геометрії вістря - плоска поверхня і аналіз
розподілу полів, що виникають під дією зовнішніх джерел різного виду, в тому
числі і ефекти посилення поля. Для вирішення завдання використовується
квазіелектростатичне наближення, яке зазвичай використовується для аналізу
плазмових коливань. На завершення проводиться комп'ютерне моделювання розподілу
електромагнітного поля поблизу голки, розташованої над підкладкою.
1.4
Електронно - променева літографія
Існують дві основні можливості
використання електронних пучків для опромінення поверхні пластини з метою
нанесення малюнка. Це одночасне експонування всього зображення цілком і
послідовне експонування (сканування ) окремих ділянок малюнка.
Проекційні системи , як правило ,
мають високу продуктивність і більш прості, ніж скануючі системи. Носієм
інформації про зображення є маска (шаблон). Зображення із шаблону передається
на пластину променем електронів.
Скануючі системи управляються
обчислювальною машиною, яка задає програму переміщення сфокусованого пучка
електронів для нанесення малюнка, виправляє ефекти дисторсії і розширення пучка
і визначає положення пластини [4]. Інформація про зображення зберігається в
пам'яті ЕОМ.
Безпосереднє нанесення малюнка за
допомогою ЕОМ дозволяє обійтися без шаблону. Тому електронно - променеві
скануючі системи можуть бути використані як для виготовлення шаблонів, так і
для безпосереднього промальовування на пластині. Ці установки мають високе
просторове розширення і точність суміщення, що наближаються до 0,1 мкм.
Електронно - променева літографія
для виготовлення шаблонів має явні переваги навіть у тих випадках, коли для
поєднання шаблону з підкладкою і експонування резиста застосовується спосіб
фотолітографії. ЕЛ забезпечує чудовий дозвіл ліній оригіналу, даючи можливість
поліпшити якість шаблону.
Проекційна електронно - променева
літографія
У електронно - променевій літографії
використовуються процеси, засновані на прямому малюванні малюнка на поверхні
резиста. Низька продуктивність процесу не дозволяє розраховувати на широке
впровадження цього методу у виробництво.
Спроби розробити ефективну систему
високопродуктивної проекційної ЕЛ довгий час не давали позитивного результату з
двох головних причин. По-перше, робота маски заснована на різній поглинаючій
здатності окремих ділянок малюнка. У результаті довгого опромінення відбувався
її нагрівання в результаті поглинання великої дози випромінювання. Це накладало
обмеження на прискорення напруги проекційних електронних літографії. Друга
причина полягала в тому, що при допустимих енергіях електронів не можна
застосовувати малі числові апертури через зниження глибини фокусу і поля зору
магнітних фокусуючих систем .
Проекційні системи
Електронно - променева проекційна
літографія заснована на експонуванні одиночного зображення великих розмірів для
отримання копій шаблону з лініями субмікронної товщини. Шаблон виготовляється
заздалегідь методом скануючої електронної літографії. Для виробництва
електронних приладів розроблені два різновиди променевих проекційних систем.
Система з точною передачею розмірів
У системі використовується
фотокатод, на який нанесений необхідний малюнок у вигляді тонкої металевої
плівки. Фотоелектрони, що вилітають з фотокатода, прискорюються у напрямку до
пластини напругою 20 кВ, прикладеним між катодом і пластиною. Однорідне
магнітне поле фокусує ці фотоелектрони на пластині ( аноді ) з одноразовим
збільшенням зображення.
Система із зменшенням зображення
В якості маски в такій системі
використовується вільно підвішена металева фольга. Потік електронів,
фокусований спеціальною електрооптичною системою, проходить через маску і
формує на пластині чітке зображення менших розмірів. Для десятикратного
зменшення розміру можуть бути сформовані поля діаметром 3 мм і отримана ширина
ліній до 0,25 мкм. Схема установки наведена на рис. 1.7.

Рис. 1.7 Схема проекційної системи
із зменшенням зображення
Для суміщення шаблону і зразка
використовується режим сканування. У цьому режимі електронний промінь
фокусується на шаблоні (а не на зразку, як при проектуванні зображення ) і
сканується по ньому так, що на зразок потрапляє зображення від цього
сфокусованого променя.
Променево скануючі системи
З гаусовим розподілом ;
З квадратним перетином ;
З круглим перетином .
При отриманні гауссового розподілу
використовується той же принцип, що і при формуванні променя в звичайному
електронному скануючому мікроскопі. За допомогою двох або більше лінз електрони
фокусуються на поверхню пластини так, що початкові розміри пучка, що йде від
джерела електронів, зменшуються. Система володіє достатньою гнучкістю, оскільки
розміри сформованого пучка можуть змінюватись в широких межах шляхом зміни
фокусної відстані електронних лінз.
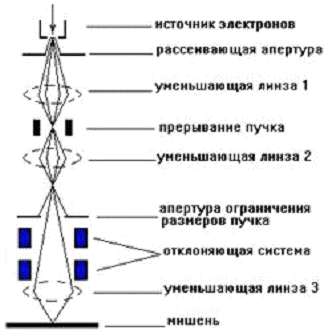
Рис. 1.8 Скануюча проекційна система
з гаусовим розподілом
Методи профілювання променя в
системах з експозицією електронами дуже різноманітні. Основою складних профілів
є промінь круглого перетину з гаусовим розподілом щільності струму, що
забезпечує експонування однієї точки зображення за деякий час. Розмір такого
пучка, відповідає напівширині гауссового розподілу, визначає просторовий дозвіл
і зазвичай в 4-5 разів менше мінімального розміру малюнка.
Існує два основних способи
переміщення пучка :
. Растровий спосіб переміщення.
Пучок сканується по всій області
кристала і для створення потрібного малюнка включається і вимикається в певні
моменти часу [5]. При растровому способі пред'являються менш жорсткі вимоги до
системи відхилення пучка, тому що внаслідок багаторазового повторення процесу
сканування спотворення, пов'язані з вихровими струмами і гістерезисом, легко
можуть бути скомпенсовані .
. Векторний спосіб переміщення.
Пучок переміщається тільки в ту
область, де необхідно провести експонування. Як правило, наноситься малюнок розкладається
на ряд найпростіших фігур. Векторне сканування ефективніше, але вимагає
використання досконалого відхиляння.
Контроль взаємного розташування
електронного пучка і пластини може здійснюватися методом порівняння становища
контрольної мітки або за допомогою точного визначення положення столу лазерним
інтерферометром. У мікроелектроніці контрольні мітки виготовляються у вигляді
тонкоплівкових смужок з матеріалу з великим атомним номером або спеціального
топографічного малюнка з матеріалу, що має атомний номер, рівний або близький
атомному номеру підкладки. При скануванні поверхні електронний пучок проходить
області, де нанесений інший матеріал, в результаті чого виробляється
відповідний сигнал.
В якості резиста зазвичай
використовують позитивні резисти, отримані на основі поліметилметакрилату (
ПММА ). Для позитивних резистів експонування електронним пучком викликає
зменшення його молекулярної ваги при розриві зв'язків між молекулами,
збільшуючи їх розчинність. Для негативного - опромінення стимулює утворення
поперечних зв'язків в молекулах полімеру. У результаті утворюється складна
слаборозчинна тривимірна молекулярна структура з великою щільністю. Розбухання
негативних резистів обмежує роздільну здатність до 1 мкм. Для позитивних - вона
становить 0.1 мкм.
Електронно - променева літографія (
ЕЛ ) єдиний спосіб створення наноструктур. Однак використовуються літографічні
процеси, засновані на прямому малюванні малюнка на поверхні резисту. Подібний
спосіб експонування хороший для наукових цілей і у виробництві фотошаблонів.
Низька продуктивність процесу не дозволяє розраховувати на широке впровадження
цього методу у виробництво.
Спроби розробити ефективну систему
високопродуктивної проекційної ЕЛ довгий час не давали позитивного результату з
двох головних причин. По перше, робота маски, заснована на різній поглинаючій
здатності окремих ділянок малюнка, приводила до нагрівання маски в результаті
поглинання великої дози випромінювання. Все це обмежувало прискорена напруга
проекційних електронних літографій. Друга причина полягала в тому, що
застосування допустимих енергій електронів не допускала застосуванні малих
числових апертур, що призводило до зниження глибини фокусу і поля зору
магнітних фокусуючих систем. Далі, великі струми променя, що забезпечує високу
продуктивність системи, руйнували високий дозвіл з причини впливу просторового
заряду.
Розуміння обмежень адсорбційної ЕЛ
до появи нових проекційних ЕЛ систем, одна з яких отримала назву SCALPEL.
Головна відмінність нових систем від попередніх полягає у використанні нового
типу масок. Маска системи SCALPEL являє собою набір мембран, виготовлених з
легких елементів, з високою проникністю для електронів. Сам малюнок утворений
матеріалом з високою відбивною здатністю до електронів. Принцип роботи системи SCALPEL
представлений на рисунку 1.9 і 1.10.

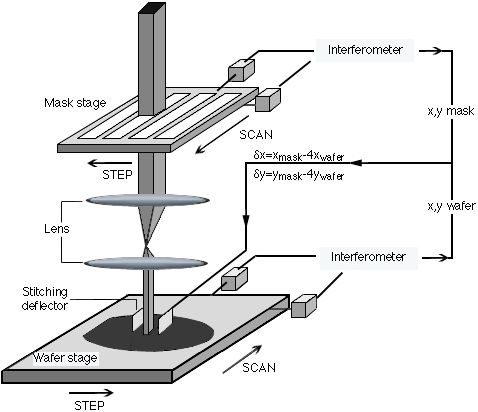
Рис. 1.9 Принцип роботи и схема
установки системи SCALPEL
Електрони проходять через мембрани
розсіюються на малі кути, тоді як малюнок розсіює електрони на великі кути.
Апаратура, розташована в зворотній фокальній площині польової оптичної системи
пропускає електрони, розсіяні на малі кути і не пропускає електрони, розсіяні
на великі кути, що призводить до формування на підкладці висококонтрастного
зображення. При цьому в масці не відбувається значного поглинання електронного
потоку, що мінімізує теплову нестабільність маски (рис 1.10)
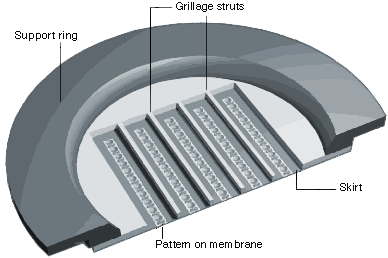

Рис.1.10 Принцип роботи установки
2. УЛЬТРАФІОЛЕТОВА
НАНОЛІТОГРАФІЯ.
2.1 Екстримальна ультрафіолетова нанолітографія
Основою інформаційних (комп'ютерних)
технологій є передова елементна база для створення комп'ютерів, пристроїв
автоматики і комунікації тощо (діоди, транзистори, елементи опто- та
наноелектроніки великі і надвеликі інтегральні схеми, процесори та ін.).
Створення великої інтегральної схеми
являє собою складний технологічний процес, що складається з ряду основних
технологічних стадій.
. Підготовка, що включає в себе:
• різку кремнієвих підкладок з
болванки чистого кремнію;
• забезпечення хімічними матеріалами
і газами для виготовлення чіпа і металами (алюміній, мідь і золото) для
провідників в чіпі;
• забезпечення джерелом УФ
випромінювання для експонування фоторезистів;
• виготовлення маски.
. Виготовлення, що включає в себе
наступні технологічні процеси:
• окислення кремнію
високотемпературним нагріванням в атмосфері газу;
• нанесення і розчинення
фоторезиста;
• опромінення фоторезиста джерелом
УФ випромінювання через маску з бажаною топологією чіпа;
• хімічне травлення оксиду кремнію і
напилюваних матеріалів;
• іонна імплантація ( допирування )
кремнію;
• нанесення полікристалічного
кремнію і металевих плівок (провідників).
В цілому, при виробництві чіпа
описані вище процедури виконуються приблизно на 20 шарах, формуючи ЗD-
структуру. Загальне число операцій при виробництві одного чіпа перевищує 250
[7]. Для збільшення продуктивності (зменшення вартості виробу) одночасно на
одній кремнієвій пластині виготовляються сотні ідентичних чипів, а стандартні
пластини досягають у діаметрі 300 мм. 3. Тестування, різка та упаковка чіпів.
Після виготовлення чіпів на пластині всі електричні ланцюги кожного чіпа
тестуються. Потім пластина розрізається алмазним інструментом і кожен чіп
відділяється. Чіп встановлюється в герметичний корпус, знову тестується і після
проходження тесту він готовий до використання.
. Випробування виготовлених виробів.
Випробування проводяться для з'ясування їх надійності та ймовірності відмов.
Основні технічні характеристики
чіпа, такі як щільність інформації, швидкість передачі даних, енергоспоживання,
в чому визначаються розмірами електронних компонентів, насамперед транзисторів
[8]. Для мінімізації цих розмірів ключовою ланкою в технологічному процесі є
літографічне устаткування, що включає в себе джерело УФ випромінювання
(ексимерний лазер), оптичну систему перенесення зображення, систему
позиціонування, сканування та суміщення маски і фотошаблона.
В даний час основні успіхи в області
субмікрометрової літографії пов'язані із застосуванням випромінювання ексимерних
лазерів з довжинами хвиль 248 і 193 нм. Світовим лідером з виробництва
літографічного обладнання є компанія ASM Lithography (Нідерланди). Продукція,
що випускається ними літографічна установка TWINS - CAN ™ AT: 1200B , оснащена
20 -ватним ArF ексимерним лазером з робочою довжиною хвилі 193 нм, забезпечує
просторовий дозвіл 80 нм на пластинах з діаметром 300 мм.
У табл. 2.1. наведені параметри
інтегральних схем, досягнуті до теперішнього часу і прогнозовані, отриманих з
використанням різних технологій. У табл. 2..2 представлені технології
експонування фоторезистов, які повинні в перспективі забезпечити виробництво
інтегральних схем, наведених у табл. 2.1.
Таблиця 2.1 Прогнози параметрів
ультраввеликих інтегральних схем
|
Параметри
|
1999 р.
|
2001 р.
|
2003 р.
|
2006 р.
|
2009 р.
|
2012 р.
|
2015-2020 рр.
|
|
Мінімальні розміри, нм
|
180
|
150
|
130
|
90
|
70
|
50
|
10
|
|
Ємність па’яті на чіпах (експерементальні),
біт
|
1 Г
|
|
4Г
|
16 Г
|
64 Г
|
256 Г
|
|
|
Ємність пам’яті на чіпах (виробництво), біт
|
256 М
|
1 Г
|
4Г
|
16 Г
|
64 Г
|
|
|
Число транзисторів в 1 см2
|
6,2 М
|
10 М
|
18 М
|
39 М
|
84 М
|
180 М
|
1 Г
|
|
Частота на чіпах, МГц
|
500-1250
|
600-1500
|
700-2100
|
900-3500
|
1200-6000
|
1500-10000
|
5000-30000
|
|
Максимальна розсіювана потужність, Вт
|
90
|
ПО
|
130
|
160
|
170
|
175
|
250-500
|
|
Розмір чіпа, мм2
|
400
|
445
|
560
|
820
|
1120
|
1580
|
|
|
Число рівнів з’днань
|
6-7
|
7
|
13
|
20
|
22-25
|
20-25
|
|
До наведених таблиць потрібно
ставитися дуже обережно, оскільки практика показала, що якраз в області
вдосконалення технології мікроелектроніки все відбувається значно швидше, ніж
планується. Так, помилка в прогнозах отримання мінімальних розмірів в малюнках
на чіпах, опублікованих у 1994 і в 2001 рр.., склала за такий короткий термін
дев'ять років.
Таблиця 2.2 Тенденції развитку
літографії
|
Ємність пам’яті на чіпі, біт
|
Рік
|
Розширення, мкм
|
Технологія експонування фоторезиста
|
|
64 М
|
1995
|
0,3-0,35
|
Випромінювання ексимерних KrF лазерів (l = 248
нм)
|
|
256 М
|
1998
|
0,25
|
Випромінювання ексимерних ArF лазерів (l = 193
нм)
|
|
1 Г
|
2001
|
0,18-0,13
|
Випромінювання ексимерних KrF лазерів (l = 248
нм) и ArF лазерів (l = 193 нм)
|
|
4 Г
|
2004
|
0,13-0,1
|
Випромінювання ексимерних ArF лазерів (l = 193
нм), EUV-літографія
|
|
16 Г
|
2007
|
0,1
|
Випромінювання ексимерних F2 лазерів (l = 157
нм), EUV-літографія
|
|
64 Г
|
2010
|
EUV-літографія
|
|
256 Г
|
2013
|
0,03-0,04
|
EUV-літографія
|
Як видно з таблиць, використання УФ
випромінювання дозволило отримати мінімальний розмір елемента чіпа на рівні
0,01 мкм. Фундаментальним перешкодою на шляху зменшення розмірів елементів
інтегральних схем є дифракційне спотворення зображення УФ випромінювання на
лінзах, апертурах і масках літографічної установки. До теперішнього часу
збільшення розміру лінз практично вичерпало свої можливості як з економічної
точки зору (вартість високоапертурний лінз), так і з технологічної.
Тому провідними світовими
виробниками великих інтегральних схем (Intel, AMD) розглядається (і
реалізується ) наступна стратегія. Для коректування зображення маски
використовуються додаткові прямокутники, які незважаючи на дифракцію
випромінювання дозволяють отримати бажане розподіл освітленості на підкладці [9].
Інше рішення полягає в застосуванні спеціальних, так званих фазоздвигаючих
масок. У цих масках на їх поверхню селективно наносяться матеріали, що
перекривають пучки, які призводять до розмитості зображення, викликаної
дифракцією (рис.2.1).

Рис.2.1 а) Шаблон без здвига фази.
б) Шаблон з фазовим здвигом
Обидва ці методи помітно ускладнюють
конструкцію масок, що призводить до істотного браку при їх виробництві (від 30
до 50%), а також подорожчання кінцевого продукту. Крім економічної проблеми
виникають і чисто технічні, пов'язані як з розрахунками коригувальних елементів
(наприклад, розрахунок 22-25 масок з корекцією зображення для процесора,
побудованого за технологією 90 нм вже вимагає більше 200 Гбіт даних), так і з
точністю їх виготовлення. Таким чином, це стратегія, спрямована на зменшення
мінімального розміру елемента інтегральних схем, також має обмежені можливості.
Перспективною стратегією в рамках УФ
літографії є зменшення довжини хвилі випромінювання, зокрема, перехід до
довжини хвилі 157 нм (випромінювання ексимерного p2 лазера). Проте можливості
цієї технології для переходу до розмірів елементів нанометрового діапазону
також обмежені (див. табл. 2.1 ).
Кардинальний перехід, до якого
реально готова світова спільнота, пов'язаний з освоєнням діапазону
екстремального ультрафіолетового випромінювання ( ЕУФ ) з довжиною хвилі 13 нм.
У США, враховуючи практичну важливість створення технології EUV - літографії (
область екстремального ультрафіолетового випромінювання ), велику вартість і
складність розробки, у вересні 1997 р. для вирішення цієї проблеми була
створена так звана Віртуальна Національна Лабораторія ( VNL ), що включає крім
національних лабораторій Міністерства енергетики ( Lawrence Berkley, Liver -
more and Sandia National Laboratories ) приватні компанії, такі як Intel ,
Motorola, Advanced Micro Devices ( AMD). Уже в березні 1999 р. в фірмі Motorola
із застосуванням цієї технології були отримані малюнки з просторовим дозволом
до 30 нм. У 2000 р. в Ліверморської національної лабораторії був виготовлений
перший варіант ( a - tool ) установки суміщення і експонування (так званого
степпера ) і в даний час проходить стадія p - tool випуску малої серії [10].
У Європі фірмою- координатором робіт
в області EUV - літографії є ASM Lithography ( Нідерланди ), яка в подальшому і
буде виготовляти степпери. Можна також відзначити, що основним виробником
степперів побудований спеціальний корпус і проходять стадії монтажу і
випробування вузли степпера. Фірма Carl Zeiss відповідає за оптику, ASM
Lithography практично відповідає за вибір джерела випромінювання [11].
Намічалося, що виготовлення та випробування a - tool степпера повинні бути
закінчені в 2004 р., p - tool в 2005 р., y - tool в 2007 р. Передбачається, що
Європа буде дуже незначно відставати в області проекційної літографії від США .
Подібні дослідження активно
проводяться в Японії. Існує національна програма " EUVL Research Program
at ASET ", в яку включені багато дослідницькі групи. Плани створення повної
технології EUV - літографії практично збігаються з планами США.
Слід зазначити, що західні фірми і
фірми Японії широко використовують російських і українських вчених ( за різними
контрактами), які, без перебільшення займають провідне положення в розробці
техніки і технології EUV - літографії.
Зараз силами ІФМ РАН , ФТІ ім. Іоффе
РАН , ТРІНІТІ , НІІІС і деяких інших інститутів успішно розвивається EUV -
літографія , яка забезпечить зменшення топологічних розмірів від 0,04 до 0,01
мкм.
Об'єднання цих технологій
забезпечить нам до середини XXI століття провідні позиції у світі в галузі
виробництва великих і надвеликих інтегральних схем .
За прогнозами SEMITECH, основним
напрямом, який визначатиме розвиток електроніки ( наноелектроніки ) з 2010 р.,
буде EUV - літографія на довжині хвилі 13,5 нм [12]. Цей напрямок дуже
динамічно розвивається в США, Європі і Японії. У науковій частині проектів
задіяна значна група російських та українських інститутів та окремих науковців.
Багато років ІФМ РАН бере участь у зарубіжних проектах і зараз має передові
позиції і розуміння проблеми. З 2003 р. в ІФМ РАН ведеться проект по створенню
макета літографа. Зараз проектується літограф малої продуктивності для
спецвиробництва. У разі придбання передового мікроелектронного виробництва
можна буде почати розробку літографа, який згодом замінить штатний .
2.2
Проблеми і перспективи ультрафіолетової нанолітографії
У мікроелектроніці
найперспективнішою технологією створення елементів розміром 16-22 нм вважають
літографію, працюючу в граничному УФ- діапазоні на довжині хвилі 13,5 нм. Її
називають EUV - нанолітографією (extreme ultraviolet). Запропоновано концепцію
створення вітчизняного EUV - наносканера з шести дзеркальним проекційним
об'єктивом з числовою апертурою NA ≥ 0,3.
Підкреслено домінуюча роль у виборі
технологи показника СОО ( cost of ownership ).
Безсумнівно, в сучасному
мікроелектронному виробництві ключовим технологічним ланкою є літографія. Вона
визначає контури деталей елементів мікросхеми, плазмові процеси і імплантацію, що
використовуються у виготовленні цих елементів ( приблизно 60-70 % всіх процесів
в маршруті виготовлення кремнієвих інтегральних схем) .
Основні світові розробники і
виробники обладнання для EUV - нанолітографії - EUV - наносканеров (рис.2.2) ,
є фірми ASML ( Нідерланди ) і Nikon (Японія). Провідні фірми- виробники
електронної техніки, використовуючи це літографічне обладнання, вже освоїли
серійний випуск НВІС для пристроїв пам'яті з технологічним рівнем (мінімальний
розмір елементів) 30 нм і 40 нм для логічних пристроїв. У планах корпорації
Intel освоїти 32 -нм норму в 2009-2010 роки Інтенсивні дослідження наближають
літографічні технології до промислового виробництва НВІС рівня 28 нм. На рис.
2.3 наведена дорожня карта фірми ASML по створенню EUV - наносканеров. Введення
технології рівняхня 16-22 нм і менш очікується в 2016-2017 роки, а по
оптимістичним прогнозами Samsung Electronics - до 2015 року.
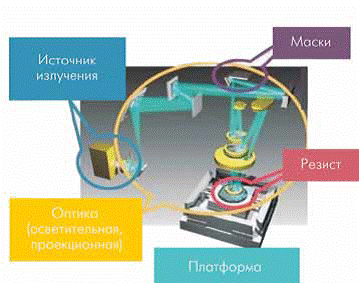
Рис. 2.2 Загальна схема
EUV-наносканерів
При цьому актуальним є створення
вітчизняного DUV - наносканера на базі лінзового і дзеркально - лінзового
проекційних об'єктивів ( ПО) ( рис.2.3) для варіантів «сухий » і іммерсіонний
193 -нм літографії (рис. 2.4), відповідно. При оцінці техніко - економічних
показників і параметрів наносканера їх технічні характеристики являються
визначальними. Для іммерсіонної літографії в якості рідини нині
використовується деіонізована вода).
Відомо, що критерій Релея визначає
теоретична межа дозволу оптичних систем ( для тест- об'єкта у вигляді
періодичної структури). Він визначає дозвіл або мінімальний розмір ( W)
елемента структури, що може бути реалізований в шарі фоторезиста на
напівпровідниковій пластині при використанні ПЗ з числовою апертурою (NA) на
робочій довжині хвилі випромінювання λ
відповідно до виразу: W = k1 ⋅
λ
/ NA [13]. Де W - це загальний критерій оцінки рівня технології виробництва
НВІС, чисельно він дорівнює половині відстані між осередками DRAM мікросхеми
або половині кроку ( HP - half pitch ) щільною лінійчатої структури ( іноді
DRAM half pitch). Технологічність методу проекційної фотолітографії, в першому
наближенні, визначається значенням параметра k1. Цей комплексний параметр
залежить від якості (чутливості) фоторезиста і варіації тихнології поліпшення
дозволу (RET - resolution enchancement technology).
У разі одноразової експозиції її
визначає тип освітлення фотошаблона і його структура. Відповідно до теорії
дифракції мінімальне значення k1 = 0,25. Але при цьому не ясно, чи можливо
реалізувати в промислових масштабах такий технологічний процес. У іммерсіонній
літографії, якщо взяти для води показник заломлення n = 1,45, максимально
досяжне значення синуса половинного кута 0,95. Тоді отримуємо NA = 1,38 і k1 =
0,25. А межа дозволу W ~ 35 нм. Порівняємо: у разі EUV - літографії λ
= 13,5 нм така межа дозволу може бути досягнутий для значень NA ~ 0,25 і k1 =
0,59. Створення дзеркально - лінзового ПО потребує розробки і впровадження
сучасних технологій виготовлення і контролю його дзеркальних компонентів.
Частина з них може бути використана і в якості підкладок для EUV - дзеркал, що
представляють собою « бреггівське » покриття з 9-11 чергуються Mо / Si
мультишарів.

Рис.2.3 Програма фірми ASML по
створенню EUV - наносканерів
Іншим критерієм, що визначає
потенційні можливості технології в масштабах промислового виробництва, є
продуктивність, або кількість відпрацьованих на годину напівпровідникових
пластин (діаметри: 150, 200 або 300 мм) при заданому розмірі чіпа (типові
розміри: 22х22мм2 або 26х32мм2). Цей показник ( при заданій потужності джерела
випромінювання) залежить від швидкодії технологічного циклу проходження
напівпровідникових пластин в літографічної установці, яка визначається
конструктивними особливостями її платформи. Так, фірма ASML це завдання вирішує
на базі платформи TWINSCAN (мал.2.6), основна ідея якої полягає в наявності
двох ідентичних столів для напівпровідникових пластин та реалізації паралельних
процесів: експонування однієї напівпровідникової пластини ( праве положення
столу) і одночасної метрологічної підготовки і координатної прив'язці другий
напівпровідникової пластини. Аналогічну ідею використовувала фірма Nikon
(платформа Tandem, але її конструкція вимагає доробки) .
Вимоги, що пред'являються до базових
критичним елементам, впливають на вимоги до оптичних елементів: шорсткість
поверхні дзеркал ( при діаметрі 100мм) - не більше 0,2 нм ( СКО ), похибка
товщин індивідуальних шарів покриттів - не більше 1 %, що складає долі
ангстрема ( при товщині шарів Si і Mо 4,1 нм і 2,7 нм) [14]. Для 193 -нм DUV -
наносканера лазерний джерело випромінювання і сама установка повинні
розташовуватися в різних по класу приміщеннях ( для джерела потрібна більш
низький клас чистоти) і на відстані до 6-8 м з підведенням випромінювання. Істотною
відмінністю EUV - наносканера є інтегрована конструкція джерела випромінювання
і колекторного дзеркала. А це вимагає ефективної системи охолодження дзеркала.

Рис.2.4 Проекційні об'єктиви для
нанолітографії: а) лінзовий NA 0,85; б) дзеркально-лінзовий NA> 0,85
У Європі , Японії та США роботи з
EUV - літографії почали в 90 -х роках для технології 100 нм. Подальше зменшення
технологічних норм в кінці 90 -х призвело до технології 65 нм, а в 2000 -х -
послідовно до 45 нм і 32 нм. Впровадження описуваної технології у промислове
виробництво виключно складна технічна проблема, що вимагає для свого рішення і
значної фінансової підтримки. Зокрема, з цієї причини впровадження EUV -
літографії для технологічної норми 32 нм відкладають кілька років, її
намагаються замінити на нові технологічні варіанти 193 нм літографії
(наприклад, технологію подвоєння щільності ліній мікроструктури (DP - Double
patterning) що відтворюється в шарі фоторезиста на напівпровідниковій пластині
і комп'ютеризовану літографію ( computational lithography ). В останні роки EUV
- літографія кинулася в область нижче 22 нм.
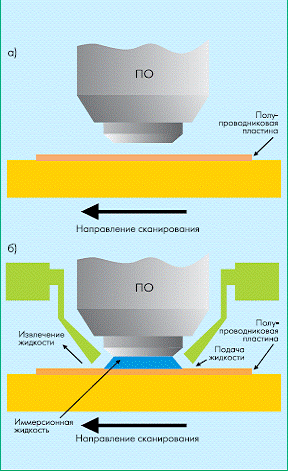
Рис.2.5 Літографічні процеси а) <
сухий > варіант, б) іммерсіонний варіант
Відзначимо історичну закономірність
у розвитку технології в частині значень NA, числової апертури ПО, і
технологічного параметра k1 (рис.2.7). Еволюційний перехід до EUV - літографії
повертає нас до «старих добрих часів» великих значень k1 і малих значень NA. З
техніко-економічної точки зору впровадження EUV - літографії означає перехід до
технології з більш високою економічною ефективністю [15]. Для її кількісної
оцінки за кордоном прийнято використовувати універсальний показник cost of
ownership ( COO ) , назва якого на українську мову можна перекласти дослівно як
«вартість володіння» (тієї чи іншої технологією) [17]. Це питання практично не
висвітлювався в українсько науково - технічній літературі і практично ніколи не
обговорювалося публічно.
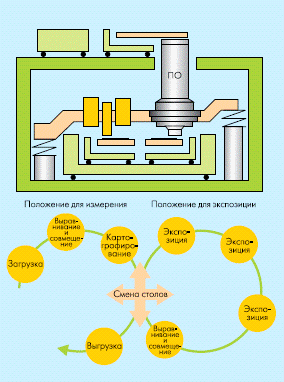
Рис.2.6 Принцип роботи платформи
TWINSCAN
При цьому відзначимо, що згідно
International SEMATECH, чотири основних фактори: кількість напівпровідникових
пластин, оброблених одним фотошаблоном, - коефіцієнт використання фотошаблона
(WPM - wafer per mask); вартість фотошаблона; вартість літографічної установки
та її продуктивність вносять основний внесок у значення показника COO. У разі
застосування літографічного обладнання, що характеризується низьким значенням
WPM, основний внесок у значення показника COO даватиме вартість фотошаблона
[18]. У той час як при високих значеннях WPM основний внесок визначатимуть
вартість установки і її продуктивність. Саме економічна доцільність
використання EUV - літографії для великомасштабного виробництва НВІС підтримує
її інтенсивний розвиток. Адже всім відомі супроводжуючі її технічні проблеми і
фінансові витрати. У жовтні 2009 року пройшов міжнародний симпозіум з питань
193 -нм іммерсіонної літографії та EUV - літографії ( 2009 International EUVL
and 193 nm Immersion Extensions Symposia ). Його учасники підкреслили
домінующая роль СОО над іншими техніко - економічними показниками при переході
на норму 22 нм. Виділили умови, необхідні для впровадження EUV - технології у
промислове виробництво.
Наявність бездефектних масок, які
зберігали свої параметри протягом життєвого циклу, і комплекс обладнання для
контролю та класифікації дефектів масок.
Довготривалий режим роботи джерела
випромінювання з потужністю 100 Вт в проміжному фокусі і енергією порядку 5 МДж
на день.
Матеріал резисту який одночасно
повинен задовольняти вимогам по дозволу, чутливості та розмиття краю лінії
(line edge roughness - LER).
Вже помітні досягнення в розробках
EUV - резисту. Наприкінці 2009 року з'явилося повідомлення про успіхи
корпорації Toshiba ( Японія ) у розробці фоторезиста з високою роздільною
здатністю, призначеного для EUV - літографії з технологічною нормою 20 нм [19].
У його основі - похідні низькомолекулярної речовини Труксен (truxene ).
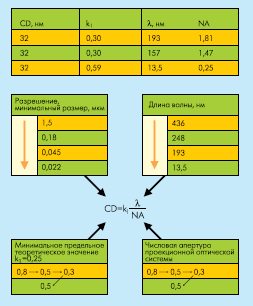
Рис.2.7 Еволюція характерних
параметрів фотолітографічного процессу
ВИСНОВКИ
літографія сьогодні розглядається
фахівцями як один з найперспективніших в майбутньому методів виготовлення
інтегральних мікросхем. Ця технологія не має обмежень у плані мініатюризації, що
вигідно відрізняє її від оптичної літографії, яка вже сьогодні наближається до
своїх кордонів застосовності .
У разі EUV літографії застосовується
метод « видавлювання » певного рельєфу на підкладці з подальшим формуванням
необхідних для функціонування мікросхеми структур. Цей метод спочатку
розроблявся в якості варіанту для подальшої мініатюризації інтегральних
мікросхем, коли інші методи себе вичерпають.
При написанні даної курсової роботи
проведено огляд наукової літератури стосовно проблеми нанолітографії в
електроніці.
. В першому розділі приведений опис
методів нанолітографії:
механічна нанолітографія;
атомна нанолітографія;
ближньопольова
нанолітографія;
електронна променева
нанолітографія.
. Другий розділ присвячений розгляду
ультрафіолетової нанолітографії (УФ), або як її називають екстремальна УФ
нанолітогоафія. Приведені дані розвитку EUV - літографії і очікувані прогнози
(але варто зауважити, як вже описувалось вище не потрібно надіятися на
запропоновані прогнози, адже почався активний розвиток нанолітографії такими
країнами як США, Японія і країни Європи в складі яких працюють і наші
співвітчизники).
променевий літографія растровий атомний
СПИСОК ВИКОРИСТАНОЇ ЛІТЕРАТУРИ
1. Алферов
Ж.И., Асеев А.Л., Талонов С.В., Копьев П.С., Панов В.И., Полторацкий Э.А.,
Сибсльдин Н.Н, Сурис Р.А. Наноматериалы и нанотехнологий // Микросистемная
техника, 2003. №8. С. 3-13.
. Shmaenok
L.A. et al. Novel instrumentation for in- and out of band metrology of EUVL
sources.- Proceedings of 2nd International EUV-Symposium, Belgium, 2003.
3. Гапонов
С.В. Работы в области проекционной EUV- литографии в рамках российской
программы. - Материалы симпозиума «Нанофизика и наноэлектроника», 2005. -
Нижний Новгород: ИФМ РАН , 2005,т.1.
. Chkhalo
N.I. et al. Manufacturing and investigation of objective lens for ultrahigh
resolution lithography facilities. - Proc.SPIE, 2008, v.7025.
. Bibishkin,
M. S. et al. Multilayer Zr/Si filters for EUV lithography and for radiation
source metrology. - Proc. SPIE, 2008, v.7025.