Многоуровневая металлизация ГИС и БГИС на основе анодированного алюминия
Министерство
образования Республики Беларусь
БГУИР
Факультет
заочного обучения
Кафедра:
Микро- и наноэлектроники
Контрольная
работа
по
дисциплине: «Технология изготовления интегральных микросхем»
г.
1. Многоуровневая металлизация ГИС и
БГИС на основе анодированного алюминия
Планаризация.
Увеличение функциональной сложности микросхем
связано с увеличением числа элементов и межэлементных соединений. Для
уменьшения площади, занимаемой металлизацией, её размещают на нескольких
уровнях, разделённых друг от друга изоляционными слоями. Металлические слои
многоуровневых систем должны отвечать тем же требованиям, что и слои
одноуровневых систем металлизации. Одной из проблем металлизации является
достижение равномерного воспроизведения ступенчатого рельефа на поверхности
подложки. К началу металлизации пластина уже имеет на поверхности много
ступенек. На рисунке 1 показан уровень заполнения ступенчатого рельефа
поверхности подложки. К проблемам металлизации относится также травление слоя
металла, поскольку обычное травление раствором для ИС использовать нельзя. На
рис. 2 схематически показаны дефекты контактов двух уровней металлизации в
результате изотропного травления. Так как металл подвергается травлению под
маской, то необходимо вводить поправку на уменьшение ширины ливни в процессе
литографического переноса топологического рисунка схемы из-за подтравливания
металла. С уменьшением планарных размеров и сближения линий компенсация
подтравливания металла становится физически невозможной. Таким образом,
необходимо использовать анизотропное травление. После проведения процесса
травления металлической пленки возможно появление скрытых дефектов
межсоединений (рисунок 3).
Проблему покрытия ступенек на поверхности
пластины можно решить несколькими способами. Во-первых, повышение температуры
подложки во время осаждения пленки (~300°С) приводит к большей поверхностной
подвижности молекул осаждаемого материала, за счет чего уменьшаются размеры
разрывов, образующихся в углах ступенек. Другим способом является оптимизация
ориентации подложек относительно источника.
Проведение оптимизации особенно важно из-за
появления участков геометрической тени в процессе осаждения при использовании
точечных источников, таких, как применяемые при электронно-лучевом или индукционном
нагреве расплава. Важным моментом в данном случае является применение объемных
методов осаждения металлических пленок. Выравнивание поверхности пластин ИС
можно выполнить с использованием процессов планаризации. Планаризация является
низкотемпературным процессом, при котором сглаживается рельеф поверхности
пластины. Существуют несколько методов планаризации. Рассмотрим некоторые из
них. Наиболее распространен метод оплавления фосфорно-силикатным стеклом
(рисунок 4). Сглаживание рельефа достигается за счет оплавления ФСС.
Температура оплавления зависит от концентрации фосфора в SiО2 (1020 см-3 Р в
ФСС - 11000С, 1021 см-3 Р в ФСС - 10000С). Повышение концентрации ФСС в SiО2
увеличивает гигроскопичность ФСС, что может привести к коррозии металлизации.


а) удовлетворительная б)
неудовлетворительная
Рисунок 1 - Уровень заполнения ступенчатого
рельефа поверхности подложки
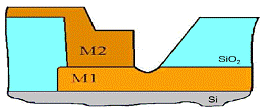
а) подтравливание первого слоя металла
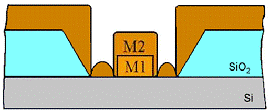
б) разрыв второго слоя металла на ступеньке
межслойной изоляции
Рисунок 2 - Дефекты двухуровневой металлизации
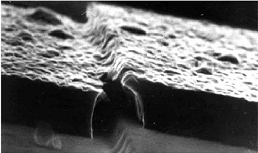
Рисунок 3 - Скрытый дефект Al - межсоединения на
ступеньке SiО2
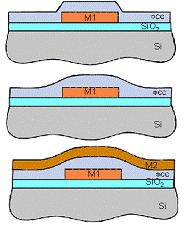
Рисунок 4 - Формирование металлизации
оплавлением фосфорно-силикатным стеклом
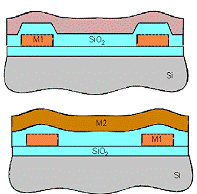
Рисунок 5 - Формирование металлизации методом
планаризации плазменным травлением
В методе планаризации плазменным травлением
сглаживание рельефа достигается за счет равенства скоростей травления резиста и
окисла (рисунок 5). На диэлектрик наносят толстый слой резиста, и структуру
подвергают процессу плазменного травления, характеризующемуся одинаковой
скоростью стравливания диэлектрика и резиста. Для обеспечения процесса
планаризации необходим промежуточный слой диэлектрика с толщиной, большей
обычной (примерно в два раза).
Другим подходом к планаризации поверхности
пластины при создании металлизации является метод «взрывной» литографии.
В методе «взрывной» литографии на пластине
формируют обратный топологический рисунок и осаждают слой металла на
маскированную фоторезистом подложку. Затем истинный топологический рисунок
отображается путем снятия литографической маски и ненужных областей
металлической пленки.
Снятие выполняется с использованием растворов,
которые растворяют итографическую маску, поднимая таким образом металлическое
покрытие. Когда металл осаждается через отверстия литографической маски, он
попадает непосредственно на подложку и остается там после удаления остальной
металлической пленки.
Если маскирующий слой образован термически
нестабильными металлами, то накладываются ограничения на температуру подложки
во время осаждения пленки, которые снижают полезные свойства слоя металла.
Маскирующий слой должен также противостоять операции очистки перед осаждением.
На рисунке 6 показан более простой маршрут
формирования структуры металлизации с помощью «взрывной» литографии.
При создании современных ИС широко используется
метод планаризации с применением химико-механической полировки (рисунок 7).
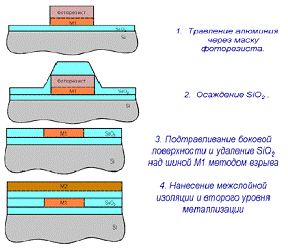
Рисунок 6 - Формирование металлизации с помощью
«взрывной» литографии
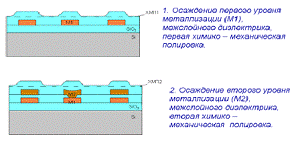
Рисунок 7 - Формирование металлизации с
применением химико-механической полировки

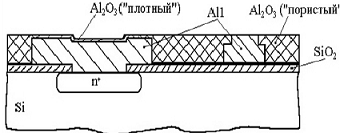
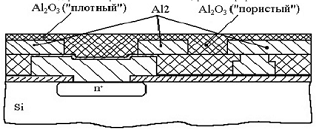
Рисунок 8 - Формирование ''бесступенчатой''
многоуровневой металлизации Al-Al2О3-Al
Термическое окисление Si, фотолитография
“контакт 1”, осаждение первого слоя алюминия, фотолитография “металл 1”,
пористое анодирование первого слоя алюминия, удаление фоторезиста.
Плотное анодирование первого слоя алюминия,
фотолитография “контакт 2”.
Осаждение второго слоя алюминия, фотолитография
“металл 2”, пористое анодирование второго слоя алюминия, удаление фоторезиста,
плотное анодирование второго слоя.
При создании планарной структуры кристаллов ИС
используется ''бесступенчатая '' многоуровневая металлизация Al- Al2О3- Al. Её
созданиеосновано на возможности варьирования свойствами окисла в зависимости от
состава электролита и режимов проведения анодирования. Суть получения
металлизации сводится к следующему: первое неглубокое окисление (режим плотного
анодирования) проводится для создания диэлектрической защитной маски от
замыканий с последующим слоем металла. Затем для получения полной изоляции
металлизированных областей по первому слою Al проводится повторное окисление
(режим ''пористого'' анодирования), в результатекоторого слой Al по всей
толщине превращается в Al2 O3 за исключениемлокальных участков под тонкой
плотной плёнкой, полученной в процессе первого окисления. На рисунке 8 показана
последовательность формирования ''бесступенчатая '' многоуровневая металлизация
Al- Al2О3- Al.
Основное преимущество такой металлизации -
возможность многократного наращивания слоев металлических соединений. Однако
создание такой металлизации представляет собой сложную технологическую задачу,
обусловленную, в первую очередь, высокими требованиями, предъявляемых к слоям
Al2 O3, которые должны обеспечить надёжную изоляцию.
Барьерные слои. Некоторые недостатки алюминия
можно устранить благодаря применению дополнительных слоев металлизации
(многослойная металлизация). Чаще всего в многослойной металлизации
используются плёнки тугоплавких металлов. Каждый слой в многослойной
металлизации выполняет вполне определённую функцию (рисунок 9).
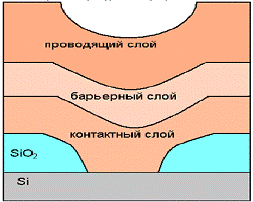
Рисунок 9 - Назначение проводящих слоев в
многослойной металлизации
Контактный слой - первый по порядку нанесения на
кремниевую пластину, должен выполняться из металла, мало проникающего в Si, не
вступающего с ним в нежелательные взаимодействия, имеющего низкое переходное
сопротивление. В качестве такого металла чаще всего используют тугоплавкие
металлы, которые в наибольшей мере соответствуют перечисленным требованиям.
Проводящий слой - последний по порядку
нанесения, должен иметь хорошую электропроводимость и обеспечивать качественное
надёжное подсоединение контактных площадок к выводам корпуса. Для проводящих
слоёв применяют Cu, Al, Au.
Иногда используются системы металлизации с
количеством слоёв более двух. Трёхслойная металлизация используется тогда,
когда сложно подобрать хорошо согласующиеся материалы контактного и проводящего
слоёв. В этом случае применяется барьерный (разделительный) слой, который
предотвращает образование интерметаллических соединений между верхними нижним
слоями, а также препятствует диффузии металла одного слоя в другой, приводящей
к ухудшению механической прочности и изменению сопротивления контакта. В
качестве барьерного слоя применяется чаще всего W, Mo, Pd.
Диффузионные барьеры могут быть существенным
фактором при получении стабильных контактов к элементам ИС. Барьерные слои в
основном имеют поликристаллическое строение, и, следовательно, их диффузионные
характеристики отличны от характеристик объемного материала при низких
температурах. Для предотвращения быстрой диффузии материала по границам зерен
необходимо пассивирование границ зерен путем введения примесей в пленки.
Например, свойства пленок Мо или Ti-W могут быть улучшены введением О или N до
концентрации 10-3 вес. %. Это примеры «заполняющих барьеров», поскольку они
препятствуют диффузии вдоль границ зерен.
Пассивные соединения, такие, как нитриды, также
можно использоватьв качестве барьера, так как они могут быть осаждены методом
реактивного ионного распыления с использованием металлических мишеней. Однако
из-за возможного взаимодействия между Al и TiN при температуре ~500°C
необходимо наличие какого-либо слоя (например Ti) между нитридом и Аl, если
применяется высокотемпературная обработка. Для взаимодействия с Аl и
образования Аl3Тi необходимо достаточное количество Ti, иначе Аl проникает
через слой TiN и будет реагировать с кремниевой подложкой. Для структур,
которые должны быть нагреты до температуры 450 °C, используют преимущественно
Та, который также образует нитрид - ТаN. Обнаружено, что структуры с
металлическим Tа между Аl и TaN превосходят структуры на основе Ti .
Использование одного и того же металла для получения слоев нитрида и металла
является более рациональным, так как эти слои могут быть осаждены
последовательно.
Тугоплавкие металлы можно осаждать
непосредственно на кремний,вскрытый в окнах. Та реагирует с Si только при
температуре выше 600 °C и образует соединение с Аl (Аl3Та) при температуре выше
450 °С. При обеспечении достаточного количества осажденного Та образование
проколов из Аl должно быть предотвращено. В то же время, использование слоя
Ti-W под Al вызывает увеличение удельного сопротивления пленки Al на 10% из-за
диффузии Ti и W в слой Al.
После того как структура прибора окончательно
сформирована, на последний металлический слой должна быть нанесена
пассивирующая пленка. Внешние выводы кристалла присоединяют к слою металлизации
черев окна, вытравленные в пассивирующей пленке. В качестве пассивирующих
пленок могут быть использованы слои низкотемпературного фосфорно-силикатного
стекла, слои диэлектриков (окислы или нитриды), полученных методом химического
осаждения из ПГС в плазме, а также слои, сформированные центрифугированием из
стеклосодержащей суспензии или из кремнийорганических соединений с последующей
термической обработкой.
Как правило, пассивирующая пленка предохраняет
металлизацию от механических повреждений перед разводкой в корпусе.
Для выполнения разводки в корпусе может применяться
проволока из сплава Al-1% Si или Аu. При соединении проволокой из сплава Al
может произойти ее разрушение непосредственно в месте контакта. Соединение
золотой проволокой выполняется с меньшими затруднениями, однако при этом могут
формироваться интерметаллические соединения, ослабляющие структуру контакта.
Признаком образования интерметаллического соединения являемся появление так
называемой пурпурной чумы - соединения AuAl2. Для предотвращения образования
интерметаллических соединений следует строго соблюдать время, в течение
которого Аu и сплав Аl находятся в контакте при высокой температуре.
Металлизация значительно коррозирует в среде с
высоким удержанием влаги. Для исключения коррозии применяют герметичные
корпусы. Если металлические структуры не герметизированы, то такие компоненты,
как хлорсодержащие соединения, которые могут оставаться после плазменного или
реактивного ионного травления, реагируют с Аl в присутствии влаги даже без
приложения электрического поля.
Проблема коррозии ИС осложняется в случае
близкого расположения металлических дорожек друг к другу и, особенно при
приложении к ним электрического поля, что имеет место в ИС. При проведении
большинства процессов сухого травления обычно осуществляется пассивирование
посредством удаления остаточного хлора. Этот остаточный хлор может, быть удален
обработкой пластин в плазме CF4-O2 или О2 сразу же после операции травления
перед контактом пластин с атмосферой. Дальнейшая стабилизация слоя металлизации
достигается путем термического окисления металла.
Недостатки Al-металлизации:
) низкая температура эвтектики Al-Si (5770C);
) высокая растворимость Si в Al в твёрдой фазе
(около 1% при 5000С), при охлаждении Si охлаждается по границам зёрен и
уменьшает механическую прочность контакта.;
) низкая механическая прочность из-за мягкости;
) большая разница в КТР Al и Si, SiO2 ;
) химическое взаимодействие с SiO2 , которое
начинается при 4500С и идёт интенсивно при 5000С +→+22 33 42 3Oi SlAlAOSi
) значительная электродиффузия, которая
появляется при плотностях тока 5⋅104
А/см2 и Т=1500С, т. е. в реальных условиях работа микросхем средней и большой
можности;
) низкая стоимость по отношению к кислотам,
щёлочам и склонность к коррозии;
) образование при повышенных температурах
хрупких нтерметаллических соединений с золотом Au2 Al и AuAl2 - явление,
известное под названием ''пурпурной чумы''. При образовании этих соединений Al
диффундирует в Au быстрее, чем Au в Al, образующие пустоты и трещины ещё более
ослабляют место подсоединения Au-проволоки к Al-контактной площадке, а
интерметаллические соединения Al с Au растворяют Si.
2. Многокристальные модули типа
MKM-D и МКМ-А. Конструктивно-технологические особенности. Предельные
возможности технологии. Частотные характеристики. Перспективы развития
Многокристальные модули
Необходимость дальнейшей миниатюризации
радиоэлектронной аппаратуры (РЭА), повышения её функциональной сложности,
быстродействия и надежности при одновременном уменьшении стоимости,
массогабаритных и мощностных показателей стимулирует развитие новых направлений
конструктивно-технологического исполнения изделий микроэлектроники. Одним из
таких направлений является их сборка в виде многокристальных модулей (МКМ),
которые уже стали наиболее совершенной формой изготовления комплектующих
изделий и основой для построения узлов и блоков современной РЭА.
Технология МКМ объединяет в себе широкий спектр
методов сборки монолитных ИМС, начиная от традиционной в виде гибридных
интегральных схем (ГИС) и кончая модулями, почти полностью изготавливаемыми из
кремния.
Основные затраты при создании МКМ идут на
разработку схем разводки, изготовление подложки, испытания и монтаж
негерметизированных ИМС, окончательную сборку, а также на внутреннее соединение
элементов.
Как и любая новая технология МКМ имеет свои
достоинства и недостатки (проблемы).
Достоинства:
уменьшение массогабаритных показателей;
высокая плотность межсоединений;
высокая надежность;
возможность сочетания передовых технологий;
ремонтопригодность;
Проблемы:
конструирование и тестирование;
выбор материалов и процессов;
межблочный монтаж.
Конструктивно-технологические решения создания
многокристальных модулей.
В общем случае многокристальный модуль (МКМ)
представляет собой две или более (до 400) монолитные интегральные схемы (ИС)
любой степени интеграции, помещенные на многослойной подложке в общий корпус и
соединенные между собой с помощью одно- или многоуровневой системы меж
соединений.
Функциональные устройства в виде МКМ занимают в
6 раз меньшие объемы в РЭА, чем аналогичные устройства в корпусах с
вертикальным размещением выводов (типа DIP), а по стоимости они в 3 раза
дешевле. Плотность упаковки элементов в РЭА с использованием МКМ в 10-15 раз
выше, чем в блоках на базе печатных плат. Благодаря меньшей длине
соединительных линий в МКМ значительно снижены значения паразитных ёмкости и
индуктивности, что приводит к повышению быстродействия схем. В ряде случаев
мощность, потребляемая РЭА на базе МКМ, может быть уменьшена в два раза.
Достоинством МКМ являются также малые габариты и масса. Однако экономическая
эффективность от применения МКМ может быть достигнута лишь при достаточно
больших объемах их выпуска.
По расположению кристаллов различают МКМ с
планарным (одноуровневым) размещением кристаллов, с установкой кристаллов на
ребро, с кристаллами в нескольких уровнях (трехмерные модули). По количеству
кристаллов можно выделить МКМ малой (от 2-4 до 20-30 ИС), средней (от 30-50 до
100 ИС) и большой (свыше 100 ИС) сложности, а по способу формирования
проводников - МКМ с толстопленочными, тонкоплёночными проводниками и со
смешанным типом используемых проводников.
Для МКМ с малым числом кристаллов, как правило,
используются корпуса, стандартизованные для сборки однокристальных ИС, в
которых основание корпуса служит одновременно подложкой.
Основания МКМ
Для изготовления МКМ большой сложности
используются конструкции 4 типов модулей (L, С, D и Si), в том числе:
MKM-L - с подложкой, представляющей собой
многослойную печатную плату (технология "кристалл на плате");
МКМ-С - с подложкой, изготовленной на основе
многослойной керамики;
MKM-D - с многослойной тонкопленочной
структурой, сформированной на керамической или эмалированной металлической
подложке;
MKM-Si - с многослойной тонкопленочной
структурой на пластине кремния.
Технология МКМ L-типа доминирует в производстве
модулей благодаря наличию сравнительно недорогих материалов для их подложек,
отработанных процессов и оборудования для монтажа кристаллов (рисунок 10).
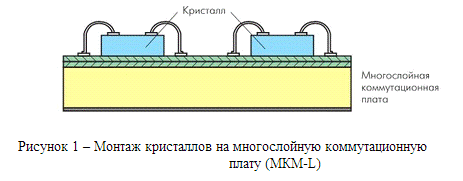
Рисунок 10 - Монтаж кристаллов на многослоёную
коммутационную плату (МКМ-L)
Кристалл устанавливают на многослойную
коммутационную плату, и его контактные площадки соединяются алюминиевой или
золотой проволокой с контактными площадками платы. Плата изготавливается из
слоистого пластика. Проволочные соединения реализуются методом термокомпрессии,
ультразвуковой сваркой, микропайкой. Используются также кристаллы с
предварительно присоединенными проволочными выводами или собранные на
ленте-носителе с автоматической разваркой выводов. Такой была конструкция
первых МКМ, но и сейчас эта технология является самой массовой.
Для оснований МКМ L-типа используются композиты
из эпоксидной смолы, полиимида, армированных кварцем, стеклом, кевларом,
пустотелыми стеклосферами. Их диэлектрическая постоянная находится в пределах
2,2-4,8. Фирма Du Pont (США) разработала керамико-полимерный материал на основе
тефлона, армированного микроволокнами AlN. Новый материал имеет
теплопроводность 25-60 Вт/м∙С, ТКР = (4-5) · 10-6 °С-1, ε
= 2,8-5.
Гибкие полиимидные платы весьма перспективны при
создании электронных средств, поскольку с их помощью можно получить
прецизионные многослойные структуры, способные свертываться в трех плоскостях и
принимать форму корпуса сложной конфигурации при монтаже. При этом гибкие платы
характеризуются высокими стойкостью к перегибам и ударопрочностью, а также
малыми габаритами и массой.
Применение гибких плат сокращает монтаж в
несколько раз, удешевляет производство на 40-45%, уменьшает вес и габариты
изделия на 30-50%.

Широкому внедрению гибких плат способствовали
разработка и использование полиимидной пленки с высокой температурой устойчивой
работы (до 570К). Кроме того, полиимидная пленка обладает хорошими
электрическими и физико-механическими свойствами. Величина тангенса угла
диэлектрических потерь (0,002) и диэлектрическая постоянная (~3,0) отвечают
требованиям к материалам, используемым при создании быстродействующих систем.
Отсутствие существенных газовыделений при термовакуумном воздействии, наряду с
высокой химической (возможностью селективного равномерного травления в сильных
щелочных средах) и радиационной устойчивостью, делают полиимидную пленку
перспективной для создания многокристальных модулей МКМ на основе многослойных
плат и бескорпусных СБИС на гибком носителе. Выбор материала и
конструктивно-технологического варианта исполнения МКМ определяет способ
проектирования платы. Таким образом, плата первоначально проектируется, как при
двумерном (плоском) варианте исполнения, с последующим анализом
помехозащищенности в трехмерном исполнении. На этапе сборочно-монтажных
операций полиимидную плату со смонтированными на ней микросхемами сворачивают в
трехмерную структуру (рисунок 11). Размер МКМ в свернутом виде по монтажной
площади не превышает площади одного из используемых кристаллов (максимального)
более чем на 20%, а по высоте определяется числом используемых кристаллов,
предварительно утоненных до 200 мкм каждый. Возможно свертывание полиимидной
основы не в прямоугольную, а в кубическую форму, что значительно увеличивает
плотность компоновки.До свертки (2D исполнение) После свертки (3D исполнение)

Рисунок 11 - Многокристальный модуль памяти на
гибком полиимидном основании в трёхмерном (3D) исполнении
Анализ достижений и тенденций развития МКМ за
рубежом показывает, что для получения наивысших технических показателей МКМ
следует применять основания (для монтажа на них кристаллов ИМС и коммутации
электрических сигналов), несущие высокоплотную многоуровневую структуру
тонкопленочных проводников. К ним относятся шлифованные керамические
(стеклокерамические) основания (рисунок 12), основания из листов (полос)
металла (например, из железоникелевого сплава «ковар»), покрытые стеклоэмалью,
которая выполняет роль диэлектрика. Основаниями также могут служить пластины
монокристаллического кремния. МКМ с такими монтажными (коммутационными)
подложками называют модулями D-типа (MCM-D). В них проводники из меди, алюминия
или золота расположены в разных уровнях на подложках, а в качестве
межуровневого изолятора используются слои, как правило, полиимида, или
бензоциклобутана, и полипараксилилена (парилена). Разновидностью МКМ D-типа
являются МКМ с кремниевыми монтажными подложками, в которых в качестве
диэлектрика между алюминиевыми проводниками на разных уровнях металлизации
применяют оксид кремния (МКМ Si-типа или просто МКМ-Si).
Как правило, основание МКМ одновременно является
элементом корпуса. В этом случае его материал по величине температурного
коэффициента расширения (ТКР) должен быть максимально близок к ТКР кремния. В
других МКМ, прежде всего Si-типа, основание с многослойной металлизацией
напаивается или приклеивается к корпусу.
Необходимость формирования сложных многослойных
проводниковых структур, рассеивания большой выделяемой МКМ мощности и
согласования ТКР потребовала создания и внедрения новых материалов для
оснований МКМ и тонкопленочных диэлектриков для межслойной изоляции.
Основания МКМ должны иметь теплопроводность не
менее 50-100 Bт/м∙°C, прочность на изгиб не менее 200 МПа,
диэлектрическую постоянную е не более 4-6, а КТР не более (4-5) ∙ 10-6
°С-1.
Традиционно используемая алюмооксидная
(корундовая) керамика и материалы печатных плат (стеклоэпоксид, стеклотекстолит
и др.) не отвечают этим требованиям, что вызывает необходимость разработки и
внедрения новых керамических и полимерных материалов. Первые включают нитриды
алюминия, кремния, карбид кремния, стеклокерамику на основе природных
материалов - муллита (ЗАl2О3 х 2SiO2) и кордиерита (2МgО х 2Аl2О3 х 5SiO2),
боросиликатного стекла. Вторые разрабатываются на основе полиимида,
фторопласта, эпоксида с различными наполнителями. Стоимость подложки зависит от
выбора диэлектрика, количества слоев в ней и плотности металлизации. Если
стоимость стандартной печатной платы с проводниками шириной 125-150 мкм равна
0,1 долл. за 6,5 кв. см (квадратный дюйм), то стоимость подложек для
современных МКМ L-типа достигает 1,5 долл. за 6,5 кв. см в пересчете на один
проводниковый слой.
Наиболее перспективным материалом для оснований
МКМ можно считать нитрид алюминия, имеющий высокую теплопроводность и
сравнительно небольшой ТКР. Однако его диэлектрическая постоянная находится на
уровне оксида алюминия, а стоимость по зарубежным данным примерно в 4 раза
выше. Тем не менее, указанные недостатки не являются большим препятствием для
внедрения AlN в производство МКМ. Стоимость алюмонитридной керамики высока
только для очень прецизионно выполненных, химически особо чистых подложек с
теплопроводностью >200 Вт/м·К и в последние годы падает по мере расширения
объемов ее выпуска. Другой недостаток - большие габариты и масса,
преодолевается принятым для МКМ D-типа конструктивным приемом, когда сигнальные
проводники размещаются в многослойной тонкопленочной структуре, в которой используется
диэлектрик с малым значением диэлектрической проницаемости, а шины заземления и
питания сформированы по толстопленочной технологии в толще многослойного
керамического основания.
Металлические основания обеспечивают
перераспределение тепла между элементами схемы, достаточно прочны и широко
используются в производстве МКМ (рисунок 13). Перспективным является
использование в качестве оснований алюминия. Это обусловлено тем, что алюминий
сочетает в себе ряд важных достоинств: высокую теплопроводность и механическую
прочность, возможность придания любой конфигурации простой механической
обработкой, малый удельный вес и высокую теплопроводность, относительно низкую
стоимость.
Наряду с этим, алюминий обладает еще одним
свойством, выделяющим его среди прочих материалов, - способностью образовывать
в процессе анодного окисления толстые (до сотен микрометров) высококачественные
диэлектрические слои.
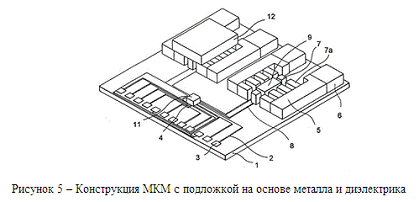
Рисунок 12 - Конструкция МКМ с подложкой на
основе металла и диэлектрика
Система межсоединений МКМ
Рост функциональной сложности электронных
устройств, использование ноговыводных полупроводниковых компонентов в МКМ
обусловили необходимость создания в них многоуровневой разводки. К
многоуровневым системам межсоединений (МСМ) предъявляются следующие основные
требования:
) высокая плотность монтажа;
) высокие электрические сопротивления и
прочность изоляции;
) низкая диэлектрическая проницаемость
межуровневой изоляции;
) малое и постоянное во времени переходное
сопротивление контактов в областях соединения проводников разных слоев;
) высокая механическая прочность;
) низкая стоимость.
В тонкопленочных многоуровневых платах
используют пленки диэлектрика толщиной 2-4 мкм. Такая толщина пленок не
позволяет создавать межуровневую изоляцию (МИ) без проколов, которые вызывают
короткие замыкания между проводниками разных уровней. Причинами проколов
изоляции являются пористость диэлектрика, загрязнения, неоднородность структуры
основания, механические повреждения и т.д. Чтобы исключить образование сквозных
проколов МИ формируют в 2-3 слоя. Однако такое решение увеличивает трудоемкость
изготовления МКМ. Увеличение толщины МИ приводит к возрастанию высоты ступенек,
на которых происходит обрыв проводников второго уровня.
Наиболее часто в многоуровневых платах на
жестких подложках в качестве МИ используют органические и неорганические
диэлектрики. Предельная толщина неорганического диэлектрика, получаемого
методами вакуумного осаждения, обычно не превышает 3-4 мкм, при этом паразитная
емкость в местах пересечений составляет 1-2 пФ при ширине проводников 100 мкм.
Большинство органических диэлектриков обладает невысокой нагревостойкостью.
Например, максимальная рабочая температура фоторезиста ФН-11КС не превышает 200ºС.
Таким образом, основными технологическими
проблемами, которые возникают при создании тонкопленочной многоуровневой
коммутации, являются пробой изоляции и обрыв проводников на ступеньках МИ.
Причем эти два дефекта связаны между собой.
Еще одной серьезной проблемой создания
тонкопленочной многоуровневой коммутации является высокая трудоемкость
изготовления, которая обусловлена большим количеством технологических операций
по формированию МИ и высших уровней коммутации. Например, формирование МИ из
полиимидного лака в два слоя требует 12 операций, высокая трудоемкость и низкий
процент выхода годных плат существенно повышают их себестоимость.
Анализ литературы убеждает в том, что для
создания надежной многоуровневой коммутации требуются толстые (более 10 мкм)
пленки диэлектрика.
Органические диэлектрики с толщиной более 100
мкм после полимеризации образуют плотную пленку без пустот и трещин.
Большинство полимеров имеет удельное объемное сопротивление не менее 1012
Ом·см. Вследствие относительной подвижности связей полимеры имеют высокий температурный
коэффициент линейного расширения (ТКЛР), порядка 10-4 -10-5 К-1. Поэтому можно
предполагать, что они плохо совместимы с металлами и полупроводниками. Однако
высокая эластичность полимеров и сравнительно небольшой интервал рабочих
температур электронных устройств позволяет широко применять их в виде пленок,
нанесенных на поверхность любого материала.
Основу современной силовой электроники
составляют медно-керамические подложки DBC. МКМ, применяемые в изделиях силовой
электроники, таких как усилители мощности, инверторы и преобразователи DC/DC -
бурно развивающееся направление электроники. Технология DBC (Direct Bond Copper
- прямая медная металлизация) - технология с применением толстой медной фольги
(0,125-0,7 мм), которая плакируется на оксид или нитрид алюминия. Создание
топологии аналогично технологии травления печатных плат. Толстые медные
проводники обеспечивают прекрасную электропроводность и теплоотвод от
полупроводниковых силовых кристаллов. Применение медно-керамических подложек
DBC в силовых МКМ обусловлено следующими характеристикам:
низкий коэффициент температурного расширения
(7,2·10-6), несмотря на сравнительно толстые слои меди (0,3 мм);
высокая электропроводность благодаря толщине
медного проводника и низкому сопротивлению;
высокая сопротивляемость меди на отрыв (>50
Н/см);
очень низкое температурное сопротивление
подложек благодаря эффективному распространению тепла в толстом слое меди, а
также благодаря отсутствию промежуточных слоев;
высокая устойчивость к механическим
воздействиям.
Один из вариантов конструкции силовых МКМ
показан на рисунке 14. Кремниевый кристалл припаивается к подложке DBC сверху,
а затем DBC паяется к плате-основанию. Затем основание присоединяется к
основному теплоотводу.
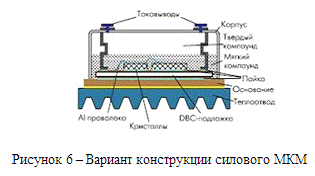
Рисунок 13 - Вариант конструкции силового МКМ
В настоящее время проводятся интенсивные работы
по созданию и исследованию межсоединений на основе меди. Медь, по сравнению с
алюминием, является более перспективным материалом для межсоединений в МКМ,
благодаря своему малому сопротивлению и повышенной стойкостью к электромиграции,
вызываемой механическими напряжениями. Металлизация на основе пленок меди в
сочетании с химико-механической планаризацией уже признана ведущими
фирмами-производителями микросхем (AMD, Intel, Sematex и др.) как процесс,
способный обеспечить изготовление МКМ, позволяющий значительно (примерно на
40%) снизить время задержки распространения сигнала по проводнику и как
следствие увеличить быстродействие устройств в целом.
К таким МСМ относятся, в частности, МСМ на
основе меди (служащей в качестве основного металла межсоединений) и оксида
алюминия (служащего в качестве межслоевого диэлектрика). Перспективным
считается изготовление такой МСМ с помощью локального электрохимического
осаждения, позволяющего исключить из технологической цепочки изготовления МКМ
дорогую операцию химико-механической полировки, и, тем самым, уменьшить
стоимость МКМ и увеличить выход годных.
Основным элементом больших современных МКМ
является многослойная подложка, исполнение которой определяет технические
характеристики изделия, его стоимость, эффективность теплоотвода и надежность.
Как правило, подложка в МКМ одновременно служит
основанием корпуса. В этом случае ее материал по величине температурного
коэффициента расширения (ТКР) должен быть максимально близок к ТКР кремния. В
других МКМ, прежде всего Si-типа, подложка с многослойной металлизацией
напаивается или приклеивается к основанию корпуса. Такую конструкцию выбрала
британская фирма Royal Signals and Radar Establishment для изготовления МКМ
Si-типа для цифрового переключателя в системе телекоммуникаций.
Необходимость формирования сложных многослойных
проводниковых структур, рассеивания большой выделяемой МКМ мощности и
согласования ТКР потребовала создания и внедрения новых подложечных материалов
и тонкопленочных диэлектриков для межслойной изоляции.
В тонкопленочных структурах в качестве изолятора
может использоваться двуокись кремния SiO2 (MKM-Si), однако количество слоев в
таких структурах ограничивается числом 3-5 из-за проблем роста внутренних
напряжений в слоях SiO2 и сложности обеспечения планарности их поверхности.
Проводниковые слои и межслойные переходы в этих структурах формируются
осаждением алюминия. Другим вариантом изготовления тонкопленочных многослойных
структур являются структуры с термостойким полимерным диэлектриком. Эти
структуры имеют металлизацию на основе Cu с подслоями Сг или Ti, используются в
МКМ с подложкой из керамики, кремния. Наиболее широко в них применяются
полиимид, в том числе модифицированный (фоточувствительный, с уменьшенным ТКР),
а также бензоциклобутан, фторсодержащий полимер марки Тефлон-AF,
поливинилхиноксалин, полипараксилилен (парилен). Эти материалы имеют ε<3,5,
но
в отличие от SiO2 почти все абсорбируют влагу, обладают большим ТКР = (35-60)·10-6
°С-1.
При изготовлении МКМ монтаж кристаллов
осуществляется напайкой или приклейкой с последующей разваркой микропроволочных
проводников или ленточных проводников, сформированных в виде расходящегося
веера в ленте-носителе. Применение находят способы сборки МКМ, в которых
кристалл, снабженный шариковыми или балочными выводами, устанавливается на
подложку в перевернутом положении. Два последних варианта монтажа кристаллов
позволяют достичь наивысшей плотности сборки МКМ, когда зазоры между
кристаллами составляют 0,25-0,5 мм.
Проволочный монтаж кристаллов применяется при
сборке МКМ с небольшим числом кристаллов и когда число контактных площадок на
каждом кристалле сравнительно невелико. Для проведения сборки МКМ разработано
автоматическое оборудование, обеспечивающее контролируемый профиль петли соединения,
мягкое касание сварочного инструмента контактных площадок, термозвуковой режим
сварки, когда сварное соединение образуется в результате одновременного
воздействия температуры, давления и ультразвуковых колебаний. При сборке обычно
используется золотая или алюминиевая микропроволока диаметром 25 мкм, но
ведутся работы по внедрению медной микропроволоки, ультратонкой золотой и
алюминиевой проволок (диаметром 12-20 мкм). Недостатки этого метода заключаются
в проблеме тестирования ИС перед сборкой в МКМ, в необходимости использования
сложного дорогостоящего оборудования и ограничениях в быстродействии ИС
(обусловленных влиянием паразитных емкостей и индуктивностей проволочных
проводников).
Список использований литературы
1. Сокол
В.А. Электрохимическая технология гибридных интегральных микросхем/ В.А. Сокол.
- Минск: Бестпринт, 2004.
2. Сокол
В.А. Многокристальные модули - стратегическое конструктивно- технологическое
направление в создании микроэлектронной аппаратуры/В.А. Сокол // Радиотехника и
электроника: респ. межведомств. сб. - Минск, 1999.
. Телец
В.А. Многокристальные модули - новое конструктивно-технологическое направление
в развитии комплектующих изделий/ В.А. Телец // Петербургский журнал
электроники. - 2000.