Технология изготовления диффузионых резисторов на основе кремния
Министерство
образования и науки российской федерации
Федеральное
государственное бюджетное образовательное учреждение высшего профессионального
образования
Воронежский
государственный технический университет
ФГБОУВПО
ВГТУ
Факультет
радиотехники и электроники
Кафедра
полупроводниковой электроники и наноэлектроники
Курсовой
проект
по
дисциплине: Процессы микро- и нанотехнологии
Тема:
Технология
изготовления диффузионых резисторов на основе кремния
Выполнил:
студент группы МТЭ-091
Токарев С.В.
Проверил:
доц. к.т.н. Пантелеев В.И.
Воронеж 2013
Содержание
Введение
.
Основные положения теории диффузии
.1
Распределение примеси при диффузии
.2
Двухстадийная диффузия
.
Диффузионные резиcторы
.
Экспериментальная часть
Заключение
Список
литературы
Введение
Одним из основных достижений микроэлектроники
является создание на основе фундаментальных и прикладных наук новой элементной
базы интегральных микросхем.
Развитие вопросов проектирования и
совершенствование технологии позволило в короткий срок создать высоко
интегрированные функциональные узлы, например в виде больших (БИС),
сверхбольших (СБИС), ультрабольших (УБИС) микросхем и программируемых устройств
- микропроцессоров.
Интегральные изделия имеют малые габариты,
экономное потребление энергоресурсов, низкую стоимость и высокую надежность,
что позволило развить электронику в интегральную и функциональную
микроэлектронику, далее в наноэлектронику.
Это в свою очередь создает базу интенсивного
развития современного общества во всех сферах (медицина, информатика,
автоматизация техпроцессов и др.).
1. Основные
положения теории диффузии
Диффузией называется процесс
переноса атомов в результате теплового движения. Направленная диффузия атомов в
твердом теле возникает при наличии градиента концентрации или градиента
температур. В полупроводниковой промышленности чаще применяется направленная
диффузия с использованием градиента концентрации примеси.
Оборудование (диффузионные
печи) должно обеспечивать изотермический нагрев с точностью не хуже ±
0,5°С на уровне 1100°С. Это вызвано тем, что коэффициент диффузии зависит от
температуры как
 (1)
(1)
где D0 -
постоянная, численно равная коэффициенту диффузии при бесконечно большой
температуре; DE - энергия
активации диффузии (для основных диффузантов в кремнии составляет 3,5 - 4,3
эВ); k -
постоянная Больцмана, эВ/К; T - температура.
1.1 Распределение
примеси при диффузии
Диффузия основных примесей в
кремний (бор, алюминий, фосфор, сурьма, мышьяк) идет по вакансиям, а прочих примесей
(золото, железо и др.) - по междоузлиям.
Концентрация примеси при
диффузии в полупроводник наибольшая в поверхностном слое, а в глубине пластины
падает до нуля. В производстве транзисторных структур на кремнии интерес
представляют два случая распределения примесных атомов. Если диффузия идет из
источника с постоянной поверхностной концентрацией примесных атомов С0,
то распределение имеет вид
 (2)
(2)
Для упрощения, вместо erfc-функции
можно использовать аппроксимацию
 .(3)
.(3)
Для этого случая глубина залегания p-n-перехода
 .(4)
.(4)
При формировании транзисторной
структуры возможна последовательная диффузия ряда примесей, и пластина
полупроводника подвергается многократным циклам диффузии. Для расчета
распределения примеси С(x, t) в этом
случае надо использовать сумму
Dt = D1t1
+ D2t2 + D3t3 + D4t4
+ …(5)
Если диффузия идет из источника с
ограниченным содержанием примеси, находящейся в начальный момент в бесконечно
тонком поверхностном слое, то профиль распределения концентрации имеет вид
 ,(6)
,(6)
где x - глубина,
соответствующая данной концентрации (см); t -
длительность диффузии примеси (с); N - плотность
атомов примеси под единицей площади поверхности, неизменная в любой момент
диффузии (ат/см2); D - коэффициент диффузии примеси (см2/с).
[1]
1.2 Двухстадийная
диффузия
В планарной технологии диффузию
проводят в две стадии, если требуется получить хорошо контролируемую низкую
поверхностную концентрацию примеси.
Вначале осуществляют короткую
диффузию из источника с постоянной поверхностной концентрацией - загонку.
Поверхностная концентрация определяется либо предельной растворимостью примеси,
либо содержанием примеси в источнике диффузанта.
Затем пластины извлекают из
печи и удаляют стеклообразный слой, образующийся на поверхности кремниевой
пластины при загонке в окисляющей атмосфере и имеющей состав, близкий к составу
боросиликатных или фосфорносиликатных стекол.
Чистые пластины помещают в
чистую печь для проведения второй стадии диффузии - разгонки, осуществляемой
при более высокой температуре, так что D2t2
>> D1t1.
Тонкий диффузионный слой, сформированный на первой стадии диффузии, является
источником с ограниченным количеством примеси.
Введенное при загонке количество
примесных атомов N (ат/см2) служит
источником диффузанта при последующей разгонке в течение времени t2 с
изменяющейся поверхностной концентрацией  .
.
Распределение примеси после стадии
разгонки определяется выражением
 (7)
(7)
Загонка во многих случаях заменяется
ионным легированием. Атомы примеси внедряются в тонкий поверхностный слой с
плотностью N (ат/см2).
Ионная имплантация обеспечивает точное регулирование поверхностной концентрации
примеси при последующей разгонке, так как
 .(8)
.(8)
Достоинством двухстадийной диффузии
является возможность совмещения операции разгонки с выращиванием маскирующей
пленки окисла кремния.
2. Диффузионные резиcторы
Резисторы в составе ИМС характеризуются
совокупностью параметров, основными из которых являются: номинальное
сопротивление R, допуск на номинал ± δR,
температурный коэффициент сопротивления TKR,
мощность рассеяния Р. Эти параметры в каждом конкретном случае зависят
от исходного материала, способа формирования резистора и его формы (структуры).
Полупроводниковые резисторы - это резисторы,
изготовленные на основе полупроводникового материала методами полупроводниковой
технологии. Различают объемные и диффузионные полупроводниковые резисторы.
Объемные резисторы получают путем создания омических (невыпрямляющих) контактов
металла с полупроводником. При идеальных контактах удельное сопротивление ρv
такого резистора определяется объемными свойствами полупроводника.
Поскольку на практике используют легированные
полупроводники, их удельное сопротивление в случае полной ионизации примеси.
 (1)
(1)
 (2)
(2)
Несмотря на простоту конструктивного и
технологического исполнения, объемные резисторы не нашли широкого применения
из-за большой занимаемой площади и температурной нестабильности.
Диффузионные резисторы формируют на основе
диффузионных слоев, толщина которых намного меньше их ширины и длины.
Диффузионные резисторы изолированы от остального объема полупроводника p-n-переходом.
Они могут быть изготовлены одновременно с другими элементами при формировании
структуры полупроводниковых ИМС.
Поэтому для реализации диффузионных резисторов в
полупроводниковых ИМС используют те же диффузионные слои, которые образуют
основные структурные области транзистора: базовую, эмиттерную или коллекторную.
Сопротивление диффузионного резистора R
определяется удельным сопротивлением полупроводникового слоя, его глубиной и
занимаемой площадью:

где  -
среднее удельное сопротивление диффузионного слоя;
-
среднее удельное сопротивление диффузионного слоя;
 -глубинадиффузии;и
b - длина и ширина участка поверхности, в который проводилась диффузия.
-глубинадиффузии;и
b - длина и ширина участка поверхности, в который проводилась диффузия.

и для каждого слоя транзистора является
постоянным.
С учетом выражения (4) сопротивление
диффузионного резистора

Так как ps
определяется требованиями к областям транзистора, то проектирование
диффузионных резисторов заданного номинала сводится к определению l и b.
В общем случае удельное
поверхностное сопротивление диффузионного слоя с учетом концентрационной
зависимости подвижности носителей заряда и неравномерного распределения примеси
по толщине слоя, обусловленного диффузией,

где  -
усредненное по концентрации значение подвижности носителей заряда;
-
усредненное по концентрации значение подвижности носителей заряда;
 - усредненное по
координате (толщине диффузионного слоя) значение концентрации примеси.
- усредненное по
координате (толщине диффузионного слоя) значение концентрации примеси.
Выражение (6) можно
представить в виде

При известных характере распределения примеси  ,
технологических режимах диффузии, характере зависимости
,
технологических режимах диффузии, характере зависимости  и
глубине залегания p-n-перехода
оно является исходным для определения удельного поверхностного сопротивления в
зависимости от характера распределения примеси в диффузионном слое.
и
глубине залегания p-n-перехода
оно является исходным для определения удельного поверхностного сопротивления в
зависимости от характера распределения примеси в диффузионном слое.
Таблица 1

Диффузионные резисторы практически могут быть
реализованы на основе любой из структурных областей транзистора. Для их
использования в ИМС на поверхности структурных областей создают омические
контакты металлизацией алюминием. Структуры диффузионных резисторов на основе
структурных областей типового планарно-эпитаксиального транзистора показаны на
рисунке 1, а их параметры приведены в таблице 1.
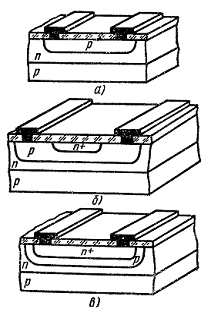
Рисунок-1- Структуры диффузионных резисторов,
сформированных на основе базового слоя (а), базового слоя, ограниченного
эмиттером (б), и эмиттерного слоя (в)
Как видно из таблице 1, наибольшим удельным
сопротивлением ρs
обладают резисторы, выполненные на основе базового слоя, ограниченного
эмиттерным переходом (рисунок 1б), однако воспроизводимость сопротивлений
низкая. По этой причине используют в основном эмиттерные или базовые слои.
Эмиттерные слои применяют для получения резисторов с малым сопротивлением
(рисунок 1в).
Наиболее распространены резисторы,
сформированные на основе базовых слоев (рисунок 1а). При этом достигается
сочетание высокого сопротивления слоя, необходимого для уменьшения площади,
занимаемой резисторами, и приемлемого (сравнительно малого) температурного
коэффициента сопротивления.
Для получения диффузионных резисторов требуемого
сопротивления, определяемого по формуле (5), диффузионные слои формируют в виде
прямоугольника (для небольших номиналов) или змейки (с целью уменьшения
занимаемой резистором площади). В этом случае отношение l/b
стремятся сделать по возможности большим (10-50) для уменьшения на расчетную
величину R изгибов резистора
(при выполнении его в виде змейки) и расширения слоя на концах (под контактные
площадки). Минимальная ширина резистора определяется процессами фотолитографии
и диффузии и достигает предельного значения порядка 5 мкм и менее. Для
диффузионных резисторов характерно наличие паразитных элементов -
распределенного конденсатора и распределенного транзистора.
Эквивалентная схема диффузионного резистора на
основе базового слоя приведена на рисунке 2. Она содержит следующие основные и
паразитные элементы: диффузия кремний полупроводниковый резистор
R1 -сопротивление
проводящего канала резистора (p-области);2
- омическое сопротивление контактов;3 - сопротивление токам утечки n-области;4
- сопротивление токам утечки подложки;
С1 - емкость коллекторного p-n-перехода;
С2 - емкость изолирующего
p-n-перехода;n-p-распределенная паразитная транзисторная структура с низким
коэффициентом В.
Паразитная транзисторная структура начнет
сравнительно хорошо проводить, если изолирующий переход будет смещен в прямом
направлении, а коллекторный переход - в обратном. Чтобы этого не произошло, в
правильно сконструированной ИМС на n- и n+ -области подается самый высокий
положительный потенциал. Обратное пробивное напряжение переходов порядка 50В, а
ток утечки обычно не превышает 10 мкА. Влияние распределенной емкости резистора
становится заметным на частотах выше 10 МГц.
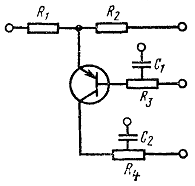
Рисунок 2 - Эквивалентная схема диффузионного
резистора, сформированного на основе базового слоя транзистора
На точность воспроизведения сопротивления
диффузионного резистора ± ΔR
влияют в основном три технологические операции:
) изготовление фоторезистивной маски;
) травление слоя Si02
при изготовлении из него защитной маски;
) диффузия примесей через окна маски на заданную
глубину. Первые две операции определяют точность рисунка, т. е. допуск на длину
(±Δl) и ширину (± Δb)
проводящего канала (слоя). Третья операция определяет глубину залегания p-n-перехода
и характер распределения концентрации примеси в p-области,
т. е. допуски на толщину канала ±  и
его удельное сопротивление ± ρV.
Указанные параметры связаны известным
соотношением:
и
его удельное сопротивление ± ρV.
Указанные параметры связаны известным
соотношением:

где  -
среднее удельное сопротивление канала резистора.
-
среднее удельное сопротивление канала резистора.
Наибольшие потери точности воспроизведения
сопротивления резистора происходят на третьей операции, т. е. во время диффузии
примесей. Кроме разброса по номиналу диффузионные резисторы обладают
существенной температурной зависимостью. Температурный коэффициент
сопротивления определяется выражением

где  -
абсолютное изменение номинала резистора в исследуемом диапазоне температур;
-
абсолютное изменение номинала резистора в исследуемом диапазоне температур;
R (ТН) -
значение номинала резистора при температуре ТН;
Т - ТН - диапазон изменения
температуры.
Высокий ТКR диффузионных резисторов обусловлен
температурной зависимостью подвижности носителей заряда  или
или
 и
концентрации примеси NД
или NА.
и
концентрации примеси NД
или NА.

Рисунок 3 - Зависимость сопротивления
диффузионных резисторов от температуры при различных значениях поверхностного
удельного сопротивления в Ом/квадрат (1 - рS
= 50; 2 - pS=
100; 3 - pS
= 200;4 - pS
= 400)
На рисунке 3 показана зависимость сопротивления
диффузионных резисторов от температуры при различных значениях удельного
поверхностного сопротивления. Отсюда видно, что ТКR
для диффузионных резисторов положителен при положительной температуре и тем
более высокий, чем выше рS.
Для диффузионных резисторов на основе базового слоя транзистора  в
диапазоне изменения температур
в
диапазоне изменения температур  и
и  в
диапазоне
в
диапазоне  .
.
Рассеиваемая диффузионным резистором мощность
определяется максимальным падением напряжения на резисторе, которое не может
превышать напряжение смещения на изолирующем p-n-переходе. Основным фактором,
ограничивающим мощность рассеяния, является нагрев резистора в процессе работы.
Для диффузионных резисторов предельной считается мощность 50 мВт/мм2.
Диффузионные резисторы для полупроводниковых ИМС
изготовляют с номиналами 50 Ом - 300 кОм и разбросом ± (10-20)%; максимальная
мощность рассеяния зависит от типа корпуса и, как правило, не превышает 0,1 Вт.
Кроме диффузионных в полупроводниковых ИМС применяют резисторы на основе
МДП-структуры. При этом в качестве резистора используют МДП-транзистор,
работающий в режимах, соответствующих наклонной области вольтамперной
характеристики. Использование МДП-структур в качестве резисторов позволяет
реализовать целый ряд цифровых ИМС только на одних МДП-транзисторах.
Для реализации больших значений сопротивления
служат высокоомные полупроводниковые резисторы на основе ионно-легированных
слоев. Такие резисторы хорошо воспроизводимы, имеют большой динамический
диапазон сопротивлений и линейные характеристики. Ионным легированием легко
получить полупроводниковые резисторы с  Ом/квадрат.
[2]
Ом/квадрат.
[2]
3. Экспериментальная
часть
Рассчитаем распределение
концентрации примеси в n+-p-n-структуре,
полученной последовательной диффузией бора в кремний с электропроводностью n-типа
и удельным сопротивлением 0,1 Ом, проводимой в режимах Тa
= 1220°С, ta
= 30 мин и Tg
= 1120°С, tg
= 1 ч. Поверхностная плотность атомов бора Na
= 6×1014 см-2,
диффузия фосфора ведется из неограниченного источника примеси с поверхностной
концентрацией, равной предельной растворимости.
.1 С помощью графика
зависимости удельного сопротивления кремния от концентрации примеси находим
концентрацию донорной примеси в исходной пластине кремния СВ = 3×1017
см-3.
.2 Определим коэффициенты
диффузии для бора и фосфора из зависимости коэффициента диффузии от
температуры.
Da
= 4×10-12 см2/с(для
бора при ta
= 1220 °С);
Da
= 6×10-13 см2/с(для
бора при tg
= l120 °C);
Da
= 6×10-13 см2/с(для
фосфора при tg
= 1120 °С).
Предельная растворимость
фосфора при 1120 °С равна C0g
= 1,5×1021 см3.
3.3 Так как  , то для
построения распределения можно использовать формулу
, то для
построения распределения можно использовать формулу
 ,
,
Где
 .
.
.4 Для рационального выбора шага по
оси x при
построении распределения определим глубину залегания коллекторного p-n-перехода:


 .
.
Для определения глубины залегания
эмиттерного p-n-перехода
 .
.
Это начальное значение. При решении
методом итераций

 .
.
Уточненное значение глубины
залегания эмиттерного p-n-перехода
будет


 .
.

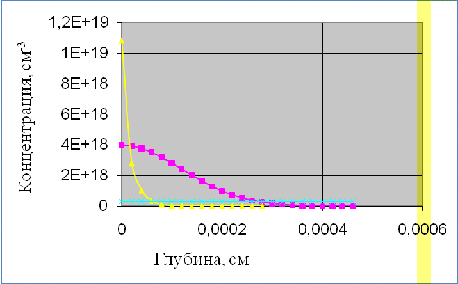
Рисунок 4 - Расчетные профили
распределения примеси в n+-p-n-структуре,
полученные двойной последовательной диффузией
Заключение
Обычно в качестве диффузионных
резисторов используют базовый или эмиттерный слой планарной транзисторной
структуры. Базовые диффузионные резисторы - высокоомные (концентрация основных
носителей заряда в базе значительно меньше, чем в эмиттере), а эмиттерные -
низкоомные. [1]
Температурный коэффициент
сопротивления диффузионного резистора зависит от концентрации примесей в
использованном диффузионном слое. Так как диффузионные резисторы формируют в
базовых областях транзисторных структур, то концентрация примесей в этих
областях определяется необходимыми параметрами и свойствами транзисторов. [2]
Допустимая мощность рассеяния
диффузионных резисторов ограничена малыми размерами и топологией резистивной
диффузионной полоски резистора (рис. 7.11, г, д), а также связана с
температурным коэффициентом сопротивления резистора, так как нагрев резистора
проходящим током вызывает изменение сопротивления и приводит к нелинейности ВАХ.
[3]
Кроме перечисленных недостатков
диффузионных резисторов и трудностей проектирования и создания интегральных
микросхем с диффузионными резисторами необходимо отметить, что при формировании
интегральных микросхем вообще и микросхем с диффузионными резисторами в
частности в структуре интегральной микросхемы образуются паразитные элементы,
которые могут нарушить нормальную работу интегральной микросхемы.
Высокий ТКС диффузионных
резисторов обусловлен температурной зависимостью концентраций примеси, что, в
свою очередь (при полной ионизации примеси), определяется изменением
подвижности носителя заряда от температуры; TKJC
зависит от изменения концентрации примесей тем больше, чем выше сопротивление
слоя.
Таким образом, все диффузионные
резисторы изготовляют на диффузионных слоях П-, р-, п-, р-структуры в едином
технологическом процессе.
Благодаря наличию
обратносмещенного перехода диффузионный резистор имеет распределенную емкость.
Вследствие малого поперечного
сечения диффузионного резистора, ток, протекающий через него, ограничен
максимальным током.
Список литературы
1. Курносов А.И., Юдин В.В. Технология
производства полупроводниковых приборов и интегральных микросхем: Учеб. пособие
для вузов по спец. “Полупроводниковые приборы”.-3-е изд., перераб. и доп. - М.:
Высш. шк., 1986.-368с.
. Гаврилов Р.А., Скворцов А.М. Технология
производства полупроводниковых приборов. “Энергия” Л.1968-240с.
. Березин. А.С., Мочалкина О.Р. Технология и
конструирование интегральных микросхем: Учеб. Пособие для вузов под ред.
И.П.Степаненко.- М.: Радио и связь, 1983.-232с.
. Технология СБИС / под ред. Зи С., в 2-х кн.
М.: Мир, 1986.