Эксплуатация установки полунепрерывного действия 'Оратория-5' и расчет времени откачки шлюза
Содержание
Введение
.
Анализ задания на проектирование
.
Обзор современного оборудования для получения тонких пленок
.1
Установка вакуумного напыления тонких пленок
.2
Трехкамерная вакуумная установка нанесения тонких пленок с полунепрерывным
циклом работы
.3
Вакуумная установка непрерывного действия
.
Анализ методов нанесения тонких пленок
.
Анализ материалов и конструкций магнетронов для ионного распыления тонких
пленок
.
Назначение, основные конструктивные элементы рабочей камеры установки
«Оратория-5»
.1
Назначение
.2
Основные конструктивные элементы
.
Порядок подготовки установки к работе
.
Основные неисправности и методы их устранения
.
Расчет времени откачки шлюза
.
Мероприятия по охране труда
Заключение
Литература
Введение
Вторая половина XX в. была ознаменована
ускоренным развитием отечественной науки, техники и производства в наиболее
важных для страны направлениях, среди которых особое место принадлежало
электронной технике.
Особая роль в развитии электронных технологий
принадлежит вакуумной технике, которая используется и как рабочая среда
электровакуумных приборов различного назначения, и как средство для
осуществления сложнейших физико-технологических процессов современной
твердотельной электроники, протекающих в высоком и сверхвысоком вакууме на
молекулярном и атомном уровне с использованием энергетических потоков
электронов, ионов, плазмы, нейтральных атомов и др.
Эти процессы широко используются для осаждения
покрытий из молекулярных и сепарированных ионных пучков, размерной обработки
остросфокусированными потоками электронов и ионов, ионного легирования,
выращивания сверхтонких структур методом молекулярно-лучевой эпитаксии и других
процессов.
В производстве ИС вакуумным нанесением тонких
пленок можно получать проводники и контактные площадки, тонкопленочные
резисторы, конденсаторы, индуктивные элементы, диэлектрические покрытия и
магнитные пленки, полупроводниковые структуры ИС.
Основными характеристиками тонких пленок
является их структура, размер зерна, чистота, адгезия к подложке, механические
напряжения, которые определяются параметрами технологического процесса и
оборудования для нанесения пленок. На качество тонких пленок влияют такие
факторы, как качество материала подложки и ее очистки, шероховатость и
температура подложки, чистота исходного материала, скорость осаждения,
парциальное давление остаточных газов в рабочей камере, взаимное расположение и
относительное перемещение источника и приемной поверхности.
Основные требования к установкам вакуумного
нанесения тонких пленок заключаются в обеспечении максимальной чистоты пленки,
ее адгезии к подложке, заданной структуры и размера зерна, получении высокой
равномерности толщины пленки, обеспечении требуемой производительности
обработки. Удовлетворение этих требований осуществляется путем выбора способа
нанесения пленки и типа вакуумной системы, выбора наиболее эффективного
источника испарения или распыления материала, способа подготовки поверхности
подложки, расчетом расстояния от источника до поверхности осаждения и
траектории их относительного перемещения.
Важную роль играет выбор методов контроля
параметров техпроцесса и системы управления. Обеспечение высокой
производительности достигается выбором оптимального варианта структуры и
компоновки, способа агрегатирования оборудования, созданием высоконадежной
конструкции.
1. Анализ задания на проектирование
Для расширения теоретических и практически
знаний и навыков по дисциплине «Наладка и эксплуатация оборудования для
термических и вакуумно-элионных процессов» введено курсовое проектирования по
теме «Эксплуатация установки полунепрерывного действия «Оратория-5».Расчет
времени откачки шлюза
Целью выполнения курсового проектирования
является изучение устройства, эксплуатацию, техническое обслуживание, основные
неисправности и методы их устранения для установки «Оратория-5».
Курсовое проектирование включает в себя
следующие задачи:
обзор современного оборудования для получения
тонких пленок;
анализ методов нанесения тонких пленок;
анализ материалов и конструкций магнетронов для
ионного распыления тонких пленок;
назначение, основные конструктивные элементы
рабочей камеры установки «Оратория-5»;
порядок подготовки установки к работе;
основные неисправности и методы их устранения;
расчет времени откачки шлюза;
разработка мероприятия по охране труда,
окружающей среды;
2.
Обзор оборудования для получения тонких пленок
Вакуумные установки для нанесения тонких пленок
разделяют на четыре группы.
К первой относят универсальные вакуумные
установки, имеющие сравнительно невысокую производительность, но обладающие
большими возможностями. Рабочая камера этих установок представляет собой
колпак, поднимаемый и опускаемый вертикально.
Работают они периодически и в основном
предназначены для исследовательских целей. Установки второй группы, более
производительные, также периодического действия, имеют подвижную или
неподвижную горизонтально расположенную рабочую камеру с групповой загрузкой
подложек. Установки третьей и четвертой групп, высокой производительности,
предназначены для оборудования цехов серийных заводов.
Установки третьей группы оснащены шлюзовыми
камерами и имеют полунепрерывный цикл работы, а установки четвертой группы
оборудованы загрузочными и транспортирующими устройствами, шлюзовыми камерами,
имеют непрерывный цикл работы и представляют собой производственные линии.
Вакуумные установки выполняются примерно по
одной схеме, имеют много общих элементов и отличаются друг от друга
конструкцией устройств, повышающих производительность труда, которая зависит от
степени непрерывности технологического процесса и количества одновременно
обрабатываемых подложек. Поэтому рассмотрим устройство и принцип действия
наиболее простых вакуумных установок и их особенности.
2.1 Установка вакуумного напыления тонких пленок
Установка вакуумного напыления тонких пленок
состоит из основания, колпака(рабочей камеры) с механизмом для его подъема и
подколпачным устройством, вакуумной системы, системы охлаждения и пульта
управления с электрическим блоком.

Рисунок 2.1 - Установка вакуумного напыления
тонких пленок
-сосуд Дьюра, 2-автоматический питатель жидкого
азота, 3-паромасляный насос, 4-азотная ловушка, 5-вакуумный затвор, 6-колпак
(рабочая камера), 7,8-карусели подложек и масок, 9-испаритель, 10-резиновое
уплотнение, 11-переносные приборы, 12-сварной стальной каркас, 13-пульт
управления, 14-вращательный механический насос, 15-блок клапанов,
16-трубопроводы
Основанием установки служит сварной стальной
каркас, закрытый металлическими панелями и панелями пульта управления. Колпак с
подколпачным устройством расположен на верхней панели(столешнице) и
представляет собой герметичную, из нержавеющей стали, открытую снизу
конструкцию, которая вакуумно-плотно соединяется с базовой плитой резиновым
уплотнением. Для наблюдения за процессом напыления в колпаке имеются смотровые
окна. Под колпаком на базовой плите размещен поворотный механизм с вращающимися
каруселями подложек и масок, а также испаритель.
Вакуумная система установки предназначена для
создания разрежения под колпаком и состоит из вращательного механического и
паромасляного насосов, вакуумного затвора, блока клапанов, трубопроводов, а
также спиральной азотной ловушки, в которую автоматическим питателем подается
из сосуда Дьюара жидкий азот.
Все вакуумные системы имеют одинаковый порядок
включения на откачку. Вначале включают механический насос, который откачивает
систему до давления 1,3*10-1 Па, а затем паромасляный, который
создает давление до 10-3 Па. Для создания более высокого вакуума
используют азотную ловушку, пропуская через нее жидкий азот.
На пульте управления сосредоточены контрольные
приборы и приборы управления (кнопки, сигнальные лампы, предохранители),
которые соединены проводами с низковольтными и высоковольтными источниками
питания, предназначенными для нагрева испаряемого вещества, зажигания тлеющего
разряда и очистки подложек.
В зависимости от назначения установки вакуумного
напыления оснащают электронно-лучевыми испарителями и устройствами программного
управления (температурой нагрева испарителя и подложек, скоростью испарения,
давлением в рабочей камере, сопротивлением осаждаемых пленок).
В периодически действующих вакуумных
напылительных установках наибольшее время расходуется непроизводительно - на
откачку рабочего объема до требуемого разрежения. Одним из способов сокращения
времени откачки является уменьшение продолжительности соприкосновения
подколпачного устройства и внутренних поверхностей колпака (рабочей камеры) с
атмосферным воздухом. Если в рабочий объем напустить осушенный воздух и поднять
колпак не более чем на 5 минут, время откачки до необходимого давления
уменьшится вдвое по сравнению с тем, когда под колпак напускают атмосферный
воздух. Другим способом снижения непроизводительных затрат времени является
использование вакуумных напылительных установок и линий соответственно
полунепрерывного и непрерывного действия. Это создает также одинаковые условия
для нанесения пленок высокого качества.
.2 Трехкамерная вакуумная установка нанесения
тонких пленок с полунепрерывным циклом работы
Трехкамерная вакуумная установка нанесения
тонких пленок с полунепрерывным циклом работы имеет рабочую камеру, а также
входную и выходную камеры - шлюзы, отделенные друг от друга вакуумными
затворами.
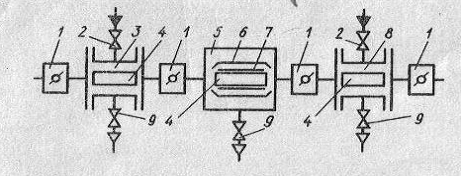
Рисунок 2.2 - Схема трехкамерной вакуумной
установки нанесения тонких пленок с полунепрерывным циклом работы
пленка магнетрон ионный распыление
1-вакуумные затворы, 2-вентили напуска воздуха,
3,8-входная и выходная камеры-шлюзы, 4-кассета, 5-рабочая камера, 6-испаритель,
7-заслонка, 9-вентили
При работе установки кассеты с подложками
подаются во входную камеру, закрываются все затворы и производится откачка
камер механическими насосами. При определенном давлении затвор между входной и
рабочей камерой открывается и кассета с подложками перемещается в рабочую
камеру, после чего во входную камеру напускается воздух, а в рабочей создается
высокий вакуум, открывается заслонка под постоянно нагретым испарителем и
производится напыление пленок. После напыления затвор открывается и кассета
перемещается в выходную камеру. Затем затвор закрывается и в выходную камеру
напускается воздух.
Далее рабочий цикл продолжается таким образом.
Когда кассета с напыленными пластинами перемещается в выходную камеру, другая
кассета подается в рабочую. Повышение производительности труда при работе на
такой установке происходит вследствие частичного совмещения подготовительных
операций, связанных с откачкой и загрузкой-выгрузкой кассет.
Вакуумные установки непрерывного действия
компонуются примерно по одной схеме и состоят из входных и выходных камер,
загрузочных и разгрузочных устройств, транспортирующего механизма и рабочей
камеры. Собирают эти установки из модулей - устройств, которые легко
присоединяются и снимаются. При этом изменяются габариты установки, ее технологический
цикл и производительность.
.3 Вакуумная установка непрерывного действия
Вакуумная установка непрерывного действия
предназначена для нанесения тонких одно- и многослойных пленок из алюминия и
его сплавов на кремниевые пластины диаметром 76, 100 и 125мм магнетронным
распылением. Установка состоит из двух шлюзовых и одной рабочей камер, системы
транспортных устройств для перемещения полупроводниковых пластин между
кассетами, трех магнетронных распылительных устройств (магратронов) и
микропроцессорной системы управления с дисплеем.
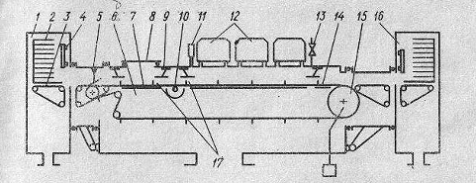
Рисунок 2.3 - Вакуумная установка непрерывного
действия для нанесения однослойных и многослойных тонких пленок магнетронным
распылением
,16-шлюзовые камеры, 2-кассета, 3-пассики подачи
пластин, 4-затвор, 5-датчик подачи пластин на конвейер, 6-рабочая камера,
7,15-конвейер и его привод, 8-устройство ионной очистки пластин, 11,13-датчик
давления и вибрационный натекатель аргона, 12-магратроны, 14-стол охлаждения
пластин, 17-щелевые каналы
Шлюзовые камеры, предназначенные для загрузки и
выгрузки кассет с полупроводниковыми пластинами, откачиваются агрегатом АВР-50
с азотной ловушкой в течение определенного времени. При этом в них для очистки
напускается аргон. Работа камер так взаимосвязана, что при разгерметизации
шлюзовой камеры давление аргона в рабочей почти не изменяется. Рабочая камера
имеет три зоны: предварительной ионной очистки пластин, нагрева их кварцевой
лампой и нанесения пленок. Зоны сообщаются через щелевые каналы, но в них поддерживается
разное давление. Вакуумная система рабочей камеры представляет собой агрегат,
состоящий из паромасляного диффузионного насоса Н-5К, азотной ловушки и
механического насоса ВНМ-18Г.
На верхней съемной крышке рабочей камеры
размещены планетарные магнетроны с подъемными магнитами, датчик давления и
натекатель аргона. В каждом водоохлаждаемом катоде магнетрона закреплена
мишень, имеющая значительную массу, что способствует ее длительной работе без
замены. Магнетроны получают питание от индивидуальных источников с
отрицательной обратной связью по току разряда и устройством эффективного
гашения дуговых разрядов высокого быстродействия.
Управляет работой установки микропроцессор на
базе ЭВМ, который позволяет задавать девять перепрограммируемых технологических
режимов, стабилизирует и контролирует их, выполняет необходимые блокировки,
считает обрабатываемые полупроводниковые пластины и выдает информацию о
состоянии технологических параметров, а также устройств и механизмов установки
на дисплей.
3. Анализ методов нанесения тонких пленок
Процесс нанесения тонких пленок требует
изолированного от атмосферы объема, в котором создается требуемое разряжение.
Процесс нанесения пленок состоит из: образования атомарного или молекулярного
потока вещества из источника испарения или распыления, переноса этого потока от
источника до подложки, конденсации атомов или молекул на подложке и образования
пленки.
Важную роль играет выбор методов контроля
параметров техпроцесса и системы управления. Обеспечение высокой
производительности достигается выбором оптимального варианта структуры и
компоновки, способа агрегатирования оборудования, созданием высоконадежной
конструкции.
Существуют два вакуумных метода нанесения тонких
пленок, различающихся по способу генерации потока частиц: метод термического
испарения и метод распыления материалов ионной бомбардировкой.
Сущность метода термического испарения (рисунок
3.1,а) состоит в нагреве материала в специальном испарителе 2 до температуры,
при которой начинается заметный процесс испарения и последующая конденсация
паров материала в виде тонкой пленки на поверхности подложек 5, расположенных
на подложкодержателе 4 на некотором расстоянии от испарителя 2. Для управления
началом и окончанием процесса осаждения служит заслонка, которая может
перекрывать поток испаренных частиц 3.
Для обеспечения требуемого качества пленок в
рабочей камере 1 необходимо поддерживать определенное разряжение и состав остаточных
газов. На рисунке 3.1,а показан пример безмасляной вакуумной системы, в которой
для обеспечения рабочего давления применен магниторазрядный насос NM,
соединенный с рабочей камерой через вакуумный затвор VP.

Рисунок 3.1-Методы вакуумного нанесения тонких
пленок.
Форвакуумная откачка рабочего объема
осуществляется механическим насосом NL. Чтобы пары масла из механического
насоса проникали в рабочую камеру, ее первоначальную откачку ведут через
клапаны VA1 и VA2 до давления примерно 100 Па, а дальнейшую форвакуумную
откачку до давления запуска высоковакуумного насоса - через клапаны VA1, VA3 и
сорбционную ловушку BS. После запуска магниторазрядного насоса механический
насос выключается. Напуск воздуха в современных форвакуумных насосах
осуществляется автоматически через встроенный в него натекатель.
Сущность метода ионного распыления (рисунок
3.1,б) состоит в бомбардировке быстрыми частицами 10 мишени 11, изготовленной
из осаждаемого материала. Выбиваемые в результате бомбардировки с поверхности
мишени атомы или молекулы 12 покидают ее и осаждаются в виде тонкой пленки на
поверхности подложек 13, расположенных на некотором расстоянии напротив мишени.
Положительно заряженные ионы отбираются из плазмы 9 за счет ускоряющего
напряжения, приложенного к мишени 11. На подложкодержатель 8 может подаваться
напряжение смещения для очистки пленки «медленными» ионами.
В схеме рисунка 3.1,б в качестве насоса
окончательной откачки применен криосорбционный насос NC. Для предварительной
откачки используется механический безмасляный насос NV поршневого типа.
Управление работой вакуумной системы осуществляется клапанами VA1…VA3,
натекателями VF1 VF2,
вакууметрами PA и PT.
И термическое испарение, и ионное распыление
широко применяются в производстве ИС.
Каждому из этих методов присущи свои
преимущества и недостатки. Термическим испарением добиваются наиболее высокой
чистоты осаждаемой пленки, скорость осаждения больше, чем при распылении, можно
создавать направленные пучки испаряемых молекул. К недостаткам метода
термического испарения относятся: изменение стехеометрического состава при
осаждении сложных веществ, трудность испарения тугоплавких материалов,
неравномерность толщины пленки на большой поверхности осаждения, низкая адгезия
к подложке, инерционность испарителей, сложность автоматизации.
Для метода ионного распыления характерны
сохранение стехеометрии распыляемых материалов, высокая адгезия пленки к
подложке, большой запас распыляемого материала, простота регулирования
параметров процесса: напряжения, тока разряда, давления рабочего газа. К
недостаткам метода можно отнести низкую скорость осаждения и возможность
загрязнения пленки остаточными газами, интенсивно десорбирующими с внутренних
поверхностей камеры.
4. Анализ материалов и конструкций магнетронов
для ионного распыления тонких пленок
При использовании метода термического испарения
основным фактором, определяющим эксплуатационные особенности и конструкцию
установок, является способ нагрева испаряемых материалов. По этому признаку
различают следующие типы испарителей: резистивные, электронно-лучевые,
индукционные, дуговые и лазерные.
Выбор типа испарителя для конкретных
технологических задач зависит от химической природы испаряемого материала,
температуры испарения и ее постоянства во времени, исходной формы испаряемого
материала (монолит, гранула, порошок, проволока), весовой емкости загрузки,
диаграммы направленности потока пара, длительности процесса осаждения,
требуемой производительности оборудования.
Самыми простыми по конструкции и доступными
являются испарители резистивного типа. К материалам, используемым для их
изготовления, предъявляются следующие требования: давление пара материала при
температуре испарения вещества должно быть пренебрежимо мало, между материалами
нагревателя и испаряемым веществом не должно происходить никаких химических
реакций, а также не должны образовываться легколетучие сплавы этих веществ, так
как в противном случае происходит загрязнение наносимых пленок и разрушение
подогревателей.
Для напыления пленок используют различные
материалы. К основным материалам относятся металлические покрытия (алюминий,
золото, цинк, медь, кремний, серебро, хром и др.), керамические покрытия,
оксидные материалы, нитриды различных материалов, сплавы (например, NiCr,
CrNiSi), химические соединения (силициды, оксиды, бориды, карбиды и др.),
стекла сложного состава (например, I2О3, В2О3,
SiO2, Аl2О3, СаО, Та2О, В2О3,
I2О3, GeO2). Пленки могут быть аморфными
(стеклообразными, например оксиды, Si), поликристаллическими (металлы, сплавы,
Si) или монокристаллическими (например, полупроводниковые пленки, полученные
молекулярно-лучевой эпитаксией). Для упорядочения структуры и уменьшения
внутренних механических напряжений пленок, повышения стабильности их свойств и
улучшения адгезии к поверхности изделий сразу же после напыления без нарушения
вакуума производят отжиг пленок при температурах, несколько превышающих
температуру поверхности при напылении. Часто посредством вакуумного напыления
создают многослойные пленочные структуры из различных материалов.
В установке используют следующие газы:
аргон предназначен для напыления меди, хрома,
никеля;
кислород предназначен для очистки подложек в
ВЧ-плазме и напыления оксидов в совокупности с аргоном;
азот, для напыления нитридов различных
материалов.
Установка вакуумного напыления состоит из трех
основных структурных единиц.
. Вакуумная камера, в которой производится
нанесение тонких пленок.
. Средства создания вакуума - форвакуумный насос
и диффузионный паромасляный насос с водной и азотной ловушками.
. Средства управления процессами напыления и
вакуумной системой, которое осуществляется при помощи приборов, расположенных в
стойке управления. Контроль за температурой подложки и измерение вакуума в
камере осуществляется при помощи милливольтметра постоянного тока с
хромель-алюмелевой температурой и вакуумметра
При нанесении тонких пленок чаще всего
применяются нагреватели из вольфрама, молибдена и тантала. По конструктивным
признакам резистивные испарители разделяют на проволочные, ленточные и
тигельные.
Тигельные испарители применяются для испарения
больших количеств вещества. Они изготавливаются из меди или тугоплавких
металлов (вольфрама, молибдена, тантала), из окислов и нитридов металлов (Al2O3,
BeO, ZrO2,
ThO2,
BN и другие) и графита.
Для испарения материалов с низкой температурой испарения можно использовать
тигли из стекла и кварца. Тигли из окиси алюминия используются для металлов,
температура испарения которых лежит ниже 16000С (Cu, Mn, Fe, Sn),
тигли из окиси бериллия могут быть использованы до температуры 17500С,
из окиси тория - до 22000С. При испарении материалов при
температурах, близких к 25000С, используются тигли из графита,
который достаточно технологичен и хорошо поддается механической обработке.
(например, Al, Si,
Ti).
Для обеспечения независимого управления нагревом
испарителей, а также температурой подложки, на которую осуществляется нанесение
тонкой металлической пленки, разработано трехканальное устройство управления
током. Устройство предназначается для регулирования температуры мощных
низковольтных нагревательных элементов.
5. Назначение, основные конструктивные элементы
рабочей камеры установки «Оратория-5»
.1 Назначение
Установка «Оратория-5» предназначена для
нанесения пленок алюминия легированного кремнием, на кремниевые пластины
диаметром 76, 100 мм с планетарной системой вращения подложек с предварительным
ионно-химическим травлением при производстве изделий электронной
промышленности.
Установка «Оратория-5» может применяться
автономно и в составе линии.
Установка обеспечивает работу при подаче в нее:
а) сжатого воздуха под давлением 4*105…5*105
Па;
б) холодной воды (+15±100С) под
давлением 3*105…4*105 Па расходом не менее 2,8*10-4
м3/с;
в) жидкого азота расходом 0,075 м3/смену.
Питание установки «Оратория-5» осуществляется от
трехфазной четырехпроводной с нулевым проводом сети переменного тока
напряжением 380 В, частотой 50 Гц.
.2 Основные конструктивные элементы
Вакуумная установка «Оратория-5» имеет шлюзовую
и рабочую камеры, которые разделены затвором.
Для создания в рабочей камере вакуума 5*10-5
Па необходимо два часа, а для напыления одного слоя металла не больше двух
минут. Поэтому в этой установке рабочая камера находится под вакуумом, а
разгерметизируется только шлюзовая камера для загрузки в нее планетарного
подложкодержателя с пластинами.
Установка «Оратория-5» имеет 4 позиции:
шлюзовая камера для загрузки-выгрузки пластин;
камера нагрева;
первый магнетрон;
второй магнетрон.
Подъемная крышка рабочей камеры обеспечивает
доступ к внутрикамерным устройствам для их обслуживания, ремонта, обработки.
Обработка пластин производится на планетарном подложкодержателе с двумя осями
вращения.
Вакуумная система построена на основе
диффузионного насоса, механического насоса, высоковакуумного затвора азотной ловушки.
Управление осуществляется с помощью программатора, который обеспечивает
стабилизацию токоразряда по давлению газа, последовательность работы механизма
и напуск азота в шлюзовую камеру для разгерметизации.
Установка «Оратория-5» состоит из следующих составных
частей и комплектов:
ü установка вакуумная;
ü ВЧ-генератор;
ü шкаф управления;
ü комплект ЗИП;
ü составные части, снимаемые при
транспортировании.
После окончания рабочего цикла каждый
подложкодержатель возвращается на исходную позицию.
6. Порядок подготовки установки к работе
.Установку «Оратория-5» нужно разместить на
площади 14 м2;
.При помощи кабелей соединить вакуумную
установку со шкафом управления;
.Подключить установку «Оратория-5» к трехфазной
четырехпроводной сети переменного тока напряжением 380В частоты 50Гц;
.Подсоединить установку «Оратория-5» к системе
вытяжной вентиляции с расходом воздуха не менее 1,67*10-1 м3/с;
.Подсоединить установку «Оратория-5» к сети
питания сжатым воздухом давлением от 4*105 до 5*105 Па;
.Подсоединить установку «Оратория-5» к
водопроводу с давлением от 3*105до 4*105 Па и
температурой от +15 до +250С;
.Подсоединить установку «Оратория-5» к баллону
аргона давлением от 0,5*105 до 4*105 Па;
.Сдача в эксплуатацию смонтированного
оборудования;
.Проверить оборудования, изделия и материалы,
необходимые для проверки соответствия установки «Оратория-5» требованиям;
.Проверить время достижения предельного
остаточного давления 6,65*10-5 Па в рабочей камере установки и
измерить остаточное давление в рабочей камере и шлюзе;
.Проверить мощность высокочастотного разряда,
давление газа в шлюзе и измерить расход газа;
.Произвести проверку мощности магратрона,
рабочего напряжения, стабильности тока разряда, индикацию процесса напыления и
измерить ток и напряжение магратрона;
.Произвести проверку автоматического цикла.
7. Основные неисправности и методы их устранения
Таблица 1- Основные неисправности и методы их
устранения
|
Наименование
неисправности
|
Вероятная
причина
|
Метод
устранения
|
|
Мала
скорость откачки из шлюза
|
Окислилось
масло в форнасосе шлюза
|
Заменить
масло в форнасосе шлюза
|
|
Самопроизвольно
откачивается питание магратронов по вакуумной блокировке
|
При
опускании уплотнения и шлюза давление в камере увеличивается выше 1,33*10-2
Па
|
а)
проверить скоростьоткачки паромасляного насоса и при необходимости сменить
масло в насосе; б) увеличить напряжение магратрона для работы аргона
|
|
Мала
температура нагрева подложек, ток нагрева ниже нормы
|
Сгорела
часть ламп нагревателя
|
Сменить
сгоревшие лампы
|
|
Не
включается напряжение нагревателя
|
Мал
расход охлаждающей воды
|
Увеличить
расход воды
|
|
Не
включается напряжение магратрона
|
Мал
расход воды в магратроне
|
Увеличить
расход воды
|
|
Качается
ток магратрона. Ток магратрона не увеличивается до заданного значения
|
Не
правильно выбрано положение иглы вибронатекателя или напряжение магнетрона
|
Отрегулировать
вручную положение иглы натекателя. Изменить напряжение магнетрона
|
|
Частые
пробои в магратроне
|
Загрязнена
поверхность материала катода магратрона
|
Отрегулировать
магратрон при пониженном напряжении до исчезновения пробоев
|
|
Не
включается генератор высокой частоты
|
Открыта
дверь вакуумной установки
|
Закрыть
все двери вакуумной установки
|
|
Мал
ток анода. Мала падающая мощность высокочастотного разряда
|
а)
неисправен ГВЧ; б) мало давление травящих газов; в) нет согласования ГВЧ с
нагрузкой
|
а)
проверить ГВЧ; б) увеличить давление травящих газов; в) с помощью устройства
согласования согласовать ГВЧ с нагрузкой
|
|
Самопроизвольно
остановился автоматический цикл
|
а)
не сработал микровключатель шлюза, уплотнения и карусели; б) не сработала
блокировка о наличии высокого вакуума в камере
|
а)
исправить датчик конечного положения дефектного механизма; б) устранить
неисправность блокировки по вакууму камеры
|
8. Расчет скорости откачки рабочей камеры
Рассчитаем скорость откачки рабочей камеры с
помощью программы «Вакуумная техника - ZXSOFT».

В главном окне программы необходимо выбрать
расчет длительности откачки.

Для расчета длительности откачки рабочей камеры
нужно ввести: объем откачиваемого сосуда, диаметр трубопровода, фактическая
длина трубопровода, требуемое давление откачки, суммарное газовыделение со
стенок, количество колен трубопровода. Для получения результатов нажимаем «ОК».

9. Мероприятия по охране труда
Охрана труда- система сохранения жизни и
здоровья работников в процессе трудовой деятельности, включающая в себя
правовые, социально-экономические, организационно-технические,
санитарно-гигиенические, лечебно-профилактические, реабилитационные и иные
мероприятия
Вредный производственный фактор-
производственный фактор, воздействие которого на работника может привести к его
заболеванию.
Опасный производственный фактор -такой,
воздействие которого на работника может привести к его травме.
Охрана труда состоит из трех частей:
. Производственная санитария - это
система организационных, гигиенических и санитарно-технических мероприятий и
средств предотвращающих воздействие на работающих ВПФ.
. Техника безопасности - это система
организационных и технических мероприятий и средств предотвращающих воздействие
на работников ОПФ.
. Пожарная безопасность - это состояние
объекта при котором исключается возможность быстрого возникновения пожара, а в
случаи его возникновения предотвращения воздействия на людей опасных факторов и
обеспечение защиты материальных ценностей.
Установка «Оратория-5»
. К работе на установке «Оратория-5» допускаются
лица, изучившие инструкцию по технике безопасности при работе на данном
оборудовании, а также местный инструктаж по безопасности труда;
. Установку «Оратория-5» может
обслуживать один человек, имеющий квалифицированную группу по технике безопасности
не ниже первой;
. Перед эксплуатацией установки
«Оратория-5» подключить к цеховому контуру заземления с помощью голой медной
или стальной шины сечением не менее 10 мм2. Болты для подключения
защитного заземления размещены на задней стенке шкафа управления и на задней
стенке вакуумной установки;
. Наладочные работы, осмотры и ремонт
механизмов производить только после отключения установки «Оратория-5» от сети
питания с помощью выключателя СЕТЬ шкафа управления;
. Запрещается во время работы отключать кабели,
соединяющие между собой отдельные составные части установки «Оратория-5»;
Запрещается работа на установке «Оратория-5» при
открытых дверях вакуумной установки и шкафа управления
Заключение
В данном курсовом проекте я приобрел
практические навыки по эксплуатации и обслуживанию оборудования для получения
тонких пленок. В ходе выполнения проекта провел обзор современного оборудования
и выбрал оптимальное, проанализировал методы нанесения тонких пленок, материалы
и конструкции магнетронов для ионного распыления тонких пленок и выбрал
оптимальное. Провел осмотр основных конструктивных элементов рабочей камеры и
принцип действия оборудования для нанесения тонких пленок, порядка подготовки,
основных неисправностей и методов их устранения. Проанализировал вопросы по
охране труда. Разработал алгоритм обслуживания установки, рассчитал время
откачки шлюза.
Литература
1
Ю. В. Панфилов, В. Т. Рябов, Ю. Б. Цветков - Оборудование производства
интегральных микросхем и промышленные роботы. Москва - Радио и связь, 1996
О.
С. Моряков «Устройство и наладка оборудования полупроводникового производства».
Москва - Высшая школа, 1989
Н.
Айнспрук, Д. Браун - Плазменная технология в производстве СБИС. Москва - Мир,
1987
Л.
Н. Розанов - Вакуумная техника. Москва - Высшая школа, 1990
В.
И. Кузнецов, Н. Ф. Немилов, В. Е. Шамякин - Основы вакуумной техники.
Издательство - Энергия, 1878
Нормативная
документация
ГОСТ
2.301 - 68 ЕСКД. Форматы.
ГОСТ
12.1.004 - 91 ССБТ. Пожарная безопасность.
ГОСТ
2.302 - 68 ЕСКД. Масштабы.
ГОСТ
12.0.003 - 74 ССБТ. Опасные и вредные производственные факторы.