Температурные зависимости параметров вольт-амперной характеристики резонансно-туннельного диода
Научно-исследовательский
ядерный университет
Московский
инженерно-физический институт
«Компьютерного
моделирования, физики наноструктур и сверхпроводимости»
Контрольная
работа
на
тему: «Температурные зависимости параметров вольт-амперной характеристики
резонансно-туннельного диода»
г.
Введение
В настоящее время интерес к
резонансно-туннельным структурам (РТС) вызван как с точки зрения их
фундаментального исследования, так и с точки зрения большого количества
возникающих возможностей для их практического применения. Преимущества
использования РТС в качестве компонентов интегральных схем (ИС), где они могут
дать существенный прирост производительности за счет возможности работать на
больших частотах. Одним из видов таких РТС является резонансно-туннельный диод
(РТД). Для построения ИС на основе РТД, необходимо знать статические и
динамические параметры, в том числе вольт-амперные характеристики (ВАХ) и
вольт-фарадные характеристики (ВФХ). Данная работа направлена на
экспериментальное исследование характеристик ВАХ и ВФХ РТД и их зависимости от
температуры.
Литературный обзор
Динамика изменения характеристик резонансного
туннелирования в широком температурном диапазоне изучена слабо и ограничивается
областью температур Т>77 К. Так, например, в [1, 2] представлены результаты
исследования термически активированного резонансно-туннельного тока при низких
уровнях напряжений, из которых было определено положение квантового уровня по
отношению к уровню Ферми контакта. В [3] проведены измерения (статистических
ВАХ в диапазоне Т=77-300 К, откуда затем определены температурной зависимости
отношения токов пик/долина двухбарьерной резонансно-туннельной структуры
AlxGa1-xAs/GaAs.
В 1974 году Чанг, Эсаки и Тсу [4] наблюдали
резонансное туннелирование в двубарьерных структурах типа Ga0.3Al0.7As - GaAs -
Ga0.3Al0.7As: первая с шириной барьеров 80 Å
и шириной ямы 50Å; вторая с
шириной барьеров и ямы по 40 Å
соответственно. Высота барьеров в обоих случаях 0.4 эВ. Концентрация электронов
в подложке и электродах (GaAs) n = 1018 см-3, а энергия Ферми 40 мэВ.
Они рассмотрели зависимость кондактанса от
напряжения при температурах 4.2 К, 77 К и 300 К. На рис.1 представлены данные,
полученные Чангом, Эсаки и Тсу для первой структуры. При комнатной температуре
мы видим монотонную кривую зависимости кондактанса от напряжения, что говорит о
сильном температурном размытии и подразумевает относительно малую высоту
барьера. С уменьшением температуры начинают проявляться особенности зависимости
кондактанса от температуры. Это говорит о том, что большой вклад в
туннелирование вносят фононы. При Т=4.2 К кривая имеет схожий характер, кроме
известного аномального поведения при нулевом напряжении смещения. Тот факт, что
особенности полученной зависимости при гелиевой температуре сгладились,
объясняется наличием структурных флуктуаций и рассеянием на примесных атомах.
Ассиметричный характер зависимостей кондактанса от напряжения объясняется
ассиметричностью исследуемой двухбарьерной структуры.

Рис. 1 - Зависимость кондактанса от напряжения
смещения для двухбарьерной гетероструктуры
Нельзя не отметить работу Соллнера [5] и его
соавторов 1983 года.
Они наблюдали резонансное туннелирование при
комнатной температуре и признаки области ОДС при 200 К. Параметры образца
Ga0.75Al0.25As/ GaAs /Ga0.75Al0.25As: ширина барьеров и ямы по 50 Å,
концентрация доноров в яме ND2 = 1017см-3, концентрация доноров во внебарьерном
GaAs ND1=ND3 = 1018см-3, высота барьеров 0.23 эВ.Так же исследовался отклик на
внешний терагерцовый сигнал, вследствие чего была выявлена граничная частота
при 2.5 ТГц. Эта работа показала, что резонансно-туннельный диод на
двубарьерной гетероструктуре может быть хорошим терагерцовым генератором.
С момента своего появления на свет, резонансно-туннельный
диод никогда не переставал быть интересным для многих физиков (бурное развитие
технологии способствует получению все более и более чистых и качественных
образцов). К таким ученым можно отнести Мёрфи, Эйзенштейна, Пфайфера и Веста.
Прежде чем обратить внимание на их работу, связанную с температурной
зависимостью [7], нужно сначала упомянуть о другой работе, которая посвящена
образцу [6], в которой подробно описана исследуемая в работе [7] структура. На
рис. 2 изображена схема исследуемого образца. Образец представляет собой
двухямную гетероструктуру GaAs / AlGaAs / GaAs (пленки GaAs шириной в 200 Å
- квантовые ямы, пленка AlGaAs в 175 Å
- барьер), которая была получена методом молекулярно-пучковой эпитаксии. По
краям образца вожжены индиевые контакты (на боковом разрезе на верхней вставке
обозначены как «С»). Они образуют омический контакт к обеим ямам одновременно
(ямы заштрихованы). Электроды “Top Gate” и “Bottom Gate” нанесены методом
фотолитографии. Подавая на них отрицательный потенциал, можно добиться того,
что каждый из индиевых электродов образует контакт к разным ямам. Например,
отрицательный потенциал, приложенный к электроду “Top Gate” приводит к
обеднению электронами той части ямы, которая находится под ним. Аналогично дело
обстоит с другой ямой и электродом “Bottom Gate”. На нижней вставке рис.2
изображен вид сверху этого образца. Он сделан в форме креста. Такая форма
позволяет использовать четырехконтактный метод Ван дер Пау для измерения
подвижности электронов и представляется возможным определить их концетрацию при
помощи эффекта Холла и Шубникова-де Гааза.

Рис. 2 - Схематическое изображение образца из
работы
Аналогичные три образца были использованы в
статье [7] (ширины барьеров AlxGa1-xAs различаются в диапазоне от 175 Å
до 340 Å
и 0.1 < x < 0.33). Эта статья посвящена влиянию электрон-электронного
(e-e) и электрон-фононного (e-ph) рассеяний на ширину резонансного пика.
Измерения были проведены методом туннельной спектроскопии при четырех температурах
в диапазоне от T = 110.7 K до 10 K. Поскольку при 2D-2D туннелировании, а здесь
рассматривается именно оно, сохраняется компонента импульса, параллельная
барьеру, то туннельная проводимость должна обращаться в нуль при всех
напряжениях, кроме тех, при которых уровни квантования в ямах выравниваются.
Авторы этой работы считают, что в данном случае e-e рассеяние вносит
доминирующий вклад в уширение пика.

Рис. 3 - Зависимость туннельной проводимости от
напряжения при разных температурах
На рис. 3 приведена зависимость dI/dV от V для
образца с одной и той же концентрацией электронов в обеих ямах (Ns = 1.6×10^11
см-2). Из графика видно, что при увеличении температуры пик уширяется и
понижается, а значит, время жизни электронов уменьшается из-за e-e рассеяния в
каждой яме. Во вставке рис.4 представлен график функции F(V)=I/V, которая
получена из данных dI/dV численным интегрированием. С этой функцией удобнее
работать, поскольку при сохранении импульса F(V) является сверткой спектральной
функции A(E,k) 2D-электронов (спектральная функция A(E,k) дает вероятность
того, что электрон с волновым вектором k имеет энергию E, и обладает сильным
пиком при энергии (ħ2 k2 /2m)). В основной части рисунка приведена
температурная зависимость ширины Г кривой F(V) для трех образцов. Образцы А и В
имеют почти равные концентрации 2D-электронов в ямах ( Ns = 1.6×10^11
см-2 у образца А и Ns = 1.5×10^11
см-2 у В ), но разное значение Г (Т=0) (так называемое количество статического
беспорядка). Образец С имеет меньшую плотность (Ns = 0.8×10^11
см-2), но такое же количество статического беспорядка, что и образец В. Факт,
что при температуре ниже T= 2 K кривая Г почти не зависит от T, является
свидетельством того, что неупругие процессы становятся пренебрежительно малыми.
В этом режиме ширина резонансной кривой чувствительна к плотности
неоднородностей и рассеянию на статическом неупорядоченном потенциале
(например, на Si-донорах). При температуре T > 2 K величина Г растет
квадратично с температурой. Причем видно, что Г увеличивается с уменьшением
концентрации Ns, следовательно, температурная часть Г зависит от плотности 2D
электронов, а не от беспорядка. А это в свою очередь предполагает неэластичные
процессы, такие, как e-e и e-ph (акустические фононы) рассеяния. Но вклад e-ph
рассеяния можно считать малым, так как при туннелировании с участием фононов с
ростом температуры пик туннельной проводимости увеличивался бы.

Рис. 4 - Зависимость ширины Г кривой F(V) от
температуры из работы
По получению вольт-амперных характеристик РТД к
настоящему времени проведено много работ, в том числе работы по изучению
зависимости ВАХ от температуры.
В работе [8] были исследованы ВАХ в диапазоне
температур 10-200 К. В качестве образца исследования выступали РТД дырочного
типа на основе гетероструктуры Si0.6Ge0.4/Si(1 0 0), изготовленные методом
химического парофазного осаждения при пониженном давлении (LPCVD). Толщина
Si0.6Ge0.4-квантовой ямы, Si-барьеров и Si0.6Ge0.4-спейсерных слоев -7, 4 и 15
нм соответственно. На рис.5 представлены полученные зависимости ВАХ.

Рис. 5 - ВАХ при T=10-200 К
Из экспериментальных ВАХ были получены
температурные зависимости следующих параметров РТД в прямом и обратном
направлении: напряжения смещения пика (рис.2а), тока пика (рис.2b), тока долины
(рис.2c), отношения ток пика/ток долины (рис. 2d), разности тока пика-тока
долины (рис. 2e).

Рис. 6 - Температурные зависимости параметров
РТД
Напряжении смещения пика постепенно уменьшается
с увеличением температуры, а при Т=110-120 К наблюдается резкий спад
напряжения, минимальное значение Vpeak=8 mV при T=200 K. Причиной подобного
скачка авторы назвали возможные изменения в процессе туннелирования, связанные
с уменьшением энергии резонансного уровня тяжелых дырок в квантовой яме
вследствие увеличения величины их эффективной массы. Зависимости токов пика и
долины от температуры имеют немонотонный характер: увеличение до максимального
значения при Т=30-70 К, а далее-резкий спад в том же температурном диапазоне
Т=100-120 К, в котором наблюдался и спад напряжения смещения пика.
Температурные зависимости (Ipeak/Ivalley) и (Ipeak-Ivalley) слабо изменяются
при низких температурах, а по достижении области спада напряжения смещения пика
терпят резкий скачок до максимума. При дальнейшем увеличении температуры
отношение тока пика к току долины уменьшается. Такой характер зависимости, по
мнению авторов статьи, связано с тем, что рост туннельного тока происходит
медленнее, чем рост фонового тока, возникновение которого связано с наличием
примесей и других факторов.
В статье [9] проведены измерения зависимости ВАХ
от температуры. В качестве образца использовалась трехбарьерная РТС
InGaAs/InAlAs, выращенная на подложке InP(001) методом молекулярной лучевой
эпитаксии (MBE). Толщина первой и второй InGaAs-квантовых ям- 6.8 и 5 нм
соответственно, верхнего InAlAs-барьера-1,9нм, среднего-3,1 нм, нижнего-1,9. В
качестве спейсерных слоев выступали слои из InGaAs толщиной 5,6 нм, контактных
слоев- n+ InGaAs, допированные Si, n=1*10^18 см-3. На рис.7(а) показаны
вольт-амперные характеристики трёхбарьерной структуры InGaAs/InAlAs, размером
3*6 мм2, полученные при комнатной (300 К) и азотной (77 К) температурах.
Эксперимент показывает, что наблюдается незначительная зависимость значения
тока пика и долины от температуры. Ток пика незначительно уменьшается при 77 К
по сравнению с 300К при V=0,2В. Так же ВАХ при 77К имеет более широкую
нисходящую часть и более высокое значение напряжения долины.

Рис. 7(a) - ВАХ РТС InGaAs/InAlAs при комнатной
и азотной температурах
На рис 7(б) приведена вольт-амперная
характеристика трёхбарьерной структуры GaAs/AlAs, размером 3*6 мм2 при комнатной(300к),
азотной(77к) и гелиевой(4к) температурах.

Рис. 7(b) - ВАХ РТС GaAs/AlAs при комнатной,
азотной и гелиевой температурах
В трёхбарьерной структуре GaAs/AlAs наблюдается
более ярко выраженная зависимость ВАХ от температуры. С понижением температуры
уменьшается пиковое значение тока, так же уменьшается отношение пик-долина.
Экспериментальная часть
В качестве образцов исследования выступали два
типа РТД, каждый из которых выполнен на основе гетероструктуры GaAs/AlAs,
выращенной методом молекулярно-лучевой эпитаксии. РТД представляет собой
двухбарьерную квантовую структуру, где барьерами являются слои из AlAs, а
квантовой ямой-слой GaAs. Слои образуют характерный двухбарьерный потенциальный
профиль дна зоны проводимости (рис.8). Параметры структуры представлены в табл.
1. Различие между двумя типами РТД состоит в разной площади мезы, для одного
она составляет 6х6 мкм2, для другого 20х20 мкм2.
Табл. 1 - Размеры слоев двухбарьерной квантовой
структуры
|
№
слоя
|
Материал
|
Толщина
слоя, А
|
|
1-конт.слой
|
GaAs,
концентр.носителей 1*1018 см-3
|
1000
|
|
2-спейсер
|
GaAs,
нелегированный
|
100
|
|
3-барьер
|
AlAs,
нелегированный
|
23
|
|
4-кв.яма
|
GaAs,
нелегированный
|
45
|
|
5-барьер
|
AlAs,
нелегированный
|
20
|
|
6-спейсер
|
GaAs,
нелегированный
|
400
|
|
7-конт.слой
|
GaAs,
концентр.носителей 1*1018 см-3
|
5000
|
На рис. 8 представлена фотография двух образцов
с мезой 6х6 мкм2, сделанная оптическим микроскопом с 200-кратным увеличением.
На нижней контактной площадке размещена структура, сверху подведена верхняя контактная
площадка.

Рис. 8 - Энергетическая диаграмма РТД с
приложенным напряжением смещения
Рис. 9 - Образец с мезой 6х6 мкм2
Стоит заметить, что структура несимметричная,
основное отличие в размере спейсерных слоёв. Поэтому были проведены
исследования как прямого, так и обратного включения РТД. Прямое и обратное
включение определяется направлением тока через структуру. Измерения ВАХ и ВФХ
РТД проводились на созданных ранее специализированных установках. Напряжение
смещения задавалось с внешнего прецизионного источника питания. Для охлаждения
образца до температуры 12 К был применен криокулер, использующий замкнутый цикл
гелия.
. Измерение ВАХ РТД.
Основными параметрами, характеризующими ВАХ,
являются отношение токов пик-долина, положение и ширина области отрицательной
дифференциальной проводимости (ОДП).
Измерение ВАХ при прямом включении РТД (образец
с мезой 6х6 мкм2)
В диапазоне температур 12- 293 К были измерены
вольт-амперные характеристики образцов в прямом направлении. На рис.1 приведены
ВАХ, полученные при температурах Т = 293 К и Т = 12 К.

Рис. 10 - ВАХ РТД в прямом направлении
Как можно заметить, ВАХ изменяется с падением
температуры как внутри области ОДП, так и до области ОДП (выполаживается), и
сама область ОДП смещается в сторону больших напряжений.
По полученным ВАХ были найдены значения
максимума модуля отрицательной дифференциальной проводимости:
|
Т=12
К
|
Т=293
К
|
|
Максимальный
модуль ОДС, ±0,1 См
|
0,53
|
0,20
|
|
Напряжение
смещения, ±2 мВ
|
1344
|
1084
|
Из полученных данных видно, что при уменьшении
температуры образца, максимальное значение отрицательной дифференциальной
проводимости увеличивается и смещается в сторону более высоких напряжений.
Для более детального исследования из ВАХ при
промежуточных значениях температуры были получены следующие дополнительные зависимости:
) Зависимость границ ОДП от температуры образца.

Рис. 11
Видно, что при уменьшении значения температуры,
ширина области ОДП сужается, а при приближении температуры РТД к азотной,
ширина ОДП становится почти постоянной.
) Зависимость тока пика и тока долины от
температуры образца.

Рис. 12
При понижении температуры до азотной значение
разность тока пика и тока долины увеличивается, при дальнейшем понижении
разность практически перестаёт изменяться.
) Зависимость отношения ток пика/ток долины от
температуры образца.

Рис. 13
Данная зависимость показывает, что с уменьшением
значения температуры отношение растёт, однако при приближении к азотной
температуре рост отношения пика к долине приостанавливается и отношение выходит
на почти постоянное значение.
) Зависимость средней дифференциальной
проводимости от температуры образца.

Рис. 14
Данная зависимость показывает, что при понижении
температуры образца, средняя дифференциальная проводимость повышается.
) Зависимость средней мощности возможного
излучения от температуры образца.

Рис. 15
При понижении температуры РТД средняя мощность
возможного излучения уменьшается.
Измерение ВАХ при обратном включении РТД
(образец с мезой 20х20 мкм2)
В диапазоне температур 52 - 298 К были измерены
вольт-амперные характеристики образцов в обратном направлении. На рис.1
приведены ВАХ, полученные при температурах Т = 298 К и Т = 52 К.

Рис. 16 - ВАХ РТД в обратном направлении
ВАХ изменяется с падением температуры как внутри
области ОДП, так и до области ОДП, а сама область ОДП смещается в сторону
больших напряжений.
По полученным ВАХ были найдены максимальные
значения отрицательной дифференциальной проводимости:
|
Т=52
К
|
Т=293
К
|
|
Максимальный
модуль ОДС, ±0,1 См
|
0,41
|
0,50
|
|
Напряжение
смещения, ±2 мВ
|
1002
|
806
|
Таким образом, при подключении РТД в обратном
направлении, при понижении температуры максимум дифференциальной проводимости
уменьшается и смещается в область более высоких напряжений смещения.
При промежуточных значениях температуры были
получены следующие дополнительные зависимости:
Зависимость границ ОДП от температуры образца.

Рис. 17
Легко заметить, что при обратном включении РТД
понижение температуры до азотной способствует расширению области ОДП,
) Зависимость тока пика и тока долины от
температуры образца.

Рис. 18
При понижении температуры разность токов пика и
долины увеличивается.
) Зависимость отношения ток пика/ток долины от
температуры образца.

Рис. 19
Отношение тока пика к току долины схоже зависит
от температуры, как и в случае прямого подключения РТД.
) Зависимость средней дифференциальной
проводимости от температуры образца.

При понижении температуры средняя
дифференциальная проводимость уменьшается.
) Зависимость средней мощности возможного
излучения от температуры образца.

Рис. 21
Из полученной зависимости видно, что при понижении
температуры мощность возможного излучения увеличивается.
. Измерение ВФХ РТД.
Для получения ВФХ был использован метод,
основанный на измерении разности фаз между током и напряжением измерительного
сигнала, с помощью фазового детектора. Напряжение смещения задавалось с
внешнего прецизионного источника питания. Для охлаждения образца до температуры
12 К был применен криокулер, использующий замкнутый цикл гелия.
ВФХ при Т=293К

Рис. 22
Полученные зависимости ВФХ имеют немонотонный
характер - наблюдаются области с почти неменяющейся ёмкостью, области с резкими
пиками и отрицательной ёмкостью. Все особенности кривой находятся в области
отрицательной дифференциальной проводимости. При прохождении в обратном направлении
наблюдается небольшой гистерезис в пиках.
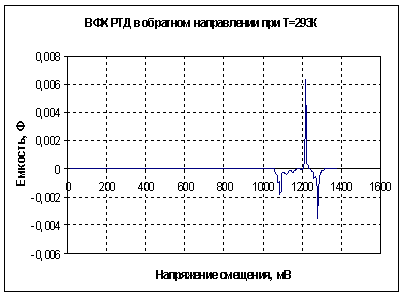
Рис. 23
ВФХ при Т=12К.
При понижении температуры общий характер кривой
сохраняется, однако все особенности в области ОДП достаточно сильно
сглаживаются.

Рис. 24
резонансный туннельный диод
напряжение

Рис. 25

Рис. 26
Выводы
В работе были измерены ВАХ и ВФХ РТД при
температурах от 298 К до 12 К в прямом и обратном направлениях.
ВАХ изменяется с падением температуры как внутри
области ОДП, так и до области ОДП (выполаживается), и сама область ОДП
смещается в сторону больших напряжений. По полученным ВАХ были найдены:
значения максимума модуля отрицательной
дифференциальной проводимости. При прямом подключении с уменьшением температуры
образца максимальное значение ОДП увеличивается и смещается в сторону более
высоких напряжений. При подключении РТД в обратном направлении с понижением
температуры максимум дифференциальной проводимости уменьшается;
зависимость границ ОДП от температуры образца.
Оказалось, что при прямом включении РТД понижение температуры способствует
сужению области ОДП, а при обратном-расширению;
зависимость тока пика и тока долины от
температуры образца. И в прямом, и в обратном направлении при понижении
температуры разность токов пика и долины увеличивается;
зависимость отношения ток пика/ток долины от
температуры образца. Обнаружено, что с понижением температуры до азотной,
отношение растёт, при дальнейшем понижении температуры отношение токи
пика/долины выходит практически на постоянное значение. Данная тенденция
сохраняется при прямом и обратном включении РТД;
зависимость средней дифференциальной
проводимости от температуры образца. При понижении температуры средняя
дифференциальная проводимость увеличивается при прямом подключении и
уменьшается при обратном;
зависимость средней мощности возможного
излучения от температуры образца. Из полученной зависимости видно, что при
понижении температуры средняя мощность возможного излучения уменьшается при
возрастающем напряжении и увеличивается при убывающем.
Воль-фарадные характеристики РТД при Т=293К и
Т=12 К имеют особенности в области ОДП. В обоих случаях наблюдается гистерезис
по емкости в пиках кривой. При понижении температуры особенности на ВФХ
по-прежнему присутствуют и сдвигаются за областью ОДП, однако наблюдается
значительное уменьшение их амплитуды.